InGaAs/GaAs 多量子阱近紅外光探測結構設計與表征*
李林森,汪 濤,朱 喆
(華東微電子研究所 微系統安徽省重點實驗室,安徽 合肥 230088)
0 引言
光探測器是一種能夠將光信號轉換成電信號的器件,因為近紅外光覆蓋的波長范圍較寬(760 nm~2 526 nm),對其進行探測分析具有潛在的軍民用價值,例如,可以通過近紅外光探測進行敵我識別、戰略預警,紅外制導可以實現末端打擊,紅外夜視可用于單兵作戰,民用領域主要有近紅外光纖通信、工業探傷檢測、氣象探測與地球資源探測、安防監控等[1-4]。正是因為近紅外探測的諸多應用需求,使得全世界范圍內的科研工作者傾注了大量的精力去研究近紅外特測材料、結構及器件。近年來,隨著對固體物理、半導體物理的認識不斷深入,以及先進制造技術例如分子束外延(MBE)、金屬化合物氣相沉積(MOCVD)、原子層沉積(ALD)等的不斷發展,科研工作者可以根據半導體能帶結構與特征設計一些新穎的結構例如量子阱、量子點等以實現各探測波段的高性能,并通過先進的半導體制程實現探測器的小尺寸和高可靠性。
半導體材料有明顯的內光電效應,所以絕大多數近紅外光電探測器采用半導體材料制作。半導體光探測器相對于光電真空管的主要優點有:較低的偏壓、寬光譜響應范圍、高峰值量子效率、寬工作溫度范圍、優異的工作參數一致性以及對機械應力有較高的耐受能力和可批量生產性[5]。目前應用于紅外輻射探測的半導體材料體系主要包括:利用本征效應的II-VI 族、III-V 族和IV-VI 族窄帶隙化合物半導體材料,利用非本征效應的硅摻雜和鍺摻雜材料,還有近年來發展的量子阱和超晶格材料。表1 中總結了這幾類紅外探測材料體系及其優缺點[6-7],從中可以看到目前最常用的HgCdTe 三元系金屬化合物屬于窄禁帶半導體材料,可通過對其組分的調控,進而使得其探測器的工作波段分布于l μm~20 μm整個紅外波段,但是在用HgCdTe 制備短波探測器時,由于組分相差非常大,材料合成難度高,同時工藝溫度很高,產生的Hg 蒸汽壓高難以控制,此外材料的分凝現象嚴重,因此其體材料生長的難度很大,器件的平面工藝也很困難。與之相比較而言,InGaAs/GaAs 體系的探測結構在材料的生長上則非常成熟,可以通過MBE 技術外延出大面積均勻的有源層,通過半導體工藝可以進行大規模的集成,最為重要的是其在室溫下可以無需冷卻系統地工作,極大地提高了器件使用的自由度。另一方面,在探測波長為2.5 μm 以下時,InGaAs/GaAs 器件已表現出比HgCdTe 器件更為優異的性能。
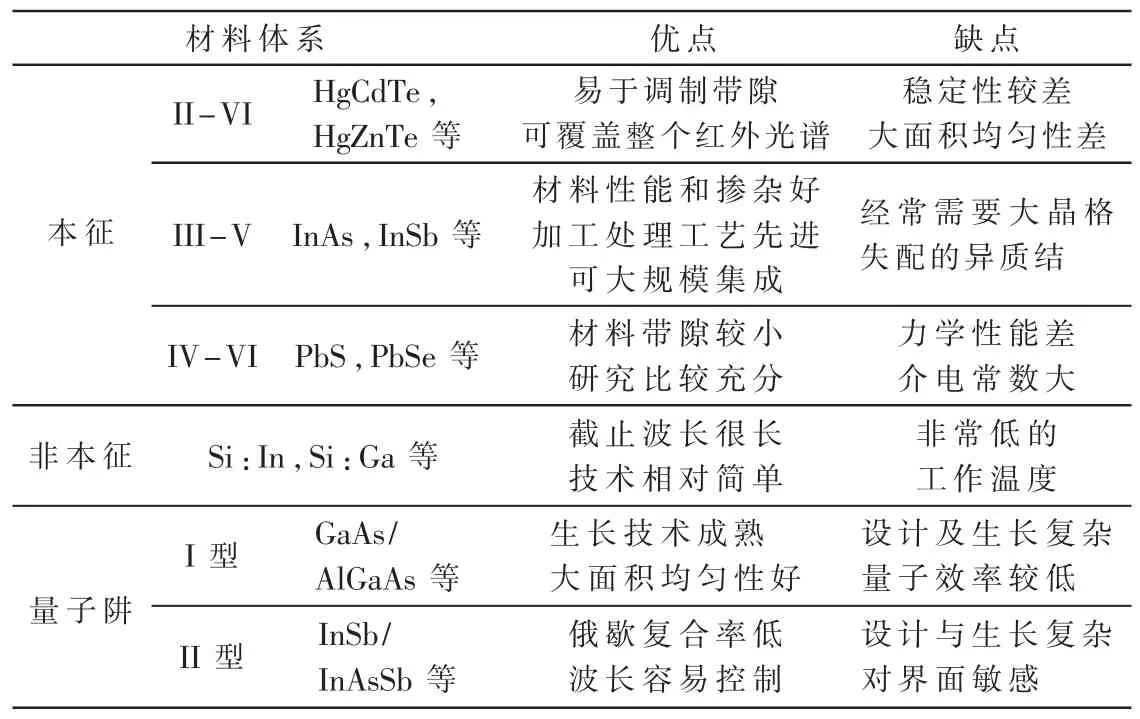
表1 用于紅外光探測器的主要材料體系及其優缺點
表2 列出了近紅外幾個波段下兩種器件的優值因子RoA 值的比較[8](300 K 對應于室溫,220 K 對應著四級熱電制冷的溫度)。從表2 可以看出,在相同的工作溫度下,對于同一個波段InGaAs 有源層的RoA 比HgCdTe材料高出了l~2 個數量級,室溫工作的InGaAs 甚至已經達到熱電制冷溫度HgCdTe 器件的水平。
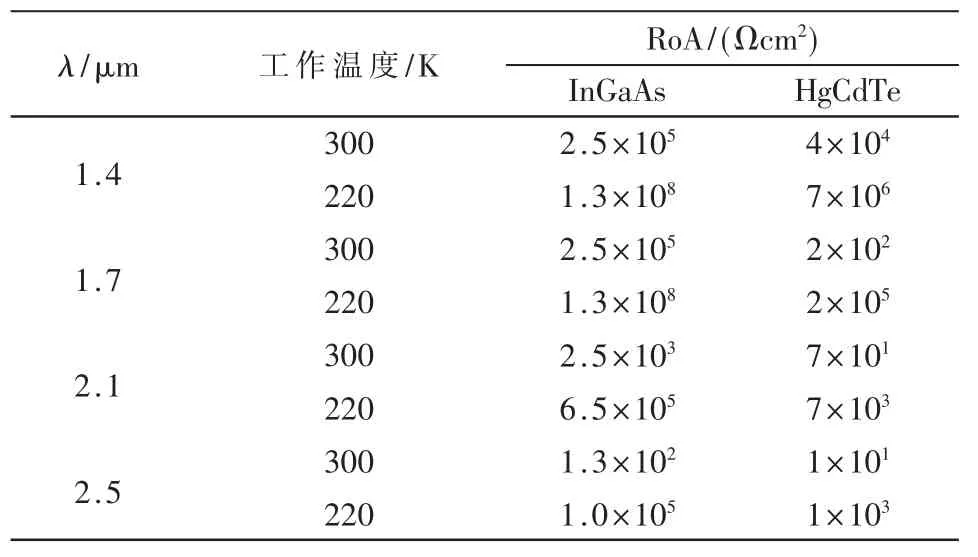
表2 InGaAs 和HgCdTe 的RoA 的比較
綜上所述,本文重點研究的是探測波長為1 μm 左右的近紅外探測器材料與結構,因此,選擇InGaAs/GaAs材料作為核心外延層,作者從理論計算開始,通過設定合理邊界條件,利用軟件Mathematica 編寫求解GaAs/InGaAs 單量子阱有限深勢阱的波函數方程,并據此設計出近紅外光上轉換器的GaAs/InGaAs 多量子阱的無機探測器結構。參考計算結果,利用MBE 方法在N-GaAs 襯底上生長GaAs/InGaAs 多量子阱的外延片,通過雙晶X 射線衍射、光致熒光光譜等分析手段,推算出量子阱結構中In 的組分、勢壘與勢阱的厚度,實驗結果與理論計算結果一致,具有很好的近紅外探測器研制價值。
1 InGaAs 材料體系
InGaAs 是一種典型的III-V 族三元化合物半導體材料,通過調整化合物中In、Ga 的比例,其禁帶寬度可在InAs 的0.35 eV 與GaAs 的1.43 eV 之間變化,對應的探測截止波長分別為3.5 μm 與0.87 μm,所以InGaAs 是制備短波紅外探測器的合適材料。InGaAs 材料最初應用于光纖通信領域,由于In0.53-Ga0.47As 的禁帶寬度為0.75eV,截止波長為1.7 μm,正好可以覆蓋光纖通信常用的1.31 μm、1.55 μm 波長,同時它和InP 材料可以做到晶格完全匹配,因此通過外延工藝可以在InP 襯底上生長出質量很高的有源層結構并制備出高質量的器件。在光纖通信需求的推動下,InGaAs 材料和器件技術有了很大的發展,技術日益成熟,已具備大規模生產的能力。此外,InGaAs 還具有一個很大的優點,就是在常溫下也可具有很高的光響應性能及低暗電流,這一優點使得InGaAs 可以擺脫制冷的制約,在儀器的小型化、降低紅外系統的成本等方面具有很大的競爭力[9]。
InAs 和GaAs 都具有閃鋅礦晶體結構,它們能以任何配比形成InxGa1-xAs 固溶體,InxGa1-xAs 也具有閃鋅礦晶體結構。其晶格常數隨組分的變化近似為線性,從GaAs 的5.653 3 ? 變化到InAs 的6.058 3 ?。
InxGa1-xAs 固溶體的禁帶寬度與組分x 和溫度T 有關,Paul[5]給出的經驗公式為:

式中,EgGaAs、EgInAs分別為GaAs 和InAs 在0 K 時的禁帶寬度,αGaAs、βGaAs、αInAs、βInAs為通過測量給出的擬合參數。
其截止波長為:

InxGa1-xAs 本征載流子濃度與組分x 和溫度T 的關系可由Paul 給出的經驗公式求得:

式中,ε=Eg/KBT 為簡約禁帶寬度,可由式(1)計算求得。
2 InGaAs/GaAs 多量子阱探測器結構的設計
2.1 量子阱的能帶理論[10]
圖1 為典型單量子阱和多量子阱的能帶結構以及波函數示意圖,在量子阱材料中,勢阱寬度已小到可與電子波長相比,電子波動性十分明顯,電子能量只能是少數幾個特定分離值。

圖1 量子阱材料的能帶結構
計算有限深量子阱中的電子態,即阱寬為Lz,阱深為V0(V0=ΔEc或V0=ΔEv)的單一勢阱中的電子狀態。在沿勢阱的z 方向,由于勢壘V0的存在,電子被束縛在勢阱附近,其波函數按指數函數衰減。根據薛定諤方程式,電子在z 方向滿足:

式中,φ(z)為電子波函數,E 為能量本征值,m*為電子有效質量。根據式(4),可以得到能量本征值滿足的方程為:

2.2 量子阱的應變對帶隙的影響[10]
如圖2(a)所示,由于In 進入GaAs 內部使得InGaAs的晶格a 大于GaAs 的晶格a0,因此在剛生長InGaAs/GaAs結構時,InGaAs 晶格在界面平面處會被二維壓縮,從而與未應變的GaAs 晶格匹配實現共格生長,這時InGaAs層處于壓應變下。另一方面,由于單胞結構試圖維持它原始未應變的體積不變(泊松效應),InGaAs 晶格在垂直于界面的方向會被拉長。當外延層的層厚小于應變臨界值時,InGaAs 晶格的彈性四角扭曲不會危及外延層的晶體質量。如果InGaAs 應變層厚度超過臨界厚度,失配位錯會大量產生,最終導致彈性應變通過位錯的形成而弛豫。
圖2(b)展示了InGaAs 和其他閃鋅礦半導體中雙軸應變的三個主要影響[11]:

圖2 GaAs/InGaAs 應變量子阱的共格外延和能帶移動
(1)簡并的J=3/2,mj=1/2 和J=3/2,mj=-3/2 價帶邊的分裂;
(2)導帶邊的移動;
(3)空穴有效質量的各向異性。
在雙軸壓應變層中,導帶邊和mj=3/2 的價帶邊定義了帶隙。凈的帶隙移動為:

形變勢α 為:

這里C11和C12是彈性常數,a 和b 分別是流體靜壓力和剪切形變勢。ε 是應變(對壓應變是負值)。對于負的應變,ΔE 一般是正值,相當于在雙軸應變下一個凈的帶隙增加。
如果InGaAs 層處于應變中并且沒有發生應變弛豫,那么:

dSub是GaAs 襯底的晶格常數(對應圖2 中的a0),dEpi是InGaAs 層的晶格常數(對應圖2 中的a)。
在壓應變下,量子阱中電子和重空穴的阱深分別為:

通過將ΔEc和ΔEg代入到上一小節的超越方程,可以得到導帶和價帶的第一束縛能級Ee1和Ehh1。
量子阱的總躍遷能為:

Eg是無應變的體材料InGaAs 的帶隙。
量子阱的發光波長為:

式中,h 是普朗克常數,c 是真空光速。
2.3 InGaAs 應變層的臨界厚度
在設計InGaAs 應變量子阱層結構時,要考慮到外延層不應超過臨界層厚度,以防止彈性應變被破壞而形成位錯和缺陷影響外延層質量,最終導致器件性能不良。Matthews 和Blakeslee 首先提出力平衡模型來計算應變量子阱的臨界厚度。力平衡模型認為[12]:襯底施加在位錯線上的力和外延層施加在位錯線上的力不相等時,就會產生位錯。當外延層InxGa1-xAs 的厚度小于臨界厚度時,應變是彈性的,不會導致失配位錯的產生;當大于臨界厚度時,應變則會馳豫,并產生失配位錯。Matthews 等人對各種組分的GaAs/InGaAs 應變量子阱進行了詳細的研究,得到了一個與實驗結果相當吻合的臨界厚度的表達式:

其中,b是Burgers矢量值;ν是泊松比;f為失配度,對應于式(8)中的ε;α為Burgers矢量與位錯線的夾角;λ是界面內垂直于滑移面和界面交線的方向與滑移方向的交角。通過結算超越方程(13),得到了在GaAs(100)襯底上外延InGaAs 隨著In 組分變化的關系圖,如圖3 所示。
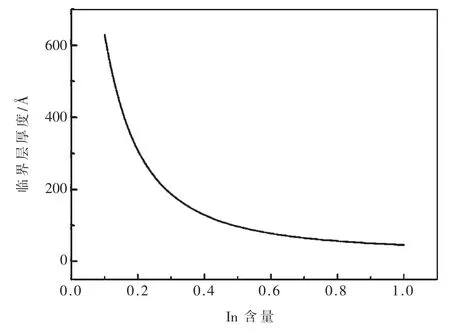
圖3 GaAs 襯底上外延InxGa1-xAs 層In 含量與臨界層厚度的關系
從圖3 中可以看到,隨著InxGa1-xAs 層中In 組分的增加,外延層和襯底的失配度也增加,InxGa1-xAs 應變層臨界厚度逐漸減小。臨界厚度隨著In 組分變化關系的確定,對于設計應變量子阱結構具有非常重要的指導意義。
2.4 InGaAs/GaAs 多量子阱探測器關鍵參數的計算和結構設計
通過對上述理論知識的綜合與應用,作者使用數學軟件Mathematica 編寫求解InGaAs/GaAs 單量子阱波函數方程,用以確定探測結構的關鍵參數,如量子阱中In的組分、量子阱的阱寬、量子阱中第一能級的位置和阱對應的探測截止波長等。在程序里加入了溫度對參數的影響,但為了計算的方便,并沒有考慮量子阱的應變對帶隙的影響,此外最終的器件為多量子阱結構,這里也沒有考慮量子阱之間可能存在的耦合情況(勢壘足夠寬,阱間耦合作用小,可以忽略)。具體器件結構如圖4所示。

圖4 InGaAs/GaAs 多量子阱探測器結構示意圖
按照圖4 中的設計參數代入程序中,算得量子阱的發射波長λc=981 nm,結果可以與后期材料生長后外延層結構的表征來對比確定計算模擬的準確性。圖4 中量子阱的層數N 可以根據需要紅外探測器需要的性能進行控制。
3 InGaAs/GaAs 多量子阱外延結構的制備與表征
3.1 InGaAs/GaAs 多量子阱外延結構的生長
InGaAs/GaAs 多量子阱器件結構使用EPI GEN-Ⅱ型MBE 設備(圖5)進行生長。關于InGaAs/GaAs 應變量子阱的生長,科研工作者已經進行了相當廣泛的研究。由于當超過600 ℃的時候,In 的偏析現象比較嚴重,因此這種材料體系的生長溫度一般不會超過600 ℃。但是當生長溫度過低時,器件光學特性也會下降。所以一般的生長溫度區間為400 ℃~600 ℃。對單量子阱來說,典型的生長方式有三種:(1)緩沖層(buffer)在600 ℃及600 ℃以上生長,然后降溫到520 ℃,生長InGaAs 量子阱層及壘層[13-15];(2)緩沖層在600 ℃及600 ℃以上生長,隨后開始降溫到520 ℃,繼續生長一定厚度的GaAs 壘層,然后停頓20 s 再生長InGaAs 量子阱層,隨后再停頓20 s 再生長蓋層,20 s 的停頓時間可以使得界面更加平滑[16];(3)與(1)類似,但阱層及壘層生長溫度為540 ℃~560 ℃。InGaAs 的生長速度一般為0.5~1 μm/h,V/III束流比為十幾比一。

圖5 EPI GEN-Ⅱ型MBE 設備
多量子阱材料的生長工藝過程與上面介紹的單層量子阱類似,采用在600 ℃生長的300 nm 的n-GaAs 緩沖層,然后在As 保護下開始降溫到520 ℃,繼續生長一定厚度的GaAs 作為隔離層(spacer),再生長InGaAs 量子阱層,然后開始對襯底升溫并生長GaAs 壘層,在生長完設計周期的量子阱層后,最后生長一層p-GaAs 作為蓋層。
在實際的外延生長過程中,重點通過控制Ga/In 的束流比來調節量子阱層中的In、Ga 組分,達到結構設計中的要求。作者通過控制Ga/In 束流比為2,按照圖4 的外延層設計結構在2 英寸N 型GaAs 襯底上外延生長了10 個周期的InGaAs/GaAs 多量子阱外延結構H-10T。
3.2 InGaAs/GaAs 多量子阱外延結構的表征
3.2.1 雙晶X 射線衍射的表征
作者對InGaAs/GaAs 多量子阱外延結構H-10T 進行雙晶X 射線衍射分析以評估GaAs/InGaAs 應變量子阱的生長質量,圖6 是H-10T 的雙晶搖擺曲線圖。從圖中不難發現除了一個最強的GaAs 襯底峰(Bragg 峰)外,在其兩側還出現了一系列(約十多個)衛星峰,這就是多量子阱結構的干涉條紋。干涉條紋出現的必要條件是:(1)外延薄膜的結晶完整性好;(2)外延膜的厚度要均勻。當外延膜處于部分弛豫狀態時,由于存在失配位錯,會使Bragg 峰加寬,并且干涉條紋也會變弱,甚至消失。即使外延膜與襯底為共格生長,但如果膜厚不均勻,也會使干涉條紋變弱或消失。圖6 中衛星峰出現的個數比較多,并且每個峰都比較尖銳,這說明H-10T 中InGaAs/GaAs 多量子阱結構的外延生長質量和界面性質是非常好的。

圖6 InGaAs/GaAs 多量子阱結構H-10T 雙晶搖擺曲線
通過雙晶搖擺曲線的分析,可以獲得量子阱的周期厚度、InGaAs 層中In 的組分及每周期中InGaAs 和GaAs各層的厚度等重要參數。
從衛星峰的角間距Δθ 可以得到超晶格的周期厚度d[17]:

采用CuKa 輻射源,λ=0.154 056 nm,θB為布拉格衍射角33.025°、Δθ 為637.7 arcseconds。代入式(14)計算得到量子阱的周期厚度為29.7 nm,與設計的厚度28 nm 接近。
從襯底衍射角與量子阱零級衍射峰的角度差ΔθB可以得到界面失配應變ε:

其中a 和a0分別是外延層和襯底的晶格常數,ΔθB是外延層和襯底的Bragg 衍射峰的角距離(即兩者的Bragg衍射角之差661.1 arcseconds)。將襯底的晶格常數a0=代入上式算得a=5.681 2?。

由此可以算出外延層的In 平均組分為0.069。
設d 為多量子阱的周期厚度,d1和d2分別是GaAs壘和InGaAs 阱層的厚度,x 為阱層中In 的組分,則有[18]:

假設GaAs 和InGaAs 層的生長時間分別是t1和t2,則參考GaAs/GaAlAs 超晶格的生長[19],有:

同時又有:

通過查找MBE 生長過程中的參數,確定時間t1和t2,代入以上幾式求出x、d1和d2。最后的結果為InGaAs 的In 組分為0.24,厚度為8.5 nm,GaAs 層的厚度為21.2 nm,這一結果和設計的結構非常匹配。
3.2.2 光致發光譜的表征
為了進一步確定和驗證所生長的H-10T 中的In 組分及樣品的質量,對它們進行了常溫下的光致發光譜(PL)測試,圖7 為H-10T 的PL 譜圖。

圖7 H-10T 的PL 譜(室溫)
從圖7 中可以看到,H-10T 的量子阱發光峰分別位于983 nm,和用Mathematica模擬出來的量子阱第一子能級發射波長981 nm 相當接近,也相互印證了設計的模型和實驗的一致性。從發光峰的半高寬來看,H-10T 的半高寬僅為11 nm,這說明外延片H-10T 的量子阱周期結構中各周期的厚度非常均勻一致,其界面質量也很好,同時,也充分說明了InGaAs 應變層始終處于應變狀態,未影響到界面微觀結構與性質。
3.2.3 原子力顯微鏡對樣品表面的表征
因為多量子阱探測器外延片最終需要通過半導體工藝實現圖形及歐姆接觸的制作,因此其表面狀態直接影響后續器件的制作。原子力顯微鏡對樣品表面的觀測具有非常高的橫向分辨率和縱向分辨率,正常情況下,橫向分別率可以達到0.1~0.2 nm,縱向分辨率高達0.01 nm,而且是實空間的三維成像,有極大的景深和對比度。圖8是H-10T 的原子力顯微鏡圖像(AFM),但從圖中,可以清晰地看到外延片的表面仍相當平整,其均方根粗糙度(RMS)僅為0.78 nm。雖然采用AFM 進行測量表征的是p-GaAs 的表面形貌,但如果下面的InGaAs/GaAs 多量子阱結構由于應力釋放出現較大弛豫,表面仍會產生較大影響。
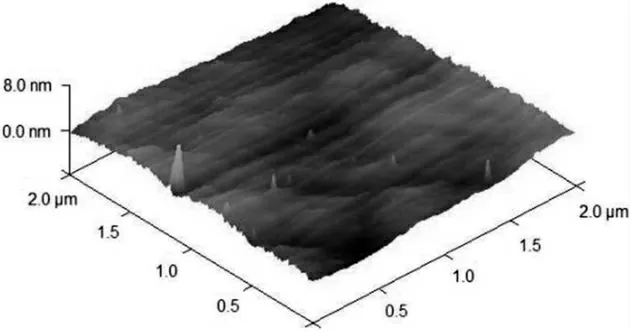
圖8 H-10T 的AFM 形貌圖
4 結論
本文介紹了可用于近紅外光探測的InGaAs 材料體系,從理論計算入手,利用軟件Mathematica 編寫求解出InGaAs/GaAs 單量子阱有限深勢阱的波函數方程,并根據此結果(InGaAs 阱層中In 組分為0.2,厚度為8 nm,量子阱的第一子能級發射波長λc=981 nm)設計出可用于近紅外光探測的InGaAs/GaAs 多量子阱結構。之后采用MBE 設備外延生長出10 周期多量子阱結構,對其進行了雙晶X 射線衍射、光致發光譜等結構表征,并推算出量子阱中In 的組分為0.24,厚度為8.5 nm,GaAs 層的厚度為21.2 nm,與設計值高度吻合,具有很好的指導意義和價值,為后續近紅外探測器的研制奠定了堅實的理論與實驗基礎。

