X射線和重離子輻射對GaN基發光二極管的影響
王 磊,李 博,張學文,李彬鴻,羅家俊,3,劉新宇,3,袁清習
(1.中國科學院微電子研究所,北京100029;2.中國科學院硅器件技術重點實驗室,北京100029;3.中國科學院大學,北京100049;4.中國科學院高能物理研究所,北京100049)
1 引 言
以電子-光子轉換效應為原理的半導體光電子器件是光電子技術的關鍵和核心部件,相關研究已是現代光電子技術和微電子技術的前沿領域,也是信息技術的重要組成部分。半導體光電子器件主要包括自發發光器件、激光器、光電探測器件、傳感器以及復合功能的異質集成器件等,它們基于多種材料和原理制備,波長可覆蓋紫外至紅外甚至太赫茲波段。此類器件具有光電轉換效率高、光譜范圍廣、功率調諧范圍大、抗電磁干擾能力強、調制頻率高、帶寬大、可多譜域成像、安全保密、方向性好及壽命長等優點,在商業、國防和航天領域廣為應用,在未來技術革新中也將發揮越來越重要的作用。研究在X 射線和Si 重離子輻射效應影響下的發光二極管的各項性能的變化,具有很大的實用價值和必要性。
2 技術發展背景
GaN 材料及其三元和四元合金材料,作為一種典型的第三代半導體材料,其禁帶寬度在0.6eV~6.2eV,覆蓋了紫外到紅外的整個波段,并具有耐高頻高壓、耐高溫、耐腐蝕等優點,在光電子器件和電子器件領域有著巨大的應用前景。GaN 基光電子器件多以InGaN/GaN 多量子阱作為有源區,波長一般在藍光和綠光波段。通過近20 年的快速發展,藍光和綠光GaN 基發光二極管和激光二極管在商業化領域已經取得長足發展[1-6]。
InGaN/GaN 多量子阱發光二極管作為可見光通訊的主要光源,在保密會議網絡系統、衛星內部、艦船內部無線通訊、火箭分離、太空艙外、深潛艙等軍事航天領域的高速無線通訊方面具有巨大的應用前景[7-9]。GaN 基發光二極管在極端環境下的可靠性研究,尤其是在多種輻射環境下的輻照效應研究,對其在國防和航天領域的應用具有重要意義。
文獻報道稱,GaN 基半導體材料與器件因其穩定的物理化學特性,比GaAs 基和Si 基材料器件具有更高的抗輻射能力[10]。但目前針對高能射線的輻射電離效應、高能重離子位移效應和熱峰效應對InGaN/GaN 多量子阱發光二極管的閾值電壓、發光功率、峰值波長及色坐標所產生的影響的研究還缺乏系統性,仍處于初級階段。發光二極管發光特性輻射效應的物理機制仍待深入研究[11-12]。
基于此背景,通過采用高能X 射線和高能Si 重離子對藍光InGaN/GaN 多量子阱發光二極管芯片進行輻射特性研究,可揭示射線和粒子輻射對二極管閾值電壓、發光功率、波長、色坐標等參數的影響,以評估發光二極管的抗輻射特性。
3 樣品和實驗
InGaN/GaN 多量子阱發光二極管采用金屬有機化學氣相外延生長法在藍寶石襯底上生長。首先在C 面藍寶石襯底上生長20nm 的低溫GaN 成核層,接著生長2μm 的低溫非摻GaN 緩沖層,再生長1μm 的Si 摻雜的N 型GaN 外延層(Si 元素摻雜濃度為1×1019/cm3)。接著生長50nm 厚的N 型AlGaN/GaN(Si 摻雜濃度為1×1019/cm3,Al 組分約為5%)用于調制后續GaN 的生長質量。再生長200nm 的N型GaN(Si 摻雜濃度為1×1018/cm3),此時有源區包括7 對InGaN/GaN 量子阱結構,其中InGaN 勢阱寬度為3nm,GaN 勢壘寬度為7nm。InGaN 量子阱中In元素組分約為20%。在量子阱形成之后緊接著生長20nm 厚的Mg 摻雜P 型AlGaN 電子阻擋層,用于提升電子空穴在量子阱中的發光復合效率(Mg 摻雜濃度為1×1020/cm3)。再生長100nm 厚的Mg 摻雜P 型GaN 用于形成PN 結(Mg 摻雜濃度為1×1020/cm3)。最后,在P 型GaN 上生長20nm 厚的非摻InGaN 蓋帽層薄膜用于P 型歐姆接觸制備。整個晶圓采用標準的紫外光刻和離子刻蝕等半導體標準工藝制備出發光二極管芯片,芯片面積為275μm×675μm。
高能X 射線輻射在中國科學院高能物理研究所同步輻射裝置的4W1A 實驗站完成。射線能量為0~50keV 的白光,劑量為0.1Mrad(Si)/s;發光二極管輻照劑量分別為1Mrad(Si)、10Mrad(Si)、33Mrad(Si)、67Mrad(Si)和100Mrad(Si)。
Si 重離子輻照在北京大學重離子加速器裝置上完成。Si 重離子能量選擇為30 MeV,注量率選擇為1.32×108/cm2s,發光二極管注量輻照的注量分別為5×1010/cm2、5×1011/cm2、1×1012/cm2和5×1012/cm2。
發光二極管的電致發光譜采用杭州遠方的白光LED 積分球(型號為ATA-1000,EVERFINE)進行測試。全部測試工作均在X 射線和Si 重離子輻照后4小時內完成。
4.結果與分析
4.1 閾值電壓
InGaN/GaN 多量子阱發光二極管在電注入條件下的閾值電壓(Vth)通常定義為:正向電流為20mA時的外加電壓大小。Vth的大小代表著發光二極管的開啟狀態。一般來說,當外加正向電壓小于Vth時,注入到二極管的電流非常小,二極管幾乎不發光。但當外加正向電壓大于Vth時,流過二極管的電流迅速增大,二極管的發光強度也迅速增大。
GaN 基發光二極管閾值電壓受X 射線輻照和Si 重離子輻照后的變化情況如圖1 所示。由圖可以看到,Vth隨X 射線劑量的增加始終維持在2.73V 左右,即使是X 射線總劑量達到了100Mrad(Si),Vth幾乎沒有發生變化。X 射線一般會在被輻照晶體內產生大量電子空穴對,但很少產生晶格位移效應和熱峰效應,說明X 射線電離效應對InGaN/GaN 多量子阱發光二極管閾值電壓等電學參數的影響很小。
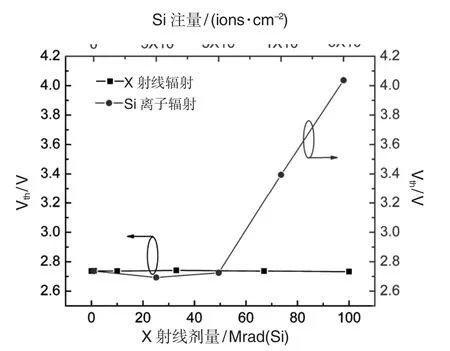
圖1 X 射線和Si 重離子輻照對閾值電壓的影響
圖1 同樣給出了GaN 基發光二極管受Si 重離子輻照前后閾值電壓的變化。與X 射線輻照有很大不同,Si 重離子輻照不但可以在GaN 材料內產生電離效應,也可以產生位移效應和熱峰效應。基于通過X 射線衍射、變溫光致發光譜和正電子湮滅譜等方法對Si 重離子輻照的GaN 外延薄膜所做的系統化分析,發現Si 重離子輻照可以在InGaN/GaN 量子阱內因熱峰效應產生In 組分局域態增強,也會因位移效應產生大量非發光復合點缺陷[13]。從圖1 中閾值電壓隨Si 重離子注量變化可以看出,當Si 離子注量小于5×1011/cm2時,GaN 基發光二極管的閾值電壓可保持在2.73V 左右;但當Si 離子注量達到1×1012/cm2和5×1012/cm2時,發光二極管的Vth分別增大到3.39V 和4.04V,二極管的伏安特性發生了明顯的退化。發光二極管Vth的增加,說明當Si 離子注量達到1×1012/cm2時,組成PN 結的P 型GaN 和N型GaN 薄膜因位移損傷而發生了明顯的載流子移除效應,導致了GaN 薄膜電學特性退化[14-17]。
4.2 發光功率
X 射線和Si 重離子輻照對InGaN/GaN 多量子阱發光二極管發光功率的影響如圖2。二極管發光功率由積分球測得,發光功率測試為正向注入電流為200mA 時的功率。從圖中可以看到,X 射線輻照下發光二極管的發光特性變化很小,說明GaN 基材料具有極高的抗高能射線電離輻射效應的能力。由其制備的光電子器件在抗電離輻射方面要明顯優于Si 基和GaAs 基器件[10]。圖2 同樣給出了發光二極管發光功率同Si 重離子注量的關系曲線。可以看到,Si 重離子輻照后GaN 基發光二極管的發光功率明顯減弱。當Si 粒子注量為5×1010/cm2時,發光功率由213mW 下降到101.8mW,相當于發光功率減半。而當Si 離子注量達到1×1012/cm2時,發光功率下降到了5mW 以下,光功率的衰減超過了97%。
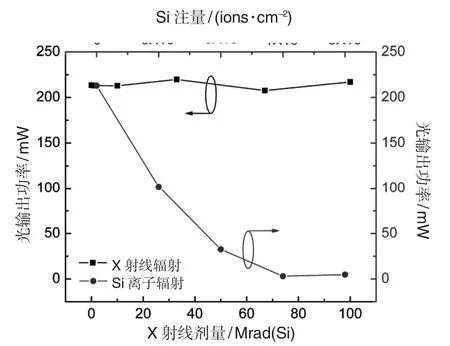
圖2 X 射線和Si 重離子輻照對發光功率的影響
由分析可以看出,Si 重離子輻照對GaN 基發光二極管發光功率的影響明顯強于X 射線輻照。而發光二極管發光功率的衰減一般是由于InGaN/GaN多量子阱層內非發光中心密度的增加引起的。通過與前面閾值電壓的變化趨勢分析可知,Si 重離子在注量為5×1010/cm2時就已經因位移效應而產生了點缺陷,并且對GaN 基發光二極管的發光功率造成了直接影響,但由于此時點缺陷密度較低,二極管的伏安特性并沒有發生明顯的變化。因此,通過發光功率和閾值電壓變化的趨勢發現Si 重離子輻照對二極管發光特性的影響要先于對電學特性的影響。
4.3 峰值波長
InGaN/GaN 多量子阱發光二極管發光峰值波長隨輻照條件的變化對發光二極管在高速無線通訊系統中的信號傳輸有重要影響。例如,一旦發光波長因輻射效應發生了漂移,波長就有可能移動到耦合光纖的透射窗口之外,從而導致發光二極管和光纖之間耦合效率降低。另外,發光波長的變化也會對光電探測效率造成影響,引起光信息傳輸效率下降、傳輸帶寬減小、信噪比惡化等問題。
圖3 給出了200mA 正向電流下GaN 基發光二極管發光峰值波長隨X 射線劑量和Si 重離子注量的變化曲線。對于X 射線輻照,從圖中可以看出當X 射線劑量高于67Mrad(Si)時,二極管的發光波長出現了微小的紅移現象(即發光波長變大,光子能量減小)。此現象可歸因于X 射線電離效應在GaN 外延各層界面生成的界面態。界面態處攜帶的電荷可以增強InGaN/GaN 多量子阱層內的壓電極化效應,從而使得量子阱內量子限制斯塔克效應更為明顯,進而導致發光二極管發光波長的微小紅移。
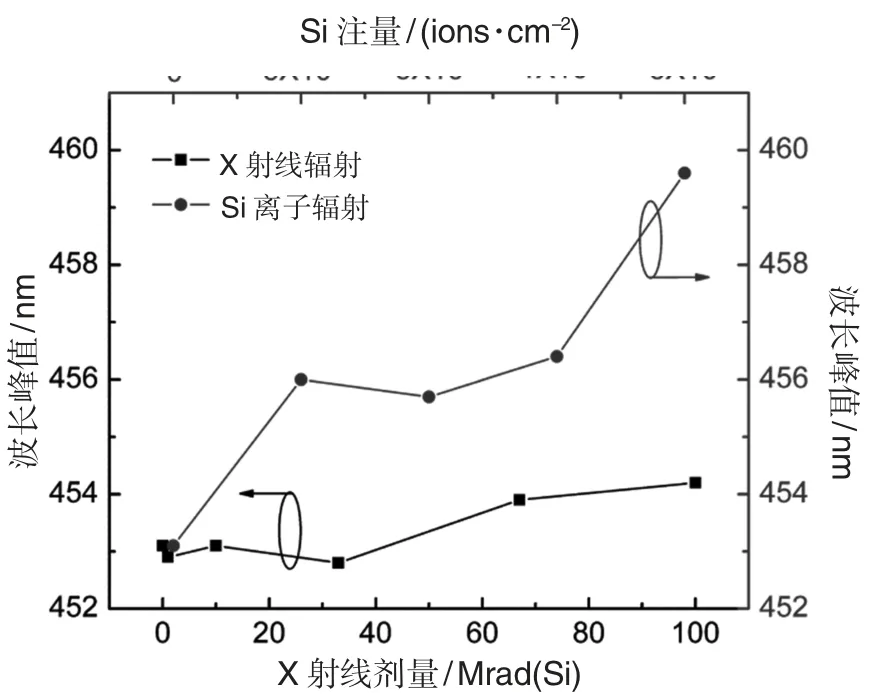
圖3 X 射線和Si 重離子輻照對發光峰值波長的影響
相比于X 射線引起的波長變化,圖3 中給出的Si 重離子引起的峰值波長變化峰位更為明顯。通過早先研究和上述分析可知,Si 重離子輻照后的峰值波長紅移主要有兩方面因素引起。一個是由于Si 重離子輻照后引起了InGaN/GaN 多量子阱內In 組分局域態增強,局域態內In 組分的漲落減小了InGaN量子阱層內的帶隙寬度,從而導致了發光波長的紅移;另一方面,閾值電壓隨Si 離子注量的變化表明當Si 離子注量達到1×1012/cm2時,GaN 外延薄膜中產生了明顯的載流子移除現象,N 型和P 型GaN 薄膜的電阻率變大,200mA 下PN 結發熱特性變得十分明顯。對于半導體材料,溫度升高帶隙減小,因此輻照后PN 結熱效應同樣導致了發光二極管發光波長的紅移。綜合以上因素。Si 重離子輻照引起的In組分局域態和載流子移除效應,導致了同一正向電流下比X 射線輻照更明顯的發光波長紅移現象。
4.4 色坐標
根據CIE 國際照明委員會的定義,發光二極管的色坐標就是指顏色在色品圖中的坐標位置,以X軸和Y 軸的數值定義,其中X 代表紅色在該顏色中的混合比例,Y 代表綠色在該顏色中的混合比例。色坐標對于評價一個發光二極管以及基于單色發光二極管和熒光粉制備的白光或混色發光二極管的顏色調制至關重要。二極管輻照后色坐標的偏差會導致太空艙內宇航員對顏色的判斷和還原出現偏差,也會對基于GaN 基白光發光二極管的可見光通信系統造成一定影響。
圖4 和圖5 分別給出了GaN 基發光二極管色坐標X 分量和Y 分量隨X 射線劑量和Si 重離子注量間的變化關系,正向注入電流同樣取200mA。與發光波長變化趨勢類似,Si 重離子引起的色坐標變化量明顯大于X 射線引起的變化量。對比色坐標X分量和Y 分量的變化可以看到,當Si 重離子注量達到5×1012/cm2時,引起的X 分量變化量約為2.26%,而Y 分量的變化量約為38.49%。這說明,輻照后色坐標的Y 分量變化明顯,而X 分量變化相對較小。
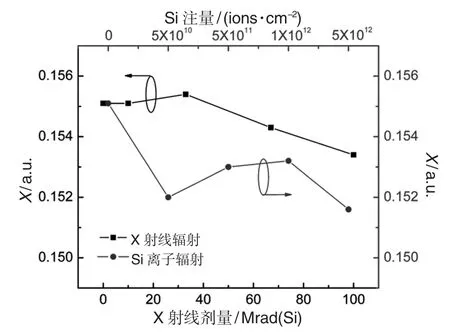
圖4 X 射線和Si 重離子輻照對色坐標X 分量的影響

圖5 X 射線和Si 重離子輻照對色坐標Y 分量的影響
5 結 束 語
對比研究了InGaN/GaN 多量子阱發光二極管發光和電學特性受白光光譜的X 射線和30MeV Si重離子輻照后的變化。通過對比發現,Si 重離子輻照的位移效應、熱峰效應和載流子移除效應比X 射線的電離效應對發光二極管特性的影響要明顯很多。在Si 重離子輻照下,發光二極管的發光特性變化明顯早于電學特性的變化,說明位移效應引起的點缺陷先作為非發光中心影響發光,再作為載流子補償中心影響GaN 外延薄膜的電阻率。宏觀表現為發光二極管的發光功率先下降,然后才是閾值電壓的升高。此外,Si 重離子輻照還引起了發光波長的明顯紅移和色坐標的偏移。波長紅移機制主要是InGaN/GaN 多量子阱的In 組分局域態增強效應和大電流下PN 結的熱效應。重離子輻照引起的色坐標偏移主要發生在Y 分量上。

