硅通孔轉接板關鍵工藝技術研究
——TSV成孔及其填充技術
2019-11-14 01:20:42劉曉陽陳文錄
印制電路信息
2019年11期
關鍵詞:工藝
劉曉陽 陳文錄
(江蘇無錫35信箱,214083)
0 引言
隨著電子產品向小型化、高性能、高可靠等方向發展,系統集成度也日益提高。當前的中央處理器(CPU)芯片封裝大都采用有機基板(載板)倒裝(FC)封裝形式,但隨著芯片尺寸不斷增大、凸點尺寸和節距的縮小導致熱膨脹系數(CTE)兼容性問題無法避免,解決途徑有兩個方面:要么降低有機基板CTE以匹配芯片,要么采用緩沖層即通過轉接板或稱內插板(interposer)解決。降低有機基板的CTE是有局限的,因此利用轉接板作為緩沖層是較佳的解決途徑。采用硅通孔(TSV:Through Silicon Via)轉接板進行的封裝稱為2.5D封裝,2.5D封裝的TSV轉接板本身僅起互連作用,將有機基板與硅基TSV轉接板互連再與芯片互連的堆疊結構稱為2.5D封裝。采用TSV轉接板的2.5D封裝與2D封裝相比,有如下優勢:
第一、轉接板與芯片都屬于硅基同質集成,材料性能相容性好;
第二、轉接板通過再布線將芯片凸點節距放大,從而大大降低有機基板布線難度;
第三、轉接板在芯片和有機基板之間形成緩沖,減少因形變對芯片的損傷;
第四、轉接板的制造工藝與集成電路的再布線工藝兼容;
第五、硅基TSV轉接板的制造及2.5D封裝技術為實現3D集成奠定基礎。
由于實現CPU與存儲器3D集成仍然存在諸多技術瓶頸,采用TSV轉接板的2.5D封裝是實現3D集成封裝的過渡解決方案,目前成為國內外研究焦點之一,TSV轉接板的典型結構示意圖(如圖1)。
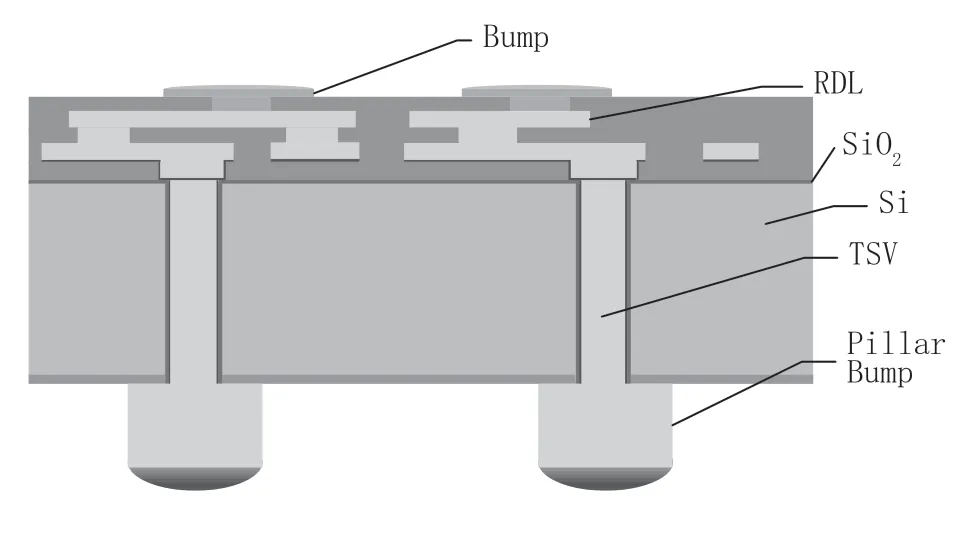
圖1 轉接板典型結構示意圖
TSV轉接板結構設計與其工藝設計關系密切,作為轉接板的TSV技術而言,與在有源器件上的Via First工藝類似,采取先刻蝕孔,再填充金屬的工藝,本文所研究的金屬是銅。……
登錄APP查看全文
猜你喜歡
中國特種設備安全(2022年5期)2022-08-26 09:19:32
礦產綜合利用(2020年1期)2020-07-24 08:50:40
山東冶金(2019年6期)2020-01-06 07:45:54
收藏界(2019年2期)2019-10-12 08:26:06
世界農藥(2019年2期)2019-07-13 05:55:12
世界農藥(2019年2期)2019-07-13 05:55:10
模具制造(2019年3期)2019-06-06 02:11:00
山東工業技術(2016年15期)2016-12-01 05:30:59
銅業工程(2015年4期)2015-12-29 02:48:39
新疆鋼鐵(2015年3期)2015-11-08 01:59:52

