針尖-樣品距離對近場掃描微波顯微鏡空間分辨率的影響
鞠 量,彭 斌,黃 和,曾慧中,張萬里
(電子科技大學(xué) 電子薄膜與集成器件國家重點實驗室,四川 成都 611731)
0 引 言
近場掃描微波顯微鏡(Near-Field Scanning Microwave Microscopy,NSMM)是微波測量技術(shù)與掃描探針測量技術(shù)的結(jié)合體[1].其工作方式是將待測樣品放置于微波探針的近場范圍內(nèi),使微波探針尖端匯集的微波場與樣品產(chǎn)生相互作用,通過測量得到的回波信號來表征樣品的表面形貌、介電性能等性質(zhì)[2].
1928年,Synge[3]首次提出了近場測試的概念,他提出用點場源(微波探針)來輻射物體,隨著點場源到物體的距離減小(近場),物體被輻射的區(qū)域也隨之變小,空間分辨率能力變高[4].在針尖-樣品距離控制問題得到了有效解決后,近場掃描測量技術(shù)取得了長足的進(jìn)步.近年來,近場掃描測量技術(shù)被廣泛應(yīng)用于微米、納米[5-7]結(jié)構(gòu)材料樣品的表征測試,以及生物細(xì)胞掃描[8,9]等微觀研究領(lǐng)域中.
本文根據(jù)近場微波測試原理,設(shè)計了一套近場掃描微波成像測試系統(tǒng),并通過其對NiFe金屬薄膜的掃描測試結(jié)果,探索了其空間分辨率隨針尖-樣品距離的變化關(guān)系,并提出了一種計算掃描圖像真實線寬的方法.
1 系統(tǒng)構(gòu)成及實驗方法
NSMM的核心結(jié)構(gòu)是諧振頻率為2.15 GHz的1/4波長同軸諧振腔[10],工作于TEM模式且品質(zhì)因數(shù)Q較高,鎢探針固定在中心導(dǎo)體下端,并從諧振腔底部開孔處伸出.NSMM系統(tǒng)的實物圖與示意圖如圖1 所示,主要包括機(jī)械連接結(jié)構(gòu):XY軸掃描臺、Z軸位移臺、矢量網(wǎng)絡(luò)分析儀等,各部件通過計算機(jī)軟件控制,實現(xiàn)自動化測試.
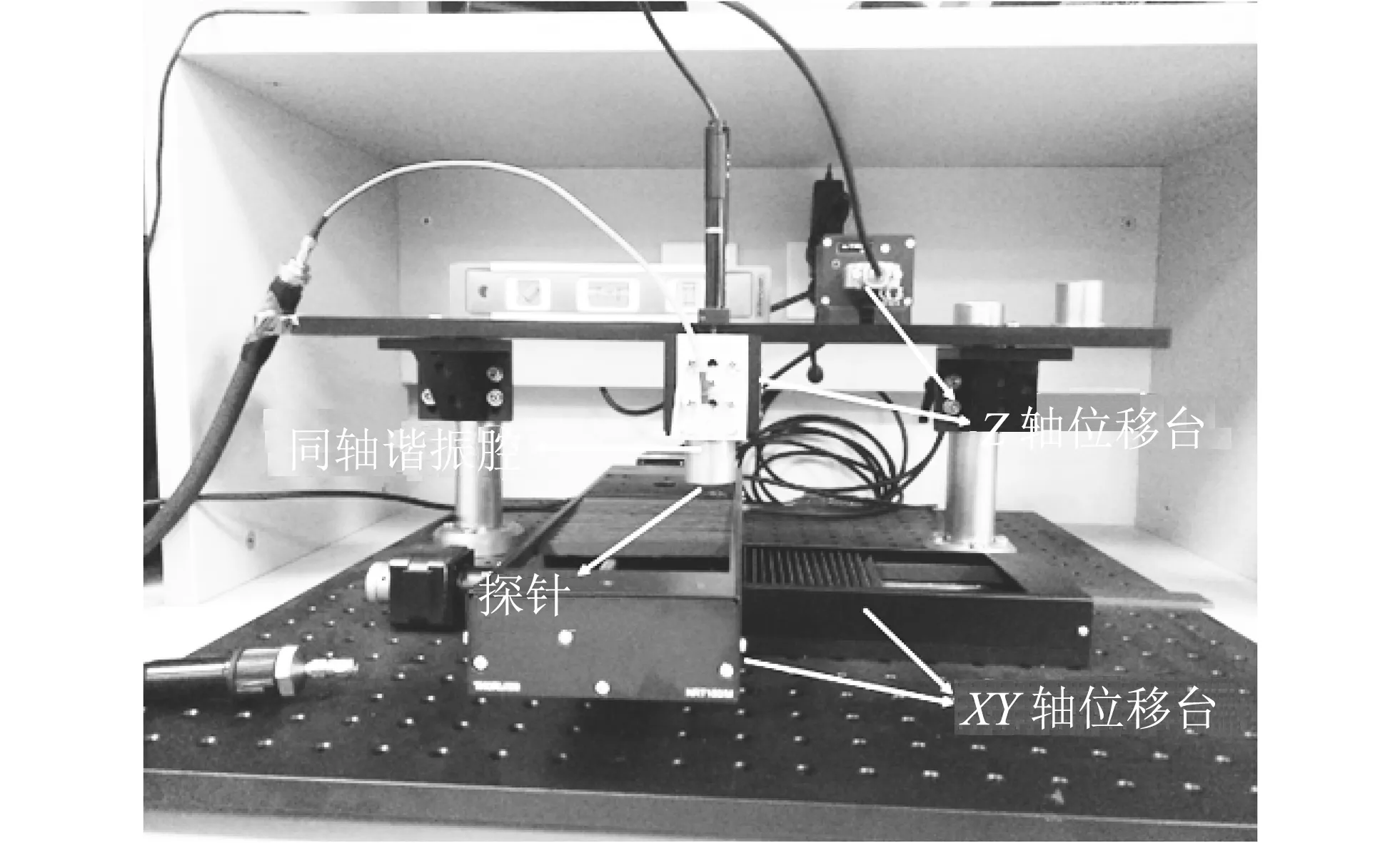
圖1 NSMM系統(tǒng)實物圖Fig.1 Photograph of the NSMM system
本文在SiO2基片上制作了兩條NiFe金屬薄膜,薄膜厚度為20 nm,寬度分別為260 μm和470 μm.沿圖2 中所示掃描方向,分別對兩條NiFe薄膜樣品進(jìn)行了線掃描測試,掃描步長為5 μm,并采用矢量網(wǎng)絡(luò)分析儀(安捷倫N5234A)測量每一測量點處諧振腔的諧振頻率f以及品質(zhì)因數(shù)Q.通過Z軸位移臺控制針尖-薄膜樣品間距,在不同針尖-樣品距離下進(jìn)行了上述線掃描.

圖2 線掃描軌跡示意圖Fig.2 Schematic diagram of line scanning trajectory
2 實驗結(jié)果與討論
圖3 是探針和NiFe薄膜表面高度h從2 μm到18 μm時,在薄膜面內(nèi)沿著垂直于NiFe薄膜線條方向掃描得到的諧振頻率隨著掃描位置的變化曲線圖.
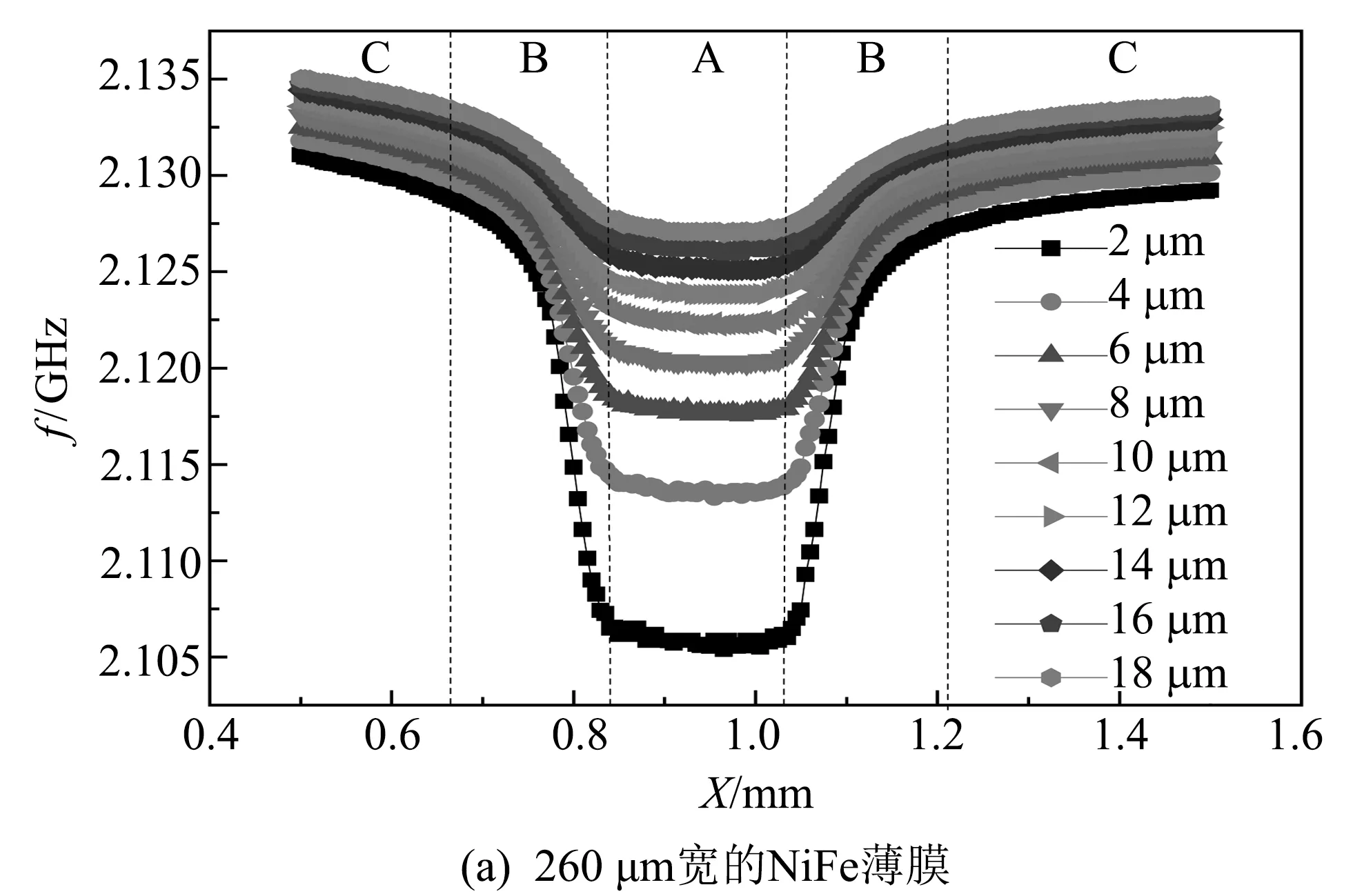
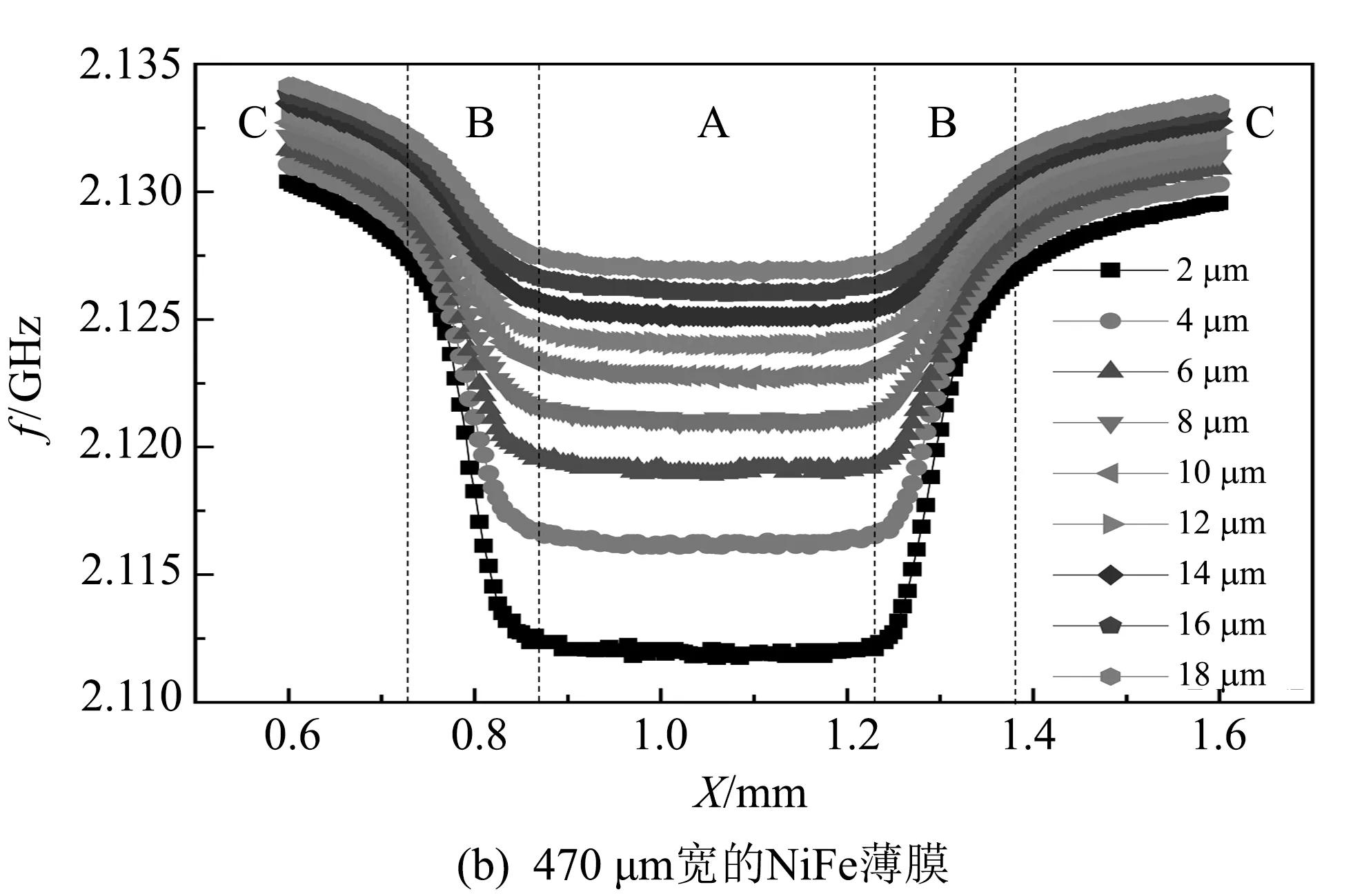
圖3 線掃描諧振頻率分布圖Fig.3 The resonant frequency distribution diagram of line scanning trajectory
從圖3 可以發(fā)現(xiàn),不同針尖-樣品距離下的掃描曲線均由A,B,C 3部分組成,其中A區(qū)域是NiFe薄膜區(qū),這一部分主要是針尖在薄膜表面的探測區(qū)域完全位于NiFe金屬薄膜范圍內(nèi)部,此處諧振頻率幾乎不變.B區(qū)域是空白基片與NiFe薄膜的過渡區(qū),這一部分針尖電場的探測范圍逐漸過渡到空白基片區(qū)域,隨著探測范圍與NiFe薄膜相交部分面積的減小,諧振頻率隨之升高.C區(qū)域是空白基片區(qū),這一部分針尖探測范圍全部位于空白基片區(qū)域,此處諧振頻率也幾乎不變.隨著針尖與樣品表面距離的增加,A區(qū)與C區(qū)對應(yīng)的諧振頻率差值減小,A區(qū)與C區(qū)的區(qū)分度降低,B區(qū)愈加模糊,這表明空間分辨能力逐漸減弱.


圖4 線掃描諧振頻率導(dǎo)數(shù)分布圖(h=2 μm)Fig.4 The resonant frequency derivative distribution of line scanning trajectory(h=2 μm)
為了從圖3 的結(jié)果中獲得NiFe薄膜寬度,對圖3 曲線求導(dǎo),其導(dǎo)函數(shù)變化曲線如圖4所示(以測量高度2 μm為例).從圖4 可以看出,曲線中有兩個峰,它對應(yīng)著頻率隨掃描位置變化最劇烈的地方.當(dāng)針尖與樣品距離趨近于零時,這兩個峰分別對應(yīng)著NiFe金屬薄膜寬度方向的兩個邊界,兩個峰之間的距離即為實際線寬,兩個峰之間的水平部分對應(yīng)于圖3中的A區(qū),且極值點圍繞A區(qū)中點坐標(biāo)對稱.對于圖4 中導(dǎo)函數(shù)的曲線可采用兩個Lorentz函數(shù)的線性疊加進(jìn)行擬合

(1)
式中:A1,A2分別為表征左右兩個峰的峰值大小系數(shù);W1,W2分別為左右兩個峰的半高寬;Xc1,Xc2分別為左右兩個峰的峰值對應(yīng)坐標(biāo).
利用式(1)對圖4 所示的曲線進(jìn)行擬合可以發(fā)現(xiàn),擬合曲線和實驗測試結(jié)果吻合得很好.分別對不同針尖-樣品距離下測試的曲線進(jìn)行擬合,可以得到左右兩個峰的半高寬以及峰的位置隨高度h的變化.圖5 是兩個NiFe薄膜樣品左右兩個峰的半高寬隨著高度h的變化曲線,可以看出,不同測試高度下,左右兩個峰半高寬W1,W2近似相等,半高寬的寬度隨高度h的增加線性增大.
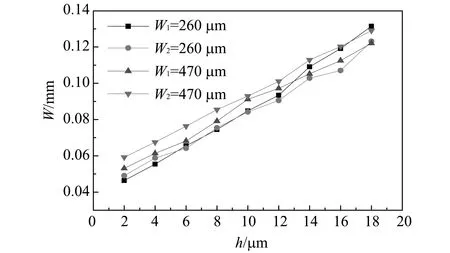
圖5 擬合曲線峰值半高寬隨針尖-樣品距離的變化曲線Fig.5 Curve of the half-maximum width of the fitting curve variation with tip-sample distance


圖6 峰位置隨針尖-樣品距離的偏移曲線Fig.6 Curve of the peak position variation with tip-sample distance
圖6 是兩個NiFe薄膜樣品左右兩個峰的位置隨高度h的變化曲線.可以看出,隨著測試高度h的增加,Xc1逐漸減小,而Xc2逐漸增大,這表明左右兩個峰的位置隨著h的增加而遠(yuǎn)離.
圖7 是左右兩個峰之間距離(Xc2-Xc1)隨著h的變化曲線.可以看出,左右兩個峰之間的距離都隨著h的增大而線性增加.對圖7 中兩條曲線進(jìn)行線性擬合,擬合的結(jié)果如表1 所示.

表1 兩峰間距擬合直線的斜率與截距Tab.1 Slope and interception of spacing xbetween two peaks Fitting Line
根據(jù)近場微波理論以及圖3的測試曲線可以得出,在探針針尖逐漸靠近樣品表面的過程中,針尖電場與樣品的相互作用增強(qiáng),針尖電場在樣品表面的探測區(qū)域逐漸減小,空間分辨能力提高,掃描圖像線寬越接近真實值,從而可以認(rèn)為兩條擬合直線的截距(h=0時)即為兩組NiFe金屬薄膜樣品的實際線寬.從擬合結(jié)果可以發(fā)現(xiàn),通過上述方法得到的NiFe薄膜線寬分別為277 μm和484 μm,這非常接近NiFe薄膜的260 μm和470 μm 的實際線寬,表明通過線性擬合來獲得薄膜線寬的方法是可行的.本文這種方法和真實線寬之間仍有一定差別,其可能的原因是:在上述方法中沒有考慮探針針尖尺寸和線掃描步長的影響,同時,在線掃描過程中,掃描方向可能沒有和線條方向嚴(yán)格垂直,從而增加了掃描長度.
3 結(jié)束語
本文根據(jù)近場微波測試原理搭建了一套近場掃描微波顯微鏡系統(tǒng),并利用其對寬度分別為 260 μm 和470 μm 的NiFe薄膜樣品進(jìn)行掃描測試以確定其空間分辨率大小,并探索了針尖-樣品距離對其空間分辨率的影響.研究結(jié)果表明,隨著針尖和樣品距離h的增加,系統(tǒng)的空間分辨率降低,通過對測試結(jié)果進(jìn)行數(shù)據(jù)分析,發(fā)現(xiàn)測試得到的兩個峰之間的距離隨針尖-樣品距離h的升高呈線性變化.結(jié)合近場微波領(lǐng)域的基本理論,本文提出了一種測量掃描圖像線寬的方法,利用極值間距擬合直線的截距來表征線寬,測試結(jié)果表明,該方法得到的結(jié)果與實際結(jié)果較為吻合.本文的工作也為后續(xù)對近場掃描微波顯微鏡的進(jìn)一步研究奠定了基礎(chǔ).

