選擇性埋氧層上硅器件的單粒子瞬態響應的溫度相關性*
高占占 侯鵬飛 ? 郭紅霞 2) 李波 宋宏甲 王金斌 鐘向麗?
本文建立了90nm工藝下的絕緣體上硅浮體器件和選擇性埋氧層上硅器件模型,通過器件電路混合仿真探究了工作溫度對上述兩種結構的多級反相器鏈單粒子瞬態脈沖寬度以及器件內部電荷收集過程的影響.研究表明,N型選擇性埋氧層上硅器件相較于浮體器件具有更好的抗單粒子能力,但P型選擇性埋氧層上硅器件的抗單粒子能力在高線性能量轉移值下與浮體器件基本相同.同時電荷收集的溫度相關性分析表明,N型選擇性埋氧層上硅器件只存在漂移擴散過程,當溫度升高時其電荷收集量變化很小,而N型浮體器件存在雙極放大過程,電荷收集量隨著溫度的升高而顯著增加;另外,P型選擇性埋氧層上硅器件和浮體器件均存在雙極放大過程,當溫度升高時P型選擇性埋氧層上硅器件襯底中的雙極放大過程越來越嚴重,由于局部埋氧層的存在,反而抑制了其源極的雙極放大過程,導致它的電荷收集量要明顯少于P型浮體器件.因此選擇性埋氧層上硅器件比浮體器件更好地抑制了溫度對單粒子瞬態脈沖的影響.
1 引 言
SOI(silicon on insulator)器件是一種“硅/絕緣層/硅”三層結構的新型硅基半導體器件,具有更小的寄生電容、更快的運行速度和更低的功耗[1,2].其全介質隔離結構能夠消除傳統體硅CMOS(complementary metal oxide semiconductor)電路中的閂鎖效應,抑制襯底的脈沖電流干擾,同時很小的電荷收集體積使它具有更好的抗單粒子能力[3?5].盡管SOI器件在電學性能上表現出許多優勢,但其內部中性體區電學懸空會產生不同程度的浮體效應,導致器件閾值電壓漂移,寄生雙極放大晶體管易于開啟,增加SOI器件的單粒子瞬態脈沖持續時間[6?8].為了減弱SOI器件的浮體效應,文獻[9,10]采用消除溝道下方部分埋氧層的工藝來使頂層硅膜與襯底相通,利用埋氧層空洞將溝道中碰撞電離產生的電荷導入襯底減小中性體區的電勢,同時依然具備SOI器件優越的電學性能,這種改善結構被稱為選擇性埋氧層(selective buried oxide,SELBOX)結 構 .但 是 當 高 能 粒 子 入 射SELBOX SOI器件后其襯底中電離產生的電子或空穴也會通過埋氧層空洞被頂層硅膜中的有源區收集,對單粒子瞬態脈沖高度和寬度產生影響,進而導致電路輸出信號出錯甚至電路燒毀.因此有必要對SELBOX SOI器件的單粒子效應進行研究.
半導體器件工作在空間環境中,不僅會受到各種射線和粒子的輻射影響,還會受到極端溫度的影響(受陽光直射一面的設備溫度可高達100℃以上,而背陰一面的設備溫度可低至–200℃).溫度會影響半導體器件內部載流子的輸運過程、碰撞電離過程,進而會導致器件內部的電荷收集過程(如漂移、擴散、雙極放大等)以及單粒子瞬態脈沖發生變化[11].近期,蔡莉等[12]研究了不同工作溫度下0.15工藝的薄膜晶體管結構SRAM單粒子翻轉情況,輻照試驗表明當Cl離子入射時工作溫度從 215K 增加到 353K,SRAM單粒子翻轉截面增加了 257%.Liu 等[13]針對 0.5工藝的部分耗盡型SOI加固SRAM器件進行了12C重離子的單粒子翻轉輻照試驗,研究發現工作溫度從293K升高到388K時SRAM器件的單粒子翻轉截面增加了98%.另外,當前體硅器件以及SOI浮體器件單粒子效應的溫度相關性模擬分析表明[14,15],溫度升高加劇了器件內部的雙極放大作用,導致晶體管漏極電荷收集量增加,最終引起單粒子瞬態脈沖寬度的增加.然而工作溫度對SELBOX SOI器件的單粒子效應機制的影響目前還尚未清楚,因此研究其單粒子效應的溫度相關性對于SLEBOX SOI器件在寬范圍溫度下的應用和進一步改善SOI結構具有重要意義.
本文分別建立了SOI浮體器件和SELBOX SOI器件模型,運用器件混合仿真手段模擬了SOI多級反相器鏈的單粒子瞬態響應過程,對比研究了兩種SOI器件的瞬態電流脈沖和反相器鏈輸出節點的瞬態電壓脈沖變化,并探究了200—450K范圍的工作溫度對單粒子瞬態脈沖寬度的影響,深入分析了在不同溫度下兩種SOI器件內部的電荷收集過程,研究結果對極端溫度環境下SOI器件的抗輻射加固和未來SOI結構的開發具有重要的指導性作用.
2 仿真設置
本文利用Sentaurus TCAD工具包分別建立了 90nm工藝下的 SOI浮體器件和 SELBOX SOI器件模型,如圖 1 所示,整個器件尺寸為 10×10×10,其中 SOI NMOS 管和 SOI PMOS管的長寬比分別為 WN∶LN=280nm∶90nm,WP∶LP=480nm∶90nm.為了使所建模型的電氣性能更接近真實器件,本文通過調整源漏輕摻雜(LDD)濃度、閾值電壓摻雜濃度以及冠狀(Halo)摻雜濃度,對兩種SOI器件物理模型進行工藝校準,即所建物理模型的輸出曲線和轉移曲線分別與SPICE (simulation program with integrated circuit emphasis)模型的電學特性曲線對比,使它們在數值上處于同一數量級,器件的具體工藝參數如表1所列.隨后開展三級反相器鏈的器件電路混合模擬仿真實驗,邏輯輸入端輸入低電平,邏輯輸出節點1的單粒子瞬態電壓脈沖信號經過緩沖節點2的傳播衰減后在節點3輸出最終的電壓脈沖信號,其中SPICE模型采用亞利桑那州立大學的90nm工藝BSIM4SPICE集約模型[16],如圖2所示.
當器件特征尺寸達到深亞微米級時,經典漂移擴散模型已經不能精確地描述非局部效應(列如速度過沖),還會造成器件過早擊穿.因此本文中載流子輸運過程采用更適合于深亞微米級短溝道器件的流體動力學模型,它包含的主要基本方程如下:泊松方程:
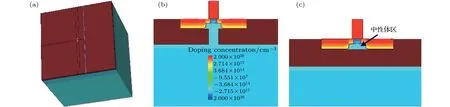
圖1 器件物理模型 (a)器件整體模型;(b)SELBOX SOI器件有源區截面;(c)浮體器件有源區截面Fig.1.Device physical models:(a)The whole structure of devices;(b)the cross section of SELBOX SOI device;(c)the cross section of floating-body device.

表1 SOI器件工藝參數Table1. Technologic parameters of SOI devices.
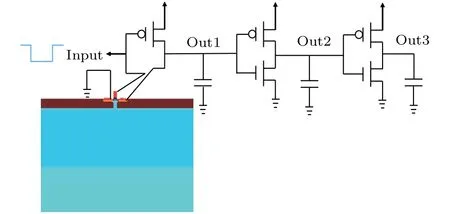
圖2 三級反相器鏈Fig.2.Three-level inverter chains.

考慮到深亞微米SOI器件中薄柵氧、超薄硅層以及高溝道摻雜所產生的量子效應,傳輸方程中還采用了密度梯度模型,其自相容地與泊松方程和載流子連續方程解算量子勢方程,量子勢是載流子濃度和濃度梯度的函數,器件模擬中通過引入量子勢來考慮量子效應.
在數值器件模擬中采用的其他物理模型還包括摻雜、溫度相關的SRH復合模型和Auger復合模型,高濃度摻雜下的禁帶變窄模型同時考慮了摻雜、溫度、電場以及載流子之間的散射和碰撞電離模型對遷移率的影響.上述這些影響MOSFET(metal-oxide-semiconductor field-effect transistor)的電學特性的物理模型詳見半導體器件仿真工具[17].
在輻照模擬過程中,首先計算器件物理模型和SPICE模型搭建的混合電路的電學特性,求得穩態解,在此基礎上耦合單粒子輻射模型,然后計算得出瞬態解.其中單粒子輻射模型采用Gaussian分布建模,Gaussian時序分布有0.25ps的延遲,轟擊粒子的初始入射半徑為0.05,入射深度為10,其他參數為 TCAD 默認設置.詳細求解高能粒子引起的電子空穴對產生率G的基本方程式如下:

其中,LET_f(l)為輻射產生的線性能量轉移值(linear energy transfer,LET),l為入射深度,wt(l)為高能粒子入射半徑,t0為初始入射時間,shi為Gaussian時序分布特征延遲時間.
3 模擬結果
3.1 SELBOX SOI器件與浮體器件的瞬態脈沖對比

圖3 室溫下 SOI NMOS 及輸出節點 3 的單粒子瞬態脈沖 (a)瞬態電流脈沖;(b)瞬態電壓脈沖Fig.3.Single-event-transient pulse of SOI NMOS and output 3 at room temperature: (a) Current pulse; (b)voltage pulse.
圖3 所示為室溫下用不同LET值的高能粒子分別入射N型浮體器件和SELBOX SOI器件后的瞬態電流以及輸出節點3的瞬態電壓.從圖中可以觀察到,盡管SELBOX SOI器件產生的瞬態電流脈沖高度要高于浮體器件,但它的電流脈沖持續時間要比浮體器件短,并且在同一LET值下其輸出節點3的電壓脈沖變化寬度也要小于浮體器件,可見N型SELBOX SOI器件比N型浮體器件有更為優異的抗單粒子能力.
圖4所示為室溫下不同LET值的高能粒子分別入射P型浮體器件和SELBOX SOI器件后的瞬態電流以及輸出節點3的瞬態電壓.與高能粒子入射N型SOI器件結果不同,SELBOX SOI器件在低LET值下的瞬態電流脈沖寬度和瞬態電壓脈沖寬度都要小于浮體器件,但是隨著LET值的不斷增大,兩種P型SOI器件的抗單粒子能力相近.
3.2 入射SOI器件時反相器鏈瞬態脈沖的溫度相關性
為了研究工作環境溫度對物理器件及輸出節點的單粒子瞬態脈沖的影響,模擬中選取LET值為 40MeV·cm2/mg 的高能粒子分別在 200,250,300,350,400和 450K 的溫度下轟擊浮體器件和SELBOX SOI器件,文中采用國際上通用的半高寬(電流或電壓峰值的一半)作為脈沖寬度.
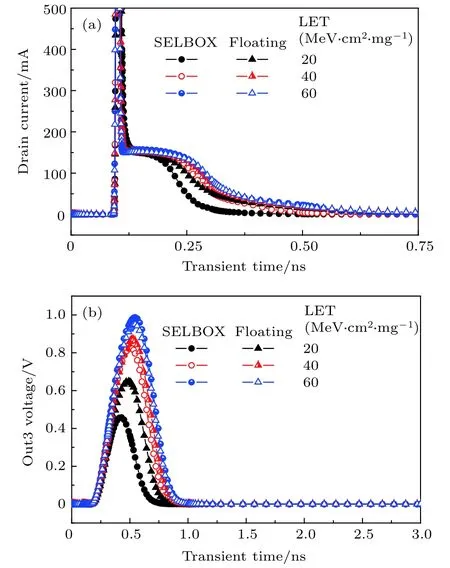
圖4 室溫下 SOI PMOS 及輸出節點 3 的單粒子瞬態脈沖 (a)瞬態電流脈沖;(b)瞬態電壓脈沖Fig.4.Single-event-transient pulse of SOI PMOS and output3at room temperature:(a)The current pulse;(b)the voltage pulse.
圖5 為高能粒子入射N型浮體器件和SELBOX SOI器件的脈沖寬度與溫度的關系.從圖5(a)可以觀察到,SELBOX SOI器件的電流脈沖寬度隨溫度的升高而增加,且增加的幅度要遠遠小于浮體器件.從圖 5(b)觀察到,在電壓脈沖傳播至節點3后,SELOBX SOI器件的輸出電壓脈沖寬度隨溫度升高幾乎不變.可見N型SELBOX SOI器件瞬態脈沖寬度相較于浮體器件受溫度的影響較小.
圖6為高能粒子入射P型浮體器件和SELBOX SOI器件時脈沖寬度與溫度的關系.對比浮體器件的脈沖寬度可以發現,SELBOX SOI器件的電流脈沖寬度和電壓脈沖寬度在300K以下要高于浮體器件,隨著溫度逐漸升高,其瞬態電流脈沖寬度和電壓脈沖寬度反而要小于浮體器件.但縱觀200—450K 整個溫度區間,P 型 SELBOX SOI器件的電流脈沖寬度和電壓脈沖寬度的變化量均要小于浮體器件.可見盡管溫度對兩種SOI器件的單粒子脈沖寬度都產生了一定影響,但SELBOX結構有效抑制了溫度對P型SOI器件單粒子效應的影響.

圖5 SOI NMOS 及輸出節點 3 的脈沖寬度隨溫度的變化(a)瞬態電流脈沖寬度的變化;(b)瞬態電壓脈沖寬度的變化Fig.5.The pulsewidth of SOI NMOS and output 3 at different temperatures: (a) Changes of the current pulsewidth;(b)changes of the voltage pulsewidth.
4 討論分析
當單粒子入射處于關閉狀態的晶體管時,器件內部會產生電子空穴對,同時部分電子或空穴被漏極收集導致晶體管被迫導通,不同溫度下漏極收集的電荷量不同,使晶體管產生不同寬度的瞬態脈沖,并在整個反相器鏈中逐級傳播.因此可從電荷收集的角度分析溫度對浮體器件和SELBOX SOI器件的單粒子瞬態脈沖的影響,這里模擬不同溫度下SOI器件分別在有源極和無源極時的電荷收集過程,討論分析兩種SOI器件在電荷收集過程中的漂移擴散和雙極放大效應的溫度相關性.
4.1 SOI NMOS的電荷收集的溫度相關性分析
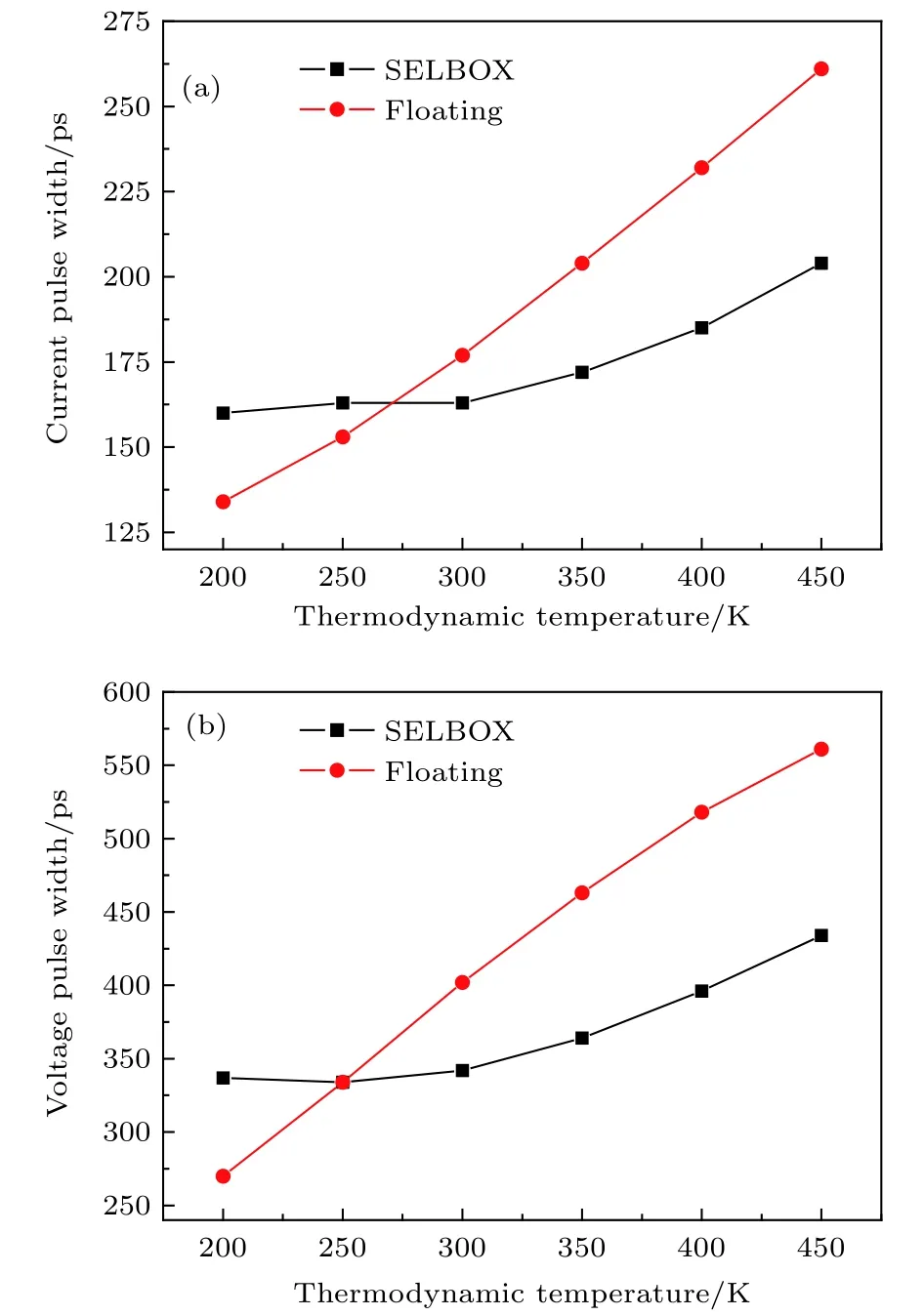
圖6 SOI PMOS 及輸出節點 3 的脈沖寬度隨溫度的變化(a)瞬態電流脈沖寬度的變化;(b)瞬態電壓脈沖寬度的變化Fig.6.The pulsewidth of SOI PMOS and output 3 at different temperatures: (a) Changes of the current pulsewidth;(b)changes of the voltage pulsewidth.
圖7 所示為在不同溫度下SOI NMOS的電荷收集量.從圖 7(a)可以看出,90nm 工藝下的浮體器件不只有漂移擴散過程,還產生了顯著的雙極放大過程,這是因為全介質隔離的結構使得電離產生的空穴無法導出,電勢被抬高后源體結正偏導致大量電子從源極注入.溫度引起熱載流子的碰撞電離率產生變化的關系式為,其中 Ei為 3,Eg為禁帶寬度,A 為材料系數,k 為玻爾茲曼常數,T為熱力學溫度.當溫度升高時,溝道中獲得能量的高能熱載流子[18]通過碰撞電離激發更多的空穴,不斷抬高體電勢,使得雙極放大持續時間增加,導致漏極收集的電荷量隨溫度升高而增加.
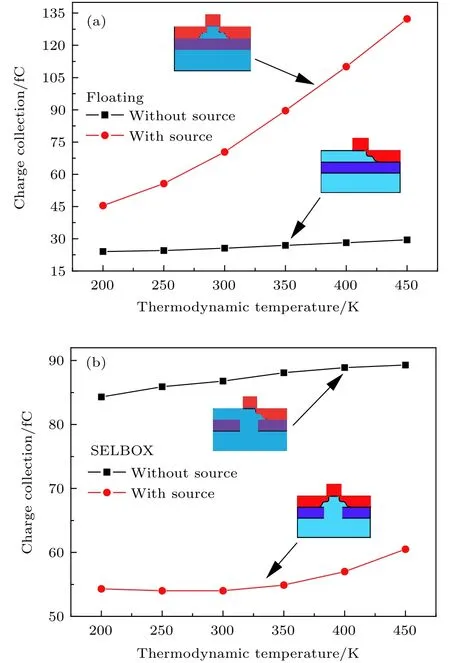
圖7 在不同溫度下 SOI NMOS 的電荷收集量 (a)浮體器件;(b)SELBOX SOI器件Fig.7.The charge collection of SOI NMOS at different temperatures:(a)Floating-body device;(b)SELBOX SOI device.
從圖 7(b)可以看到,SELBOX SOI器件的電荷收集過程與浮體器件有所不同,在有源極時收集的電荷量要低于無源極時的電荷量,說明源漏極都起到了收集電荷的作用,并不存在雙極放大效應,這和文獻[19,20]中100nm工藝以下的N型器件電荷收集過程類似,主要原因是由于局部埋氧層的存在,頂層硅膜中產生的電子空穴對較少,并且電離產生的空穴通過埋氧層空洞被底電極收集致使中性體區電勢沒有抬高,抑制了源–中性體區–漏構成的NPN晶體管的雙極放大作用.溫度造成晶格振動引起的散射概率變化的關系式為:聲學波分支的散射概率 P∝m*2·T3/2,其中 m*為電子有效質量,T為熱力學溫度;光學波分支的散射概率率[21].當溫度升高時,晶格振動越劇烈,粒子散射越強,導致埋氧層下方電離的部分電子通過鏤空通道被漏極收集,因此漏極收集的電荷量逐漸增加.
4.2 SOI PMOS的電荷收集的溫度相關性分析
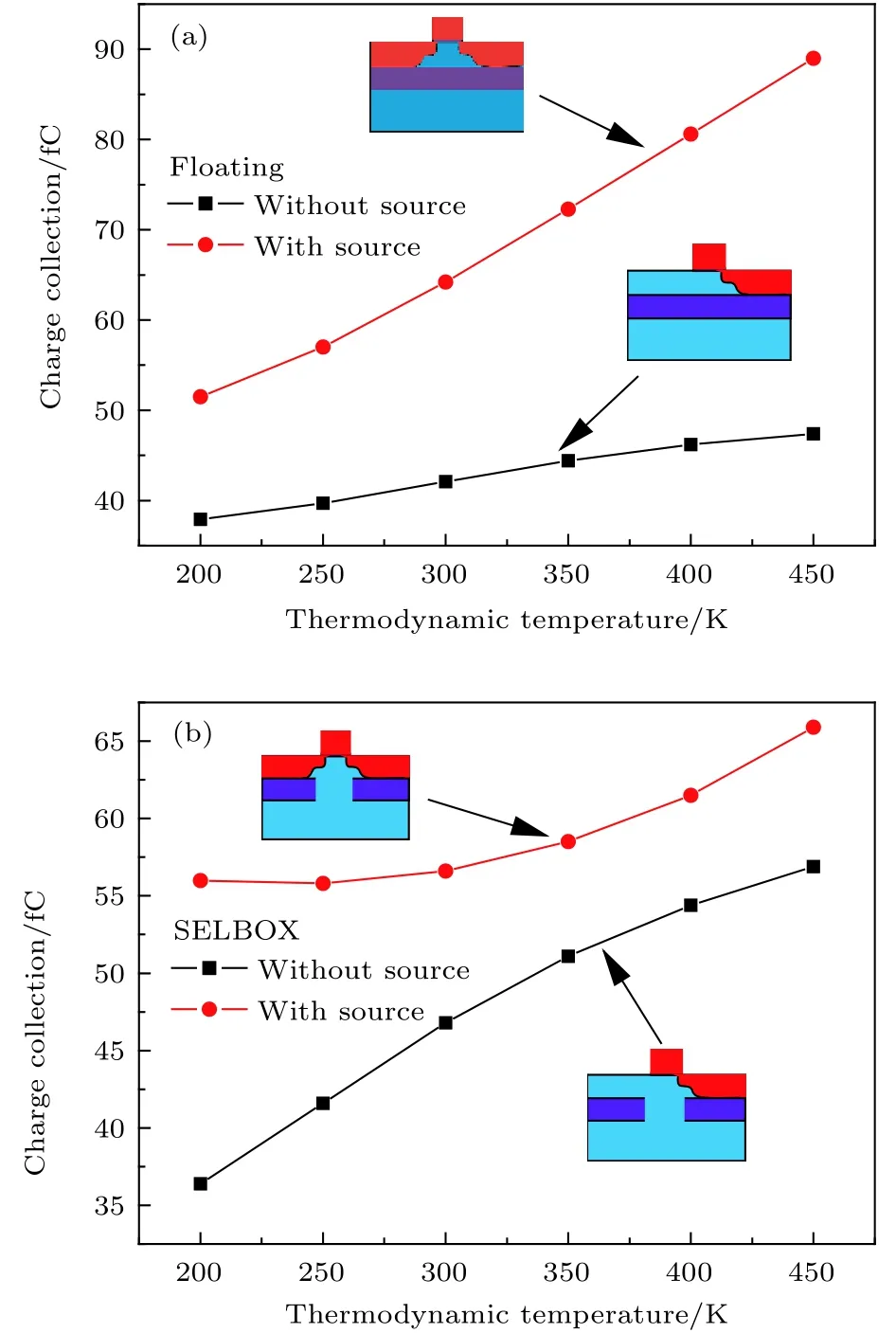
圖8 在不同溫度下 SOI PMOS 的電荷收集量 (a)浮體器件;(b)SELBOX SOI器件Fig.8.The charge collection of SOI PMOS at different temperatures:(a)Floating-body device;(b)SELBOX SOI device.
圖8 所示為在不同溫度下SOI PMOS的電荷收集量.從圖 8(a)可以看出,P 型浮體器件的電荷收集量受溫度影響的變化趨勢,和N型浮體器件的電荷收集過程類似.圖9所示為SOI器件產生雙極放大的原理圖.從圖 9(a)可以看到,由于埋氧層的完全隔離,器件不會受到襯底中的寄生雙極晶體管的影響[22],在無源極條件下漏極收集的電荷量隨著溫度的升高只是小幅增加.而在有源極條件下浮體器件源極注入的電荷量隨著溫度的升高而顯著增加(如圖8(a)所示),主要原因是溫度的升高使得高能熱載流子增加,導致碰撞電離產生的電子滯留在中性體區拉低電勢,使得漏–中性體區–源構成的PNP晶體管開啟,源極大量注入空穴,最后被漏極收集.
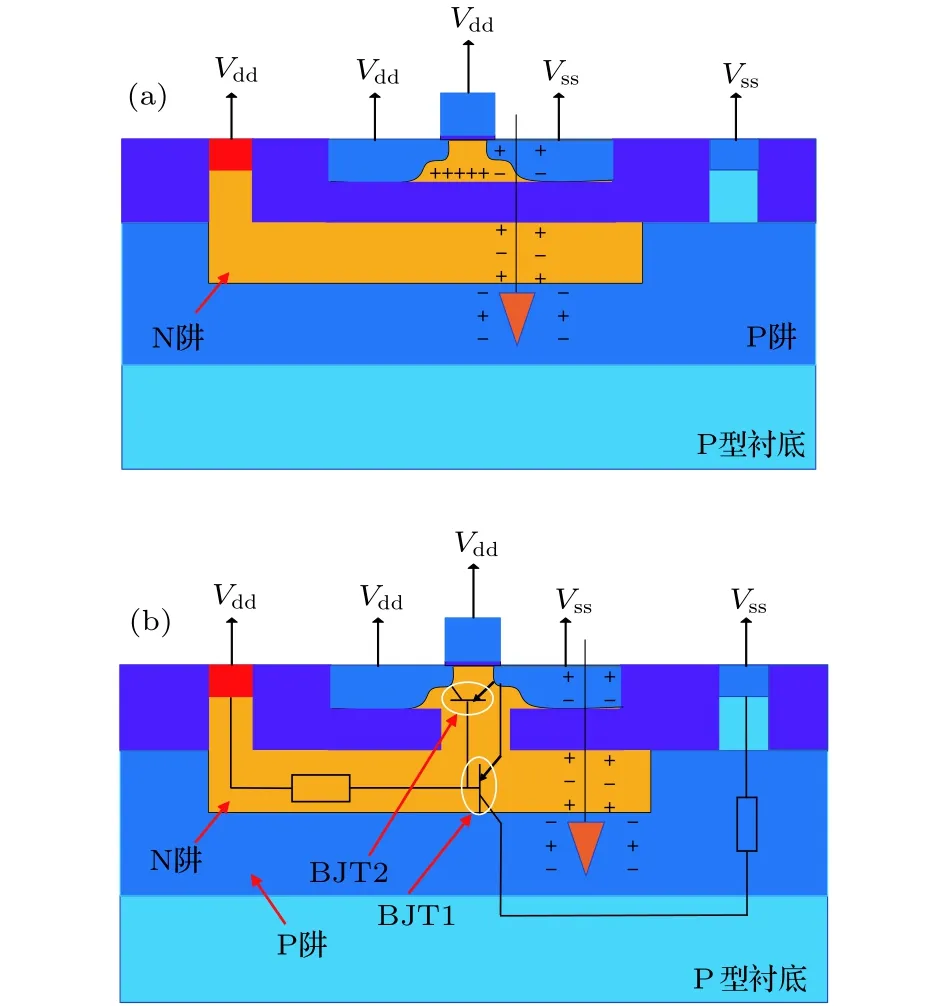
圖9 SOI器 件 產 生 雙 極 放 大 的 原 理 (a)浮 體 器 件 ;(b)SELBOX SOI器件Fig.9.The bipolar amplification effect of SOI devices:(a)Floating-body device;(b)SELBOX SOI device.
從圖 8(b)可以看到,與 N 型 SELBOX SOI器件的情況完全不同,P型SELBOX SOI器件在去掉源極的情況下漏極收集的電荷量隨著溫度的升高顯著增加.根據圖9(b)所示,此時器件內部只存在寄生晶體管BJT1,當單粒子入射后N阱與P阱之間的PN結被穿通,電子大量運動到N阱中,使其電勢下降,而P阱由于空穴的積累,電勢被抬高,導致N阱和P阱之間的PN結正偏,當溫度升高時P阱到P阱接觸以及N阱到N阱接觸之間的電阻都將變大[23],使得N阱與P阱之間的電勢差隨著溫度的升高而增加,這樣就直接導致大量空穴從襯底進入N阱中,除去一些空穴和電子復合外,另一部分空穴通過埋氧層空洞被漏極收集,最終使得無源極時漏極收集的電荷隨著溫度的升高而增加(如圖8(b)所示).但是對比有無源極時的電荷收集過程,可以看到構成寄生晶體管BJT2的源極注入的電荷量隨著溫度的升高反而下降了,這與文獻[24]中體硅器件產生的雙極放大效應隨著溫度的升高而增加恰恰相反,主要是因為N阱與P阱之間的PN結面積要遠大于源極與N阱之間的PN結面積,根據上述無源極時的電荷收集原理,當溫度升高時從P阱注入N阱的空穴變多,但由于局部埋氧層的阻隔,注入N阱的空穴不能完全被漏極收集,導致N阱電勢有所抬高,使得源極與N阱之間的電勢差減小,從而源極注入電荷變少.
5 結 論
本文建立了 90nm工藝下的浮體器件和SELBOX SOI器件模型,通過器件混合模擬研究了SOI器件的單粒子脈沖和電荷收集的溫度相關性.在室溫下N型SELBOX SOI器件的抗單粒子能力有明顯提升,而P型SELBOX SOI器件的抗單粒子能力在高LET值下基本不變.單粒子瞬態脈沖的溫度相關性模擬表明,SELBOX SOI器件有效削弱了溫度對單粒子脈沖寬度的影響.從電荷收集的溫度相關性分析得出,N型和P型浮體器件都具有顯著的雙極放大效應,當溫度升高時,高能熱載流子引起的碰撞電離愈發嚴重,加劇了其雙極放大效應;而N型SELBOX SOI器件只存在漂移擴散效應,溫度升高并沒有對漏極的電荷收集量產生很大影響;對于 P 型 SELBOX SOI器件,溫度升高加劇P阱–N阱–—漏極構成的晶體管雙極放大效應,但有效抑制了漏極–體區–源極構成的晶體管雙極放大效應,使其漏極電荷收集量要少于P型浮體器件.以上結論為SELBOX SOI器件廣泛應用在200—450K范圍的空間環境以及未來開發更優異的SOI結構提供理論基礎.

