Hf0.5Zr0.5O2鐵電薄膜的制備和性能研究
李晨雨,朱俊,陳歡文
(電子科技大學電子薄膜與集成器件國家重點實驗室,四川 成都610054)
Hf0.5Zr0.5O2鐵電薄膜的制備和性能研究
李晨雨,朱俊,陳歡文
(電子科技大學電子薄膜與集成器件國家重點實驗室,四川 成都610054)
運用脈沖激光沉積方法,在Pt(111)基片上沉積制備Hf0.5Zr0.5O2鐵電薄膜。通過對X射線衍射(XRD)分析表明,薄膜的正交相隨襯底溫度升高而增強,隨薄膜厚度增加而減小。P-E電滯回線實驗表明,提高襯底溫度有助于增強薄膜鐵電性能。400℃氧氣中原位退火后薄膜剩余極化(2Pr)達到8μC/ cm2。5V以下薄膜漏電流密度為3.2×10-6A/cm2。Hf0.5Zr0.5O2薄膜的疲勞特性測試表明,在經過2×109次反轉后可參與翻轉總極化值有一定下降。
脈沖激光沉積;Hf0.5Zr0.5O2薄膜;鐵電;XRD;疲勞測試
0 引 言
因為鐵電存儲器具有雙穩態極化特性,普遍被認為是應用前景廣泛的非易失性存儲器。大多數研究都集中在鈣鈦礦結構的傳統鐵電材料上。然而傳統鈣鈦礦結構的鐵電薄膜在應用于硅基鐵電存儲器上,已經被證明有很多困難,如鐵電尺寸效應、小的帯隙、與硅的界面許多不匹配、結晶過程中因熱處理導致的退化等[1]。
近年來,二元氧化物HfO2、ZrO2因其高的介電常數,被廣泛應用于場效應管柵介質層[2]。和大多數二元氧化物相似,HfO2、ZrO2被認為一般成中心對稱的晶體結構,具有線性的介質特性。因此盡管這些氧化物被成功地引入微電子技術,但人們并沒有考慮到它們除了電介質的這種有限的功能外的其他用途。
最近Johannes Müller等報道,HfO2薄膜在不同元素摻雜的情況下會出現鐵電性,如Si,Y,Al, Zr[3-7]。這將對鐵電存儲器的發展產生很大的推進作用。氧化鉿基鐵電體與CMOS工藝兼容,為鐵電存儲器制造提供了更簡便的方法。而且由于它的介電常數高,可以有效地減少FeFETs器件的尺寸,從而提高電路集成度,且適合未來開發三維器件。在各種摻雜材料中,Zr被認為最有發展前景,因為它的化學特性與Hf幾乎相同。與其他摻雜材料相比在特定成分比附近(Hf∶Zr=1∶1)都具有較為明顯的鐵電性,適合大量生產。
摻雜HfO2薄膜的鐵電性一般被認為來源于形成了非中心對稱的Pbc21正交相晶體結構[3-7]。一般正交相的Hf0.5Zr0.5O2只有在高壓環境下才是穩定相。但薄膜狀態的Hf0.5Zr0.5O2在二維張應力或拉應力環境下很可能產生正交相的轉換。Johannes Müller等人用原子層累積(ALD)技術制備了鐵電性能良好的Hf0.5Zr0.5O2薄膜。通過XRD圖譜分析,在30.5°的(111)取向的峰被認為是正交相的衍射峰[8]。
本文采用脈沖激光沉積(PLD)技術在以Pt(111)為底電極的 Si(001)基片上生長 Hf0.5Zr0.5O2鐵電薄膜。并對其進行了XRD,P-E電滯回線,I-V特性,進行疲勞測試。
1 實驗
本文所使用的Hf0.5Zr0.5O2靶材是由HfO2、ZrO2按照1∶1的化學計量比配置燒制而成。以Pt為底電極的Si(001)基片作為襯底材料。使用由沈陽中科儀器公司生產的PLD外延設備以及德國LAMBDAPHYSIK公司生產的脈沖寬度為30nsN的KrF準分子激光器(波長為248nm)。實驗前基片分別是丙酮、酒精。在去離子水中用超聲清洗3分鐘,然后經過高純度N2吹干后,迅速放入真空腔體。控制激光脈沖能量為140mj,頻率為3Hz。在20pa氧壓不同溫度下生長Hf0.5Zr0.5O2薄膜。生長完成后薄膜在5×104pa氧壓下原位退火30min。為了對薄膜進行電性能測試,本文利用電子束蒸發在Hf0.5Zr0.5O2薄膜上制備的Ti/Au電極,電極面積為0.00025cm2。
采用英國Bede公司生產的D1型多功能X射線衍射(XRD)儀分析薄膜生長取向以及結晶程度。I-V性能表征采用Hewlett-Packard 4155B半導體參數分析儀。P-E電滯回線測試和疲勞特性測試采用Radiant RT66A鐵電測試儀。
2 結果與分析
2.1 薄膜結構分析
圖1 為在不同襯底溫度下生長的Hf0.5Zr0.5O2薄膜的XRD2θ掃描圖譜。結果顯示隨著襯底溫度升高,薄膜在28.5°的 (-111)單斜相衍射峰和38.5°的(102)正交相衍射峰均增強。說明薄膜結晶性能隨襯底溫度升高而增強。但是考慮到Hf0.5Zr0.5O2薄膜的鐵電性能,應抑制中心對稱的單斜相結構產生。

圖1 不同襯底溫度下制備的Hf0.5Zr0.5O2薄膜的XRD圖譜
圖2 是在相同條件下制備厚度不同的Hf0.5Zr0.5O2薄膜的XRD2θ掃描圖譜。可以看到隨著薄膜厚度增加,單斜相衍射峰(-111)逐漸增強。正交相衍射峰(102)則逐漸減弱。說明減小薄膜厚度可以有效地抑制單斜相產生。

圖2 不同厚度Hf0.5Zr0.5O2薄膜的XRD圖譜
2.2 薄膜鐵電性能分析
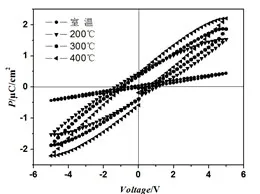
圖3 不同襯底溫度下制備的Hf0.5Zr0.5O2薄膜的P-E電滯回線
圖3 為不同襯底溫度制備的Hf0.5Zr0.5O2薄膜的電滯回線。由圖3可以看到,正常室溫下薄膜呈順電相。隨著襯底溫度升高,薄膜的剩余極化強度增強,矯頑場減弱。說明提高襯底溫度可以有效提高薄膜鐵電性,與前面XRD分析結果相符合。
圖4 為400℃下制備的Hf0.5Zr0.5O2薄膜經過在400℃氧氣中原位退火后的電滯回線。退火后的薄膜鐵電性能提升較大,10V下最大剩余極化可以達到8μC/cm2。當電壓加到11V時,薄膜漏電比較嚴重。同時看到,P-E曲線窗口沒有閉合,這可能是由于采用了非對稱的上下電極而導致的。

圖4 400℃下氧氣中原位退火后Hf0.5Zr0.5O2薄膜的P-E電滯回線
2.3 薄膜漏電性能分析
鐵電薄膜的性能與其絕緣特性密切相關,因此測試薄膜漏電性能,圖5所示。在測試范圍內薄膜漏電流隨電壓增大而增加。在正負電壓下,薄膜的漏電流曲線對稱。在1V下薄膜漏電流密度為3.9×10-7A/cm2,在5V電壓下漏電流密度為3.2×10-6A/cm2。結果表明Hf0.5Zr0.5O2薄膜具有良好的絕緣性能。
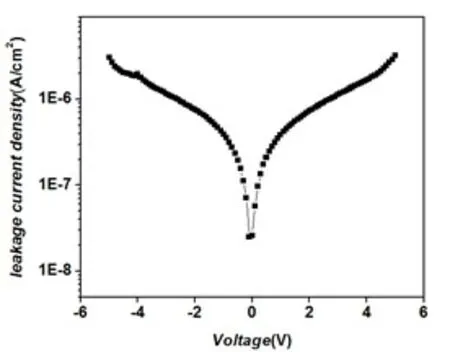
圖5 在pt/Si上生長的Hf0.5Zr0.5O2薄膜的I-V特性曲線
2.4 薄膜疲勞特性分析
圖6 為Hf0.5Zr0.5O2薄膜的疲勞特性曲線。測試頻率1MHz,測試電壓8V。由圖6可以看到,薄膜的剩余極化在經過107次翻轉后開始明顯減小。經過2×109次翻轉后,薄膜可參與翻轉的總極化值下降了24.6%。這可能是在極化反轉過程中,晶體內部內應力來不及釋放,造成微小裂紋,破壞了電場的連續性,使得晶體的部分自發極化不能被電場反轉,導致剩余極化減小。
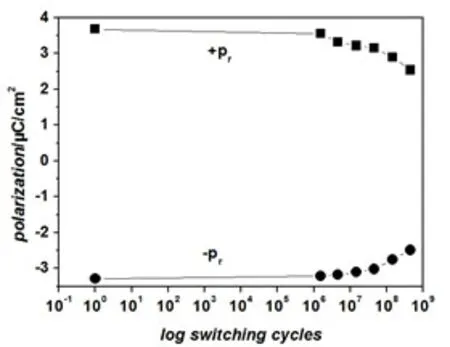
圖6 在pt/Si上生長的Hf0.5Zr0.5O2薄膜的疲勞特性曲線
3 結 論
通過使用脈沖激光沉積法,在以Pt為底電極的Si(001)基片上制備出了Hf0.5Zr0.5O2鐵電薄膜。其鐵電性主要來源于非中心對稱的正交結構。正交相與襯底溫度和薄膜厚度有關。隨著襯底溫度升高,正交相增強。隨著厚度增加正交相減弱。薄膜鐵電性能隨襯底溫度增高而增強。在400℃氧氣中原位退火后,薄膜剩余極化可以達到8μC/cm2,5V下漏電流密度達到3.2×10-6A/cm2。薄膜剩余極化在經過2×109次翻轉后,可參與翻轉總極化值下降了24.6%。實驗表明Hf0.5Zr0.5O2具有良好的鐵電性能和絕緣性能,能滿足作為MFIS結構中鐵電材料的要求。
[1]D.S.Jeong,R.Thomas,R.S.Katiyar,et al.Emerging memories:resistive switching mechanisms and current status[J].Rep.Prog.Phys.2012,75:076502.
[2]趙毅.高K柵介質研究進展[J].半導體技術,2004,29 (5):16-19.
[3]T.S.B?scke,J.Müller,D.Br?uhaus,et al.Ferroelectricity in hafnium oxide thin films[J].Appl.Phys.Lett. 2011,99:102903
[4]J.Müller,U.ScHf?der,T.S.B?scke,et al.Ferroelectricity in yttrium-doped hafnium oxide[J].Appl.Phys. 2011,110:114113.
[5]S.Müller,J.Müller,A.Singh,et al,Incipient ferroelectricity in Al-doped HfO2thin films[J].Adv. Funct.Mater,2012,22:2412.
[6]J.Müller,T.S.B?scke,U.ScHf?der,et al,Ferroelectricity in simple Binary ZrO2and HfO2[J].Nano Lett,2012,12:4318.
[7]M.H.Park,H.J.Kim,Y.J.Kim,et al.Evolution of phases and ferroelectric properties of thin Hf0.5Zr0.5O2films according to the thickness and annealing temperature[J],Appl.Phys.Lett,2013,102:112914.
[8]J.Müller,T.S.B?scke,D.Br?uhaus,et al,Ferroelectric Zr0.5Hf0.5O2thin films for nonvolatile memory applications[J].Appl.Phys.Lett,2011,99:112901.
責任編輯王榮輝
TN304
A
1674-5787(2014)03-0149-03
10.13887/j.cnki.jccee.2014(03).045
2014-04-22
李晨雨(1988—),男,重慶北碚人,碩士研究生,主要從事HfZrO系列鐵電薄膜的制備及性能研究。

