基于濕法腐蝕凹槽陽極的低漏電高耐壓AlGaN/GaN 肖特基二極管*
武鵬 朱宏宇 吳金星 張濤? 張進成? 郝躍
1) (西安電子科技大學,寬禁帶半導體器件與集成電路全國重點實驗室,西安 710071)
2) (中國飛行試驗研究院,西安 710089)
得益于鋁鎵氮/氮化鎵異質結材料較大的禁帶寬度、較高的擊穿場強以及異質界面存在的高面密度及高遷移率的二維電子氣,基于該異質結材料的器件在高壓大功率及微波射頻方面具有良好的應用前景,尤其是隨著大尺寸硅基氮化鎵材料外延技術的逐漸成熟,低成本的氮化鎵器件在消費電子方面也展現出極大的優勢.為了提高鋁鎵氮/氮化鎵肖特基二極管的整流效率,通常要求器件具有較小的開啟電壓、較低的反向漏電和較高的擊穿電壓,采用低功函數金屬陽極結構能有效降低器件開啟電壓,但較低的陽極勢壘高度使器件易受界面缺陷的影響,導致器件反向漏電增大.本文采用一種新型的基于熱氧氧化及氫氧化鉀腐蝕的低損傷陽極凹槽制備技術,解決了常規干法刻蝕引入的表面等離子體損傷難題,使凹槽表面粗糙度由0.57 nm 降低至0.23 nm,器件陽極反向偏置為–1 kV 時的漏電流密度由1.5×10–6 A/mm 降低至2.6×10–7 A/mm,另外,由于熱KOH 溶液對熱氧氧化后的AlGaN 勢壘層及GaN 溝道層具有良好的腐蝕選擇比,因此避免了干法刻蝕腔體中由于等離子體分布不均勻導致的邊緣刻蝕尖峰問題,使器件反向耐壓由–1.28 kV 提升至–1.73 kV,器件性能得到極大提升.
1 引言
隨著半導體功率器件及模塊的不斷發展,現有的硅(Si)快恢復二極管已逐漸難以滿足未來高速信息化應用領域需求,現階段車載激光雷達通常采用Si 快恢復二極管作為電路的續流管,但較長的反向恢復時間阻礙了電路的工作頻率,導致信息采集較慢,難以滿足未來智能駕駛的需求,而性能較好的碳化硅(SiC)肖特基二極管(SBD)價格相對較高,難以實現高性能激光雷達的普及應用.基于Si 襯底的氮化鎵(GaN)SBD 不僅具有相對低廉的成本,同時還具有可與SiC SBD 媲美的反向恢復時間,在未來高速信號的采集及輸運方面具有非常好的應用前景.GaN 作為第三代半導體的典型代表,在實現高耐壓、大功率器件方面具有得天獨厚的優勢[1?4],尤其是基于鋁鎵氮/氮化鎵(AlGaN/GaN)異質界面強極化效應而產生的高面密度和高遷移率的二維電子氣(2DEG),為實現高功率密度單片集成電路提供了極佳方案[5?8].由于缺乏大尺寸單晶GaN 同質襯底,以及GaN 同質外延界面存在高陷阱態密度等問題,現階段基于AlGaN/GaN異質結的材料通常采用SiC 和Si 等異質襯底,導致外延材料具有較高的穿透位錯密度[9?11].平面結構AlGaN/GaN SBD 具有較大的陽極勢壘高度及勢壘寬度,器件開啟電壓通常高達1.5 V,另外,受到陽極金屬下方高穿透位錯密度的影響,器件通常具有較大的反向漏電.為了實現較高的工作效率,GaN SBD 通常需要具有較小的開啟電壓和較小的反向漏電,通過采用凹槽陽極結構使陽極金屬與溝道處的2 DEG 直接接觸可以有效降低器件開啟電壓,并實現對陽極下方穿透位錯免疫的效果[12?16].
對于凹槽陽極結構AlGaN/GaN SBD 而言,通過優化器件陽極結構及界面特性,可以有效提高器件性能.通過在陽極邊緣引入高電子遷移率晶體管(HEMT)金屬-絕緣層-半導體(MIS)柵結構[17?20],阻斷器件反向偏置時陽極邊緣的載流子通路,可以有效降低器件反向漏電,同時,得益于凹槽MIS 柵結構對陽極邊緣電場的調控作用,器件的反向耐壓得到了有效的提升.另外,采用鰭型(Fin)柵結構替代MIS 柵結構[21,22],可以進一步實現超低器件反向漏電.通過采用低功函數金屬及金屬氮化物陽極結構[12,13,19],可以有效降低陽極勢壘高度,實現較低的器件開啟電壓和導通電阻.對于低功函數金屬陽極結構而言,陽極肖特基勢壘特性更易受到界面陷阱態的影響,因此,通過采用低損傷GaN 刻蝕技術降低陽極凹槽界面陷阱態密度,對實現同時具備低開啟電壓和低反向漏電的高性能AlGaN/GaN SBD 器件具有重要的意義.
本文基于低功函數金屬鎢陽極技術,采用濕法腐蝕陽極凹槽制備技術替代常規干法氮化鎵刻蝕工藝,解決了AlGaN/GaN SBD 陽極凹槽制備過程中引入的刻蝕損傷較大導致器件反向漏電大的難題,同時得益于濕法腐蝕技術的自停止優勢,實現了具有明顯原子臺階流的刻蝕表面,與采用干法刻蝕的凹槽陽極器件相比,凹槽底部表面粗糙度由0.57 nm 降低為0.23 nm,反向擊穿電壓由1.28 kV 提升至1.73 kV,且正向導通特性無明顯退化,器件整體性能得到大幅度提升.
2 器件結構與制備
本文所制備的基于濕法腐蝕凹槽陽極結構的AlGaN/GaN SBD 器件的截面結構如圖1 所示,材料各層結構從上至下依次為2 nm GaN 帽層,23 nm Al 組分為25%的AlGaN 勢壘層,0.8 nm AlN插入層,200 nm 非故意摻雜GaN 溝道層和6 μm的碳摻雜高阻緩沖層,襯底采用1 mm 厚度的p 型導電Si 材料.為了降低外延材料與Si 襯底之間較大晶格失配的影響,樣品緩沖層采用超晶格結構,有效抑制了樣品穿透位錯密度,提升了GaN 溝道材料質量,從材料層面保障了器件實現較高耐壓和較低反向漏電的可行性.
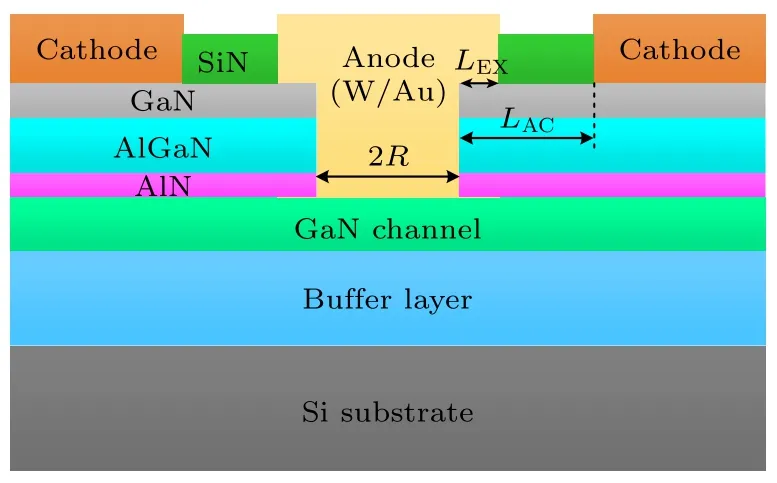
圖1 凹槽陽極結構低功函數陽極金屬AlGaN/GaN SBD器件截面圖Fig.1.Cross-sectional schematic view of AlGaN/GaN SBD with groove anode and low work-function metal as anode.
為了減少實驗過程中對外延材料表面的損傷及污染,樣品經丙酮、異丙醇超聲清洗后放置于低壓化學氣相沉積(LPCVD)系統中進行高質量氮化硅(SiN)鈍化層的生長,與等離子體增強化學氣相沉積(PECVD)法相比,采用LPCVD 法生長的鈍化層具有更好的材料質量,且能夠滿足后續GaN歐姆接觸高溫退火的需求,經測試可知,SiN 鈍化層厚度約為56.3 nm.臺面隔離有助于減少器件之間的串擾,首先采用反應離子刻蝕(RIE)設備以氟基氣體為等離子體源對隔離區域的SiN 材料進行過刻蝕,裸露出下方GaN 材料,然后采用氯氣和氯化硼的混合氣體在感應耦合等離子體刻蝕(ICP)設備中對GaN 進行刻蝕,經過臺階儀測試可知,器件間的總隔離深度約為210 nm.陽極區域的SiN鈍化層采用與臺面隔離相同的工藝進行刻蝕移除,然后在ICP 設備中以氯化硼氣體為等離子體源進行低功率的慢速低損傷刻蝕,刻蝕速率約為1.6 nm/min,刻蝕時間為3 min,用以移除陽極區域的GaN 帽層,露出下方的AlGaN 勢壘層,然后把樣品置于690 ℃的管式退火爐中進行高溫氧化處理,氧化時間為40 min.由于勢壘層熱氧氧化生成Al2O3的吉布斯自由能高于溝道氧化生成Ga2O3的吉布斯自由能,而在該溫度下氧氣可與AlGaN勢壘層發生反應生成Al2O3,而與GaN 材料的反應強度較弱,因此較長的氧化時間有助于保障AlGaN 勢壘層被充分氧化,且對下方GaN 材料界面影響較小.隨后把樣品置于70 ℃熱氫氧化鉀(KOH)溶液中進行濕法腐蝕,移除被氧化的AlGaN勢壘層,裸露出下方的GaN 材料.由于熱氫氧化鉀(KOH)溶液僅與熱氧氧化后的勢壘層發生反應,而不與下方的GaN 材料發生反應,因此實現了自停止的刻蝕效果[23?25].
在器件歐姆接觸金屬沉積之前,采用與前文相同的RIE 刻蝕工藝移除歐姆接觸區域的SiN 鈍化層,然后在電子束蒸發設備中依次沉積多層Ti/Al/Ni/Au (22/140/55/45 nm)金屬,并在氮氣氛圍中高溫退火35 s 形成低阻歐姆接觸.器件陽極金屬通過采用磁控濺射設備沉積雙層W/Au(30/150 nm)金屬,較低的陽極金屬功函數是實現器件較小開啟電壓的關鍵,然后在氮氣氛圍下對陽極界面采用490 ℃退火處理,促進陽極金屬與凹槽界面的GaN 材料成鍵,從而減小界面懸掛鍵及陷阱態密度,該陽極后退火處理是低功函數金屬陽極AlGaN/GaN SBD 實現低反向漏電的關鍵步驟.在濕法腐蝕凹槽陽極結構AlGaN/GaN SBD 器件制備的過程中,同時制備基于干法刻蝕的凹槽陽極結構AlGaN/GaN SBD 器件作為對比實驗,器件陽極凹槽結構首先采用RIE 刻蝕工藝移除陽極下方的SiN 鈍化層,然后采用低功率的慢速低損傷刻蝕工藝移除AlGaN 勢壘層,并在氮氣氛圍下采用450 ℃退火5 min 修復刻蝕損傷,除陽極凹槽制備工藝外,其余各步工藝均與濕法腐蝕凹槽陽極結構AlGaN SBD 器件制備方法相同.本文制備的AlGaN/GaN SBD 器件的陽極半徑(R)為100 μm,陰陽極間距(LAC)為15 μm,場板長度(LEX)為2 μm.
3 結果與討論
采用原子力顯微鏡(AFM)分別對濕法腐蝕陽極凹槽及干法刻蝕陽極凹槽形貌進行測試,結果如圖2(a)和圖2(b)所示,其中,內部插圖為凹槽刻蝕界面的表面粗糙度,測試范圍為3 μm×3 μm.得益于熱KOH 溶液對熱氧氧化后的AlGaN 勢壘層與GaN 溝道層之間的選擇性腐蝕,采用濕法腐蝕技術的凹槽深度約為82 nm,即熱KOH 溶液的腐蝕反應自停止于GaN 溝道表面,凹槽底部GaN 溝道表面出現明顯的原子臺階流,表面粗糙度約為0.23 nm,且凹槽底部與刻蝕側壁之間夾角較為陡直.對于采用干法刻蝕技術的陽極凹槽而言,為了確保陽極金屬與溝道中的2 DEG 直接接觸,本文對陽極下方的AlGaN 勢壘層采用過刻蝕的方法,總刻蝕深度約為94 nm,凹槽底部GaN 溝道表面出現顆粒狀形貌,表面粗糙度約為0.57 nm,另外,由于干法刻蝕過程中腔體內的等離子體分布不均勻,導致凹槽底部與側壁之間存在明顯的刻蝕尖峰,當器件處于反向偏置時,該刻蝕尖峰會導致陽極邊緣電場進一步聚集,從而降低器件的擊穿電壓.
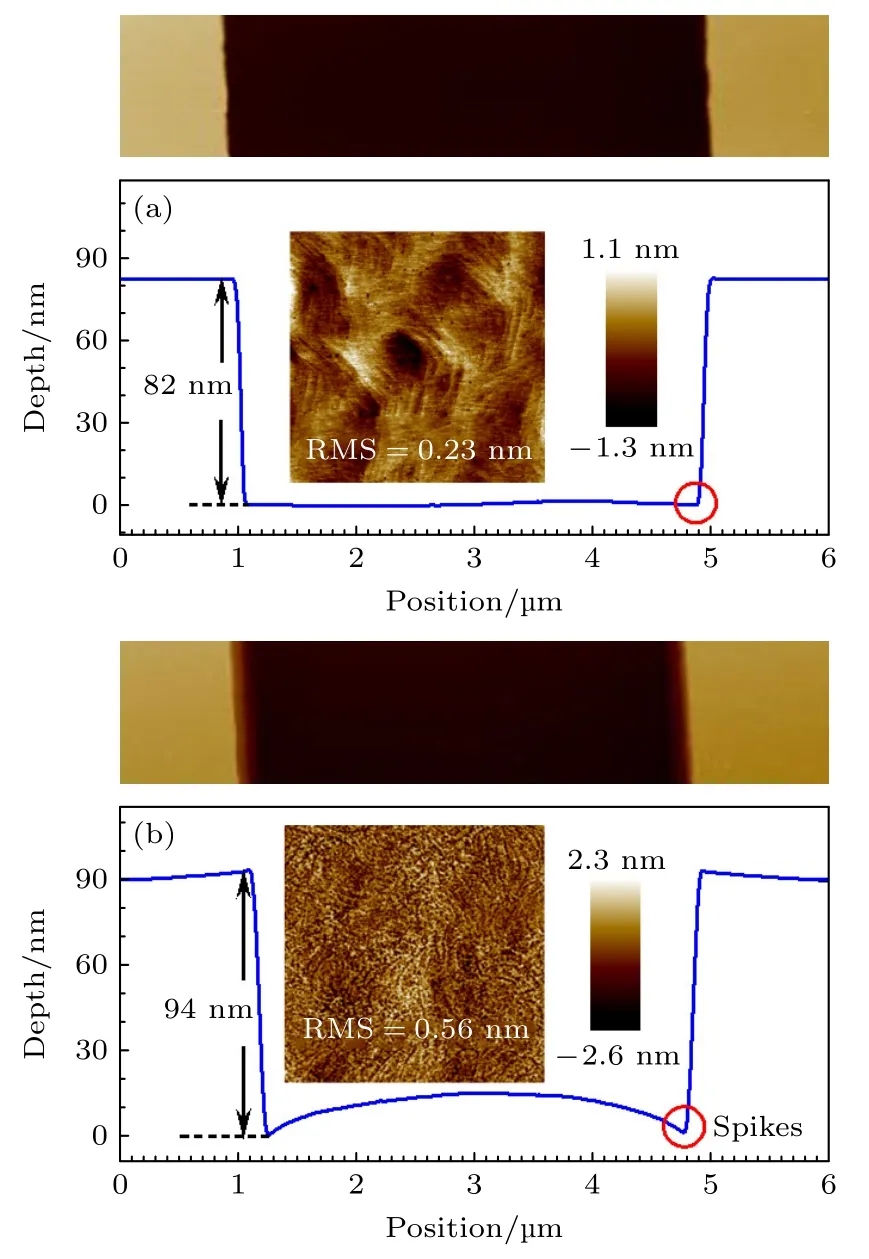
圖2 (a)濕法腐蝕和(b)干法刻蝕陽極凹槽深度及凹槽底部表面形貌Fig.2.Depth of groove anode and roughness of the bottom surface fabricated by (a) wet etching and (b) dry etching.
圖3 為采用濕法腐蝕技術制備的器件陽極凹槽邊緣透射電子顯微鏡的測試結果,從圖3 可知,采用LPCVD 生長的SiN 鈍化層厚度約為56.3 nm,GaN 帽層、AlGaN 勢壘層及AlN 插入層的總厚度約為25.8 nm,且采用該濕法腐蝕技術制備的陽極凹槽結構實現了邊緣陡峭的刻蝕效果,勢壘層與GaN 溝道表面夾角近似為90°,且GaN 溝道表面較為平坦,未出現干法刻蝕過程中由于腔體內等離子體分布不均勻所導致的刻蝕尖峰.
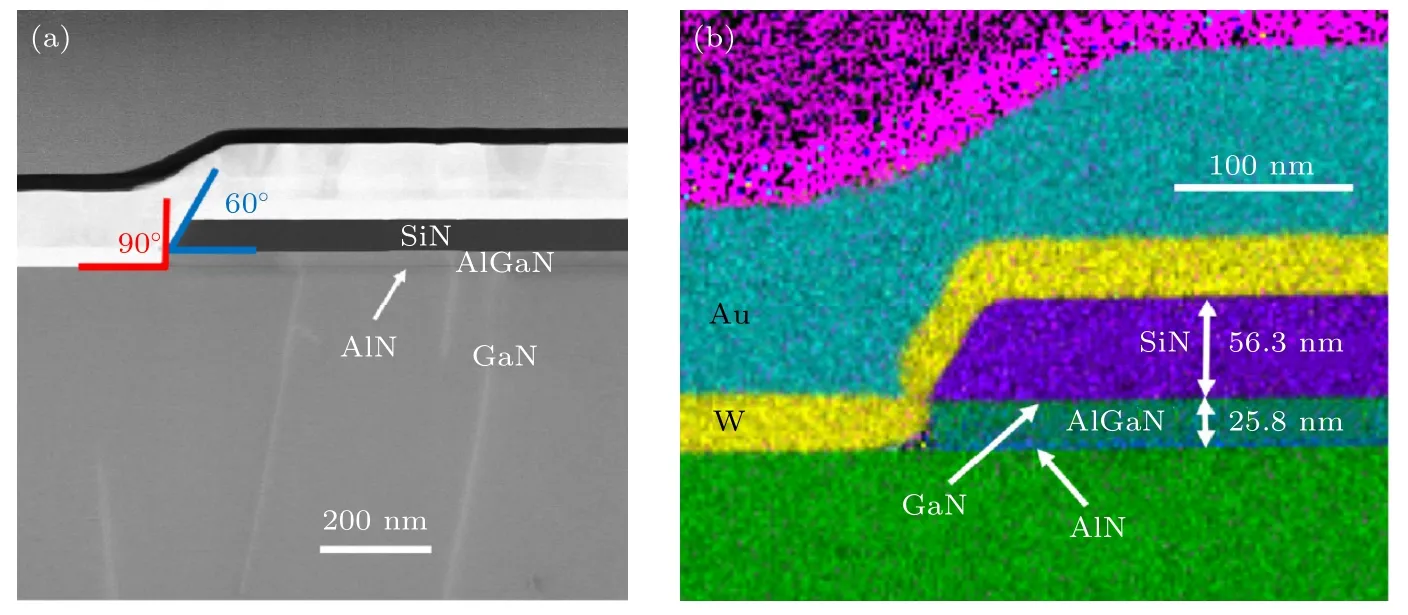
圖3 基于濕法腐蝕凹槽制備技術的AlGaN/GaN SBD 陽極凹槽邊緣的(a)透射電子顯微鏡切面圖和(b)EDS 元素分析Fig.3.(a) Transmission electron microscopy and (b) EDX analysis around the anode edge of the AlGaN/GaN SBD fabricated by wet-etching technique.
由于本文采用先鈍化技術對樣品表面進行保護,因此在器件陽極凹槽制備的過程中需先采用RIE 設備移除表面的SiN 鈍化層,為了避免殘留的SiN 鈍化層影響后續ICP 設備對AlGaN 勢壘層的刻蝕效果,通常SiN 鈍化層的實際刻蝕時間應長于理論所需的刻蝕時間,該過程不可避免地會在樣品表面引入氟離子,導致陽極界面勢壘高度的變化,另外,氟離子在長時間高壓應力偏置作用下會產生移動,引起器件閾值電壓的漂移.圖4(a)和圖4(b)分別為采用X 射線光電子能譜(XPS)設備對濕法腐蝕凹槽表面及干法刻蝕凹槽表面F 1s 核級譜的測試結果,從圖4 可知,采用勢壘層熱氧氧化及濕法腐蝕技術所制備的樣品表面無明顯的F 1s 峰位,而采用常規干法刻蝕所制備的凹槽樣品表面存在較多的氟離子,因此,濕法腐蝕陽極凹槽制備技術可以有效解決SiN 鈍化層刻蝕過程中所引入的氟離子注入問題.

圖4 (a)濕法腐蝕和(b)干法刻蝕陽極凹槽表面F 1s 核級譜Fig.4.F 1s core-level spectra of the bottom surface fabricated by (a) wet etching and (b) dry etching.
圖5 為采用Keithley 4200 半導體參數分析儀對器件的正向測試,器件陽極偏置電壓從0 V 逐漸增至2.5 V,步長為0.01 V.本文定義器件的開啟電壓為陽極正向電流密度達到1 mA/mm 時所對應的陽極偏壓,采用濕法腐蝕及干法刻蝕技術的凹槽陽極結構AlGaN/GaN SBD 器件的開啟電壓分別為0.43 V 和0.44 V,與采用后鈍化工藝的器件相比[12,13],器件開啟電壓均正向增大.由于AlGaN/GaN 異質結界面處的高濃度2DEG 位于GaN 溝道靠近勢壘層一側,距離異質界面約為幾納米寬度,同時,由凹槽側壁表面和次表面原子重構所引入的空間電荷區寬度也在幾納米范圍,導致基于該濕法腐蝕凹槽制備技術的肖特基勢壘寬度寬于基于常規干法刻蝕凹槽制備技術的肖特基勢壘寬度,因此出現基于該濕法腐蝕凹槽陽極GaN SBD 器件的輸出電流相對偏低的情況.圖6 為采用Agilent B1505 高壓半導體分析儀對器件反向擊穿特性的測試結果,由于濕法腐蝕陽極凹槽制備過程中避免了等離子體的刻蝕損傷,因此,當器件的反向偏置電壓為–1 kV 時,反向漏電僅為2.6×10–7A/mm,而采用干法刻蝕陽極凹槽技術的Al-GaN/GaN SBD 器件的反向漏電高達1.5×10–6A/mm,定義器件反向漏電流為10 μA/mm 時所對應的陽極偏置電壓為器件的擊穿電壓,則器件的擊穿電壓分別為–1.73 kV 和–1.28 kV.

圖5 線性坐標下器件正向導通特性Fig.5.Forward I-V characteristics of the fabricated Al-GaN/GaN SBDs in linear-scale.
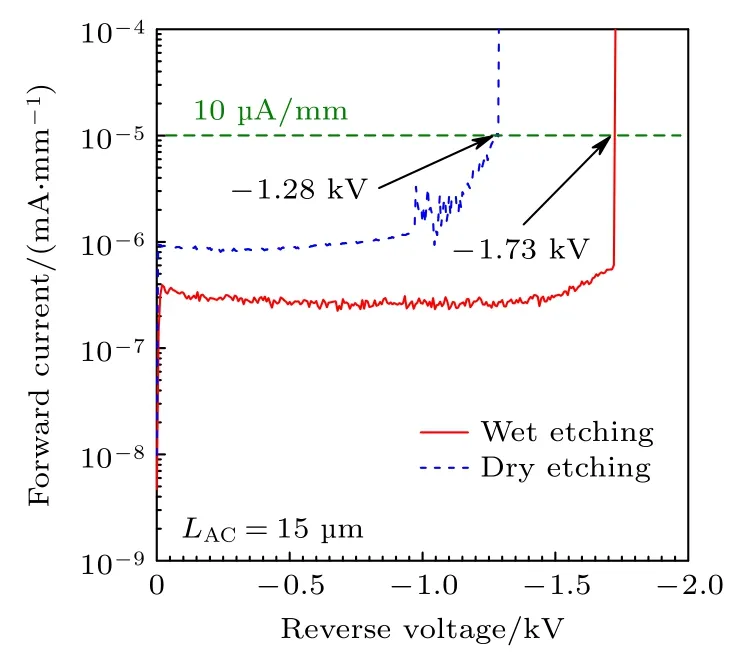
圖6 半對數坐標下器件反向擊穿特性Fig.6.Reverse I-V curves of the fabricated AlGaN/GaN SBDs in semi-log scale.
圖7 為基于濕法腐蝕技術的陽極凹槽表面Ga 3d 核級譜,由于Ga-N 鍵的吉布斯自由能為–157 kJ/mol,Ga—O 鍵的吉布斯自由能為–285 kJ/mol,故GaN 溝道表面處的Ga-N 鍵在高溫熱氧氧化的過程中會與氧氣反應生成Ga—O 鍵[26],導致峰位在測試強度為20.7 eV 附近出現明顯突變,通過對Ga 3d 核級譜分峰擬合可知,Ga—O 鍵與Ga—N鍵的峰值強度比值約為13.8%.界面處高質量GaO 薄膜能夠有效抑制器件反向漏電,進一步提高器件性能[27].
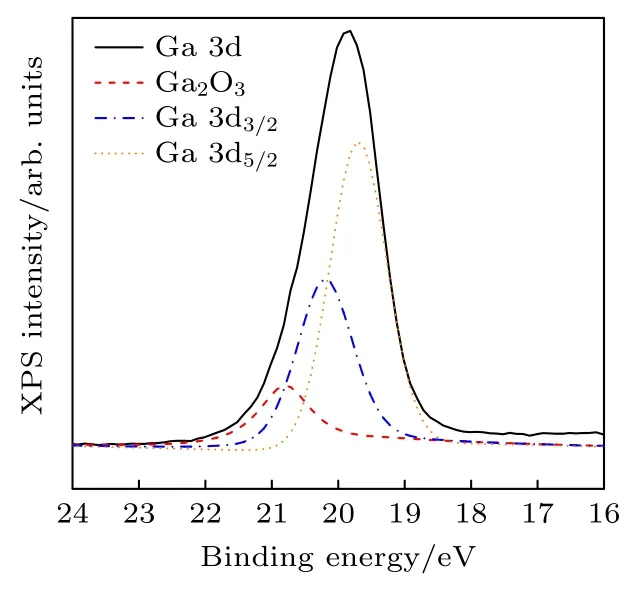
圖7 濕法腐蝕凹槽表面Ga 3d 核級譜Fig.7.Ga 3d core-level spectra of the bottom surface fabricated by wet etching.
4 結論
本文基于凹槽陽極結構AlGaN/GaN SBD 器件,采用濕法腐蝕凹槽陽極制備技術,解決了陽極凹槽等離子體干法刻蝕所引入的刻蝕損傷以及刻蝕腔體內等離子體分布不均勻所導致的刻蝕邊緣與凹槽底部刻蝕尖峰的問題,器件反向擊穿電壓由1.28 kV 提升至1.73 kV,另外,得益于低功函數金屬陽極較低的肖特基勢壘高度,器件正向開啟電壓僅為0.43 V,且陽極反向偏置電壓為1 kV 時,漏電僅為2.6×10–7A/mm.濕法腐蝕陽極凹槽制備技術,在實現低開啟電壓、低反向漏電及高擊穿電壓AlGaN/GaN SBD 器件中展現出了極大的應用潛力,進一步推動了低損耗、大功率AlGaN/GaN SBD 器件的發展.

