數值模擬頂部籽晶溶液生長法制備單晶碳化硅的研究進展
隋占仁,徐凌波,崔 燦,王 蓉,楊德仁,皮孝東,韓學峰
(1.浙江理工大學物理系,浙江省光場調控技術重點實驗室,杭州 310018;2.浙江大學杭州國際科創中心,浙江省寬禁帶半導體重點實驗室,杭州 311200;3.浙江大學材料科學與工程學院,硅材料國家重點實驗室,杭州 310027)
0 引 言
寬禁帶半導體材料碳化硅(silicon carbide, SiC)憑借著其高擊穿場強、高熱導率、高飽和電子遷移率、高化學穩定性、抗輻射等性能,在電力電子器件領域擁有廣闊的發展前景。尤其是在高溫、高頻、高功率等應用場景下有著得天獨厚的優勢[1-3],其優異的性能使得SiC在半導體材料市場上受到廣泛青睞,以SiC為代表的寬禁帶半導體材料對國民經濟和國防軍工的發展具有重要意義,并已獲得國家的高度重視與大力支持[4]。為成功實現SiC在相關領域的大規模應用,制備高質量、大尺寸的SiC單晶襯底是必不可少的。當前主流的SiC單晶制備方法是物理氣相傳輸(physical vapor transport, PVT)法、高溫化學氣相沉積(high temperature chemical vapor deposition, HTCVD)法和頂部籽晶溶液生長(top-seeded solution growth, TSSG)法,其模型如圖1所示。其中PVT法在這幾種方法中占據主導地位[5],雖然目前國內外PVT法制備6英寸(1英寸=2.54 cm)的SiC單晶襯底已經實現了產業化[6],國外直徑8英寸的單晶襯底也正在邁入產業化階段。但是PVT法制備SiC單晶仍然面臨著很多問題,如SiC單晶位錯密度較高(約為102~104cm-2)[7]、擴徑難度大、成品率低,以及高純SiC粉體獲取困難等[8-9]。不同于PVT法,TSSG法是從溶解C的硅熔體中生長SiC單晶的方法。這種方法生長SiC晶體是在接近熱平衡的條件下進行的,其低生長溫度和接近熱力學平衡的條件會使得晶體質量顯著提高[10],適合制備高質量的SiC晶體。不僅如此,TSSG法制備SiC還具有生長過程可調控性強、易擴徑、易實現p型摻雜等優勢。基于TSSG法這些獨特優勢,近年來對該方法的研究日趨增多。

圖1 三種SiC單晶生長技術的模型示意圖[11]Fig.1 Schematic diagram of three methods for SiC single crystal growth[11]
利用計算機對TSSG法進行數值模擬研究是這些研究中非常重要的一環,對內部現象的探究及指導實際生產都有非常重要的意義。本文首先回顧TSSG法生長SiC單晶及相關數值模擬分析的發展歷程,接著簡要介紹TSSG法生長SiC單晶及數值模擬的基本原理。然后根據目前研究進展分別介紹了數值模擬計算分析TSSG法生長SiC單晶模型涉及的主要模塊、影響單晶生長的主要因素(如馬蘭戈尼力、浮力、電磁力等)和TSSG法生長SiC單晶數值模型的優化方法。最后,指出了數值模擬TSSG法生長SiC單晶在未來的研究重點并進行總結。
1 數值模擬分析TSSG法的發展歷程
大多數半導體單晶都可以從熔融狀態或溶液中生長出來,但SiC本身的特性使其難以利用這種方法生長出單晶。計算結果顯示,化學計量比的SiC只有在壓力達到105atm、溫度達到3 200 ℃時才能熔融[12],這樣苛刻的生長條件很難在工業上大規模應用。雖然液相法生長半導體單晶研究歷史悠久(20世紀60年代Halden等[13]就第一次使用液相制備出SiC單晶),但很長一段時間業界一直將PVT法制備SiC晶體視為標準方法,對液相法生長SiC晶體的研究一直較少[14-16]。盡管研究者們在PVT法生長SiC研究方面取得了顯著的進展,但PVT法生長的SiC晶體仍存在大量的缺陷,如微管、位錯和寄生多型體等[17]。時至今日,PVT法生產的SiC晶體位錯仍較多[18],嚴重影響器件性能[19-21]。意識到此問題后,研究者們便逐漸將注意力轉移到液相法上來。與PVT法相比,液相法生長SiC單晶的優點是生長條件接近熱平衡,缺陷在晶體生長過程中橫向傳播,因此可以產生更高質量的晶體[22-23],Murayama等[24]研究表明,相較于PVT法,使用TSSG法可將所有類型缺陷的密度降低兩個數量級。近10年來,TSSG法生長SiC單晶取得了不錯的進展,籽晶尺寸也在不斷擴大,圖2給出了近年來TSSG法獲取的典型大尺寸SiC單晶及其直徑與厚度。
TSSG法生長SiC單晶是在高溫、半封閉的環境下進行的,且內部溶液不透明,導致研究者很難通過原位觀察獲得生長過程中內部高溫溶液、籽晶等重要區域的狀態信息,現有手段也很難在不影響爐內生長的前提下對爐內狀態進行監測。除此之外,只有對大量的實驗數據進行研究整理才能有效地對模型進行優化。但現實中這點是不容易實現的,一方面是由于TSSG法生長SiC單晶是非常緩慢的過程,獲得足夠多的數據需要耗費大量時間。另一方面則是實驗模型的改進成本較高,細微的改動可能需要將整個裝置重新制造和安裝。而且根據研究需要,這種對設備的調整通常是持續多次的,會耗費大量人力、物力和時間成本。另外該過程中還可能由于環境改變等不可控因素對實驗結果產生一些未知影響。這些問題都極大制約了研究者們對TSSG法內部機理的探索,限制了TSSG法生長SiC單晶的發展。隨著計算機技術與模擬計算技術的發展,研究者們發現利用計算機可以模擬出整個實驗過程中爐內的狀態變化,并直觀地將結果展示出來。事實也證明,應用該技術可以大幅降低研究者們探究TSSG法生長機理的難度。
目前數值模擬分析已成為材料科學研究與工程研發的必備工具,對晶體生長模型的優化起到十分重要的作用[30]。數值模擬TSSG法生長SiC單晶的主要工作是利用數值模擬計算程序模擬出TSSG法生長SiC單晶過程中內部模塊產生的變化。首先在計算機上搭建好擬研究的TSSG生長爐模型,并設置好初始條件、邊界條件、控制方程等。然后開始計算,利用計算機求解出相應的控制方程,模擬出單晶生長過程中產生的現象,如熔體的流動、內部熱場分布、濃度分布等。最后對所得結果進行分析并總結規律,利用得到的結論繼續改進實驗模型或指導實際生產,形成正反饋從而促進TSSG法生長SiC單晶的發展。針對TSSG法生長SiC單晶過程的數值模擬工作最早可追溯到2010年,Mercier等[31]對高溫溶液法進行了系統的建模研究,研究內容涵蓋了溫度梯度、坩堝結構、電磁對流、馬蘭戈尼力等不同因素對傳熱和對流的影響。圖3是Mercier團隊使用的數值模型的結構圖,其主要由感應加熱器、基座、絕熱石墨氈和內部石墨坩堝(作為高溫溶液的容器和C源)等部分組成。
2013年,Kusunoki等[27]在爐子內部加入了浸沒導向器(immersion guide, IG),并對改進后的新裝置進行了數值模擬計算研究,圖4展示了加入IG裝置后的生長爐模型與其流場的數值模擬結果,研究證明在爐內加入IG裝置會使得溶液中產生更均勻的流動,更利于SiC單晶的高質量生長。2014年,作者又在此基礎上進行了更深入的研究[32],他們發現通過選擇合適的IG形狀,有利于籽晶下方區域形成更均勻的向上流動,對生長高質量的SiC單晶十分有利。作者還計算了不同IG條件下單晶的生長速率,與實驗吻合較好。最終通過選取最佳形狀的IG裝置對內部溶液進行控制,成功生長出直徑為3英寸、厚度為4 mm的4H-SiC晶錠。
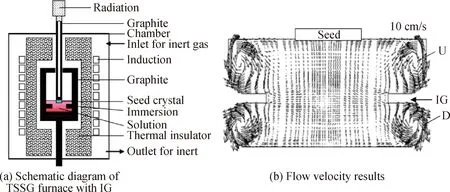
圖4 Kusunoki的改進模型[27]Fig.4 Kusunoki’s improved model[27]
2016年,Umezaki等[33]通過對TSSG法生長SiC單晶進行全局計算流體動力學(computational fluid dynamics, CFD)模擬,發現使用TSSG裝置進行SiC單晶生長期間,隨著籽晶轉速的增加,生長速率顯著提高。同年,韓國Ha等[34]基于有限元分析(finite element analysis, FEA)計算了TSSG法中硅熔體的溫度分布、速度場和C濃度分布,其計算結果表明不同熱場對C濃度分布會造成顯著差異,且晶體附近的小溫度梯度更有利于SiC晶體的穩定生長。還有一些研究主要是針對坩堝的改進,如Mukaiyama等[35]、Choi等[36]與Horiuchi等[37]分別對坩堝的形狀、內表面形貌、尺寸及旋轉速度等方面做出了研究,為TSSG法生長更高質量SiC單晶提供了一些新的優化思路。最近幾年,隨著人工智能(artificial intelligence, AI)技術的發展,將晶體生長與現代人工智能技術相結合的研究也逐漸增多。如Wang等[38]利用強化學習(reinforcement learning, RL)模型,優化TSSG法生長SiC晶體過程中的熔體流動,從而以更高的速率生長更均勻的SiC晶體。2021年Yu等[39]利用機器學習技術,加快了對坩堝模型幾何形狀優化的進程。作者將機器學習技術與遺傳算法結合,在較短的時間內從大量備選的坩堝參數中獲得了最佳參數配置,其使用的TSSG模型和神經網絡示意圖如圖5所示。基于此設計出了最佳生長系統,成功制備了直徑150 mm的SiC單晶。這些針對TSSG系統的創新工作對指導實際晶體生長,獲得質量更高、生長速度更快的SiC單晶有著重要意義。

圖5 Yu的模型示意圖[39]Fig.5 Schematic diagram of Yu’s model[39]
2 數值模擬分析TSSG法的基本原理
TSSG法生長SiC單晶常見的生長爐模型如圖1(c)所示,其主要結構由外部感應加熱線圈、石墨保溫氈、同時當作高溫溶液容器和C源的高純度石墨坩堝、高溫熔體、SiC籽晶和懸桿構成。進行SiC單晶生長時,先用感應線圈加熱坩堝至原料完全熔融。通常將爐內溫度范圍控制在1 700~2 100 ℃,等穩定的溫度場形成后,高溫溶液中C的濃度達到平衡,將帶有籽晶的懸桿從頂部緩緩浸入高溫溶液。生長時,通過控制溫場使高溫溶液在軸向上產生圖6所示的溫度梯度。由于溫度梯度的存在,坩堝頂部和底部的C的溶解度不同:上方靠近籽晶處溫度較低,C溶解度較低;下方溫度較高,C溶解度則較高。底部達到C飽和的熔體流到溫度較低的籽晶附近后,溶液中過飽和的C結合高溫溶液中的Si就可以在籽晶表面上生長出SiC單晶(溶解的C由石墨坩堝源源不斷地供應)。當過飽和部分的C析出后,溶液隨著對流回到坩堝壁處的高溫區域,并再次從石墨坩堝處溶解C,形成飽和溶液。整個過程循環反復進行著SiC單晶的生長[40]。該過程中爐內的溫度梯度是晶體生長的根本驅動力,影響著溶液流向及C的濃度分布。另外,C在純硅中的溶解度很低(在實驗溫度范圍內溶解度通常小于0.1%[41]),提高高溫溶液的C濃度是快速生長SiC單晶所必需的,因此研究者經常在坩堝內添加Cr、Ti、Y等金屬助溶劑以增加C在硅熔體中的溶度[42-43]。
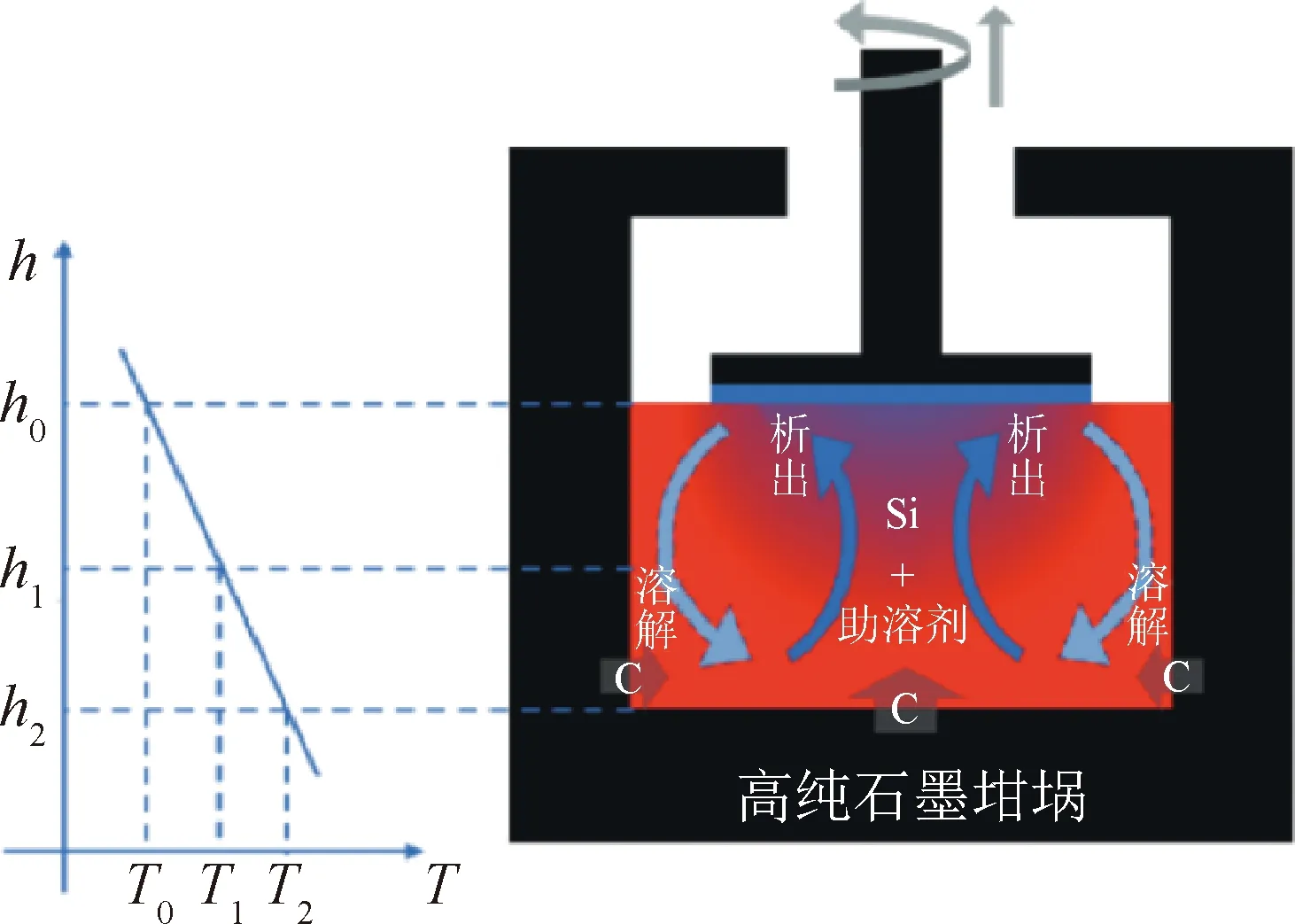
圖6 TSSG法生長SiC單晶示意圖[11]Fig.6 Schematic diagram of growing SiC single crystal by the TSSG method[11]
對TSSG法生長SiC的數值模擬主要方法是利用有限元程序對上述SiC單晶的生長過程進行仿真。其一般步驟是在有限元軟件里搭建好TSSG生長爐的幾何模型,如模型的基本幾何形狀、坩堝形狀和尺寸、籽晶大小等。然后根據研究內容設置模型的初始條件、邊界條件、各種材料的物理屬性及控制方程,再對建好的模型進行網格劃分。計算時有限元軟件會將系統的求解區域根據劃分的網格離散成一個個小單元的分組體系,把一個連續的無窮自由度問題變為離散的有限自由度問題,最后利用計算機求解[37-39,44]。目前很多研究組進行了TSSG法生長SiC晶體的建模仿真工作,并取得了不錯的成果。圖7所展示的是一些研究小組所建立的TSSG法生長SiC的典型數值模型。
圖7(a)是Ujihara等[45-47]建立的一種比較經典的TSSG生長爐模型,該模型被用于探究馬蘭戈尼對流、靜磁場、籽晶旋轉等因素的影響,對后來研究有很高參考價值;圖7(b)是Park等[46]利用數值模擬的方法研究石墨坩堝輻射率對溫度分布的影響時所使用的模型,左半側展示的是該模型的幾何圖形,右半側展示的是網格劃分;圖7(c)展示的是Mercier等[47]的計算模型,其特點是相較于其他模型,內部多了電阻加熱裝置,來獲得適合的溫度梯度。
3 對流與傳熱模塊
TSSG法生長SiC單晶的數值模擬主要分為流動、傳熱和傳質三個模塊,其中對流與傳熱模塊是TSSG法生長SiC單晶模型中最基礎、最重要的模塊,模型內部良好的流場與溫度場是實現TSSG法生長SiC單晶的關鍵[11]。對傳熱與流動進行數值模擬計算研究旨在計算出系統的溫度場和Si熔體的流場分布,加深研究者對熔體內部傳熱傳質現象理解,從而根據計算結果對實驗設計加以改進。如Mercier等[31]證明了馬蘭戈尼力和電磁力對溶液生長過程失穩的重要性;Ujihara等[45]通過數值模擬給出了TSSG法生長SiC單晶過程中各種力對SiC單晶生長影響大小的排序為:表面張力>電磁力>離心力、浮力;Ha等[34]通過數值模擬計算和實驗結合,證明了在晶體和熔體之間的界面附近小溫度梯度的熱區結構會使TSSG法生長的SiC晶體更加穩定。Lefebure等[49]揭示了濃度場和對流模式之間的直接關系,強調了對流在C傳輸中的重要作用。TSSG法生長SiC單晶過程中熔體內傳熱和流動現象由連續性方程、動量守恒和能量守恒方程所控制,它們是進行模擬計算的主要理論依據。方程如下[50]:
連續性方程:
(1)
動量方程:
(2)
能量方程:
(3)
式中:ρ是熔體密度;v是熔體速度;t是時間;p是壓力;μ是熔體動力粘度;βT是熔體熱膨脹系數;T是熔體溫度;T0是熔體中的最低溫度;g是重力加速度;α是熱擴散率。上述方程基于下列幾個假設[34]:
1)生長熔體是一種不可壓縮的牛頓流體。
2)C溶解度低,不考慮溶質對流。
3)熔體內溫差足夠小,可運用Boussinesq近似。
4)動態界面變形(由于熔體中的對流)可忽略不計。
在實際的數值計算中可能會根據實際模型對上述方程進行適當調整,但原理基本類似。表1列出來的是計算時使用的高溫溶液的參數;圖8展示的是TSSG法生長SiC晶體時,坩堝中高溫溶液流場和溫度分布的模擬結果。

表1 TSSG法數值模擬中使用的高溫溶液物理特性Table 1 Physical properties of the solutions used in numerical simulation of the TSSG method

圖8 不同類型坩堝內溶液的溫場與流場分布。(a)不含IG導流器的流速和溫度分布[32];(b)含IG導流器的流速與溫度分布[32];(c)流場模擬結果[45];(d)溫場擬結果[45];(e)相同模型不同隔熱層設計下的流場與溫場分布(左:短隔熱層結構,右:長隔熱層結構)[34]Fig.8 Flow velocity and temperature distribution of melt in different crucibles. (a) Flow velocity and temperature results without IG[32]; (b) flow velocity and temperature results with IG[32]; (c) flow velocity results[45]; (d) temperature results[45]; (e) flow velocity and temperature results of different insulation structure (left: short insulation structure; right: long insulation structure)[34]
從圖8中可以看出,在TSSG生長過程中,使用不同類型的坩堝,內部溶液的流向也不相同。高質量晶體生長的條件包括溶液內部均勻的流動和籽晶下方自下向上的流動。這種流向可將坩堝底部的C濃度高的溶液更快地輸運至籽晶表面,實現SiC單晶在頂部籽晶表面快速析出。迄今為止,針對數值模擬中基礎的流動與傳熱模型的優化主要集中在以下幾個方向:爐內溫度控制、坩堝旋轉及形狀、籽晶旋轉與提拉技術。下面將針對這幾方面的相關研究進行梳理與總結。
3.1 爐內溫度控制
生長爐內部需要保持特定的溫度梯度來保證含C溶液在籽晶表面析出(見圖6),過大或過小的溫度梯度或不合適的溫度場設定都會對SiC單晶生長產生不利影響。如溫度梯度過小會導致浮力對流不夠強,不利于C從坩堝壁附近到籽晶表面的運輸,晶體生長緩慢;梯度過大則會導致單晶生長不穩定、產生不穩定湍流[31,51]。不合理的溫度場還可能會導致SiC晶體的表面粗糙,降低SiC晶體品質等[52]。為了獲得更適宜的溫度分布,研究者們做了很多嘗試。如Lefebure等[53]進行了具有極低溫度梯度的坩堝設計,極低軸向溫度梯度用來提高晶體生長質量,如圖9所示,極低的徑向溫度梯度用來避免浮力對流的任何失穩。研究發現對流在C從溶解區到結晶區的傳輸過程中起主要作用。
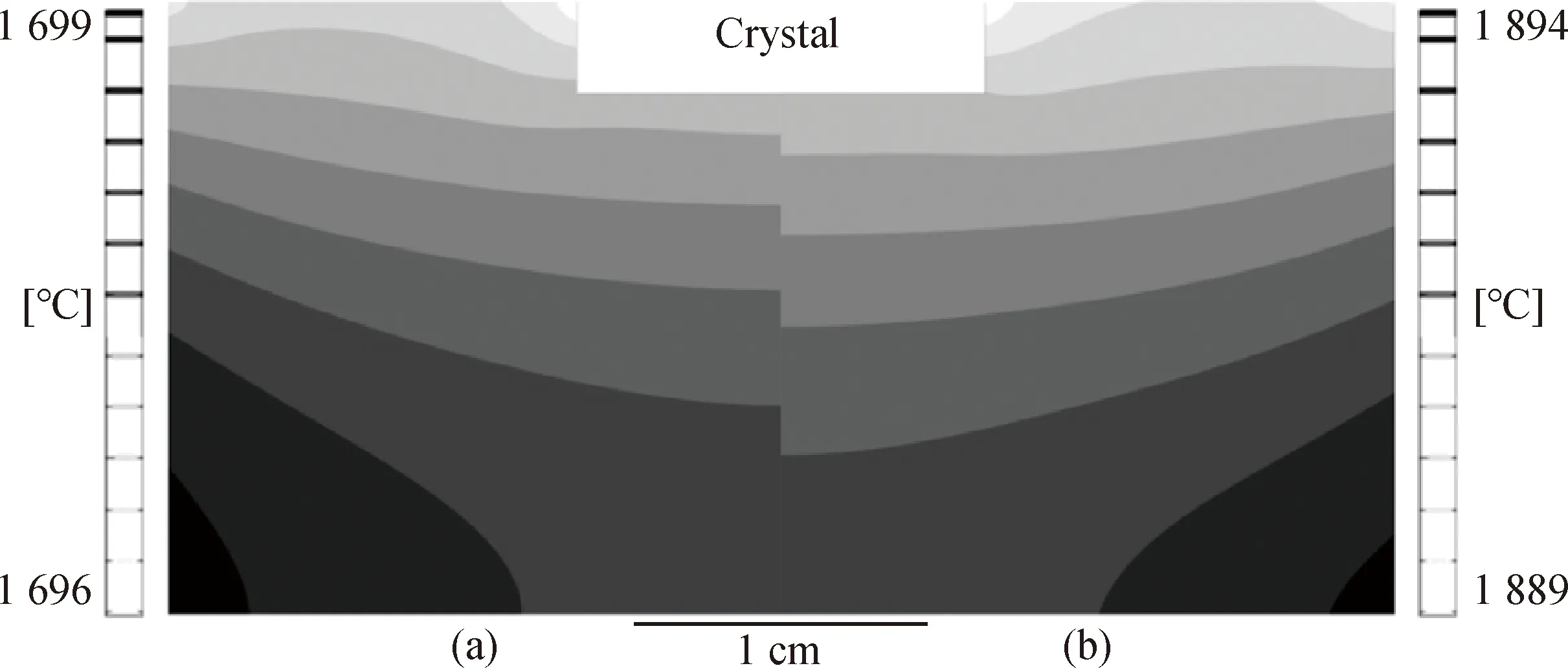
圖9 低溫度梯度模型在溫度為1 700 ℃(a)和1 900 ℃(b)時的溫場[53]Fig.9 Temperature results of low temperature gradient model in 1 700 ℃ (a) and 1 900 ℃ (b)[53]
2018年,Ha等[34]將普通TSSG生長爐的石墨隔熱層增高,顯著改變了生長爐的溫度梯度。由于改進后的結構減少了垂直方向的熱損失,使得坩堝獲得了更小的溫度梯度(不同模型溫度分布如圖10所示,其生長出的單晶對比如圖11所示)[34]。實驗結果表明,具有更小溫度梯度的熱場結構,尤其是在籽晶與高溫溶液交界面附近區域的低溫度梯度,有利于SiC晶體的穩定生長。2019年,該作者的另一研究[54]表明調整溫區的孔徑是精細控制熔體中溫度梯度的有效方法,可獲得更高質量SiC單晶。
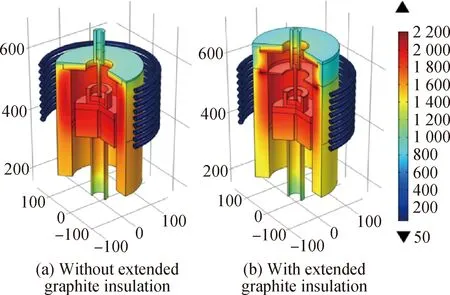
圖10 生長爐的溫度分布(單位:℃)[34]Fig.10 Temperature distribution of furnace (unit: ℃)[34]
Koike等[55]嘗試了與傳統溫度場不同的非軸對稱溫度場,并進行仿真計算,如圖12所示,發現在籽晶下方,溶液對流是非軸對稱并且是單向的,而且籽晶附近的過飽和度溶液流動增大。利用這種非軸對稱溫度分布引起的非軸對稱溶液對流,在TSSG法中獲得了凸形晶體生長界面,該研究為TSSG法生長不同晶面形狀提供了新的思路。

圖12 Koike的非軸對稱溫度場模型[55]。(a)Si溶液模型示意圖;坩堝壁(b)和坩堝底部(c)的非軸對稱熱邊界條件Fig.12 Koike’s non-axisymmetric temperature distribution model[55]. (a) Schematic diagrams of Si solution;non-axisymmetric thermal boundary conditions of the crucible wall (b) and the crucible bottom (c)
3.2 坩堝旋轉技術及形狀調控
迄今為止,在TSSG法生長SiC單晶的研究中,與坩堝相關的優化主要集中在對坩堝形狀、尺寸和結構的調整。坩堝的形狀變化對溫度、感應加熱系統引起的洛倫茲力分布、流場、溶液中的C濃度和SiC的生長速率具有顯著的影響[35],坩堝旋轉則主要導致流場的變化進而影響SiC單晶生長。利用數值模擬計算技術可以更深入探索坩堝的形狀、結構、旋轉等因素對晶體生長的影響。Mercier等[31]為了避免馬蘭戈尼力產生的流動對晶體生長的不利影響,設計出減少自由表面尺寸的向內傾斜型坩堝模型并進行了仿真,發現傾斜坩堝在晶體生長穩定性、持續時間和液體自由表面的寄生成核等方面都有更好表現。Choi等[36]為了研究坩堝形狀對溫度梯度及C濃度分布的影響,對坩堝形狀進行了改進和模擬分析,經其改進后的坩堝為階梯壁式設計,具有連續的鋸齒形狀,如圖13所示,該設計顯著改變了溫度梯度并提高了溶液中的C濃度,證實了階梯坩堝結構有利于提高SiC晶體的生長速率。Liu等[56]認為影響TSSG法穩定生長大尺寸晶體的原因是隨著坩堝尺寸的增大產生的感應加熱不均勻,從而導致溶液流動不利于晶體生長。作者通過改進坩堝形狀,建立了新的TSSG模型(模型見圖14)并進行數值模擬。模擬結果表明,通過合理調整新坩堝模型的下層半坩堝的高度H1和寬度L1,可以實現大尺寸(4英寸)碳化硅錠的相對穩定生長。Yoon等[57]考慮到溶液中溶解的C由石墨坩堝提供,通過對坩堝表面進行粗糙化,促進了坩堝壁處C的溶解,有效地提高了SiC單晶的生長速率。
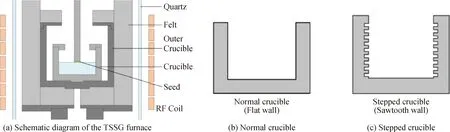
圖13 Choi的生長爐模型示意圖[36]Fig.13 Schematic diagram of Choi’s furnace model[36]
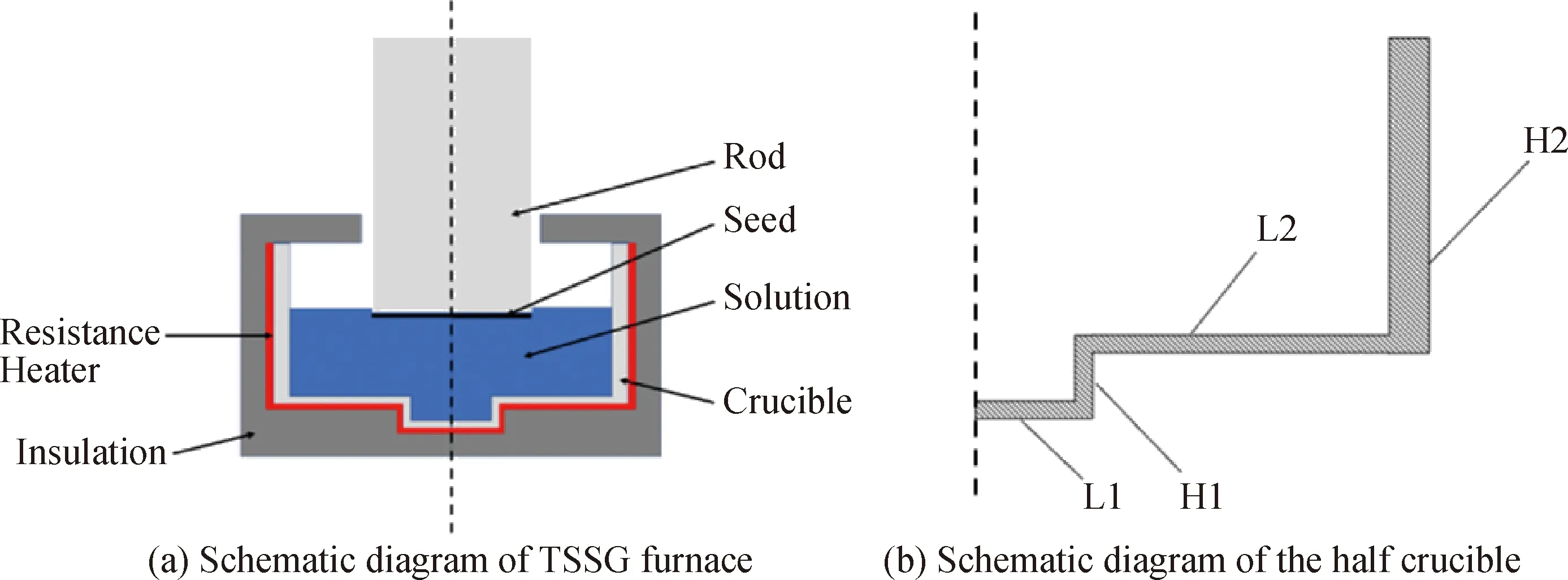
圖14 Liu對坩堝形狀的改進模型[56]Fig.14 Liu’s model of adjusted crucible shape[56]
加速坩堝旋轉技術(accelerated crucible rotation technique, ACRT)是一種在晶體生長過程中按照一定的規律變速旋轉坩堝,從而在液相中引入強制對流的技術,被廣泛利用在晶體生長領域[58-59]。為了提高生長速度,Kusunoki等[60]使用ACRT在Si-Ti-C溶液里生長SiC單晶。作者研究了ACRT強制對流對生長速率的影響并對生長過程中的流體流動進行了數值模擬。結果表明,ACRT技術不僅顯著提高了SiC晶體生長速率,還改善了籽晶表面的均勻性。
3.3 籽晶旋轉與提拉技術
籽晶的旋轉會影響籽晶與液面接觸面附近的溶液流動,進而影響SiC晶體生長。2016年,Umezaki等[33]通過對TSSG法生長SiC單晶模型進行CFD模擬,計算了籽晶在不同旋轉條件下溶液中的動量、熱量和傳質現象。其計算結果表明,籽晶的旋轉會導致生長界面下方的不流動溶液層強制流動而使得該層變薄,導致溶質C的濃度梯度增大,提高了SiC單晶生長速度。同年,Daikoku等[61]開發了一種稱為凹表面溶液生長(solution growth on concave surface, SGCS)法的新技術,通過控制單晶生長過程中籽晶與液面的相對位置,討論了籽晶浸入液面、籽晶面與液面平齊和籽晶在液面上方這三種情況。并對浸入、靜態和拉伸這三種不同條件下的籽晶進行仿真,仿真結果與凹形、凸形籽晶生長的模型如圖15所示。作者通過實驗證明了SGCS生長技術有助于抑制嚴重的臺階聚束現象,大幅減少單晶中的溶劑夾雜物,可獲得高質量的SiC單晶。

圖15 籽晶與液面處于浸入條件(a)、靜態條件(b)和拉伸條件(c)下溶液的溫場和流場分布;籽晶附近溶液向上流動的條件下凹表面一直保持平滑(d),以及凸表面上由于方向相同的臺階流和溶液流引起的臺階聚束現象(e)[61]Fig.15 Temperature and flow velocity results indipping condition (a), static condition (b), pulling condition (c); the concave surface has been maintained smooth (d), convex surface has giant step bunching caused by the same direction for the step flow and solution flow (e) under the condition of upward flow of solution at seed crystal[61]
Yamamoto等[45]也對提拉籽晶對晶體生長的影響進行了數值模擬研究。不過他們側重的是籽晶提拉高度變化所引起的高溫溶液表面形狀變化對SiC單晶生長帶來的影響。該研究通過控制提拉桿改變了液面形貌。數值模擬結果如圖16所示,在0.5 mm和1 mm拉力導致的表面變形情況下,熔體中的溫差略有增加。但相較于其他影響因素如浮力、馬蘭戈尼力、電磁力等,該因素對晶體生長影響效果不明顯。
4 基本模型的改進——加入馬蘭戈尼力、電磁力
很多研究已經證明,對TSSG法生長SiC單晶進行模擬時,熔體流動存在4種主要的對流:浮力對流、強制對流、電磁對流和馬蘭戈尼對流[45,49,61]。液體表面的馬蘭戈尼力與外部加熱線圈所產生的電磁力都是引起坩堝內熔體對流的重要因素。與浮力對流、強制對流相關的溫度、坩堝等設計在前文已作出闡述。本節主要探討馬蘭戈尼力與電磁力對TSSG法生長SiC單晶的影響,以及利用數值模擬方法對這些因素的調控研究。
馬蘭戈尼效應是指在流體自由表面,因為表面張力梯度而造成的傳質現象。表面張力不同的液體在一起會產生表面張力梯度,表面張力大的液體對其周圍表面張力小的液體會產生拉力,液體會從表面張力低處向張力高的方向的流動[62-63]。在TSSG法生長SiC的模型中,馬蘭戈尼效應主要與坩堝內徑向溫度梯度、助溶劑摻雜、流體流場等因素有關。它可能會在熔體內部產生不利于生長的湍流,對單晶生長影響明顯。利用數值模擬的方法對TSSG法生長SiC單晶的馬蘭戈尼效應進行仿真可以很直觀地觀察其產生的影響。Yamamoto等[45]重點對TSSG法中馬蘭戈尼效應進行了研究,使用的完整計算模型如圖7(a)所示。作者在坩堝底部和側壁上使用了無滑移邊界條件,在自由表面使用了馬蘭戈尼對流的邊界條件,在環境溫度2 000~2 200 ℃條件下進行了模擬計算。圖17、圖18分別展示了考慮馬蘭戈尼力與忽略馬蘭戈尼力的流場、溫度場、濃度分布在達到平衡時的計算結果。

圖17 忽略馬蘭戈尼效應時的流速分布(a)、溫度分布(b)、濃度分布(c),以及自由表面附近區域流速分布細節圖(d)[45]Fig.17 Flow velocity (a), temperature (b), concentration (c), and a closed-up view of the flow velocity along the seed and the free surface (d) in the case of flat free surface in the absence of the contribution of Marangoni convection[45]
從圖17(a)可以明顯看出,未考慮馬蘭戈尼效應時,籽晶軸向的熔體流向是向上的,有利于將高濃度的含C溶液輸運到籽晶表面,可促進SiC單晶生長。而引入馬蘭戈尼效應后,自由表面會產生一個朝向籽晶方向的流動,該流動到籽晶附近時會發展為向下的流動(見圖18(d)中A處),不利于C溶液流動到籽晶表面,會抑制C的輸運進而影響SiC單晶生長。圖17(c)和圖18(c)對比可發現,考慮馬蘭戈尼效應后,籽晶下方C濃度明顯降低,這也證明馬蘭戈尼效應對SiC單晶的生長有不利影響。
在TSSG生長SiC過程中,外部線圈會在坩堝內部形成電磁場,熔體會受到洛倫茲力的影響而導致流體運動狀態發生改變。2011年,Mercier等[64]針對外部加熱線圈的位置和頻率對坩堝內高溫溶液的影響進行了建模和數值計算。首先,他們在僅考慮電磁對流的情況下進行了模擬計算,通過只改變線圈的頻率與位置來研究電磁力的影響(模擬結果見圖19)。后續又在考慮浮力對流的因素下進行了仿真。發現高頻率線圈產生的磁場只有在液體的外圍產生較大影響,對液體內部影響幾乎可以忽略不計;低頻率產生的洛倫茲力較小,但分布更均勻,影響范圍也較大。另外,電磁力產生的對流影響相較于浮力對流而言較小,整個流動過程還是由浮力對流主導,但電磁力對籽晶附近的對流影響較大,會使籽晶下方附近流速顯著增加。
為了提高SiC晶體的生長率,Mercier等[65]又針對交變磁場對高溫溶液中C的輸運展開了研究,使用的模型及模擬結果如圖20所示。研究通過改變線圈的位置與頻率來控制溶液內洛倫茲力的分布和大小,發現C通量會受到線圈的位置與頻率的顯著影響,但對溫度場的影響幾乎可以忽略不計。通過數值計算發現將線圈置于溶液上方并且使用低頻率線圈可能是最有利于SiC單晶生長的情況。

圖20 Mercier生長爐模型示意圖與仿真結果[65]。(a)初始條件與幾何模型;(b)只考慮浮力和馬蘭戈尼對流情況下硅熔體中的對流與溫度分布Fig.20 Schematic diagram and simulation of the Mercier growth furnace model[65].(a) Initial conditions and geometric models;(b) temperature and flow velocity results in the silicon melt for pure thermal case (buoyancy and Marangoni convection)
Ariyawong等[66]通過對TSSG法生長SiC單晶的模擬計算研究發現,在使用單個線圈進行感應加熱時,當線圈頻率低于某一臨界值時,線圈產生的電磁對流可以控制熔體中C的運輸,從而使SiC單晶生長速度顯著提高。高溫溶液中過弱或過強的對流均不利于快速生長高質量SiC單晶,對流太弱阻礙C運輸,生長緩慢;對流太強導致SiC單晶不均勻、缺陷多、質量差。為了在這兩者之間找到更適合生長的環境,Wang等[67]在考慮了籽晶旋轉的情況下對垂直磁場(vertical magnetic field, VMF)和勾形磁場(cusp magnetic field, CMF)產生的影響進行了數值模擬仿真研究,希望通過調控磁場增強TSSG生長過程中的C輸運,模擬發現弱的CMF可用于控制電磁對流,抑制馬蘭戈尼對流;將籽晶旋轉與溶液內垂直磁場進行結合可以有效提高單晶生長速度和均勻性,提高晶體質量。Wang等[68]又針對線圈頻率與峰值電流對熔體的影響進行了模擬計算,證明了TSSG生長SiC單晶過程中溶液流動主要是洛倫茲力導致的電磁對流與表面張力梯度導致的馬蘭戈尼對流的融合,而籽晶附近電磁對流可以抑制馬蘭戈尼對流影響。
5 對C的溶解與輸運研究——傳質模塊
對高溫溶液內C輸運的研究一直是TSSG生長SiC單晶中的研究重點,TSSG法能否生長出高質量SiC單晶很大程度上取決于C是否能從坩堝壁等高C濃度處持續均勻地傳遞到籽晶附近。對C在溶液中的傳質現象進行數值模擬可以準確獲得C在坩堝內部的濃度分布、過飽和度等信息,是優化TSSG模型傳質模塊的有效途徑。在TSSG生長SiC單晶的數值模型中,C的輸運相關控制方程如式(4)所示[33]:
傳質方程:
(4)
式中:C是碳的摩爾濃度;D是溶質擴散系數(D=1.7×10-8m2/s)。在模擬計算中,通常把C平衡濃度Ceq設置為坩堝-高溫溶液、SiC單晶-高溫溶液交界面的邊界條件。Ceq的值由式(5)給出:
(5)
式中:ρSi是液態硅溶液的密度;MSi是硅的摩爾質量;xCeq是C平衡時的摩爾分數,其值隨溫度變化的關系式[69]如下:
(6)
有些模型為了描述坩堝內C溶解或析出的趨勢,定義了一個過飽和度S:S>0時,C將會析出;S<0時,C會繼續溶解。
S=C-Ceq
(7)
數值模擬模型中SiC單晶的生長速率Vg是根據籽晶表面處的C通量計算出來的,其表達式如式(8)所示。其中MSiC是碳化硅的摩爾質量,ρSiC是碳化硅密度,n為垂直于籽晶面的單位向量。
(8)
有了以上幾個方程便可以利用數值模擬TSSG生長SiC單晶中溶質C的行為。圖21是Lefebure等[49]使用的計算模型,以及將C平衡濃度Ceq設置為坩堝-溶液、SiC籽晶-溶液界面的邊界條件時計算出的溶質C的濃度分布圖。

圖21 Lefebure的計算模型與仿真結果[49]。(a)TSSG坩堝的示意圖;(b)C濃度的分布(箭頭表示歸一化C通量);(c)C過度飽和度分布(S的計算表達式見式(7))Fig.21 Lefebure’s model and simulation results[49].(a) Schematic diagram of TSSG furnace; (b) carbon concentration (arrows indicate the normalized carbon flux); (c) the distribution of supersaturation in the liquid (S is calculated from Eq.(7))
在實驗中作者發現對流在C從溶解區到結晶區的輸運中起到了重要作用。指出了SiC晶體生長的限制參數是C的溶解度而不是C的輸運,指出了提高增長率需要使用助溶劑增加C的溶解性的觀點,如使用Ti-Si 或Cr-Si溶液體系。除此之外,Yoon等[57]針對C從石墨坩堝的溶解進行了研究。作者認為形成于Si溶液與石墨坩堝的接觸面的SiC層也可當作C源。并用實驗指出了含有SiC涂層的石墨坩堝可以有效提高溶液中C濃度,提高TSSG法制備 SiC單晶的增長率,尤其是在晶體生長初期和低溫條件下效果更佳。該結論不同于大多數假定C直接來源于石墨坩堝的研究,為優化坩堝內C濃度提供了新思路。
如上所述,將C盡可能多地溶解到高溫溶液中是TSSG法生長SiC單晶的重點。但C在純硅溶液中的溶解度很低(1 700 ℃硅溶液中C溶解度僅有0.06%)[71],雖然溫度的升高會一定程度上提高溶解度,但C的溶解度依然是制約SiC單晶生長的重要因素。在溶液中加入助溶劑元素是增加高溫溶液對 C 的溶解度的有效途徑。如向高溫溶液中摻雜Ti或Cr可以有效提高C的溶解度[70,72-73]。但在增加溶解度的同時,助溶劑元素也會改變高溫溶液的密度、黏度、表面張力、凝固點等與晶體生長密切相關的物理參數,從而直接影響晶體生長的熱力學和動力學過程[11]。在數值模擬領域,選用不同的助溶劑體現在數值模擬過程中的操作主要是通過改變模型中高溫溶液熱力學與流體力學參數,如密度、黏度、表面張力和C在溶液中的擴散系數等。不同助溶劑對應不同參數會得到不同計算結果,一般而言模擬軟件很少提供這些混合材料的數據,這些參數具體值還需要通過實驗或其他計算獲取。
6 新的進展——與人工智能技術的結合
研究者們在傳統數值模擬基礎上進行了很多新的嘗試。例如將數值計算模擬與當前迅猛發展的機器學習(machine learning, ML)、人工神經網絡(artificial neural network, ANN)等現代人工智能技術相結合,優化TSSG法生長SiC單晶的計算模型和預測模擬結果。機器學習是人工智能科學的分支,是一種通過數據或以往的經驗來自動改進計算機算法的研究[74],它可以讓計算機更有效地處理數據。研究者們利用機器學習,通過大量的數據對所用模型進行訓練,分析出數據中隱藏的結構或規律,可對事件的發生進行判斷或預測[75]。機器學習主要分為三類,有監督學習、無監督學習和強化學習,圖22給出了它們的主要工作流程[76-77]。

圖22 機器學習的工作流程圖。(a)有監督學習[76];(b)無監督學習[76];(c)強化學習[77]Fig.22 Working flow chart.(a) Supervised learning[76]; (b) unsupervised learning[76]; (c) reinforcement learning[77]
在晶體生長的數值模擬領域,機器學習技術主要運用在預測晶體生長模型的仿真結果及模型參數優化上[78]。2018年,Tsunooka等[79]運用了上述有監督機器學習模型,如圖22(a)所示,對TSSG法生長SiC單晶的CFD模擬進行了預測。他們建立了TSSG生長SiC單晶的計算模型并定義了其主要參數如溫度分布、籽晶尺寸、籽晶和坩堝的旋轉速率等,模型與參數取值區間如圖23(a)~(c)所示。通過使用不同的可變參數值對模型進行800次CFD模擬,以計算不同溫度和晶種旋轉配置下的過飽和度分布和流速。然后使用這些結果數據來訓練預測模型,再用訓練好的模型反過來對模型進行CFD預測。結果此模型進行預測所花費的時間要遠小于傳統數值模擬計算需要的時間(比傳統CFD模擬快約107倍),而且其預測結果與實際計算仿真所得結果高度吻合,如圖23(d)、(e)所示。這種方法所帶來的巨大時間優勢有望顯著加快研究者對晶體生長模型的開發。

圖23 Tsunooka的機器學習預測實驗[79]。(a)TSSG法生長SiC單晶模型示意圖;(b)CFD的計算域;(c)參數區間;(d)機器學習模型預測的結果;(e)CFD仿真結果Fig.23 Tsunooka’s prediction experiment by ML[79]. (a) Configuration of the TSSG process; (b) computational domains for CFD simulations; (c) ranges of variable parameters;(d) results of ML model prediction; (e) CFD simulation results
2020年,Sekimoto等[38]利用強化學習與數值模擬相結合來探索SiC單晶生長的最優控制方案。在研究中,他們利用RL模型控制電磁場,削弱馬蘭戈尼對流的影響;采用TSSG法生長的二維數值模擬結果對RL模型進行訓練,發現在RL模型控制下,晶體生長速率可以得到顯著提升;將RL優化過的感應線圈參數用于三維數值模擬,結果也表現出了更高更均勻的生長速率。晶體生長是一個動態的過程,在此過程中施加動態的調控來保證生長界面所處的狀態持續穩定對于晶體質量有重要的意義,尤其是長時間晶體生長的情況[11]。2021年,Dang等[80]通過訓練機器學習模型,即時預測生長爐內非穩態變化,如坩堝損耗等情況,并進行及時調整。設計出能夠保證生長條件始終如一的自適應控制模型,可保持高速、均勻、長時間的生長速率。Takehara等[81]也對機器學習預測TSSG生長SiC單晶方面進行了研究。他們發現靜磁場和籽晶旋轉速率對晶體生長和溶液流動的影響較大,利用貝葉斯算法對靜磁場和籽晶旋轉速率等相關控制參數進行了有效優化,并對貝葉斯優化確定的最優配置進行了詳細的分析等。這些研究無疑證實了傳統數值計算與新興人工智能技術相結合的潛力與獨特優勢,相關研究將會有力地推動數值模擬晶體生長領域的發展。
7 結語與展望
TSSG法生長SiC單晶具有生長溫度低、易擴徑等多種優勢,近20年來獲得了很多研究者的關注。但TSSG法生長機理復雜,影響因素較多,在實際生長過程中難以對生長條件進一步改進與優化,而利用數值計算方法來模擬晶體生長過程可有效解決這一問題。本文首先介紹了數值模擬TSSG法生長SiC單晶研究的發展歷程和原理,然后系統地描述了數值模擬模型使用的傳熱、流動和傳質模塊,以及生長過程中起主要作用的幾種影響因素,如馬蘭戈尼力、電磁力、旋轉帶來的剪切應力等,梳理了迄今為止人們對生長模型的一些改進和新方法(如CFD與機器學習的結合等)。基于以上發展歷程,本文認為未來對數值模擬TSSG法生長SiC單晶的研究需要重點關注以下幾個方面:
1)提高C在高溫溶液中的溶解度,設計高C溶解度的TSSG生長單晶碳化硅模型。制約TSSG法生長SiC單晶速度的重要因素之一是C在高溫溶液里溶解度過低,無法保證溶液中有充足的C元素在籽晶處析出。未來可重點關注于提高C在高溫溶液中溶解度的相關數值模擬研究,可通過研究生長過程中C的溶解行為,設計不同熱場、流場、坩堝結構等,獲得更高C溶解度的TSSG生長模型。
2)利用數值模擬手段進一步探究C在高溫溶液中輸運行為。目前進行的數值模擬工作通常簡單地將石墨坩堝壁作為C源、溶液中C的平衡濃度作為邊界條件來計算C的濃度分布。對C在溶液中具體運動、C源的變化(如生長中產生的SiC沉淀也可作為C源)、生長中坩堝損耗等影響C輸運行為的因素研究還不夠深入。對C在高溫溶液中輸運行為進行深入研究對提高單晶生長的速度和質量是十分重要的。
3)利用機器學習加速數值模擬的計算速度,設計更準確、高效、適用于優化SiC單晶生長的機器學習模型也是未來研究工作的重點之一。加強晶體生長的數值模擬計算與機器學習的融合,如構建更精確的訓練模型,考慮更多優化參數,選擇更適宜的參數范圍等。充分利用機器學習的快速計算與預測能力來降低數值模擬計算時間和計算成本,從而促進對TSSG法生長SiC單晶模型的設計與實驗工藝的優化。
最后,雖然TSSG法的數值模擬工作距離完美還原實際生長過程中爐內的各種現象還存在一定的差距,但對晶體生長過程中主要因素及影響的定性或定量的分析都已得出了很多有價值的結論,指導優化了TSSG法生長SiC單晶的實驗。相信通過研究者們對數值模擬、機器學習、TSSG法單晶生長等進一步探索,TSSG法制備SiC單晶一定會在未來充分發揮其優勢,實現產業化,進而推動整個SiC產業的發展。

