內嵌橫向PNP 晶體管的新型靜電放電雙向防護器件*
劉靜 黨躍棟 劉慧婷 趙巖
(西安理工大學電子工程系,西安 710048)
提出一種內嵌橫向PNP 晶體管的靜電放電(ESD)雙向防護器件(PNP_DDSCR).對新結構器件在不同ESD 應力模式下的響應過程以及電流輸運機制進行研究,內嵌橫向PNP 晶體管的引入,提高了DDSCR 系統內部寄生晶體管的注入效率,促進正反饋系統建立,同時引入兩條新的電流泄放通路,抑制電導調制效應,提高了電流泄放能力.結果表明,與傳統的DDSCR 器件相比,PNP_DDSCR 器件在傳輸線脈沖(TLP)測試仿真中觸發電壓下降了31%,維持電壓提高了16.8%,ESD 設計窗口優化44.5%,具有更低的導通電阻.快速傳輸線脈沖(VF-TLP)測試仿真結果表明,新結構器件對瞬態過沖電壓有更好的鉗位能力,同時保持了較大的開啟速度,在VF-TLP 應力0.1 A 時,PNP_DDSCR 器件的過沖電壓僅為DDSCR 器件的37%.
1 引言
隨著集成電路特征尺寸的不斷縮小,靜電放電(electro static discharge,ESD)所引起芯片可靠性問題越來越不可忽視[1?3].雙向可控硅(dual directional silicon controlled rectifier,DDSCR)是一種具有雙向靜電防護能力的半導體器件,它具有單位面積魯棒性強、導通電阻低等優點,在集成電路領域得到廣泛應用[4].然而隨著現代集成電路工藝水平的發展,常規DDSCR 存在以下問題限制其ESD 防護能力進一步提高: 第一,DDSCR 阱區摻雜濃度低(通常為1×1017cm–3左右),導致觸發電壓較高[5?7];第二,傳統DDSCR 在觸發后,寄生的NPN 和PNP 雙極晶體管形成正反饋,加劇了大注入下的電導調制效應,維持電壓較低[8?10];第三,DDSCR 電流泄放路徑較長,導致瞬態過沖電壓較高[11,12].
業界普遍采用增加額外高摻雜層或者寄生MOS結構降低觸發電壓[13,14],但會帶來魯棒性降低以及泄漏電流增大的問題,影響器件的可靠性[15].對于提高維持電壓,一般采用寄生結構增加電流泄放通路的方法,但會增加版圖面積且無法解決觸發電壓較大的問題[16].上述技術手段在一定程度上提高了DDSCR 器件的ESD 防護水平,但不能從根本上解決各項性能指標之間的矛盾[17,18].因此,為了滿足現代集成電路對于ESD 防護器件的高要求,提出一種綜合性能更優的新型ESD 防護器件是一個亟待解決的問題[19].
本文基于0.18 μm CMOS 工藝對傳統DDSCR器件在不同ESD 應力模式下的響應過程以及電流輸運機制進行研究,提出內嵌橫向PNP 型雙極晶體管的DDSCR 結構(PNP_DDSCR).對新結構器件與傳統DDSCR 器件內部的正反饋建立機制及電導調制效應進行對比分析.PNP_DDSCR 不僅可以提供輔助觸發電流,使得正反饋機制更容易建立,同時引入兩條新的電流泄放通路抽取過剩載流子,抑制電導調制效應.新結構中內嵌晶體管使得電流泄放路徑更短,體電阻更低,電流泄放能力提升的同時對瞬態過沖電壓有更好的鉗位能力.
2 器件結構及電流輸運機制
PNP_DDSCR 器件的剖面結構如圖1(a)所示,對應的等效電路如圖1(b).傳統DDSCR 剖面圖與等效電路圖分別如圖2(a),(b)所示.傳統DDSCR 器件從下到上依次為P 型襯底、N 型埋層,并列排布厚度為1 μm 的N 型阱區和P 型阱區,采用淺溝槽隔離厚度為0.1 μm 的N+區和P+區.傳統DDSCR 器件阱區摻雜濃度低,正反饋的建立依賴于阱區反偏PN 結的雪崩效應,觸發電壓較高.器件導通后,雪崩效應增大了電導調制效應,器件內部僅存在一條電流泄放通路抽取過剩載流子,導致維持電壓較低,電流泄放能力弱.與傳統結構不同的是,PNP_DDSCR 器件在中間N 阱中嵌入兩個P+區,與N 阱區構成內嵌橫向PNP 型雙極晶體管,其中兩個P+區分別與T1 端子和T2 端子相連.內嵌PNP 結構在器件觸發時提供輔助觸發電流,促進正反饋建立,降低觸發電壓,器件導通后引入新的電流泄放通路抽取過剩載流子,提高器件的電流泄放能力,提高維持電壓.
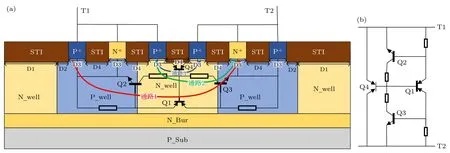
圖1 PNP_DDSCR 器件結構剖面圖與等效電路圖Fig.1.Structural cross-section and equivalent circuit diagram of PNP_DDSCR device.
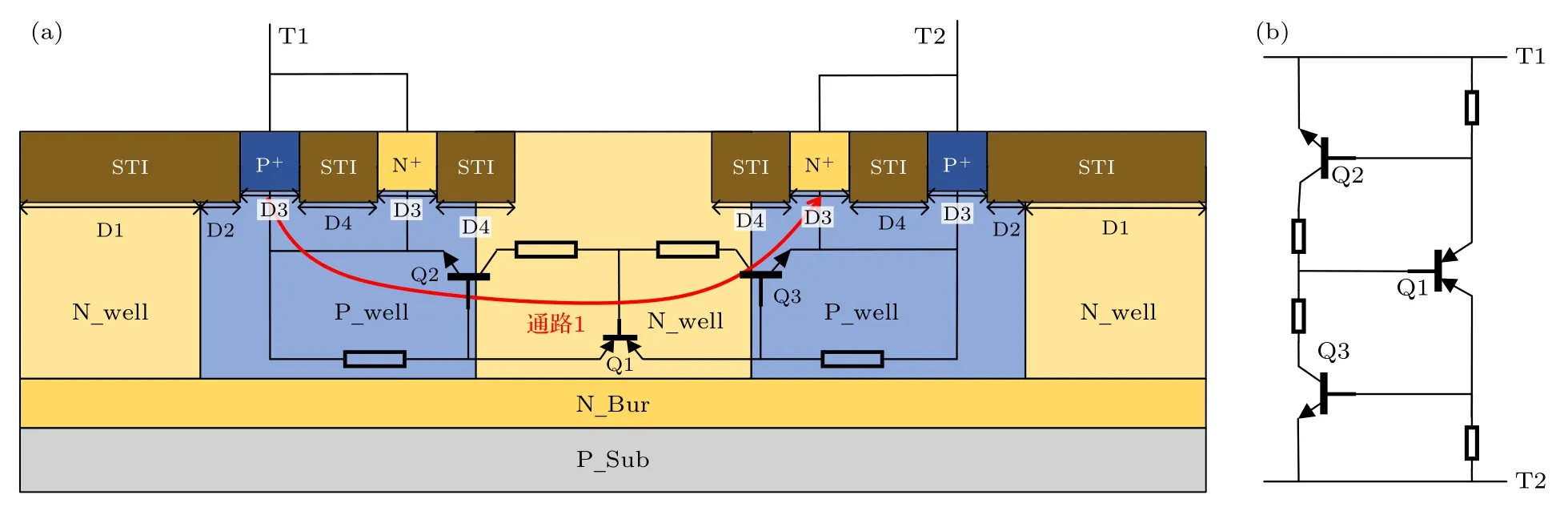
圖2 DDSCR 器件結構剖面圖與等效電路圖Fig.2.Structural cross-section and equivalent circuit diagram of DDSCR device.
PNP_DDSCR 新結構器件中,當ESD 應力作用于T1 端子時,內嵌PNP 晶體管率先導通,與T1 端子相連的P+區充當發射區,向PNP_DDSCR 的中間N 阱注入載流子,此時該結構中存在N_Well/P+與N_Well/P_Well 兩個反偏PN 結.隨著T1 端子的ESD 應力進一步增大,反偏PN結發生雪崩擊穿后,形成圖1(a)中的3 條電流泄放路徑(通路1、通路2、通路3).通路1 為T1 端P+區和P 阱、N 阱、T2 端P 阱、T2 端N+區構成的主SCR 通路;通路2 為T1 端內嵌P+區、N 阱、T2 端P 阱、T2 端N+區構成的寄生SCR 通路;通路3 為內嵌PNP 晶體管通路.由于PNP_DDSCR中內嵌PNP 晶體管直接連通T1 端子和T2 端子,在器件工作時提供觸發電流,輔助SCR 結構觸發,降低觸發電壓.在整個系統導通以后,存在3 條電流泄放路徑抽取過剩載流子,削弱電導調制效應,提高電流泄放效率,器件保持良好的電壓鉗位能力.PNP_DDSCR 器件的結構和電學特性具有高度對稱性,當ESD 應力作用于T2 端子時,器件的電流輸運機制與上述分析一致.
3 ESD 特性分析
PNP_DDSCR 具有觸發電壓低,維持電壓高,瞬態過沖電壓低等特點,為進一步評估PNP_DDSCR器件的ESD 防護能力,本文對PNP_DDSCR 器件與傳統DDSCR 器件進行了傳輸線(transmission line pulse,TLP)仿真測試、快速傳輸線脈沖(very fast TLP,VF-TLP)仿真測試的對比分析.仿真測試中,選用的仿真模型主要包括費米模型、禁帶變窄模型、遷移率退化模型、雪崩模型、SRH(Shockley-Read-Hall)復合模型、俄歇復合模型、熱力學模型、analytic TEP 模型等,數值計算采用Newton,Bank-Rose,ParDiSo,NaturalBoxMethode等方法.器件的關鍵尺寸如表1 所示,兩種器件的各區域摻雜濃度完全一致,具體參數如表2 所示.
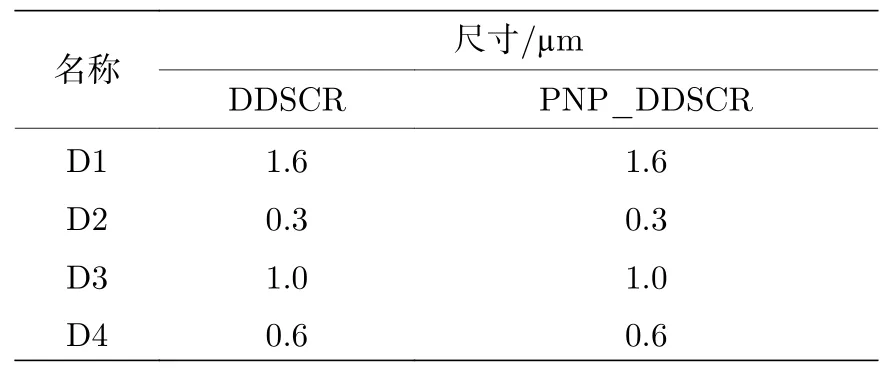
表1 PNP_DDSCR 的關鍵尺寸表Table 1.Critical dimensions of PNP_DDSCR.

表2 摻雜濃度參數表Table 2.Doping profile.
3.1 準靜態電學特性分析
人體放電模型(human body model,HBM)防護能力是ESD 防護設計中需要滿足的基礎指標,TLP 脈沖仿真測試能夠有效衡量器件的HBM 防護能力[20].如圖3 所示為PNP_DDSCR 器件和傳統DDSCR 的TLP 脈沖仿真測試結果,其中第一象限為ESD 應力作用于T1 端子(正向)的情況,第三象限為ESD 應力作用于T2 端子(負向)的情況.由圖3 可以看出,PNP_DDSCR 的觸發電壓為11.6 V,相比DDSCR 的16.8 V 降低約31%,PNP_DDSCR 的維持電壓相比傳統DDSCR 由3.71 V 提升至4.33 V,提升約16.8%,ESD 設計窗口優化44.5%.上述結果表明,新結構器件可以同時降低觸發電壓,提升維持電壓,具有更好的HBM防護性能.
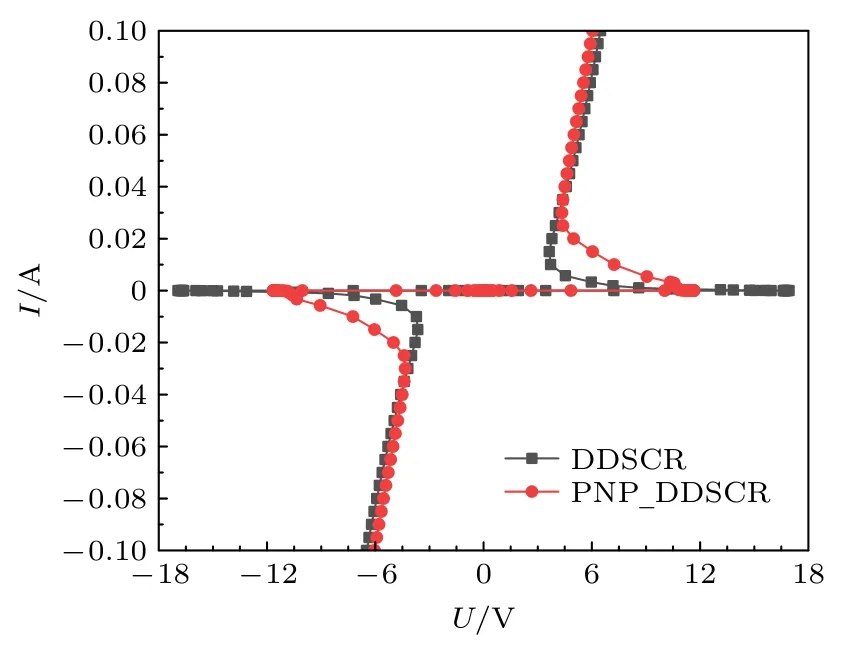
圖3 DDSCR 與PNP_DDSCR 的TLP 仿真測試I-V 曲線對比Fig.3.Comparison of TLP simulation test I-V curves between DDSCR and PNP_DDSCR.
內嵌PNP 晶體管在PNP_DDSCR 器件ESD防護中發揮關鍵作用.圖4 給出了內嵌PNP 晶體管工作時的電流傳輸示意圖.
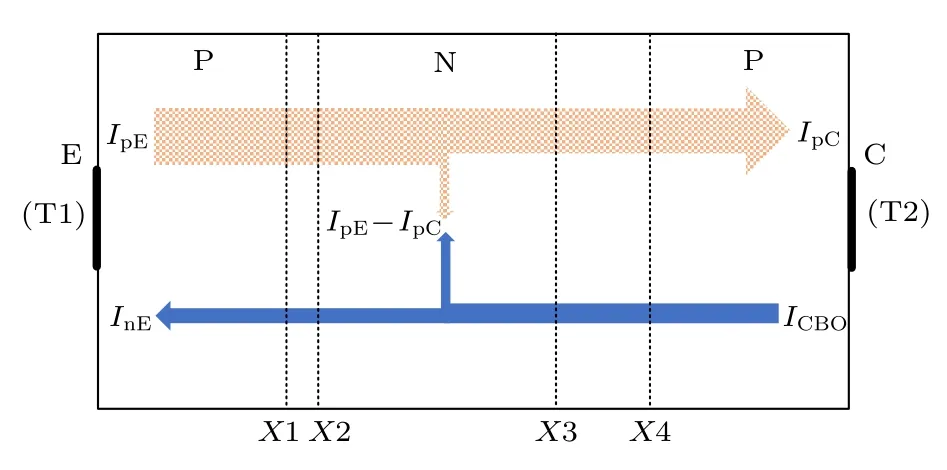
圖4 內嵌PNP 晶體管電流傳輸示意圖Fig.4.Schematic diagram of embedded PNP transistor current transmission.
PNP_DDSCR 器件正向工作時,內嵌PNP晶體管發射結正偏,空穴注入基區,在基區邊擴散邊復合,到達集電結邊界后,被集電結電場掃入集電區,形成集電極電流.同時,基區多子電子以及被集電結電場從集電區抽取到基區的電子,一部分與基區積累的空穴復合,另一部分注入到發射區被T1 端子收集,基極開路時這些電子流流動形成的ICBO相當于IB,根據雙極晶體管電流公式[21]:

其中β0是晶體管的共射極直流電流放大系數.PNP_DDSCR 器件正向開啟時,內嵌PNP 晶體管的發射區注入N 阱區的載流子受到電場力的作用,一部分流向內嵌PNP 晶體管的集電區被T2 端子收集,另一部分到達N 阱/P 阱反偏結的邊緣被電場掃進P 阱,電流流過產生壓降,促進正反饋通路建立.而SCR 的開啟(觸發)電壓VBF為[21]

其中n為常數,VB是阱區反偏結的擊穿電壓,α1和α2分別為SCR 正反饋系統中兩個晶體管的共基極直流電流放大系數.由(3)式可得,SCR 的開啟電壓要低于內部PN 結的雪崩擊穿電壓.傳統DDSCR 器件的α1+α2很小,導致觸發電壓較高,本文提出的PNP_DDSCR 器件中內嵌P+區和P 阱區共同向N 阱區注入載流子,增大了晶體管的注入效率,即α1+α2增大,因此PNP_DDSCR具有較低的觸發電壓.
抑制電導調制效應是SCR 提高維持電壓的關鍵.DDSCR 開啟后,為了保持SCR 路徑導通,環路增益應滿足[22]

為了削弱電導調制效應,PNP_DDSCR 器件引入兩條新的電流泄放路徑,大量載流子被分離在主體SCR 通路外,使該路徑上的寄生三極管的增益大大降低.為了保持SCR 通路的正常導通,該路徑上載流子濃度應趨于保持穩定,滿足環路增益的條件,在阱區反偏PN 結處將有更高的電場激發更多的雪崩載流子,需要更高的外偏壓.這是PNP_DDSCR 維持電壓提升的原因.
圖5 是PNP_DDSCR 器件T1 端子分別施加2×10–7A 和3×10–7A 應力TLP 電流時的電壓響應.SCR 主體路徑還沒有開啟,內嵌PNP 通路逐漸導通,器件仍處于高阻值狀態.在該狀態下,隨著脈沖幅值的增加,器件兩端電壓響應逐步增加,器件內部碰撞電離明顯增強,主要集中在寄生PNP 晶體管的集電結與阱區反偏PN 結處,共同產生過剩載流子,如圖6(a),(b)所示.圖7(a),(b)分別為PNP_DDSCR 器件T1 端子分別施加2×10–7A 和3×10–7A 應力TLP 電流時的電流密度分布圖.內嵌PNP 晶體管是主要的電流泄放通路,且電流密度隨著脈沖幅值的增加而增加,這里產生的電流流過N 阱區的電阻產生壓降,作用于主SCR 與寄生SCR 中的PNP 晶體管的發射結,加速PNP 管導通,進一步促進SCR 結構開啟.因此PNP_DDSCR 具有較低的觸發電壓.

圖5 PNP_DDSCR 器件T1 端子施加不同應力TLP 電流時的電壓響應Fig.5.Voltage response of PNP_DDSCR device T1 terminal when TLP current with different stress is applied.
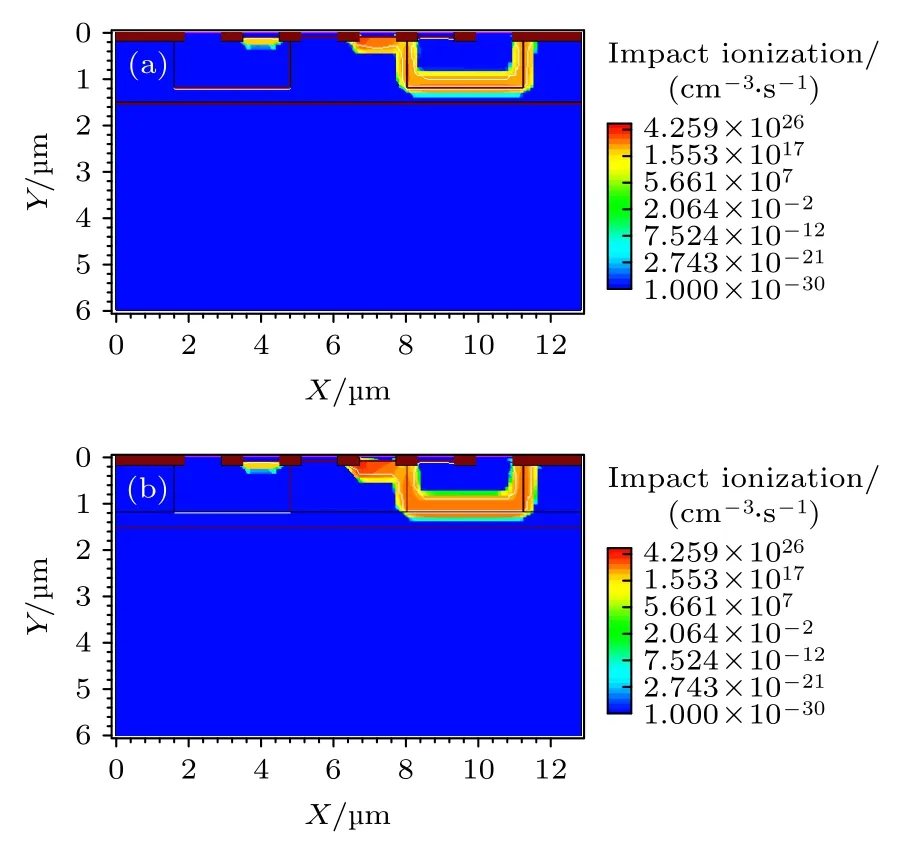
圖6 PNP_DDSCR 器件碰撞電離分布圖 (a) T1 端子應力為2×10–7A TLP 電流;(b) T1 端子應力為3×10–7 A TLP電流Fig.6.Impact ionization distribution diagram of PNP_DDSCR device: (a) T1 terminal stress is 2×10–7 A TLP current;(b) T1 terminal stress is 3×10–7 A TLP current.

圖7 PNP_DDSCR 器件電流密度分布圖 (a) T1 端子應力為2×10–7 A TLP 電流;(b) T1 端子應力為3×10–7 A TLP電流Fig.7.Current density distribution diagram of PNP_DDSCR device: (a) T1 terminal stress is 2×10–7 A TLP current;(b) T1 terminal stress is 3×10–7 A TLP current.
當PNP_DDSCR 器件內部的寄生晶體管都開啟后,隨著內部主SCR 結構與寄生SCR 結構系統中的晶體管逐漸達到飽和狀態,PNP_DDSCR器件兩端電壓降低到最小值,即維持電壓.維持電壓的大小取決于電導調制效應的強弱,器件觸發后,碰撞電離產生大量過剩載流子,傳統DDSCR僅有1 條泄放通路,電流泄放效率低,不利于維持電壓的提升.但PNP_DDSCR 有3 條泄放通路共同抽取過剩載流子,抑制電導調制作用,為了滿足環路增益,需要更高的外偏壓.因此PNP_DDSCR具有高于傳統DDSCR 的維持電壓.
圖8(a),(b)分別是DDSCR 器件與PNP_DDSCR 器件T1 端子應力為0.08 A TLP 電流的電流密度分布圖.在該應力強度下,兩種器件都完全開啟,相比DDSCR 器件,PNP_DDSCR 器件多條電流泄放路徑共同作用,電流密度分布范圍廣泛,導通電阻更低,準靜態I-V特性曲線泄放過程中斜率更大.
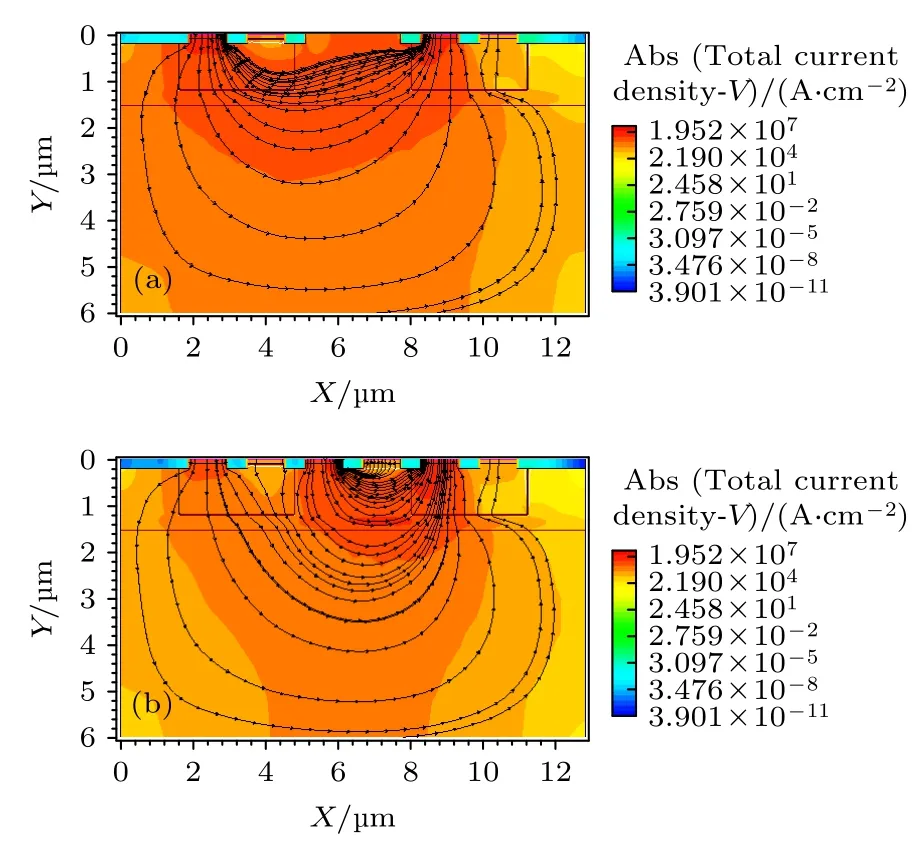
圖8 T1 端子應力為0.08 A TLP 電流的電流密度分布圖 (a) DDSCR 器件電流密度分布圖;(b) PNP_DDSCR電流密度分布圖Fig.8.Current density distribution diagram of 0.08 A TLP current at T1 terminal: (a) Current density distribution diagram of DDSCR device;(b) current density distribution diagram of PNP_DDSCR device.
圖9 是DDSCR 器件與PNP_DDSCR 器件T1 端子TLP 電流脈沖應力為2.68 A 時最高溫度隨時間變化過程對比圖.傳統DDSCR 器件最高溫度隨時間升高,在最終時刻達到極大值(930 K),如圖10 所示,最熱點位置位于阱區反偏PN 結附近.
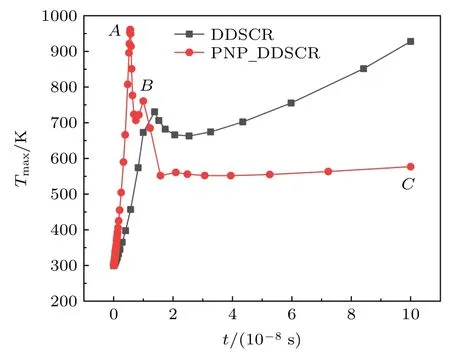
圖9 T1 端子應力為2.68 A TLP 電流的最高溫度隨時間的變化過程對比圖Fig.9.The temperature changing processes with time for T1 TLP stress of 2.68 A.
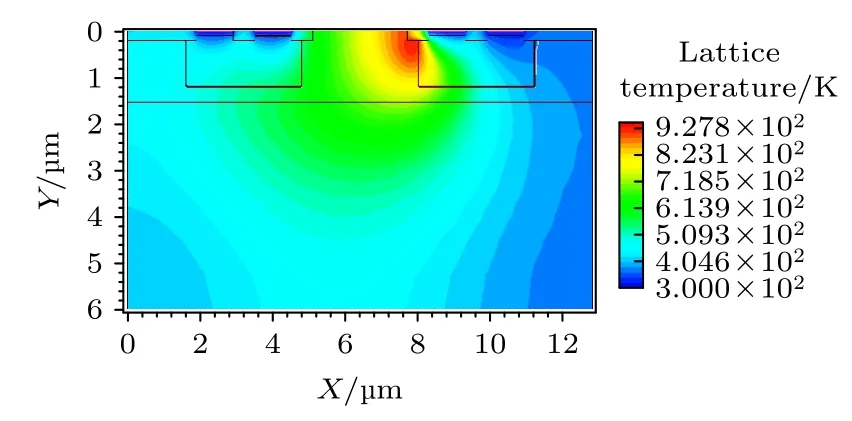
圖10 DDSCR 器件溫度分布圖Fig.10.Temperature distribution diagram of DDSCR device.
PNP_DDSCR 器件開啟過程中,最高溫度隨時間的變化存在兩個極值(952 K,760 K),而后下降,最后平穩上升.圖11 是PNP_DDSCR 器件導通過程中不同時刻的溫度分布圖.當TLP 脈沖作用于PNP_DDSCR 器件T1 端子時,內嵌PNP晶體管路徑優先開啟,導致該路徑上出現電流擁擠,最高溫度快速達到極大值,最熱點位于內嵌PNP 晶體管的集電結附近.隨著SCR 路徑的逐步開啟,電流分布范圍擴大,最熱點開始發生轉移,該過程中出現第2 個極值,當SCR 路徑完全開啟后,最熱點轉移至阱區反偏PN 結附近,由于PNP_DDSCR 器件具有多條電流泄放路徑,電流擁擠程度遠低于傳統DDSCR 器件,隨著脈沖時間的延長,SCR 路徑完全開啟后,阱區反偏PN 結附近的最熱點溫度增加緩慢.
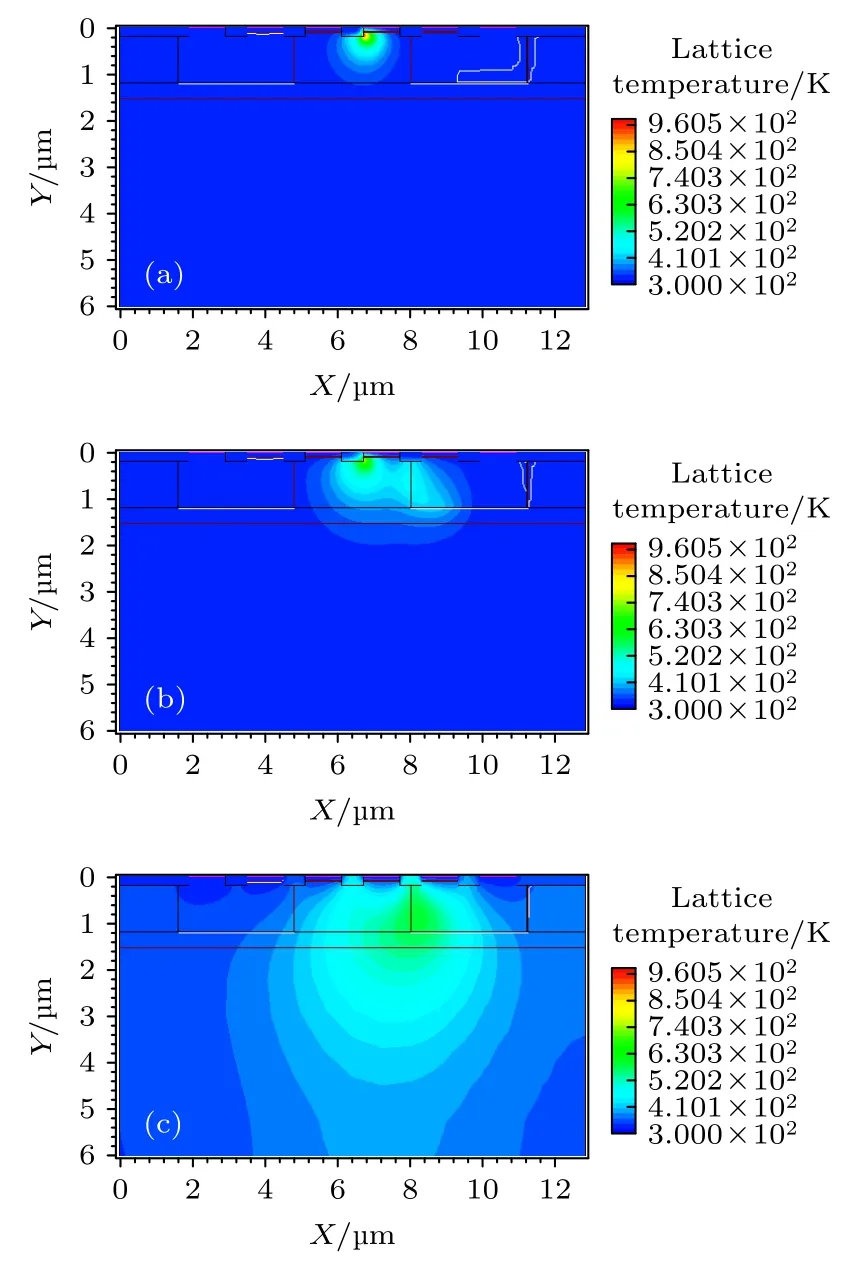
圖11 圖9 中三點PNP_DDSCR 器件導通過程溫度分布圖 (a) A 點;(b) B 點;(c) C 點Fig.11.Temperature distribution of PNP_DDSCR device at different point in Fig.9: (a) Point A;(b) point B;(c) point C.
圖12 是DDSCR器件與PNP_DDSCR 器件T1 端子TLP 脈沖應力強度為2.68 A 時的單位面積平均溫度隨時間的變化過程對比圖,整個開啟過程中,PNP_DDSCR 器件的平均溫度都低于傳統DDSCR 器件,隨著脈沖時間的增加,平均溫度的差值進一步擴大.PNP_DDSCR 器件中的寄生結構導致快速出現溫度極值,但在器件完全導通后由于多條電流泄放路徑的共同作用,器件具有較強的散熱能力.
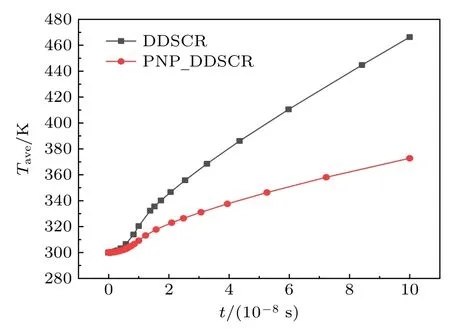
圖12 T1 端子應力為2.68 A TLP 電流的單位面積平均溫度隨時間的變化過程對比圖Fig.12.The change processes of average temperature per unit area with time when T1 TLP stress is 2.68 A.
3.2 瞬態開啟特性分析
充電器件模型(charged device model,CDM)放電時間極短,一般為ns 級別.VF-TLP 脈沖仿真測試能夠有效衡量器件的CDM 防護能力,其中瞬態過沖電壓和開啟速度是關鍵指標[23].
圖13 是PNP_DDSCR 和DDSCR 在VF-TLP仿真測試下的電流-過沖電壓曲線(正向).PNP_DDSCR 觸發路徑上的寄生電阻更小,實現了比傳統DDSCR 更低的瞬態過沖電壓,隨著VF-TLP電流脈沖幅值的增大,過沖電壓的差值進一步擴大.
圖14 為DDSCR 和PNP_DDSCR 在VF-TLP電流為0.1 A 時的瞬態電壓響應過程.由圖14 可得PNP_DDSCR 的瞬態過沖電壓比DDSCR 低了將近30 V,與圖13 中顯示的一致.由兩種器件電壓響應過程可知,PNP_DDSCR 與DDSCR 恢復到穩態的時間相近,保持了較快的開啟速度.兩種器件在該電流強度下不同時間點的電勢分布圖,如圖15 所示.1×10–10s 時刻兩種器件T1 端子電勢同時達到峰值,但差值明顯,與DDSCR 器件T1 端子電勢46.41 V 相比,PNP_DDSCR 此時T1 端子電勢僅為17.16 V,下降了63%;在8×10–9s時刻,器件均完全開啟,T1 端子電勢差值減小,都恢復到較低的值,進入穩定狀態.

圖13 電流-過沖電壓曲線對比圖Fig.13.Comparison of current-overshoot voltage curve.
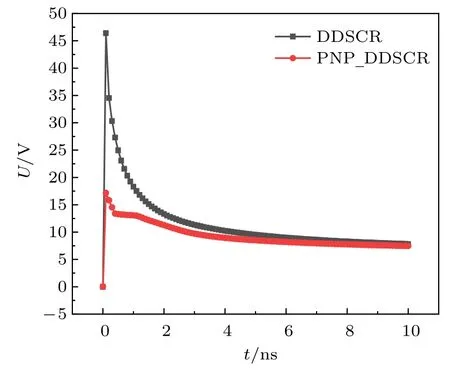
圖14 0.1 A VF-TLP 響應過程對比圖Fig.14.Comparison of VF-TLP response process at 0.1 A.

圖15 0.1 A VF-TLP 脈沖強度不同時刻電勢分布圖 (a) 1×10–10 s 時刻DDSCR 電勢分布圖;(b) 1×10–10 s 時刻PNP_DDSCR電勢分布圖;(c) 8×10–9 s 時刻DDSCR 電勢分布圖;(d) 8×10–9 s 時刻PNP_DDSCR 電勢分布圖Fig.15.Potential distribution diagram of 0.1 A VF-TLP pulse intensity at different times: (a) DDSCR potential distribution diagram at 1×10–10 s;(b) potential distribution diagram of PNP_DDSCR at 1×10–10 s;(c) DDSCR potential distribution diagram at 8×10–9 s;(d) potential distribution diagram of PNP_DDSCR at 8×10–9 s.
綜上所述,PNP_DDSCR 器件在保持較快開啟速度的前提下對過沖電壓有更好的鉗位能力,在CDM 防護模式下同樣具有較強的保護能力.
4 結論
基于傳統DDSCR 結構,提出一種內嵌橫向PNP 晶體管的ESD 雙向防護器件(PNP_DDSCR),內嵌橫向PNP 晶體管的引入促進了SCR 系統中正反饋通路的建立,抑制電導調制效應,降低寄生電阻.對比分析了新結構器件與傳統DDSCR 器件在不同ESD 應力模式下的響應過程以及電流輸運機制.TLP 脈沖測試結果表明,內嵌PNP 晶體管結構在器件觸發時提供輔助觸發電流,降低觸發電壓,在器件開啟后,引入兩條新的電流泄放通路,抑制電導調制效應的同時提高了電流泄放能力;VF-TLP 脈沖測試結果表明,PNP_DDSCR 器件觸發路徑上的寄生電阻更小,對瞬態過沖電壓有更好的鉗位能力,同時保持了較快的開啟速度.

