新型雙面交叉T型溝槽碳化硅中子傳感器*
董翰林, 于成浩, 郭浩民, 韓運成, 張立龍
(1.杭州電子科技大學 電子信息學院,浙江 杭州 310018; 2.中國科學院合肥物質科學研究院,安徽 合肥 230031)
0 引 言
中子探測問題一直受到空間探索、國土安全、核電站、高能物理實驗等領域的高度關注[1~3]。碳化硅(SiC)中子傳感器的抗輻射能力遠優于硅或鍺傳感器[4]。并且與3He正比計數管相比,SiC中子傳感器具有工作電壓低、電荷收集快、體積小、中子伽馬判別能力強等優點[5]。由于中子是電中性的,用于識別中子的方法通常依賴于中子和轉換材料(6LiF,10B)發生核反應產生的次級帶電粒子[6]。當這些帶電粒子進入SiC二極管的有源區時,通過庫侖散射產生多個電子—空穴對,最終通過外電極對電子和空穴進行收集便可獲得微小的電流脈沖信號,從而便間接地實現對中子的探測[7]。
已有幾個研究小組在結構參數設計以提高本征檢測效率方面做出了實質性的早期貢獻[8],由于中子轉換材料的自吸收作用,薄膜涂層中子傳感器的探測效率低于5 %[9]。為了提高中子探測效率,研究人員開發了疊層硅中子傳感器[10]。此外,堪薩斯州立大學還開發了硅微結構半導體中子探測器(microstructured semiconductor neutron detector,MSND)[11]。目前,大多數研究都集中在SiC薄膜涂層中子傳感器上,而關于SiC微結構中子傳感器的報道很少[12]。
1 單面型SiC中子傳感器
1.1 平面型SiC中子傳感器的仿真分析
平面型SiC中子傳感器由中子反應膜和SiC二極管器件組成,如圖1(a)中的插圖所示。常用的中子轉換材料有6LiF和10B,而中子與6LiF反應產生的帶電粒子能量更高,更容易將中子信號從伽馬背景噪聲中區分出來。中子先與6LiF發生反應產生2.05 MeV的α粒子和2.73 MeV的氚粒子,為了保持動量守恒,α粒子和T粒子向著相反的方向出射。基于蒙特卡洛技術[13,14]的Geant4工具包可以逐步追蹤這些粒子,直到它們失去全部能量或離開世界體。由于中子捕獲概率隨著轉換層厚度t的增加而增加。然而,由于轉換材料對次級帶電粒子的自吸收效應,導致次級粒子將其能量沉積在轉換材料中,而對輸出脈沖信號沒有貢獻。如果轉換器層很厚,則導致次級粒子的能量沉積在轉換層中,而無法到達SiC二極管區域。因此,轉換層厚度在平面型傳感器的設計中至關重要。通過將低能甄別閾值(low energy level discrimination threshold,LLD)設置為300 keV便可以濾除掉Gamma背景的干擾,因此中子探測效率便可以定義為在SiC傳感器區域中沉積能量大于LLD的事件數除以入射到傳感器的中子事件數。探測效率和能量淀積譜隨轉換層厚度t的變化分別如圖1(a)和圖1(b)所示。
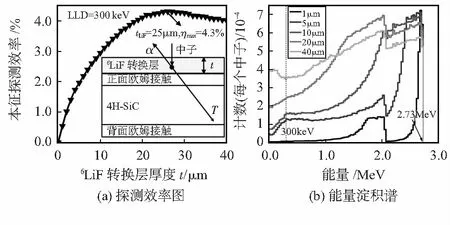
圖1 平面型SiC中子傳感器
從圖1可以看出,當轉換層的厚度小于或大于最佳厚度時,探測效率都會下降。很明顯,當6LiF 的厚度達到25 μm左右,本征檢測效率達到最大值4.3 %,然后隨著6LiF厚度的增加,探測效率緩慢下降。這種現象是因為限制熱中子本征探測效率的兩個因素是中子吸收效率和反應產物逸出概率。當轉換層較薄時,中子被俘獲的概率較小,因此次級粒子的數量較少。當轉換層較厚時,由于轉化材料對次級粒子的自吸收增強,反應產物逸出的概率降低。這從能量淀積譜圖中同樣可以發現當6LiF的厚度較薄時,在2.05 MeV附近可以觀察到明顯的α峰,在2.73 MeV附近可以觀察到明顯的T峰。這是因為次級粒子通過薄轉換層僅損失少量能量,因此大部分可以進入SiC傳感器。當6LiF的厚度繼續增加到40 μm時,高能區間的計數減少,而低能區間的計數增加。這主要是由于轉換層的自吸收效應增強,這也不利于區分背景伽馬射線。由于次粒子向著相反方向噴射,每次核反應后,只有一個次級粒子可以進入 SiC 傳感器區域,因此,可以發現圖1(b)中的能量截止值是能量最高的次級粒子的能量值。
1.2 溝槽型SiC中子傳感器的仿真分析
由于轉換材料的自吸收效應,平面型SiC中子傳感器的本征探測效率被限制在5 %以下。幸運的是,如圖2(a)所示的溝槽型微結構中子傳感器可以突破這一限制。因為溝槽型SiC中子傳感器可以增加6LiF的填充量和次級粒子入射到SiC區域中的概率。影響溝槽型SiC中子傳感器的本征探測效率的結構參數有溝槽間隙Tg,溝槽寬度Tw和溝槽深度H。
對于用6LiF 回填的溝槽型MSND,任意選擇溝槽寬度Tw為20 μm。當LLD=300 keV時,溝槽型MSND在不同溝槽深度H下本征探測效率隨溝槽間隙Tg的變化如圖2(b)所示。可以發現,隨著溝槽間隙Tg的增加,本征探測效率先急劇增加,然后緩慢下降。當溝槽間隙Tg約為5 μm時,無論溝槽深度H如何,本征探測效率都取到最大值。接著當溝槽深度H固定為100 μm,當LLD=300 keV時,本征探測效率隨溝槽間隙Tg變化,如圖2(c)所示。可以發現,當溝槽寬度Tw取不同的值時,溝槽間隙Tg為5 μm時本征探測效率總是達到最大值且與溝槽寬度Tw無關。
基于上述結論,對于6LiF回填的MSND,最優的溝槽寬度Tg可以固定為5 μm。并且隨著溝槽寬度Tw的增加,探測效率先升高后降低。如圖2(d)所示,在不同溝槽深度H的情況下,當溝槽寬度Tw約為15 μm時,本征探測效率均達到最大值。因此,6LiF回填的MSND的最佳參數組合是15 μm的溝槽寬度Tw和5 μm的溝槽間隙Tg。

圖2 溝槽型SiC中子傳感器
2 雙面溝槽型SiC中子傳感器
2.1 新型雙面交叉式T型溝槽結構
為了進一步提升器件的性能,已有團隊提出了雙面蝕刻的交叉式微結構如圖3(a)所示[15]。盡管制造起來更加困難,但電場將在整個檢測器區域中均勻分布,并且收集所有產生的電荷所需的信號積分時間將減少,并且不受增加的微結構深度的限制。但由于中子經過SiC區域將不能被吸收,因此存在中子的自由流通路徑,不利于探測效率的提升。本文提出了一種新型雙面交叉式T型溝槽結構的SiC中子傳感器如圖3(b)所示。該結構可以完全消除中子自由流通路徑,可以提升中子吸收概率進而可以大幅度提升器件的中子探測效率。同樣兼具電場均勻和信號積分時間短等優點。
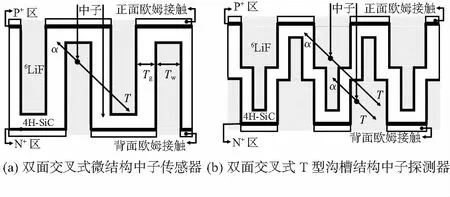
圖3 兩種結構示意
2.2 結果對比分析
傳統的雙面交叉式微結構中子傳感器需要在4H-SiC外延片的正面和反面分別進行交叉式的溝槽刻蝕,需要往正面和背面的溝槽內部都回填中子轉換材料6LiF。而雙面交叉式T型溝槽結構中子傳感器可以在4H-SiC外延片的正面和反面通過兩次曝光和兩次刻蝕后形成交叉式的T型溝槽,可以進一步增加SiC刻蝕深度。然后在雙面T型溝槽內分別形成P區和N區,接著將T型溝槽內回填滿中子轉換材料。本文提出的T型溝槽SiC結構相較于傳統的交叉指型中子傳感器可以完全消除中子自由流通路徑,進而可大幅提升中子探測效率。當溝槽深度H為100 μm時,采用蒙特卡洛軟件Geant4對兩種結構的中子傳感器的本征中子探測效率隨著LLD的變化情況如圖4(a)所示。交叉型結構的探測效率隨著LLD的變化較小,而雙面T型溝槽的探測效率隨著LLD的變化減小很快,當LLD大于800 keV后,探測效率低于傳統的交叉型。但是實際中的Gamma射線或者背景噪聲在SiC中淀積的能量一般都在300 keV以下,因此,將LLD設置為300 keV時,就完全可以消除掉背景噪聲或者Gamma射線引入的誤計數。雙面T型溝槽型中子探器件相比于傳統交叉指型傳感器件,中子探測效率提升了7.23 %。顯然,T型溝槽中子傳感器可以大幅度提升中子探測效率。而且從SiC實際的工藝出發,100 μm的刻蝕深度是很難實現的[16]。而本文提出的T型溝槽可以通過兩次刻蝕就很容易實現100 μm的刻蝕深度。
此外,由于SiC材料的P區和N區只能使用離子注入形成,但是深溝槽的底部和側壁離子注入形成連續的P區和N區難度很大,而本文提出的T型溝槽結構可以只在上溝槽部分使用離子注入形成部分的P區和N區摻雜,如圖4(b)所示的結構。這樣也有助于提高器件的電荷收集效率,可以進一步提升器件的性能。
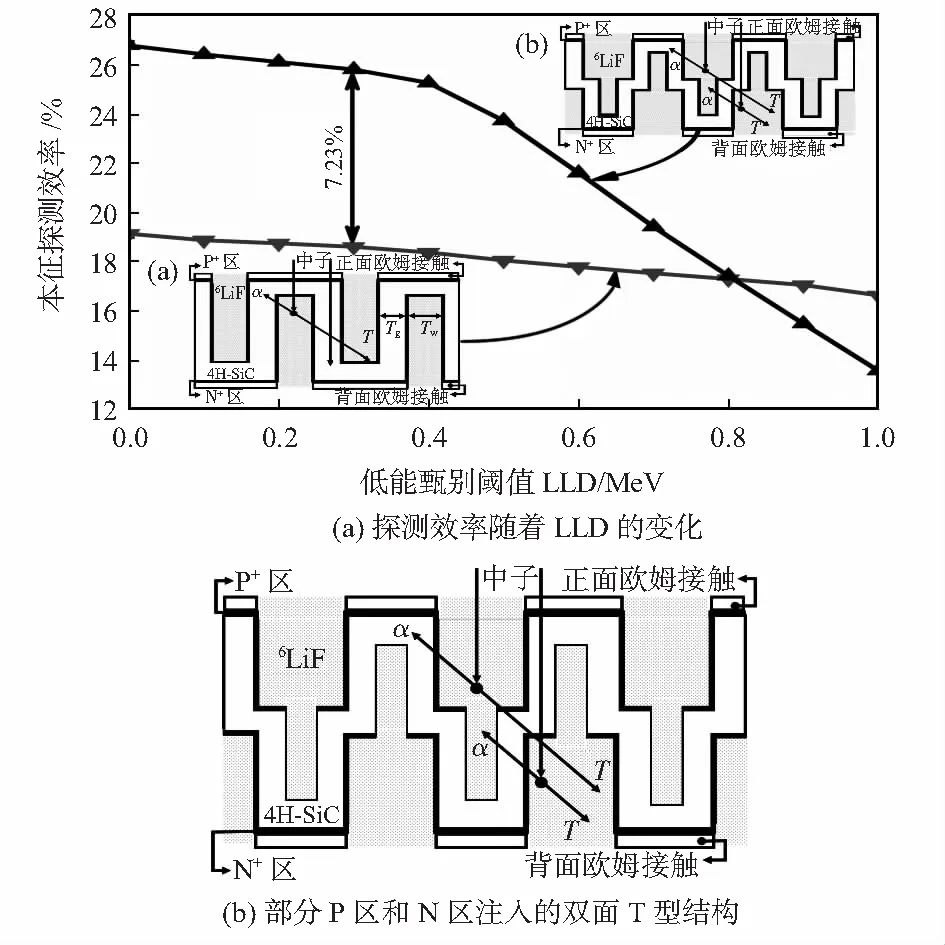
圖4 兩種結構探測效率對比結果分析
3 結 論
由于中子是電中性的,用于識別中子的方法通常依賴于次級帶電粒子。本文中,基于Geant4工具包研究了基于SiC的中子傳感器的性能。考慮了薄膜涂層和溝槽型中子傳感器,并根據相關結構參數計算了它們的本征探測效率,LLD值固定在300 keV。由于轉換材料的自吸收效應,薄膜涂層SiC中子傳感器的本征探測效率被限制在5 %以下。溝槽型SiC中子傳感器可以突破這一限制。基于傳統的交叉型溝槽結構提出新型雙面T型溝槽結構,可以完全消除中子自由流通路徑進而顯著提高中子的本征探測效率。并且本文提出的T型溝槽結構可以只在上溝槽部分使用離子注入形成部分摻雜的P區和N區。這樣也有助于進一步提高器件的電荷收集效率進而提升器件的性能,為以后深溝槽高性能SiC中子傳感器的制造提供了方案。

