圓柱形諧振式MPCVD裝置的模擬及調(diào)控
劉繁,翁俊,汪建華,2,周程
表面功能化
圓柱形諧振式MPCVD裝置的模擬及調(diào)控
劉繁1,翁俊1,汪建華1,2,周程1
(1.武漢工程大學(xué) 湖北省等離子體化學(xué)與新材料重點(diǎn)實(shí)驗(yàn)室,武漢 430205;2.中科院等離子體物理研究所,合肥 230031)

微波等離子體化學(xué)氣相沉積;等離子體;金剛石膜
金剛石膜因其獨(dú)一無二的物理化學(xué)性能,被廣泛應(yīng)用于電化學(xué)、半導(dǎo)體和航天航空等領(lǐng)域,而高質(zhì)量的金剛石膜更是廣泛應(yīng)用于軍事領(lǐng)域[1-3]。在眾多金剛石膜的制備方法(如熱絲化學(xué)氣相沉積(HFCVD)法、高溫高壓(HTTP)法、直流等離子體噴射(DC- PACVD)法、電子回旋共振(ECR)法、微波等離子體化學(xué)氣相沉積(MPCVD)法等[4-8])中,MPCVD法因其激發(fā)的微波等離子體電子密度高、無電極污染等優(yōu)點(diǎn),被認(rèn)為是制備高質(zhì)量金剛石膜的首選方法。
隨著MPCVD技術(shù)近20年的不斷發(fā)展以及對高質(zhì)量大面積金剛石膜的迫切需求,高功率微波源的應(yīng)用、MPCVD裝置的核心器件——微波等離子體諧振腔的設(shè)計(jì)和改進(jìn)成為科研工作者研究的重點(diǎn)。如德國Füner等設(shè)計(jì)的在2.45 GHz(6.0 kW)和915 MHz(60 kW)微波源下工作的橢球形諧振腔裝置[9-10];美國Schuelke的研究小組以及ASTex公司設(shè)計(jì)的2.45 GHz(6.0 kW)和915 MHz(60 kW)的圓柱形石英鐘罩式MPCVD裝置[11-12];美國Seki公司開發(fā)的AX6500和AX6600系列大面積微波等離子體諧振腔裝置[13-14]。這些研究工作都將研究重心放在提高微波功率和改進(jìn)微波諧振腔的結(jié)構(gòu)上。在我國,包括中科院合肥等離子體物理研究所、北京科技大學(xué)等在內(nèi)的許多科研院所,針對微波諧振腔結(jié)構(gòu)同樣開展了大量的相關(guān)研究[15-17]。北京科技大學(xué)設(shè)計(jì)出一系列圓柱形多模MPCVD裝置,并于2019年和河北激光研究所[18]在研制的915 MHz/75 kW高功率MPCVD裝置上制備了直徑為127 mm的大面積自支撐金剛石膜。同時(shí),筆者的研究小組也成功研發(fā)了一系列高功率多模MPCVD裝置,并在該系統(tǒng)上進(jìn)行了金剛石膜可控性生長的實(shí)驗(yàn)研究。研究結(jié)果表明,提高微波功率和設(shè)計(jì)高品質(zhì)因素的多模微波諧振腔,可以顯著擴(kuò)大所激發(fā)的微波等離子體的面積,改善微波等離子體的均勻性,從而有助于提升所沉積的金剛石膜的質(zhì)量及尺寸。但大面積微波等離子體的激發(fā)不僅依賴于微波功率的提高和微波諧振腔的改進(jìn),還與MPCVD裝置的氣壓、功率、溫度等放電參數(shù)之間的協(xié)調(diào)匹配息息相關(guān)。
本文在采用理論計(jì)算與多物理場模擬軟件Comsol對微波等離子體進(jìn)行模擬分析的基礎(chǔ)上,結(jié)合實(shí)驗(yàn)具體分析,討論放電參數(shù)之間的調(diào)控規(guī)律,對常見的圓柱形MPCVD裝置進(jìn)行系統(tǒng)的研究。利用等離子體光譜診斷分析了諧振腔內(nèi)等離子體的放電特征,獲得了裝置中合適的功率與氣壓匹配值。同時(shí),在MPCVD裝置上進(jìn)行了微米及納米金剛石膜制備的基礎(chǔ)實(shí)驗(yàn)研究,為調(diào)控和優(yōu)化高功率大面積MPCVD裝置提供了理論與實(shí)驗(yàn)基礎(chǔ)。
1 圓柱形MPCVD裝置簡介
本文分析的MPCVD裝置為研究組自行研制的圓柱形單模諧振腔裝置,其結(jié)構(gòu)如圖1所示,主要由微波系統(tǒng)、電源系統(tǒng)以及真空系統(tǒng)三大部分組成[19]。由磁控管輸出的2.45 GHz微波經(jīng)由矩形波導(dǎo)以主模TE10傳輸,在傳輸線的終端,采用探針電激勵(lì)的方式耦合到圓柱形單模微波諧振腔內(nèi),并在基片臺(tái)上方激發(fā)出球形的微波等離子體。其中,傳輸系統(tǒng)中的三螺釘阻抗調(diào)配器主要用于調(diào)節(jié)整個(gè)微波系統(tǒng)的阻抗匹配,以期實(shí)現(xiàn)耦合到諧振腔內(nèi)的微波能最大化,而水負(fù)載和環(huán)形器則能保證反射的微波能全被水負(fù)載定向吸收,從而達(dá)到保護(hù)微波源的目的。
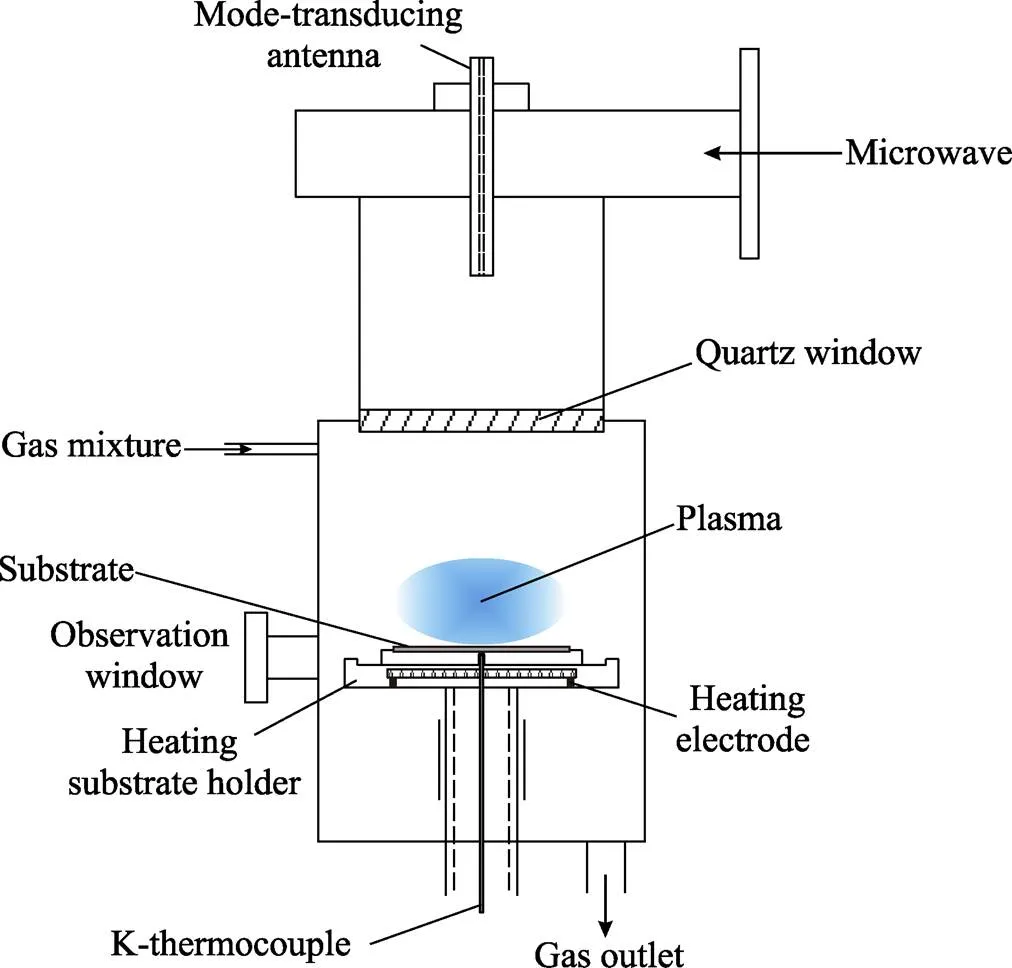
圖1 圓柱形MPCVD裝置
2 結(jié)果與討論
2.1 MPCVD裝置等離子體理論計(jì)算
在微波等離子體裝置中,等離子體內(nèi)能量的傳遞主要是通過加速電子與分子之間的碰撞來實(shí)現(xiàn)的。為了使在等離子體中耗散的高頻功率達(dá)到可能的最大值,也就是等離子體吸收的功率密度最大,可以通過對能量轉(zhuǎn)換頻率進(jìn)行分析來找到功率密度達(dá)到最大值的具體條件。等離子體對輸入的微波能量的吸收功率密度可通過方程(1)進(jìn)行求解計(jì)算.

其中,一個(gè)震蕩周期內(nèi)的靜電能量max和能量轉(zhuǎn)換頻率可分別通過方程(2)和(3)進(jìn)行求解計(jì)算。


式(1)—(3)中:為等離子體吸收功率密度;e、和分別為電子密度、電子電荷和電子質(zhì)量;0為微波電場強(qiáng)度;和pe分別為能量轉(zhuǎn)換頻率和電子等離子體頻率;c為電子碰撞頻率。
在許多實(shí)驗(yàn)中,通過調(diào)節(jié)氣壓,可將電子碰撞頻率當(dāng)作一個(gè)與壓強(qiáng)幾乎成正比的函數(shù)來處理。因此,當(dāng)能量轉(zhuǎn)換頻率對電子碰撞頻率的導(dǎo)數(shù)為0時(shí),能量轉(zhuǎn)換頻率可取得最大值。通過對公式(3)求導(dǎo)取零值計(jì)算,可得:

計(jì)算可得,當(dāng)外加射頻頻率等于電子碰撞頻率=c時(shí),能量轉(zhuǎn)換頻率達(dá)到最大值,亦即此時(shí)的等離子體對輸入的微波能量的吸收功率密度最大。由于電子與中性粒子的碰撞頻率與氣壓成正比,當(dāng)氣壓較低時(shí),對應(yīng)的碰撞頻率也較低,等離子體從微波場中獲得的能量較低,即等離子體吸收功率密度較低。當(dāng)氣壓逐漸升高到一定程度時(shí),碰撞頻率升高,等離子體吸收功率密度也相應(yīng)增加。在氣壓與功率相匹配的條件下(即=c時(shí)),等離子體從微波場中獲得的能量達(dá)到最大。隨著氣壓的進(jìn)一步升高,碰撞頻率過高,電子因其平均自由程變小而不能實(shí)現(xiàn)有效的加速,因此等離子體吸收功率密度不增反減。
電子與中性粒子的碰撞頻率為:

因此,對于2.45 GHz的微波等離子體而言,能量轉(zhuǎn)換頻率和等離子體的吸收功率密度最大時(shí),氣壓與氣體溫度之間滿足如下關(guān)系:

2.2 MPCVD裝置等離子體數(shù)值模擬
根據(jù)理論計(jì)算可以得到,等離子體的吸收功率密度與氣壓和氣體溫度之間有著密切的關(guān)聯(lián),只有當(dāng)溫度和氣壓滿足特定的關(guān)系時(shí),微波耗散在等離子體中的功率值才能達(dá)到最大。同時(shí),根據(jù)理論計(jì)算和前期的實(shí)驗(yàn)研究可知,微波功率同樣是影響微波諧振腔內(nèi)等離子體相關(guān)參數(shù)的重要因素之一。等離子體的吸收功率密度除了與電子密度e成正比,還與微波電場強(qiáng)度的平方成正比,而微波電場強(qiáng)度直接由MPCVD裝置輸入的微波功率決定,相關(guān)研究工作在文獻(xiàn)[19]中有詳細(xì)的報(bào)道。電子密度e也與氣壓、微波功率緊密相關(guān)。
工作氣壓為10 kPa的條件下,不同微波功率下的MPCVD裝置的等離子體電子密度分布如圖2所示。由圖2可知,當(dāng)功率從1000 W升到3500 W時(shí),等離子體中的電子密度明顯升高,表明增加微波功率是提高等離子體電子密度的有效途徑。
輸入微波功率為1000 W的條件下,不同工作氣壓下MPCVD裝置的等離子體電子密度分布如圖3所示。在功率和氣壓極度不匹配的情況下,極難有效激發(fā)出等離子體,因此在模擬過程中,計(jì)算結(jié)果會(huì)出現(xiàn)不收斂。因而,僅在有效的氣壓范圍內(nèi)對等離子體進(jìn)行模擬計(jì)算。由圖3可知,當(dāng)氣壓從5 kPa升到10 kPa時(shí),等離子體中電子密度同樣也會(huì)升高,特別是最低電子密度升高了5個(gè)數(shù)量級。表明在有效氣壓范圍內(nèi),等離子體中電子的均勻性會(huì)隨著氣壓的升高而改善。
模擬可知,微波功率和工作氣壓是提高電子密度的有效途徑,但在裝置實(shí)際的調(diào)配過程中,功率和氣壓并不是獨(dú)立調(diào)控的,它們之間存在一定的匹配關(guān)系。只有當(dāng)微波功率和工作氣壓在相互匹配的狀態(tài)下,微波能才不會(huì)過多地耗散在微波傳輸線及阻抗調(diào)控器件上,等離子體的吸收功率密度才能在各不同階段實(shí)現(xiàn)最大化。
2.3 MPCVD裝置實(shí)驗(yàn)及光譜分析
由于微波諧振腔內(nèi)的諧振模式在軸向上具有周期性,因此當(dāng)氣壓相對給定的微波功率較低時(shí),球會(huì)往石英介質(zhì)窗處跑,容易在石英介質(zhì)窗處發(fā)生放電現(xiàn)象。當(dāng)氣壓相對給定的微波功率較高時(shí),又會(huì)出現(xiàn)基片臺(tái)過熱的情況,會(huì)對基片臺(tái)的加工設(shè)計(jì)提出更多要求。因此,只有在氣壓和功率匹配的情況下,才能實(shí)現(xiàn)吸收功率密度大,并激發(fā)出適合高質(zhì)量金剛石膜生長要求的微波等離子體。結(jié)合實(shí)驗(yàn)和理論分析,得到的典型圓柱形MPCVD裝置的微波功率與工作氣壓的等離子體邊界如圖4所示[20]。

圖2 不同微波功率下的等離子體電子密度分布

圖3 輸入微波功率為1000 W時(shí)不同工作氣壓下的等離子體電子密度分布
由圖4可知,本課題組研制的圓柱形單模MPCVD裝置的工作氣壓和微波功率相互之間有一個(gè)匹配邊界,即在虛線以內(nèi)的范圍調(diào)控工作氣壓和微波功率,都能夠激發(fā)出微波等離子體。以正斜率上的等離子體激發(fā)邊界為例,當(dāng)工作氣壓下降時(shí),如果對應(yīng)給定的微波功率,也就是微波諧振腔內(nèi)的微波電場,壓力下降得過多,就會(huì)超出邊界范圍,此時(shí)石英介質(zhì)窗處的微波電場變強(qiáng),微波等離子體將會(huì)在窗口處激發(fā)出等離子體。同理,以負(fù)斜率上的等離子體激發(fā)邊界為例,當(dāng)工作氣壓升高時(shí),如果對應(yīng)給定的微波功率壓力上升太多,也會(huì)超出邊界范圍,此時(shí)基片臺(tái)會(huì)出現(xiàn)過熱的現(xiàn)象。因此,如果需要圓柱形單模MPCVD裝置能夠?qū)崿F(xiàn)長期穩(wěn)定的運(yùn)行,微波功率和工作氣壓必須在穩(wěn)定邊界內(nèi)運(yùn)行。

圖4 圓柱形MPCVD裝置的微波功率與工作氣壓邊界
結(jié)合理論與實(shí)驗(yàn)研究,得到本課題組自制的圓柱形單模MPCVD裝置穩(wěn)定高效運(yùn)行的操作步驟,如圖4所示。微波功率以500 W為步長逐漸升高的情況下,相應(yīng)的工作氣壓選取在圖中圓圈點(diǎn)處時(shí),裝置的氣壓和功率匹配良好,能實(shí)現(xiàn)微波能利用的最大化。
在工作氣壓不變,微波功率分別為1500、2000、2500、3000 W下,圓柱形單模MPCVD裝置微波諧振腔內(nèi)激發(fā)的等離子體發(fā)射光譜如圖5所示。由圖5可知,不同功率條件下,CH4和H2的混合氣體所激發(fā)的微波等離子體中都含有刻蝕非金剛相的活性基團(tuán)Hα、Hβ,以及金剛石膜生長過程中必需的含碳活性基團(tuán)CH、C2,且活性基團(tuán)的強(qiáng)度隨著微波功率的升高而增強(qiáng)。
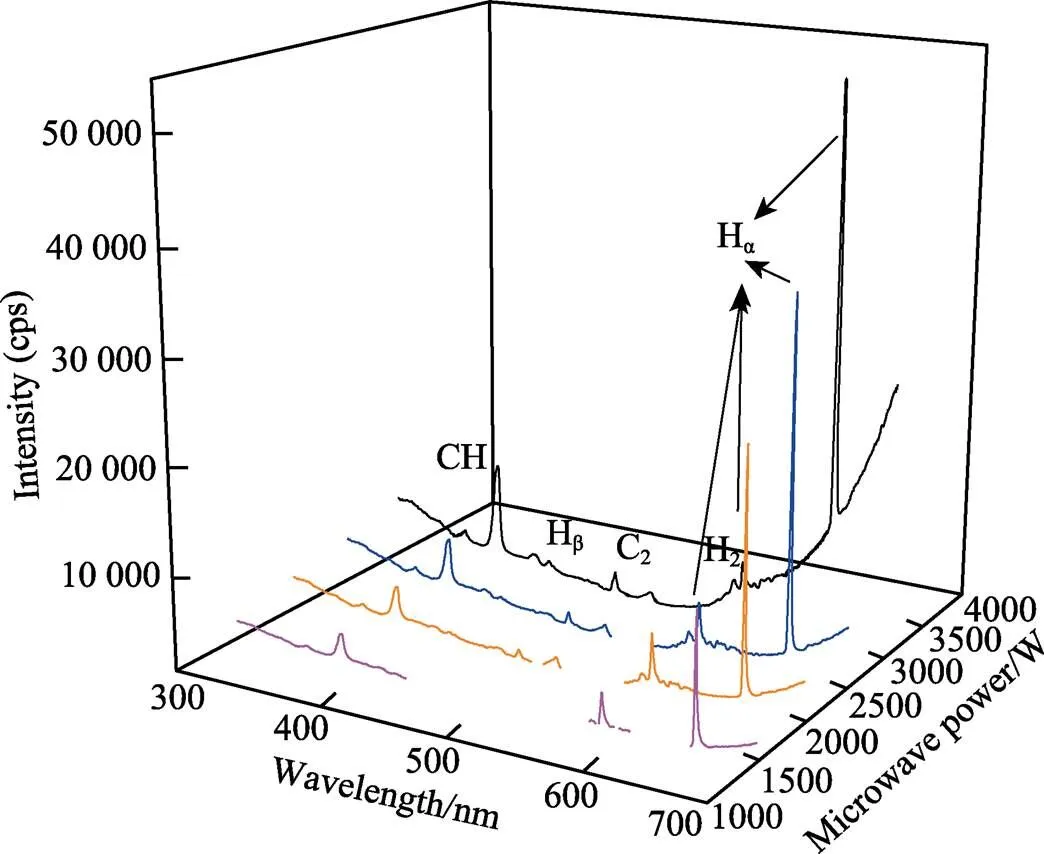
圖5 不同微波功率下的等離子體發(fā)射光譜圖全譜
當(dāng)工作氣壓一定,甲烷的體積分?jǐn)?shù)為2%時(shí),進(jìn)一步計(jì)算在不同微波功率下對腔體內(nèi)激發(fā)的等離子體發(fā)射光譜,可以得到所激發(fā)的等離子體電子密度為[21]:

其中,F(xiàn)WHA(full width at half area)為Balmer線系中Hα(656.19 nm)譜線半高寬處的求和面積。
根據(jù)公式(7)的計(jì)算,可得到電子密度隨著微波功率變化的趨勢,如圖6所示。在CH4和H2的混合氣體中,等離子體的電子密度隨著微波功率的升高而顯著增加。在MPCVD放電中,微波作為等離子體的激發(fā)源,是等離子體中活性基團(tuán)能量的主要來源,因而微波功率是影響等離子體電子密度的關(guān)鍵因素之一。微波氣壓一定時(shí),即諧振腔內(nèi)電子碰撞的平均自由程一定的情況下,當(dāng)微波功率較低時(shí),等離子體從微波電場中獲得的能量很少,因此等離子體電子密度較低。隨著微波功率的升高,等離子體獲得的能量也隨之增加,電子密度逐漸升高。當(dāng)微波功率升高到與工作氣壓相匹配的情況下,電子密度達(dá)到峰值。當(dāng)微波功率繼續(xù)升高,而工作氣壓仍舊維持不變時(shí),微波功率與工作氣壓不能有效匹配,吸收功率密度反而會(huì)降低,即使輸入的微波功率增加,但有效耦合到等離子體中的微波能反而降低,電子密度反而下降。
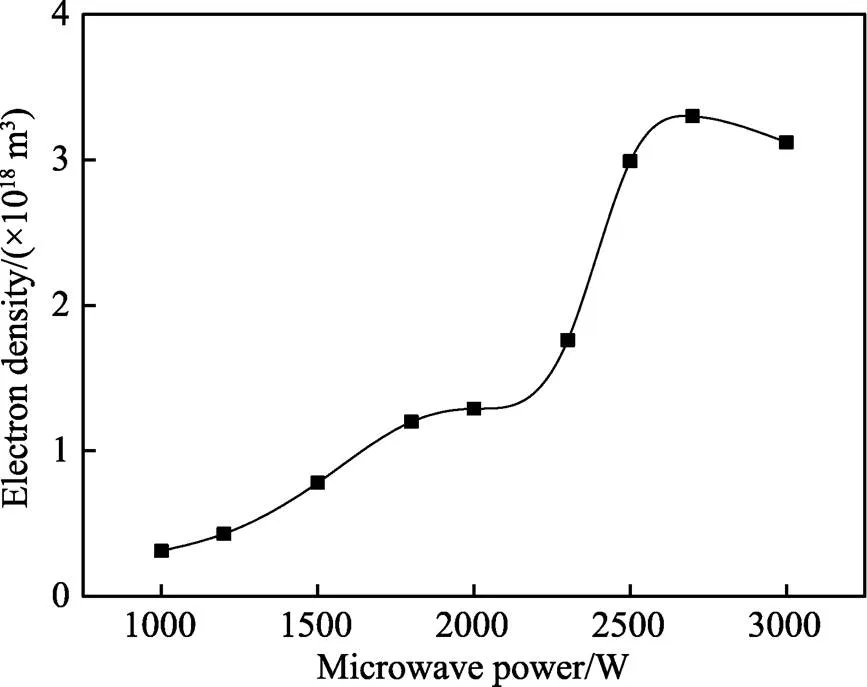
圖6 電子密度隨功率變化趨勢
2.4 高質(zhì)量金剛石膜的制備
在微波功率為2800 W,工作氣壓為15 kPa,甲烷的體積分?jǐn)?shù)為2%的生長條件下,開展了金剛石膜的沉積實(shí)驗(yàn)。實(shí)驗(yàn)過程中,可從觀察窗口觀察到等離子體密度較高的等離子體球,如圖7a所示。經(jīng)過10 h的沉積實(shí)驗(yàn)后,對生長的金剛石膜的表面形貌、生長結(jié)構(gòu)及質(zhì)量分別進(jìn)行SEM、XRD和Raman光譜的表征,其結(jié)果如圖7b—d所示。金剛石膜的SEM圖顯示,所沉積得到的金剛石膜晶粒生長良好,在晶面上沒有看到明顯的非金剛石相或晶粒團(tuán)聚體。金剛石膜的XRD表征結(jié)果顯示,所獲得的金剛石膜具有明顯的<111>取向。金剛石膜所對應(yīng)的Raman光譜也顯示,所獲得的金剛石膜在1332 cm–1處呈現(xiàn)出尖銳的金剛石相特征峰。對于產(chǎn)生上述實(shí)驗(yàn)結(jié)果的原因,可解釋為:金剛石膜的生長是一個(gè)sp3相生長和sp2相被刻蝕的過程,這個(gè)過程敏感地依賴于放電環(huán)境的狀態(tài)。通過微波功率及沉積氣壓的調(diào)整,可以明顯提高等離子體中的電子密度。電子密度的提高,可以顯著提高利于金剛石膜生長的含碳基團(tuán)的含量,也可以增強(qiáng)原子H對金剛石膜中sp2相的刻蝕作用,從而在提高金剛石膜生長速率的同時(shí),提高金剛石膜的質(zhì)量。上述結(jié)果表明,在較高的功率密度下,可制備得到晶型結(jié)構(gòu)良好且質(zhì)量優(yōu)良的金剛石膜。

圖7 等離子體諧振腔放電和金剛石膜的SEM、XRD、Raman圖
3 結(jié)論
本文通過計(jì)算模擬、等離子體診斷與實(shí)驗(yàn)相結(jié)合的方式,對圓柱形單模MPCVD裝置進(jìn)行了系統(tǒng)的研究,獲得了豐富的實(shí)驗(yàn)數(shù)據(jù),得到了等離子體與放電參數(shù)和等離子體吸收密度之間的協(xié)調(diào)規(guī)律,并從等離子體中活性基團(tuán)的運(yùn)動(dòng)及分布層面揭示了實(shí)現(xiàn)裝置內(nèi)微波能利用率最大化的協(xié)調(diào)機(jī)理,主要得到以下結(jié)論。

2)單一地增加微波功率是提高微波等離子體電子密度的有效途徑,提高工作氣壓也能很大程度上增強(qiáng)等離子體電子密度和改善等離子體球的均勻性。但要實(shí)現(xiàn)微波能最大化利用,兩者之間亦存在一定匹配關(guān)系。微波功率增加,工作氣壓亦隨之增加,實(shí)現(xiàn)匹配調(diào)控,才能實(shí)現(xiàn)微波能有效利用最大化。
3)在理論模擬的指導(dǎo)下結(jié)合實(shí)驗(yàn)調(diào)控,揭示了微波功率和工作氣壓之間的匹配關(guān)系,得到了等離子體放電的穩(wěn)定邊界。利用光譜診斷的方法,對不同微波功率下激發(fā)的微波等離子體進(jìn)行診斷可得,所激發(fā)的等離子體中含有大量的Hα、Hβ、CH及C2這類適合高質(zhì)量金剛石膜沉積的活性基團(tuán),功率與氣壓相匹配的情況下,電子密度可達(dá)到最大值。沉積金剛石膜的實(shí)驗(yàn)測試結(jié)果也從另一方面驗(yàn)證了,調(diào)控在最佳狀態(tài)下的MPCVD裝置更適合高質(zhì)量金剛石膜的制備。
[1] TANG S, LI P, LIU D, et al. Cutting performance of a functionally graded cemented carbide tool prepared by microwave heating and nitriding sintering[J]. High tem-perature materials and processes, 2019, 38: 582-589.
[2] JHA S K, PHUAH X L, LUO J, et al. The effects of ex-ternal fields in ceramic sintering[J]. Journal of the Ameri-can Ceramic Society, 2019, 102(1): 957-970.
[3] GONG M, PENG Q, XU Z, et al. The effect of oxygen on the epitaxial growth of diamond[J]. Journal of semicond-uctors, 2018, 39(12): 42-45.
[4] YU S X, ZHANG Z, LU W Z, et al. Effect of deposition parameters on crystalline of CVD diamond[J]. Integrated ferroelectrics, 2019, 197(1): 133-138.
[5] SONG C W, JIN R, HWANG N M, et al. Deposition behavior of boron-doped diamond with varying amount of acetone by hot filament chemical vapor deposition[J]. Electronic materials letters, 2019, 15: 630-638.
[6] LU F X, TANG W Z, HUANG T B, et al. Large-area high- quality diamond film deposition by high power DC arc plasma jet operating at gas recycling mode[J]. Diamond & related materials, 2001, 10(9-10): 1551-1558.
[7] 汪建華, 袁潤章, 鄔欽崇, 等. 用微波ECR等離子體濺射法在藍(lán)寶石(0112)晶面上生長ZnO薄膜的研究[J]. 物理學(xué)報(bào), 1999, 48(5): 955-960. WANG J H, YUAN R Z, WU Q C, et al. the study of epitaxial growth ZnO thin film on a (0112) sapphire sub-strate using ECR plasma sputtering method[J]. Journal of physics, 1999, 48(5): 955-960.
[8] SUN Q, WANG J, WENG J, et al. Surface structure and electric properties of nitrogen incorporated NCD films[J]. Vacuum, 2017, 137: 155-162.
[9] FUNER M, WILD C, KOIDL P. Novel microwave plasma reactor for diamond synthesis[J]. Applied physics letters, 1998, 72(10): 1149-1151.
[10] FUNER M, WILD C, KOIDL P. Simulation and develop-ment of optimized microwave plasma reactors for diam-ond deposition[J]. Surface & coatings technology, 1999, 116-119(4): 853-862.
[11] KING D, YARAN M K, SCHUELKE T, et al. Scaling the microwave plasma-assisted chemical vapor diamond dep-o-sition process to 150–200 mm substrates[J]. Diamond & related materials, 2008, 17(4-5): 520-524.
[12] BESEN M M, SEVILLANO E, SMITH D K. Microwave plasma reactor: USA, 5.556475[P]. 1996-09-17.
[13] SU J J, LI Y F, DING M H, et al. A dome-shaped cavity type microwave plasma chemical vapor deposition reactor for diamond films deposition[J]. Vacuum, 2014, 107(3): 51-55.
[14] WENG J, LIU F, WANG J H, et al. Deposition of large- area uniform diamond films by microwave plasma CVD [J]. Vacuum, 2018, 495: 1-8.
[15] 唐偉忠, 李義鋒, 蘇靜杰, 等. 一種新型的TM021模式的高功率微波等離子體金剛石膜沉積裝置: 中國, CN 103695865A[P].2014-04-02. TANG W Z, LI Y F, SU J J, et al. A new TM021 mode high power microwave plasma diamond film deposition device: China, CN 103695865A[P]. 2014-04-02.
[16] ZOU W D. Modelling and simulation of microwave plas-ma reactor[J]. Plasma devices & operations, 2004, 12(3): 187-192.
[17] LI Y F, AN X M, LIU X C, et al. A 915 MHz/75 kW cylindrical cavity type microwave plasma chemical vapor deposition reactor with a ladder-shaped circumferential an-tenna developed for growing large area diamond films [J]. Diamond & related materials, 2017, 78: 67-72.
[18] 李義鋒, 唐偉忠, 姜龍, 等. 915 MHz高功率MPCVD裝置制備大面積高品質(zhì)金剛石膜[J]. 人工晶體學(xué)報(bào), 2019(7): 1262-1267. LI Y F, TANG W Z, JANG L, et al. Large area high quality diamond films deposition by 915 MHz high power MPCVD reactor[J]. Journal of synthetic crystals, 2019(7): 1262-1267.
[19] 劉繁, 翁俊, 汪建華, 等. 圓柱形單模MPCVD裝置的數(shù)值模擬與實(shí)驗(yàn)研究[J]. 金剛石與磨料磨具工程, 2017, 37(2): 50-54. LIU F, WENG J, WANG J H, et al. Simulation and exper-imental study of a cylindrical single-mode microwave pl-a-sma CVD device[J]. Diamond and abrasives engineer-ing, 2017, 37(2): 50-54.
[20] EEVLIO S. Microwave plasma deposition of diamond [M]. Berlin: Springer Berlin Heidelberg, 1998: 14-23.
[21] SHERBINI A M E, HEGAZY H, SHERBINI T M E. Me-a-surement of electron density utilizing the Hα-line from laser produced plasma in air[J]. Spectrochimica acta part B atomic spectroscopy, 2006, 61(5): 532-539.
Simulation and Control of Cylindrical Resonant MPCVD Device
1,1,1,2,1
(1.Key Laboratory of Plasma Chemistry and Advanced Materials of Hubei Province, Wuhan Institute of Technology, Wuhan 430205, China; 2.Institute of Plasma Physics, Chinese Academy of Sciences, Hefei 230031, China)

microwave plasma chemical vapor deposition; plasma; diamond film
2020-04-30;
2020-08-04
LIU Fan (1983—), Female, Ph. D., Lecturer, Research focus: low temperature plasma technology and simulation.
翁俊(1986—),男,博士,講師,主要研究方向?yàn)榈蜏氐入x子技術(shù)與金剛石膜材料。郵箱:84312739@qq.com
Corresponding author:WENG Jun (1986—), Male, Ph. D., Lecturer, Research focus: low temperature plasma technology and diamond film materials. E-mail: 84312739@qq.com
劉繁, 翁俊, 汪建華, 等.圓柱形諧振式MPCVD裝置的模擬及調(diào)控[J]. 表面技術(shù), 2021, 50(4): 184-190.
O539
A
1001-3660(2021)04-0184-07
10.16490/j.cnki.issn.1001-3660.2021.04.017
2020-04-30;
2020-08-04
國家自然科學(xué)基金項(xiàng)目(51402220);湖北省教育廳基金項(xiàng)目(Q20151517)
Fund:National Natural Science Foundation of China (51402220); Project of Hubei Provincial Department of Education (Q20151517)
劉繁(1983—),女,博士,講師,主要研究方向?yàn)榈蜏氐入x子技術(shù)與模擬。
LIU Fan, WENG Jun, WANG Jian-hua, et al. Simulation and control of cylindrical resonant MPCVD device[J]. Surface technology, 2021, 50(4): 184-190.

