一種具有低壽命區(qū)的陽(yáng)極短路4H-SiC IGBT仿真研究
毛鴻凱,蘇芳文,林 茂,張 飛,隋金池
(杭州電子科技大學(xué) 電子信息學(xué)院,浙江 杭州 310018)
硅(Si)基器件的發(fā)展已達(dá)到了材料的極限,無(wú)法滿足電力電子系統(tǒng)越來(lái)越多的要求。以SiC、GaN為代表的第三代寬禁帶半導(dǎo)體材料逐漸取代Si材料進(jìn)入了研究人員的視線中。SiC材料禁帶寬度大,飽和電子漂移速度高,熱導(dǎo)率高以及擊穿電場(chǎng)強(qiáng)度大,被廣泛應(yīng)用在高溫、高壓及抗輻射等領(lǐng)域中[1-5]。
近幾年,很多研究者都將研究焦點(diǎn)轉(zhuǎn)移到了對(duì)器件的導(dǎo)通壓降和擊穿電壓進(jìn)行折中,而對(duì)于器件關(guān)斷損耗的研究則相對(duì)較少[6-8]。目前主流的解決方法有3種:(1)合理設(shè)置器件的尺寸和參數(shù),例如N+緩沖層的厚度及摻雜濃度;(2)設(shè)計(jì)具有特殊作用的新型IGBT器件,例如在器件內(nèi)部引入載流子增強(qiáng)層、異質(zhì)結(jié)以及透明陽(yáng)極等[9-10];(3)盡可能開(kāi)發(fā)出新型的器件制造工藝,例如在NO氣氛中生長(zhǎng)柵氧化層等。
為了在不影響器件其他特性的前提下進(jìn)一步降低器件的關(guān)斷損耗,文中提出了一種在P基區(qū)中引入低壽命區(qū)同時(shí)集電極做成階梯型的LS-IGBT,通過(guò)控制注入到N-漂移區(qū)中的載流子數(shù)量來(lái)改善器件的電學(xué)特性。利用半導(dǎo)體器件仿真工具Silvaco Atlas對(duì)LS-IGBT進(jìn)行電學(xué)特性的模擬仿真,然后分析器件的擊穿電壓、導(dǎo)通壓降及關(guān)斷損耗相對(duì)于傳統(tǒng)結(jié)構(gòu)發(fā)生的變化。最終在維持擊穿電壓不變及不犧牲正向特性的前提下,獲得關(guān)斷損耗大幅減小的LS-IGBT結(jié)構(gòu)。
1 器件結(jié)構(gòu)及參數(shù)
1.1 器件結(jié)構(gòu)
圖1分別是傳統(tǒng)溝槽結(jié)構(gòu)(C-IGBT)和文中所提含低壽命區(qū)及階梯型集電極結(jié)構(gòu)(LS-IGBT)的半元胞二維橫截面示意圖。從圖中可以看出,所提結(jié)構(gòu)相對(duì)于傳統(tǒng)結(jié)構(gòu)改變的只是P基區(qū)中引入了低壽命區(qū),并且集電極電極做成了階梯形狀,除此之外,兩個(gè)器件的其余部分參數(shù)完全一致,相關(guān)結(jié)構(gòu)參數(shù)及摻雜參數(shù)如表1所示[11-12]。柵極側(cè)墻和底部氧化層的厚度分別為50 nm和100 nm。N-漂移區(qū)中的載流子壽命為1 μs,N+緩沖層中的載流子壽命為0.1 μs。新結(jié)構(gòu)中低壽命區(qū)域載流子壽命為1×10-10s,寬度為1.1 μm,P+集電區(qū)寬度為0.4 μm。

(a)

(b)圖1 器件橫截面示意圖(a)C-IGBT (b)LS-IGBTFigure 1. Schematic cross-sections of the device(a) C-IGBT(b) LS-IGBT

表1 器件結(jié)構(gòu)參數(shù)Table 1. Device structural parameters
由于此前沒(méi)有進(jìn)行過(guò)此結(jié)構(gòu)的流片及相關(guān)測(cè)試工作,所以為了說(shuō)明本文提出結(jié)構(gòu)的實(shí)驗(yàn)可行性,下面給出了實(shí)現(xiàn)該結(jié)構(gòu)的主要工藝步驟。具體工藝流程如下:(1)在N+襯底上依次生長(zhǎng)N+緩沖層、N-漂移區(qū)、CSL電流擴(kuò)展層、P-基區(qū);(2)使用中子輻射形成低壽命區(qū),同時(shí)進(jìn)行干法刻蝕形成柵極溝槽區(qū)域[13-14];接著使用高能離子注入形成P+源區(qū)、N+源區(qū)以及P+屏蔽層[15];(3)在干氧氣氛下生長(zhǎng)柵極氧化層,并填充摻雜的多晶硅以形成柵電極;(4)將器件翻轉(zhuǎn),移除N+襯底,使用高能離子注入依次形成P+集電區(qū)和N+緩沖層;(5)使用金屬進(jìn)行填充,依次形成發(fā)射極和集電極[16]。
因?yàn)镾iC材料硬度比較大,因此刻蝕難度較高,故可以使用SiO2作為掩膜,并利用含有SF6的感應(yīng)耦合等離子體(ICP)刻蝕方法進(jìn)行刻蝕。具體的刻蝕方案可以使用SF6/O2/Ar氣體的組合,其流量分別是4.2/8.4/28 sccm;壓強(qiáng)和溫度分別為0.4 Pa和80 ℃;ICP功率選取500 W,偏壓功率固定為15 W。在ICP刻蝕的過(guò)程中要時(shí)刻注意微型溝槽的形成,它可以引起電場(chǎng)集中效應(yīng),進(jìn)而降低器件的擊穿電壓。刻蝕結(jié)束后溝槽表面難免會(huì)顯得比較粗糙,可通過(guò)后續(xù)的高溫退火過(guò)程加以改善。
1.2 工作原理
LS-IGBT器件主要用于在基本不影響擊穿特性及導(dǎo)通特性的前提下進(jìn)一步降低關(guān)斷功率損耗。其主要原理是當(dāng)柵極電壓大于閾值電壓,且集電極施加一定的正電壓時(shí),N+源區(qū)中的電子就會(huì)經(jīng)由反型溝道注入到N-漂移區(qū),同時(shí)集電區(qū)也會(huì)有空穴注入到漂移區(qū),器件和傳統(tǒng)結(jié)構(gòu)處于導(dǎo)通模式。與傳統(tǒng)結(jié)構(gòu)不同的是,其集電區(qū)面積比較小,所以在同一個(gè)集電極偏置電壓下,集電區(qū)注入的空穴數(shù)量就會(huì)少于傳統(tǒng)結(jié)構(gòu)。但是由于其在P-基區(qū)中引入了低壽命區(qū),所以注入的空穴只有很小的一部分會(huì)經(jīng)由P-基區(qū)而到達(dá)P+源區(qū),最終經(jīng)過(guò)兩者的綜合作用,就會(huì)使得器件在不影響正向?qū)ㄌ匦缘那疤嵯聯(lián)碛辛己玫年P(guān)斷特性。
2 電學(xué)特性仿真與分析
本次模擬仿真使用Silvaco Atlas仿真軟件,數(shù)據(jù)分析使用Origin數(shù)據(jù)處理軟件。在仿真中物理模型及相關(guān)參數(shù)的選取均是基于前人的研究。經(jīng)過(guò)仿真的器件已經(jīng)經(jīng)過(guò)了流片驗(yàn)證[17-18],這些模型及參數(shù)被廣泛用于仿真其他類型的4H-SiC IGBT。仿真中所使用的模型參數(shù)列于表2。仿真中主要使用的物理模型包括能帶變窄模型(BGN)、平行電場(chǎng)依賴性模型(FLDMOB)、費(fèi)米模型(Fermi Model)、濃度依賴性遷移率模型(CONMOB)和復(fù)合模型(Schockley-Read-Hall、AUGER)等[19]。

表2 仿真模型參數(shù)Table 2. Simulation model parameters
2.1 擊穿特性
當(dāng)器件的柵極和源極接地,集電極施加正向偏壓時(shí),其工作于正向阻斷模式。當(dāng)集電極電壓達(dá)到15 kV時(shí),器件剛好達(dá)到它的雪崩擊穿電壓。擊穿時(shí)器件內(nèi)部的二維電場(chǎng)分布如圖2所示。從圖中可以看出,擊穿時(shí)傳統(tǒng)結(jié)構(gòu)和所提結(jié)構(gòu)的最大電場(chǎng)都出現(xiàn)在溝槽下方的屏蔽層拐角處,并且最大電場(chǎng)分別為2.96 MV·cm-1和3.03 MV·cm-1。因?yàn)?H-SiC材料的臨界擊穿電場(chǎng)是3 MV·cm-1,所以在此處依據(jù)器件內(nèi)部最大電場(chǎng)強(qiáng)度是否達(dá)到3 MV·cm-1來(lái)判斷器件是否發(fā)生了雪崩擊穿。

(a)
2.2 正向特性
圖3所示是傳統(tǒng)結(jié)構(gòu)和所提結(jié)構(gòu)的正向通態(tài)特性對(duì)比圖。從圖中可以看出,在集電極電流密度為100 A·cm-2時(shí),C-IGBT和LS-IGBT的導(dǎo)通壓降分別為10.88 V和9.98 V,新結(jié)構(gòu)的通態(tài)壓降相比于傳統(tǒng)結(jié)構(gòu)降低了8.3%。所提結(jié)構(gòu)雖然集電區(qū)的空穴注入面積相對(duì)較小,但是其內(nèi)部由于引入了低壽命區(qū),這就使得絕大部分注入到N-漂移區(qū)中的空穴都參與了電導(dǎo)調(diào)制效應(yīng),提升了空穴載流子的利用率,改進(jìn)結(jié)構(gòu)的正向特性不但沒(méi)有損失還有所提高。

圖3 C-IGBT和LS-IGBT的正向I-V特性曲線圖Figure 3. Forward I-V characteristic curves of C-IGBT and LS-IGBT
圖4所示是器件正常導(dǎo)通時(shí),位于X=1.45 μm處整個(gè)N-漂移區(qū)中的空穴濃度分布。從圖中可以明顯的看出,新結(jié)構(gòu)在集電極一側(cè)的空穴注入濃度小于傳統(tǒng)結(jié)構(gòu)。結(jié)合圖3所示器件擁有優(yōu)異的正向特性,這些結(jié)果證明了低壽命區(qū)在器件導(dǎo)通過(guò)程中所發(fā)揮的重要作用。

圖4 整個(gè)漂移區(qū)中的空穴濃度分布 Figure 4. Hole concentration distribution in the entire drift region
2.3 關(guān)斷特性
IGBT是基于電導(dǎo)調(diào)制效應(yīng)工作的雙極型器件,其正常導(dǎo)通時(shí)在N-漂移區(qū)中存儲(chǔ)了大量的少數(shù)載流子,這就使得原來(lái)?yè)诫s濃度較低、電阻較大的N-漂移區(qū)的通態(tài)電阻變的特別小,實(shí)現(xiàn)了較小的通態(tài)損耗。但是這對(duì)于器件的關(guān)斷過(guò)程來(lái)說(shuō)是非常不利的,存儲(chǔ)在漂移區(qū)中的少數(shù)載流子泄放需要一定的時(shí)間,會(huì)形成較大的拖尾電流,進(jìn)而產(chǎn)生不可忽略的關(guān)斷功率損耗。
因?yàn)槿粘I钪虚_(kāi)關(guān)器件的應(yīng)用電路通常比較復(fù)雜,所以根據(jù)其應(yīng)用范圍抽象出簡(jiǎn)單的關(guān)斷特性測(cè)試電路,測(cè)試電路如圖5所示。其中母線電壓Vbus設(shè)置為擊穿電壓的60%(9 000 V),柵極電阻的阻值為10 Ω,電流源的電流值為2.1×10-6A。同時(shí)選用頻率為5 kHz,占空比為50%且電壓變化范圍從-5 V到20 V的電壓源來(lái)控制器件的導(dǎo)通和關(guān)斷。電路中的二極管D可以視為理想元件,器件橫截面面積為0.021 cm2主要是為了使通過(guò)器件橫截面的電流密度為100 A·cm-2。

圖5 關(guān)斷特性測(cè)試電路圖Figure 5. Turn-off characteristic test circuit diagram
圖6所示是傳統(tǒng)結(jié)構(gòu)和所提結(jié)構(gòu)的關(guān)斷特性曲線圖。從圖中可以很明顯的看出,無(wú)論是關(guān)斷時(shí)電壓的上升速度還是電流的下降速度,新結(jié)構(gòu)都有明顯的優(yōu)勢(shì)。經(jīng)過(guò)數(shù)據(jù)分析可以得出,傳統(tǒng)結(jié)構(gòu)和所提結(jié)構(gòu)的關(guān)斷損耗分別為7.77 mJ和1.2 mJ,新結(jié)構(gòu)的關(guān)斷損耗提升了84.5%。
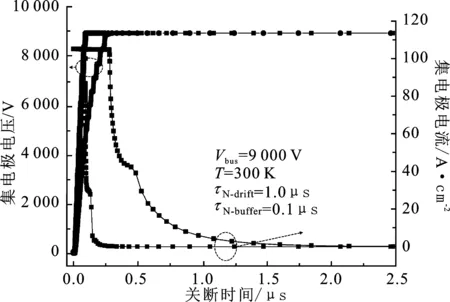
圖6 C-IGBT和LS-IGBT的關(guān)斷特性曲線Figure 6. Turn-off characteristic curves of C-IGBT and LS-IGBT
3 結(jié)束語(yǔ)
針對(duì)現(xiàn)有4H-SiC IGBT存在導(dǎo)通壓降和關(guān)斷損耗難以折中的問(wèn)題,本文提出了含有低壽命區(qū)及階梯型集電極的LS-IGBT結(jié)構(gòu)。在基本不影響器件其他電學(xué)特性的前提下,進(jìn)一步降低了器件的關(guān)斷損耗。當(dāng)器件處于正向?qū)üぷ髂J綍r(shí),其集電極一側(cè)雖然相對(duì)于傳統(tǒng)結(jié)構(gòu)注入的空穴數(shù)量較少,但是因?yàn)槠銹-基區(qū)中存在低壽命區(qū),就使得注入到N-漂移區(qū)中的空穴有很少的一部分可以通過(guò)P-基區(qū)到達(dá)P+源區(qū),從而可實(shí)現(xiàn)較低的通態(tài)壓降及關(guān)斷損耗。本文通過(guò)使用半導(dǎo)體器件仿真工具Silvaco Atlas對(duì)改進(jìn)結(jié)構(gòu)和傳統(tǒng)對(duì)照結(jié)構(gòu)進(jìn)行相關(guān)電學(xué)特性的對(duì)比仿真分析進(jìn)一步驗(yàn)證了設(shè)計(jì)思想。仿真結(jié)果顯示,在傳統(tǒng)結(jié)構(gòu)和改進(jìn)結(jié)構(gòu)擊穿電壓一致的前提下,改進(jìn)結(jié)構(gòu)的關(guān)斷損耗和導(dǎo)通壓降相對(duì)于傳統(tǒng)結(jié)構(gòu)分別提升了84.5%和8.3%。

