直接紋影成像技術初步研究
王 敏,謝愛民,黃訓銘
(1.四川大學電子信息學院, 成都 610064; 2.中國兵器裝備集團自動化研究所, 四川 綿陽 621000;3.中國空氣動力研究與發展中心, 四川 綿陽 621000)
在風洞試驗及其他流體波系分析等試驗中,均涉及到流場的顯示和測量問題[1]。在工程實際使用中,為了避免對流場的干擾,一般需要采用光學非接觸測量方式,如紋影技術、陰影技術和干涉技術3種[2]。在部分領域研究時,也有配合采用粒子圖像測速(PIV)的方式進行速度的融合測量。相對PIV而言,紋影技術進行流體結構顯示時不需要單獨的跟蹤物質;相對干涉技術和陰影技術而言,紋影技術更容易使用和通常情況下敏感度更高[3]。
傳統的紋影系統設計在19世紀得到了完善,并首次公開提出了聚焦紋影系統概念與設計方法[4]。直到19世紀末,紋影技術在風洞流場結構顯示中得到廣泛使用[3],隨后出現了利用反射式紋影系統對流場的速度和密度進行測量,并在后續的研究中逐漸發展了透射式紋影技術和聚焦紋影技術[3,5]。2013年,謝愛民等提出了激波風洞流場密度測量的聚焦紋影技術和圖像密度場處理技術[5,6]。隨后,在日本和歐洲也相繼開展了諸多紋影系統相關的設計和定量分析研究[7-9],與國內發展類似,逐步聚焦到了聚焦紋影系統的研究上。目前,紋影技術的多種方式在實際工作中同時存在并偶爾同時使用。但由于聚焦紋影技術可以獲取流場某個聚焦平面信息,從而更有利于對于流場波系的定量研究,逐漸成為了近年來甚至未來幾年的一個研究重點和熱點。本研究重點針對紋影法測量,尤其是聚焦紋影測量方法進行闡述,并給出當前的幾種最新技術概念和初步的試驗結果。
1 紋影法的基本原理
當一束光通過非均勻的流場或某透明介質時,會發生折射現象。這是由于非均勻介質中密度梯度的變化導致折射率的改變。對于空氣與其他氣體之間的關系有如下公式,設該氣體折射率為n,密度為ρ;則有:
n=kρ
(1)
其中,k≈0.23 cm3/g,為可見光的標準大氣環境下測量的Gladstone-Dale系數。式中可知n僅僅與氣體的密度有關系。而同時,根據氣體一般狀態方程:
(2)
式中:P為氣體的氣壓;R為氣體常數;T為絕對溫度值。因此可得知光經過流場發生的偏析本質上與所經過的氣體的氣壓和溫度有關。
針對式(1)給出了氣體介質中光線折射率與密度的關系,但同時需要認識到對于液體也有類似的關系,但不可沿用上面公式,這里只討論氣體狀態下的紋影方法。
非均勻氣體介質下,光線偏析的光程方程式[10]:
(3)

(4)
(5)
式中:εx表示光線通過流場后發生的(x,y)平面內x方向上發生的角度;εy表示光線通過流場后發生的(x,y)平面內y方向上發生的角度。
紋影法主要是通過測量光線的偏折角度來分析流場性質。其中,流場的折射率和流場梯度的變化均會對密度分析產生相應的影響。
2 幾種典型的紋影系統
2.1 透射式紋影系統
透射式紋影,也被稱為標準單點光源下的基本準直紋影系統,其光學原理如圖1所示[9]。

圖1 基本的透射式紋影系統示意圖
由圖1可以看出,其基本原理就是利用光線通過流場后偏折的積分效應,記錄流場圖像明暗變化,并通過刀口切割點光源的像來提高光線偏折的靈敏度。測量時,通常在成像面后放置一組透鏡,可以把流場圖像直接成像到相機靶面上。當光源為白光時,透射式紋影中的紋影透鏡需要組合透鏡以校正色差,紋影透鏡尺寸增大時其材料的選擇和制造難度都增大,成本也將成倍增加。因此,透射式紋影系統主要在小視場(小于Ф200 mm)的條件下使用;采用單色光源時,可在小于Ф500 mm的視場下應用。
2.2 反射式紋影系統
反射式紋影是為了提高測試視場大小而提出的另外一種紋影方案[11],其光學原理圖如圖2所示。

圖2 典型的反射式紋影系統示意圖
從圖2可以看出,光源發出的光束經過聚光鏡后可提高其在測試區域的照度,光束穿過狹縫后均勻照射到球面反射鏡表面,經反射后再平行經過測試區域,其余光路與透射式紋影方法相同。反射式紋影系統實現了較大測試區域的成像,降低了大口徑透鏡的制造難度和成本,但反射鏡口徑大于800 mm時其制造難度和成本同樣不可忽視。反射式紋影獲得的流場信息仍然是光束沿測試區域路徑引起的光線偏折的累積效果。另外,同透射式紋影相比,反射式采用了離軸方式,增加了系統像差,通常采用如圖2所示的“Z”型結構最大限度校正系統像差,即光源和成像物鏡分布在球面反射鏡不同側。
2.3 聚焦紋影系統
聚焦紋影技術的發展相對前兩種紋影要晚一些。圖3為典型的聚焦紋影系統結構,與上述兩種紋影的區別是:光路中使用了菲涅耳透鏡、源格柵和刀口柵。源格柵和刀口柵都是由明暗相間的條紋組成;刀口柵是源格柵的縮小像,但其明暗條紋剛好與源格柵的相反,因此刀口柵通常采用對源格柵進行照相復制的方法進行制造。

圖3 典型的聚焦紋影系統示意圖
在聚焦紋影系統中[12],通過聚焦透鏡,系統可以針對特定平面進行聚焦,在像面上獲取的信息主要反映該聚焦平面兩側為一個急劇聚焦區域內密度梯度積分信息,非急劇聚焦區域的信息被作為背景信息模糊掉,從而更能真實反映測試區域某一截面的流場結構。傳統紋影與聚焦紋影的擴展函數曲線如圖4所示[13],Z1和Z2為光束穿過的流場區域。

圖4 擴展函數示意圖
在圖4中,擴展函數主要反映的是不同區域密度梯度變化對紋影圖像灰度變化的影響程度。理想聚焦紋影獲得的流場信息主要反映圖4中虛線的區域,也就是聚焦紋影系統的急劇聚焦深度區域。但實際上聚焦紋影的擴展函數如圖4的拋物線,因此,聚焦紋影獲取的流場信息仍主要反映某個較窄的流場區域。上述反射式和透射式紋影因其積分效應特性,通常不能根據紋影圖像獲得流場密度定量值,而聚焦紋影具有的聚焦特性,可以根據聚焦紋影圖像開展流場密度定量測量。
基于提高成像分辨率及光束的收集效率的考慮,提出了使用場鏡的聚焦紋影系統[14],系統構成原理如圖5所示。光源(可以為寬光源)經過菲涅耳透鏡和源格柵后經過測試區、聚焦透鏡、刀口柵后再通過一個場鏡和透鏡進入CCD的靶面上,完成對流場區域成像。
從圖3和圖5的聚焦紋影系統光路核心在于提出了源格柵和刀口柵,并采用菲涅耳透鏡來實現對光源擴束后的均勻化和照度增強。源格柵通常尺寸比測試區域要大,實際上通過測試區域的光束為大尺寸源格柵形成的寬光源產生的光束,因此通過聚焦透鏡對測試區域成像時景深會比較小。如普通照相一樣,當景深較小時未對焦的區域模糊化并作為均勻背景,因而聚焦紋影系統中就形成了急劇聚焦深度。同時,由原理圖可以得知整套系統可以使用小口徑的聚焦透鏡來對大的測試區域流場進行測試,并可以獲得相對高的分辨率和靈敏度。其設計較常規紋影系統相比也更復雜,但針對相同大小區域進行測量時其總成本和制造難度會更低,且可以獲得更小厚度的測試區域的流場分布顯示。
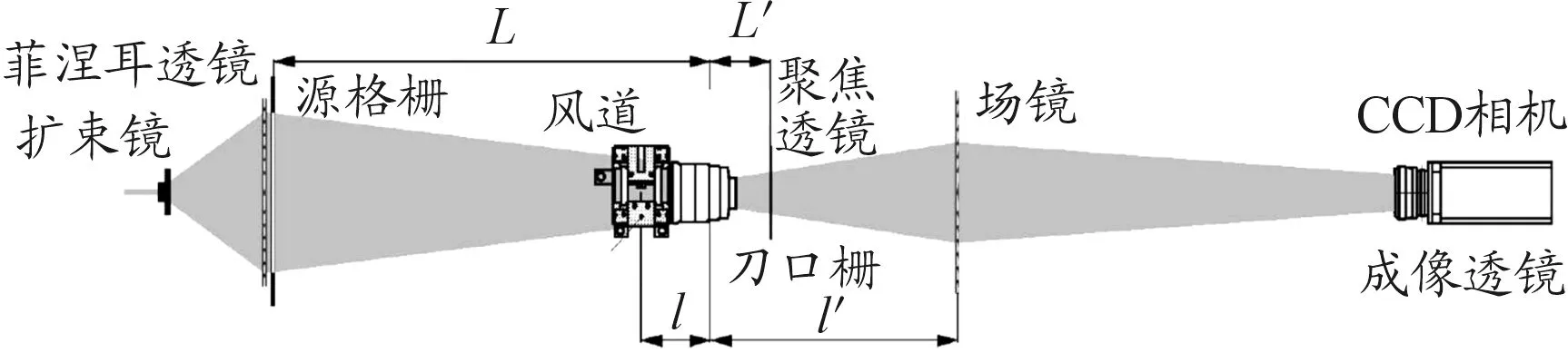
圖5 使用場鏡的聚焦紋影系統示意圖
聚焦紋影系統中主要關鍵參數的公式如下:
1) 分辨率w[12]:
w=2(l′-L′)λ/mb
(6)
其中:λ為光源的波長,m為像空間光路的放大系數,為刀口柵亮條紋寬度。
2) 急劇聚焦深度DS[12]:
DS=4λl2×(l′-L′)/Al′b
(7)
其中,A為聚焦透鏡的通光口徑。
(8)
其中,a為刀口柵的切割余下的光源像寬度,其他定義如圖3所示。
聚焦紋影系統可以實現對于某個聚焦面的波系結構進行顯示,并通過系統參數的配置實現測量平面(有一定厚度)的移動和總體參數的調節[15]。另外,為了實現同時測量多個流場區域的界面,可通過光路分光和參數配置優化可實現多截面的聚焦紋影系統[15]。
盡管聚焦紋影系統中可以使用成本相對便宜的菲涅耳透鏡,但因目前國內菲涅耳制造水平的限制,菲涅耳透鏡直徑很難超過2 000 mm,這也制約著使用菲涅耳透鏡開展大視場聚焦紋影技術的研究。
3 基于光源拼接的聚焦紋影成像技術
隨著風洞實驗等技術的發展,測試模型不斷增大,迫切需要開展大視場流場顯示技術,如前所述,常規紋影受光學元件(透鏡或球面反射鏡)尺寸的限制,聚焦紋影系統中受菲涅耳透鏡尺寸的限制,對于視場大于2 m的紋影系統在工程制造上都顯得比較困難,而基于光源拼接的聚焦紋影技術將有望實現視場大于2 m[16]。
3.1 基于LED光源拼接的大視場聚焦紋影
為了滿足某工程項目中視場大于2 m的紋影系統,提出了一種基于光源拼接的大視場聚焦紋影技術[16]。該技術仍然采用成熟的聚焦紋影系統的基本原理,但如果使用大尺寸菲涅耳透鏡,其尺寸將達到4 m×2 m,目前國內菲涅耳透鏡制造工藝難以滿足如此大尺寸菲涅耳透鏡要求。根據聚焦紋影成像原理,提出了采用大型陣列LED光源來替代菲涅耳透鏡,通過陣列LED光源產生錐形光束通過測試區域。因為LED陣列可根據需要不斷拓展,因而可以解決大視場聚焦紋影系統中測試區域的照明問題。并通過直接照明的原理進行了驗證實驗[16]。實驗結果表明,采用LED直接照明,可以獲得靈敏度較高、成像光斑較均勻的流場紋影效果,但需要適當提高LED光源的功率從而提高像面的明暗度。根據使用設備的需要,設計的大尺寸紋影系統的光學系統總體原理如圖6所示,其測試視場w2將達到3 m×1.5 m,拼接的光源尺寸w1達到4 m×2 m;源格柵尺寸同光源尺寸一樣,也采用拼接方式實現。

圖6 大視場聚焦紋影系統示意圖
從圖6可以看出,聚焦透鏡口徑并不大,但LED陣列光源、柔光屏和源格柵尺寸很大,其中在一定程度上柔光屏可以取消掉,因為現有LED照明的設計可以實現非常高的均勻照度,同時可以減少照度的損失,提高測試區域和到達透鏡位置的照度。在工程實施中,大尺寸源格柵同LED光源集成一體來實現,并需要充分考慮LED光源的散熱、控制、集成和維護等難點。
3.2 基于LED光源拼接的直接紋影成像技術
根據聚焦紋影成像原理,如果直接把陣列LED光源作為源格柵,即把圖6的柔光屏和源格柵取消,直接用刀口柵切割光源像,也能夠實現聚焦紋影效果,整個系統將變得更加簡單。
圖7為100顆LED綠光源按照10個×10個方式布置為300 mm×300 mm的陣列光源,每顆光源功率最大1W。按照參考文獻[16],考慮中間位置的光源對測試區域貢獻較大,基于測試區域光束均勻性的考慮,中間位置的LED光源布置要稀疏一些。光源通過聚焦透鏡后,相應地形成了陣列LED光源像,如圖8所示。
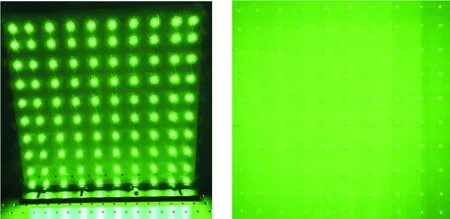
圖7 拼接的陣列LED光源像 圖8 LED光源像
根據光源像的特點,采用多根金屬條切取光源像,如圖9所示,并期望在成像面上獲得紋影圖像,但最終發現因為光源間距過大,成像面上的光束很不均勻,如圖10所示。

圖9 刀口柵切割光源像 圖10 成像面的蠟燭火焰
如果把蠟燭放置距離LED更遠位置時,成像光斑會更加均勻,但此時成像屏的光束較弱。在此原理裝置中,為解決此問題,在陣列光源前面放置重新設計明暗條紋較密的源格柵[16],源格柵明暗條紋間距為1 mm,并設計相應的刀口柵。再對蠟燭火焰流場進行顯示時獲得了較好的紋影效果,如圖11所示。可以看出,整個測試區域圖像背景光斑均勻,蠟燭火焰紋影圖像中的氣流擾動特征明顯。
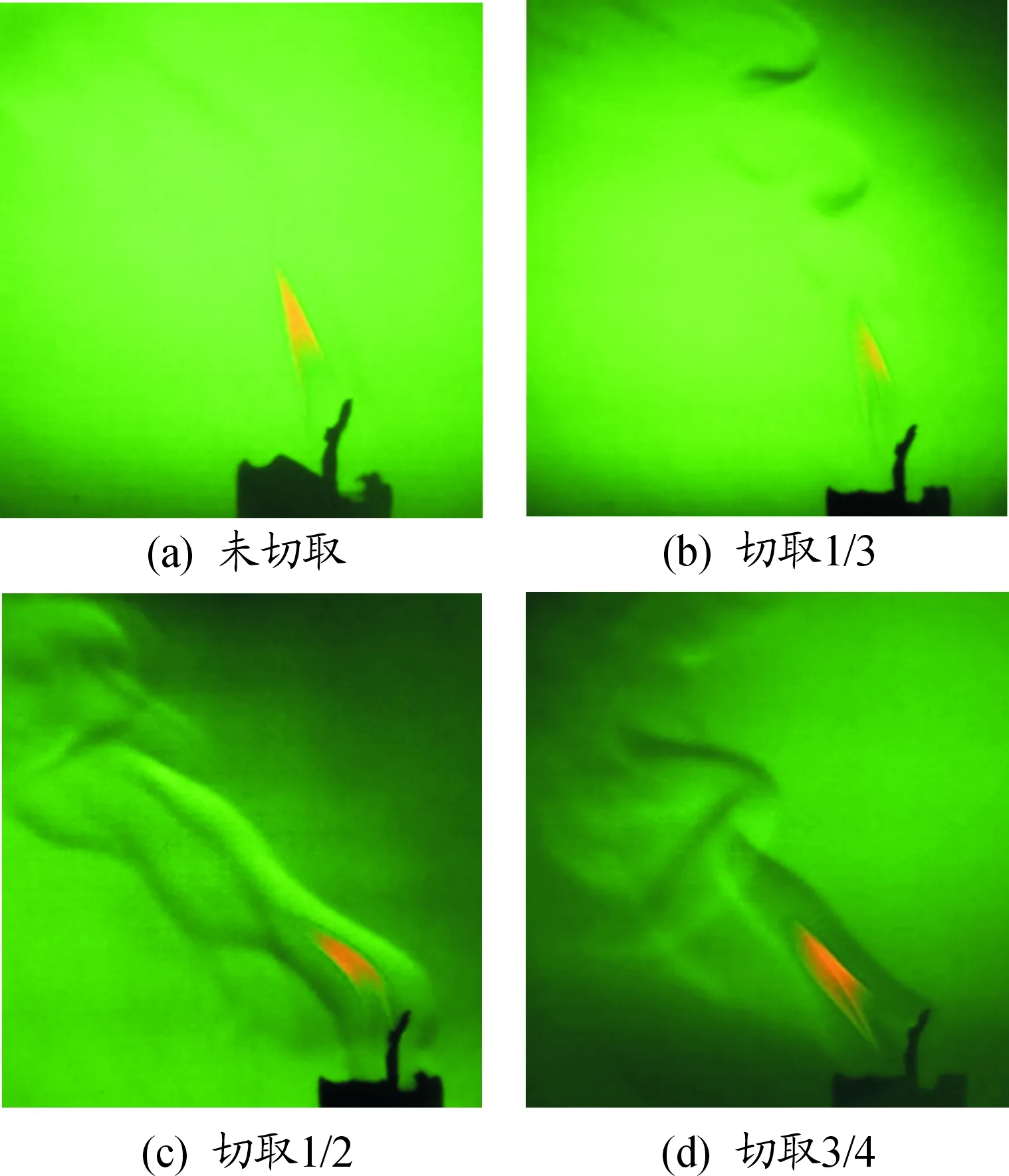
圖11 不同程度切取光源像時的流場圖像
從上述原理裝置的驗證效果可以看出,如果把LED光源按照源格柵的尺寸(即間距1 mm)進行布置,同樣可以獲得圖11所示的紋影效果,這種方式則可實現較大視場的聚焦紋影成像。從原理裝置表明,因為LED光束的發散性,照射到聚焦透鏡的光束較少,光束的利用率較低,而使用成像屏時進一步降低了光束的利用效率及成像分辨率。因此,則需按照圖5中使用場鏡方式提高光束的收集效率,但聚焦紋影系統中場鏡的口徑比紋影圖像尺寸還要大,使用玻璃加工的場鏡成本會非常高,為此提出了使用菲涅耳透鏡和小口徑玻璃透鏡相結合的方式實現場鏡功能。如圖12所示,在場鏡前端使用大尺寸菲涅耳透鏡,在后端使用小口徑玻璃制造的透鏡。該技術將在下一步研究中進行實驗驗證。

圖12 菲涅耳透鏡與光學玻璃透鏡方式組合的場鏡示意圖
4 結論
三種紋影技術可根據實際需求、利用各種紋影的優點開展相應的流場顯示工作,如需要較小視場和使用單色光源時可以使用簡單的透射式紋影結構。
某風洞建設中,根據目前的研究基礎正在開展基于光源拼接的方式實現視場1.5 m的聚焦紋影系統研制,取得了較好的實驗效果。

