氮化鎵晶片的化學(xué)機(jī)械拋光工藝
鈕市偉, 陳 瑤, 王永光, 寇青明, 朱玉廣
(蘇州大學(xué)機(jī)電工程學(xué)院,蘇州 215000)
氮化鎵(GaN) 材料是繼第一代Ge、Si半導(dǎo)體材料和第二代GaAs、InP化合物半導(dǎo)體材料之后的第三代新型半導(dǎo)體電子材料,具有大的寬能帶隙,高的電子飽和遷移率,低的介電常數(shù),良好的化學(xué)穩(wěn)定性和良好的光學(xué)性能[1-3],GaN晶片在電力電子器件、微電子器件及光電子器件等領(lǐng)域應(yīng)用時(shí),對(duì)表面加工質(zhì)量的要求非常高,GaN的晶格完整性和平整度依賴于晶片的表面加工質(zhì)量[4-6],因此,通過對(duì)GaN材料表面平坦化,以改善GaN基器件的性能。化學(xué)機(jī)械拋光(CMP)是唯一能夠有效實(shí)現(xiàn)GaN材料全局平坦化的精密表面處理技術(shù)[7-8],并在光電子學(xué)和高功率半導(dǎo)體器件領(lǐng)域有著廣泛的應(yīng)用[9-10]。Asghar等[11]利用0.3 mol/L的KMnO4,采用含有磨料Al2O3和SiO2的拋光液對(duì)GaN晶體進(jìn)行拋光時(shí),結(jié)果表明,當(dāng)以Al2O3、SiO2作磨料時(shí),GaN的材料去除速率分別為85 nm/h和39 nm/h;表面粗糙度分別為0.13 nm和0.07 nm。Aida等[12]采用機(jī)械拋光對(duì)GaN晶片進(jìn)行研究,證明了含SiO2磨粒的拋光液可以有效去除表面劃痕等損傷,以獲得高質(zhì)量GaN晶片表面。Murata等[13]利用鐵與H2O2溶液發(fā)生芬頓反應(yīng)后的溶液作為拋光液,然后再對(duì)GaN晶體化學(xué)刻蝕。可以看出,目前氮化鎵平坦化技術(shù)仍然存在諸多問題,例如:低的去除率和不穩(wěn)定的表面質(zhì)量,導(dǎo)致高加工成本以及低實(shí)際生產(chǎn)效率。上述研究表明:利用氧化輔助CMP方法能夠提升GaN拋光中晶體表面Ga2O3的轉(zhuǎn)化效率,從而提高材料去除速率。因此,利用過氧化氫的強(qiáng)氧化性提高GaN晶體表面Ga2O3的轉(zhuǎn)化效率,通過對(duì)工藝參數(shù)的優(yōu)化研究,探索其材料去除基本規(guī)律。
基于此,通過對(duì)單晶 GaN 晶片的 CMP 加工技術(shù)的深入研究分析,針對(duì)氮化鎵化學(xué)機(jī)械拋光中存在的問題,借助于原子力顯微鏡(AFM)等分析儀器和納米粒子的化學(xué)機(jī)械拋光(CMP)方法,通過設(shè)計(jì)單因素實(shí)驗(yàn),研究了不同工藝參數(shù)對(duì)GaN晶片CMP的影響,然后通過正交實(shí)驗(yàn)獲得一組較佳的GaN晶片CMP工藝參數(shù)。
1 實(shí)驗(yàn)
1.1 實(shí)驗(yàn)材料
實(shí)驗(yàn)樣品采用蘇州納維科技有限公司生產(chǎn)的型號(hào)為GaN-T-N、直徑為50.8 mm的原始GaN晶片。拋光試驗(yàn)所用試樣尺寸為10 mm×10.5 mm×0.445 mm,如圖1所示。
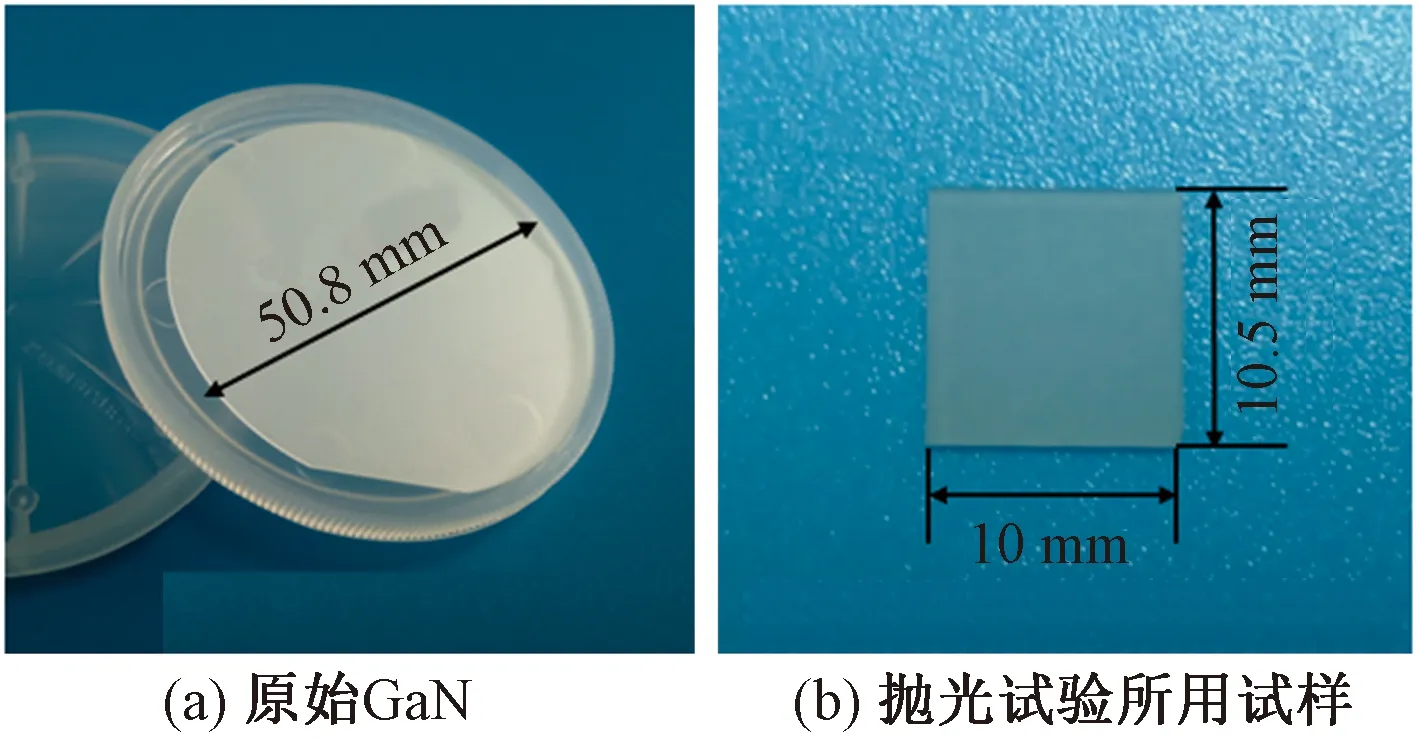
圖1 實(shí)驗(yàn)所用GaN晶片F(xiàn)ig.1 The GaN used in experiment
1.2 拋光液配制
拋光液的配制:量取一定量的硅溶膠,在磁力攪拌的作用下將其緩慢加至去離子水中,得到二氧化硅懸浮液,再向懸浮液中依次加入一定量的H2O2、甘氨酸和對(duì)苯二甲酸(PTA),同時(shí)超聲攪拌至完全溶解,最后,拋光液的 pH由有機(jī)堿及檸檬酸調(diào)節(jié)。
1.3 試驗(yàn)條件
GaN晶片CMP實(shí)驗(yàn)采用沈陽科晶設(shè)備有限公司生產(chǎn)的UNIPOL-1200S自動(dòng)壓力研磨拋光機(jī),晶片通過雙面膠粘在專用精密夾具圓盤上,拋光墊選用聚氨酯拋光墊(IC-1000),試驗(yàn)過程中,拋光頭的速度設(shè)定為80 r/min,拋光液的流速為20 mL/min,拋光時(shí)間為15 min。拋光后,樣品用去膠清洗劑清洗,并采用無水乙醇和去離子水超聲清10~15 min。然后通過氮?dú)飧稍飿悠酚糜诜Q重和表面質(zhì)量檢測(cè)。試驗(yàn)方案如表1所示。在實(shí)驗(yàn)過程中,用磁力攪拌器連續(xù)攪拌拋光液,使拋光液中的顆粒均勻分散,用蠕動(dòng)泵精確控制拋光液的流速。

表1 CMP 試驗(yàn)方案Table 1 Experiment program of CMP
通過精度為0.000 01 g、型號(hào)為ST-E120B II的超精密電子天平測(cè)量拋光前后GaN晶片的質(zhì)量。以nm/h為單位計(jì)算GaN晶片的材料去除率(MRR),公式如下:

(1)
式(1)中,m1為GaN晶片拋光前的質(zhì)量;m2為GaN晶片拋光后的質(zhì)量;ρ為GaN晶片的密度,其值為6.15 g/cm3;s為GaN晶片的面積,其值為1.05 cm2;t為拋光時(shí)間,其值為15 min。
采用原子力顯微鏡(AFM)測(cè)量和分析拋光后GaN晶片表面質(zhì)量。
1.4 單因素拋光實(shí)驗(yàn)
為探究拋光工藝參數(shù)對(duì)GaN晶片的材料去除速率和表面粗糙度的影響,選擇了下壓力、拋光盤轉(zhuǎn)速以及氧化劑濃度等幾個(gè)因素進(jìn)行單因素實(shí)驗(yàn),在保證其他拋光參數(shù)不變的情況下,將下壓力分別設(shè)為4.69×104、9.38×104、14.1×104、18.8×104、23.5×104Pa,拋光盤轉(zhuǎn)速分別設(shè)為50、75、100、125、150 r/min,氧化劑濃度分別設(shè)為0.2%、0.4%、0.6%、0.8%、1.0%。
1.5 正交實(shí)驗(yàn)
CMP是化學(xué)反應(yīng)成膜與機(jī)械作用除膜的重復(fù)交替進(jìn)行的過程。各種因素的相互作用不能忽略。基于單因素實(shí)驗(yàn),需要通過正交試驗(yàn)確定GaN晶片的CMP的最佳組合。GaN材料是一種硬度高和化學(xué)惰性強(qiáng)的半導(dǎo)體材料,影響GaN應(yīng)用的主要因素是加工效率和表面質(zhì)量。因此,正交試驗(yàn)的目的是獲得高材料去除率和低表面粗糙度。尋求較優(yōu)的拋光工藝參數(shù),進(jìn)而獲得滿足GaN材料應(yīng)用的表面。為避免實(shí)驗(yàn)次數(shù)過多,并根據(jù)單因素實(shí)驗(yàn)分析,選定拋光壓力、拋光盤轉(zhuǎn)速以及氧化劑濃度三個(gè)拋光工藝因素,每個(gè)因素選取三個(gè)水平,正交實(shí)驗(yàn)因素和水平如表2所示。

表2 GaN晶片CMP正交實(shí)驗(yàn)水平表Table 2 The orthogonal experiment chart in CMP of GaN
2 結(jié)果與討論
2.1 下壓力對(duì)GaN化學(xué)機(jī)械拋光的影響
下壓力對(duì)材料去除率和粗糙度的影響如圖2所示。當(dāng)下壓力為4.69×104~23.5×104Pa時(shí),GaN晶片材料去除率隨下壓力的增加而顯著增加。但當(dāng)下壓力超過14.1×104Pa時(shí),GaN表面粗糙度顯著增加,結(jié)果表明,下壓力過大影響CMP的機(jī)械和化學(xué)作用之間的平衡,過度的機(jī)械作用會(huì)導(dǎo)致GaN的表面損傷。當(dāng)拋光壓力為14.1×104Pa時(shí),材料去除率達(dá)到96.66 nm/h,且粗糙度較低,表面質(zhì)量較好。因而,在GaN CMP過程中,應(yīng)選擇適中的下壓力。

圖2 下壓力對(duì)GaN材料去除率和粗糙度的影響Fig.2 Effect of downforce on removal rate and roughness of GaN materials
2.2 拋光盤轉(zhuǎn)速對(duì)GaN化學(xué)機(jī)械拋光的影響
拋光盤轉(zhuǎn)速對(duì)材料去除率和粗糙度的影響如圖3所示。由圖3可知,拋光盤轉(zhuǎn)速在50~150 r/min時(shí),隨著轉(zhuǎn)速的增加,GaN材料的去除率增加。隨著轉(zhuǎn)速的增加,GaN、磨粒和拋光墊之間的相互作用頻率增加,GaN表面的機(jī)械作用增加,單位時(shí)間的材料去除率也增加;新的拋光液以更高的速度進(jìn)入拋光墊和GaN表面。同時(shí),拋光液可以及時(shí)帶出拋光產(chǎn)物,去除率隨之提高。當(dāng)轉(zhuǎn)速增加至100 r/min時(shí),材料去除率達(dá)到 88.31 nm/h,表面粗糙度降低至0.59 nm。但是,離心力隨著轉(zhuǎn)速上升而變大,使得拋光墊上的拋光液分布不夠均勻,并且不能充分利用拋光液。當(dāng)轉(zhuǎn)速達(dá)到150 r/min 時(shí),材料去除率僅從88.31 nm/h增到 91.3 nm/h,同時(shí)表面粗糙度也隨之增大。因此,GaN CMP拋光盤轉(zhuǎn)速的最佳值為100 r/min。

圖3 拋光盤轉(zhuǎn)速對(duì)GaN材料去除率和粗糙度的影響Fig.3 Effect of polishing pad rotating speed on material removal rate and roughness of GaN materials
2.3 H2O2濃度對(duì)GaN化學(xué)機(jī)械拋光的影響
H2O2濃度對(duì)GaN材料去除率和粗糙度的影響如圖4所示。當(dāng)H2O2濃度為0.2%~0.8% 時(shí),隨著H2O2濃度的增加,GaN材料去除率增加,當(dāng)H2O2濃度達(dá)0.8%時(shí),材料去除率達(dá)到峰值83.96 nm/h,粗糙度達(dá)最低0.442 nm;H2O2濃度超過0.8%時(shí),材料去除率有所下降,粗糙度也顯著增加,說明過低或過高的H2O2濃度打破了CMP機(jī)械作用與化學(xué)作用之間的平衡,H2O2濃度低,CMP機(jī)械作用大于化學(xué)作用,GaN表面存在劃痕等損傷層;H2O2濃度高,CMP化學(xué)作用大于機(jī)械作用,表面覆蓋氧化層,存在腐蝕坑,導(dǎo)致GaN表面質(zhì)量都變差,粗糙度隨之變大。因而,在GaN CMP過程中,應(yīng)選擇適宜的H2O2濃度。

圖4 H2O2濃度對(duì)GaN材料去除率和表面粗糙度的影響Fig.4 Effect of H2O2 concentration on material removal rate and roughness
2.4 正交試驗(yàn)結(jié)果分析
GaN晶片CMP的正交實(shí)驗(yàn)方案如表3所示。

表3 正交試驗(yàn)方案Table 3 The interactive orthogonal experimental program
通過極差法計(jì)算GaN晶片的CMP材料去除率,如表4所示。其中,Kmn表示在第n(n=A,B,C)列因子的m(m=1,2,3)水平下實(shí)驗(yàn)材料的去除率的總和;kmn表示實(shí)驗(yàn)材料在第n列因子的m水平上的平均材料去除率;Rn表示第n列因子的極差值水平,極差值越大,反映出該因子影響程度越大。

表4 極差分析數(shù)據(jù)計(jì)算表Table 4 Calculated data for range analysis
從表4可以看出,在上述試驗(yàn)因素中,對(duì)GaN晶片CMP材料去除率影響程度從高到低依次為:下壓力(A)、H2O2濃度(C)、拋光盤轉(zhuǎn)速(B)。
由正交試驗(yàn)結(jié)果確定優(yōu)化方案,以材料去除率為試驗(yàn)指標(biāo),指標(biāo)越大越好。綜合上述極差分析結(jié)果,GaN晶片CMP的最佳工藝組合為 A2B1C2,即下壓力為14.1×104Pa,H2O2濃度為0.8%,拋光盤轉(zhuǎn)速為75 r/min。材料去除率最大為103.98 nm/h,表面粗糙度最低為0.334 nm,樣品表面如圖5所示。

圖5 正交實(shí)驗(yàn)方案6拋光后GaN晶體表面AFM圖Fig.5 AFM images of GaN surface after CMP in orthogonal experiment 6
根據(jù)因素水平的變化對(duì)實(shí)驗(yàn)結(jié)果平均kn的影響,可做因素-效果趨勢(shì)圖如圖6所示。可知,下壓力對(duì)實(shí)驗(yàn)結(jié)果影響最大,當(dāng)下壓力14.1×104Pa時(shí),GaN晶片的材料去除率最大;H2O2濃度影響次之,拋光盤轉(zhuǎn)速影響最低,轉(zhuǎn)速從75 r/min增加至125 r/min,材料的去除率基本保持不變。
由圖6可知,因素A和因素C的k1、k2、k3變化較顯著,說明下壓力對(duì)GaN晶片CMP去除率的影響最大,H2O2濃度其次;因素 B 的k1、k2、k3變化不顯著,說明拋光盤轉(zhuǎn)速的大小對(duì)GaN晶片CMP去除率的影響相對(duì)較小。

圖6 因素-效果趨勢(shì)圖Fig.6 Factors-effects trend
3 結(jié)論
研究了利用CMP對(duì)GaN 晶體進(jìn)行拋光,在大量的實(shí)驗(yàn)基礎(chǔ)上可以得出以下結(jié)論。
(1)下壓力、拋光盤轉(zhuǎn)速和氧化劑濃度都會(huì)對(duì)GaN晶體表面質(zhì)量有重要的影響,其中,下壓力對(duì)材料去除率的影響最大,拋光盤轉(zhuǎn)速次之,H2O2濃度最小。
(2)文章采用自制的納米SiO2拋光液能改善晶體表面質(zhì)量,同時(shí)可以提高晶體的加工效率,并且對(duì)環(huán)境無污染、對(duì)人體無害。試驗(yàn)表明:在下壓力為14.1×104Pa、轉(zhuǎn)速為75 r/min、H2O2濃度為0.8%的條件下,GaN晶片的材料去除率達(dá)最快,達(dá)到103.98 nm/h,表面粗糙度低至0.334 nm。晶片表面未有機(jī)械損傷,滿足應(yīng)用要求,對(duì)今后GaN晶體的研究具有重要的意義。

