硒摻雜鍺碲相變存儲材料的第一性原理研究
方治乾, 繆奶華,2, 周健,2,*
(1. 北京航空航天大學 材料科學與工程學院, 北京 100083;2. 北京航空航天大學 國際交叉科學研究院 集成計算材料工程中心, 北京 100083)
硫系化合物半導體長期以來被用作光學信息存儲介質,如DVD-RW和DVD-RAM等[1]。近年來,其也被廣泛研究用于最有前景的下一代非易失性電子信息存儲器,相變存儲器(Phase Change Memories, PCM)[2-3]。相變存儲器利用相變存儲材料在低電導、低反射率的非晶態與高電導、高反射率的晶態之間快速相變的特性來實現信息存儲。常用的相變存儲材料主要集中于GeTe-Sb2Te3偽二相線上,包括位于兩端的母體材料GeTe、Sb2Te3以及三元的Ge1Sb2Te4、Ge1Sb4Te7和Ge2Te2Sb5等[4-6]。其中,GeTe是一種性能優異的相變存儲材料[7-8]。相較于Ge2Sb2Te5(GST),GeTe具有較高的再結晶溫度(189℃)和較高的熔點(700℃)[9],其數據能在105℃左右長期保持,可用于較高溫度下的信息存儲。然而,隨著現代科技的進一步發展,汽車電子和航空航天領域對信息存儲提出了更高的挑戰。汽車電子領域要求存儲器工作溫度在120℃左右,而航空航天領域則要求其能在150℃下工作10年。GeTe材料已無法滿足這些行業的需求。亟需對GeTe相變存儲材料進行性能改進,以滿足信息存儲領域日益提升的高溫應用要求。
元素摻雜是一種有效的半導體改性方式。科研人員對此進行了研究,實驗表明Se摻雜GeTe相變存儲材料具有更優異的性質。Vinod等制備了不同Se摻雜量的(GeTe)1-xSex薄膜,指出Se摻雜能大幅提高GeTe的再結晶溫度,增強其數據保持力[10];Se摻雜同時能提高GeTe非晶的光學帶隙,10%的Se摻雜可大幅提高GeTe的非晶電阻,使晶相與非晶相的電阻差異增加2個數量級[11]。由于GeTe中可以存在高達8%~10%的本征Ge空位[12-13],Vinod和Sangunni推測摻入的Se原子可能占據Ge空位的位置,從而抑制了GeTe的結晶[11]。然而,這些實驗研究主要針對Se摻雜后的物相組成、電學性質、光學性質和熱動態性質等。Se摻雜對于體系的原子構型、成鍵情況等微觀性質的影響以及性能增強的作用機制尚不明晰。這些微觀性質需要通過第一性原理計算模擬來進一步理解,從而更好地為未來實驗提供理論指導。此外,與GeTe同系列的Ge2Te2Sb5的Se摻雜實驗表明,當GST1-xSex中Se含量x超過10%時,出現了奇特的相轉變性質:摻雜后的GST材料在受熱時直接由無定型態結晶為穩態六方,而跳過中間的亞穩面心立方相(face-centered cubic, fcc)[14]。而Wang等進行了Sb2Se摻雜Ge2Sb2Te5的研究,指出當Se原子含量超過9%時,亞穩面心立方相轉變為穩定六方相的過程被抑制[15]。Se摻雜PCM對相轉變過程的影響較大。對硫系化合物相變存儲材料的Se摻雜進行計算研究,也可以為解釋相變存儲材料晶相演變機制提供線索。
本文采用第一性原理計算方法,對Se摻雜完美GeTe和含本征Ge空位的GeTe的幾何構型、成鍵情況和電子性質進行了研究。結果表明,對于完美GeTe,Se優先取代Te原子。而對于存在本征Ge空位的GeTe晶體,Se摻雜原子不會占據Ge空位,而傾向于取代Ge空位最近鄰Te原子。Se原子與Ge空位的相互吸引,形成了較強的Ge—Se鍵,抑制了GeTe相變存儲材料的結晶,從而提高了其數據保持能力和服役溫度。Se原子與本征Ge空位最近鄰時,使兩相的電子局域函數(Electron Localization Function,ELF)分布和體積更加接近,可能是導致奇特相轉變性質的重要原因。
1 計算方法
本文計算基于維也納大學開發的從頭算模擬軟件包(Vienna Ab-initio Simulation Package,VASP)[16]。體系采用了Ge(4s24p2)、Te(5s25p4)的標準PAW贗勢。與先前的GeTe計算一致,本文使用了廣義梯度近似GGA-PBE[17-19]來描述交換關聯泛函。截斷能設置為350 eV,k點設置為3×3×3的Gamma中心k點網格。截斷能和k點的設置都進行了收斂性測試。自洽計算的收斂判據設置為電子步能量差小于10-5eV,而結構弛豫收斂判據則為每個原子上的殘余應力均小于0.1 eV/nm。
GeTe包含2個晶相,分別為穩態菱方相(rhombohedral)和高溫亞穩面心立方相[20]。信息存儲主要通過GeTe非晶態和穩態菱方相之間的快速轉變來實現[21]。因此,本文主要研究Se摻雜對于菱方相的影響,并與Se摻雜的面心立方相進行了類比分析。GeTe菱方相是一種扭曲的氯化鈉結構,可以看做由GeTe面心立方相中Ge原子亞結構和Te原子亞結構沿[111]方向錯動一定距離形成的[22]。這種結構變形屬于派爾斯變形(Peierls distortion)[23]。GeTe菱方相中形成了交替的3個Ge—Te長鍵和3個Ge—Te短鍵。從[111]方向觀察,GeTe也可以被當做層狀結構;其中,由Ge—Te短鍵連接的原子可視為處在同一層。基于GeTe菱方結構的慣用胞,構建了2×2×2的超胞,包含64個原子,結構如圖1(a)所示。對GeTe面心立方相,同樣采用了2×2×2的超胞,如圖1(b)所示。所有構型均進行了結構弛豫。計算優化得到的單胞晶格數據如表1所示。對于無缺陷的菱方相和面心立方相,計算得到晶格常數和晶胞角度分別為a0=0.6086nm,α=88.14°和a0=0.601 9nm,α=90°與實驗測量值及前人的計算值吻合[20,24]。由于GeTe中存在大量的本征Ge空位,在摻雜分析中必須考慮Ge空位的影響。對于存在本征Ge空位的GeTe體系的Se摻雜計算,分別構造了Ge31Te32(共63個原子)的菱方結構和面心立方結構,并對所有構型均進行了結構優化。
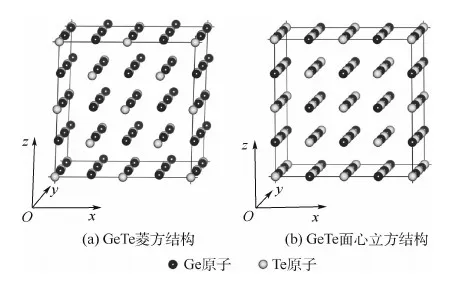
圖1 GeTe晶體結構Fig.1 Crystalline structure of GeTe

結 構a0/nmα/(°)V/nm3Eg/eV菱方相GeTe0.608688.140.225050.62菱方相Ge32Te31Se10.608387.940.224620.58菱方相Ge31Te31Se10.605887.770.221880.58菱方相Ge31Te320.606287.820.222340.59菱方相Ge31Se1Te320.608488.120.22486—面心立方相GeTe0.6019900.218080.38面心立方相Ge32Te31Se10.6003900.216340.40面心立方相Ge31Te31Se10.6024900.218520.52面心立方相Ge31Te320.5994900.215370.31面心立方相Ge31Se1Te320.6010900.21704—
注:晶格常數a0、晶胞角度α、慣用胞體積V以及帶隙Eg。
摻雜形成能的計算式[25-26]為
(1)
式中:Efinal和Einitio分別為末態體系和初始體系的總能;μi為第i種原子的化學勢,通常是其最穩定單質中單個原子的能量;Ni為缺陷形成后與形成前第i種原子的數量差。
本文考慮了缺陷生長環境對于摻雜形成能的影響。當Se取代Te時,在富Te情況下,被取代的Te原子視為與體相Te單質中的一個Te原子結合;而富Ge情況下,被取代的Te原子則視為與體相Ge單質中的一個Ge原子結合,重新形成新的Ge—Te單元。故而在富Te情況下,Te原子化學勢即為Te體相單質中單個原子的能量,而Ge原子化學勢則為μGe=μGeTe-μTe。其中μGeTe為GeTe晶相中Ge、Te原子對的能量,μTe為Te原子化學勢。反之,在富Ge情況下,Ge原子化學勢為Ge體相單質中單個原子能量,而Te原子化學勢為μTe=μGeTe-μGe。
2 結果與討論
2.1 GeTe完美晶體的Se摻雜
本節研究了Se摻雜GeTe完美晶體。當摻雜Se原子時,可能的占位情況有:取代Ge原子、取代Te原子或占據間隙位置。由于Se間隙原子造成較大的晶格畸變,具有較高形成能,故不作比較。計算得到不同取代位置的形成能Ef如表2所示。
從表2可以看出,對于GeTe的菱方相和面心立方相,無論在富Ge或富Te的情況下,摻雜的Se原子均優先取代Te原子。Se摻雜的形成能為負,表明Se原子容易摻雜到GeTe中。從表1中還可以看出,少量Se摻雜對于GeTe完美晶體菱方結構和面心立方結構的體積影響很小,造成體積的微量坍縮。主要由于Se的原子半徑小于Te。此外,較低的形成能和較小的晶格變化,表明在GeTe中能實現高濃度的Se摻雜。這與實驗觀測一致,實驗中Se摻雜量達到20%時,依然沒有造成GeTe結構的破壞[11]。

表2 Se摻雜完美GeTe不同取代位置的形成能
對GeTe完美晶體的Se摻雜進行了電子局域函數分析,如圖2所示。由于Se、Te屬于同主族元素,Se原子與Te原子具有十分相似的電子局域函數分布。對于GeTe菱方相,由于派爾斯形變,形成的Ge—Te短鍵鍵長RGe1-Te=0.286 nm,Ge—Te長鍵鍵長RGe2-Te=0.325 nm,與實驗值十分接近[20]。當Se取代Te原子時,也呈現出長短鍵交替的情況,然而,其中Ge—Se短鍵變得更短(RGe1-Se=0.266 nm),而Ge—Se長鍵變得更長(RGe2-Se=0.334 nm)。這是由于Se原子具有較強的電負性,與其同層最近鄰Ge原子(Ge1)形成了較強的Ge—Se鍵。同時Se原子較小的原子半徑,使得其與鄰層最近鄰Ge原子(Ge2)的鍵合變弱。Se摻雜使得體系中原子分層排布的現象更加明顯。
此外,GeTe面心立方結構則具有6個等同的Ge—Te鍵,RGe-Te=0.301 nm,如圖2(c)所示。Se取代Te原子之后,Se原子的電子局域函數依然呈球狀分布,形成6個等同的Ge—Se鍵,RGe-Se=0.292 nm,鍵長較Ge—Te鍵變短。兩相中,Se摻雜均形成了較強的Ge—Se鍵,對Ge原子的移動起到抑制作用。Ge—Se原子主要為共價鍵結合,詳細解釋見后續的電子態密度分析。

圖2 完美GeTe晶體摻雜前后在 (100) 面上的ELF截面圖(等高線間隔為0.14)Fig.2 ELF contour plots on (100) plane for Se doped ideal GeTe crystal (interval is 0.14)
2.2 含本征Ge空位的GeTe晶體的Se摻雜
本文2.1節計算基于GeTe的完美晶體模型。然而,實際上GeTe是一種非化學計量比的半導體,GeTe中存在高濃度的本征Ge空位。對GeTe進行摻雜研究時,必須考慮其中大量存在的本征Ge空位的影響。由于Ge、Se具有相近的離子半徑(分別為67 pm和64 pm),Vinod和Sangunni[11]推測Se原子可能占據Ge空位的位置。因此,本文研究了Se摻雜含Ge空位的GeTe體系(Ge31Te32,共63個原子)。對Se占據Ge空位和Se取代Te原子的情況作了重點比較。
根據摻入的Se原子與Ge空位距離的不同,構建了多種模型。計算得到的形成能如圖3所示。當Se占據Ge空位時,Se原子與Ge空位距離即為0。對于菱方相,Ge空位最近鄰Te原子有2種,分別為同層最近鄰和鄰層最近鄰,用A1和A2表示。點間連線以便于觀察。從圖3可以看出,無論對于菱方相還是面心立方相,當存在Ge空位時,摻雜的Se原子依然不會占據Ge空位位置,而是傾向于取代Ge空位最近鄰的Te原子。對于菱方相,則優先取代Ge空位同層最近鄰的Te原子。從另一個角度來看,Se雜質原子與Ge空位具有一定互相吸引作用。這種吸引作用會抑制Ge空位的移動。

圖3 Se摻雜Ge31Te32菱方相和Ge31Te32面心立方相的形成能隨Se原子與Ge空位之間距離的變化Fig.3 Formation energy of Se doping in rhombohedral Ge31Te32 and fcc Ge31Te32 versus distance between doped Se atom and Ge vacancy
圖4為菱方相中Se取代Ge空位同層最近鄰Te原子時(A1構型)和鄰層最近鄰Te原子時(A2構型)的原子結構, 虛線環表示Ge空位,深色球、淺色球分別表示Ge、Te原子,1號原子為Se。形成能計算結果表明,Se原子更傾向于占據Ge空位同層最近鄰的位置。A1與A2之間形成能差異在50 meV/supercell左右。由圖4可以發現,Ge空位使體系中形成了較強的層間Ge—Te鍵,部分抵消了Ge空位帶來的影響。A1構型的成鍵情況為:3個Ge—Se鍵(R1-2=R1-3=0.256 nm,R1-4=0.297 nm),2個層間Ge—Te較強鍵(R5-6=R7-8=0.312 nm)。A2構型成鍵情況為:3個Ge—Se鍵(R1-2=0.282 nm,R1-3=R1-4=0.260 nm),3個層間Ge—Te鍵(R5-6=R7-8=0.312 nm,R9-10=0.309 nm)。由于Se取代同層的最近鄰Te原子(A1)相較于鄰層的最近鄰Te原子(A2)所引起的晶格畸變更小,因此更容易形成。
進一步對含Ge空位的菱方相和面心立方相的Se摻雜進行了電子局域函數分析,如圖5所示。其中圖5(a)~(c)為菱方相,圖5(d)~(f)為面心立方相。從圖5(a)中可以看出,對于菱方相,Ge空位對ELF的影響十分局域。Ge空位同層最近鄰Te原子(Te1),與鄰層的Ge原子(Ge1)形成較強的層間Ge—Te結合(RGe1-Te1=0.311 nm)。

圖4 Se摻雜GeTe的2種構型Fig.4 Two configurations of Se doped GeTe

圖5 Se摻雜含Ge空位的GeTe體系的在(100)面上的ELF截面圖(等高線間隔為0.12)Fig.5 ELF contour plots on (100) plane for Se doped GeTe systems with intrinsic Ge vacancy (interval is 0.12)
圖5(b)為Se占據Ge空位同層最近鄰時的情況,ELF分布與未摻雜體系十分接近,因此Se摻雜對GeTe菱方相電子分布的作用較小。而當Se占據Ge空位時,Se原子周圍的電子分布類似于球形,形成近乎等同的6個Se—Te鍵,(RSe-Te1=0.309 nm,RSe-Te2=0.316 nm)。此時Se雜質原子對周圍Te原子的電子局域函數分布造成較大的影響,導致體系能量升高,從而具有較高的形成能。摻雜的Se原子不會占據Ge空位。
對于GeTe面心立方相,Ge空位對電子局域函數的影響也較小。與眾不同的是,當摻入的Se原子與Ge空位最近鄰時,造成電子局域函數的較大變化。此時GeTe體系中的電子局域函數分布甚至接近于菱方相中的分布,部分Ge—Te鍵出現長短鍵分化,從而降低了體系的能量,形成能較低。Se摻雜模糊了GeTe面心立方相和菱方相的界線。而Se占據Ge空位時,對周圍Te原子的影響較大,形成能較高,不易存在。
以上分析得出,對于GeTe實際晶體,Se摻雜元素并不會占據Ge空位的位置。摻入的Se原子更傾向于靠近Ge空位,二者具有一定吸引作用,從而限制了Ge空位的移動。GeTe相變存儲材料的相轉變與電場下Ge空位的定向移動關系密切[27-28]。Se摻雜對于Ge空位移動的抑制作用,是導致其再結晶溫度升高的重要原因。此外,實驗和計算指出,GeTe和Ge2Sb2Te5中大量存在的本征Ge空位并非以單一Ge空位的形式存在,而是形成多空位群或者小孔洞[29-30]。Se雜質原子可能聚集在空位群或孔洞處,從而對相變存儲材料的動態相變過程起到更大的影響。Se摻雜含有Ge空位的GeTe體系,使得兩晶相的相似度增加。這種性質也可能是實驗中觀察到Se摻雜PCM出現奇特相變現象的原因。
另外,從表1晶胞數據中可以明顯觀察到,對于含Ge空位的菱方相,Se摻雜導致晶胞體積減小。而反常的是,Se摻雜含Ge空位的面心立方相導致晶格常數和體積增大。主要是Se摻雜后電子局域函數變化所造成的。Se摻雜后,GeTe菱方相和面心立方相將具有更相近的晶格常數和體積。這對于減小GeTe相變過程中的體積變化十分有益,有助于提高相變存儲材料的穩定性。
不同體系的總態密度如圖6所示,虛線表示費米能級位置,設置為0 eV處。其帶隙變化值如表1所示。Ge空位導致費米能級向價帶內移動,呈現出p型半導體的性質。對于GeTe菱方相,Se摻雜對態密度的影響較小,造成帶隙的少量降低。3% Se摻雜使菱方結構Ge31Te32的帶隙僅僅下降了1.7%。Se摻雜可使GeTe菱方晶體保持良好的導電性質。此外,對于含Ge空位的GeTe面心立方晶體,Se摻雜則會使導帶底向能量更高處移動,顯著增加其帶隙。面心立方結構的Ge31Te31Se1相較于Ge31Te32,帶隙增加了67.7%。這主要是由摻雜后晶格常數增大所引起的。
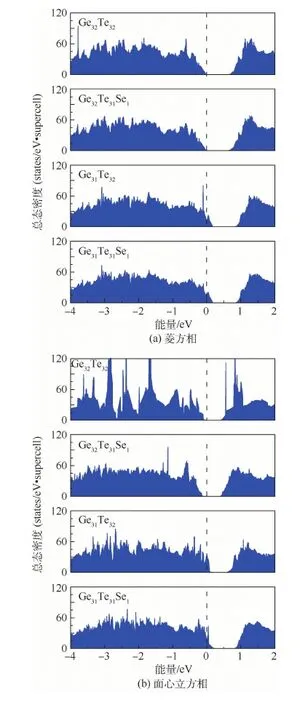
圖6 菱方相和面心立方相總態密度Fig.6 Total density of states for rhombohedral phase and fcc
圖7(a)、(b)分別為Ge32Te31Se1菱方相和面心立方相中,摻雜的Se原子與其最近鄰Ge原子和Te原子的分波態密度圖(PDOS),虛線表示費米能級位置,設置為0 eV處。可以看出,Ge 4p電子和Te 4p電子具有很強的p-p耦合,形成Ge—Te共價鍵。而Se原子的PDOS分布與Te原子十分相似。摻雜的Se原子與Ge原子形成類似于Ge—Te鍵的Ge—Se共價鍵。Se原子的3p電子態密度分布離價帶頂較遠,處在較低能量位置。

圖7 菱方相Ge32Te31Se1和面心立方相Ge32Te31Se1Ge原子、Te原子和Se原子的分波態密度Fig.7 Partial density of states for Ge atom, Te atom and Se atom in rhombohedral Ge32Te31Se1 and fcc Ge32Te31Se1
Se原子與Ge原子的p電子態密度耦合更加顯著,因而Ge—Se共價鍵較Ge—Te共價鍵更強。
3 結 論
1) 對于GeTe完美晶體,Se摻雜優先取代Te原子。而對于含Ge空位的GeTe晶體,Se原子不會占據Ge空位,而更傾向于取代Ge空位最近鄰的Te原子。對于菱方相,則傾向于取代Ge空位同層最近鄰的Te原子。Se雜質原子與Ge空位存在一定的吸引作用,阻礙了Ge空位的移動,可以提高GeTe相變存儲材料的再結晶溫度,使其具有更好的數據保持力和更高的服役溫度。
2) Se摻雜導致菱方相的體積收縮,而面心立方相的體積膨脹,減小了由菱方相到面心立方相轉變時的體積差異,提高了相變存儲材料的穩定性。
3) Se原子摻雜對GeTe菱方相的電子結構影響較小,使其帶隙略微減小。故少量Se摻雜不會影響GeTe菱方相的導電性質。此外,Se摻雜使面心立方相的帶隙增大。Se摻雜含Ge空位的面心立方晶體呈現類似于菱方相的電子局域函數分布,減小了兩相的差異。為解釋實驗中Se摻雜PCM出現的奇特相轉變性質提供了重要線索。
綜上,Se摻雜的GeTe是一種性質優異的相變存儲材料,具有較高的再結晶溫度,適用于航空航天、汽車電子等較高溫度的信息存儲領域。對Se摻雜后的非晶態性質需要后期進一步探索。
致謝感謝北京航空航天大學司晨老師在研究過程中給予的幫助和指導。
參考文獻 (References)
[1] OVSHINSKY S R.Reversible electrical switching phenomena in disordered structures[J].Physical Review Letters,1968,21(20):1450-1453.
[2] RAOUX S,WELNIC W,IELMINI D.Phase change materials and their application to nonvolatile memories[J].Chemical Reviews,2010,110(1):240-267.
[3] WONG H S P,SALAHUDDIN S.Memory leads the way to better computing[J].Nature Nanotechnology,2015,10(3):191-194.
[4] LENCER D,SALINGA M,GRABOWSKI B,et al.A map for phase-change materials[J].Nature Materials,2008,7(12):972-977.
[5] LENCER D,SALINGA M,WUTTIG M.Design rules for phase-change materials in data storage applications[J].Advanced Materials,2011,23(18):2030-2058.
[6] RAOUX S.Phase change materials[J].Annual Review of Materials Research,2009,39(1):25-48.
[7] PERNIOLA L,SOUSA V,FANTINI A,et al.Electrical behavior of phase-change memory cells based on GeTe[J].IEEE Electron Device Letters,2010,31(5):488-490.
[8] BRUNS G,MERKELBACH P,SCHLOCKERMANN C,et al.Nanosecond switching in GeTe phase change memory cells[J].Applied Physics Letters,2009,95(4):043108.
[9] CHONG T,SHI L,ZHAO R,et al.Phase change random access memory cell with superlattice-like structure[J].Applied Physics Letters,2006,88(12):122114.
[10] VINOD E M,SINGH A K,GANESAN R,et al.Effect of selenium addition on the GeTe phase change memory alloys[J].Journal of Alloys and Compounds,2012,537(19):127-132.
[11] VINOD E M,SANGUNNI K S.The effect of Se doping on spectroscopic and electrical properties of GeTe[J].Thin Solid Films,2014,550(1):569-574.
[12] KOLOBOV A V,TOMINAGA J,FONS P,et al.Local structure of crystallized GeTe films[J].Applied Physics Letters,2003,82(3):382-384.
[13] TONG F,MIAO X S,WU Y,et al.Effective method to identify the vacancies in crystalline GeTe[J].Applied Physics Letters,2010,97(26):261904.
[14] VINOD E M,RAMESH K,SANGUNNI K S.Structural transition and enhanced phase transition properties of Se doped Ge2Sb2Te5alloys[J].Scientific Reports,2015,5:8050.
[15] WANG M,LU Y,SHEN X,et al.Effect of Sb2Se on phase change characteristics of Ge2Sb2Te5[J].CrystEngComm,2015,17(26):4871-4876.
[16] HAFNER J.Ab-initio simulations of materials using VASP:Density-functional theory and beyond[J].Journal of Computational Chemistry,2008,29(13):2044-2078.
[17] BL?CHL P E.Projector augmented-wave method[J].Physical Review B,1994,50(24):17953-17979.
[18] PERDEW J P,WANG Y.Pair-distribution function and its coupling-constant average for the spin-polarized electron gas[J].Physical Review B,1992,46(20):12947-12954.
[19] MIAO N,SA B,ZHOU J,et al.Investigation on Ge5-xSbxTe5phase-change materials by first-principles method[J].Applied Physics A,2010,99(4):961-964.
[20] GOLDAK J,BARRETT C S,INNES D,et al.Structure of alpha GeTe[J].The Journal of Chemical Physics,1966,44(9):3323-3325.
[21] LEVIN E M,BESSER M F,HANUS R.Electronic and thermal transport in GeTe:A versatile base for thermoelectric materials[J].Journal of Applied Physics,2013,114(8):083713.
[22] CHATTOPADHYAY T,BOUCHERLE J.Neutron diffraction study on the structural phase transition in GeTe[J].Journal of Physics C:Solid State Physics,1987,20(10):1431.
[23] PEIERLS R E.Quantum theory of solids[M].Oxford:Oxford University Press,1955.
[24] SUN Z,TIAN S,SA B.Investigation of the structure and properties of rhombohedral Cu-Ge-Te alloys by ab initio calculations[J].Intermetallics,2013,32(2):292-296.
[25] ZHANG S,WEI S H,ZUNGER A,et al.Defect physics of the CuInSe2chalcopyrite semiconductor[J].Physical Review B,1998,57(16):9642.
[26] WEI S H.Overcoming the doping bottleneck in semiconductors[J].Computational Materials Science,2004,30(3):337-348.
[27] NAM S W,CHUNG H S,LO Y C,et al.Electrical wind force-driven and dislocation-templated amorphization in phase-change nanowires[J].Science,2012,336(6088):1561-1566.
[28] NUKALA P,AGARWAL R,QIAN X,et al.Direct observation of metal-insulator transition in single-crystalline germanium telluride nanowire memory devices prior to amorphization[J].Nano Letters,2014,14(4):2201-2209.
[29] SUN Z,ZHOU J,BLOMQVIST A,et al.Formation of large voids in the amorphous phase-change memory Ge2Sb2Te5alloy[J].Physical Review Letters,2009,102:075504.
[30] UPADHYAY M,ABHAYA S,MURUGAVEL S,et al.Experimental evidence for presence of voids in phase change memory material[J].RSC Advances,2014,4(8):3659-3668.

