MEMS加工技術(shù)綜合性實驗
李東玲, 尚正國, 佘 引, 王勝強
(重慶大學(xué) 光電工程學(xué)院, 重慶 400044)
MEMS加工技術(shù)綜合性實驗
李東玲, 尚正國, 佘 引, 王勝強
(重慶大學(xué) 光電工程學(xué)院, 重慶 400044)
為了滿足微電子學(xué)以及儀器科學(xué)與技術(shù)等專業(yè)實踐教學(xué)與人才培養(yǎng)的需要,以MEMS加速度開關(guān)為應(yīng)用對象,開展MEMS加工技術(shù)綜合性實驗研究。根據(jù)MEMS加速度開關(guān)的結(jié)構(gòu)特點,設(shè)計加工工藝流程;以MEMS工藝?yán)碚撝R為基礎(chǔ),結(jié)合實踐教學(xué),開展?jié)穹ǜg、陽極鍵合、ICP刻蝕等關(guān)鍵加工工藝研究,完成MEMS加速度開關(guān)原理樣品的研制。該實驗從器件結(jié)構(gòu)、加工工藝到測試分析,簡單直觀,有利于學(xué)生全面掌握MEMS加工工藝,培養(yǎng)學(xué)生的科研興趣和實踐能力。
實踐教學(xué); 綜合實驗; 工藝流程; 關(guān)鍵加工工藝
微機電系統(tǒng)(micro-electro-mechanical system,MEMS)是在微電子技術(shù)的基礎(chǔ)上,融合了硅微加工、LIGA和精密機械加工等技術(shù)的一項新興的科學(xué)領(lǐng)域,集微傳感器、微執(zhí)行器、微電源系統(tǒng)、信號處理和控制電路、高性能電子集成器件、接口、通信等于一體[1],是一個多學(xué)科交叉的高新技術(shù)領(lǐng)域,涉及機械、電子、物理、化學(xué)、生物、材料以及光學(xué)等學(xué)科,其特征尺寸從毫米、微米到納米量級。MEMS技術(shù)憑借集成度高、體積小、重量輕、功耗低、適合大批量生產(chǎn)等優(yōu)勢,近年來得到迅猛發(fā)展,研制出各種MEMS器件,并在汽車工業(yè)、通信網(wǎng)絡(luò)、軍事裝備以及生物醫(yī)學(xué)等領(lǐng)域獲得了重要應(yīng)用[2-3]。
微機械結(jié)構(gòu)和部件的加工技術(shù)是成功研制MEMS器件的關(guān)鍵。它通過光刻、腐蝕、淀積、鍵合等工藝制備微機械可動結(jié)構(gòu),并實現(xiàn)電學(xué)連接,是目前最重要的新興技術(shù)之一[4]。然而,國內(nèi)對MEMS加工技術(shù)的重視程度不夠,大量的人才集中在MEMS設(shè)計及應(yīng)用拓展等領(lǐng)域,而對加工工藝的研究較少,存在嚴(yán)重的設(shè)計與加工脫節(jié)、理論與實踐脫節(jié)的問題[5]。MEMS加工技術(shù)已成為制約我國MEMS技術(shù)發(fā)展的瓶頸[6]。
MEMS加工技術(shù)作為重慶大學(xué)光電工程學(xué)院微電子學(xué)以及儀器科學(xué)與技術(shù)專業(yè)學(xué)生的重要技能之一,在半導(dǎo)體器件與物理、微光機電系統(tǒng)、微米/納米技術(shù)等專業(yè)課程中均有涉及,但大都是理論教學(xué),缺乏系統(tǒng)的實驗指導(dǎo)。
本文基于重慶大學(xué)光電工程學(xué)院MEMS工藝平臺,以MEMS加速度開關(guān)為具體對象,設(shè)計MEMS加工工藝實驗,使學(xué)生充分理解并掌握MEMS加工工藝,鞏固和延伸課堂知識,同時培養(yǎng)學(xué)生的科研興趣和實踐能力,服務(wù)于科學(xué)研究與人才培養(yǎng)。
1 設(shè)備及材料
設(shè)備:本實驗在重慶大學(xué)MEMS工藝平臺完成,主要加工設(shè)備有:德國Karl Suss雙面光刻機MA6/BA6、鍵合機SB6e,德國FHR公司的磁控濺射系統(tǒng)MS-100,英國STS公司的ICP深槽刻蝕系統(tǒng)MP0597,七星華創(chuàng)的氧化擴散系統(tǒng)L4512II-36/ZM以及中電2所的濕法腐蝕系統(tǒng)SDX-6225B等。腐蝕深度及表面粗糙度分別采用美國Ambios公司的臺階儀Xp-100以及光學(xué)輪廓儀Xi-100測試,線條尺寸及結(jié)構(gòu)形貌采用光學(xué)顯微鏡BX-51以及掃描電子顯微鏡JSM-5610LV觀測。
材料:敏感結(jié)構(gòu)層的制作選用N型<100>單晶硅片,厚度為500 μm±25 μm,電阻率為2~4 Ω·cm;絕緣襯底為Pyrex7740硼硅玻璃,厚度為500 μm±20 μm。化學(xué)試劑均為分析純,工藝氣體為99.999%的高純氣體。
2 實驗設(shè)計
實驗根據(jù)MEMS加速度開關(guān)的結(jié)構(gòu)特點,設(shè)計加速度開關(guān)加工工藝流程。突破濕法腐蝕、陽極鍵合、ICP刻蝕(感應(yīng)耦合等離子體刻蝕)等關(guān)鍵加工工藝,加工出加速度開關(guān)原理樣品,并進行初步測試。本次實驗的目的,旨在培養(yǎng)學(xué)生理論與實際聯(lián)系的能力,使學(xué)生深刻理解并掌握MEMS加工工藝。
2.1 MEMS加速度開關(guān)的結(jié)構(gòu)及原理
MEMS加速度開關(guān)的結(jié)構(gòu)示意圖見圖1,主要由敏感質(zhì)量塊、彈性梁、可動觸點、固定電極、玻璃襯底等組成。初始狀態(tài)下,可動觸點與固定電極保持一定間距,開關(guān)斷開;當(dāng)開關(guān)受到大于開關(guān)閾值的外界沖擊加速度作用時,敏感質(zhì)量塊發(fā)生位移,使得可動觸點與固定電極接觸,相互分離的信號傳輸線導(dǎo)通,開關(guān)執(zhí)行閉合動作;當(dāng)外界沖擊加速度消失或小于閾值時,可動觸點與固定電極分開,開關(guān)斷開。
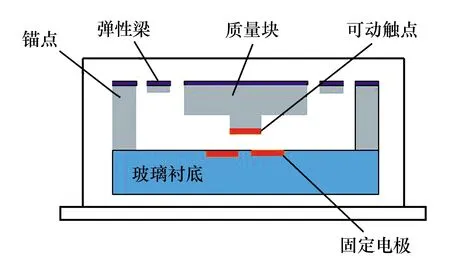
圖1 MEMS加速度開關(guān)結(jié)構(gòu)示意圖
2.2 工藝流程設(shè)計
根據(jù)MEMS加速度開關(guān)的結(jié)構(gòu)特點,要實現(xiàn)MEMS加速度開關(guān)的制備,需要定義以下結(jié)構(gòu)和參數(shù):(1)可動觸點與固定電極初始間距;(2)可動觸點與固定電極;(3)折疊梁和質(zhì)量塊。MEMS加速度開關(guān)的加工工藝流程圖如圖2所示:
(a) 熱氧化生長的SiO2300 nm;
(b) 光刻1,形成正面淺槽,BHF腐蝕SiO2;
(c) 以SiO2為掩膜,濕法腐蝕Si 3μm,形成初始間距;
(d) 光刻2,濺射TiW/Au(40 nm/120 nm),并采用Lift-off工藝形成可動觸點圖形;
(e) 以SiO2、觸點金屬為掩膜,ICP干法刻蝕硅35 μm,形成觸點高度;
(f) 正反面去除SiO2;
(g) 玻璃基片光刻3,磁控濺射TiW/Au(40 nm/120 nm),并采用Lift-off工藝形成固定電極;
(h) 硅-玻璃陽極鍵合,實現(xiàn)對敏感結(jié)構(gòu)的支撐;
(i) 濕法減薄至硅層厚度60 μm,形成結(jié)構(gòu)層;
(j) 背面濺射金屬Al(200 nm),光刻4,濕法腐蝕Al,形成質(zhì)量塊和折疊梁結(jié)構(gòu)。
(k) 以Al為掩膜,ICP刻蝕25 μm,釋放結(jié)構(gòu)。
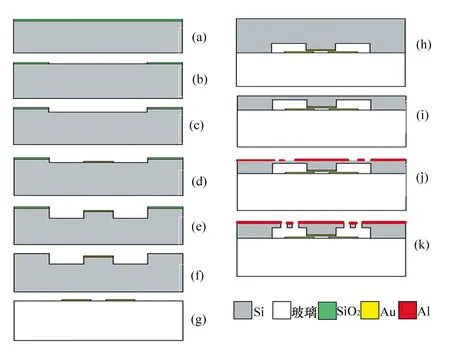
圖2 MEMS加速度開關(guān)工藝流程圖
3 結(jié)果及討論
3.1 TMAH各向異性濕法腐蝕
硅的各向異性濕法腐蝕是MEMS加工工藝中最基礎(chǔ)、最關(guān)鍵的技術(shù),是指不同晶向的硅在腐蝕液中表現(xiàn)出不同的腐蝕速率[7]。TMAH(四甲基氫氧化氨)水溶液是典型的各向異性濕法腐蝕液,具有成本低、腐蝕表面光滑、與IC工藝兼容、無污染等優(yōu)點[8]。實驗表明腐蝕液濃度、腐蝕溫度等參數(shù)對腐蝕特性有顯著影響。圖3為不同體積分?jǐn)?shù)TMAH溶液在不同溫度下的腐蝕速率。可見,隨著溫度的升高,腐蝕速率逐漸增大;相同溫度下,濃度越低腐蝕速率越快。

圖3 不同溫度下腐蝕速率與TMAH體積分?jǐn)?shù)的關(guān)系曲線
圖4為不同體積分?jǐn)?shù)的TMAH溶液腐蝕相同深度時腐蝕表面的粗糙度。當(dāng)TMAH溶液的體積分?jǐn)?shù)為25%時,腐蝕表面的粗糙度僅為1.58 nm(見圖4(a));但當(dāng)TMAH的體積分?jǐn)?shù)降為10%時,表面粗糙度增加到18.7 nm(見圖4(b) )。另外,隨著腐蝕深度的增加,表面粗糙度也逐漸增加。

圖4 不同濃度TMAH腐蝕液的腐蝕表面粗糙度
在本實驗中,正面淺槽的刻蝕和濕法減薄均采用TMAH濕法腐蝕工藝。根據(jù)加速度開關(guān)的結(jié)構(gòu)特點,對濕法腐蝕工藝又有不同的要求,如淺槽的腐蝕需要較小的表面粗糙度,而減薄工藝需要較快的刻蝕速率。因此,需要根據(jù)特定應(yīng)用對腐蝕液進行調(diào)整:淺槽刻蝕選用25% TMAH,70 ℃下腐蝕,腐蝕3 μm時的表面粗糙度為1.32 nm;濕法減薄采用5%TMAH,85 ℃下腐蝕,腐蝕速率為1 μm/min。
3.2 陽極鍵合
陽極鍵合又稱靜電鍵合,是靠強電場的作用將玻璃與硅或金屬鍵合在一起。陽極鍵合的工藝溫度低,鍵合界面牢固、長期穩(wěn)定性好,是目前應(yīng)用最廣泛的鍵合工藝[9]。
陽極鍵合在 Karl SUSS鍵合機 SB6e中完成。鍵合時,將對準(zhǔn)好的樣片放在鍵合機中,Pyrex7740玻璃接負極,硅結(jié)構(gòu)層接正極(如圖5所示)。當(dāng)溫度升高后,玻璃中Na+的遷移率提高[10],在外加電場作用下,Na+迅速移動至陰極并析出,O2-則向陽極硅移動,從而形成約幾微米厚的空間電荷區(qū)。此時,玻璃空間電荷區(qū)中的電場高達106V/cm,使得硅和玻璃界面間產(chǎn)生了巨大的靜電吸引力,使玻璃與硅表面緊密接觸,最終形成Si—O—Si結(jié)構(gòu),完成鍵合。

圖5 陽極鍵合示意圖
鍵合過程中的電流、電壓特性可以定性反映陽極鍵合過程,如圖6所示,包括預(yù)鍵合和鍵合2個過程。預(yù)鍵合電壓為-500 V,由于此時電壓較低,且電極之間接觸面積小,使得預(yù)鍵合過程中電流無明顯變化;而在鍵合過程中,電壓高達1 000 V,電流先快速上升至最大值,并穩(wěn)定一段時間,隨后呈指數(shù)下降,并最終穩(wěn)定在一個很小的值。一般認為當(dāng)電流降為最大電流的10%時,鍵合基本完成[11]。
在MEMS加速度開關(guān)中,通過陽極鍵合可實現(xiàn)硅結(jié)構(gòu)層與玻璃襯底的鍵合,定義可動觸點與固定電極之間的相對位置,并實現(xiàn)對結(jié)構(gòu)層的支撐。根據(jù)MEMS加速度開關(guān)的結(jié)構(gòu)特點,優(yōu)化的陽極鍵合工藝為:溫度350 ℃,電壓為-800 V,真空度0.1 Pa(10-6bar),壓力0.5×105Pa(0.5 bar),時間10 min。

圖6 陽極鍵合電流、電壓曲線
3.3 ICP刻蝕
感應(yīng)耦合等離子體(ICP)刻蝕,是在硅上制備高的深寬比微結(jié)構(gòu)、實現(xiàn)可動結(jié)構(gòu)釋放的關(guān)鍵工藝[12]。
ICP刻蝕在英國STS公司的MP0597刻蝕設(shè)備中進行,工藝氣體為SF6、C4F8以及O2。ICP 刻蝕過程是復(fù)雜的物理和化學(xué)過程的結(jié)合,用刻蝕/鈍化交替進行的方法來實現(xiàn)硅的各向異性深槽刻蝕[13]。在刻蝕周期內(nèi),Coil電源產(chǎn)生高速螺旋運動的刻蝕等離子體,實現(xiàn)對硅的刻蝕;在鈍化周期內(nèi),由Coil電源產(chǎn)生鈍化的等離子體,在整個圖形的底部及側(cè)壁上積淀形成鈍化層,實現(xiàn)對底部和側(cè)壁的保護;Platen電極為螺旋運動的離子提供偏置電壓,在加速離子運動的同時,使等離子體垂直作用于基片表面,使得垂直方向的刻蝕速率遠大于該方向的鈍化速率,從而實現(xiàn)高深寬比的深槽刻蝕。
影響ICP刻蝕的因素很多,如氣體流量、腔室壓力、射頻功率以及偏壓、溫度等。由于MEMS加速度開關(guān)為典型的Glass-Si-Glass結(jié)構(gòu),且彈性梁的結(jié)構(gòu)參數(shù)對開關(guān)性能具有重要影響,因此刻蝕過程中既要保證刻蝕的均勻性,又要保證彈性梁的尺寸精度。優(yōu)化的ICP刻蝕工藝見表1,刻蝕速率為2.1~2.2 μm/min,側(cè)壁陡直度為89.6~90.5°,深寬比為20∶1。圖7為采用該工藝釋放得到的彈性梁結(jié)構(gòu)顯微圖,梁寬為29.8 μm,梁厚為30.2 μm,無明顯的橫向鉆蝕。

表1 優(yōu)化的ICP刻蝕工藝

圖7 ICP刻蝕的彈性梁結(jié)構(gòu)
研制的MEMS加速度開關(guān)芯片如圖8所示。采用振動測試系統(tǒng)對開關(guān)性能進行了初步測試,得到開關(guān)的閾值為14.3g(g為重力加速度),響應(yīng)時間為0.8 ms。

圖8 MEMS開關(guān)芯片及輸出特性測試
4 結(jié)語
針對微電子學(xué)以及儀器科學(xué)與技術(shù)等專業(yè)在專業(yè)實習(xí)、畢業(yè)設(shè)計和日常開放實驗教學(xué)中的需要,以課堂知識為基礎(chǔ),針對典型MEMS器件開展MEMS加工工藝實驗研究,設(shè)計了MEMS加速度開關(guān)的加工工藝流程,開展了濕法腐蝕、陽極鍵合、ICP刻蝕等工藝實驗,使學(xué)生不僅全面、系統(tǒng)地掌握了MEMS加工工藝,而且獲得了MEMS器件從結(jié)構(gòu)、加工到測試的直觀體驗,激發(fā)了學(xué)生的學(xué)習(xí)熱情和科研興趣。
References)
[1] 沈培宏. MEMS技術(shù)[J]. 光電技術(shù),2006,3(1):13-17.
[2] 王亞珍,朱文堅. 微機電系統(tǒng)(MEMS)技術(shù)及發(fā)展趨勢[J]. 機械設(shè)計與研究,2004,20(1):10-12.
[3] 張亞偉. 微機電系統(tǒng)技術(shù)及其應(yīng)用[J]. 商品與質(zhì)量,2016,5(13):5-8.
[4] 楊擁軍. 劃時代的MEMS加工技術(shù)[J]. 國防制造技術(shù),2009(5): 36-42.
[5] 鐘建,顧可可,于軍勝,等. 薄膜太陽能光伏器件工藝制備及測試實驗教學(xué)平臺[J]. 實驗技術(shù)與管理,2014,31(6):183-185.
[6] 郝一龍,張大成,李婷. 硅基MEMS加工技術(shù)[C]//慣性儀表與元件學(xué)術(shù)交流會.2003.
[7] TangB.,Sato K. Formation of Silicon Nano Tips in Surfactant-Modified Wet Anisotropic Etching[J]. Applied Physics Express,2011,4 (5):056501-3.
[8] 崔丹丹,端木慶鐸,王國政,等. 硅微通道結(jié)構(gòu)釋放中濕法腐蝕特性研究[J/OL].(2015-04-27)[2016-12-07].http://www.paper.edu.cn/releasepaper/content/.
[9] Wei J,Xie H,Nai M L,et al. Low temperature wafer anodic bonding[J]. Micromechanics&Microengineering,2003,13(2):217-222.
[10] 宋永剛,秦會峰,胡利方,等. 硼硅玻璃與硅陽極鍵合機理分析[J]. 兵器材料科學(xué)與工程,2006,29(4):5-7.
[11] 王芳,姚明秋. 不同陽極鍵合結(jié)果的影響因素研究[J]. 科技風(fēng),2015(2): 14-15.
[12] 展明浩,宋同晶,皇華,等. 基于ICP的硅高深寬比溝槽刻蝕技術(shù)[J]. 電子科技,2012,25(8):77-79.
[13] S?kmen ü,Stranz A,Fündling S,et al. Shallow and deep dry etching of silicon using ICP cryogenic reactive ion etching process[J]. Microsystem Technologies,2010,16(5):863-870.
Comprehensive experiment of MEMS machining technology
Li Dongling, Shang Zhengguo, She Yin, Wang Shengqiang
(College of Optoelectronic Engineering,Chongqing University,Chongqing 400044,China)
In order to meet the needs of the practical teaching and personnel training in microelectronics,instrument science and technology,etc., and by taking MEMS acceleration switch as the object of application,the comprehensive experimental study of MEMS machining technology is carried out. According to the structure characteristics of MEMS acceleration switch,the machining technological process is designed. Based on the knowledge of MEMS process theory and practical teaching,the key processing technology such as wet etching,anodic bonding,ICP etching,etc., is studied, and the principle sample of MEMS acceleration switch is developed. This experiment is comprehensive,systematic,simple and intuitive from the aspects of the device structure and the processing technology to the test analysis,and it is beneficial for the students to master the MEMS processing technology comprehensively,and to cultivate their research interest and practical ability.
practical teaching; comprehensive experiment; technological process; key machining technology
10.16791/j.cnki.sjg.2017.07.025
2016-12-13
國家自然科學(xué)基金專項基金科學(xué)儀器基金項目(61327002);重慶大學(xué)教改項目(2015Y19)
李東玲(1982—),女,河北秦皇島,博士,工程師,研究方向為微納器件及加工技術(shù).
E-mail:lidongling@cqu.edu.cn
TN305.7; G642.0
A
1002-4956(2017)07-0095-04

