多芯片組件BGA-垂直通孔結構參數對信號傳輸特性的影響
周保林,周德儉,盧 楊
(桂林電子科技大學 機電工程學院,廣西 桂林 541004)
?
多芯片組件BGA-垂直通孔結構參數對信號傳輸特性的影響
周保林,周德儉,盧楊
(桂林電子科技大學 機電工程學院,廣西 桂林541004)
為了提高多芯片組件的信號傳輸特性,用HFSS軟件建立了多芯片組件的BGA-垂直通孔互聯模型,分析垂直通孔半徑、焊盤半徑、反焊盤半徑及信號線與地間的距離等結構參數對傳輸特性的影響。分析結果表明,該模型的回波損耗隨著通孔半徑和焊盤半徑的增大而增大,隨信號線與地間距離的增大而減小;特性阻抗隨通孔半徑和反焊盤半徑的增大突變值達到最大。通過仿真分析得到傳輸性能較優的參數組合:通孔半徑0.1 mm,焊盤半徑0.16 mm,地層反焊盤半徑0.325 mm,信號線與地間距離0.06 mm,可有效地減小特性阻抗的突變及信號的反射和延遲。
多芯片組件;結構參數;BGA焊點;反焊盤;垂直通孔;回波損耗
隨著微波技術的發展,電子設備朝著短小、輕薄、高速、高可靠性及多功能和低成本的方向發展。微波多芯片組件相對于傳統的微波器件,具有尺寸小、集成度高、功耗低、穩定性高、抗干擾強等優勢,被廣泛應用于手機、雷達等無線通信領域[1]。但隨著多芯片組件的密度和信號時鐘頻率的不斷提高,由互聯結構引起的寄生效應以及反射、串擾、損耗等信號傳輸性問題也越來越嚴重,已成為制約組件整體性能的瓶頸[2]。垂直通孔的BGA互聯作為多芯片組件中互聯結構的主要形式,是傳輸線在不同層間連接的最普遍形式[3],具有互聯密度高、高頻特性突出、封裝尺寸小、熱膨脹可靠性高且可同時實現圓片級封裝等優點[4]。在低頻段,由通孔產生的寄生效應很小,基本不會對信號的傳輸產生影響,但隨著數據速率的增加和信號上升沿的陡變,進入微波波段時,通孔就變成了一種非連續結構,由于此時信號通孔會產生寄生效應,信號通過通孔時其高頻分量會產生衰減和反射,引起信號的畸變,從而帶來一系列的信號完整性和電磁干擾問題。若在高速、高頻條件下無法保證信號的有效傳輸,將會造成整個系統性能的下降甚至崩潰,影響系統的可靠性。因此,建立多芯片組件的BGA-垂直通孔三維仿真模型,分析影響組件信號傳輸性能的主要結構參數和影響規律必不可少。
目前國內外學者對信號完整性的研究主要集中在PCB過孔和互連線等方面,而對BGA-垂直通孔過渡結構進行傳輸特性分析較少涉及。Tero等[5]利用BGA連接母板和上層封裝模塊,采用共面波導和屏蔽通孔形式,使回波損耗(S11)、插入損耗(S21)在50 GHz頻率內分別<-22 dB、>-0.6 dB,通過改變結構參數將帶寬拓展到70 GHz;熊華清等[6]對單個BGA焊點空洞建模,研究了BGA焊點中不同位置、大小和數目的空洞對焊點傳輸特性的影響;梁穎等[7]針對硅通孔高度、直徑和絕緣層厚度3個結構參數建立25種不同水平組合的HFSS模型,并獲取了這25種硅通孔的回波損耗和插入損耗,進行了方差分析;石光耀等[8]研究了BGA焊點形態(高度、最大外徑和焊點端口直徑)以及分布對反射、串擾的影響。上述研究表明,在高頻條件下BGA-垂直通孔的結構參數對信號傳輸特性有重要影響。鑒于此,以BGA-垂直通孔為研究對象,采用三維電磁仿真軟件HFSS,建立多芯片組件互聯結構模型,對高頻下的BGA-垂直通孔過渡結構進行仿真分析,研究BGA焊球半徑、地層反焊盤半徑、垂直通孔半徑和焊盤半徑等結構參數對互聯結構回波損耗的影響。
1 BGA-垂直通孔過渡結構三維電磁仿真模型
BGA-垂直通孔互聯模型如圖1所示。其中:R1為焊盤半徑;R2為地層反焊盤半徑;g為信號線寬度;s為信號線與地間的距離。BGA-垂直通孔互聯模型下層材料采用Ferro-A6系列LTCC(低溫共燒陶瓷)制作,介電常數5.9,介質損耗角0.002 7,每層生磁帶厚度127 μm,燒結后厚度0.6 mm。上層材料采用R04350,介電常數3.58,厚度1 mm。信號線采用共面波導和微帶線經垂直通孔連接,將信號線的特性阻抗設置為50 Ω,上下層之間采用BGA焊接的形式,在信號傳輸通孔周圍設計了一圈屏蔽孔,作為物理支撐,同時可起到屏蔽信號的作用[9]。為了確保單一的共面波導模式沿信號線傳播,在共面波導與地間設置2排屏蔽通孔[10]。模型的具體尺寸參數為:焊球半徑0.3 mm,焊球高度0.24 mm,焊盤半徑0.18 mm,通孔半徑0.1 mm,信號線寬度、信號線與地間的距離分別為0.25、0.15 mm。
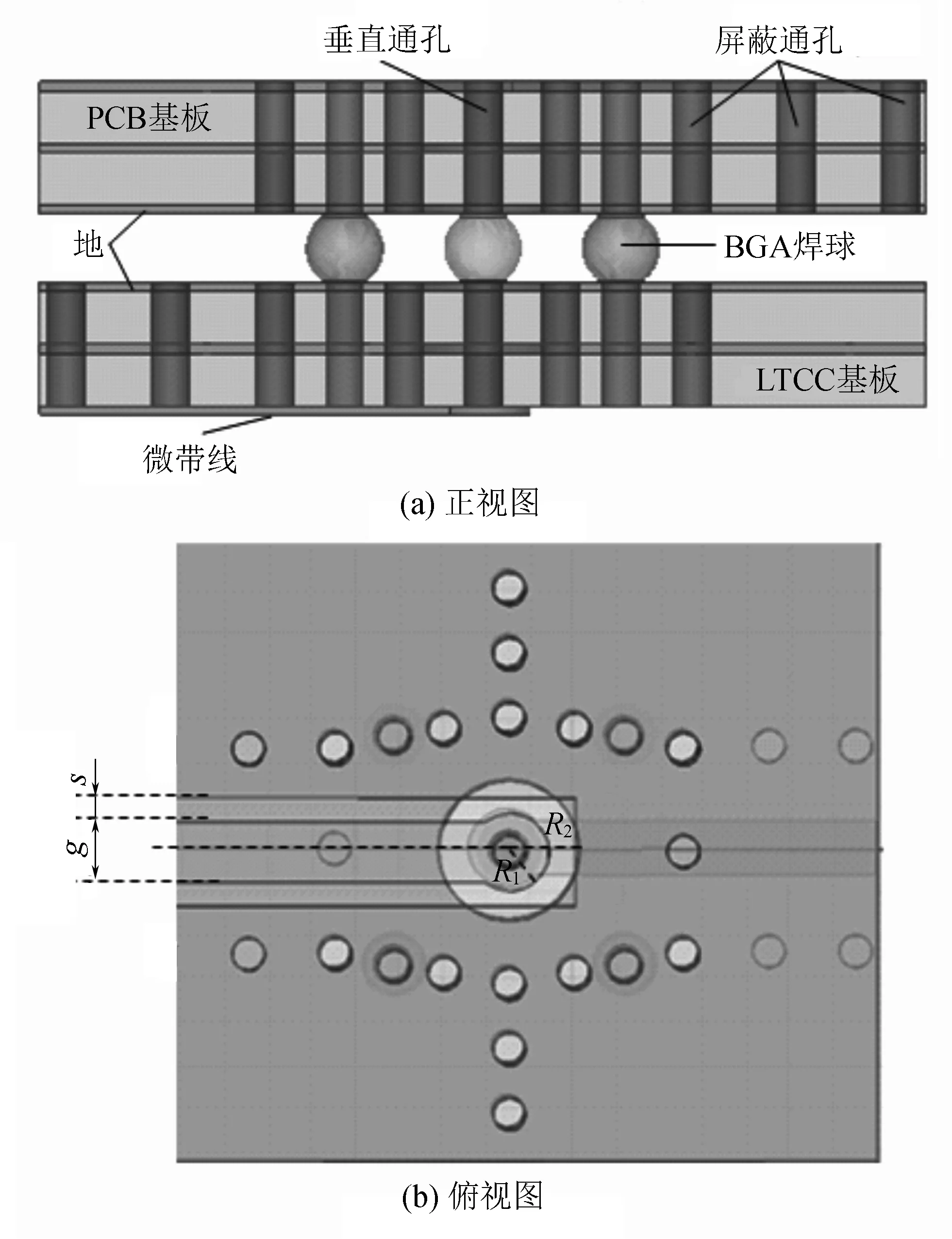
圖1 BGA-垂直通孔互聯模型Fig.1 BGA-via interconnection model
運用三維電磁場仿真軟件HFSS,建立BGA-垂直通孔互聯模型。該模型為兩端口網絡,設置邊界條件和收斂條件,在共面波導和微帶線兩端添加波端口,仿真得到的回波損耗、插值損耗和特性阻抗作為評價互聯模型傳輸特性的指標。回波損耗S11表示有多少能量被反射回到源端,該值越小越好,一般建議S11<0.1較好,按公式y=20lgS11換算成以dB為單位,即-20 dB。
2 基于BGA-垂直通孔仿真模型的傳輸特性分析
2.1垂直通孔半徑對仿真模型傳輸特性的影響
固定焊盤半徑為0.18 mm,地層反焊盤半徑為0.325 mm,信號線與地間的距離為0.06 mm,其他參數和設置保持不變,分別選取通孔半徑為0.100、0.125、0.150、0.175 mm,研究通孔半徑對BGA-垂直通孔互聯模型傳輸特性的影響。通過HFSS仿真軟件對其進行建模,仿真得到的傳輸特性曲線如圖2~4所示。

圖2 不同通孔半徑下的S11曲線Fig.2 S11 curves of different via radius
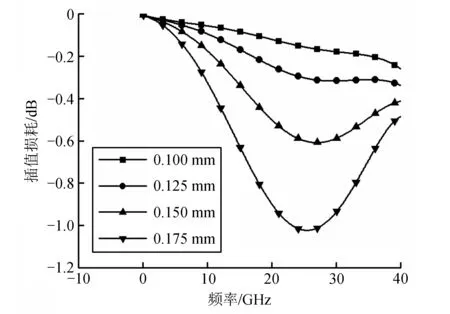
圖3 不同通孔半徑下的S21曲線Fig.3 S21 curves of different via radius
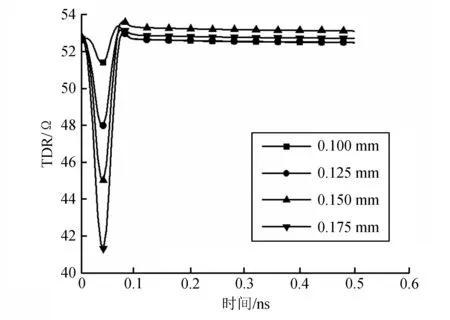
圖4 不同通孔半徑下的TDR曲線Fig.4 TDR curves of different via radius

2.2焊盤半徑對傳輸特性的影響
固定地層反焊盤半徑0.325 mm、通孔半徑0.100 mm、信號線與地間距離0.06 mm,其他參數和設置保持不變,僅改變焊盤半徑,焊盤半徑分別選取0.16、0.18、0.20、0.22 mm,研究焊盤半徑對BGA-垂直通孔互聯模型傳輸特性的影響。仿真得到的不同焊盤半徑下的S11曲線如圖5所示。

圖5 不同的焊盤半徑下S11曲線Fig.5 S11curves of different pad radius
從圖5可看出,頻率為0~3 GHz時,焊盤半徑對回波損耗的影響很小;頻率為3~40 GHz時,焊盤半徑對信號的傳輸性能影響很大,回波損耗隨著焊盤半徑的增大而增大。當焊盤半徑為0.22 mm時,回波損耗最大,此時能量發射最大;當焊盤半徑為0.16 mm時,回波損耗最小。因此,焊盤半徑最好應在0.16 mm以內,以保證阻抗的連續性和較大的傳輸系數。
2.3地層反焊盤半徑對仿真模型傳輸特性的影響
固定通孔半徑0.100 mm,焊盤半徑0.16 mm,信號線與地間的距離0.06 mm,其他參數和設置保持不變,地層的反焊盤半徑分別選取0.300、0.325、0.350、0.375 mm,研究地層反焊盤半徑對BGA-垂直通孔互聯模型傳輸特性的影響。仿真得到不同地層反焊盤半徑下的TDR曲線如圖6所示。
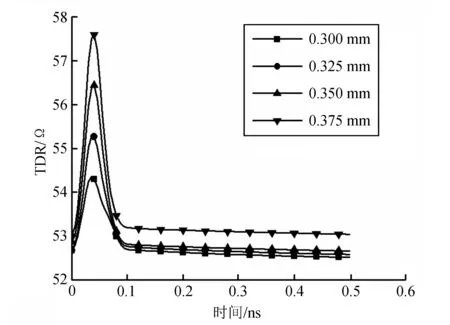
圖6 不同地層反焊盤半徑下的TDR曲線Fig.6 TDR curves of different anti-pad radius
從圖6可看出,當反焊盤半徑為0.375mm時,互聯模型的特性阻抗突變最大。因高速電路中垂直通孔本身存在對地或電源的寄生電容和電感,通孔的寄生電容隨反焊盤半徑的增大逐漸減小,電路的阻抗R=L/C逐漸增大,從而導致阻抗不匹配,引起信號的反射、串擾噪聲等現象,大大降低了信號的傳輸性能[11]。
2.4信號線與地間距離對仿真模型傳輸特性的影響
固定地層的反焊盤半徑0.325 mm,焊盤半徑0.16 mm,通孔半徑0.100 mm,信號線與地之間距離選取0.06、0.08、0.10、0.12 mm,研究信號線與地間距離對BGA-垂直通孔互聯模型傳輸特性的影響。仿真得到不同信號線與地間距離的S11、S21曲線如圖7、8所示。
由圖7知,S11參數隨著信號線與地間距離的增大而減小,其反映的是反射損耗,即距離越近,反射損耗越大,信號的傳輸性能越差。圖8中信號線與地間距離分別為0.06、0.08、0.10、0.12 mm時,在40 GHz對應的的插入損耗依次為-0.42、-0.50、-0.56、-0.74 dB。距離為0.06 mm時,傳輸系數在0~40 GHz只減少了0.42 dB,而在距離為0.12 mm時,傳輸系數在0~40 GHz減少了0.74 dB,相對下降幅度為43%,因此信號線與地間距離對插入損耗的影響較大。因為隨著距離的增大,信號沿傳輸線向外輻射,能量損耗增大,傳輸到另一端的信號大大減弱。

圖7 不同信號線與地間距離的S11曲線Fig.7 S11curves of different distance between signal line and ground

圖8 不同信號線與地間距離的S21曲線Fig.8 S21curves of different distance between signal line and ground
3 結束語
利用HFSS有限元仿真軟件,建立了一種微波多芯片組件的三維模型,分析了結構參數與回波損耗、插值損耗及特性阻抗的關系。分析結果表明,多芯片組件互聯模型回波損耗隨通孔半徑和焊盤半徑的增大而增大,隨信號線與地間距離的增大而減小;特性阻抗隨通孔半徑和反焊盤半徑的增大,突變值達到最大。當通孔半徑為0.100 mm,地層反焊盤半徑為0.325 mm,信號線與地間距離為0.06 mm,焊盤半徑為0.16 mm時,多芯片組件的傳輸特性最優。雖然該三維模型建立在相關理論之上,但未經過實驗驗證,今后可搭建實驗平臺進行測試,以便與仿真結果進行比對驗證。
[1]辛榮提,沈亮,冷智輝,等.結構一體化天線發展及其應用[C]//2014(第五屆)中國無人機大會論文集,2014:179-184.
[2]周駿.微波毫米波三維高密度SIP技術研究[D].南京:東南大學,2013:2-3.
[3]李偉.微波多層電路垂直互聯過孔等效電路研究[D].成都:電子科技大學,2014:8-9.
[4]LEUNG T,MILLER D.Coupling of vias in electronic packaging and printed circuit board structures with finite ground plane[J].IEEE Transactions on advanced packaging,2003,180-184.
[5]TERO K,JUKKA H.An ultra-wideband BGA-via transition for high-speed digital and millimeter-wave packaging applications[J].IEEE/MTT-S Int Microwave Symp,2007(6):1637-1640.
[6]熊華清,李春泉,尚玉玲.BGA焊點空洞對信號傳輸性能的影響[J].半導體技術,2009,34(10):946-952.
[7]劉培生,黃金鑫,仝良玉,等.硅通孔技術的發展與挑戰[J].電子元件與材料,2012,31(12):76-80.
[8]石光耀,尚玲玉,曲理.BGA焊點形態和布局對信號完整性的影響[J].桂林電子科技大學學報,2013,33(4):279-283.
[9]張屹遐.微波LTCC垂直通孔互聯建模研究[D].成都:電子科技大學,2012:17-18.
[10]KANGASVIERI T,HALME J,LAHTI M.Ultra-wideband shield vertical via transitions from DC up to the V-band[C]//Proceedings of the European Microwave Integrated Circuits Conference,2006:476-479.
[11]楊榮彬,胡玉生.高速PCB中過孔電容的分析[J].機電技術,2011(6):107-108.
編輯:張所濱
Influence of MCM BGA-via structure parameters on signal transmission characteristics
ZHOU Baolin, ZHOU Dejian, LU Yang
(School of Mechatronic Engineering, Guilin University of Electronic Technology, Guilin 541004, China)
In order to improve the signal transmission characteristics of the multi-chip module, the BGA-via interconnection model was built in HFSS software, the impacts of structure parameters included via radius, bonding pad radius, anti-pad radius and distance between signal lines and ground on signal transmission characteristics were studied. The results show that the return loss of the multi-chip module BGA-via is increased with the increase of hole radius and pad radius, and the return loss of the multi-chip module BGA-via is decreased with the increase of the distance between the signal line and the ground. With the increase of via radius and anti-pad radius, characteristic impedance reaches the maximum. The structure parameters are obtained through the simulation analysis of signal transmission characteristics. Anti-pad radius is 0.325 mm, via radius is 0.1 mm, pad radius is 0.16 mm and distance between signal line and ground is 0.06 mm. The characteristic impedance mutation, signal reflection and delay are effectively reduced.
multi-chip module; structure parameter; BGA solder joint; anti-pad; vertical via; return loss
2016-03-05
國防973項目“多能量***研究”
周德儉(1954-),男,浙江金華人,教授,博士,研究方向為微電子組裝與封裝。E-mail:emezdj@guet.edu.cn
TN603.5
A
1673-808X(2016)04-0289-05
引文格式:周保林,周德儉,盧楊.多芯片組件BGA-垂直通孔結構參數對信號傳輸特性的影響[J].桂林電子科技大學學報,2016,36(4):289-293.

