光讀出紅外成像芯片真空封裝研究*
張云勝, 馮 飛, 魏旭東, 戈肖鴻, 王躍林
(1.中國科學院 上海微系統與信息技術研究所,上海 200050;2.中國科學院大學,北京 100049)
光讀出紅外成像芯片真空封裝研究*
張云勝1,2, 馮 飛1, 魏旭東1, 戈肖鴻1, 王躍林1
(1.中國科學院 上海微系統與信息技術研究所,上海 200050;2.中國科學院大學,北京 100049)
為解決光讀出紅外成像焦平面陣列器件的真空封裝,提出了一種新穎的真空封裝方法。該封裝結構由可見光窗口、硅墊片和紅外窗口三部分構成。硅墊片和可見光窗口(玻璃)通過陽極鍵合形成封裝腔體,用于放置芯片;紅外窗口不僅選擇性增透8~14 μm波段的紅外輻射,且作為封裝蓋板;封裝腔體和紅外窗口在真空室內通過焊料鍵合完成真空封裝。該封裝結構通過了氣密檢測,并測試得到了200 ℃電烙鐵熱像圖。
真空封裝; 紅外成像焦平面陣列; 光讀出; 陽極鍵合; 焊料鍵合
0 引 言
真空封裝對于紅外焦平面陣列(infrared focal plane array,IRFPA)芯片是必不可少的[1~4]。IRFPA需要封裝來保護內部脆弱的微結構免于外界水汽、灰塵等造成的損壞;更重要的是需要真空環境來確保芯片的正常工作。迄今為止,已有多種針對電讀出IRFPA的真空封裝方案,可以分為芯片級封裝[1]、圓片級封裝[2,3]和像素級封裝[3,4]。芯片級真空封裝是研發最早且目前仍被廣泛使用的一種真空封裝方法,但是其封裝效率比較低。圓片級真空封裝提高了封裝效率,但該方法對IRFPA芯片的成品率要求較高,否則,將會封裝相當比例的廢片,從而浪費昂貴的紅外濾波片。像素級真空封裝也是為了提高封裝效率而研發的一種封裝方法。一個代表性的案例是由CEA-LETI研發的,其創新之處是在圓片上用半導體薄膜對像素進行真空封裝。然而,方案中使用薄膜作為封裝蓋板,比較脆弱,難以有效保護內部脆弱的像素結構。
上述封裝方案中沒有光讀出紅外焦平面陣列(optically readable infrared focal plane array,ORIRFPA)芯片所需的可見光窗口,因而需要研發新的封裝方法。本文提出了一種新穎的真空封裝方法:硅墊片和玻璃可見光窗口通過陽極鍵合形成容納芯片的封裝腔體;紅外窗口作為封裝蓋板,不僅可以選擇性增透波長8~14 μm的紅外輻射,而且可以有效地保護內部的像素結構。
1 ORIRFPA工作氣壓對其像素性能的影響
ORIRFPA通過機械變形將目標的紅外圖像轉換為可見光圖像[5~9],其成像性能一般由噪聲等效溫差(noise equivalent temperature difference,NETD)來衡量。而NETD∝G[5],G為ORIRFPA芯片的總熱導。對于ORIRFPA
G=Gconst+Gair.
(1)
Gconst由ORIRFPA芯片的材料、結構等參數決定,對于一個特定的芯片而言是個定值,且與其工作氣壓無關。Gair為與ORIRFPA芯片工作氣壓p相關的熱導,即封裝腔體內部空氣熱傳導熱導[6]。下面將詳細分析Gair與芯片工作氣壓p的關系。
真空封裝結構剖面如圖1所示,d1=20 μm是像素到襯底的距離;d2=730 μm是像素到封裝殼體上表面的距離。

圖1 真空封裝結構剖面示意圖
在標準大氣壓下,像素和襯底以及封裝殼體之間的空氣熱傳導熱導為[6]
(2)
其中,kair=26×10-2W/(m·K)為空氣的熱導率,Am為微鏡面積,d2遠大于d1,則后一項可以忽略,所以
(3)
在稀薄空氣下,kair是氣壓p的函數,其關系式為[6]
(4)
kair0=26×10-2W/(m·K)為一個大氣壓p0下的空氣熱導率,λ0為一個大氣壓下空氣分子的平均自由程,而分子平均自由程與氣壓的關系為
(5)
其中,玻耳茲曼常數kB=1.38×10-23J/K,氣體的溫度為T,空氣分子的平均直徑是δ=3.5×10-10m。當p<308.5Pa時,λ>20μm,像素與襯底之間的距離會限制空氣分子的運動。所以,當p<308.5Pa時,實際的平均自由程取20μm,即λ=20μm,故
kair=8.43×10-5p,
(6)
(7)
如圖2所示,空氣熱傳導熱導與封裝腔內氣壓呈線性關系。由于NETD∝G∝p,要提高ORIRFPA芯片的性能,即減小NETD,則需要對芯片進行真空封裝來降低芯片工作氣壓p。
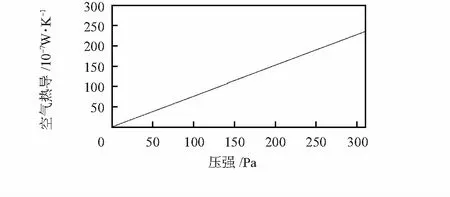
圖2 空氣熱導隨壓強變化曲線
而與氣壓無關的像素本身熱導(熱輻射熱導和梁結構的熱導)為1.34×10-7W/K[6]。當封裝內部氣壓p為1.77Pa時,空氣熱導等于像素本身熱導。所以,當氣壓小于1.77×10-2Pa時,空氣熱導只有像素本身熱導的1 %,影響可以忽略不計,故紅外芯片需要的內部真空度至少要低于1.77×10-2Pa。
2 ORIRFPA芯片真空封裝結構與ANSYS仿真
針對光讀出紅外芯片的特點,提出了一種新穎的真空封裝方法:首先,制作用于真空封裝的腔體;然后,挑選出性能合格的IRFPR芯片;第三,將芯片焊料鍵合到封裝腔體內;最后,在真空室內將紅外蓋板焊料鍵合到封裝腔上完成真空封裝。
封裝結構如圖3所示,真空封裝由三部分構成:玻璃可見光窗口、硅墊片和紅外窗口,硅墊片和玻璃可見光窗口通過陽極鍵合形成用來放置芯片的封裝腔體;紅外窗口不僅對波長8~14μm的紅外輻射進行選擇性增透,而且用來作為封裝蓋板,可以較好地保護內部脆弱的芯片結構。

圖3 封裝結構圖
假設封裝結構內部為真空、外部為一個大氣壓,采用ANSYS有限元分析軟件對該真空封裝結構進行了仿真,其結果如圖4。由仿真分析可知,應力最大值是34.42MPa,分布在封裝腔體的內棱中間位置(圖4中圓圈所示)。已知硅的屈服強度是6GPa,所用的Pyrex7740玻璃的屈服強度至少是150MPa。仿真結果表明:采用硅、玻璃來制作ORIRFPA真空封裝腔體是完全可行的。

圖4 封裝結構應力分布剖面圖
3 真空封裝結構制作
如圖5所示,真空封裝結構制作流程為:
1)硅墊片的制作:使用KOH腐蝕工藝制作硅墊片;
2)硅墊片和玻璃可見光窗口陽極鍵合,形成封裝腔體;
3)在封裝腔體上制作Au并圖形化,形成Au粘附層;
4)將本實驗室已制備的性能良好的ORIRFPA芯片焊料鍵合到封裝腔體內;
5)制備紅外窗口:使用普通硅片作為紅外窗口,在上面濺射Au并圖形化,形成粘附層;
6)紅外窗口在真空環境下焊料鍵合到封裝腔體片上,完成真空封裝。

圖5 真空封裝制作流程
制作得到了所需的真空封裝結構,如圖6所示。

圖6 封裝實物圖
4 測試結果與分析
將12組真空封裝樣品(其中10組未加入紅外芯片的封裝片,2組加入紅外芯片)進行氟油粗檢,結果無氣泡產生,初步說明封裝結構具有氣密性。
將已通過氟油粗檢的ORIRFPA真空封裝芯片進行了熱成像測試并得到了200 ℃電烙鐵的熱像圖,如圖7所示。

圖7 200 ℃電烙鐵熱像圖
真空封裝結構腔體容積為0.58×10-6m3,在真空封裝完成后104h測得200 ℃電烙鐵熱像圖;與不同真空度下芯片熱成像的能力對比,可知封裝腔體內部真空度約為1 000Pa,故該真空封裝結構的空氣漏率約為1.52×10-9Pa·m3/s,滿足了MIL—STD—883E對漏率的要求。
5 結 論
本文詳細闡述了一種新穎的光讀出紅外成像焦平面陣列芯片的真空封裝方法,該真空結構包括三部分:玻璃可見光窗口、硅蓋板和紅外窗口。該真空封裝通過了氟油粗檢, 漏率為1.52×10-9Pa·m3/s,符合MIL—STD—883E對漏率的規定。該真空封裝后的紅外成像焦平面陣列芯片可以對200 ℃的電烙鐵清晰成像,表明了該真空封裝方法是有效的。
[1]HataH,YoshiyukiNakaki,HiromotoInoue,etal.UncooledIRFPAwithchipscalevacuumpackage[C]∥ProcofSPIEonInfraredTechnologyandApplicationsXXXII,Orlando,2006:620619—1-620619—10.
[2]GoochR,SchimertT,McCardelW,etal.Wafer-levelvacuumpackagingforMEMS[J].JVacSciTechnolA,1999,17(4):2295-2299.
[3]AstierA,ArnaudA,Ouvrier-BuffetJ,etal.AdvancedpackagingdevelopmentforverylowcostuncooledIRFPA[C]∥ProcofSPIEonInfraredComponentsandTheirApplications,Bellingham,2004:107-116.
[4]DumontG,RabaudW,BaillinX,etal.PixellevelpackagingforuncooledIRFPA[C]∥ProcofSPIEonInfraredTechnologyandApplicationsXXXVII,Orlando,2011:80121I—1-80121I—7.
[5]ZhaoY,MaoM,HorowitzR,etal.Optomechanicaluncooledinfraredimagingsystem:Design,microfabrication,andperforman-ce[J].JMEMS,2002,11(2):136-146.
[6] 楊廣立.微機械反射式光讀出非制冷紅外成像陣列器件研究[D].上海:中國科學院研究生院上海微系統與信息技術研究所,2007:25-27.
[7] 馮 飛,焦繼偉,熊 斌,等.一種新穎的基于MEMS技術的光讀出熱成像系統性能分析與制作[J].紅外與毫米波學報,2004,23(2):125- 130.
[8] 楊廣立,馮 飛,熊 斌,等.一種微機械光讀出紅外成像陣列器件機械特性對器件性能影響的研究[J].光學精密工程,2007,15(5):699-705.
[9]OuYi,LiZhigang,DongFengliang,etal.Design,fabrication,andcharacterizationofa240×240MEMSuncooledinfraredfocalplanearraywith42μmpitchpixels[J].JMEMS,2013,22(2):452-461.
Vacuum packaging research of optically readableinfrared imaging chip*
ZHANG Yun-sheng1,2, FENG Fei1, WEI Xu-dong1, GE Xiao-hong1, WANG Yue-lin1
(1.Shanghai Institute of Microsystem and Information Technology,Chinese Academy of Sciences,Shanghai 200050,China; 2.University of Chinese Academy of Sciences,Beijing 100049,China)
A novel vacuum packaging method is proposed for vacuum packaging optically readable infrared imaging focal plane array(ORIRFPA)device.The vacuum packaging structure is made up of three parts,a visible light window,a silicon spacer,and an infrared window.The silicon spacer is bonded to visible light window-glass using anodic bonding to form packaging cavity,for chip placement;infrared window is not only used to selectively transmit infrared radiation ranges from 8 μm to 14 μm,but also is used as packaging cover board;packaging cavity is solder bonded to infrared window in vacuum chamber.Then the packaging structure passes air tightness test,and thermal images of soldering iron at temperature 200 ℃ are test and obtained.
vacuum packaging; IRFPA; optically readable; anodic bonding; solder bonding
2014—06—06
國家自然科學基金資助項目(60876081,61172151); 國家“ 863”計劃資助項目(2009AA04Z317)
10.13873/J.1000—9787(2015)02—0044—03
TN 215
A
1000—9787(2015)02—0044—03

