RF LDMOS功率器件關鍵參數仿真
陳慧蓉,顧愛軍,徐 政
(中國電子科技集團公司第58研究所,江蘇 無錫 214035)
1 引言[1]
為解決傳統MOS功率器件擊穿電壓與工作電流之間的矛盾,1969年Y.Tarui提出了LDMOS器件結構,直到20世紀90年代,LDMOS器件基本作為開關器件用于電源及電機控制等領域。20世紀90年代,隨著移動通訊的發展,移動基站對射頻功率器件的性能提出了新的要求,MOTOROLA公司投入巨資進行射頻線性LDMOS功率器件的研發,LDMOS才真正作為射頻功率器件出現并一舉擊敗硅雙極及GaAs功率器件,占據移動基站用線性射頻功率器件90%以上的市場份額。現在LDMOS射頻功率器件輸出功率已經達到kW級,增益、效率及可靠性都有了顯著的提升,隨著LDMOS射頻功率器件設計和加工技術越來越成熟以及可靠性的不斷提高,LDMOS又在向脈沖大功率應用領域發展,適合雷達脈沖使用的LDMOS新產品也在不斷被推向市場,國內外對LDMOS器件在雷達系統上應用也進行了大量的研究。
2 主要參數[2]
RF MOS功率器件的主要參數包括擊穿電壓、截止頻率和導通電阻。
2.1 擊穿電壓
擊穿特性主要表現在源漏結的擊穿電壓和柵氧擊穿電壓。
源漏通常用高摻雜以減小電阻,因而源漏結的擊穿電壓主要取決于輕摻雜材料的雜質濃度和集中程度。摻雜濃度越低,擊穿電壓越高;結的曲率半徑rj越大,擊穿電壓越高。用擴散或注入形成的矩形源漏區,通常具有柱形或球形曲率半徑。當rj=1μm時,柱面結的擊穿電壓大約有100V,球面結只有50V左右;當rj=0.1μm時,柱面結的擊穿電壓大約有30V,球面結只有10V左右。隨著淺結的應用,曲率半徑越來越小,擊穿電壓的改善面臨挑戰。
100nm厚的高質量柵氧厚度可承受50V~100V的電壓,但是工藝中產生的缺陷、金屬沾污、針孔等使得柵氧的擊穿特性變差。
提高擊穿電壓的辦法有:(1)RESURF優化技術,綜合考慮漂移區單位面積的總雜質含量、襯底雜質濃度、漂移區長度和漏結的曲率半徑;(2)漂移區輕摻雜;(3)增加結的曲率半徑,減小電場集中;(4)增加柵氧厚度;(5)柵介質材料和結構的變更。
2.2 截止頻率fT
截止頻率fT定義為短路電流增益為1時的頻率。常用表達式為式(1)~(3)。與載流子壽命成反比,主要由跨導和柵電容決定,跨導與柵長成反比,與氧化層電容成正比。事實上,RF LDMOS是一種特殊的短溝道MOSFET器件,溝道電子在很小的源漏電壓下就能達到飽和,不再隨源漏電壓變化,跨導變為常數,這是RF LDMOS具有極好線性、IM3小的主要原因。


提高頻率的方法有:(1)縮短溝道,降低Cgs,降低柵電阻;(2)溝道濃度要低;(3)漂移區輕摻雜、短、淺;(4)采用高阻外延降低源漏間電容Cds;(5)盡可能減小漏極電感;(6)減小柵電極和源漏n+區交疊形成的電容。
2.3 導通電阻Ron
按照簡化模型,導通電阻可以看成是由溝道電阻(Rchannel)、漂移區電阻(Rdrift)和源漏串聯電阻(Rds)三部分構成,其中Rds還包括連接到襯底的p+sinker電阻,即:

減小Ron的方法有:(1)縮短溝長,減小Rchannel;(2)減小LDD的長度,增加摻雜濃度,降低漂移區電阻。
由以上分析可以看出,BVDS、fT和Ron的優化相互之間存在著矛盾和制約。
3 參數仿真結果
3.1 工藝流程與器件剖面
工藝流程如下[3]:首先在電阻率0.01Ω·cm~0.02Ω·cm 摻硼<100> 晶向襯底上,外延生長一層濃度為1.3×1015cm-3、厚度9.5μm 的外延層,然后進行背面源結構的ICP刻蝕,濃硼擴散,多晶硅淀積,高劑量硼注入,隨后進行場區注入和場區氧化,接著進行柵犧牲層氧化并漂除,利用氫氧合成形成柵氧化層,再利用LPCVD淀積柵多晶硅,并光刻形成柵多晶硅圖形,利用柵多晶硅作為自對準邊界進行溝道注入推進以及源區注入推進,淀積金屬Co并形成難熔金屬硅化物CoSi2,至此LDMOS芯片的基本結構已經形成。
接下來的工藝是LPCVD淀積SiO2、Si3N4、開接觸孔、正面金屬化、鈍化、芯片減薄及背面金屬化等。
3.2 電參數仿真
漂移區的雜質分布是決定LDMOS器件性能的關鍵,它決定器件的導通電阻、擊穿電壓、輸出電容和安全工作區,表1對比了不同漂移區分布對參數的影響。
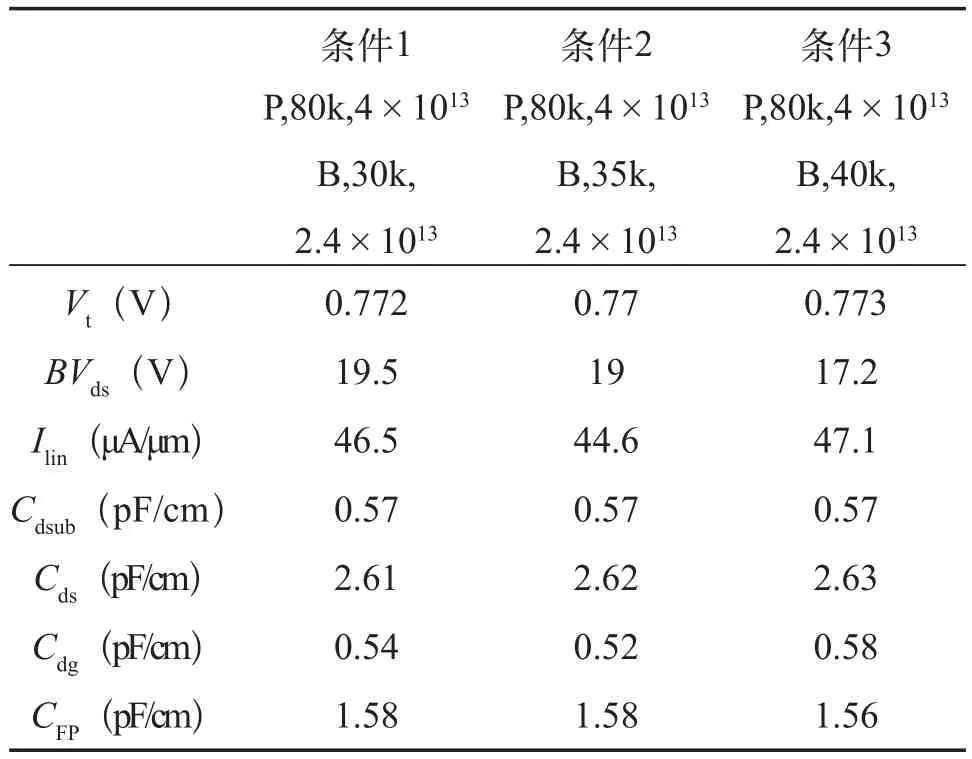
表1 漂移區注入對器件特性的影響
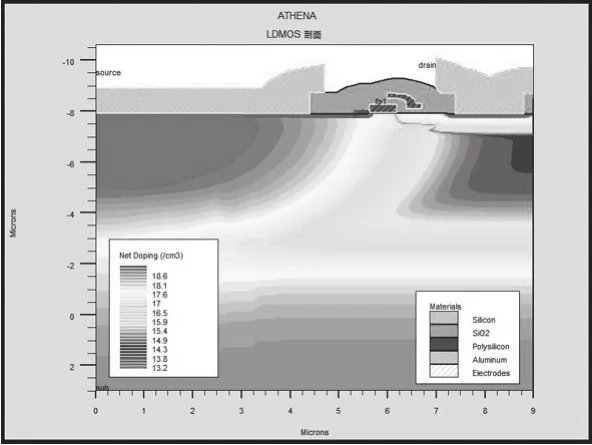
圖1 LDMOS剖面
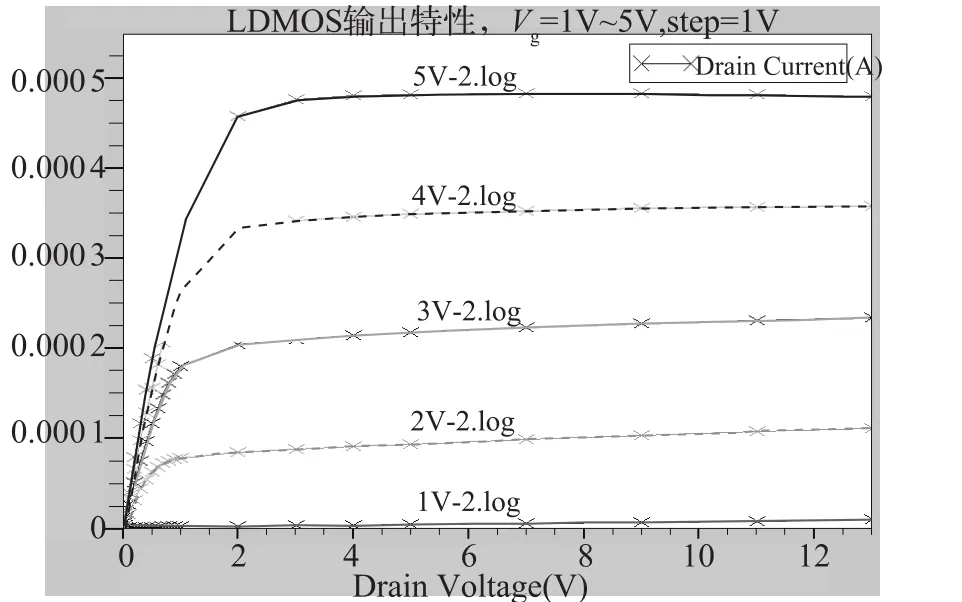
圖2 LDMOS輸出特性(Vgs=1V~5V,Vds=13V)
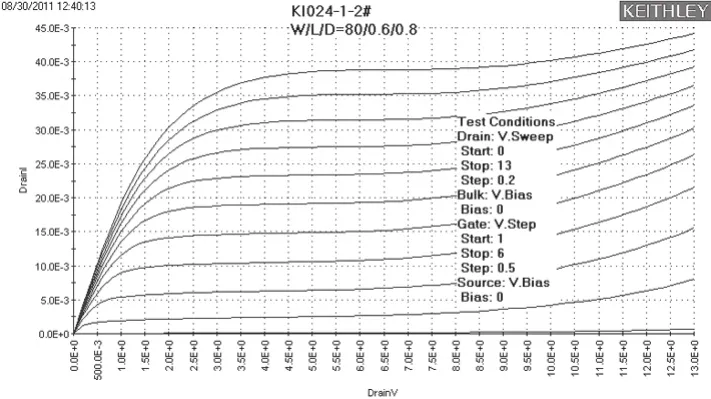
圖3 輸出特性(W/L=80/0.6)測量結果

表2 微波參數測試
測試條件為:偏置電流180mA,輸入功率25dBm。
4 結論
使用文中的工藝條件和器件結構,成功開發出典型工作電壓6V(可在3V~8V使用,優化結構后可達12V)、工作頻率520MHz、效率58%、SOT89封裝、輸出功率6W的系列產品(1W、2W、4W、6W)。
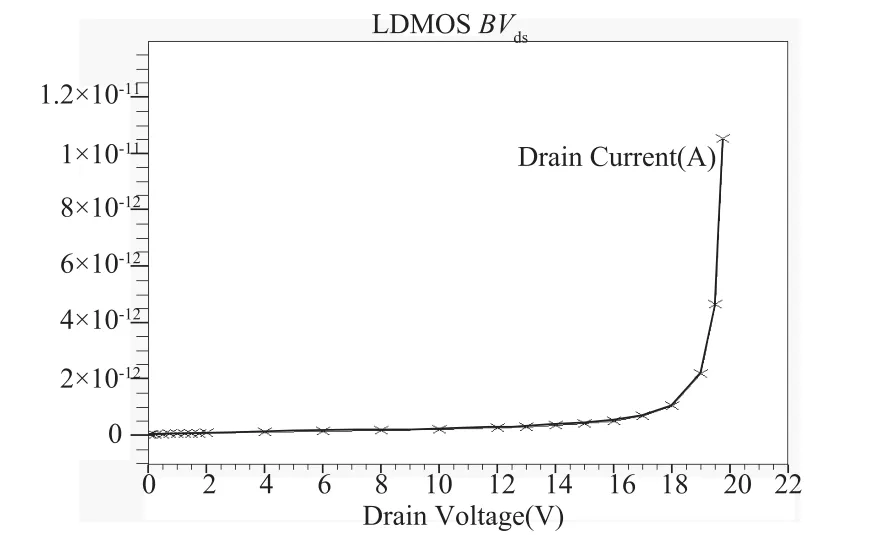
圖4 LDMOS擊穿特性(Vg=Vs=0),BVds=19.5V

圖5 擊穿特性測量結果(Vg=Vs=0),BVds=20.5V
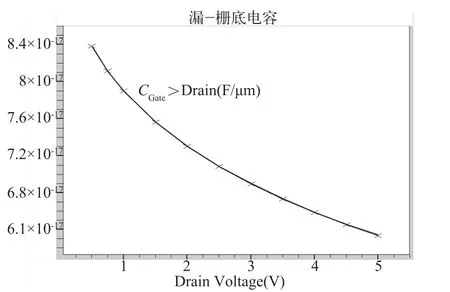
圖7 漏-柵電容隨漏壓變化
[1] 王佃利,等.硅LDMOS射頻功率器件的發展歷程與趨勢[J].固體電子學研究與進展,2011,31(2).
[2] 黃曉蘭,等.功率RF LDMOS的關鍵參數研究[J].半導體學報,2006,27(增刊).
[3] 王佃利,等.P波段450W硅LDMOS脈沖功率器件的研制[J].固體電子學研究與進展,2011,31(1).

