氮化硅薄膜的應力與性能控制*
周 東,許向東,王 志,王曉梅,蔣亞東
(電子科技大學光電信息學院, 電子薄膜與集成器件國家重點實驗室,成都 610054)
氮化硅薄膜是一種物理、化學性能均非常優秀的半導體薄膜,具有較高的介電常數、良好的耐熱抗腐蝕性能、和優異的機械性能等,因此,在微機電系統中常被用作絕緣層、表面鈍化層、保護膜和功能層等。目前為止,人們開發了多種制備SiNx薄膜的方法,例如低壓化學氣相沉積(LPCVD)、等離子增強化學氣相沉積(PECVD)等。但是采用傳統方法制得的氮化硅薄膜一般都處于某種應力狀態。應力的存在不僅削弱了SiNx薄膜的絕緣、鈍化、密封等效果,而且,還會直接影響到半導體器件的性能,從而制約了SiNx在實際中的應用。因此,對于SiNx薄膜,殘余應力及其性能的控制顯得至關重要。
SiNx薄膜殘余應力的控制方面,主要是運用傳統的“條件優化法”,即改變薄膜的制備工藝參數來達到減小應力的目的,而新的“結構優化法”是通過加入某些特定的介質層,或者設計特定的多層介質模型結構達到減小薄膜應力的目的。但在已發表的相關文獻中,往往把SiNx薄膜的應力和其它物理性能分開來討論,但探索兩者之間相互關系的文章較少。最 近, Jaddcbsen[1]和 Aumer[2]分 別對 Si和AlInGaN/InGaN量子阱的研究發現,通過薄膜壓力的適當調控可以促使薄膜的電學、光學特性等發生相應變化,這種現象被稱之為薄膜的“應力工程”,是當今學術界和工業界的一個研究熱點,越來越受微電子和光電領域專家們關注。
本文一方面,通過關鍵沉積條件的改變,利用傳統的“條件優化法”控制SiNx薄膜的殘余應力;另一方面,我們還通過引入多層膜結構,利用新的“結構優化法”調控SiNx薄膜應力。此外,本文還對相關薄膜的一些重要物理性能進行了測量,評估應力與這些物理性能之間的聯系。相關結果對深入理解SiNx薄膜性能、改進器件的制造工藝等,有一定的指導意義。
1 實驗部分
本實驗中, SiNx和SiO2薄膜都是通過PECVD制備。實驗步驟如下:首先,用piranha溶液清洗直徑為100 mm的Si(100)晶片,在80 ℃下浸泡10 min;然后,用稀釋的HF溶液清洗硅片90 s,清除有機物雜質及表面氧化物;最后,用N2吹干硅片,然后,傳到PECVD系統(Orion II, Trion)沉積SiNx和SiO2薄膜。沉積的樣品分別由下面儀器系統分析:掃描電子顯微鏡(SEM,JSM-5 900 LV),臺階儀(Alpha-Step 500),拉曼光譜儀(Renishaw inVia),橢圓偏振儀(SE850),納米壓痕儀(CSM,Nano Hardness&Scratch Tester)和X光電子能譜(XPS,PHIQuantera SXM)等。
2 結果與討論
2.1 條件優化法調控SiNx薄膜的應力
在沉積SiNx薄膜的過程中,反應氣體SiH4與NH3的流量比是影響SiNx薄膜應力和成分的重要因素。為了研究反應氣體流量比對SiNx應力的影響,本文選擇高頻PECVD模式,在其它工藝條件保持不變的情況下,僅改變硅烷的流量,制備一系列SiNx薄膜,測量相關薄膜的應力與其它性能。工藝條件如下:沉積功率為 60 W, 腔室氣體壓強為0.6 Torr,反應氣體流量比NH3/N2=30/1 000 sccm,上下電極溫度為300/250 ℃,沉積時間為15 min;依次改變硅烷流量為6, 10, 20, 30, 40, 50 sccm。氣體流量比對氮化硅應力影響如圖1。
圖1揭示,在實驗條件下,利用高頻PECVD制備的氮化硅薄膜表現為張應力。當SiH4/NH3流量比由1/3 增至1/1時,薄膜殘余應力隨流量比增大呈下降趨勢;然而,當SiH4/NH3的流量比繼續增大時,氮化硅薄膜殘余應力又呈上升趨勢。其中,流量比為1/1時,所制備的氮化硅薄膜的殘余應力最小。
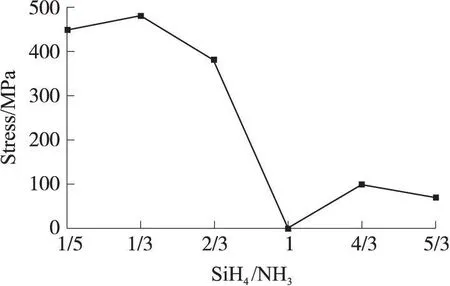
圖1 高頻PECVD氮化硅薄膜殘余應力與SiH4/NH3 的流量比的關系曲線
進一步利用橢圓偏振技術,對相關氮化硅薄膜的特性進行測量,相關結果總結在表1中。表1表明,隨著硅烷流量的增加:(1)氮化硅薄膜的沉積速率不斷增大,然而,薄膜的均勻性卻不斷變差(非均勻性增大);(2)所制備的氮化硅薄膜的光折射率不斷增大;(3)氮化硅薄膜的光學帶隙不斷減少。

表1 沉積速率、非均勻性、折射率、Eg與SiH4 流量關系
上述實驗表明,通過條件的優化(如反應氣體流量比、或沉積溫度等),可以較好地調控薄膜的殘余應力,從而制備出具有理想薄膜應力的SiNx薄膜;但是,條件變化對薄膜的其它物理性能也將產生較大影響。例如,通過硅烷流量的增大,可以使SiNx薄膜的折射率增大,但同時,光學帶隙(Eg)也發生減小。為了克服“條件優化法”在該方面的不足,本文進一步采用下面介紹的結構優化法來控制SiNx薄膜的應力。
2.2 結構優化法調控SiNx薄膜的應力
本實驗中, SiNx和SiO2薄膜都是通過PECVD制備,測試薄膜應力的多層膜結構和鍍膜工藝如圖2。鍍膜工藝參數如下:射頻頻率為13.56 MHz, 功率600 W,反應室溫度為300 ℃,壓強為0.6 Torr,反應氣體N2O/SiH4流量比為 100/150 sccm, NH3/SiH4流量比為200/250 sccm。
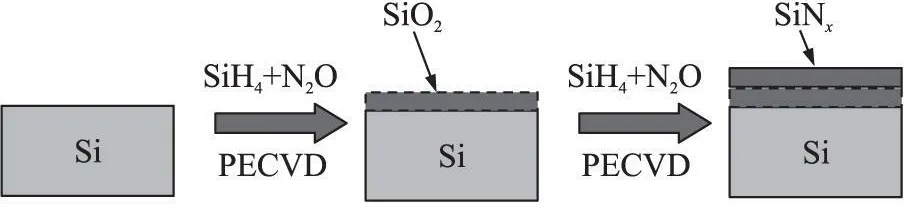
圖2 改變應力的多層膜結構及相關的制備工藝
薄膜的表面形貌由SEM進行測量, 圖3a為550 nm SiO2/Si(100)的SEM圖像, 在外延層與Si襯底相接觸的地方沒有觀察到明顯的界面,這與氮化硅薄膜(圖3b)的情況明顯不同。圖3b為110 nm SiNx/Si(100)的SEM圖, SiNx與Si的界面非常明顯。此外,圖3b還顯示,在薄膜表面還有谷峰和一個突起表面,這暗示在SiNx薄膜表面相對不平整。圖3c為110 nmSiNx/240 nm SiO2/Si(100)的SEM圖,可以看出,在多層膜結構(圖3c)中, SiNx/SiO2和SiO2/Si的界面都不明顯,而且,薄膜表面變得非常平整、沒有如圖3b的突島出現。
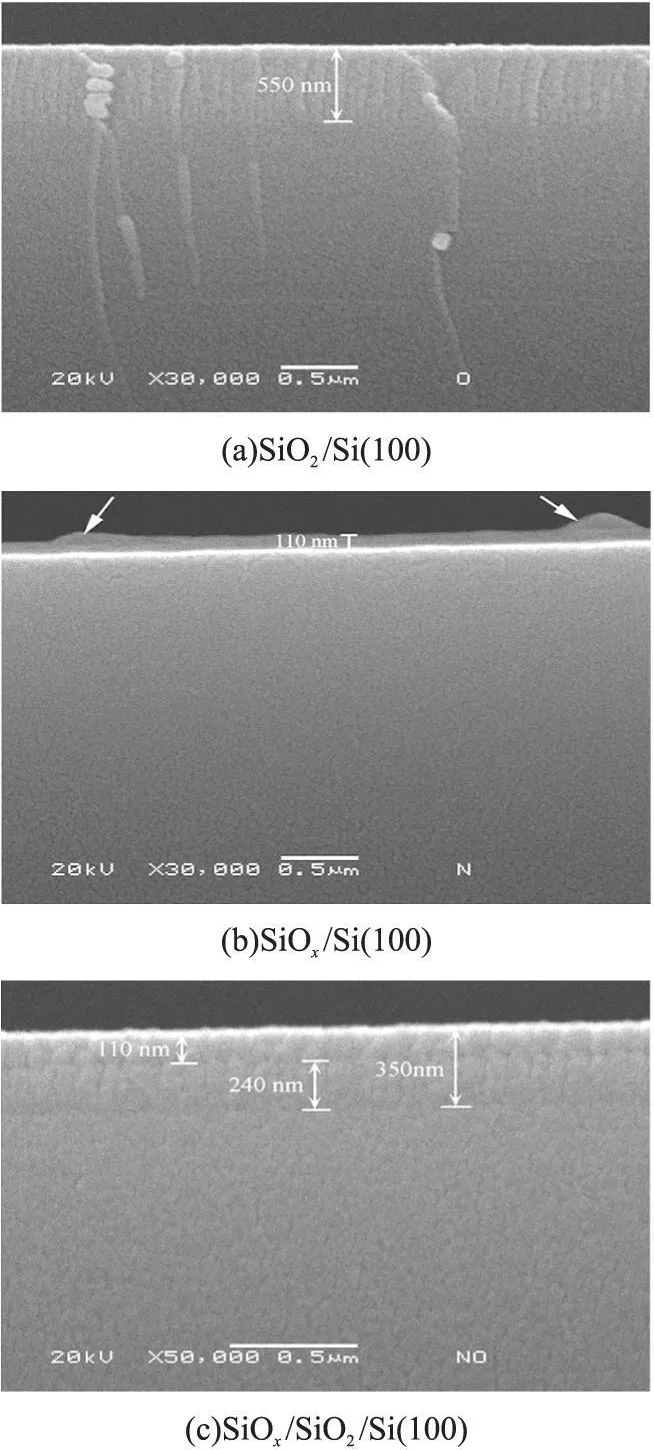
圖3 樣品斷面SEM圖像
本文運用曲率測量的方法來計算SiNx薄膜的殘余應力,最終結果如圖4所示。薄膜應力狀態很容易通過曲線形狀來判斷,若曲線呈凸線(如圖4a,c)說明薄膜呈壓應力(記為負號),若為凹線(如圖4b)為張應力(記為正號)。雙軸薄膜應力可通過Stoney公式定量地計算出來[3]:


圖4 樣品的曲率圖
式中R0,R分別為有、無外延薄膜時襯底的曲線半徑;ts, tj分別為襯底和表面薄膜的厚度;Es為襯底楊氏模量,對于Si襯底有:Es/(1-vs)=180.5 GPa, vs為泊松比。將圖4中曲率半徑結果和SEM測得的薄膜厚度代入式(1)中,可算出550 nm SiO2/Si(100), 110 nm SiNx/Si(100)和110 nm SiNx/240 nm SiO2/Si(100)樣品殘余應力分別為-610、+358和-57 MPa。
本文還利用拉曼光譜儀對薄膜應力進行測量與驗證。在拉曼光譜測試中,采用激勵光源波長為514.5 nm、功率為10 mW的氬離子激光器。由于應力的存在使拉曼譜峰發生位移,位移的程度反映了應力的大小。本文中,薄膜的殘余應力σ利用如下的經驗公式[4]進行計算:

式中k為相關系數(518 MPa?cm)[5], ω, ω0分別為Si基底在有、無應力時的拉曼頻率。通過實驗,本文中拉曼峰值確定為w0=520.45 cm-1。圖5為典型的拉曼光譜,將拉曼頻率和參數(k和w0)[4]代入公式(2),可分別得到550 nm SiO2/Si(100), 110 nm SiNx/Si(100), 和110 nm SiNx/240 nm SiO2/Si(100)樣品的應力分別為-575、+399、-47 MPa,與曲率半徑的測量結果很好地相吻合,都表明SiO2過渡層的存在確實可以減少表層SiNx薄膜的張力。這說明,我們通過構建多層膜調節薄膜應力的想法是確實可行的。

圖5 550 nm SiO2/Si(100), 110 nm SiNx/Si(100)和110 nm SiN1/240 nm SiO2/Si(100)樣品拉曼光譜
在實際應用中,楊氏模量Ef和薄膜硬度Hf也是非常重要的參數,圖6為實驗獲取的典型的載荷壓痕深度(P-h)曲線。本文中,每個樣品都進行了十次壓痕測試,運用 Oliver和Pharr的方法[6]計算相關薄膜的楊氏模量與薄膜硬度,并取其平均值,最終得到單層和雙層結構中SiNx薄膜的楊氏模量分別為289.7±20.2 和 235.8±21.9 GPa,其硬度分別為45.3±4.1 和35.1±5.1 GPa,表明SiNx的Ef和Hf值都隨著張應力的減少而減少。

圖6 550 nm SiO2/Si(100)(a)和110 nm SiNx/240 nm SiO2/Si(100)(b)樣品載荷 壓痕深度曲線
而且,本文還通過橢圓偏振儀(采用氙燈為光源,測量波長范圍為280-800 nm)檢測所制備的SiNx薄膜的光學性能。SiNx折射率運用柯西—洛倫茲模型來計算,其均方根誤差為0.87 ~1.63。圖7表明了單層和雙層膜結構SiNx薄膜的折射率均隨著入射光波長的增加而減少。需要注意的是,在測量波長范圍內,單層結構的SiNx薄膜的折射率都比雙層結構中SiNx的折射率小。考慮到這兩種SiNx薄膜樣品中的殘余應力分別為+358 MPa的張力和-57 MPa的壓應力,這說明SiNx薄膜的折射率隨著薄膜張力的減少而增大。我們注意到,該實驗結果與Toivola、Gorokhov等[7-8]運用LPCVD制備SiNx薄膜的測試結果相類似,都表明SiNx薄膜的折射率與薄膜應力存在著上述聯系。
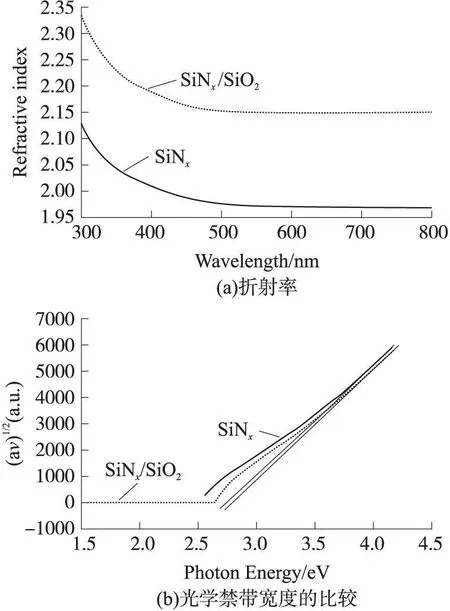
圖7 110 nm SiNx/Si(100)和110 nm SiNx/240 nm SiO2/Si(100)樣品
根據橢偏儀測量結果,可以通過Tauc關系[9]推測不同薄膜的光學帶隙Eg

其中α為吸收系數, hν為光子能量, A為常數。其中α=4πk/λ, k為橢偏測量的消光系數, λ為入射光波長。
圖7(b)為上述兩種氮化硅薄膜的Eg值,分別為2.74±0.03 eV和2.78 ±0.04 eV。令人驚奇的是,圖7(b)結果表明單、雙層結構的氮化硅薄膜的Eg非常接近,并不像圖7(a)所示的折射率的差別那么大。除此之外,考慮到化學計量比Si3N4的Eg為5.0 eV、折射率為2.0[7],圖7(a)和(b)的結果還表明,本文中兩種樣品可能都是富Si型氮化硅薄膜。通過對110 nm SiNx/Si(100)樣品在Ar+濺射15 min后獲取的XPSSi 2p和N 1s譜圖,計算得到N/Si比為1.11 ~1.13。對于雙層膜, N/Si原子比的XPS測量結果也為1.11 ~1.13,與單層膜的結果相同。XPS進一步證明,樣品確實為富Si型SiNx薄膜。如圖8所示,通過對SiNx、Si的結合能分析還表明,單、雙層膜的SiNx薄膜中都含有少量Si成分。由此可知,圖7(b)中SiNx薄膜的光學禁帶寬度低可歸因于SiNx中含有Si成分,由此揭示:在SiNx薄膜中增加Si成分可減少禁帶寬度Eg,而增加SiO2可增加其禁帶寬度Eg。

圖8 110 nm SiNx/Si(100)中SiNx薄膜的XPSSi 2p圖譜
由上面的分析和研究可知,兩種方法制備的SiNx薄膜都是在相同的PECVD、相同的參數和工藝條件下制備的,而且SiNx薄膜厚度相同, XPS研究結果表明SiNx薄膜成分相同,不同的是在“結構優化法”調控薄膜應力的方法中,增加了SiO2介質層,從而降低了薄膜的內應力;另外,從“應力工程”的角度研究發現, “結構優化法”調控薄膜應力的同時,使SiNx薄膜的折射率增大,值得注意得是,光學帶隙基本保持不變,從而大大提高薄膜的光學性能,這些結論與Jaddcbsen[1]和Aumer[2]非常的相似,確實可以通過“應力工程”對應力控制的同時,改善薄膜的光學性能;但是本文也存在一些缺陷,在“結構優化法”調控薄膜應力試驗中發現,楊氏模量和硬度等力學性能相應減弱,因此引入了一個值得思考的問題,可能通過三層膜結構 (即 SiNx/SiO2/SiNx),或者多層膜結構改善該方面的缺陷。
3 結論
綜上所述,我們通過構建一種特殊的雙層膜結構,有效地控制了SiNx薄膜的殘余應力,由此使SiNx薄膜的殘余應力從高的張應力(+358 MPa)降低到低的壓應力(-57 MPa),應力的改變使SiNx薄膜的折射率發生增大、楊氏模量和硬度相應降低,重要的是, SiNx薄膜的光學帶隙基本保持不變。通過構建的雙層膜結構有效地改善了SiNx薄膜的質量和物理特性。該結構適合于應用到實際的器件制造中,尤其適用于非制冷紅外微橋探測器的懸浮微橋結構中。而且,我們的實驗還揭示, SiNx薄膜低的光學帶隙(~2.80 eV)主要是因為薄膜中含有Si成分,證明了SiNx薄膜的光學帶隙主要依靠其內部的化學組成。本文揭示一種通過構建多層膜結構控制薄膜應力,從而調控光電薄膜物理性能的新方法。
[ 1] Jacoben R S, Andersen K N, Borel, P I et al.Strained Silicon As a New Electro-Optic Material[J].Nature.2006, 441:199-202.
[ 2] Aumer M E, LeBoeuf S F, Bedair SM, et al.Effects of Tensile and Compressive Strain on the Lum inescence Properties of AlIn-GaN/InGaN Quantum Well Structure, Appl.Phys.Lett.2000,77:821-824.
[ 3] Stoney GG.The Tension ofMetallic Films Deposited by Electrolysis[ J] .Proc.R.Soc.London, Ser.A 1909, 82:172-175.
[ 4] Strikar V T, Swan A K, Unlu M S, et al.Micro-Raman Measurement of Bending Stresses in Micromachined Silicon Flexures[ J].Micro-Electro-Mech.Syst.2003, 12:779-784.
[ 5] Wolf IDe, Vanhellemont J, Romanano-Rodrfguez A, et al.Micro-Raman Study of Stress Distribution in Local Isolation Structures and Correlation with Transmission Electron M icroscopy[ J] .Appl.Phys.1992, 71:898-906.
[ 6] Oliver W C, Pharr G M.An Improved Technique for Determining Hardnessand Elastic Modulus Using Load and Displacement Sensing Indentation Experiments[J] .Mater.Res.1992, 7:1564-1583.
[ 7] Toivola Y, Thurn J, Cook R F, et al.Influence of Deposition Conditions on Mechanical Properties of Low-Pressure Chemical Vapor Deposited Low-Stress Silicon Nitride Films[ J] .Appl.Phys.2003, 94:6915-6922.
[ 8] Gorokhov E B, Prinz V Ya, Noskov AG, etal.ANovelNanolithographic Concept Using Crack-Assisted Patterning and Self-Alignment Technology[ J] .Electrochem.Soc.1998, 145:2120-2132.
[ 9] Tong Li, Jerzy K, Wei K, et al.Interference Fringe-Free Transm ission Spectroscopy of Amorphous Thin Films[ J] .Appl.Phys.2000, 88:5764-5771.

