0.5μm有源區腐蝕工藝的正交優化
秦永偉,趙金茹,王春棟,李 俊
(中國電子科技集團公司第58研究所,江蘇 無錫 214035)
0.5μm有源區腐蝕工藝的正交優化
秦永偉,趙金茹,王春棟,李 俊
(中國電子科技集團公司第58研究所,江蘇 無錫 214035)
文章基于Precision 5000等離子刻蝕技術,運用正交優化實驗法,控制由LPCVD制備的Si3N4膜層對SiO2的選擇比,對0.5 μm有源區腐蝕工藝進行優化。運用minitab軟件獲得選擇比的主效應圖、效應的Pareto圖、正態概率圖,并討論O2、Ar、CHF3氣體對選擇比的影響,最終獲得各氣體成分的最佳配比。實驗結果表明有源區腐蝕中通過提高過腐蝕中Si3N4對SiO2的選擇比來減少SiO2的損失,可以成功地將SiO2的損失控制在合理范圍內,且腐蝕后平面、剖面形貌等各種參數符合產品要求。
選擇比;有源區腐蝕;正交優化實驗法
1 引言
隨著器件尺寸的不斷縮小,對等離子體刻蝕技術提出了更高的挑戰。本文采用Precision 5000設備腐蝕有源區,主腐蝕步(ME)采用終點檢測系統來控制Si3N4腐蝕過程,當Si3N4下面一層材料SiO2剛好露出來時,Si3N4便停止腐蝕。理想情況下,要腐蝕的薄膜厚度和腐蝕速率均是完全均勻的,并不需要過腐蝕步(OE),所以相對于襯底的選擇比也就不用考慮了。實際工藝中這種理想狀態是不存在的,并且當各向異性腐蝕遇到臺階形貌時,過腐蝕步總是需要的,但是有源區過腐蝕中Si3N4相對于SiO2的選擇比必須足夠大,從而避免底層的氧化物被完全刻蝕,避免Si襯底受到實質性刻蝕。因為過度的刻蝕硅襯底,將會影響整個器件的性能。本文針對有源區腐蝕后剩余SiO2一直為零的問題,運用正交優化實驗法對Si3N4腐蝕的過腐工藝進行優化,使Si3N4下層材料SiO2損失控制在15nm以內,且剖面形貌合格(α>75°),如圖1。
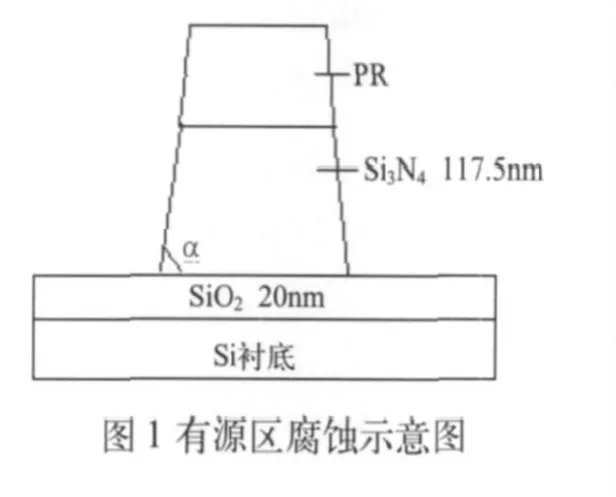
2 反應離子刻蝕(RIE)原理
Si3N4是一種優質的電介質材料,通常以LPCVD或PECVD制得,作為氧化隔離介質或鋁鈍化層。刻蝕Si3N4的氣體很多,通常能產生F、CL活性機的氣體都可以刻蝕Si3N4。主要以CF4或CHF3作為典型的F離子源。同時F離子也是刻蝕SiO2的主要氣體成分,因此以F離子源刻蝕Si3N4的選擇比通常比較低。表1列舉了由這些氣體產生的等離子體進行刻蝕時有代表性的氣體及材料。

本文主要研究以CHF3作為F的等離子體氣體源來刻蝕Si3N4膜層,其中Ar主要用于濺射刻蝕(即通過碰撞產生刻蝕作用),Ar同時也起到氣體稀釋、增加碰撞幾率的作用。本實驗通過調節O2、Ar、CHF3的氣體比例,來控制由LPCVD制備的Si3N4膜層對SiO2的選擇比, 刻蝕機理反應方程式如下:

其中O2和SiO2分解出來的氧等離子體在高壓下與基團反應,生成CO↑、CO2↑、H2O↑、OF↑等多種揮發性氣體,從而完成表面刻蝕。
3 實驗過程
本實驗在原來過腐蝕(OE)菜單基礎上進行優化,主腐蝕步驟不做改變,仍然采用終點檢測系統自動找終點。
原來過腐蝕(OE)菜單為:
Press:60 mtorr;RF:250 W;CHF3:12 sccm;Ar:45 sccm;O2:5 sccm。
Si3N4速率為109.4nm/min,SiO2速率為63.06nm/min,故Si3N4對SiO2的選擇比為1.73。其中壓力和功率不做改變,通過正交優化試驗,拉偏過腐蝕步(OE)中的Ar、CHF3、O2配比,提高Si3N4對SiO2的選擇比。
現在采用Minitab軟件進行實驗設計,本文中采用的3因子2水平的正交實驗,共進行4次試驗,考察Ar、CHF3、O2的流量對選擇比的貢獻(本實驗中所指選擇比都是指Si3N4對SiO2選擇比),如表2所示。根據Minitab給出的實驗設計進行實驗,實驗數據結果見表3。

由Minitab工具進行數據分析,選擇比作為反應值,得出選擇比的主效應圖、效應的Pareto圖、正態概率圖,最后由Minitab生成最優條件篩選圖。
圖2為選擇比的主效應圖,其中縱坐標為輸出力矩,橫坐標為所設計實驗的各因子水平,其中傾斜度越大表示符合水準的效果越大。從圖2中可以明顯看出,氧氣的流量從5sccm升高到10sccm時,氮化硅對二氧化硅的選擇比迅速上升;當氬氣流量增加時,選擇比增加較為平緩;而當三氟甲烷流量增加時,選擇比反而降低。
圖3為效應的pareto圖,Pareto圖可同時看到效果的大小與重要性。超過指針線(即圖中虛線)的C因子為有影響,即氧氣的流量對選擇比影響最大。
圖4為正態概率圖,離直線遠離的因子可認為信號因子,從圖中可以看出C因子O2對選擇比有較大的影響,而其他因子對選擇比影響較小。

圖5為最優條件篩選圖,由Minitab軟件自動篩選的最優條件為:Ar:45sccm;CHF3:12sccm;O2:10sccm。這里的最優條件主要以選擇比作為標準。

以圖5獲得的選擇比最優條件作為實驗條件,獲得實驗結果為:二氧化硅腐蝕速率48.64nm/min;氮化硅腐蝕速率130.24nm/min;氮化硅對二氧化硅的選擇比為2.68。
最優化實驗結果與原菜單工藝結果相比,選擇比由原來的1.73提高到2.68,按照優化后的工藝進行正片工藝驗證,OE時間定為8s,重復做4片,損失的二氧化硅平均值為8nm,符合二氧化硅損失要求(<15nm)。

CD loss=0.6028-0.5764=0.026nm,CD Loss合格。
圖6、7為采用最優化條件進行實驗的SEM平面及剖面圖,采用優化實驗做出的有源區條平面圖形光滑無鋸齒狀,剖面形貌正常,角度為85.2°,無倒角。

4 結論
本文采用DOE實驗,用最少的實驗次數獲得了最多的信息量。實驗結果表明,Si3N4對SiO2的選擇比受O2的流量影響最大。同時運用MINTIB軟件獲得最優化條件,得到了Ar、CHF3、O2的最佳配比。實驗驗證結果良好,選擇比得到較大的提高,有源區腐蝕中SiO2損失可以控制在合理范圍內,且平面、剖面形貌等各種參數符合產品要求。這對以后半導體產品良率的提升具有一定的參考價值。
[1]Wang Chundong, Teng Baohua , Zhang Xianjun, et al. Investigation of the seeding-layer effect for a ferroelectric thin film with the transverse Ising model [J]. Physica A,2009, 388∶ 1472-1478.
[2]Michael Quirk, Julian Serda. 韓鄭生等譯. 半導體制造技術[M].北京:電子工業出版社,2004.
[3]施敏. 半導體期間物理與工藝[M].蘇州:蘇州大學出版社,2002.
[4]崔錚. 微納米加工技術及其應用[M].北京:高等教育出版社,2005.
Study of the Etching Technology in 0.5 Micro-island with Orthogonal Optimization Method
QING Yong-wei, ZHAO Jing-ru, WANG Chun-dong, LI Jun
(China Electronic Technology Group Corporation No.58Research Institute,Wuxi214035,China)
Based on the plasma etching technology in Precision 5000, by controlling the selecitivity between Si3N4(which was prepared by LPCVD) and SiO2, the etching technology in 0.5 micro-island was optimized with the help of the orthogonal optimization method. Using the software of Mintab,the main effect figure, the Pareto effect figure and the normal-probability effect figure were got. Meanwhile the influence of O2,Ar,CHF3to the selecitivity was investigated. The most suitable proportion of all the gases was found. The results show that the loss of SiO2can be sucessful controlled by improving the selecitivity between Si3N4and SiO2. In addition, the plane and the profile of Si3N4are all accord with the standard.
selecitivity; etching of island; orthogonal optimization method
TN305.7
A
1681-1070(2010)09-0038-03
2010-07-12

秦永偉(1981-),男,河北唐山人,2004年畢業于杭州電子科技大學,現為中國電子科技集團第58研究所二部設備維修工程師,主要從事設備維修和協助工藝研究及開發工作;
趙金茹(1983-),女,遼寧海城人,2006年畢業于遼寧大學,現為中國電子科技集團第58研究所二部腐蝕組工藝工程師,主要從事腐蝕工藝研究開發工作。

