固態熱遷移下Cu/SAC305/Cu微焊點界面IMCs微觀形貌演變研究
楊廓 李五岳 李爽 閆志成 田野
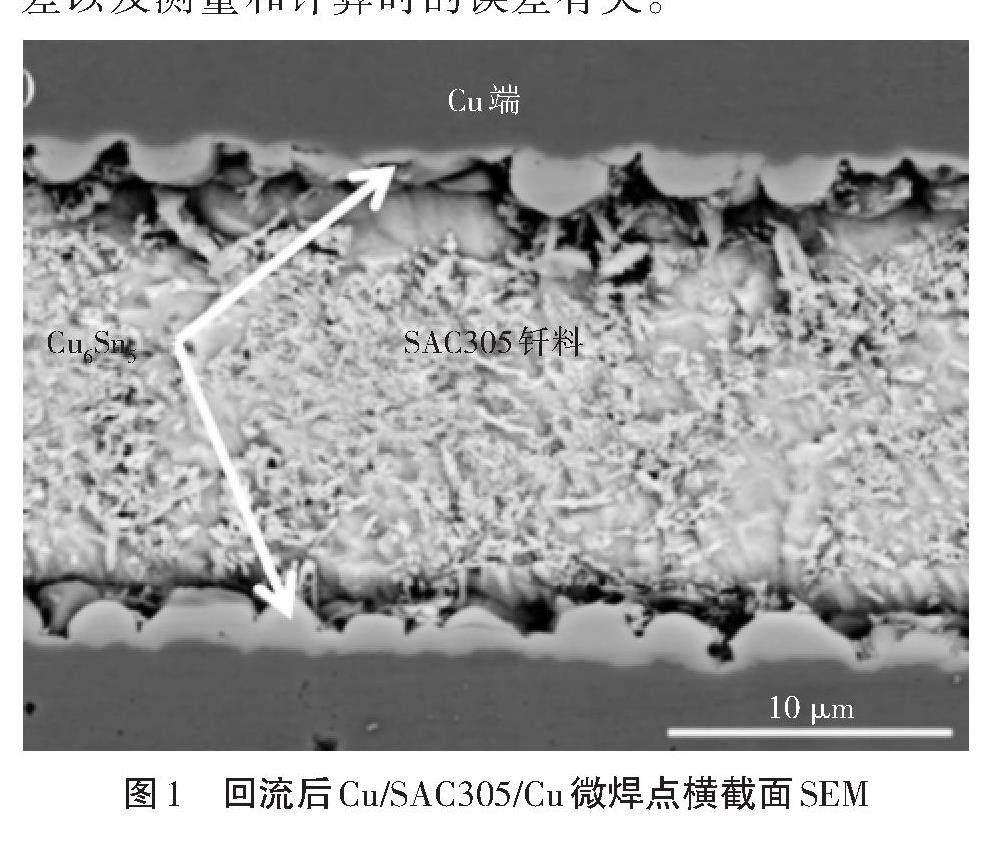


摘 要:【目的】研究固態熱遷移條件下Cu/SAC305/Cu微焊點中金屬間化合物(IMCs,Intermetallic Compounds)微觀形貌演變與非均勻化生長規律。【方法】使用回流焊機制備微焊點,并利用固態熱遷移平臺開展熱遷移試驗。【結果】隨著熱遷移時間的延長,在冷端Cu與Cu6Sn5界面處產生Cu3Sn新相,界面IMCs總厚度增加,形貌由均勻分布的扇貝狀轉化為層狀,微焊點界面存在冷端IMCs增長顯著快于熱端的非均勻化生長現象。【結論】研究了Cu/SAC305/Cu微焊點服役過程中微觀形貌演變規律,為可靠性評估提供一定的參考。
關鍵詞:Cu/SAC305/Cu微焊點;固態熱遷移;非均勻化生長
中圖分類號:TG40;TN405?? 文獻標志碼:A ????文章編號:1003-5168(2024)08-0040-04
DOI:10.19968/j.cnki.hnkj.1003-5168.2024.08.008
Microstructure Evolution of Cu/SAC305/Cu Micro-Solder Joint
Interface IMCs Under Solid State Thermal Migration
YANG Kuo LI Wuyue LI Shuang YAN Zhicheng TIAN Ye
(Henan University of Technology, Zhengzhou 450001, China)
Abstract: [Purposes] This paper studies the microstructural evolution and non-uniform growth law of intermetallic compounds in Cu/SAC305/Cu micro-solder joints under solid-state thermal migration conditions. [Methods] In this paper, the reflow soldering mechanism is used to prepare micro solder joints, and the thermal migration test is carried out by using the solid-state thermal migration platform. [Findings] As the thermal migration time increases, Cu3Sn new phase forms at the Cu/Cu6Sn5 interface on the cold side, and the total thickness of the intermetallic compounds (IMCs) at the interface increases. The morphology changes from a uniformly distributed fan-shaped structure to a layered structure. The micro-solder joint interface exhibits a non-uniform growth phenomenon where the growth rate of the IMCs on the cold side is significantly faster than that on the hot side. [Conclusions] This experiment investigates the microstructural evolution of Cu/SAC305/Cu micro-solder joints during service, providing valuable insights for reliability assessment.
Keywords: Cu/SAC305/Cu micro-solder joints; solid-state thermal migration; non-uniform growth
0 引言
芯片特征尺寸接近物理極限,制約了摩爾定律延續,導致半導體工業進入“后摩爾時代”[1]。與此同時,隨著人們對電子產品性能及可靠性要求的逐漸提高,電子產品不斷向微型化、高性能和多功能方向發展,致使三維IC集成微互連高密度化,互連尺寸不斷減小,微焊點的尺寸甚至縮小至10 μm以下[2]。這給微焊點的可靠性和工作壽命帶來了較大的挑戰,其中較為顯著的是在服役過程中,由溫度梯度導致原子定向遷移致使微焊點微觀結構轉變,從而顯著影響微焊點的力學性能。Cu/SAC305(Sn-3.0Ag-0.5Cu)/Cu互連結構為微電子封裝的主要焊接結構之一,因此研究在固態熱遷移條件下Cu/SAC305/Cu微焊接結構中IMC微觀結構演變有著重要意義,可為該種微焊點的可靠性評估提供一定的參考。
近年來,Ouyang等[3]采用原位觀察法研究了SAC305釬料的微焊點,發現Sn原子會在固態熱遷移效應作用下定向遷移至熱端,并在附近釬料中積聚,同時冷端形成大量的孔洞。Hsu等[4]研究了Cu/Sn-Ag/Cu微焊點的熱遷移現象對IMC的作用規律,發現隨著服役時間的延長,冷端界面的Cu6Sn5層明顯厚于熱端界面。Li等[5]研究發現冷端IMC的生長速率是熱端的2.7倍,并出現顯著的非均勻生長現象。隨著服役時間的增加,IMC厚度增加,使得非均勻現象愈加明顯,力學性能隨之發生改變,從而使微焊點的可靠性及工作壽命受到影響[6]。
本研究基于峰值溫度270 ℃下回流制備互連高度為20 μm的Cu/SAC305/Cu微焊點,通過控制微焊點在熱遷移平臺上的熱遷移時間,觀察不同時間節點(25 h、60 h、100 h和130 h)下焊點的微觀組織形貌,研究Cu/SAC305/Cu結構中熱、冷端兩端界面IMC的微觀形貌演變規律。
1 試驗過程及方法
試驗所用母材為T2級紫銅棒(純度99.9%、長度20 mm、直徑1 mm),釬料選用SAC305(尺寸為2 mm×2 mm×30 μm)。首先,制備微焊點。將母材和釬料清洗后,使用自制高精度夾具固定并控制互連高度在20 μm,后放入無鉛回流焊機(HW-R108NC)中,設置峰值溫度為270 ℃,回流時間為410 s,回流完成后迅速取出并冷卻至室溫。其次,開展熱遷移試驗。使用高溫膠將回流試樣固定在自制的熱遷移平臺上,設置焊點的溫度梯度為5 750 ℃/cm,并控制熱遷移時間為25 h、60 h、100 h和130 h。最后,觀察微觀組織形貌。將熱遷移試樣放入模具中,加入環氧樹脂進行冷鑲嵌固定,脫模后使用不同目數的砂紙進行粗磨和細磨,隨后依次使用粒徑為0.3 μm、0.05 μm的Al2O3拋光液進行拋光,接著將其置于1%鹽酸+99%無水乙醇混合液中腐蝕2 s。隨后將處理后的熱遷移試樣放置在SIGMA500蔡司掃描電子顯微鏡下,對橫截面形貌進行觀察,并利用ImageJ圖像處理和origin數據分析等軟件對試驗結果進行分析。
2 結果與分析
2.1 回流后Cu/SAC305/Cu微焊點微觀組織形貌變化
270 ℃下經回流鍵合410 s后Cu/SAC305/Cu微焊點的橫截面SEM如圖1所示。由圖1可知,微焊點組織形貌可分為銅母材、釬料層以及銅層與釬料層之間的界面IMC等三部分,其中界面IMC形貌為連續均勻的扇貝狀,兩側IMC的厚度分別約為0.733 μm、0.837 μm。兩側IMC層厚度存在微小的差距,可能與回流過程中微焊點兩側存在溫度差以及測量和計算時的誤差有關。
回流后界面IMC的EDX圖譜如圖2所示。由圖2可知,Cu原子百分比為54.82%,結合圖3的Cu-Sn二元相圖,可知界面IMC為Cu6Sn5,且沒有檢測到Cu3Sn存在。這是由于該微焊點在回流過程中發生反應擴散,即隨著溫度升高釬料熔化,Cu向熔融態釬料層中擴散,當Cu原子在釬料中的溶解度達到飽和后,Cu原子與Sn原子結合生成Cu6Sn5。
2.2 固態熱遷移下Cu/SAC305/Cu微焊點IMC演變研究
不同熱遷移時間下Cu/SAC305/Cu微焊點橫截面微觀形貌SEM如圖4所示。熱遷移25 h后的形貌如圖4(a)所示,可以觀察到兩側界面Cu6Sn5晶粒經熱遷移25 h后,由初始的扇貝狀轉變為較為平整的層狀。其厚度也有所增加,其中冷端增厚顯著,冷端厚度為2.740 μm,熱端厚度為0.954 μm。同時可以觀察到,在冷端Cu/Cu6Sn5界面處產生了一薄層IMC,對此層IMC進行EDX能譜分析,如圖5所示,Cu原子占比76.24%,Sn原子占比23.76%,并結合Cu-Sn二元相圖可知,此層IMC為Cu3Sn。其中Cu3Sn有兩種來源。Cu6Sn5層增厚從而有效抑制Cu原子向熔融態釬料中擴散,導致Cu6Sn5層中Cu原子濃度升高,Cu6Sn5與Cu原子反應生成Cu3Sn。同時界面處的Sn原子濃度較高時,Cu原子可以與Sn原子直接反應生成Cu3Sn。
隨著熱遷移時間增加到60 h,如圖4(b)所示,Cu6Sn5依然表征為層狀并產生明顯突起,冷端厚度顯著增加至7.570 μm,Cu3Sn厚度略微增加。熱端厚度有些許增長,為1.573 μm。熱遷移時間繼續延長至100 h和130 h,如圖4(c)和(d)所示,IMC形貌和種類不變,且明顯觀測到冷端界面Cu6Sn5的厚度增加迅速,Cu3Sn無明顯變化。熱端Cu6Sn5層的厚度略微增加。經測量,100 h和130 h冷端的厚度分別為8.180 μm和10.980 μm,熱端的厚度分別為2.168 μm和2.010 μm。
由圖4(d)可知,熱遷移130 h時,冷端IMC與熱端IMC部分接觸,釬料占比隨著Cu-Sn固-固反應而不斷減少,逐漸向全IMCs微焊點轉變,力學性能也隨之改變,由于IMC質硬脆,因此拉伸強度將會逐漸增加。
不同熱遷移時間Cu6Sn5層厚度變化如圖6所示。冷端厚度顯著增加,在60 h前厚度增加迅速,隨即減緩,最后在100 h后厚度增加再次加快;熱端厚度變化不明顯,始終保持均勻緩慢增加。兩側Cu6Sn5高度差隨著時間的延長而增加,非均勻化生長現象愈加顯著。這是由于在溫度梯度作用下,Cu原子自熱端向冷端遷移,冷端反應界面處Cu濃度始終處于高濃度狀態,該側的Cu6Sn5生長速率較快,厚度增長迅速。而熱端Cu原子濃度由于Cu原子的熱遷移而處于較低的狀態,Cu6Sn5生長速率較慢,熱端厚度增長緩慢。
綜上所述,熱遷移后兩側IMC形貌發生轉變,由均勻分布的扇貝狀轉為層狀,在冷端Cu和Cu6Sn5間產生Cu3Sn新相,兩側IMC厚度均有增加,并發生冷端生長速率遠大于熱端的非均勻性生長現象。
3 結論
①等溫回流過程中,Cu6Sn5為均勻連續的扇貝狀,且兩側Cu6Sn5層的厚度接近。
②熱遷移過程中,Cu6Sn5由扇貝狀逐漸轉化為層狀,并在冷端的Cu/Cu6Sn5界面處產生層狀Cu3Sn相。
③隨著熱遷移時間的延長,兩側IMC非均勻化生長愈發明顯,其中冷端厚度增長遠遠大于熱端,且反應前期增長速度較快,隨著反應的進行逐漸減緩,到反應后期再次加快。
④熱遷移后期,兩端IMC部分連接,有向全IMCs微互聯點轉變的趨勢。
⑤微互連點中IMCs占比增大,其力學性能將由釬料主導轉變為IMCs主導,因此力學性能將發生變化。
參考文獻:
[1]劉寶磊.Cu-Sn化合物電流輔助定向生長與微焊點瞬態鍵合機理[D].哈爾濱:哈爾濱工業大學,2017.
[2]陳湜.等溫回流時Cu/Sn/Cu微尺度焊點界面IMC生長行為與晶粒演變研究[D].大連:大連理工大學,2020.
[3]OUYANG F Y, KAO C L. In situ observation of thermomigration of Sn atoms to the hot end of 96.5Sn-3Ag-0.5Cu flip chip solder joints[J]. Journal of Applied Physics, 2011, 110(12):123525.
[4]HSU W N, OUYANG F Y. Effects of anisotropic β-Sn alloys on Cu diffusion under a temperature gradient[J]. Acta Materialia, 2014, 81:141-150.
[5]LI Y, XU L Y, ZHAO L, et al. Inhibition of roof-type Cu6Sn5 grains on migration of Cu atoms under temperature gradient [J]. Journal of Materials Science, 2024,59(2):669-685.
[6]GONG J, LIU C, CONWAY P P, et al. Evolution of CuSn intermetallics between moltenSn/Ag/Cu solder and Cu substrate[J]. Acta Materialia, 2008, 56(16):4291-4297.
收稿日期:2024-03-01
基金項目:河南省科技攻關項目“半導體集成電路的系統級三維堆棧封裝鍵合技術研發”(182102410048)。
作者簡介:楊廓(1997—),男,碩士生,研究方向:微互連工藝及可靠性。
通信作者:田野(1981—),男,博士,教授,研究方向:集成電路系統。

