肖特基結多數載流子積累新型絕緣柵雙極晶體管*
段寶興 劉雨林 唐春萍 楊銀堂
(西安電子科技大學微電子學院,寬禁帶半導體材料與器件教育部重點實驗室,西安 710071)
絕緣柵雙極晶體管(insulated gate bipolar transistor,IGBT)是現代功率半導體器件的核心,因其良好的電學特性得到了廣泛的應用.本文提出了一種具有肖特基結接觸的柵半導體層新型多數載流子積累模式IGBT,并對其進行特性研究和仿真分析.當新型IGBT 處于導通狀態,柵極施加正向偏壓,由于肖特基勢壘二極管極低的正向導通壓降,使得柵半導體層的電壓幾乎等于柵極電壓,從而能夠在漂移區中積累大量的多數載流子電子.除了現有的電子外,這些積累的電子增大了漂移區的電導率,從而顯著降低了正向導通壓降.因此,打破了傳統IGBT 正向導通壓降受漂移區摻雜濃度的限制.輕摻雜的漂移區可以使新型IGBT 具有較高的擊穿電壓,同時減小了關斷過程中器件內部耗盡層電容,因此整體米勒電容減小,提升了關斷速度,減小了關斷時間和關斷損耗.分析結果表明,600 V 級別的擊穿電壓時,新型IGBT 的正向導通壓降,關斷損耗和關斷時間相比常規IGBT 分別降低了46.2%,52.5%,30%,打破了IGBT 中正向導通壓降和關斷損耗之間的矛盾.此外,新型IGBT 具有更高的抗閂鎖能力和更大的正偏安全工作區.新型結構的提出滿足了未來IGBT 器件性能的發展要求,對于功率半導體器件領域具有重大指導意義.
1 引言
2020 年9 月,中國政府在第75 屆聯合國大會上明確提出了力爭在2030 年前實現“碳達峰”,2060 年前實現“碳中和”.功率半導體器件在實現雙碳目標中發揮著關鍵作用,因為功率半導體器件是電力電子系統的基礎,具有變頻、變壓、整流、功率放大和管理等重要作用,能夠實現對電能的調節、控制和轉換,從而提高整個系統的能源轉換效率和可持續性,降低能耗減少碳排放,進而實現節能減排.而絕緣柵雙極晶體管(insulated gate bipolar transistor,IGBT)作為功率半導體器件的核心,其重要程度不言而喻.IGBT 的概念起源并發展于20 世紀80 年代的早期[1],它是由雙極型晶體管(bipolar junction transistor,BJT)和金屬氧化物半導體場效應晶體管(metal oxide semiconductor field effect transistor,MOSFET)組成的復合全控型電壓驅動式功率半導體器件[2],兼具了BJT 低正向導通壓降和MOSFET 高輸入阻抗兩方面的優點[3],在消費電子、電力系統、工業系統、新能源汽車、可再生能源發電等多個領域得到廣泛應用.因此在雙碳目標的背景之下,開發設計出性能更加優異的新型IGBT 器件將對于建設資源節約型和環境友好型社會具有重大意義.
在IGBT 當中,擊穿電壓和正向導通壓降之間存在著矛盾[4],通常來說,要想獲得較高的擊穿電壓,器件漂移區的摻雜濃度須低,但是低摻雜濃度會使得正向導通壓降較高.同時在IGBT 中還存在著另一個關鍵問題,即正向導通壓降和關斷損耗之間的矛盾.要想獲得低正向導通壓降,需要增強漂移區的電導調制效應,但是會在漂移區中存儲大量的載流子,在關斷時難以在短時間內將它們抽取或復合,因此會造成關斷損耗增大.研究者們也進行了大量相關研究來致力于改善正向導通壓降和關斷損耗之間的關系.溝槽柵IGBT 消除了平面柵帶來的結型場效應晶體管(junction field effect transistor,JFET)效應,從而能夠減小正向導通壓降[5].逆導型IGBT 在集電極處為電子提供了通路,從而能快速關斷,減小關斷損耗[6].此外,載流子存儲層溝槽柵IGBT[7],具有P 型環和點注入的溝槽柵 IGBT 結構[8],具有自偏置PMOS 的IGBT結構[9],以及最近提出的集電極工程半超結雙向IGBT、階梯分離式溝槽柵IGBT、平面陽極柵超結IGBT[10-12],都可以改善正向導通壓降和關斷損耗之間的折中.
為了更好地解決IGBT 中存在的問題,本文將積累的思想應用在IGBT 上,提出了一種具有肖特基結接觸的柵半導體層新型多數載流子積累模式IGBT (novel majority carrier accumulation mode IGBT with Schottky junction contact gate semiconductor layer,AC-SCG IGBT),在滿足耐壓的條件下,以同時降低正向導通壓降和關斷損耗.所提出的AC-SCG IGBT 在常規IGBT 的側面引入了具有肖特基結接觸的N-N+-N 的柵半導體層.器件導通時高電勢的柵半導體層在漂移區積累多數載流子電子用以增強電導率以降低正向導通壓降,電子的引入使得漂移區摻雜濃度與正向導通壓降無關,通過輕摻雜保證耐壓并改善關斷特性.除此之外,較好的抗閂鎖能力和較高的擊穿電壓使得其具有更大的正偏安全工作區(forward biased safe operating area,FBSOA).本文所提出的IGBT 為硅基IGBT,也是當前最為主流的IGBT 材料,對硅基IGBT 的研究永遠不會過時.當然隨著第3 代半導體材料SiC 的發展,一些IGBT 的研究也會應用SiC 作為襯底材料或者是形成硅與SiC 的異質結,亦或是采用SiC 作為封裝的基板材料,基于SiC 寬帶隙的特點,其應用在IGBT 上會使其在更高溫度、更高阻斷電壓和更高的輻射環境下工作.Synopsys 公司推出的用以對半導體器件進行模擬仿真的軟件Sentaurus TCAD[13]已經被用來實現AC-SCG IGBT 的特性,仿真結果表明,在600 V級別的擊穿電壓下,AC-SCG IGBT 的正向導通壓降為0.84 V,關斷損耗為0.77 mJ/cm2,關斷時間為155.8 ns,與常規IGBT 相比分別降低了46.2%,52.5%,30.0%.
2 器件結構
圖1 顯示了常規溝槽型IGBT 和所提出的AC-SCG IGBT 的結構示意圖.AC-SCG IGBT 的特征是具有肖特基結接觸的N/N+/N 的柵半導體層,它位于器件的側面區域,從N+發射極到P+集電極,覆蓋整個漂移區,其兩端連接柵極和集電極.為了實現較好的電隔離,柵半導體層和左側結構用一層薄SiO2進行分隔[14].與常規的溝槽柵IGBT相比,所提出的AC-SCG IGBT 制作工藝的不同在于其采用了深溝槽刻蝕技術.圖2 為AC-SCG IGBT 的工藝流程,圖2(a)為通過外延形成P+/Nbuffer/N;圖2(b)為根據合適的深寬比進行從上到下的深溝槽刻蝕;圖2(c)為溝槽內進行SiO2生長,刻蝕掉底部的SiO2,留下溝槽側壁氧化層;圖2(d)為通過外延回填在溝槽內形成N/N+/N;圖2(e)為離子注入;圖2(f)為通過背面減薄工藝減薄P+襯底,最后金屬化形成電極.深溝槽刻蝕為許多高性能縱向器件的制備提供了可行的技術,比如應用深溝槽刻蝕技術的器件[15-18].
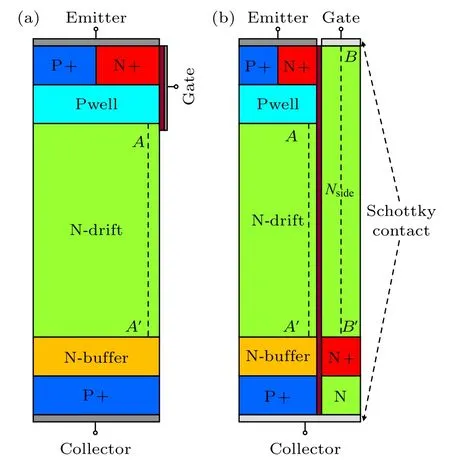
圖1 兩種器件結構示意圖 (a)常規IGBT 結構;(b) ACSCG IGBT 結構Fig.1.Schematic cross sections of the two devices: (a) Conventional IGBT structure;(b) AC-SCG IGBT structure.
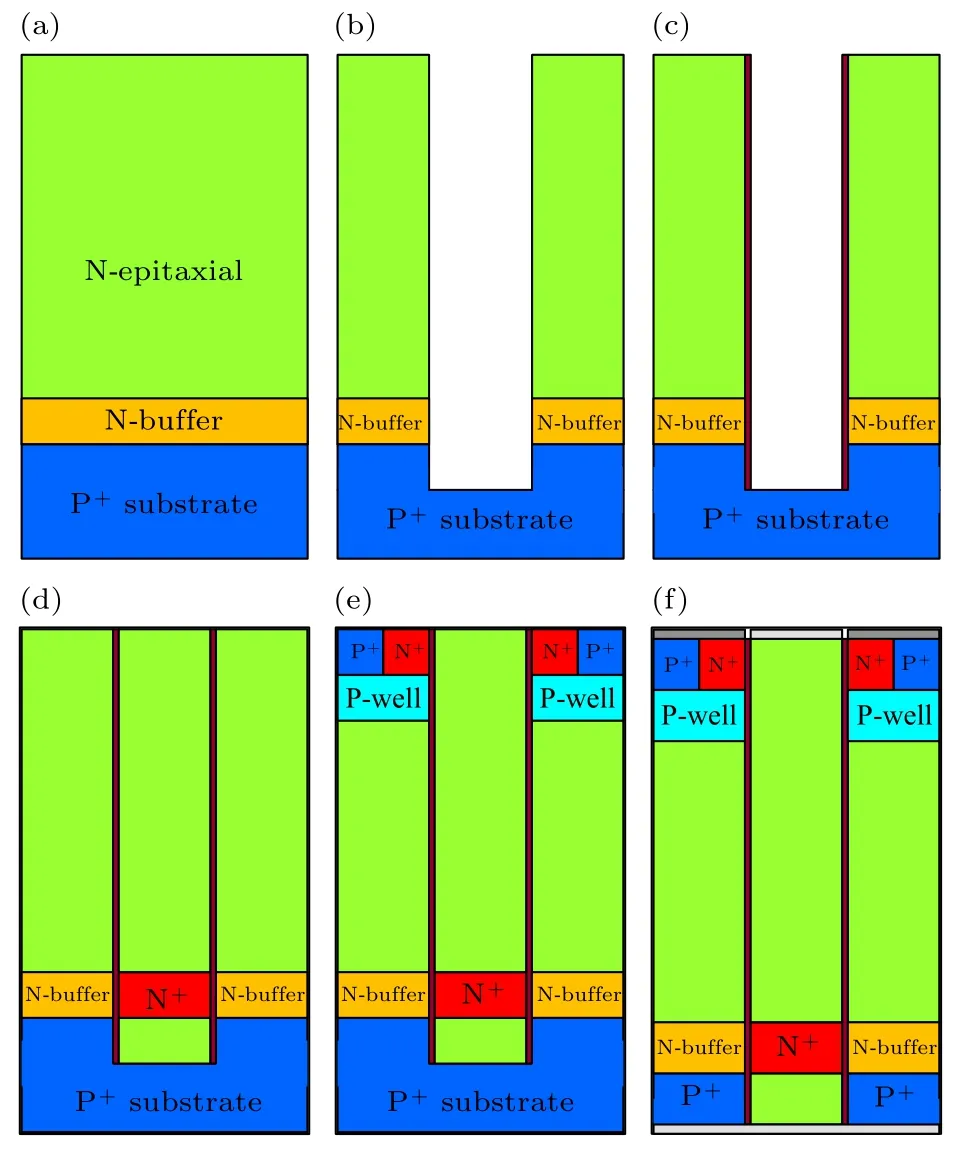
圖2 AC-SCG IGBT 的工藝流程圖 (a)外延;(b)深溝槽刻蝕;(c) SiO2 生長;(d)外延回填;(e)離子注入;(f)背面減薄和金屬化Fig.2.Process flow for AC-SCG IGBT: (a) Epitaxy;(b) deep trench etching;(c) performing SiO2 growth;(d) epitaxial backfilling;(e) ion implantation;(f) back thinning and metallization.
AC-SCG IGBT 積累層的形成如圖3 所示,當對柵極施加正向偏壓,整個Nside柵半導體層的電勢為柵極電壓VG減去肖特基二極管的內建電勢φbi,由于φbi值很小,因此Nside柵半導體層的電勢幾乎與柵極電壓相同.該電壓會將漂移區中帶負電荷的電子吸引到靠近氧化層的界面處形成高密度的電子積累層,電子由圖3 中圓形符號表示.在導通時,積累的電子和注入的空穴會對N 型漂移區的電導進行調制,從而增大電導率,減小正向導通壓降.需要注意的是,根據半導體物理知識,柵半導體層上的電勢與肖特基結接觸形成的勢壘ΦBN無關,ΦBN的作用可以減小漏電流.此外,漂移區中積累電子形成的同時,柵半導體層也會產生等量的空穴,設置N+區可阻斷柵極和集電極之間的空穴電流[19].表1 顯示了常規IGBT 和所提出的ACSCG IGBT 的關鍵參數和電學特性值.
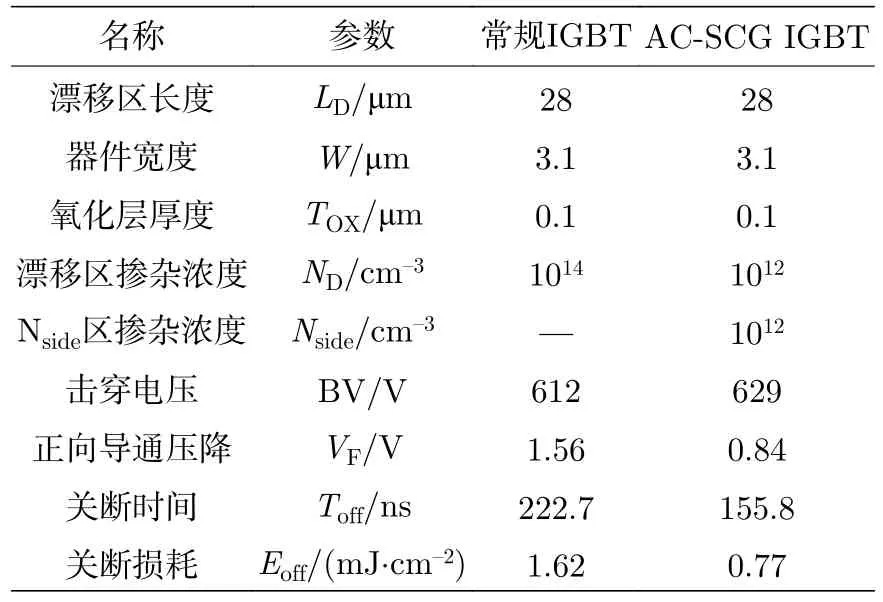
表1 常規IGBT 和AC-SCG IGBT 的關鍵參數和電學特性值Table 1.Key parameters and electrical characteristic values of the conventional IGBT and AC-SCG IGBT.

圖3 正柵極電壓下AC-SCG IGBT 積累層的截面示意圖及柵半導體層的電位分布Fig.3.Schematic cross sections of AC-SCG IGBT accumulation layer and potential distributions of the gate semiconductor layer under the positive gate voltage.
3 仿真結果與分析
圖4 為常規IGBT 和AC-SCG IGBT 的擊穿電壓和正向導通壓降隨漂移區摻雜濃度的變化情況.需要注意,由圖1(b)可知,在AC-SCG IGBT中,其漂移區摻雜濃度和柵半導體層的Nside區域和N 型區域的摻雜濃度相同,漂移區摻雜濃度發生改變時,二者隨之改變.從圖4(a)可以看出,常規IGBT 的擊穿電壓和正向導通壓降都隨著漂移區摻雜濃度的升高而降低,二者之間存在矛盾,這與大多數常規器件中的規律是一致的.從圖4(b)可以看出,AC-SCG IGBT 的正向導通壓降幾乎不受漂移區摻雜濃度的影響,打破了擊穿電壓和正向導通壓降之間的矛盾.因此,對于AC-SCG IGBT,可以選擇低漂移區摻雜濃度以獲得高擊穿電壓和低正向導通壓降.
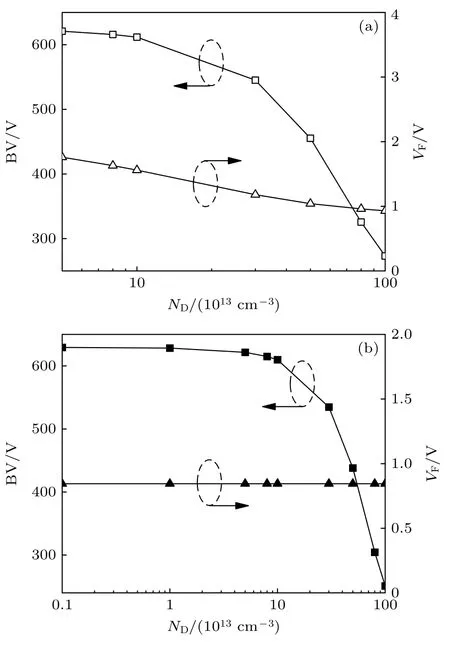
圖4 兩種器件的BV 和VF 隨ND 變化的曲線圖 (a)常規IGBT 結構;(b) AC-SCG IGBT 結構Fig.4.BV and VF as a function of ND of the two devices:(a) Conventional IGBT;(b) AC-SCG IGBT.
圖5(a)為常規IGBT 和AC-SCG IGBT 在擊穿時沿線AA'的垂直電場分布,可以看出二者都呈現出近似梯形的電場分布,這是因為N 型buffer區的引入對縱向電場進行調制.它們主要都是由P 型阱區和N 型漂移區之間的反偏結承擔電壓,耗盡層主要在N 型漂移區內延伸.結果表明,常規IGBT 和和AC-SCG IGBT 的擊穿電壓分別為612 V 和629 V,二者的擊穿電壓都處于600 V 的級別.圖5(b)則顯示了AC-SCG IGBT 在擊穿時沿線BB'的垂直電場分布,柵半導體層主要依靠反偏的肖特基二極管承擔電壓,耗盡層在Nside區域當中,N+區域與N 型buffer 區的作用相同.對于AC-SCG IGBT 來說,其沿線AA'的垂直電場分布不僅僅受到N 型buffer 區的影響,還受到沿線BB'均勻電場的調制,從而使得沿線AA'的電場分布更加均勻.
圖6 為AC-SCG IGBT 在擊穿時柵氧化層兩側的電勢分布,通過仿真分析的結果可以明顯看出柵氧化層兩側的電勢分布幾乎一致,在同一水平位置不存在橫向壓降,因此薄氧化層不會被擊穿.
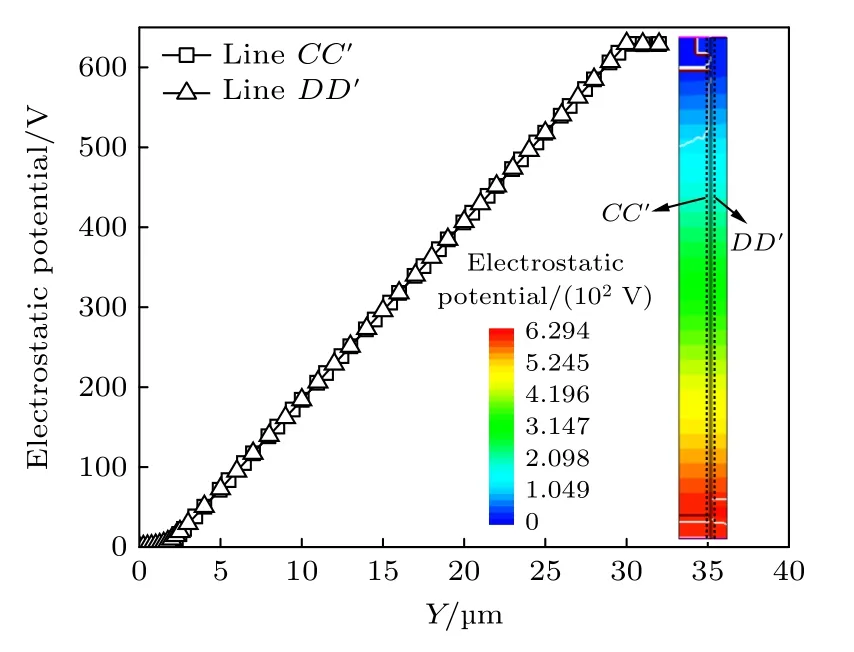
圖6 AC-SCG IGBT 柵氧化層兩側的電勢分布Fig.6.Potential distribution on both sides of AC-SCG IGBT gate oxide.
圖7 為常規IGBT 和AC-SCG IGBT 的輸出特性在不同柵極電壓的變化情況.由于漂移區中靠近氧化層附近電子的積累,增強了電導率,因此AC-SCG IGBT 的輸出電流明顯高于常規IGBT.柵極電壓越大,柵半導體層和N 型漂移區之間的電勢差就越大,這樣在器件處于導通狀態時就會積累更多的電子,因此輸出電流較高,正向導通壓降較低.圖7 內的插圖則為在VG=10 V 時,輸出特性的放大圖,正向導通壓降的值為電流密度等于100 A/cm2時對應的電壓.仿真結果表明,ACSCG IGBT 的正向導通壓降為0.84 V,與常規IGBT 的1.56 V 相比降低了46.2%.圖8 則進一步顯示了兩種器件在相同柵壓VG=10 V 下的飽和特性對比,雖然由于漂移區小部分縮減形成柵半導體層帶來的多數載流子積累效應,新結構的輸出電流會大于傳統結構,但隨著集電極電壓的逐漸增大最終達到飽和電流時,仿真結果顯示新結構的飽和電流其實只略微大于傳統結構.由于二者飽和電流相差很小,因此對短路耐受能力影響不大.
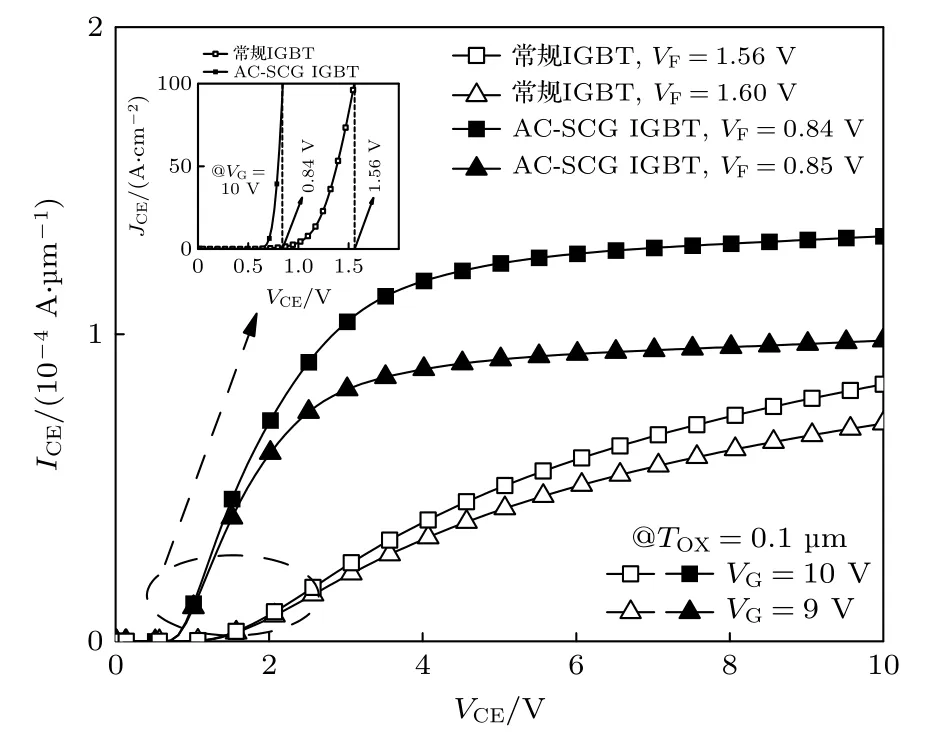
圖7 兩種器件在不同VG 下的輸出特性Fig.7.Variation of output characteristics for the two devices under VG.
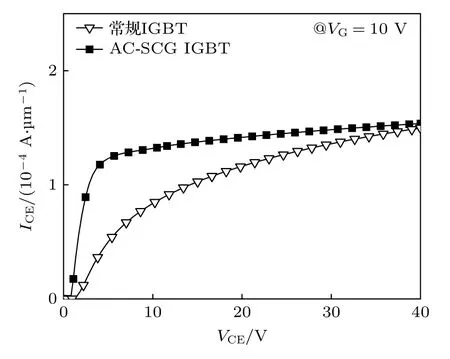
圖8 兩種器件在VG=10 V 下的飽和特性Fig.8.Saturation characteristics for the two devices under VG=10 V.
AC-SCG IGBT 的輸出特性也與氧化層厚度TOX有關.從圖9 可以看到,隨著TOX的減小,ACSCG IGBT 的正向導通壓降逐漸減小,導通特性更好.這是因為當TOX較小時,氧化層電容會相應增大,在相同的柵極電壓下,漂移區靠近氧化層一側會積累更多的電荷,使得電子密度增加,因此會得到更大的輸出電流和更低的正向導通壓降.
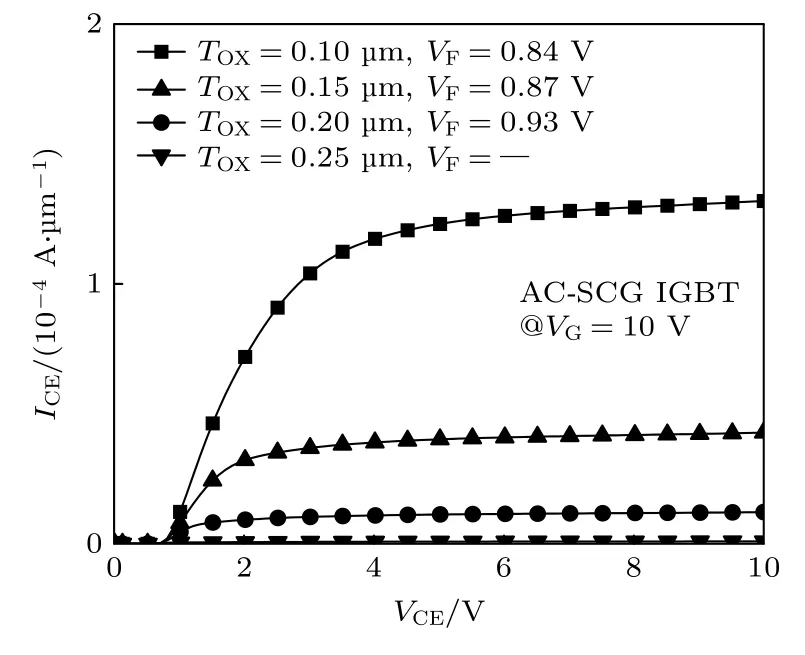
圖9 AC-SCG IGBT 在不同TOX 下的輸出特性Fig.9.Variation of output characteristics for the AC-SCG IGBT under TOX.
圖10(a)為帶感性負載的IGBT 開關電路,圖10(b)則為常規IGBT 和AC-SCG IGBT 關斷特性的曲線圖.從圖10(b)可以看出,與常規IGBT相比,AC-SCG IGBT 在關斷過程中電壓VCE上升更快,關斷時間短,關斷損耗低.從圖11 可以看出,當漂移區摻雜濃度相同時,AC-SCG IGBT 的米勒電容CGC幾乎與常規IGBT 一樣,并沒有因為氧化層的延長而增大,這是因為在關斷時ACSCG IGBT 在集電極處多串聯了一個肖特基勢壘電容,從而削弱了氧化層延長增大電容帶來的影響.因此,具有低漂移區摻雜濃度的AC-SCG IGBT內的耗盡層電容更小,因此整體米勒電容更小,如圖11 仿真結果所示.低的米勒電容可以使得ACSCG IGBT 在關斷過程中VCE上升快,能夠快速關斷,從而減小關斷時間和關斷損耗.仿真結果表明,AC-SCG IGBT 的關斷損耗為0.77 mJ/cm2,關斷時間為155.8 ns,與常規IGBT 相比分別降低了52.5%和30.0%.
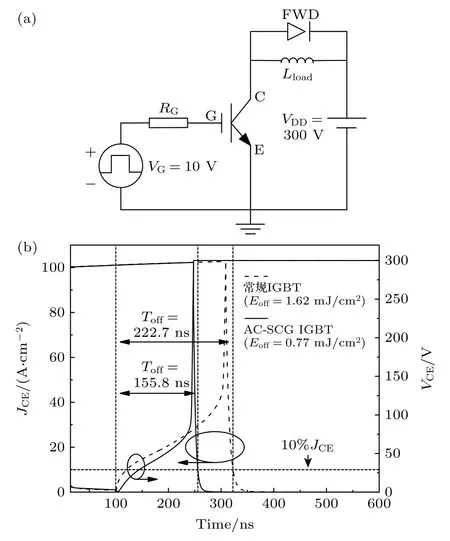
圖10 開關電路與關斷特性圖 (a)帶感性負載的IGBT開關電路圖;(b)兩種器件的關斷特性曲線Fig.10.Switching circuit and turn-off characteristics diagram: (a) Switching circuit with inductive load for IGBT;(b) turn-off characteristics for the two devices.
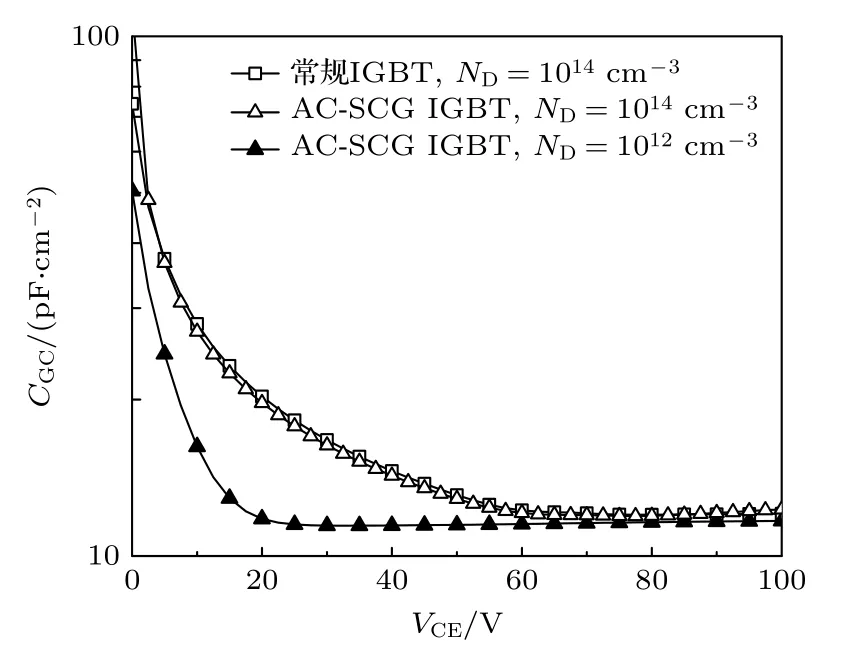
圖11 兩種器件的米勒電容Fig.11.CGC as a function of VCE of the two devices.
圖12 為常規IGBT 和AC-SCG IGBT 的正向導通壓降和關斷損耗的折中曲線.折中曲線是通過改變集電極P 區的摻雜濃度以得到不同VF值下的Eoff[20].從圖12 可以看到,與常規IGBT 相比,在擊穿能力相同的條件下,AC-SCG IGBT 的正向導通壓降和關斷損耗分別降低了46.2%和52.5%.可以證明所提出的AC-SCG IGBT 具有更低的正向導通壓降和關斷損耗,在二者之間取得了比常規IGBT 更好的折中特性.
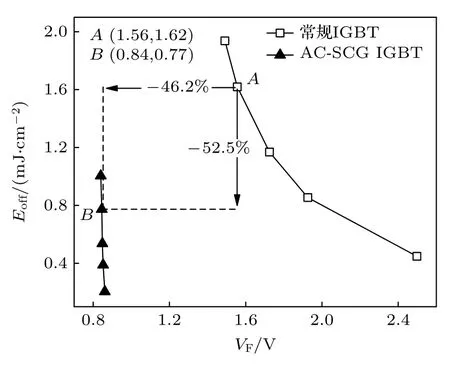
圖12 兩種器件VF 和Eoff 的折中曲線圖Fig.12.Trade-off curves between VF and Eoff for the two devices.
除了上述優異的電學特性外,與常規結構相比,新結構還提高了電學可靠性.圖13 為兩種器件在不同柵壓下I-V曲線組成的FBSOA,可以看到AC-SCG IGBT 具有更大的FBSOA.這是因為,與常規IGBT 相比,AC-SCG IGBT 的P-well區域的尺寸更小,因此該區域的體電阻更小,所以其抗閂鎖能力更強;加之漂移區輕摻雜帶來較好的耐壓特性,AC-SCG IGBT 的FBSOA 更大.
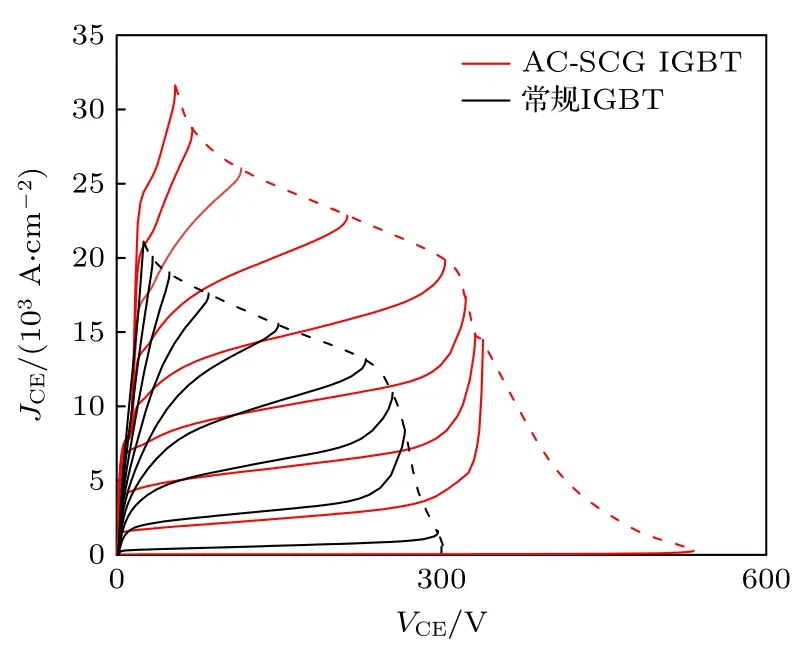
圖13 兩種器件的FBSOAFig.13.FBSOA of the two devices.
4 結論
針對目前在IGBT 中存在的固有問題和矛盾,本文提出了一種具有肖特基結接觸的柵半導體層新型多數載流子積累模式IGBT 器件結構,并通過仿真研究其擊穿、輸出、關斷、安全工作區等相關特性.由于積累的作用,AC-SCG IGBT 漂移區的電導率提高,漂移區的摻雜濃度不受正向導通壓降的限制,可以采用低漂移區摻雜濃度以獲得高擊穿電壓和低正向導通壓降.此外,輕摻雜的漂移區使得器件在關斷過程中內部的耗盡層電容較小,因此整體的米勒電容較小,能夠快速關斷從而減小關斷時間和關斷損耗.結果表明,在600 V 級別的擊穿電壓下,與常規IGBT 比,AC-SCG IGBT 的正向導通壓降和關斷損耗分別降低了46.2%和52.5%,實現了更低的正向導通壓降和關斷損耗,打破了二者之間存在的矛盾.與此同時,AC-SCG IGBT 具有更強的抗閂鎖能力,加之輕摻雜帶來的較好的耐壓特性,使其具有更大的FBSOA.新型結構的提出,其優異的性能將為IGBT 領域提供更多的創新和可能性.

