GaAs 插入層對InGaAs/AlGaAs 量子阱發(fā)光性質的影響
于海鑫,王海珠*,郎天宇,呂明輝,徐睿良,范 杰,鄒永剛
(1.長春理工大學 重慶研究院,重慶 401135;2.長春理工大學 高功率半導體激光國家重點實驗室,吉林 長春 130022)
1 引言
InGaAs/GaAs 多量子阱作為有源區(qū),已經在激光二極管、光電探測器等各種光電器件中得到了廣泛應用[1-5]。但是,在940 nm 波段的InGaAs/GaAs 量子阱外延生長過程中,還存在GaAs 勢壘層不能良好限制載流子、可能會使載流子發(fā)生逃逸的問題[6-9]。因此,開展針對InGaAs/AlGaAs 多量子阱的研究是十分必要的。使用AlGaAs 材料代替?zhèn)鹘y(tǒng)的GaAs 勢壘層是個不錯的選擇。首先,AlGaAs 的晶格常數(shù)和GaAs 相近,但是AlGaAs 的禁帶寬度要遠高于GaAs,對于在900 nm 左右發(fā)光的量子阱,可以起到很好的限制載流子的作用。從制備方法上來說,近年來主要使用金屬有機物化學氣相沉積(Metal-organic chemical vapor deposition,MOCVD)和分子束外延(Molecular beam epitaxy,MBE)的方法生長良好的InGaAs/AlGaAs 多量子阱[10-12]。最近,Zhang 等通過優(yōu)化砷化鎵的厚度,研究了砷化鎵插入層對InGaAs/AlGaAs QWs光學特性的影響[13]。但是,對于MOCVD 生長的InGaAs/AlGaAs 多量子阱仍有許多問題沒有解決。InGaAs 量子阱材料的熱穩(wěn)定性差,需要在低溫下進行沉積,但對于AlGaAs 材料則需要升溫生長以保證Al 原子的正常遷移,這會導致量子阱在生長時候有一個溫度差[14],溫度越高,In 原子越有可能發(fā)生偏析[15-16]。并且,在InGaAs 和AlGaAs 的界面處可能會生成InAlGaAs 四元合金,影響量子阱的質量和發(fā)光效果。為了減少這兩種因素可能帶來的不利影響,我們在InGaAs/AlGaAs 的界面處引入插入層阻止高溫生長過程中的In 偏析,阻止InAlGaAs 四元合金的形成。對于插入層材料的選擇,基于晶格常數(shù)、禁帶寬度[17],我們選擇GaAs 作為插入層材料,這是因為GaAs 和襯底材料匹配,不會帶來額外的晶格失配;其次,GaAs 材料的發(fā)光波長在860 nm 附近,對于940 nm 左右的波段是透明的,并不會對阱層產生影響。
本文利用MOCVD 技術在GaAs 襯底上生長了InGaAs/AlGaAs 多量子阱材料,并在量子阱中引入GaAs 插入層阻擋升溫過程的In 偏析和In-GaAlAs 四元合金的形成,并且減小失配,改善量子阱的生長質量和發(fā)光質量。通過變溫光致發(fā)光(Photoluminescence,PL)和變功率PL、X 射線衍射(X-ray diffraction,XRD)、原子力顯微鏡(Atomic force microscope,AFM)測試,驗證引入GaAs 插入層的InGaAs/AlGaAs 多量子阱發(fā)光特性變化和生長質量的改善。本文對研究InGaAs/AlGaAs 多量子阱的發(fā)光性能及輻射復合機制具有重要意義。
2 實 驗
實驗采用德國Aixtron 公司200/4 型MOCVD設備進行InGaAs/AlGaAs 多量子阱的外延生長制備。以三甲基鎵(TMGa)和三甲基銦(TMIn)及三甲基鋁(TMAl)作為Ⅲ族源,砷烷(AsH3)作為Ⅴ族源,高純氫氣(H2)作為Ⅲ族源的載氣。生長時反應腔室壓力維持在10 kPa(100 mbar),且在富Ⅴ族氣體的氛圍下進行。
圖1 給出了帶GaAs 插入層和不帶GaAs 插入層的InGaAs/AlGaAs 多量子阱的生長結構示意圖,從圖中可以看出,InGaAs/AlGaAs 多量子阱結構生長在N 型無偏角的GaAs(100)襯底和緩沖層上。在生長前,對襯底在650 ℃的溫度下進行5 min 的退火處理,以去除表面氧化物。之后生長300 nm 厚的GaAs 緩沖層,隨后將溫度升高到680 ℃生長AlGaAs 勢壘層,然后將溫度降低到600 ℃生長InGaAs 勢阱層,再升高溫度到680 ℃生長AlGaAs 勢壘層,生長三個周期的量子阱結構。其中,每個量子阱結構包括6 nm 厚的In0.17Ga0.83As 量子阱層和8 nm 厚的Al0.3Ga0.7As 勢壘層,兩者的生長速率分別為0.507 μm/h 和0.58μm/h。最后,生長120 nm 厚的GaAs 蓋層以保護量子阱,此為A 樣品。作為對比,設計生長6 nm的GaAs 插入層,在生長完AlGaAs 勢壘層之后生長6 nm 的GaAs 插入層,然后降溫到600 ℃生長InGaAs 阱層和GaAs 插入層,最后升溫生長8 nm AlGaAs 勢壘層和GaAs 插入層。生長三個周期量子阱,并生長120 nm 的GaAs 蓋層,作為樣品B。生長結束后在AsH3氣體的保護下,將反應室溫度降至室溫,以便后續(xù)測試表征。
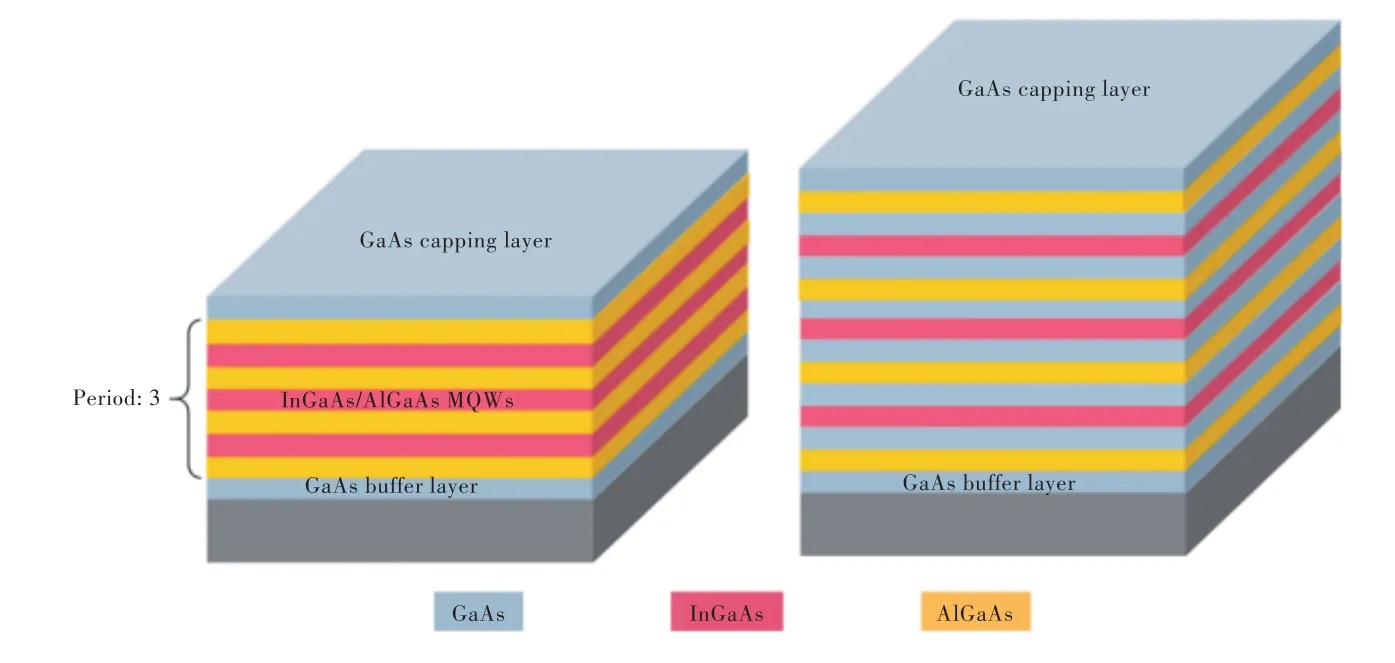
圖1 InGaAs/AlGaAs 多量子阱結構示意圖Fig.1 Schematic structure of InGaAs/AlGaAs MQWs
本文生長獲得的量子阱材料的變溫及變功率PL 由HORIBA iHR550 光譜儀完成,選用InGaAs探測器,激發(fā)光源是波長為447 nm 連續(xù)輸出的半導體激光器,光斑直徑為0.4 cm。樣品放置在液氦制冷臺上,用帶有CaF2窗口鏡片的真空罩保護。變溫PL 測試的溫度調節(jié)范圍為20~300 K,功率密度維持在150 mW/cm2;變功率PL 測試的功率密度調節(jié)范圍為10~70 mW/cm2,溫度維持在20 K。
3 結果與討論
首先,我們先對沒有GaAs 插入層的樣品A 進行光致發(fā)光測試,結果發(fā)現(xiàn)A 樣品在室溫下不發(fā)光,如圖2 所示。而樣品A 變溫PL 測試顯示,其在低溫下發(fā)光,并隨著溫度升高,樣品發(fā)光質量變差,直到完全消失,如圖3 所示。為了探究樣品A在低溫下的發(fā)光性質,對我們A 樣品進行低溫20 K 條件下變功率測試,功率密度為10~70 mW/cm2,并對測試結果進行了擬合曲線分析,結果如圖4 和圖5 所示。

圖2 A 和B 樣品的室溫PL 測試Fig.2 PL spectra of two samples at room temperature
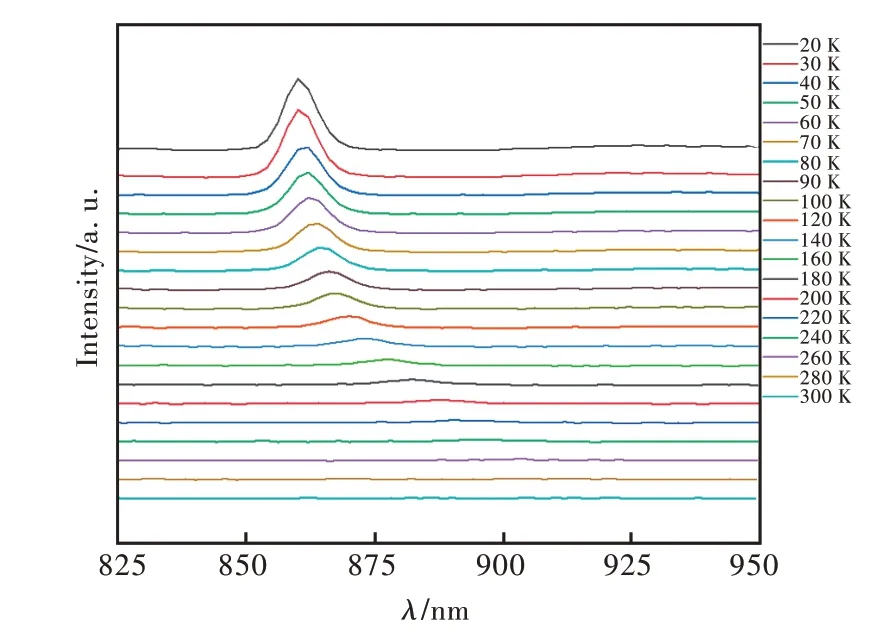
圖3 樣品A 的變溫PL 測試結果Fig.3 Temperature-dependent PL results of sample A

圖4 A 樣品的變功率PL 測試圖Fig.4 Excitation power-dependent PL results of sample A
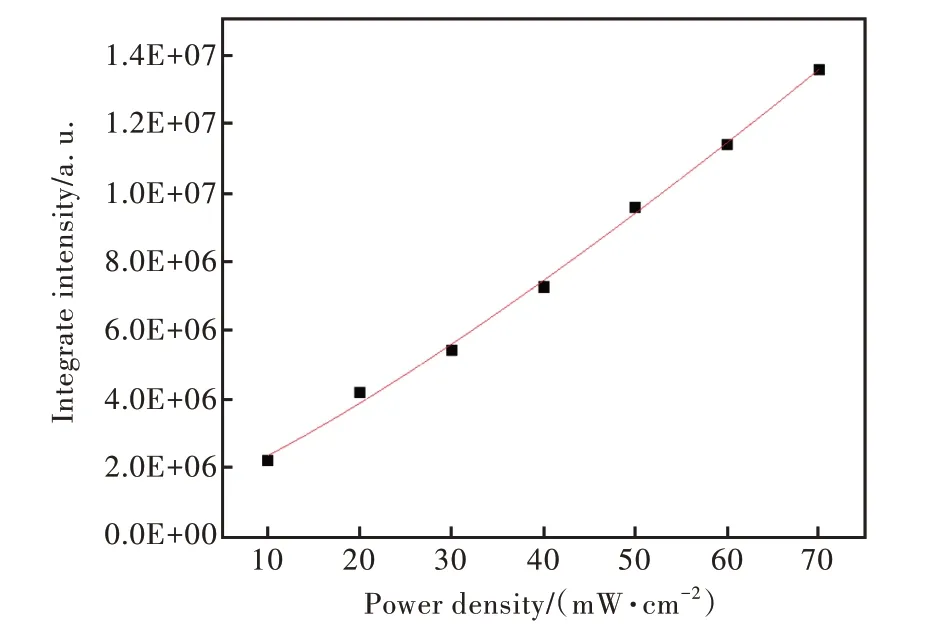
圖5 樣品A 在不同激發(fā)功率下的積分強度Fig.5 The integral strength of sample A under different excitation power
針對變功率PL 的積分強度與功率密度建立對應關系,積分強度與激發(fā)功率的關系如下所示:
其中I為PL 積分強度,β為輻射效率,I0為激發(fā)功率密度,a為特征值。經過擬合得出樣品A 在20 K 溫度下的a=1.22(a>1),推斷為自由激子輻射復合發(fā)光。對于樣品A,在低溫下的發(fā)光機制為自由激子復合發(fā)光,但是隨著溫度升高發(fā)光質量變差直到光強完全消失。隨著溫度降低發(fā)光強度增大的原因是低溫下能夠抑制非輻射通道的散射,導致了更多的能量被轉移到輻射通道中,增強了輻射復合的發(fā)生,增加了發(fā)光效率。隨著溫度的升高發(fā)光強度減小直到消失的原因是載流子發(fā)生了熱逃逸,隨著溫度進一步升高,環(huán)境溫度能量大于激子結合能,使自由激子解離,抑制了輻射復合的產生,這也導致自由激子復合峰的強度降低,直至完全消失。
接下來,我們又對樣品B 進行室溫PL 測試,結果如圖2 所示。隨著GaAs 插入層的引入,In-GaAs/AlGaAs 多量子阱發(fā)光有了明顯改善。對于GaAs 插入層的引入改善了InGaAs/AlGaAs 多量子阱的發(fā)光情況,可能有以下幾點原因:(1)GaAs 插入層的引入分離了阱層InGaAs 和壘層AlGaAs,減少了阱層和壘層界面處InAlGaAs 四元化合物的形成,減少了非輻射復合的形成,進而改善了PL的發(fā)光質量。(2)抑制阱層InGaAs 的偏析:在樣品A 升溫到680 ℃生長AlGaAs 勢壘層時,升溫表面為InGaAs 層,從600 ℃升溫到680 ℃需要幾分鐘,會使表面的InGaAs 發(fā)生In 的偏析,從而降低InGaAs 的生長質量,進而導致樣品發(fā)光不理想。而加入GaAs 插入層的樣品B 在生長AlGaAs 時升溫表面是GaAs 層,抑制了阱層InGaAs 的偏析,并起到限制與保護阱層In 原子的作用,提高了阱層InGaAs 的生長質量,從而改善了量子阱的發(fā)光質量。(3)改善載流子輸運:加入GaAs 插入層可以改善載流子的輸運過程。這是因為GaAs 和Al-GaAs 具有相似的晶格常數(shù)和晶體結構,插入層可以縮小應變差異并平滑材料界面,從而減少載流子的散射和復合。這將提高載流子的遷移率和激子壽命,從而增強PL 強度。(4)調整能帶結構:插入層可以調整InGaAs/AlGaAs 多量子阱的能帶結構。由于InGaAs 和AlGaAs 的晶格常數(shù)不同,多量子阱內部也存在應變,從而使能帶位置發(fā)生變化。引入插入層可以緩解這種應變,進而影響載流子的能級分布和激子能級位置,從而改變PL峰的峰位和強度。(5)減少缺陷密度:加入GaAs插入層可以減少材料中的缺陷密度。多量子阱的界面和結構是材料中缺陷的主要來源之一。我們認為起主導作用的原因是插入層可以平滑多量子阱,從而減少位錯和其他缺陷,提高量子阱生長質量,進而提高載流子的壽命并增強PL 強度。
為了繼續(xù)探究GaAs 插入層的引入對量子阱界面生長質量的影響,我們對兩個樣品進行了XRD 測試分析,結果如圖6 所示。生長的兩個樣品的衍射圖均表現(xiàn)出明顯的周期性衍射峰,表明其周期性結構和高結晶質量。對比引入GaAs 插入層的B 樣品和沒有引入GaAs 插入層的樣品A,XRD 測試結果的衛(wèi)星峰有明顯的增加,表明在引入GaAs 插入層之后,量子阱的生長質量有明顯改善[18-20]。這充分說明擁有GaAs 插入層的樣品B 的結晶質量要遠遠好于樣品A,也可以進一步說明引入GaAs 插入層改善了InGaAs/AlGaAs 多量子阱的生長質量,從而改善了發(fā)光情況。

圖6 樣品A 和B 的XRD 測試結果Fig.6 XRD results of A and B samples
為了繼續(xù)探究GaAs 插入層的引入對量子阱生長質量的影響,我們對兩個樣品進行了AFM 測試分析,樣品的表面粗糙度(Roughness measurement of the surface,RMS)結果如圖7 所示。樣品A的RMS=0.467 nm,樣品B 的RMS=0.269 nm,說明GaAs 插入層的引入可以降低樣品表面粗糙度,進一步表明GaAs 插入層的引入可以提高多量子阱的生長質量,進而影響量子阱發(fā)光性能。
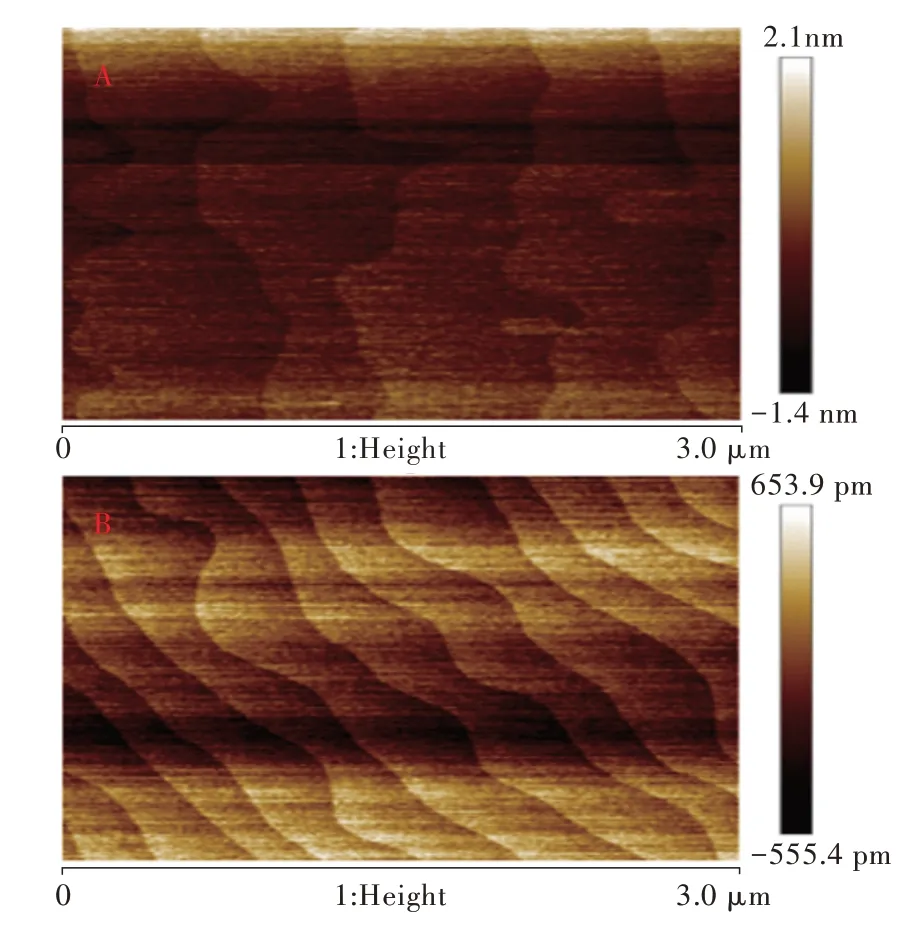
圖7 樣品A 和B 的AFM 測試結果Fig.7 AFM results of A and B samples
為了進一步探究GaAs 插入層的引入對發(fā)光性能的影響,我們又對樣品B 進行了變溫PL 測試,測試結果如圖8 所示。可以發(fā)現(xiàn)在低溫下隨著溫度升高,樣品B 的發(fā)光波長有些異常變化。為了更加直觀地看到隨著溫度升高波長的變化情況,我們又做了溫度與波長和半峰寬(Full wave at half maximum,F(xiàn)WHM)的關系圖,如圖9 所示。從圖中可以看到,隨著溫度從20 K 升高到60 K,波長出現(xiàn)先紅移再藍移的現(xiàn)象,推測出現(xiàn)這種“S”型變化可能是InGaAs/AlGaAs 多量子阱內部“局域態(tài)”發(fā)光導致。為了驗證樣品B 中可能出現(xiàn)“局域態(tài)”的猜想,我們又對樣品B 在低溫20 K 下進行了變功率實驗,功率密度仍然為10~70 mW/cm2,結果如圖10 所示。利用圖9 中的數(shù)據(jù),我們進行了擬合分析,曲線如圖11 所示。結果發(fā)現(xiàn)擬合曲線得到a=0.88(a<1),進而得出樣品B 在低溫下為缺陷導致發(fā)光,由此推測低溫狀態(tài)下的異常’S’型波長變化為“局域態(tài)”導致的發(fā)光[21-22]。
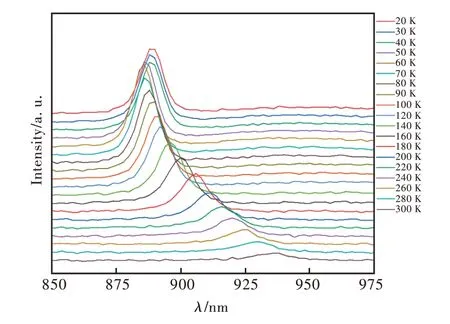
圖8 樣品B 的變溫PL 測試結果Fig.8 Temperature-dependent PL results of sample B
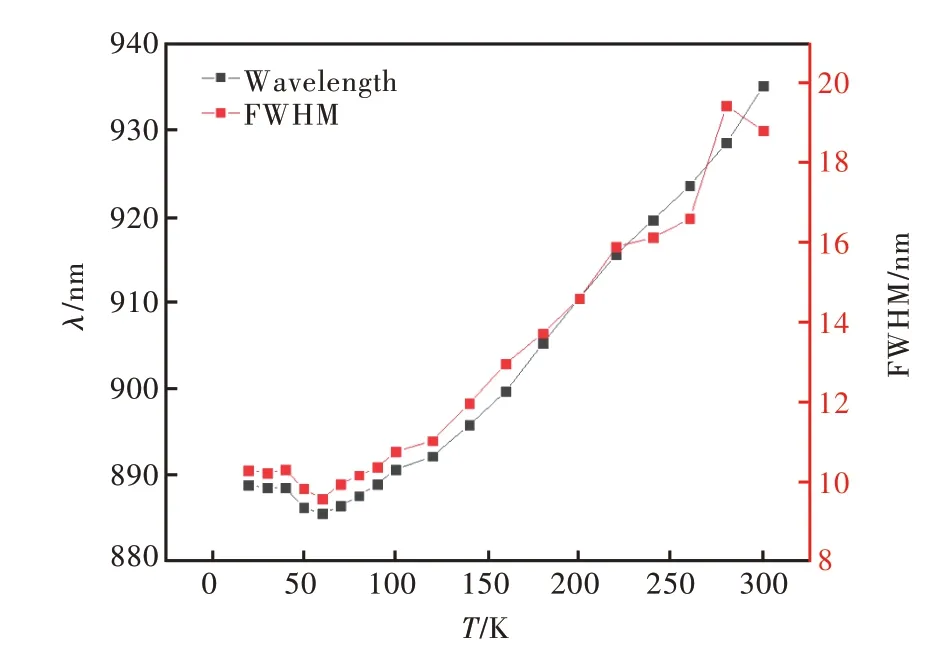
圖9 樣品B 溫度相關的峰值位置和溫度相關的FWHMFig.9 Sample B temperature-dependent peak position and temperature dependent FWHM

圖10 B 樣品的變功率PL 測試圖Fig.10 Excitation power-dependent PL results of sample B
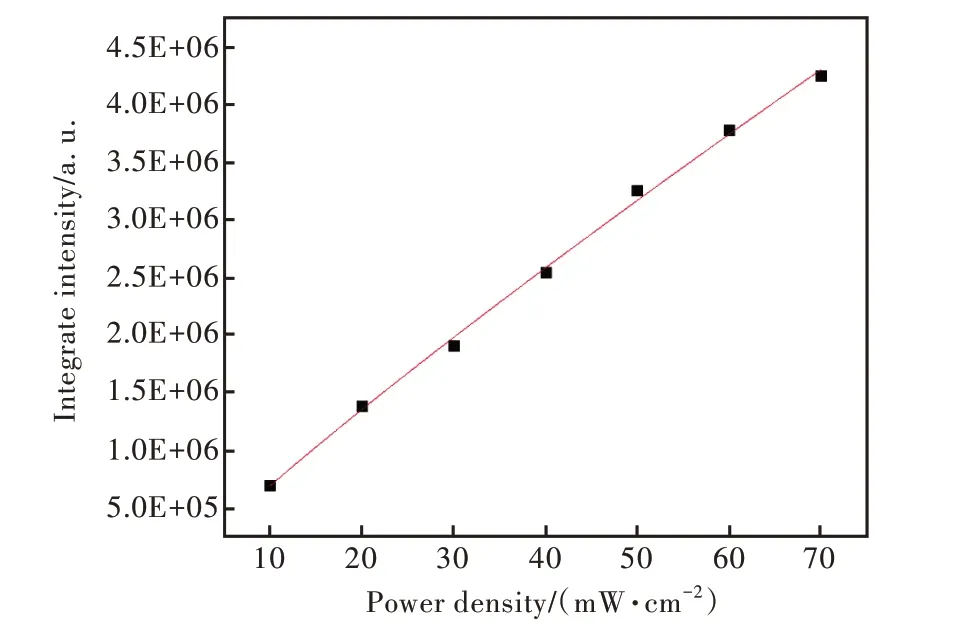
圖11 樣品B 在不同激發(fā)功率下的積分強度Fig.11 The integral strength of sample B under different excitation power
對于引入了GaAs 插入層的樣品B 出現(xiàn)“局域態(tài)”的現(xiàn)象,我們推測是因為與阱層InGaAs 接觸的AlGaAs 層,相較于GaAs 層,更不容易與In 原子互換,也就是說InGaAs 的In 原子更容易偏析進入GaAs 層,從而導致局部In 原子的數(shù)量下降,故而加入了GaAs 插入層的樣品B 會出現(xiàn)“局域態(tài)”現(xiàn)象。
4 結論
本文通過MOCVD 設備生長了三周期的In-GaAs/AlGaAs 多量子阱材料。首先通過室溫PL和變溫PL 測試發(fā)現(xiàn),沒有加入GaAs 插入層的樣品在室溫下不發(fā)光,在低溫下發(fā)光正常并且a>1,為自由激子發(fā)光。推測是低溫下能夠抑制非輻射復合的產生,隨著溫度升高,載流子發(fā)生了熱逃逸,發(fā)光質量逐漸變差。而引入GaAs 插入層的樣品在低溫和室溫下都正常發(fā)光,但是在低溫時隨著溫度升高,波長有“S”型變化,并且低溫20 K 時變功率測試a<1,推測為引入GaAs 層的樣品量子阱內部出現(xiàn)“局域態(tài)”,是因為In 原子更容易偏析進入GaAs 層之中,進而導致了阱層In-GaAs 形成In 原子密度不同的區(qū)域。后續(xù)又進行XRD 和AFM 測試,發(fā)現(xiàn)引入GaAs 插入層的樣品衍射峰的數(shù)量明顯多于沒有插入層的樣品,并且樣品表面粗糙度也有明顯的下降,表明GaAs 插入層的引入改善了多量子阱的結晶質量,導致樣品B 發(fā)光質量好于樣品A;但是同時也會引入“局域態(tài)”,給量子阱的發(fā)光性質帶來變化。本研究可以加深對InGaAs/AlGaAs 多量子阱輻射復合機制的理解,對引入GaAs 插入層的InGaAs/AlGaAs多量子阱發(fā)光性質的研究具有重要意義。
本文專家審稿意見及作者回復內容的下載地址:http://cjl.lightpublishing.cn/thesisDetails#10.37188/CJL.20230202.

