高穩定性ZnO∶Ga/InGaN異質結微型綠光發光二極管
林毅,周雷,范寶路,于彥龍,徐春祥
(1.淮陰工學院 數理學院,江蘇 淮安 223003;2.東南大學 生物科學與醫學工程學院,江蘇 南京 210096)
1 引 言
基于半導體材料的發光二極管(LED)在固態照明、可見光通信、農業生產、電子顯示、生物醫療與生命科學等領域得到了廣泛的應用[1-4]。作為典型的可見光光源,高能效比、使用壽命長的綠色光源在各方面具有重要作用,但綠光發光材料和器件的制備一直受限于“Green gap”和“Efficiency droop”兩個問題的困擾[5-7]。近十多年來,基于鈣鈦礦、有機分子、氮化物等不同材料[5,8-9],人們已成功制備了多種不同結構的綠光LED。但這些材料和器件在實現綠光發射的同時,仍然存在一些亟需解決的問題。對于鈣鈦礦綠光LED,器件結構中鈣鈦礦發光層與電極材料以及緩沖層之間存在的缺陷態會嚴重影響器件的發光效率。此外,鈣鈦礦微納米晶相對較差的穩定性也極大地制約了鈣鈦礦LED的制備與應用。對于有機發光二極管(OLED),其光電性能依賴于高性能有機材料,且其發光強度、效率和壽命相對較低。對于In-GaN綠光LED,目前已得到了廣泛的研究,但器件的“Green gap”和“Efficiency droop”問題尤為突出。為了實現綠光發射,需要提高InGaN量子阱中的In組分。高In組分會增加InGaN中的缺陷態密度和極化電場,從而導致材料中載流子非輻射復合的幾率增加、光譜半峰寬過寬以及光譜品質降低等一系列問題[10-11]。并且,由于其強極化場的存在,量子斯塔克效應也對InGaN基光電器件性能造成很大影響[12-13]。對于微型結構器件,隨著材料和器件特征尺寸減小,載流子非輻射復合、載流子溢出、積熱等問題越發嚴重,也會導致低維綠光器件的發光效率進一步下降[14-16]。而較為苛刻的生長條件和極其昂貴的生長處理設備也限制了In-GaN基低維綠光器件的制備和推廣應用[13,17]。因此,針對綠光微型發光器件,設計合理的材料結構體系,從而實現經濟、穩定、高效的綠光發射,仍然是該領域的一個研究重點。
氧化鋅作為一種典型的寬帶隙(3.37 eV)半導體,室溫下激子束縛能高達60 meV,在制備高性能光電器件方面已經得到了廣泛的應用[18-20]。氧化鋅還具有豐富的微納結構、優異的結晶質量以及光滑的表面,是制備微納發光器件的理想材料。本文采用化學氣相沉積(CVD)方法生長了結晶質量優異的鎵摻雜ZnO微米線(ZnO∶Ga MW),選擇p型InGaN襯底作為空穴注入層,設計制備了n-ZnO∶Ga MW/p-InGaN異質結發光器件。實驗結果表明,當正向電壓大于一定值時,該器件發射出明亮的綠光,發光峰位于540 nm,半峰寬(FWHM)約為32 nm。隨著電流在一定范圍內增加,該器件的電致發光峰位、半峰寬沒有明顯的變化,呈現出良好的發光穩定性。能帶結構分析表明,綠光發射歸因于n-ZnO∶Ga微米線的電子與p-InGaN的空穴在異質結界面發生的輻射復合。該器件的相對外量子效率(REQE)在注入電流增加時下降較小,這表明本實驗設計制備的n-ZnO∶Ga MW/p-InGaN異質結發光二極管一定程度上解決了高缺陷態密度和強極化電場所導致的“Green gap”和“Efficiency droop”兩個重要問題。進一步,本實驗使用金納米薄膜對ZnO∶Ga微米線進行修飾,優化了異質結界面接觸,有效提高了綠光發光二極管的發光強度。因此,本文設計的異質結構獲得了高穩定性的綠光發射,有望實現高性能綠光發光器件的制備與應用。
2 實 驗
2.1 ZnO∶Ga微米線生長
本文采用CVD法,以超純Ga2O3粉末作為摻雜源,在無催化條件下制備了ZnO∶Ga微米線。具體步驟如下:將質量比為9∶1∶10的高純ZnO粉末、Ga2O3粉末和碳粉充分研磨混合,取適量混合粉末作為生長源,均勻平鋪于尺寸為10 cm(長)×2 cm(寬)×1.5 cm(高)的石英舟內。將清洗過的硅片(2 cm×2 cm)拋光面朝下,覆蓋在石英舟上,隨后將石英舟推放至管式爐的高溫中心區域。通入氬氣和少量氧氣作為生長氣體,氣體總流量為135 mL/min。將高溫管式爐快速升溫至1 100℃,反應1 h后,待管式爐自然冷卻至室溫,取出石英舟,即可在硅片和石英舟側壁直接觀測到密集的ZnO∶Ga微米線,如圖1(a)所示。

圖1 (a)石英舟中ZnO∶Ga微米線的光學照片;(b)單根ZnO∶Ga微米線的SEM圖像;(c)ZnO∶Ga微米線的XRD圖譜;(d)單根ZnO∶Ga微米線的EDS元素分析,表明Zn、Ga和O三種元素均勻分布在微米線中。Fig.1(a)Optical photograph of the synthesized ZnO∶Ga MW.(b)SEM image of an individual ZnO∶Ga MW,illustrating straight and smooth sidewall facets.(c)XRD pattern for the synthesized ZnO∶Ga MWs.(d)EDS elemental mapping of a ZnO,illustrating its uniform composition of Zn,O and Ga species.
2.2 異質結發光器件制備
本實驗中的綠色發光器件采用單根ZnO∶Ga微米線作為n型材料,p型InGaN襯底作為空穴注入層(該襯底為商業化晶片,采用金屬有機化學氣相沉積在藍寶石襯底上依次生長p型GaN和InGaN量子阱層)。該器件的制作流程如下:(1)首先利用電子束蒸鍍設備在InGaN襯底一側制備Ni/Au納米薄膜電極,厚度為40~50 nm;(2)利用電子束蒸鍍設備和掩模板在InGaN襯底上沉積厚度約為5μm的MgO薄膜作為絕緣層,用于避免頂部電極與InGaN襯底之間的物理接觸;(3)選取直徑約為10μm、結晶質量優異的單根ZnO∶Ga微米線,將其放置于MgO絕緣層溝道中;(4)將ITO導電玻璃放置在ZnO∶Ga微米線上方作為異質結器件的頂部歐姆接觸電極,n-ZnO∶Ga MW/p-InGaN異質結器件即制作完成;(5)選取直徑約為10μm、結晶質量優異的單根ZnO∶Ga微米線,利用電子束蒸鍍設備在其表面蒸鍍厚度約為10 nm的Au納米薄膜,然后再將其放置于InGaN襯底上MgO絕緣層溝道中;(6)將ITO導電玻璃放置在Au薄膜修飾的ZnO∶Ga微米線上方,n-Au@ZnO∶Ga MW/p-InGaN異質結器件即制作完成。
2.3 樣品表征
采用Keysight B1500A測試和表征ZnO∶Ga微米線、InGaN襯底以及上述制備的兩種異質結發光器件的電學特性。異質結發光器件的電致發光(EL)特性采用由ANDOR探測器(CCD-13448)和LabRAM-UV Jobin-Yvon光譜儀組成的微區光譜測試系統進行測試。發光器件的電致發光圖像在光學顯微鏡下觀察和拍攝。采用He-Cd激光器(激發波長為325 nm)作為單根ZnO∶Ga微米線和InGaN襯底光致發光(PL)的激發光源,使用上述微區光譜測試系統采集其PL光譜。
3 結果與討論
3.1 ZnO∶Ga微米線形貌與光電學性質
本文采用CVD方法生長了結晶質量優異的ZnO∶Ga微米線,單根微米線的掃描電子顯微鏡照片如圖1(b)所示。從圖中可以清楚地觀察到ZnO∶Ga微米線典型的四邊形邊界以及光滑的表面。利用X射線衍射(XRD)測試設備分析了單根ZnO∶Ga微米線的晶體屬性,測試結果如圖1(c)所示。XRD結果表明,ZnO∶Ga微米線的晶格衍射峰位于31.73°、34.33°和36.15°處,與六角纖鋅礦結構ZnO的標準卡片(JCPDS no.36-1451)對比,這三個主要衍射峰分別歸因于纖鋅礦ZnO的(100)、(002)和(101)面。該測試結果進一步證明采用該實驗方法生長的單根ZnO∶Ga微米線具有標準的六角纖鋅礦結構和較高的結晶質量[19,21]。為了證明鎵元素已成功摻入,采用能量色散X射線能譜(EDS)對ZnO∶Ga微米線進行元素分析。所得結果如圖1(d)所示,Zn、O和Ga元素均勻分布在整根微米線上。這表明實驗所制備的ZnO∶Ga微米線成功地摻雜了Ga元素,即Ga原子取代Zn原子的位置形成替位GaZn[21-22]。
采用He-Cd激光器作為激發光源對ZnO∶Ga微米線進行光學表征,光致發光譜如圖2(a)所示。單根ZnO∶Ga微米線PL光譜的主要發光峰位于377 nm的紫外波段,光譜半峰寬為10.3 nm,這對應于ZnO∶Ga的近帶邊發射。此外,PL光譜中可見光波段微小的隆起歸結于ZnO∶Ga微米線的缺陷能級所產生的發光。PL光譜結果同樣說明了本實驗制備的單根ZnO∶Ga微米線具有較高的結晶質量和光學特性。將單根微米線放置在載玻片上,用銦作為電極連接在微米線兩端,使用Keysight B1500A半導體參數分析儀測試單根ZnO∶Ga微米線的電學特性,相應的電流-電壓(I-V)曲線如圖2(b)所示。相對于未摻雜的ZnO微米線,Ga元素的摻雜使ZnO∶Ga微米線的導電能力得到了極大的提高和改善。因此,擁有優異電學和光學特性的單根ZnO∶Ga微米線為制備高性能的電致發光器件提供了良好的材料基礎[19,21-22]。
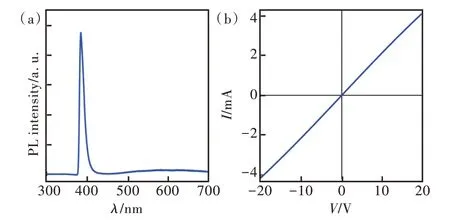
圖2 (a)單根ZnO∶Ga微米線的PL光譜;(b)單根ZnO∶Ga微米線的I-V曲線。Fig.2(a)PL spectrum of a ZnO∶Ga MW.(b)I-V characteristic curve of an individual ZnO∶Ga MW.
3.2 n-ZnO∶Ga MW/p-InGaN異質結電致發光
選擇單根ZnO∶Ga微米線和p型InGaN襯底制備了異質結發光器件,相應的器件制備過程參考上文實驗部分,器件的結構示意圖如圖3(a)上插圖所示。在該器件結構中,Ni/Au電極作為陽極電極,ITO作為 陰極電極,MgO作為ITO與p-In-GaN襯底之間的絕緣層。首先,采用Keysight B1500A對制備的異質結進行相應的電學特性測試,器件的I-V特性曲線如圖3(a)所示。圖線總體呈現良好的整流特性,漏電流在偏壓為-15 V時為8×10-6A,器件的開啟電壓約為4.7 V。反向電壓下較低的漏電流可以證明ZnO∶Ga/InGaN界面中低的缺陷態密度以及其優異的結晶質量,這與之前報道的基于ZnO/Si、ZnO/GaN等異質結光電器件類似[18,23-24]。
在n-ZnO∶Ga MW/p-InGaN異質結發光器件的電致發光測試過程中,電子由ZnO∶Ga微米線一側注入,空穴由p-InGaN一側注入。當正向偏壓超過開啟電壓時,可以觀察到明亮的綠光發射,圖3(a)下插圖為器件在1.9 mA工作電流下的發光照片。當注入電流從0.15 mA增加到2.0 mA時,使用光譜儀記錄其電致發光光譜。圖3(b)展示了所制備的異質結器件在不同輸入電流下的EL光譜,其發光峰位于540 nm,半峰寬約為32 nm。隨著注入電流的增加,發光強度出現明顯的增強,而相應的發光峰峰位幾乎沒有任何移動,這表明器件中的量子斯塔克效應可以忽略不計[25-26]。圖3(b)插圖為該異質結發光器件EL光譜的積分強度和半峰寬隨注入電流的變化關系曲線。隨著注入電流的增加,光譜的積分強度幾乎呈線性增加,相應的半峰寬變化幅度很小(30.9~32.4 nm),這進一步顯示了該器件對量子斯塔克效應的不敏感性,也證明了基于n-ZnO∶Ga MW/p-InGaN材料體系制備的異質結綠光發光二極管擁有較高的穩定性。以上實驗結果充分說明,本實驗設計的n-ZnO∶Ga MW/p-InGaN異質結結構可以用于構筑新型微結構綠光發光二極管。

圖3 (a)n-ZnO∶Ga MW/p-InGaN異質結發光器件的I-V曲線,上插圖為該器件的結構示意圖,下插圖為器件在1.9 mA工作電流下的發光照片;(b)器件的EL光譜,注入電流為0.15~2.0 mA,插圖為器件EL光譜積分強度和半峰寬隨注入電流的變化關系;(c)器件的相對外量子效率;(d)1.8 mA注入電流下,器件電致發光強度隨時間變化關系。Fig.3(a)I-V curve of the fabricated n-ZnO∶Ga MW/p-InGaN heterojunction,the upside inset shows the schematic diagram of the device,and the downside inset is the digital picture of the luminous device at an input current of 1.9 mA.(b)EL spectra of the heterojunction device measured by varying current in the range of 0.15-2.0 mA,the inset is variation cure of the integrated EL intensity and FWHM versus injection current.(c)Variation of the REQE as a function of injection current.(d)Time-dependent EL intensity of the device measured at the input current of 1.8 mA.
作為光電器件的一個重要指標,外量子效率(EQE)ηEQE可以證明光電器件的高效性、可靠性、穩定性。對于發光器件,其定義為器件發射光子數與注入電子數之比,可以通過以下公式計算:

其中,Np表示異質結發光二極管發射的光子數,Ne表示注入器件的電子數,e、h、c、J分別表示元電荷、普朗克常數、光速、異質結發光二極管中的電流,Iλ表示某一波長下所有光子的總能量。由于e、h和c是常數,Iλ與光譜儀測得的EL光譜強度成正比,因此我們可以定義異質結發光二極管相對外量子效率(REQE)ηREQE,表示為:

其中,Iλ-EL表示特定波長的電致光譜強度。計算各個注入電流下器件的EL光譜積分強度并除以電流強度,即可得到器件電致發光的相對外量子效率。
在注入電流為0.6~5.4 mA的情況下采集其EL光譜并計算其相對外量子效率,圖3(c)為該器件的相對外量子效率(REQE)隨注入電流變化的曲線。如圖所示,在較低的輸入電流下(0.6~1.2 mA),REQE急劇增加,在3.1 mA的注入電流下達到最大值;當注入電流達到3.7 mA時,REQE開始明顯下降。當器件的注入電流達到5.4 mA時,REQE相對于最大值下降了約4%,總體表現出相對較小的下降。與傳統綠色發光二極管相比,本實驗所設計的n-ZnO∶Ga MW/p-InGaN發光二極管在較高的注入電流下顯示出相對較低的效率降低。這表明n-ZnO∶Ga中的電子和p-InGaN中的空穴在n-ZnO∶Ga MW/p-InGaN異質結界面處的非輻射復合幾率較低。該現象可以歸因于本實驗所制備的ZnO∶Ga微米線具有良好的結晶質量及表面形貌,且其內部本征缺陷較少。此外,我們在室內正常環境下對器件進行了長期的發光穩定性測試。注入電流為1.8 mA,其他光譜測試條件保持完全一致,測試結果如圖3(d)所示。經過12個月存儲后,器件的發光強度只有微小降低,EL譜形狀也未出現明顯變化。該結果進一步證明,本工作中制備的n-ZnO∶Ga MW/p-InGaN異質結綠光二極管具有較高的穩定性。
為了探究n-ZnO∶Ga MW/p-InGaN綠光發光二極管的發光機制,對p-InGaN襯底進行光致發光測試。圖4(a)為歸一化的InGaN襯底的PL光譜和器件的EL光譜對比。如圖所示,InGaN襯底的PL光譜發光峰位于508 nm,半峰寬為27.3 nm。將ZnO∶Ga微米線PL譜(圖2(a))、InGaN襯底的PL譜與器件EL譜進行比較,可以推斷本實驗制備的n-ZnO∶Ga MW/p-InGaN異質結發光二極管的綠色發光既不是來自于單根ZnO∶Ga微米線的近帶邊發光或者可見區發光,也不是來自單純的InGaN襯底的發光,而是基于ZnO∶Ga/InGaN結區界面處電子-空穴的輻射復合[24,27]。采用Anderson能帶模型給出正向偏壓下該器件的能帶結構示意圖以探究異質結發光器件中載流子的傳輸過程及其電致發光的物理機制。如圖4(b)所示,在異質界面上出現了導帶和價帶的不連續,當施加正向電壓時,電驅動注入的空穴傾向于聚集在異質結區的InGaN襯底一側,而電子則傾向于聚集在ZnO∶Ga微米線一側,形成type-Ⅱ型異質結。當施加的電壓超過開啟電壓時,電子和空穴在結區界面處輻射復合并發射出綠光。
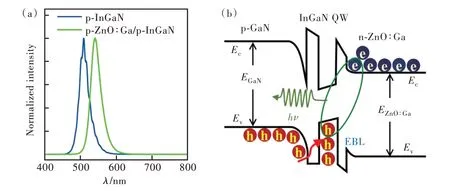
圖4 (a)p-InGaN襯底和制備的異質結器件歸一化光譜;(b)n-ZnO∶Ga MW/p-InGaN異質結在正向偏壓下的能帶結構圖。Fig.4(a)Comparison of normalized PL emission of p-InGaN template and EL of the fabricated heterojunction LED.(b)The energy band diagram of the n-ZnO∶Ga MW/p-InGaN heterojunction under forward bias.
3.3 n-Au@ZnO∶Ga MW/p-InGaN異質結器件
在上述實驗過程中發現,單根ZnO∶Ga微米線和InGaN襯底之間存在不均勻接觸,進而導致本實驗所制備的n-ZnO∶Ga MW/p-InGaN器件工作時微米線上存在零星的暗斑。為了優化n-ZnO∶Ga MW/p-InGaN異質結的結區界面以改善器件的發光效果,采用Au納米薄膜修飾ZnO∶Ga微米線,相應步驟參照上文2.2節部分。圖5(a)為Au納米薄膜修飾的ZnO∶Ga微米線的SEM圖像,右上方插圖清楚地展示了附著在ZnO∶Ga微米線表面的Au納米薄膜。
利用He-Cd激光器對Au納米薄膜修飾前后的微米線進行光譜表征,結果如圖5(b)所示。相較于修飾前的ZnO∶Ga微米線,其位于377 nm紫外波段的近帶邊發光得到了顯著增強,峰值強度提高到原值的2.4倍;位于507 nm可見波段的缺陷發光同樣得到了一定程度的增強,峰值強度提高到原值的1.8倍。這一現象主要歸因于Au納米結構的表面等離激元共振對Au@ZnO∶Ga微米線光場的場增強效應[28-30]。
使用Keysight B1500A測試了Au納米薄膜修飾前后ZnO∶Ga微米線的電學特性,相應的I-V曲線如圖5(c)所示。相較于未修飾的ZnO∶Ga微米線,Au納米薄膜的修飾進一步提高了ZnO∶Ga微米線的導電能力。結合單根Au@ZnO∶Ga微米線和p型InGaN襯 底制 備 了n-Au@ZnO∶Ga MW/p-InGaN異質結發光器件,相應的器件結構示意圖如圖5(d)中的插圖所示。使用Keysight B1500A對Au修飾的異質結發光器件的電學特性進行表征,器件相應的I-V曲線如圖5(d)所示。I-V曲線表現出良好的整流特性,相應的開啟電壓為3.5 V。對比未采用Au修飾的異質結器件,修飾后器件的開啟電壓明顯降低(從4.7~3.5 V)。特別是在13 V的正向偏壓下,器件工作電流已達到了2 mA。因此,器件的導電能力得到了極大的提升和改善。
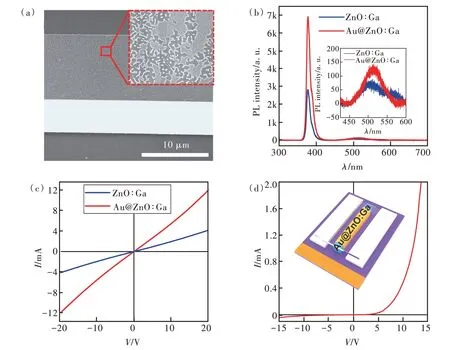
圖5 (a)Au納米薄膜修飾后ZnO∶Ga微米線的SEM圖像;(b)單根Au@ZnO∶Ga微米線與ZnO∶Ga微米線PL光譜,插圖為Au修飾前后缺陷光對比;(c)Au納米薄膜修飾前后ZnO∶Ga微米線的I-V曲線;(d)n-Au@ZnO∶Ga MW/p-InGaN異質結發光二極管的I-V曲線,插圖為相應的器件結構示意圖。Fig.5(a)SEM image of an individual Au@ZnO∶Ga MW,the inset image shows an enlarged view of the facets with Au nanofilm.(b)PL spectra of ZnO∶Ga MW and Au@ZnO∶Ga MW.The inset is the defect emission before and after Au decoration.(c)I-V characteristic curves of the individual ZnO∶Ga MW and Au@ZnO∶Ga MW.(d)Electrical characterization via I-V curve of the fabricated n-Au@ZnO∶Ga MW/p-InGaN heterojunction.The inset shows schematic architecture of the n-Au@ZnO∶Ga MW/p-InGaN heterojunction LED.
在相同的測試條件下對n-Au@ZnO∶Ga MW/p-InGaN異質結器件進行了電致發光性能測試。圖6(a)為兩種類型器件在1.6 mA工作電流下的單根微米線發光照片。從圖中可以明顯看出,ZnO∶Ga微米線存在明顯的不連續暗斑,其原因可能是微米線與襯底接觸不均勻。而對于Au@ZnO∶Ga微米線,發光區均勻覆蓋整個微米線,且更加明亮。圖6(b)展示了Au納米薄膜修飾的異質結器件EL光譜,相應的注入電流為0.2~1.7 mA。從EL光譜中可以看出,器件的發光峰位仍位于540 nm。隨著注入電流的增加,發光強度出現明顯的增強,相應的發光峰峰位沒有明顯的移動。對兩種器件的EL光譜積分強度隨注入電流的變化關系進行比較,結果如圖6(c)所示。對于n-ZnO∶Ga MW/p-InGaN發光二極管而言,隨著注入電流的增加,光譜的積分強度增加較為緩慢。引入Au納米薄膜修飾ZnO∶Ga微米線后,發光器件的光譜積分強度增長更加迅速。以上結果表明,Au納米薄膜的修飾改善了n-ZnO∶Ga MW/p-InGaN異質結界面的接觸,優化了結區界面,從而提高了其發光強度。

圖6 (a)1.6 mA工作電流下單根ZnO∶Ga微米線與Au@ZnO∶Ga微米線發光照片;(b)n-Au@ZnO∶Ga MW/p-InGaN異質結發光二極管在電流為0.2~1.7 mA下的EL光譜;(c)n-ZnO∶Ga MW/p-InGaN發光二極管與n-Au@ZnO∶Ga MW/p-In-GaN發光二極管的發光積分強度隨注入電流的關系對比。Fig.6(a)Digital pictures of single ZnO∶Ga MW and Au@ZnO∶Ga MW at the same input current of 1.6 mA.(b)EL spectra of n-ZnO∶Ga MW/p-InGaN heterojunction device measured by varying current in the range of 0.2-1.7 mA.(c)Variation of the integrated EL intensity versus injection current for n-ZnO∶Ga MW/p-InGaN heterojunction and n-Au@ZnO∶Ga MW/p-InGaN heterojunction.
4 結 論
本文在實驗上采用單根n-ZnO∶Ga微米線結合p-InGaN襯底制備了微型綠光發光二極管,實現了高穩定性的綠光發射。器件的發光中心波長始終位于540 nm附近,光譜半峰寬約為32 nm。在較高的工作電流注入下,該器件的相對外量子效率下降較小,表明采用單根ZnO∶Ga微米線和p-InGaN襯底制備的發光二極管能夠有效地規避量子斯塔克效應,具有良好的發光穩定性。此外,利用Au納米薄膜修飾ZnO∶Ga微米線,成功優化了異質結結區界面,提高了器件的發光強度。本研究結果可為高穩定性、高亮度微型綠光發光器件的設計制備提供重要的理論依據和實驗參考。
本文專家審稿意見及作者回復內容的下載地址:http://cjl.lightpublishing.cn/thesisDetails#10.37188/CJL.20220331.

