C面藍(lán)寶石拋光液組分優(yōu)化
計(jì) 健,梁志強(qiáng),周 海,蔣 網(wǎng),任相璞
(1.鹽城工學(xué)院機(jī)械工程學(xué)院,鹽城 224051;2.北京理工大學(xué)機(jī)械與車輛學(xué)院,北京 100081)
0 引 言
藍(lán)寶石由于化學(xué)性質(zhì)穩(wěn)定、機(jī)械性能優(yōu)異、耐熱耐磨損[1]、介電性能良好[2-3]、拉伸強(qiáng)度高和抗熱沖擊性高等性能,被廣泛應(yīng)用于半導(dǎo)體照明、國(guó)防軍工以及航空航天等領(lǐng)域。但藍(lán)寶石制造一般需經(jīng)過晶棒制造、套料、切片、倒邊、粗研磨、精研磨、拋光、清洗等工序得到應(yīng)用成品,其中的拋光工序是使用化學(xué)機(jī)械拋光(chemical mechanical polishing,CMP)來實(shí)現(xiàn)其全局平坦化的。而藍(lán)寶石表面質(zhì)量和其材料去除效率是其CMP工藝中的兩大評(píng)價(jià)指標(biāo),如何通過改變拋光液成分等參數(shù)來提升這兩個(gè)指標(biāo),是研究者們共同關(guān)注的問題。
近年來,國(guó)內(nèi)外學(xué)者對(duì)藍(lán)寶石拋光液進(jìn)行了諸多研究。陳國(guó)美等[4]研究了兩性離子表面活性劑月桂酰胺基烷基甘氨酸(N-Lauroylsarcosine,NL)(上海國(guó)藥產(chǎn))在拋光液pH值為6~12時(shí)對(duì)A面藍(lán)寶石晶片CMP拋光效果的影響,當(dāng)拋光液pH值為12時(shí),材料去除率達(dá)最大值2 202 nm/h,拋光表面的表面粗糙度為0.807 nm。崔雅琪等[5]研究了在拋光液中分別添加非離子表面活性劑異辛醇聚氧乙烯醚、陰離子表面活性劑十二烷基苯磺酸和陽(yáng)離子表面活性劑十二烷基三甲基氯化銨對(duì)A面藍(lán)寶石襯底CMP去除速率和表面狀態(tài)的影響,發(fā)現(xiàn)在一定濃度范圍內(nèi)3種表面活性劑均有助于提高藍(lán)寶石材料去除速率并降低其表面粗糙度,其中陽(yáng)離子表面活性劑相對(duì)于陰離子、非離子表面活性劑而言,能得到較好的表面質(zhì)量及潔凈度。汪海波等[6]以不同粒徑磨料混合,放大粒徑分散性影響,研究單一磨料和2種粒徑混合磨料對(duì)拋光速率的影響,發(fā)現(xiàn)2種不同粒徑混合能夠明顯提高拋光速率,并在一定質(zhì)量比條件下拋光速率可以達(dá)到最大值,而且粒徑差距越大拋光速率越快。董雙陽(yáng)等[7]研究了拋光液pH值、濃度及拋光溫度對(duì)CMP拋光藍(lán)寶石去除率的影響,發(fā)現(xiàn)藍(lán)寶石在CMP過程中的材料去除率均隨拋光液pH值和溫度的升高呈先增大后減小趨勢(shì)。
C面是藍(lán)寶石的基面(0001面),其表面質(zhì)量直接決定了在其上生長(zhǎng)的GaN外延層的質(zhì)量,目前,雖然對(duì)藍(lán)寶石CMP拋光液有了較多研究,但是對(duì)C面藍(lán)寶石拋光液中的表面活性劑的種類研究較少,不同的表面活性劑有不同的作用,比如潤(rùn)滑、分散、增大摩擦力作用等,所以本文對(duì)C面藍(lán)寶石拋光液組分進(jìn)行優(yōu)化研究,探究拋光液組分對(duì)C面化學(xué)機(jī)械拋光的影響,為后續(xù)生產(chǎn)實(shí)踐提供指導(dǎo)意義。因此,采用單因素試驗(yàn)探究拋光液磨粒種類、磨粒粒徑、拋光液pH值以及表面活性劑種類等因素對(duì)C面藍(lán)寶石拋光效果的影響,并采用正交試驗(yàn)對(duì)拋光液組成成分進(jìn)行優(yōu)化,確定藍(lán)寶石材料去除率高及表面質(zhì)量好的最優(yōu)成分組合。
1 實(shí) 驗(yàn)
1.1 CMP拋光原理
CMP拋光原理示意圖與晶片-磨粒-拋光墊的模型圖分別如圖1、圖2所示[8]。藍(lán)寶石工件粘在載物盤上,拋光墊粘在研拋盤上,拋光液由輸液管滴加在拋光墊上,磨拋頭主軸可對(duì)工件施加壓力,磨拋頭主軸與研拋盤均可獨(dú)自轉(zhuǎn)動(dòng),拋光過程中拋光液與工件發(fā)生化學(xué)反應(yīng)生成較軟的物質(zhì),該物質(zhì)再由拋光液中的磨粒通過機(jī)械作用去除。

圖1 拋光原理示意圖Fig.1 Schematic diagram of polishing principle

圖2 晶片-磨粒-拋光墊的拋光模型Fig.2 Polishing model of wafer-abrasive-pad
1.2 試驗(yàn)材料
試驗(yàn)工件為C面單晶藍(lán)寶石,由鹽城晶美應(yīng)用材料有限公司提供。工件具體尺寸:直徑為5 cm,厚度為0.02 mm,工件實(shí)物圖與二維形貌圖分別如圖3、圖4所示。圖4中拋光前的藍(lán)寶石晶片二維形貌顯示其表面質(zhì)量較差,表面有較多的劃痕,且全局粗糙度為42 nm。

圖3 工件實(shí)物圖Fig.3 Workpiece physical map

圖4 二維形貌圖Fig.4 Two-dimensional topography
1.3 試驗(yàn)條件
試驗(yàn)平臺(tái)為ZYP230旋轉(zhuǎn)擺動(dòng)重力式研磨拋光機(jī),拋光壓力通過增減磨拋頭上的負(fù)重塊來調(diào)節(jié),拋光盤轉(zhuǎn)速由拋光機(jī)平臺(tái)控制,流量泵控制拋光液流量。拋光結(jié)束后,用無水乙醇在超聲波清洗機(jī)中對(duì)工件清洗10~15 min,充分清洗掉工件表面的雜質(zhì);清洗結(jié)束后,使用吹風(fēng)機(jī)吹干工件表面的無水乙醇,再進(jìn)行稱重和表面質(zhì)量檢測(cè)。
1.3.1 材料去除率檢測(cè)
用精度為0.1 mg的FA2004電子天平(上海舜宇恒平科學(xué)儀器有限公司生產(chǎn))稱量藍(lán)寶石拋光前后的質(zhì)量差,再由式(1)計(jì)算其材料去除率[9]:
(1)
式中:RMRR為材料去除率,nm/min;ρ為藍(lán)寶石密度,3.98 g/cm3;S為藍(lán)寶石工件與拋光墊的接觸面積,此處為19.47 cm2;t是研磨時(shí)間,min;Δm為藍(lán)寶石拋光前后的質(zhì)量差,g。
1.3.2 表面質(zhì)量檢測(cè)
采用KEYENCE VK-X100/X200激光形貌儀對(duì)拋光前后藍(lán)寶石的二維、三維形貌進(jìn)行檢測(cè)。形貌儀實(shí)物圖如圖5所示。
1.4 單因素拋光試驗(yàn)
為了研究拋光液成分對(duì)C面藍(lán)寶石晶片CMP表面形貌及RMRR的影響,選擇拋光磨粒類型、拋光磨粒粒徑、拋光液pH值、表面活性劑種類等重要因素進(jìn)行單因素試驗(yàn),拋光磨粒平均尺寸分別為12 nm、20 nm、50 nm和100 nm。磨粒選擇氧化鈰(CeO2)、二氧化硅(SiO2)和氧化鋁(Al2O3)。SiO2為硅溶膠,Al2O3為α相剛玉,拋光液pH值為5、6、7、8、9、10、11和12,pH值調(diào)節(jié)使用NaOH與H3PO4(NaOH含量≥96%,H3PO4含量≥85%)。表面活性劑選擇上海國(guó)藥產(chǎn)的十六烷基三甲基溴化銨(hexadecyl trimethyl ammonium bromide,CTAB)、十二烷基苯磺酸鈉(sodium dodecyl benzene sulfonate,SDBS)、脂肪醇聚氧乙烯醚(primary alcobol ethoxylate,AEO)和三乙醇胺(triethanolamine,TEA)。拋光液由磨粒、去離子水、過氧化氫、表面活性劑、pH調(diào)節(jié)劑配成[10],拋光磨粒質(zhì)量分?jǐn)?shù)為4%,表面活性劑的質(zhì)量分?jǐn)?shù)為1%,過氧化氫的質(zhì)量分?jǐn)?shù)為2.5%。具體的拋光參數(shù)如表1所示。單因素試驗(yàn)過程中,環(huán)境溫度為25 ℃,拋光時(shí)間為1 h,拋光壓力為1.5 kPa,拋光盤轉(zhuǎn)速為30 r/min,拋光液流速為10 mL/min等因素保持不變。

表1 藍(lán)寶石單因素拋光試驗(yàn)參數(shù)Table 1 Sapphire single factor polishing test parameters
1.5 正交試驗(yàn)
CMP是一個(gè)非常復(fù)雜的過程,是化學(xué)和機(jī)械作用共同作用的結(jié)果。單因素檢驗(yàn)結(jié)果不能直接組合,因?yàn)檫€必須考慮因素之間的效應(yīng)。因此,為了獲得化學(xué)機(jī)械拋光的最佳因素組合,需要在單因素試驗(yàn)基礎(chǔ)上進(jìn)行正交試驗(yàn)。在拋光后的藍(lán)寶石表面形貌達(dá)到要求的情況下,選取RMRR為正交試驗(yàn)指標(biāo),采用極差分析法來確定因素間主次關(guān)系,得出一組最優(yōu)的拋光液成分參數(shù)組合。
正交試驗(yàn)的因素水平表如表2所示,為了減少試驗(yàn)次數(shù),采用SiO2為拋光磨粒,既能保證合適的RMRR,又能得到較好的表面質(zhì)量。選擇表面活性劑、拋光液pH值、磨粒粒徑3個(gè)因素,并分別選取3個(gè)水平制定L9(34)正交試驗(yàn)表。正交試驗(yàn)拋光其他工藝參數(shù)與單因素試驗(yàn)時(shí)保持一致。

表2 正交試驗(yàn)參數(shù)水平表Table 2 Parameter level table of orthogonal test
2 結(jié)果與討論
2.1 磨粒種類對(duì)藍(lán)寶石CMP的影響
試驗(yàn)使用的納米Al2O3、SiO2、CeO2磨粒[11]均來自邦瑞新材料科技有限公司。TEA為藍(lán)寶石CMP較常見的表面活性劑,磨粒粒徑D50選擇過大,材料去除率會(huì)較大,但表面質(zhì)量相對(duì)較差,當(dāng)粒徑D50選擇過小,去除率又相對(duì)過小,所以在此選擇最常用粒徑20 nm,而拋光液為弱堿性時(shí),有利于藍(lán)寶石的拋光,所以在此pH值選擇9。在磨粒粒徑D50為20 nm,TEA為表面活性劑,pH值為9條件下,使用3種不同磨粒制成的拋光液對(duì)C面藍(lán)寶石進(jìn)行CMP拋光,其表面形貌如圖6所示,拋光后藍(lán)寶石表面的RMRR如圖7所示。
如圖6所示,使用Al2O3磨粒拋光后的藍(lán)寶石晶片表面質(zhì)量較差(見圖6(a)),相比拋光前的圖4表面質(zhì)量并沒有改善,表面仍然有很多劃痕,全局粗糙度為48 nm,這是因?yàn)檠趸X硬度較大,其莫氏硬度達(dá)到了9,在拋光過程中的機(jī)械作用強(qiáng),很容易劃傷晶片表面。使用SiO2和CeO2為磨粒拋光后的藍(lán)寶石晶片,表面質(zhì)量都得到明顯改善(見圖6(b)、(c)),其中CeO2的表面質(zhì)量最好,其晶片全局表面粗糙度為21 nm,表面幾乎無劃痕;而SiO2為磨粒拋光后的表面劃痕也很少,全局表面粗糙度也僅為23 nm,表面質(zhì)量也較好。

圖6 三種磨粒拋光后藍(lán)寶石晶片形貌Fig.6 Morphology of sapphire wafers after polishing with three kinds of abrasive grains
由圖7可以看出,當(dāng)其他條件都相同,Al2O3磨粒的RMRR最大,達(dá)到41.72 nm/min,SiO2的RMRR處于中間水平,達(dá)到12.90 nm/min,CeO2的RMRR較低,僅達(dá)到7.53 nm/min。

圖7 磨粒種類對(duì)RMRR的影響Fig.7 Effect of abrasive species on RMRR
因此,從材料去除率方面分析,CeO2磨粒的材料去除率明顯不如SiO2磨粒的。這是由于SiO2和CeO2的莫氏硬度分別為7和6,SiO2的機(jī)械作用稍強(qiáng)于CeO2的。所以,以SiO2為磨粒時(shí)的RMRR要高于CeO2磨粒的,而表面質(zhì)量相差不是很大。綜合RMRR和表面形貌2個(gè)因素,優(yōu)先選擇SiO2為磨粒時(shí)拋光效果最佳。
2.2 拋光液pH值對(duì)CMP的影響
pH值作為CMP中相對(duì)重要的因素,對(duì)晶片材料去除和表面形貌有顯著影響。在其他工藝參數(shù)相同,TEA為表面活性劑,SiO2磨粒粒徑D50為20 nm條件下,拋光液pH值與RMRR的關(guān)系如圖8所示。由圖8可以看出:隨拋光液pH值增大,藍(lán)寶石晶片的RMRR呈先上升后下降趨勢(shì)。當(dāng)拋光液pH值為9時(shí),RMRR最大為12.90 nm/min。

圖8 拋光液pH值對(duì)RMRR的影響Fig.8 Effect of pH values of polishing slurry on RMRR
這是因?yàn)樵趬A性較強(qiáng)的環(huán)境下,Al2O3和SiO2磨粒會(huì)與水發(fā)生式(2)~式(4)的反應(yīng),且堿性越強(qiáng)化學(xué)反應(yīng)越劇烈,導(dǎo)致了磨粒的粒徑減小、硬度降低,使CMP過程中的機(jī)械作用有所減弱。同時(shí),在堿性條件下,藍(lán)寶石晶片與拋光液發(fā)生式(5)~式(7)的反應(yīng),OH-濃度較高時(shí),將導(dǎo)致CMP中的化學(xué)作用增強(qiáng),化學(xué)作用與機(jī)械作用失去平衡狀態(tài),所以隨著拋光液pH值的繼續(xù)增大,RMRR會(huì)表現(xiàn)為下降趨勢(shì)。而在弱堿性環(huán)境下,隨著pH增大,拋光液中的H+濃度減少,反應(yīng)式(8)和式(9)中的化學(xué)作用將減弱,且在pH值小于7的情況下拋光液中的SiO2會(huì)發(fā)生團(tuán)聚現(xiàn)象[12],因此SiO2磨粒的分散性較差也會(huì)影響其機(jī)械作用,所以弱堿性環(huán)境下的藍(lán)寶石RMRR普遍較低。當(dāng)pH值接近9時(shí),CMP中的機(jī)械作用和化學(xué)作用協(xié)同效果相對(duì)較好,所以其RMRR相對(duì)較高。因此,在選取SiO2為磨粒時(shí),可優(yōu)先選擇pH值在9附近。
Al2O3+H2O=2AlO(OH)
(2)
Al2O3+3H2O=2Al(OH)3
(3)
(SiO2)x+2H2O=(SiO2)x-1+Si(OH)4
(4)
Al2O3+2OH-=2AlO2-+H2O
(5)
AlO(OH)+OH-=AlO2-+2H2O
(6)
Al(OH)3+OH-=AlO2-+2H2O
(7)
SiO2+4H+=Si4++2H2O
(8)
Al2O3+6H+=2Al3++3H2O
(9)
2.3 磨粒粒徑對(duì)CMP的影響
在pH值為9,TEA為表面活性劑,SiO2為磨粒,其他工藝參數(shù)相同條件下,磨料粒徑對(duì)藍(lán)寶石晶片RMRR的影響如圖9所示。由圖9可以看出,磨粒粒徑增大,RMRR也隨之增大。當(dāng)磨粒粒徑從12 nm增大到100 nm時(shí),RMRR從7.74 nm/min增大到了19.57 nm/min。磨粒粒徑大小會(huì)影響磨粒的壓力和切入工件的深度。一般來說,粒徑大的磨粒機(jī)械作用較強(qiáng),材料去除率較高,但粒徑大的磨粒易在工件表面產(chǎn)生大的劃痕甚至裂紋,使工件表面質(zhì)量降低,因而使用粒徑小的磨粒可以得到較好的工件表面質(zhì)量。拋光壓力一定時(shí),磨粒粒徑改變會(huì)使單個(gè)磨粒的載荷發(fā)生改變,磨粒尺寸越大,單顆磨粒所受的載荷就越大,軋入藍(lán)寶石晶片的深度也就越大,去除晶片的量也就越大,因此材料去除率也就越大。
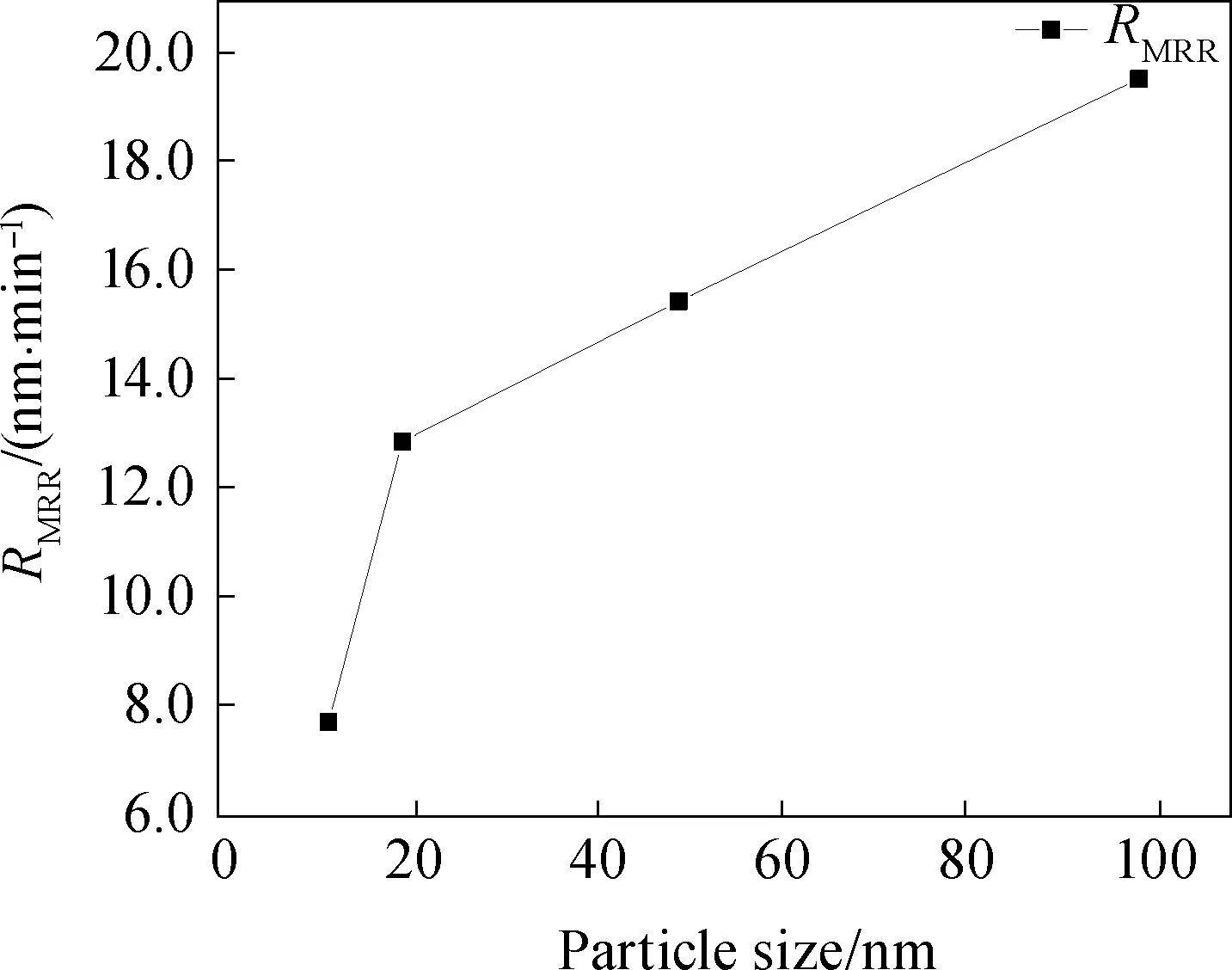
圖9 磨粒粒徑對(duì)RMRR的影響Fig.9 Influence of abrasive particle size on RMRR
2.4 表面活性劑對(duì)CMP的影響
表面活性劑在CMP拋光過程中也起著重要作用,它不僅能通過改變磨粒表面電位來改變磨粒的分散性,還能在拋光后的工件表面形成膜,有助于拋光后晶片的清洗等。
在拋光液pH值為9,SiO2磨粒粒徑D50為20 nm,其他工藝參數(shù)相同條件下,TEA、CTAB、SDBS、AEO 4種表面活性劑對(duì)RMRR的影響如圖10所示。由圖10可知:以TEA為表面活性劑時(shí)的RMRR最高,其次依次是CTAB、AEO、SDBS的。這是由于SiO2在堿性環(huán)境下呈負(fù)電性,而CTAB為陽(yáng)離子表面活性劑,在溶液中會(huì)電解出正電荷,正電荷會(huì)中和SiO2磨粒表面的負(fù)電荷,致使磨粒之間的靜電力減少,使磨粒分散性較好,因此其RMRR較高;SDBS一般為陰離子型表面活性劑,陰離子型的表面活性劑具有潤(rùn)滑作用,降低了磨粒與工件之間摩擦力,所以RMRR較低;TEA為非離子型表面活性劑,其在溶液中有助磨的效果,可以增大磨粒與藍(lán)寶石晶片之間的摩擦力,增大其機(jī)械作用,且TEA還可以改進(jìn)油性污垢,提高去污性能,清洗后的藍(lán)寶石晶片污垢較少,因此TEA做表面活性劑時(shí)的RMRR最高;AEO一般為非離子型表面活性劑,也具有潤(rùn)滑作用,且會(huì)吸附在晶片表面,由于吸附在藍(lán)寶石晶片上的表面活性劑不能完全清洗干凈,有一部分表面活性劑吸附在晶片上,使得拋光前后質(zhì)量差偏小,所以去除率較低。

圖10 不同表面活性劑對(duì)RMRR的影響Fig.10 Influence of different surfactants on RMRR
2.5 正交試驗(yàn)結(jié)果分析
表2的L9(34)正交試驗(yàn)方案及試驗(yàn)結(jié)果如表3所示。

表3 正交試驗(yàn)方案和試驗(yàn)結(jié)果Table 3 Orthogonal test scheme and test results
由表3數(shù)據(jù)得出極差分析結(jié)果(見表4),表中的Ki(i=1,2,3)表示因素在i水平下的RMRR之和,ki(i=1,2,3)則是Ki的三分之一,極差R為ki之間最大的差值。由表4可以看出:極差R的結(jié)果顯示各試驗(yàn)因素對(duì)藍(lán)寶石晶片CMPRMRR的影響主次順序?yàn)槟チA?A)、表面活性劑(B)、拋光液pH(C)。
由表4數(shù)據(jù)做出拋光試驗(yàn)因素水平圖,如圖11所示。由圖11可以看出:材料去除率最大的因素組合為A3B2C2,即磨粒粒徑為50 nm,表面活性劑選CTAB,拋光液pH值為9。在此參數(shù)下,拋光前后的藍(lán)寶石晶片的三維形貌如圖12所示,圖12中拋光后的藍(lán)寶石表面質(zhì)量得到很大改善,其全局粗糙度也從42 nm變?yōu)?7 nm。結(jié)合單因素、正交試驗(yàn),可以發(fā)現(xiàn)去除率均與磨粒粒徑呈正相關(guān),即磨粒粒徑越大,材料去除率越高。當(dāng)拋光液pH值在9附近時(shí),無論單因素還是正交試驗(yàn)去除率均達(dá)到最大值。而在表面活性劑方面則有所區(qū)別,單因素試驗(yàn)中,TEA效果最好,CTAB在正交試驗(yàn)上效果更好,這是因?yàn)楫?dāng)磨粒粒徑D50為20 nm時(shí),TEA的助磨增益要比CTAB的分散增益好,當(dāng)磨粒粒徑D50增大到50 nm時(shí)效果發(fā)生了反轉(zhuǎn),導(dǎo)致在正交試驗(yàn)上選擇CTAB作為表面活性劑更好。

表4 極差分析結(jié)果Table 4 Range analysis results

圖11 拋光試驗(yàn)因素水平圖Fig.11 Level chart of polishing test factors

圖12 拋光前后藍(lán)寶石的三維形貌圖Fig.12 3D topography of sapphire before and after polishing
3 結(jié) 論
探究拋光液組分對(duì)藍(lán)寶石CMP拋光材料去除率及表面形貌的影響,并進(jìn)行單因素試驗(yàn)及正交試驗(yàn),得出如下結(jié)論:
(1)在拋光磨粒質(zhì)量分?jǐn)?shù)為4%,環(huán)境溫度為25 ℃,拋光時(shí)間為1 h,拋光壓力為1.5 kPa,拋光盤轉(zhuǎn)速為30 r/min,拋光液流速為10 mL/min時(shí),以C面藍(lán)寶石RMRR及表面質(zhì)量為目標(biāo),單因素試驗(yàn)過程中的Al2O3、SiO2、CeO23種不同磨粒,Al2O3能保證較大的RMRR,但工件表面質(zhì)量較差,SiO2和CeO2的RMRR及表面相貌均較好,但CeO2的拋光效率低,SiO2的拋光效率適中,因此優(yōu)選SiO2磨粒拋光。
(2)在SiO2磨粒粒徑D50為20 nm,表面活性劑為TEA,pH值為9條件下,進(jìn)行單因素試驗(yàn)。隨拋光液pH值增大,C面藍(lán)寶石CMP的材料去除率變化趨勢(shì)為先增大后減小,當(dāng)拋光液pH值為9時(shí)的材料去除率最大為12.90 nm/min;隨SiO2磨粒平均粒徑從12 nm增大到100 nm,材料去除率從7.74 nm/min增大到19.57 nm/min;在TEA、CTAB、SDBS和AEO 4種表面活性劑中,TEA的RMRR最高,其次依次是CTAB、AEO、SDBS的。
(3)在拋光后的藍(lán)寶石表面形貌達(dá)到要求情況下,選取RMRR最大為優(yōu)化目標(biāo)進(jìn)行試驗(yàn)因素正交試驗(yàn),極差分析結(jié)果顯示各試驗(yàn)因素對(duì)藍(lán)寶石晶片CMP的RMMR的影響主次順序?yàn)槟チA?A)、表面活性劑(B)、拋光液pH(C)。
(4)以SiO2為磨粒,RMRR最大的組分組合為磨粒粒徑為50 nm,表面活性劑選CTAB,拋光液pH值為9。在此參數(shù)下拋光后的藍(lán)寶石表面質(zhì)量得到很大改善。

