SOI高壓LDMOS單粒子燒毀效應機理及脈沖激光模擬研究*
師銳鑫,周 鋅,2,喬 明,2,王 卓,李燕妃
(1.電子科技大學電子科學與工程學院,成都611731;2.電子科學大學廣東電子信息工程研究院,廣東東莞523000;3.中科芯集成電路有限公司,江蘇無錫214072)
1 引言
隨著電子設備在航空航天領域應用越來越廣泛,空間輻射環境中的高能質子、中子、α粒子和重離子等都能導致航天器電子系統中的功率半導體器件發生單粒子效應,嚴重影響航天設備的可靠性和壽命。自從1975年BINDER等人在衛星數字電路中發現單粒子效應之后,針對航天用的電子設備的抗輻射加固設計從未停止,國際半導體IR公司推出的抗輻射產品,第六代(HiRel)功率器件MOS管采用獨有的CoolMOS技術,抗電離總劑量(Total Ionizing Dose,TID)能力達100 krad(Si),采用氙離子時,線性能量傳輸(Linear Energy Transfer,LET)值ELET為55 MeV·cm2/mg,而鋁離子作為加速粒子時ELET可達84 MeV·cm2/mg。國內李燕妃等人通過研究開發抗輻射工藝平臺時發現,LDMOS器件在增加P型埋層結構后,其抗單粒子能力達到100 MeV·cm2/mg。
功率半導體器件的特點是內部電場強度大和工作電壓高,使其更容易發生單粒子燒毀(Single Event Burnout,SEB)效應。脈沖激光[1]和重離子都可以引起器件內部產生大量的電子空穴對,而導致高壓SOI LDMOS(Silicon-On-Insulator Lateral Double Diffusion Metal Oxide Semiconductor)內部寄生三極管開啟后,器件無法正常工作而失效[2-8]。20世紀80年代,由于單粒子輻射實驗復雜且昂貴,而脈沖激光模擬實驗具有高效率、可控性強和便捷等優點,而被廣大學者所采用。相較于VDMOS而言,SOI高壓LDMOS器件的單粒子燒毀效應研究相對較少,因此本文通過TCAD仿真確定SOI高壓LDMOS器件的單粒子失效敏感點并分析了失效機理,最后通過脈沖激光模擬實驗驗證了仿真結果[9-11]。
2 SOI高壓LDMOS器件結構
圖1 為研制的SOI高壓LDMOS器件結構剖面示意圖。器件結構總長20 μm,頂層硅厚度為1.5 μm,埋氧層厚度為1.2 μm,場氧化層厚度0.5 μm。P阱和N阱的摻雜濃度分別為1×1017cm-3和6.7×1016cm-3,離子注入后推結形成雙阱結構,漂移區通過離子注入的方式形成,摻雜濃度為5×1015cm-3,承擔器件的擊穿電壓,器件結構參數如表1所示。由于金屬層較厚,脈沖激光無法穿透金屬,器件設計時源極場板僅覆蓋部分漂移區。通過調節源極場板長度,確保表面電場分布優化,器件擊穿電壓達到180 V。
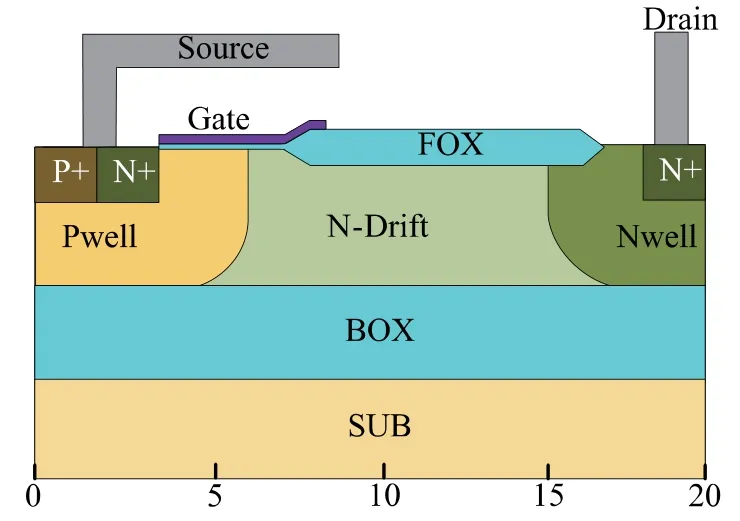
圖1 SOI高壓LDMOS器件結構示意圖

表1 SOI高壓LDMOS器件參數
3 單粒子燒毀效應機理
利用Synopsy公司的TCAD軟件進行SEB機理仿真研究,電學特性仿真使用復合模型和遷移率模型。復合模型包括肖克萊復合、碰撞離化模型以及重離子輻射模型(Heavy Ion Model),參數如表2所示。重離子入射角度為90°(垂直于界面),入射深度為1.5 μm,入射寬度為0.03 μm,入射離子時間為50 ps,ELET為0.75 pc/μm。遷移率模型考慮了遷移率與摻雜濃度、電場的關系。

表2 重離子輻射模型相關參數
圖2 為重離子入射后漏極電流隨時間變化的典型圖。當器件受到重離子轟擊后,硅材料會吸收高能離子的能量,使得電子從價帶躍遷至導帶中,在重離子的入射軌跡附近產生大量的電子空穴對。電子空穴對通過擴散運動和漂移運動的方式消散,漂移運動為主要方式。在電場的作用下,電子被漏極抽走,空穴向源極運動,從而形成瞬態光電流。若器件未發生SEB,則瞬態電流恢復至初始狀態;反之,器件瞬態電流將增大,使得器件長時間工作在大電流狀態,導致器件失效。
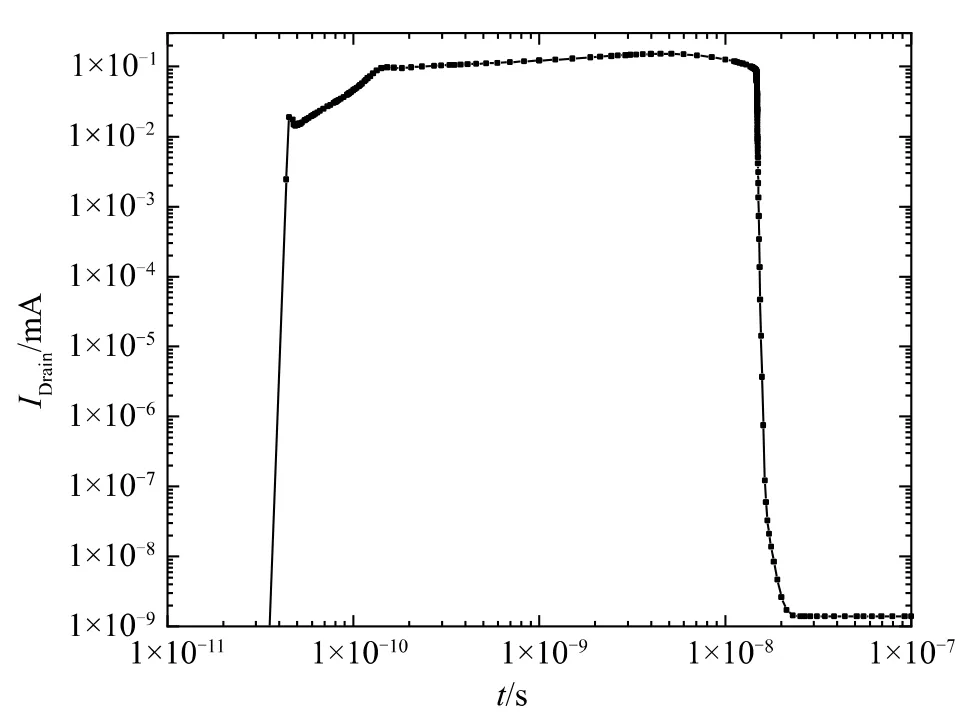
圖2 重離子入射后漏極電流隨時間變化典型圖
圖3 為不同入射位置的瞬態光電流峰值和器件漏極電壓為60 V時的表面電場分布圖。仿真中,偏置條件為漏極電壓VDrain接60 V、源極電壓Vsource、柵極電壓Vgate和襯底電位Vsub接0 V,分別對SOI高壓LDMOS器件的不同位置處進行重離子轟擊。根據理論分析可知,由重離子作用而產生的電子空穴對主要和ELET有關,但電子空穴對在電場作用下擴散和漂移時,會碰撞電離二次產生額外的電子空穴對,因此導致器件不同部位的瞬態光電流大小不同。從圖3可以看出,離子入射處電場越強,產生的光電流峰值越大。在X=7 μm處,電場值為1.5×105V/cm,離子入射后產生的光電流達到0.26 mA。因此,研制的SOI高壓LDMOS器件的敏感點位于X=7 μm處。
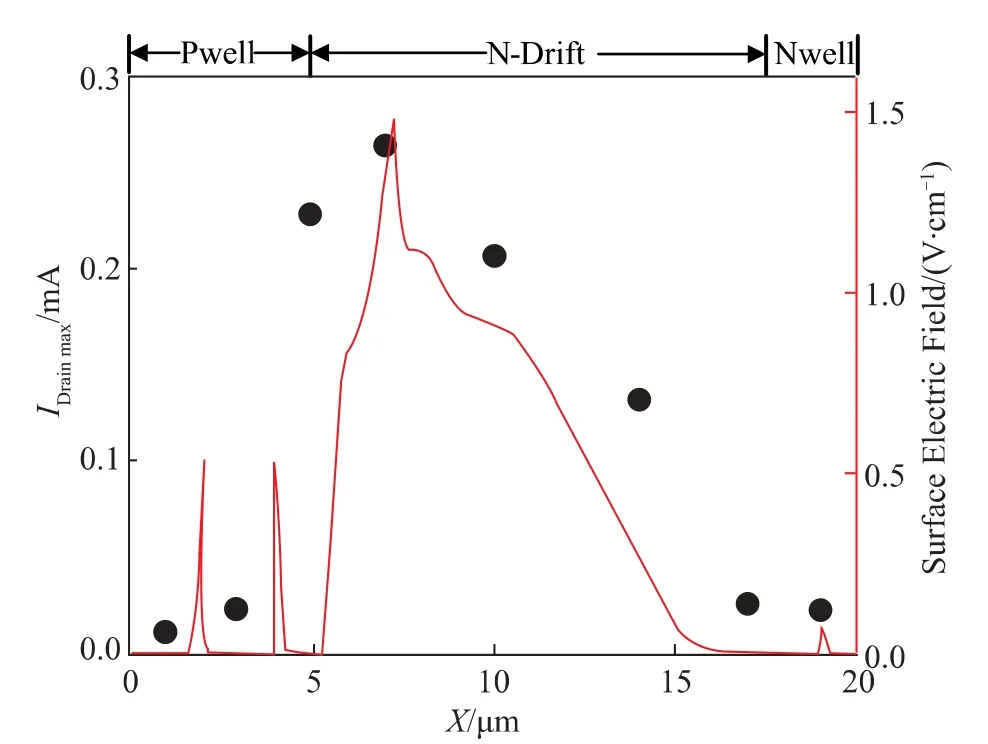
圖3 不同入射位置的瞬態光電流峰值和VDrain=60 V時表面電場分布
圖4 為不同漏極偏置下的光電流變化(入射位置為X=7 μm)圖。從圖4可以看出,隨著器件漏極的偏置電壓增加,瞬態光電流也隨之增加。當VDrain=85 V時,瞬時光電流峰值達到7.96 mA,且無法恢復至初始狀態,此時器件發生SEB效應。器件失效的主要原因是空穴在往P型體區漂移的過程中,導致寄生NPN三極管基區壓降大于0.7 V,從而使Pwell/N+結處于正偏狀態。此時Pwell/N-Drift結處于反偏,寄生三極管NPN處于放大狀態,電流急劇增加,因此器件發生燒毀而失效。

圖4 不同工作電壓對瞬態光電流的影響
圖5 和6分別對比80 V和85 V電壓下器件電子電流分布隨時間的變化圖和器件碰撞電離率隨時間的變化圖,選取了3個時間點:1 ps(入射前)、50 ps(入射時)和1 μs(入射后)。如圖5(a)、(d)和6(a)、(d)所示,器件未受到重離子轟擊,同時器件未發生擊穿,因此電子電流和碰撞電離率處于較低量級;如圖5(b)、(e)和6(b)、(e)所示,器件受到重離子轟擊,硅材料吸收能量后,在入射位置周圍產生了大量的電子空穴對,在外加電場的作用下形成電子電流,同時大量電子空穴對擴散或漂移的過程中提高了入射位置周圍的碰撞電離率;如圖5(c)、(f)和6(c)、(f)所示,器件受到重離子轟擊后,VDrain=80 V時器件額外產生的電子空穴對消散,器件電子電流恢復至初始狀態,未發生SEB效應,但當VDrain=85 V時,由于寄生三極管NPN開啟的作用,器件的電子電流并沒有恢復至初始狀態,且器件內部較大的碰撞電離率維持著寄生管的開啟。
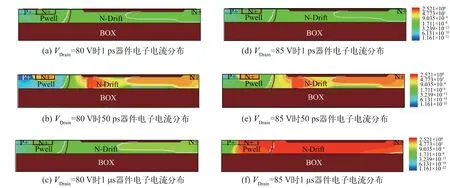
圖5 80 V和85 V電壓下器件電子電流分布隨時間變化
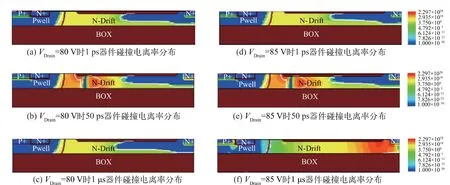
圖6 80 V和85 V電壓下器件碰撞電離率隨時間變化
4 脈沖激光模擬試驗
重離子的ELET是對硅材料電離出電子空穴對能力的描述,但是脈沖激光對硅材料的影響是用能量大小來描述的,因此需要建立ELET和能量之間的關系。通過激光的強度I隨著入射深度x的衰減關系滿足Beer定律,同時根據ELET=(dE/dx)/ρ,得式(1):

其中,ΔE為敏感體積中吸收的激光能量,Eion為重離子使材料電離的能量,ρ為材料密度,Ephoto為脈沖激光使材料電離的能量,A=1.6×10-13,h為敏感體積厚度,Re為反射率[12]。
圖7 (a)為脈沖激光模擬試驗的測試電路圖。通過示波器檢測SOI高壓LDMOS器件VDS的變化,當有瞬態電流產生經過采樣電阻(R=1 kΩ)后,由于電阻的分壓導致VDS下降,示波器采取電壓下降沿的方式捕捉瞬態電流的變化。根據式(1)計算,1.2 nJ的能量換算成ELET為1 pc/μm,試驗結果如圖7(b)所示,激光的圓心在X=7 μm處,位于源極場板的邊緣,試驗結果表明,VDrain=80 V、激光能量為2 nJ時,器件瞬態光電流可以恢復至初始狀態。
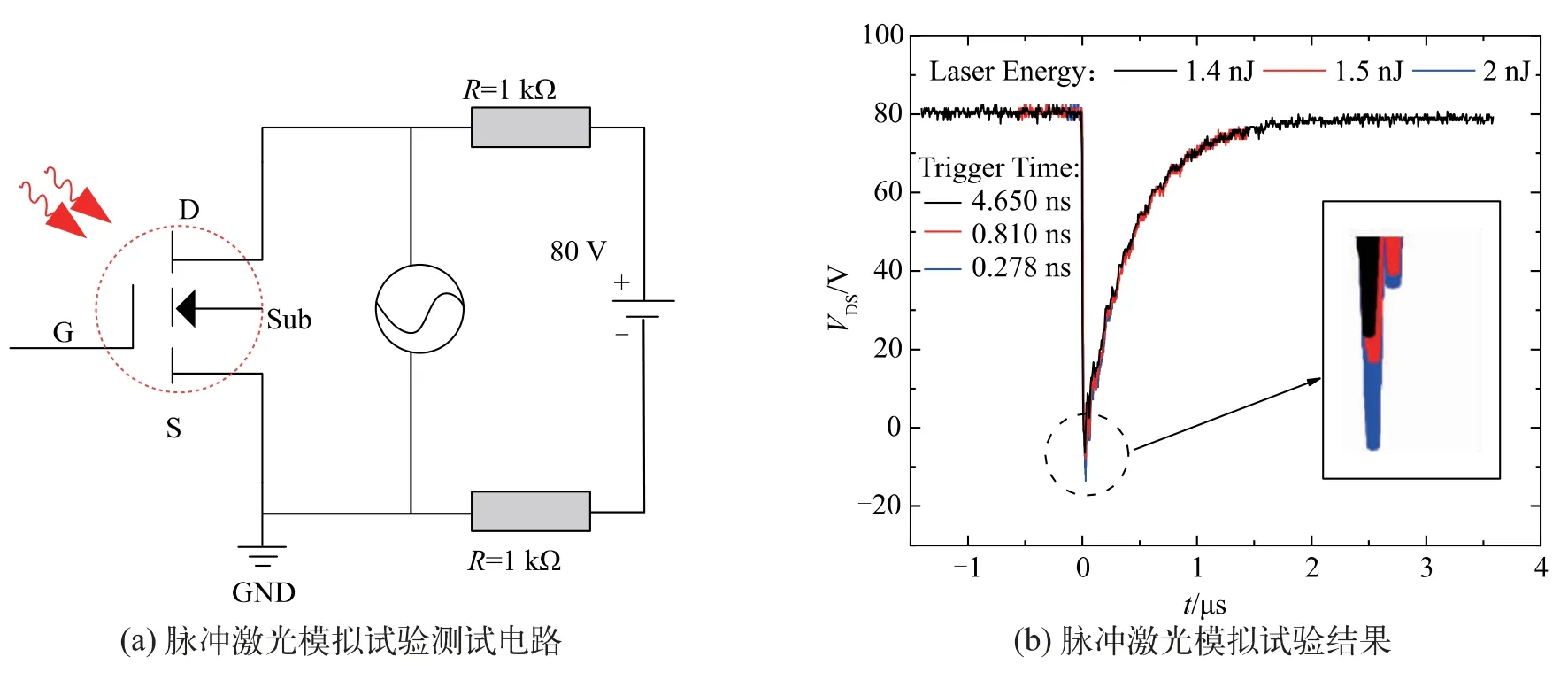
圖7 脈沖激光模擬試驗
5 結論
本文通過TCAD仿真軟件對SOI高壓LDMOS器件進行SEB效應機理及脈沖激光模擬試驗的研究。仿真結果表明,瞬態光電流大小與器件表面電場分布有關,因此器件單粒子敏感點位于表面電場峰值處,當漏極電壓VDrain=80 V時,器件不發生SEB效應,但是隨著漏極電壓繼續增加,器件瞬態光電流逐漸增大至不恢復狀態,通過對器件內部電勢及碰撞電離率的分析可知,高電場下產生額外的電子空穴對維持寄生NPN三極管開啟,器件長時間工作在高壓大電流狀態下而發生SEB效應。采用脈沖激光對器件敏感點進行輻射試驗,偏置條件為VDrain=80 V,脈沖激光能量為2 nJ時,器件瞬態電流先增加后降低至初始狀態,未發生SEB效應,與仿真結果一致。

