反應(yīng)磁控濺射氧化鎳薄膜的自旋塞貝克效應(yīng)
羅 健,張小偉,代 波
(西南科技大學(xué)材料科學(xué)與工程學(xué)院,環(huán)境友好能源材料國家重點實驗室,綿陽 621010)
0 引 言
熱電效應(yīng)和熱磁效應(yīng)早在19世紀(jì)前就已經(jīng)為人所知,它們反映了熱流和電荷電流的耦合,并在溫度計、發(fā)電機(jī)和冷卻器中得到廣泛的應(yīng)用[1]。熱流與自旋流相互作用,就產(chǎn)生了熱自旋電子學(xué)[2],其不僅僅是自旋電子學(xué)的子領(lǐng)域,更是自旋電子學(xué)、材料熱學(xué)、磁學(xué)的一個交叉學(xué)科,是一個熱傳輸現(xiàn)象和電子自旋之間的新興研究領(lǐng)域[3-5]。
自旋塞貝克效應(yīng)是自旋電子學(xué)研究中的熱點,該效應(yīng)是指在(亞)鐵磁體中存在溫度梯度時能夠產(chǎn)生自旋塞貝克電壓信號的現(xiàn)象[6-7]。由于溫度梯度而使自旋方向向上和自旋方向向下的電子分布不均,出現(xiàn)自旋極化現(xiàn)象,進(jìn)而產(chǎn)生自旋塞貝克電壓,自旋塞貝克電壓再驅(qū)動自旋流,這使得來自鐵磁體的自旋流能夠在宏觀尺度上注入到附著的非磁性金屬中[8]。逆自旋霍爾效應(yīng)[9-10]則能將注入非磁性金屬的自旋流轉(zhuǎn)換成電荷電壓,從而產(chǎn)生電動勢,易于測量[11]。
研究者們從磁性半金屬Co2MnSi[12]到磁性半導(dǎo)體(Ga,Mn)As[13],甚至在磁性絕緣體LaY2Fe5O12[14]和(Mn,Zn)Fe2O4[15]中,都觀察到了自旋塞貝克效應(yīng),這些觀察結(jié)果證實了自旋塞貝克效應(yīng)是鐵磁體的普遍特征[16]。上述實驗采取的結(jié)構(gòu)均為鐵磁體/順磁金屬,因為Pt能夠靈敏地探測到產(chǎn)生的自旋流[17],其常被作為順磁金屬層[18-19],而關(guān)于產(chǎn)生自旋流的鐵磁體,研究者們則進(jìn)行了關(guān)于種類和選擇的探索[20-21]。在關(guān)于自旋塞貝克效應(yīng)的研究進(jìn)展中,反鐵磁性絕緣體/順磁金屬結(jié)構(gòu)[22-24]較為常見,已有部分實驗證明,具有強自旋軌道耦合的反鐵磁性金屬也可以作為高效的自旋流產(chǎn)生器[25-27]。
本實驗采用反鐵磁性絕緣體NiO、順磁金屬Pt,以Si作為襯底,以Si/NiO/Pt結(jié)構(gòu)研究NiO相關(guān)的自旋塞貝克效應(yīng)。
1 實 驗
1.1 薄膜制備
本實驗采用中國科學(xué)院沈陽科學(xué)儀器有限公司JGP-450A型磁控濺射系統(tǒng),以直流反應(yīng)磁控濺射沉積NiO薄膜,靶材為金屬鎳靶(購于晶邁中科材料科技有限公司),純度(質(zhì)量分?jǐn)?shù))99.95%,直徑76.2 mm,厚5 mm。鍍膜襯底為硅片,鍍膜本底真空度優(yōu)于2×10-4Pa,靶間距為10 cm,濺射氣體為高純氬氣,反應(yīng)氣體為高純氧氣。在沉積薄膜的過程中,改變?yōu)R射功率、氧氬比例(流量比)、工作氣壓、襯底溫度中的一種,獲得系列薄膜,具體濺射參數(shù)如表1所示。

表1 NiO薄膜反應(yīng)濺射具體實驗參數(shù)Table 1 Specific experimental parameters of NiO thin film by reactive sputtering
1.2 樣品表征及性能測試
薄膜的厚度采用臺階儀(Bruker Dektak-XT)進(jìn)行測量;用X射線衍射儀(XRD,荷蘭帕納科X’pert pro,Cu Kα1(λ=0.154 06 nm))對樣品進(jìn)行物相和晶體生長取向表征;薄膜樣品的表面形貌和粗糙度分別采用高分辨冷場發(fā)射掃描電子顯微鏡(SEM, Zeiss Sigma 300)和掃描探針顯微鏡(AFM,日本精工公司SPA-300HV,掃描探針:NSC 15,曲率半徑<10 nm)進(jìn)行表征。
Si/NiO/Pt樣品結(jié)構(gòu)如圖1所示,其自旋塞貝克電壓信號在綜合測試平臺進(jìn)行測試。
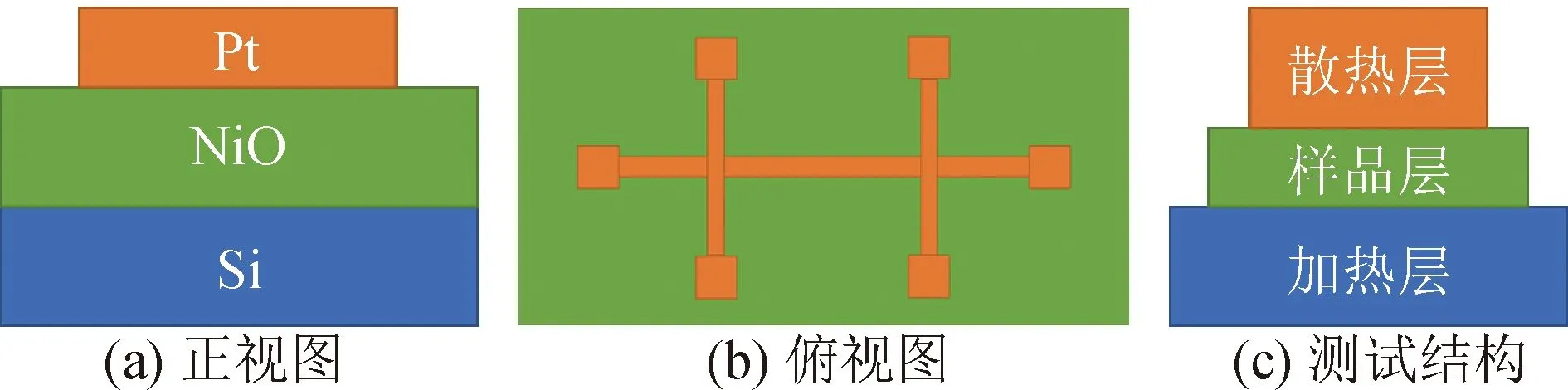
圖1 樣品及測試結(jié)構(gòu)示意圖Fig.1 Schematic diagram of sample and test structure
2 結(jié)果與討論
2.1 不同濺射條件對NiO薄膜相結(jié)構(gòu)的影響
本實驗中的Ar流量固定為100 mL/min,調(diào)節(jié)O2流量,O2與Ar的氣流量數(shù)值之比即為氧氬比例。首先設(shè)定氧氬比例為0.15、濺射氣壓為0.3 Pa、襯底溫度為常溫,控制濺射功率50~130 W,制備出NiO薄膜的XRD圖譜如圖2(a)所示。當(dāng)濺射功率為50 W時,并沒有看到很明顯的NiO衍射峰,濺射粒子因能量較小,碰撞成核概率低,小尺寸晶核多,薄膜的結(jié)晶性很差。當(dāng)濺射功率上升為70 W時,觀察到了與(111)晶面和(200)晶面對應(yīng)的兩種不同NiO衍射峰。隨著濺射功率從70 W增加到110 W,(111)峰強度持續(xù)增大,(200)峰逐漸消失。濺射功率70 W到130 W的區(qū)間里,NiO薄膜的擇優(yōu)取向始終是沿著(111)晶面,并在110 W時(111)峰強度相對最大。當(dāng)濺射功率為130 W時,(111)峰強度較110 W時減小,并再次出現(xiàn)(200)峰。
設(shè)定濺射功率為110 W、濺射氣壓為0.3 Pa、襯底溫度為常溫,控制氧氬比例0.05~0.3,制備出NiO薄膜的XRD圖譜如圖2(b)所示。當(dāng)氧氬比例為0.05時,測得(200)和(220) NiO衍射峰,此時NiO薄膜沿(220)晶面擇優(yōu)生長。當(dāng)氧氬比例為0.1時,(220)峰消失,新出現(xiàn)(111)峰,薄膜沿(111)晶面擇優(yōu)生長。此時制得的NiO薄膜結(jié)晶性尚可,為多晶薄膜。當(dāng)氧氬比例上升為0.15時,(200)峰消失,只剩下(111)峰,且峰強度較大。繼續(xù)增加氧氣比例,NiO薄膜仍然只有(111)峰,但強度明顯呈現(xiàn)下降趨勢,薄膜結(jié)晶性越來越差。
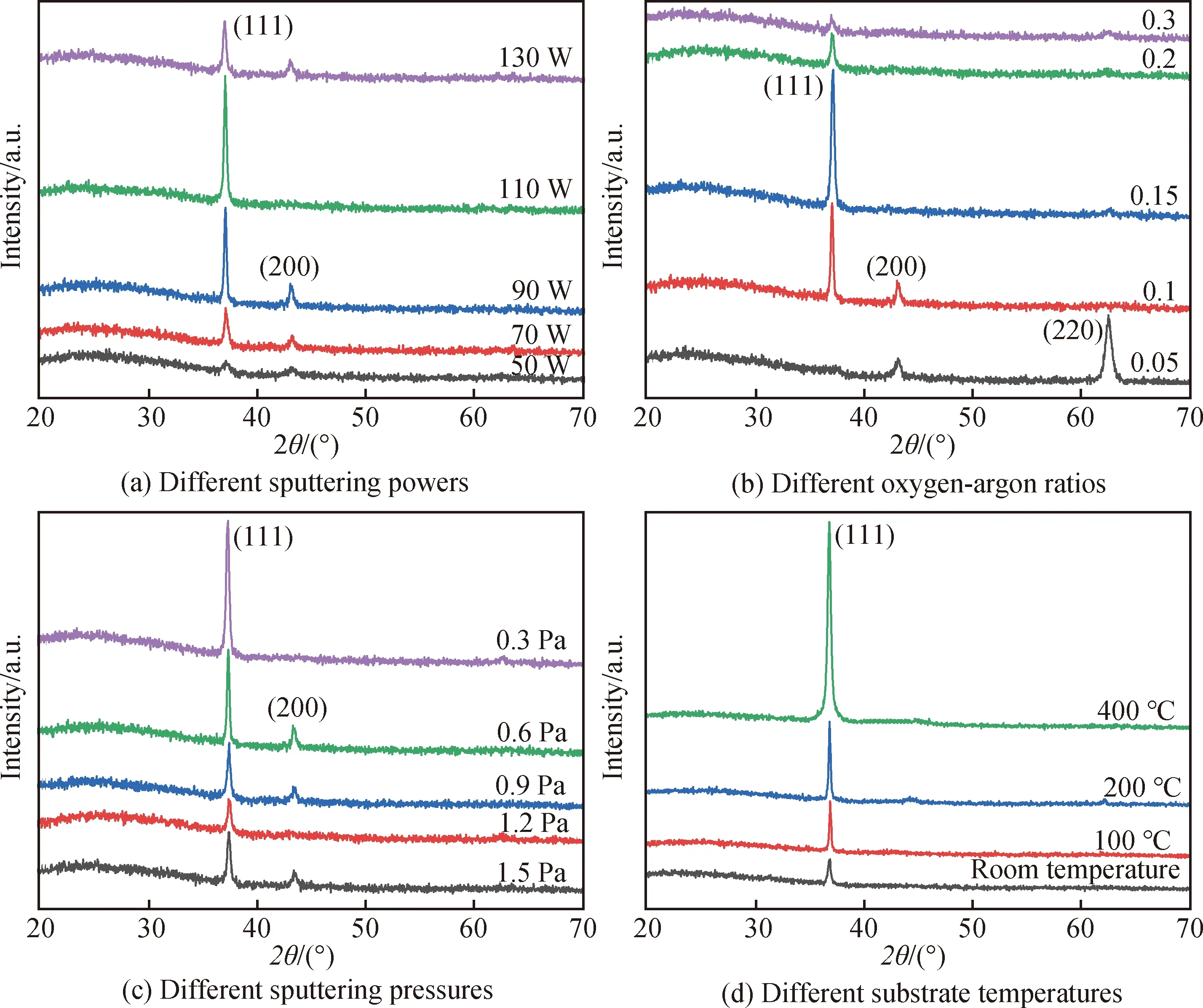
圖2 不同濺射參數(shù)條件的XRD圖譜Fig.2 XRD patterns with different sputtering parameters
設(shè)定濺射功率為110 W、氧氬比例為0.15、襯底溫度為常溫,控制濺射氣壓0.3~1.5 Pa,制備出NiO薄膜的XRD圖譜如圖2(c)所示。整體來看,在濺射氣壓不斷升高的情況下,NiO薄膜始終沿著(111)晶面擇優(yōu)生長。在濺射氣壓為0.3 Pa時, NiO薄膜只觀察到(111)峰,且強度較大,NiO薄膜結(jié)晶性良好。在濺射氣壓上升至0.6 Pa和0.9 Pa時,同時觀察到了(111)和(200)峰,兩種情況下(200)峰強度均相對較弱,(111)峰強度均相對較強,此時NiO薄膜的擇優(yōu)取向性變差。當(dāng)濺射氣壓增加至1.2 Pa時,(200)峰消失,只有(111)峰,強度再次降低。當(dāng)濺射氣壓升至1.5 Pa時,(200)峰再次出現(xiàn),并伴隨著(111)峰強度的增大。
設(shè)定濺射功率為110 W、氧氬比例為0.15、濺射氣壓0.3 Pa,控制襯底溫度從常溫到400 ℃,制備出NiO薄膜的XRD圖譜如圖2(d)所示。在不同襯底溫度下,NiO膜的結(jié)構(gòu)性質(zhì)變化不大。所有樣品僅(111)面有強烈的衍射峰,說明為該薄膜高度(111)取向且結(jié)晶性良好。圖中還可以還發(fā)現(xiàn),隨著襯底溫度的增加,衍射峰的強度增強,半寬峰減小,表明薄膜的結(jié)晶程度隨襯底溫度的升高而增加。
由上述實驗結(jié)果可知,濺射功率110 W、氧氬比例0.15、濺射氣壓0.3 Pa、襯底溫度400 ℃沉積出的NiO薄膜結(jié)晶性最好,為沿(111)晶面取向生長的高質(zhì)量薄膜,保障了Si/NiO/Pt結(jié)構(gòu)中自旋塞貝克效應(yīng)測試的穩(wěn)定性和準(zhǔn)確性[28],為后續(xù)實驗最適濺射參數(shù)。
2.2 NiO薄膜的表征
為了進(jìn)一步確定NiO薄膜的表面形貌和結(jié)晶質(zhì)量,采用SEM對不同濺射工藝參數(shù)的NiO薄膜樣品進(jìn)行表征。圖3分別是濺射功率110 W、氧氬比例0.15、濺射氣壓0.3 Pa,襯底溫度100 ℃和400 ℃的SEM照片。當(dāng)襯底溫度為100 ℃時,NiO薄膜晶粒緊湊、縫隙較少,表面的晶粒尺寸較小而且致密,但顆粒粒徑大小不均勻。當(dāng)襯底溫度為400 ℃時,薄膜更為致密,表面較平整,晶粒尺寸明顯增大;說明襯底溫度升高使薄膜表面的均勻性和致密度變得更好。
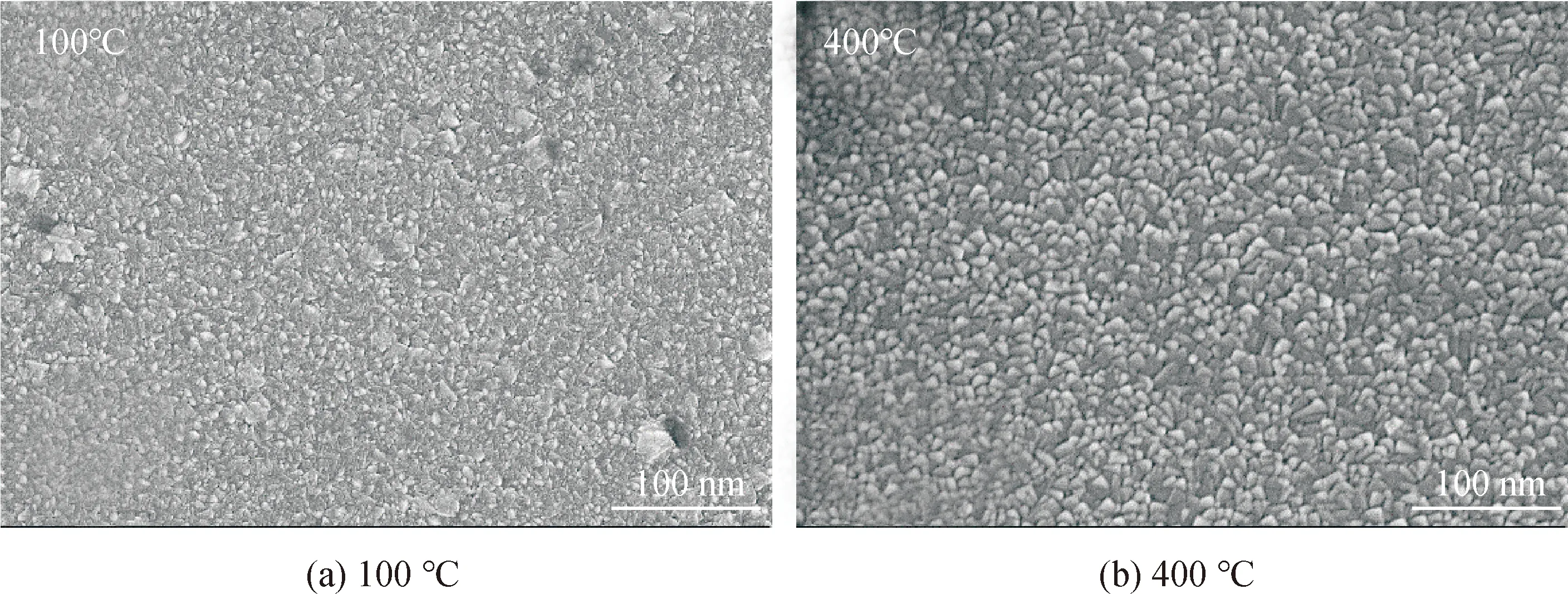
圖3 不同襯底溫度制備的NiO薄膜的SEM照片F(xiàn)ig.3 SEM images of NiO thin films prepared at different substrate temperatures
在后續(xù)實驗中,會在NiO薄膜的表面沉積不同厚度的Pt,對NiO薄膜的表面平整度有較高的要求。此處以最適濺射參數(shù)制備了不同厚度的NiO薄膜,并使用掃描探針顯微鏡測試其表面平整度。
以濺射功率110 W、氧氬比例0.15、濺射氣壓0.3 Pa、襯底溫度400 ℃的條件制備了不同厚度的NiO薄膜,其掃描探針顯微鏡圖像(AFM,1 μm × 1 μm)如圖4所示。其中厚度為50 nm時,薄膜平均粗糙度(Ra)為0.63 nm,均方根粗糙度(RMS)為0.91 nm;厚度為100 nm時,Ra為0.62 nm,RMS為0.87 nm;厚度為200 nm時,Ra為0.59 nm,RMS為0.83 nm;厚度為400 nm時,Ra為0.55 nm,RMS為0.76 nm。不同厚度NiO薄膜的平均粗糙度和均方根粗糙度均小于所沉積Pt的最小厚度,完全滿足實驗要求。
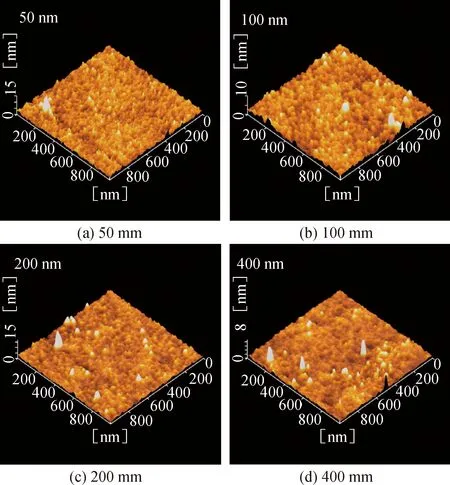
圖4 不同厚度NiO薄膜的AFM照片F(xiàn)ig.4 AFM images of NiO thin films with different thicknesses
2.3 Si/NiO/Pt結(jié)構(gòu)的自旋塞貝克效應(yīng)測試
樣品的溫度梯度(溫差)是產(chǎn)生自旋塞貝克效應(yīng)的條件之一,也是影響自旋塞貝克電壓信號的重要因素,本文研究了Si/NiO(300 nm)/Pt(5 nm)結(jié)構(gòu)中溫差對自旋塞貝克電壓信號的影響。初始溫度設(shè)定為300 K,控制加熱層和散熱層溫度,保持溫差在測試過程中的穩(wěn)定,溫差分別為3 K、6 K、9 K、12 K時,所測得的自旋塞貝克電壓如圖5(a)所示,隨著溫差的增大,Si/NiO/Pt結(jié)構(gòu)中的自旋塞貝克電壓信號呈增強的趨勢,且具有明顯的一次函數(shù)線性關(guān)系,自旋塞貝克電壓隨溫差的增大而增大。
改變磁場方向180°,在探究自旋塞貝克電壓與磁場角度關(guān)系的同時,驗證自旋塞貝克電壓與溫差的關(guān)系。控制溫差分別為3 K、6 K、9 K、12 K,將圖5(a)情況的磁場方向定義為0°,在H=500 Oe時得到的自旋塞貝克電壓信號為負(fù)值,旋轉(zhuǎn)樣品托盤180°后,磁場方向變相翻轉(zhuǎn)180°,在H=500 Oe時,得到的是正值。將兩次測量結(jié)果一同展示,如圖5(b)所示,圖中給出了磁場角度、溫差和自旋塞貝克電壓三者的關(guān)系,磁場角度的反向會使所測得的自旋塞貝克電壓反向,但對其數(shù)值幾乎不會有影響。隨后,在固定溫差為12 K的條件下,具體探究磁場角度對自旋塞貝克電壓的影響,控制磁場角度從0°變化到360°,每30°進(jìn)行一次測試,圖5(c)所示為測試結(jié)果。由圖可見,磁場角度對自旋塞貝克電壓的影響滿足余弦函數(shù)的情況,在磁場角度變化的影響下,0°和180°時自旋塞貝克電壓信號最強,90°和270°時為零。

圖5 溫差變化和磁場角度變化對自旋塞塞貝克效應(yīng)的影響Fig.5 Influence of temperature difference and magnetic field angles change on the spin Seebeck effect
保持NiO的厚度為300 nm,溫差為12 K,磁場角度為0°。改變Pt的厚度,使之分別為3 nm、5 nm、8 nm、10 nm,對樣品進(jìn)行測試,其結(jié)果如圖6(a)所示,隨著Pt層厚度的增加,Si/NiO/Pt結(jié)構(gòu)中自旋塞貝克電壓值呈單調(diào)遞減的趨勢。引起自旋塞貝克效應(yīng)的本質(zhì),是Si/NiO/Pt結(jié)構(gòu)中的反鐵磁材料NiO薄膜,順磁金屬Pt只是利用逆自旋霍爾效應(yīng),將NiO中的自旋流轉(zhuǎn)化為Pt中的電荷電流,處理后其表示為自旋塞貝克電壓。隨著順磁金屬層Pt厚度的增加,其電阻越來越小,相同條件下的逆自旋霍爾效應(yīng)也越來越弱,隨之轉(zhuǎn)化的電壓也變小,所以Pt層越厚,所測得的自旋塞貝克電壓信號越弱。
順磁金屬Pt對自旋塞貝克電壓信號強弱有所影響,作為反鐵磁材料的NiO薄膜厚度,也直接影響著Si/NiO/Pt結(jié)構(gòu)中自旋塞貝克電壓信號的強弱。此處選取前序?qū)嶒炈鶞y得自旋塞貝克電壓信號最大的測試參數(shù)來進(jìn)行下一步研究,即溫差12 K、Pt層厚度3 nm、磁場角度0°,改變NiO厚度分別為50 nm、150 nm、300 nm、400 nm,測試結(jié)果如圖6(b)所示,Si/NiO/Pt結(jié)構(gòu)中自旋塞貝克電壓信號強度隨NiO厚度單調(diào)遞增。正如前文中所提到的一樣,Si/NiO/Pt結(jié)構(gòu)中自旋塞貝克電壓信號本質(zhì)上來源于反鐵磁材料NiO中自旋塞貝克效應(yīng)產(chǎn)生的自旋流,NiO的厚度越大,結(jié)構(gòu)中所帶的自旋電子自然越多,在其他實驗條件相同的情況下,就能得到更強的自旋塞貝克電壓信號。
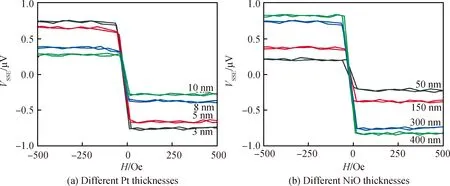
圖6 Pt層厚度和NiO層厚度對自旋塞貝克效應(yīng)的影響Fig.6 Influence of Pt layer thickness and NiO layer thickness on the spin Seebeck effect
3 結(jié) 論
利用反應(yīng)磁控濺射制備了較高質(zhì)量的NiO薄膜,濺射功率110 W、氧氬比例0.15、濺射氣壓0.3 Pa、襯底溫度400 ℃時,制備出的NiO薄膜結(jié)晶性較好,符合后續(xù)實驗要求。
在Si/NiO/Pt結(jié)構(gòu)中,NiO層的厚度越大所測得的自旋塞貝克電壓信號越強,而Pt層的厚度越大自旋塞貝克電壓信號越弱;溫差與自旋塞貝克電壓呈簡單的線性關(guān)系,溫差越大測得的自旋塞貝克電壓也越大;磁場角度與自旋塞貝克電壓之間滿足余弦函數(shù)關(guān)系式,即在0°和180°時所得自旋塞貝克電壓最大,90°和270°時為零。整個測試結(jié)果滿足鐵磁體/順磁金屬結(jié)構(gòu)的一般規(guī)律。

