射頻系統2.5D/3D封裝結構的研究進展
王豪杰,崔碧峰,王啟東,許建榮,王翔媛,李彩芳
(1.北京工業大學微電子學院,北京 100124;2.中國科學院微電子研究所,北京 100029)
1 引言
隨著5G通信的發展,射頻系統的復雜度越來越高,系統內部集成的無源元件和有源器件數量呈幾何級增長,射頻系統的小型化集成變得尤為重要[1-2]。射頻系統通常包括基帶、射頻和天線三部分,其中基帶部分用于處理物理層中的所有通信算法;射頻部分則包括發射通道和接收通道,信號發射時,射頻部分將基帶信號轉換成射頻信號,通過天線發射信號;接收信號時,天線接收信號,射頻部分將接收的射頻信號轉換成基帶信號。
目前射頻系統主要有SoC(System on Chip)和SiP(System in Package)兩種集成方式[3-6]。SoC中不同制造工藝的元器件,在一些情況下會出現工藝不兼容造成集成度降低,而且在射頻系統中容易出現信號傳輸、電磁干擾和電磁屏蔽、系統散熱等問題[7-8],無法真正實現射頻系統的異質集成。SiP的發展正好彌補了SoC技術的不足,不僅可以減小系統體積,提高系統性能,還具有靈活的設計方案、系統的異質集成、較短的開發周期。相比于普通封裝,射頻系統封裝更加注重器件封裝后的散熱、射頻信號傳輸、電磁屏蔽等能力[9-11]。為實現更高的射頻系統封裝能力,現已開發出多種射頻封裝結構,其中又以先進三維封裝結構作為未來主要發展方向。本文詳細介紹了3種主流的射頻先進三維封裝結構及相關工藝,為射頻系統三維封裝發展提供一定的研究基礎。
2 RF SiP關鍵技術
射頻系統中無源元件占總元器件數量的60%~80%,如果將其全部集成為一個封裝模塊,可預見到射頻系統體積將會大幅減小,因此射頻封裝結構從簡單的2D平面有源器件和無源元件的橫向集成逐漸向3D垂直有源器件和無源元件的縱向集成發展。由于射頻系統自身特性及應用環境,在電磁兼容、散熱、信號傳輸、器件小型化等方面,對材料、器件、工藝都有更高的標準。目前,2.5D/3D射頻系統封裝技術的研究主要包括中介層(Interposer)技術、埋入技術和堆疊技術。
2.1 2.5D中介層結構
根據所用材料的不同,中介層可分為硅基、玻璃基與有機材料。中介層結構主要由重分布層(Re-Distribution Layer,RDL)和通孔兩部分組成,其中通孔是作為中介層的核心組成部分,通孔工藝的發展影響著整個中介層結構的性能指標。由于中介層結構擁有高精度布線、MEMS(Micro Electro Mechanical System)集成、IPD(Integrated Passive Device)集成和優良的微波性能等能力,近年來成為全世界研究先進封裝結構的熱點之一。中介層結構在射頻系統封裝中已經得到廣泛的應用,例如射頻前端模塊中收發機的集成、MEMS振蕩器的集成、MEMS濾波器的集成等。通過該結構優異的異質集成能力可以形成一個高度統一的射頻系統,并且面對日益復雜的射頻系統,提供了高集成度、高性能、微體積射頻系統封裝解決方案。
2.1.1 硅基中介層
硅基中介層的RDL層采用和晶圓布線層相同的工藝,因此RDL層布線精度、線寬、線距相比于傳統基板布線得到了質的提升,線寬線距已經達到0.4μm/0.4μm[12]。此外RDL還可以通過在疊層之間集成無源器件,來增加中介層結構的集成能力。其中電容的集成是通過蒸鍍Ti/Au(金屬層1)和電鍍Cu(金屬層2)工藝構建MIM(Metal Insulator Metal)結構薄膜電容,當氮化硅作為MIM薄膜電容的絕緣體時,電容密度達到320 pF/mm2。電感的集成是利用布線圖形電鍍Cu形成螺旋電感,已有研究表明布線層集成螺旋電感在2 GHz頻率下品質因數為6,電感值可達3 nH[13-14]。
硅基中介層的通孔是通過在硅片上進行DRIE(Deep Reactive Ion Etching)工藝刻蝕出TSV(Through Silicon Via)。TSV深寬比經過多年的發展,當前先進TSV工藝可以達到5μm直徑、50μm深,深寬比達到了1∶10,較大的深寬比提高了硅基中介層的集成能力。TSV對射頻系統電氣性能的影響主要因素有信號TSV與地TSV之間的距離、深度、直徑、形狀。2013年HUANG等人通過改變地TSV與信號TSV的距離,測試信號TSV的傳輸性能,得出在低于7 GHz的頻率下,較大的間隔距離具有較好的傳輸性能,但是在25 GHz頻率以上,較小的間隔距離反而具有較好的傳輸性能[15]。2018年WANG等人通過電磁仿真TSV不同直徑的傳輸性能,得出在低頻或45 GHz以上超高頻率時,不同的TSV直徑對射頻傳輸參數S11影響較小,但在37~43 GHz的頻率范圍內,隨著TSV直徑的增大,TSV的射頻傳輸參數S11隨之減小[16]。TSV的形狀包括普通的T形TSV、兩同軸階梯空心環TSV、S-COV(Silicon-Core Coaxial Via)等。TSV在加工制造過程中的理想形狀為圓柱體,但由于實際加工中工藝條件限制,TSV一般為T形,即側面有一定的傾斜,T形TSV的傾斜度會對電磁特性產生較大的影響,在高頻時理想圓柱形TSV相比于T形TSV有更優異的傳輸性能。高頻信號傳輸時,由于趨膚效應,信號只在傳輸路徑表面附近傳輸,因此,為減少工藝成本,改善TSV高頻性能,對TSV形狀進行優化,2017年LEE等人提出S-COV形狀,其在TSV通孔內的硅芯表面淀積金屬Cu作為垂直互連通道,并且利用ABF(Ajinomoto Build-up Film)有機材料良好的電磁性能,將其填充在信號和地之間作為有機絕緣層,不僅降低了TSV的制造成本,同時增強了射頻傳輸能力[17]。2018年YAN等人研究出兩同軸階梯空心環TSV形狀,其采用HR-Si(High Resistivity Silicon)作為介質層,由于HR-Si擁有較低的損耗因子,因此HR-Si介質層可以有效降低射頻信號的損耗,使TSV在高頻環境下擁有更佳的信號傳輸能力[18-19]。
隨著TSV工藝的發展,一些基于TSV中介層的封裝應用得以實現。與平面電容、電感相比,三維無源器件具有更高的品質因數和更好的高頻響應。SUN等人將中介層平面布線電感下方的硅利用DRIE和RIE(Reactive Ion Etching)工藝刻蝕掉,其所形成的3D懸浮電感比平面電感品質因數提升了一倍,工作帶寬提升了兩倍[20]。硅基中介層嵌入微流道的應用,中介層中既包括傳輸電信號的TSV,也包括傳導熱量的微流道,CAI等人測試采用了嵌入微流道硅基中介層封裝的GaN功率放大器,在微流道內液體流速為1.7 m/s的情況下,散熱能力達到400 W/cm2熱負荷,滿足功率放大器的要求[21]。目前射頻硅基MEMS主要應用在振蕩器、雙工器和濾波器,將射頻MEMS高度靈活集成在射頻系統封裝中,從而減小互連寄生參數,實現優越的電氣性能[22-23]。
2.1.2 玻璃基中介層
從材料本身性質來看,玻璃有較好的射頻性能,包括高體電阻率、低介電常數、低介電損耗、熱膨脹系數可調性好等特點,在射頻系統中玻璃基中介層相較于Si基中介層具有高線性度、低插入損耗和低成本的優點。因此國內外研究機構對玻璃基中介層展現出濃厚的興趣,其中2013年美國的佐治亞理工封裝研究中心探索了一種超小型化和多功能系統的新概念,稱為3D IPAC(Integrated Passive and Active Components),使用小型TGV(Through Glass Via)通孔在超薄玻璃基中介層進行雙面有源器件和無源元件互連,元器件互連距離為30~50μm,利用3D IPAC集成的新型薄膜無源元件比當前薄膜無源元件的厚度減少4/5[24]。
對于玻璃基中介層的3D射頻系統集成,先進玻璃基RDL層線寬線距達到2μm/2μm[19,25]。TGV制作方法通常包括濕法刻蝕、RIE、噴砂、激光刻蝕、光敏玻璃的使用和玻璃回流工藝[26]。對于小孔徑TGV的加工,以目前的加工能力還無法達到先進TSV孔徑的相同水平。
近年來基于TGV技術的玻璃基中介層被廣泛研究,2016年基于TGV工藝的高品質因子3D電感器已被研究,其顯示出良好的射頻性能和基于TGV工藝在電子元件微型化方面的巨大潛力[27];2017年HWANGBO等人通過在玻璃基中介層集成收發天線,在3D封裝結構中進行無線點對點的數據傳輸,突破了小型化封裝芯片與芯片間互連的瓶頸,優化了3D封裝的設計和制造能力,減小了封裝體積[28];2018年SHAH等人測試了采用共形電鍍工藝的TGV通孔,測試結果顯示,在10 GHz時TGV的射頻傳輸參數S21為0.014 dB,直流電阻為28 mΩ,在三次諧波測試中,擁有TGV的共面波導測試結構相比于無TGV的共面波導結構僅高2 dB,表明了結構整體優良的線性性能[29];2019年ZHANG等人采用TGV技術在玻璃上集成BPF(Bandpass Filter),采用基于TGV的屏蔽環,不僅增強了帶通濾波器的抗干擾性,并且提高了帶通濾波器的散熱能力,集成TGV屏蔽環的BPF相比于不帶TGV屏蔽環的BPF,其FBW(Fraction Bandwidth)增加了3.1%,對集成TGV屏蔽環的BPF進行熱仿真,得出BPF最高溫度僅為69.6℃。基于TGV技術的BPF在小型化、工藝難度和制造成本上都有較大的優勢,在BPF中心頻率5 GHz附近,測得插入損耗為2.25 dB,返回損耗為15.8 dB[30]。由于先進的DRIE刻蝕工藝無法應用到TGV中,因此玻璃基中介層尚不能形成高深寬比的通孔。當前TGV常采用激光打孔工藝制造,激光工藝存在孔內殘渣較多和孔徑較大的問題,增加了填孔時間和填孔材料成本。并且在器件應用范圍、結構復雜度及集成度等方面低于硅基中介層,嚴重制約了玻璃基中介層的發展。
2.1.3 有機中介層
有機基板憑借自身在成本和制造方面的巨大優勢,逐漸出現在高密度封裝的中介層結構中。目前,先進的有機中介層RDL布線密度量產可以達到8μm/8μm的線寬線距,現研究的RDL層布線密度最大可以達到2μm/2μm線寬線距。有機中介層中的微孔可以由CO2激光、UV激光、曝光光敏介質層等工藝形成,其中由于CO2激光的波長較大,在激光打孔時,介質會產生大量的熱量,難以形成40μm以下的孔徑;UV激光可以選擇光斑大小及打孔模式,現已能夠量產40μm孔徑的微孔,并已開始對30μm以下孔徑進行研究;曝光光敏介質層工藝是目前研究40μm以下孔徑的最新探索,通過曝光介質層能夠形成5~20μm的微孔孔徑[19]。
有機中介層具有和硅基、玻璃基中介層相似的集成能力,并且完全適配各種尺寸需求的中介層封裝,有機材料熱膨脹系數(CTE)較大,為降低有機中介層的CTE參數,通過在介質層中填入陶瓷和SiO2材料來提高系統的兼容性,常用的介質層材料為ABF,內部填充SiO2小球。在實際應用中,除了在一些需要采用超高布線密度和超低介電損耗的情況下,有機中介層將是較適合的中介層結構。2013年OKAMOTO等人研究了有機中介層想要達到和硅基中介層相同或者更高的傳輸帶寬,不僅需要較小的線寬線距,而且對有機材料的介電常數和表面粗糙度都有更高的要求[31]。2014年YOSHIZAWA等人將以STO(Strontium Titanate Oxide)為介質材料的電容埋入到有機中介層中,通過與MOS(Metal Oxide Semiconductor)片上集成電容比較,得出STO電容對提高工作頻率和降低供電電壓的顯著貢獻[32]。
表1從集成度方面詳細對比了硅、玻璃、有機中介層結構,在實際應用中根據封裝需要選擇合適的材料[33-34]。表2列舉了硅、玻璃、有機3種材料的電磁參數,可以看出玻璃更加適合用于高速信號的傳輸[35]。中介層結構本質上還算不上真正的3D封裝結構,但卻是現階段封裝技術可支撐并實現的先進封裝結構。

表1 中介層封裝結構對比(單位:μm)
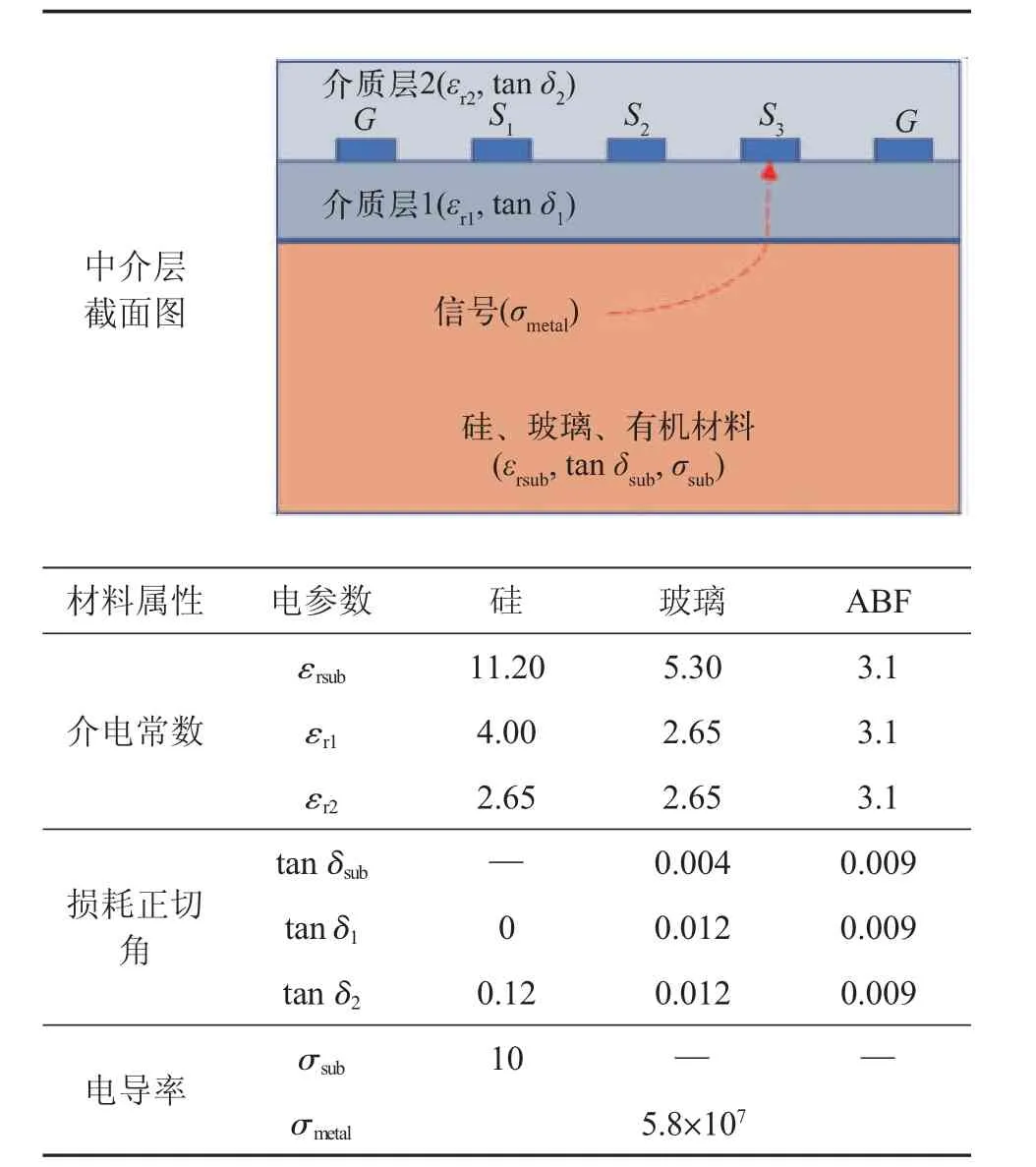
表2 硅、玻璃、有機材料電參數
2.2 埋入結構
基板埋入結構最早開始于20世紀60年代,最初只是在陶瓷基板中埋入無源器件,構成簡單的埋入結構,經過不斷的發展,埋入結構已研究出將有源、無源器件混合埋入基板中的工藝[35-36]。常見的先進封裝結構都是在基板表面上集成的3D結構,而埋入結構是向下發展的3D封裝結構,它是通過在基板內部埋入有源和無源器件形成一個基板內部的微系統。常用的封裝基板材料有陶瓷、有機基板兩種,其中陶瓷基板材料由于成本、工藝、集成度等原因,較少應用在埋入結構中。有機基板埋入是目前應用最廣、工藝成熟度最高的埋入結構,并且為了匹配射頻器件中不斷提高的信號傳輸頻率,有機基板制造廠商已經產出可以應用到毫米波波段的高頻板材,例如LCP(Liquid Crystal Polymer)、BT(Bismaleimide Triazine)、ABF等,大大拓寬了有機基板的應用范圍和工藝開發靈活度。
早期基板埋入結構如圖1所示[35-40],大致分為芯片先置型埋入結構和芯片后置型埋入結構。芯片先置型埋入結構指的是先將芯片嵌入到基板中,然后在芯片和基板上面進一步制作多層互連線,該結構具有良好的電氣性能、可靠性和縱向集成能力,但是加工工藝復雜,埋入芯片時容易對芯片造成一定的損傷,埋入芯片一次成型不可修復;芯片后置型埋入結構是在疊層基板制作完成之后在基板上開腔,然后將芯片埋入該腔體而形成的封裝結構,該結構具有工藝簡單、成品率高、散熱好等優點,但是對于埋入基板的表面空間,由于芯片的埋入不再適合集成其他器件,降低了埋入基板的集成度,因此需根據埋入器件類型和應用需求,選擇合適的埋入結構。

圖1 早期基板埋入結構
為了追求更好的電性能、更直接的散熱通道,更輕、更小的尺寸和更低的成本,結合芯片先置型埋入和芯片后置型埋入封裝技術,中國科學院微電子研究所提出了兩種埋入型板級封裝技術,即器件埋入芯層和器件埋入壓合層兩種埋入結構(見圖2所示)[41]。器件埋入壓合層可以將更多的器件埋入基板中,有更高的集成度,但是由于埋入器件的厚度不一致,芯片背部不適合激光鉆盲孔,因而不適合有背金接地要求的芯片埋入;器件埋入芯層可以埋入有背金接地要求的芯片,但是只適合厚度相似的芯片的埋入。工作時如果射頻功率器件不能及時導出熱量,器件產生的高熱會導致熱應力沖擊,造成結構缺陷、失效和損傷。有機基板埋入結構憑借芯層材料和介質層材料的快速發展,無論埋入何種材料的射頻芯片,都能尋找與其CTE相近的基板進行埋入,減小因熱應力而導致的結構損壞,此外由于芯片是埋入在基板,芯片產生的熱量可以通過與其相連的導熱通道直接將熱量傳導至封裝外部,有效地解決了芯片熱管理問題。在射頻封裝中有機基板埋入因小型化、低成本、工藝成熟等優點,在眾多封裝結構中脫穎而出。采用埋入結構封裝的射頻系統與目前的封裝結構相比,可以減小50%的封裝體積,并且射頻系統性能保持不變[42]。日本封裝廠商TDK采用SESUB(Semiconductor Embedded in Substrate)埋入技術與傳統封裝的性能對比如圖3所示[43]。

圖2 埋入結構

圖3 SESUB埋入技術與傳統SiP封裝的性能對比
2.3 堆疊結構
堆疊結構是真正意義上的3D封裝,封裝結構是從垂直的維度上來增加系統的集成度。早期堆疊結構主要應用在存儲器芯片封裝中,將多個存儲芯片在垂直方向上堆疊起來實現高帶寬數據交換。近些年3D堆疊結構逐漸開始應用在射頻系統領域,堆疊結構解決了系統集成Tx/Rx射頻前端鏈路、天線、變頻模塊、基帶部分的小型化和電磁兼容等難題。當前3D堆疊結構主要包括引線鍵合堆疊、TSV堆疊、PoP(Package on Package)3種堆疊封裝結構,它們具有不同的特點,應用場景也不盡相同。其中PoP封裝結構在射頻系統封裝中應用廣泛,是目前和未來主要研究的射頻封裝堆疊結構。
2.3.1 引線鍵合堆疊結構
引線鍵合堆疊結構如圖4所示[44],利用引線鍵合互連技術,把不同功能的射頻芯片通過層疊的方式,堆成緊湊的三維立體結構。引線鍵合堆疊是將多個裸芯片通過粘膠層垂直粘貼在一起,再將粘貼完成的裸芯片和基板封裝在一起,芯片與芯片之間的互連、芯片與基板之間的互連都是采用打線的方式進行鍵合,適合芯片間的異質集成。但是由于堆疊是用打線進行互連的,對于射頻系統傳輸線阻抗匹配和寄生參數會造成不利的影響,因此引線鍵合堆疊結構較少在射頻領域中應用。

圖4 3D引線鍵合堆疊
2.3.2 TSV堆疊結構
TSV堆疊結構如圖5所示[45],每個堆疊芯片通過倒裝互連的方式將芯片垂直堆疊在一起,堆疊芯片中的TSV通孔用作上下層的互連通道,該結構所使用的TSV工藝和中介層的TSV工藝相同。晶圓上TSV密度和電性能影響著堆疊結構的互連密度和互連帶寬,由于TSV堆疊結構是通過犧牲一定的芯片使用面積來達到高密度封裝的,因此互連區域TSV的尺寸大小同樣影響著堆疊封裝密度,另外,TSV通道設計對射頻信號的串擾、損耗、反射等信號傳輸問題至關重要。TSV堆疊結構與引線鍵合堆疊結構相比,擁有更快的通信速度、更低的能量消耗、更短的互連距離、更高的集成度。但是,TSV堆疊結構對裝配精度、材料兼容性及堆疊芯片的尺寸統一要求嚴格,對于多種異質射頻芯片的封裝就會顯得力不從心,因此該種堆疊結構較少在射頻系統中應用,更多應用在多個存儲芯片和邏輯芯片之間的高帶寬互連。當前TSV堆疊結構是T/R組件一體化研究的熱點,射頻前端器件與天線通過堆疊形成TSV瓦片式堆疊結構。將射頻芯片進行堆疊封裝,無論是引線鍵合堆疊還是TSV堆疊,都會改變芯片表面傳輸線的介電常數,從而影響射頻性能,此外,射頻芯片表面常有較為脆弱的空氣橋結構,在堆疊裝配過程中極易遭到損壞。
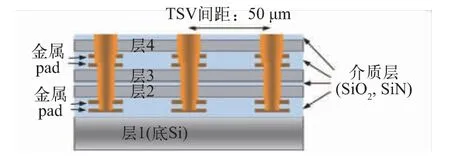
圖5 TSV芯片堆疊
2.3.3 PoP堆疊結構
PoP堆疊結構如圖6所示[46-47],由多個封裝體在垂直方向鍵合組成,根據鍵合方式又分為PoP堆疊和柔性基板PoP堆疊。PoP堆疊結構是將2個獨立的封裝體通過鍵合在垂直的方向上堆疊在一起,PoP上層和下層互連常用的有3種鍵合類型:銅柱(Through InFO Vias,TiVs)、穿塑孔(Through Mold Via,TMV)、焊接球,其中TiVs在互連密度、互連尺寸、互連距離上都要明顯優于其他2種鍵合類型。柔性基板PoP堆疊是通過普通基板和柔性基板相結合的方式形成的3D堆疊,柔性基板嵌入在2個普通基板中間層,作為2個普通基板的電互連通道,利用柔性基板的可彎曲特性,可以將2個普通基板進行上下堆疊,提高封裝集成度。上下基板互連部分的柔性基板主要由3部分構成:金屬層、介質層、粘貼層,其中金屬層作為上下基板的電互連傳輸通道,粘貼層主要是增加互連部分的機械強度,相比于利用導通孔進行垂直互連的堆疊結構,柔性基板PoP堆疊結構具有更高的互連密度和異構集成度。在設計射頻系統PoP堆疊結構時,通過對低損耗垂直傳輸、信號通道隔離、模擬和數字信號通路的低串擾和有效的熱管理優化,射頻PoP堆疊結構實現了良好的電氣和可靠性性能。
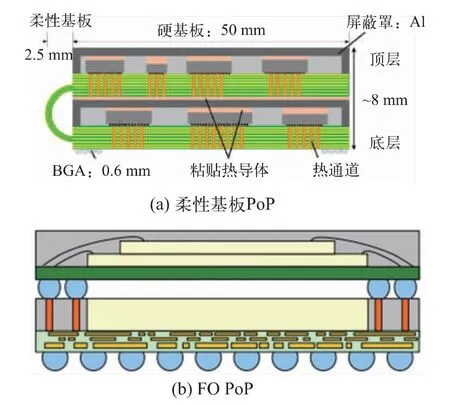
圖6 PoP堆疊結構
2017年NAIR等人利用e-WLB(Embedded Wafer Level BGA)技術設計并制作了一種適用于可穿戴電子系統的三維堆疊封裝,該結構中集成6個射頻和數字IC,以及24個不同尺寸的無源組件,3D堆疊封裝尺寸為6.0 mm×5.5 mm×1.9 mm,比使用傳統印刷電路板技術制作的相同系統小55%,測試結果表明,系統性能與之前的系統相同或更好[48]。2018年HSU等人提出一種低翹曲6層堆疊扇出封裝結構,這種FO PoP堆疊結構在縱向和橫向上都具有較高的集成靈活性,并且該3D扇出堆疊方案繼承了扇出封裝的散熱優勢,減少了熱串擾,為高度異構和復雜系統集成提供了一個有力的解決方案[49]。2018年LIU等人提出了基于PoP結構的雙頻段射頻SiP模塊的設計與實現,采用BGA(Ball Grid Array)將RO4350B高頻基板與BT-HDI(High Density Interconnect)基板垂直疊加,射頻SiP的尺寸為3.8 cm×4.0 cm×0.4 cm,集成了50個裸片和251個無源器件,射頻通路的插入損耗優于0.4 dB,通道隔離和混合信號隔離優化后均優于60 dB,全負載熱模仿真表明,芯片結溫可以滿足125℃的要求[50]。2017年WU等人研究了一種柔性基板的三維堆疊射頻SiP結構,該封裝結構應用在微基站的射頻前端系統集成,設計的射頻SiP為為5.0 cm×5.3 cm×0.8 cm,包括超過33個有源芯片和600個以上的無源組件[47]。柔性基板PoP對于天線集成提供了一個較好的解決方案,很好地解決了AiP(Antenna in Package)小型化的難題[51]。表3詳細對比了IC堆疊與PoP堆疊的優劣勢,PoP在成本、堆疊靈活性和熱管理指標上擁有較大優勢[49]。
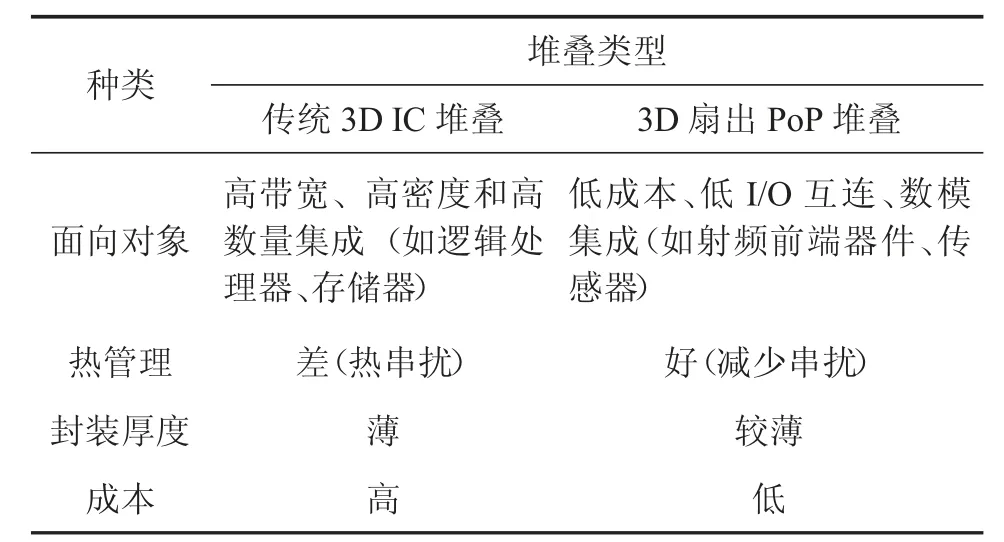
表3 PoP與傳統3D IC堆疊結構對比
3 3D RF SiP結構遇到的挑戰
先進射頻封裝結構在發展過程中,會由于封裝材料、工藝、裝配等因素制約其在射頻系統中應用。先進封裝結構中所用到的主要材料有硅、玻璃和有機材料,每種封裝材料所遇到的研究挑戰都有所差別,因此根據封裝材料特性來適配加工工藝和射頻器件是必不可少的。
3.1 中介層結構
中介層結構包含硅基中介層、玻璃基中介層、有機中介層3種材料結構。硅基中介層芯片和I/O集成數量的挑戰,對于較薄硅基中介層加工制造時涉及到鍵合和解鍵合工藝,鍵合膠耐受溫度一般低于150℃,而RDL介質層固化溫度較高,從而影響多層布線的集成;硅基中介層中的PI(Polyimides)和金屬層及基底之間的黏附力,PI表面均勻性,亦影響布線層數。硅基中介層成本上的挑戰在于為實現超高密度的布線采用半導體前道工藝,導致制造成本過高,增大了企業成本壓力。玻璃基中介層TGV的工藝挑戰是常用的玻璃打孔工藝(噴砂、光敏玻璃)存在孔型不均勻和不平整問題,激光打孔時會產生介質飛濺、孔周邊殘渣去除困難等問題,由于現有工藝無法形成高深寬比的TGV,造成填孔時間和材料成本增加;在散熱方面,由于玻璃的導熱率遠小于硅,導致結構中熱量無法及時散出。有機中介層結構對于5μm以下的線寬線距,常規的基板加工工藝困難,常采用半導體工藝來實現超高密度的布線;由于超薄介質材料中無法填料,中介層存在翹曲問題,對有機中介層的可靠性也帶來挑戰。
3.2 埋入結構
對于埋入結構來說,埋入基板中集成有源器件、無源元件及多功能器件,多種器件異構集成在埋入結構中,將會導致多種材料及結構性物理參數的失配,如果沒有一定的緩沖和兼容機制,熱集中時會降低埋入層和整體結構的可靠性。另外,埋入器件后埋入層表面的清潔、介質壓合后的平整度和埋入器件的兼容性,也影響著結構穩定和信號完整性。
3.3 堆疊結構
對于TSV堆疊結構,對芯片堆疊裝配工藝的挑戰來自于對于超薄芯片的裝配精度和平整度的要求非常嚴格,此外堆疊結構中射頻異構系統集成以及相關熱機械可靠性問題也是一個嚴峻挑戰。對于PoP堆疊結構,主要研究和挑戰是堆疊封裝后結構的翹曲和互連距離增加,結構翹曲降低了PoP封裝的可靠性,影響器件的使用壽命,封裝間互連距離的增加將會導致射頻信號傳輸性能變差。此外,I/O間距過大,對PoP高密度集成也形成了較大的挑戰。
4 RF SiP結構的研究趨勢
射頻系統在向著高頻、高密度、多功能、小型化、結構多樣化以及低成本方向發展的同時,會遇到工藝、信號完整性、熱管理等方面的挑戰。為了滿足射頻系統對低介電常數、低損耗材料的需求,通過不斷研究已經開發出如陶瓷系材料(Al2O3、SiO2等)、有機材料(BT、聚酰亞胺等)、硅基材料、玻璃基材料等高頻射頻封裝材料。未來的先進結構必然是一體化封裝,從射頻器件一體化(射頻開關、低噪聲放大器、功率放大器等)封裝,到系統一體化(從前端邏輯器件到后端天線)集成,形成一個體積更小、散熱更強、一體化程度更高的射頻系統封裝。圖7為2014年格魯曼(NGAS)公司面向異質集成開發的先進三維封裝結構,內部集成多種異質模塊,為未來高集成度射頻系統封裝的發展提供了一定的指導意義[52]。
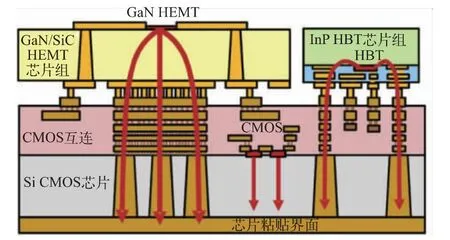
圖7 NGAS異質集成結構
5 結論
本文介紹了目前射頻系統封裝結構的發展現狀及現有的先進射頻封裝工藝。從先進射頻封裝技術發展要求來看,射頻系統全方位、一體化三維封裝勢在必行。

