C波段連續波200 WGaN內匹配功率管設計與實現
湯茗凱,唐世軍,顧黎明,周書同
(南京電子器件研究所,南京 210016)
1 引言
目前,連續波內匹配功率管廣泛應用于衛星地面通信、微波散射通信和電子對抗等系統中,已經成為無線通信系統的關鍵器件之一。隨著無線通信技術的發展,通信距離要求越來越長,數據傳輸量越來越大,連續波內匹配功率管必定朝著大功率方向發展。
以GaN材料為基礎的第三代半導體工藝器件,具有高電子遷移率和高場強擊穿電壓等顯著特征。與典型材料以Si和GaAs為代表的第一代與第二代半導體相比,第三代半導體在工作帶寬、熱導率、功率密度和效率等方面優勢明顯,更加適用于對可靠性、效率和功率有高要求的軍用無線微波通信領域。因此用第三代半導體制作的GaN管芯設計出大功率連續波內匹配功率管已經成為一個研究熱點[1-3]。
近年來,國內外多家半導體企業研制出多種型號的連續波GaN內匹配功率管,工作頻率從P波段到X波段[4-7],輸出功率從幾瓦到百瓦級別不等。C波段連續波內匹配功率管公開報道的產品有日本TOSHIBA公司研制出的一款5.8~6.7 GHz頻段130 W連續波GaN內匹配功率管(型號TGI5867-130LHA,工作電壓40 V),美國Cree公司推出的一款4.4~5.0 GHz頻段180 W連續波GaN內匹配功率管(型號CGHV50200F,工作電壓40 V)。受制于管芯最高工作結溫和功率管體積的影響,上述C波段連續波內匹配功率管工作電壓為40 V,最大輸出功率在180 W量級,功率附加效率(PAE)在50%以內,管芯熱阻典型值達到0.8℃/W。本文基于南京電子器件研究所自主研制的GaN HEMT管芯,利用GaN管芯模型提取阻抗,采用多胞管芯功率合成技術,在工作電壓為28 V條件下進行連續波測試,4.4~5.0 GHz頻帶內輸出功率提升到200 W(典型值220 W),飽和功率增益10 dB,功率附加效率提高到50%(典型值53%),管芯熱阻降到0.52℃/W。
2 器件工藝及特性
本文研制的GaN HEMT器件剖面如圖1所示,GaN HEMT器件在101.6 mm(4英寸)半絕緣SiC襯底上生長AlGaN/GaN異質結材料,該材料包含GaN緩沖層、AlGaN插入層和AlGaN勢壘層[8]。GaN HEMT器件柵長為0.35μm,雙場板結構設計,源漏間距為3.0μm。GaN HEMT器件采用歐姆接觸工藝制作,包含Ti/Al/Ni/Au 4層金屬體系,光刻形成包含Ti/Al的漏(Drain)和源(Source)電極以及包含Ni/Au的柵(Gate)電極,采用電子束剝離和蒸發工藝實現柵條金屬化。最后利用源通孔接地,并且將襯底減薄至100μm以增加器件本身的散熱能力。
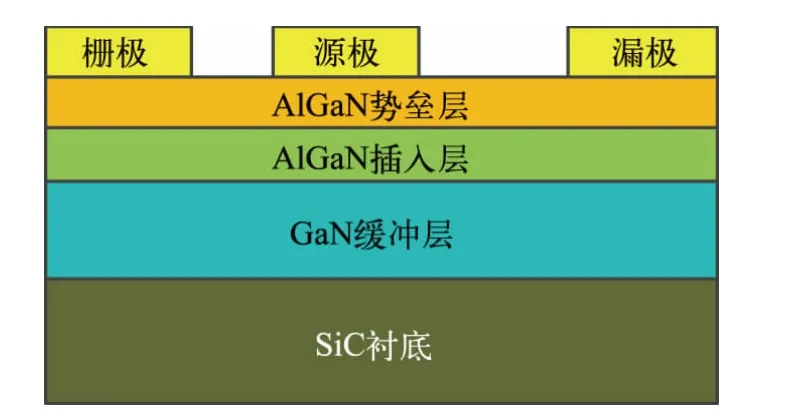
圖1 GaN HEMT剖面示意圖
采用上述工藝制作的GaN HEMT管芯結構如圖2所示,該管芯柵極采用分胞結構,胞與胞之間用電阻連接,可以提升匹配電路的穩定性;接地通孔直接制作在源條上有效提升散熱能力,降低器件熱阻,增加可靠性。

圖2 12 mm GaN HEMT管芯結構
4μm×100 μm標 準PCM(Process Control Monitor)監控管芯在漏壓VDS=28 V、漏極電流IDS=100 mA/mm、連續波測試條件下,PCM管芯截止頻率達到18 GHz。該PCM管芯在4.7 GHz頻率點上的最佳功率匹配與最佳效率匹配條件下的微波特性分別如圖3和圖4所示。最佳功率匹配時該PCM管芯功率密度為4.73 W/mm,功率增益(Gp)為12.7 dB,PAE為56.2%;最佳效率匹配時該PCM管芯功率密度為4.33 W/mm,功率增益為12.1 dB,PAE為59.1%。
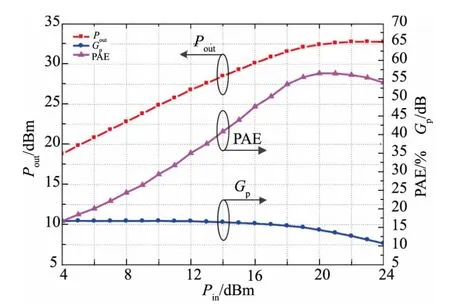
圖3 4μm×100μm管芯4.7 GHz最佳功率匹配性能曲線
3 匹配電路設計
該內匹配功率管的拓撲電路如圖5所示,從圖中可以看出輸入輸出匹配網絡類似,均先通過L-C低通網絡將4只12 mm GaN HEMT管芯阻抗變換到某個值,然后通過微帶阻抗變換電路將阻抗匹配到50Ω。依據負載牽引系統提取的最佳效率和最佳功率匹配阻抗值,選取合適的阻抗進行匹配電路設計,輸入端采用的匹配方式實現良好的輸入駐波,輸出端采用的匹配方式實現大功率輸出。
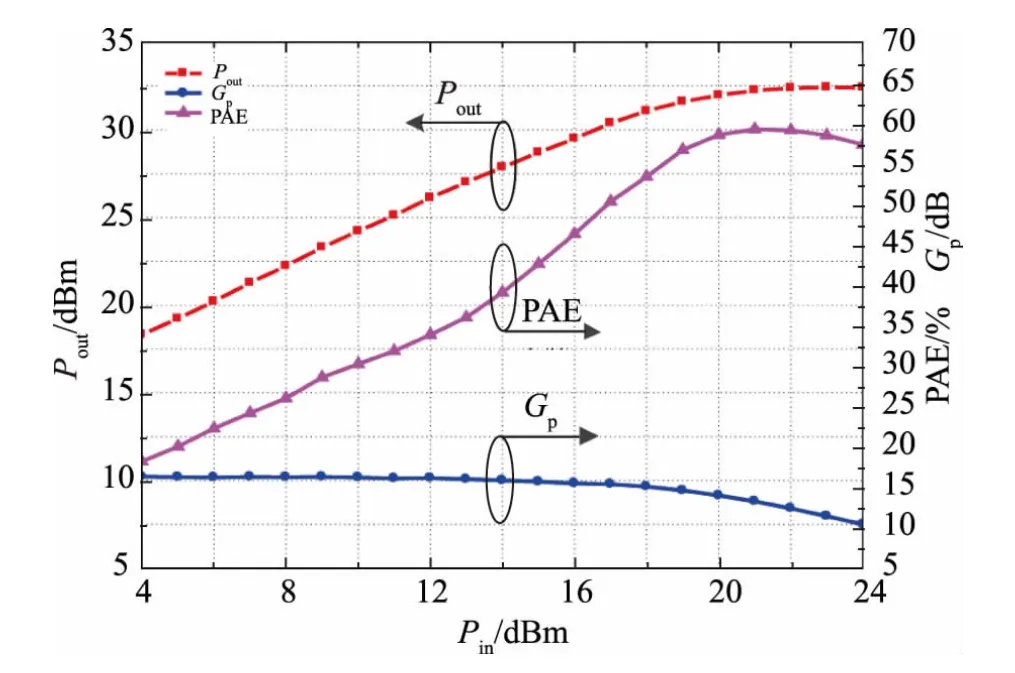
圖4 4μm×100μm管芯4.7 GHz最佳效率匹配性能曲線
匹配電路中輸入輸出第一級L-C匹配網絡中電感L采用金絲替代實現,輸入端采用直徑為25μm的金絲;輸出端功率大,因此采用耐功率能力更強的直徑為38μm的金絲保證長期工作的可靠性;輸入輸出匹配電容C采用高介電常數陶瓷板作為基底進行制作,陶瓷板介電常數為85,厚度為180μm。輸入輸出微帶阻抗變換電路則采用低介電常數陶瓷板作為基底進行制作,陶瓷板介電常數為9.9,厚度為380μm。
按照圖5所示拓撲電路進行輸入輸出阻抗匹配電路仿真設計,性能指標要求:工作頻帶4.4~5.0 GHz,小信號增益(S21)大于等于14 dB,輸入端反射系數(S11)小于等于-15 dB。仿真偏置條件設置為:漏極工作電壓為28 V,柵極工作電壓為-2.2 V。仿真方法為:先進行原理圖仿真,當性能指標達到設計要求后,再進行版圖仿真,然后將版圖仿真結果帶入原理圖進行聯合仿真,提高仿真結果準確度。

圖5 內匹配功率管拓撲電路
經過多輪迭代優化后小信號增益(S21)和輸入端反射系數(S11)仿真結果如圖6所示。從圖中可以看出4.4~5.0 GHz頻帶內小信號增益(S21)大于14.5 dB,輸入端反射系數(S11)小于-15 dB,仿真結果滿足設計要求。
電路仿真完成后進行電路制作,最終裝配鍵合完成的內匹配功率管內部結構如圖7所示,采用金屬陶瓷封裝,封裝尺寸為24.0 mm×17.4 mm;4個GaN HEMT管芯合成輸出,單管芯物理尺寸為3.4 mm×0.8 mm。管芯與匹配電路用金錫焊料(Au80%Sn20%)高溫(T=300℃)燒結在金屬陶瓷封裝內,輸入輸出端阻抗值均為50Ω。
4 測試結果
內匹配功率管小信號增益和輸入端反射系數實際測試曲線如圖8所示,測試條件設置為:漏極工作電壓為28 V,柵極工作電壓為-2.2 V,輸入功率為0 dBm。從圖中可以看出4.4~5 GHz頻帶內小信號增益(S21)大于14.5 dB,比仿真值小0.3~0.4 dB,這主要由于仿真環境是理想條件,而實際電路有損耗;輸入端反射系數(S11)小于-15 dB,與仿真結果基本一致。
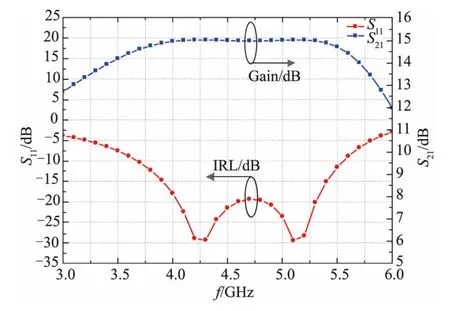
圖6 小信號增益與輸入端反射系數仿真結果
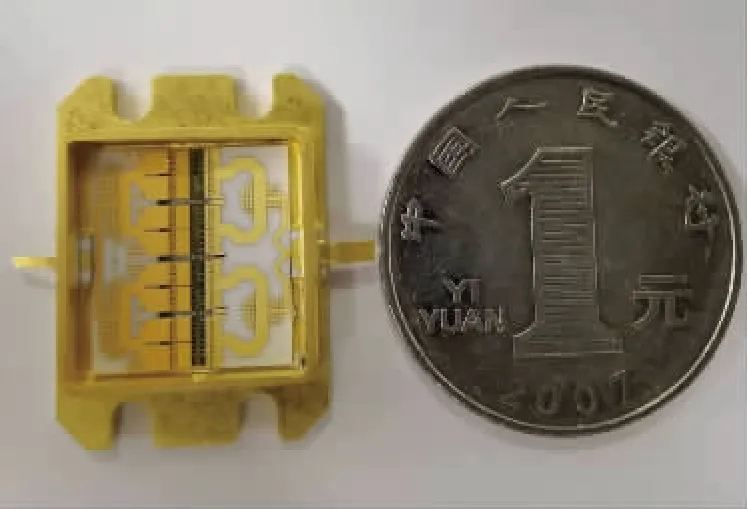
圖7 200 W連續波內匹配功率管照片
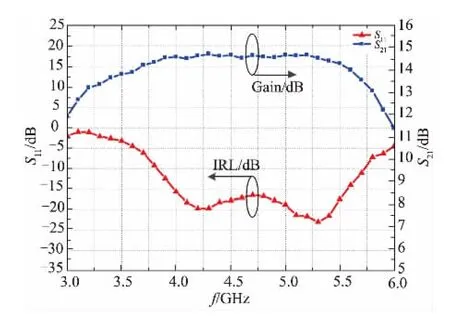
圖8 小信號增益與輸入端反射系數測試結果
25℃環境溫度條件下的功率壓縮特性如圖9所示,測試條件:漏極工作電壓28 V,柵極工作電壓-2.2 V,連續波測試。圖9所述內容為輸出功率(Pout)、Gp和PAE隨輸入功率(Pin)變化曲線,從圖中可以看出在Pin達到43 dBm時,Pout達到53.6 dBm,此時PAE為52.2%,Gp壓縮4.3 dB,符合GaN HEMT管芯增益壓縮特性。

圖9 內匹配功率管功率壓縮特性
25℃環境溫度條件下的功率特性如圖10所示,測試條件為:漏極電壓28 V,柵極電壓-2.2 V,輸入功率43 dBm,連續波測試。圖10所述內容為Pout、Gp和PAE隨頻率變化曲線,從圖中可以看出在4.4~5.0 GHz頻段內,Pout大于200 W,PAE大于51%,Gp大于10.5 dB。
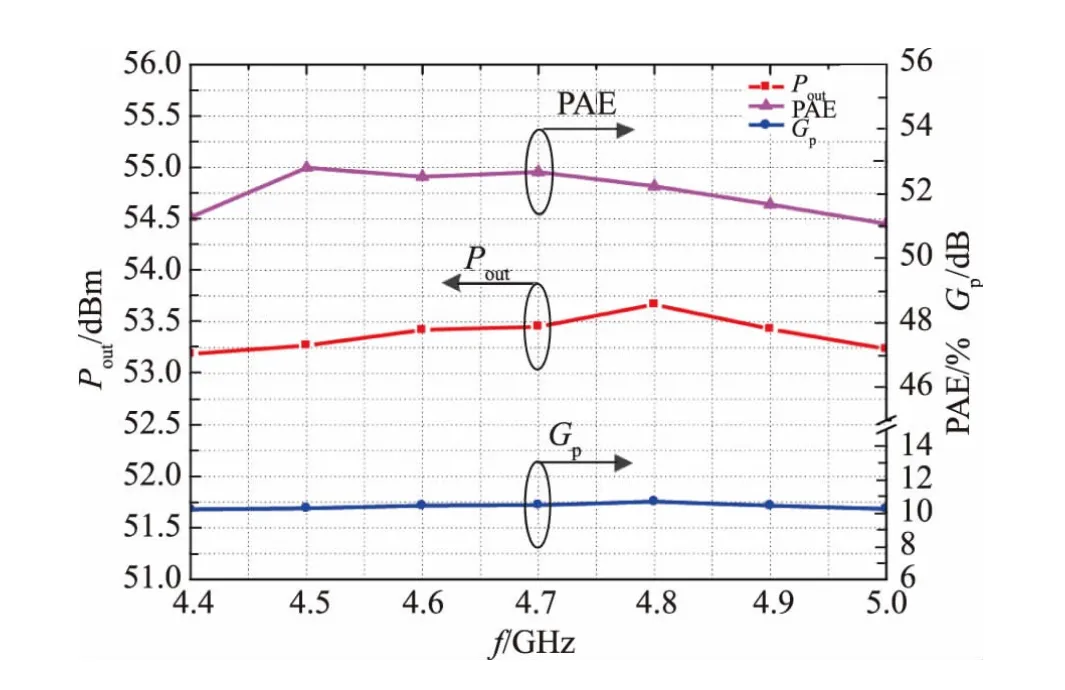
圖10 內匹配功率管功率特性
連續波輸出功率200 W內匹配功率管的熱特性對其可靠性極其重要[9]。本文對該內匹配功率管進行了紅外熱成像測試,測試條件為:漏極工作電壓VDS=28 V,柵極工作電壓VGS=-2.2 V,Pin=43 dBm,熱臺溫度設置為70℃,此時Pout=196 W,功耗Pd=390 W,管殼溫度tc=92℃,功率管芯溝道溫度tj=198℃,

計算出熱阻Rth(j-c)=0.52℃/W。
設計并實現的內匹配功率管性能指標與國內外其他廠家C波段類似產品性能指標對比情況如圖11所示。從圖中可以看出設計的內匹配功率管是C波段同類產品連續波輸出功率唯一達到200 W以上的,并且其功率附加效率最大,其性能指標處于領先水平。
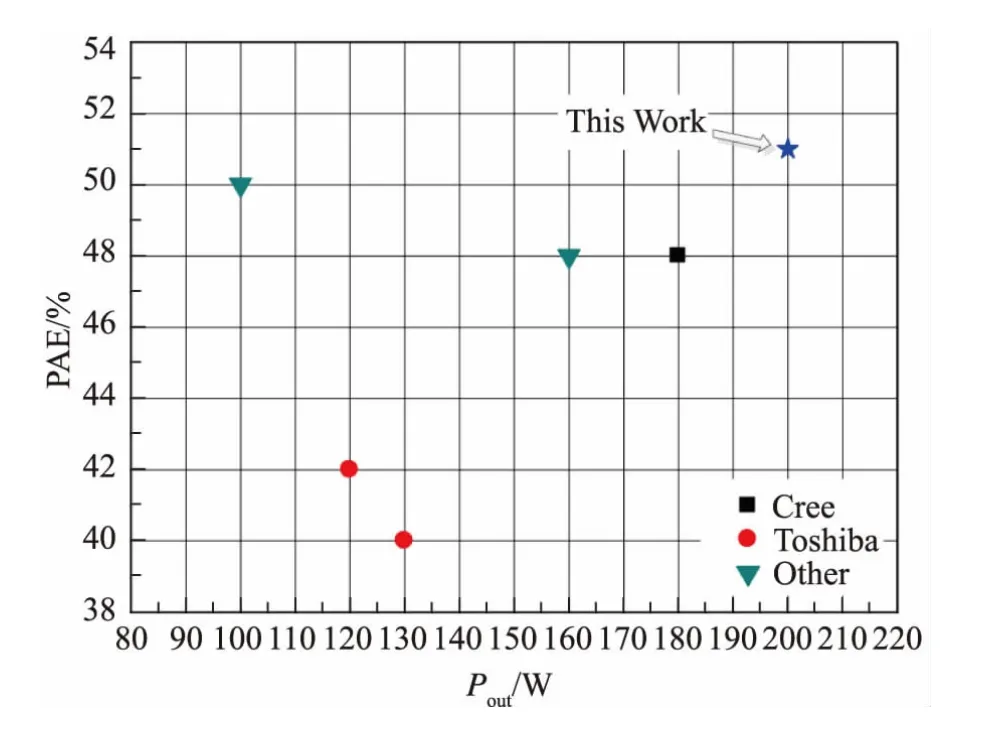
圖11 C波段連續波功率管性能對比
5 總結
本文報道了一款基于GaN HEMT工藝的C波段連續波大功率內匹配功率管的設計。該內匹配功率管采用大功率多胞合成技術,實現了在4.4~5 GHz頻帶內輸出功率大于200 W,功率附加效率最低值51%,小信號增益達到14.5 dB,功率增益10 dB以上,熱阻為0.52℃/W,性能指標達到設計預期,具有廣闊的市場應用前景。

