外接電容對脈沖激光輻照Si-APD時的溫升影響
陳 良,魏 智,王 頔,劉紅旭,金光勇
(長春理工大學 吉林省固體激光技術(shù)及其應用重點實驗室,吉林 長春 130022)
1 引 言
隨著激光技術(shù)的飛速發(fā)展,與之結(jié)合使用的光電探測器也得到了越來越廣泛的應用[1-4]。與此同時,激光與光電探測器的相互作用得到了大量地研究,其中,作為激光作用對象的光電探測器可以分為非雪崩光電探測器和雪崩光電探測器兩種。早在1974年,J.F.Giuliani和C.L.Marquardt對激光輻照光電晶體管前后的暗電流,光電流和響應度等光電性能參數(shù)進行了研究[5-6]。1991年陸啟生等研究了激光輻照InSb探測器的溫升過程及損傷機制[7]。Gautier B和Moeglin P等研究了激光輻照導致的光電探測器的物理損傷與電學性能下降之間的關(guān)系[8-10]。針對雪崩類光電探測器,1990年Steve E.Watkins等人[11]利用1064 nm Nd∶YAG激光輻照雪崩光電二極管,對實驗過程中的反向飽和電流、噪聲電流、擊穿電壓、結(jié)電容和表面形貌損傷進行了監(jiān)測。2000年,薛建國等[12]用脈沖激光實驗研究了雪崩二極管的損傷閾值與脈沖激光的重復頻率、輻照時間的關(guān)系。2018年,本人所在研究組發(fā)現(xiàn)了毫秒脈沖激光與Si-APD相互作用時,其內(nèi)部的焦耳熱起到了較大的作用[13]。
事實上,光電探測器在實際使用中往往要和電容相串聯(lián),其主要目的是隔絕直流背景分量、更好地提取脈沖信號,以便于后續(xù)電路的脈沖信號放大處理。更進一步來說,電容和電阻性元件所組成的選頻網(wǎng)絡(luò)還能夠濾除其他頻率的雜波、進而提高了脈沖信號的信噪比。另一方面,光電探測器吸收激光能量后往往導致自身的溫升而影響了探測性能。從目前的研究來看,人們并沒有考慮到外接電容對激光輻照光電探測器時溫升特性的影響。本論文首次開展了外接電容對毫秒脈沖激光輻照外接電容電路中Si-APD的溫升特性研究,獲得了外接電容對Si-APD表面溫升的影響規(guī)律,這為Si-APD在實際應用中的熱損傷防護以及外接電路中電容大小的選取提供了理論依據(jù)。
2 模型建立
當毫秒脈沖激光與反偏電壓下外接電容電路中的Si-APD相互作用時,其熱傳導方程可寫為[14-15]:
(1)
其中,T(r,z,t),ρ,c,k分別是溫度場分布、材料密度,比熱和熱導率;QL(r,z,T)是外部激光熱源;QE(r,z,T)是內(nèi)部焦耳熱源。QL(r,z,T)可進一步寫成:

(2)
其中,E是激光的單脈沖能量;rlas是位于探測器表面的激光光斑半徑;τ是激光的脈沖寬度;R(T)和α(T)分別是硅的反射系數(shù)和吸收系數(shù);g(t)是激光束的時間分布。這些參量定義為:
(3)

(4)

(5)
焦耳熱可寫成電場和電流密度的乘積,即:
QE(r,z,T,t)=E(z)JL(r,z,T,t)
(6)
E(z)是p-n結(jié)的內(nèi)部電場。電流密度由下式給出[16-17]:
JL(T,r,t)=
(7)

(8)
n型載流子和p型載流子的電場分別為:
(9)
(10)
其中,zn和zp分別是n型載流子和p型載流子的p-n結(jié)的勢壘邊界。式中,z的范圍為zn≤z≤zp。
當t=0時,材料的初始溫度是均勻的,并且環(huán)境溫度通常被認為是:
Tt=0=Ti(0)=298 K
考慮到以激光熱和焦耳熱作為熱源,對其他表面采用了絕熱邊界條件,其條件如下:
(11)
(12)
3 模型仿真
在理論模型的基礎(chǔ)上,對能量密度為15 J/cm2的1.0 ms脈沖激光輻照不同外接電容電路中Si-APD的表面溫升進行仿真模擬。除上述提及的變量外,模擬中使用的其他變量為:材料密度ρ=2330-2.19×10-2T(kg·m-3),比熱c=352.43+1.78T-2.21×10-2T2+1.3×10-6T3-2.83×10-10T4(J·kg·K-1),導熱系數(shù)k=22.23+422.52×exp(-T/255.45)(W·m-1-1),τn=10×10-6s,τp=10×10-6s,其中m0是電子質(zhì)量。由于激光強度高,且倍增區(qū)很薄,因此考慮M=1。圖1為能量密度為15 J/cm2、脈沖寬度為1.0 ms的脈沖激光輻照不同外接電容電路中Si-APD的表面溫升的仿真結(jié)果。從圖中可以看出,雖然入射激光的能量密度、


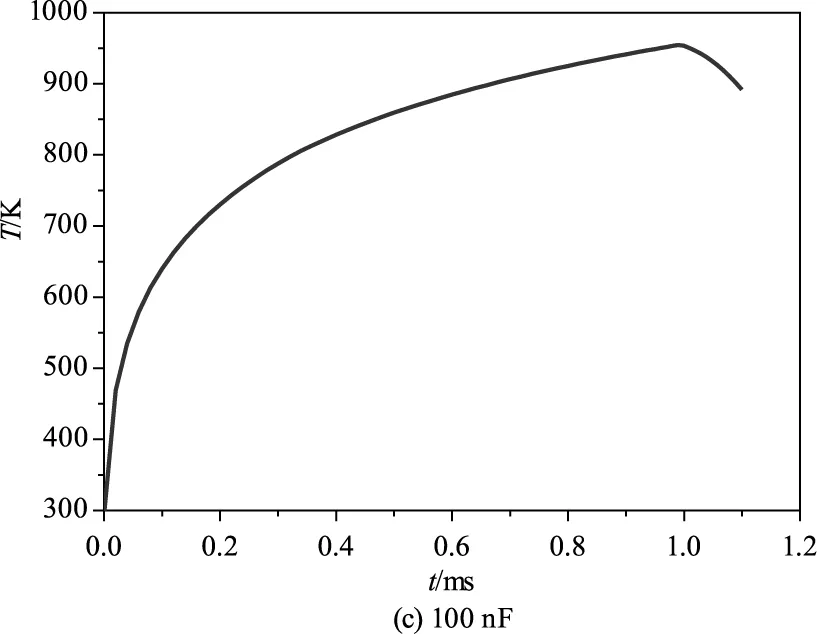

圖1 能量密度為15 J/cm2的1 ms脈沖激光輻照不同電容電路中Si-APD表面升溫過程模擬仿真結(jié)果
脈沖寬度相同,但是當無外接電容時,Si-APD的表面最高溫度為1087 K,然而當先后接入1 μF、100 nF、47 pF時,Si-APD的表面最高溫度分別為997 K、954 K、932 K,相對于無外接電容情況,表面溫度分別降低了90 K、133 K、155 K。由此可以看出,電容越小,Si-APD表面溫度的最高值越低。產(chǎn)生這一現(xiàn)象的根本原因是Si-APD表面的溫升由外部的激光和內(nèi)部的焦耳熱共同作用所產(chǎn)生的。由于外接電容的存在,對回路中的電流起到了一定的阻礙作用,電容值越小,對電流的阻礙能力越強,從而限制了Si-APD內(nèi)部焦耳熱的進一步產(chǎn)生,所以外接電容越小,Si-APD表面的溫度就越低。
4 實驗裝置
為了對毫秒脈沖激光輻照Si-APD的溫升特性進行深入研究,本論文采用Nd∶YAG毫秒脈沖激光作為輻照光源,其脈沖寬度為0.5~3 ms可調(diào)、波長為1064 nm,輸出波形為高斯型,聚焦后光斑尺寸為360 μm。采用點溫儀(KLEIBER,IMGA740)對Si-APD表面的溫升過程進行監(jiān)測,其中利用激光信號對點溫儀進行觸發(fā)。Si-APD同反偏電壓源、電容和限流電阻串聯(lián)在電路中。其中,反偏電壓和限流電阻大小分別為180 V和50 MΩ,電容分別選擇了1 μF、100 nF、1 nF、47 pF。實驗采用的Si-APD為拉通型結(jié)構(gòu),由四層不同的摻雜分布和不同厚度的薄膜組成,依次為重摻雜n區(qū)、p區(qū)、本征區(qū)和摻雜p區(qū),形成N+-P-π-P+柱狀結(jié)構(gòu)。各層的摻雜濃度依次為5×1019cm-3,5×1016cm-3,5×1012cm-3及1×1019cm-3。厚度分別為1 μm,3 μm,50 μm及250 μm。實驗裝置如圖2所示。

圖2 毫秒脈沖激光器輻照偏壓下的外接電路中的Si-APD的實驗方案
5 實驗結(jié)果
為了驗證理論模型的正確性,我們開展了不同外接電容電路條件下的激光輻照Si-APD的表面溫升實驗,結(jié)果如圖3所示。從圖3中可以看出,在相同的激光能量密度條件下,外接電容的不同對Si-APD的表面溫升產(chǎn)生了顯著的影響。電容值越小,Si-APD表面溫度的最大值越低,這與圖1中的模擬仿真結(jié)果相一致。

圖3 能量密度為15 J/cm2的1.0 ms脈沖激光輻照不同電容電路中Si-APD的表面溫升過程
另外,從圖中還可以看出,在激光的作用初期,Si-APD表面溫升迅速,這主要是由于激光和p-n結(jié)內(nèi)部焦耳熱共同作用的結(jié)果,大約在0.1 ms左右到達溫升平臺期,并且電容值越大,溫升的平臺期越高,溫升的變化也越平坦,這主要是由于:一是p-n結(jié)溫度過高,半導體失效,焦耳熱消失;另一方面,隨著溫度的升高,Si的吸收系數(shù)減小,導致Si對入射激光的吸收降低。當激光作用結(jié)束時,Si-APD的表面溫度達到最大值,隨后,在熱傳導的作用下表面溫度迅速下降。
為了更詳細地研究電容對Si-APD表面溫升的影響,將能量密度為15 J/cm2的1.0 ms脈沖激光輻照不同電容電路中Si-APD的表面最高溫度提取出來,如表1所示。

表1 能量密度為15 J/cm2的1.0 ms脈沖激光輻照不同電容電路中Si-APD的最高表面溫度
從表中可以清楚地看出,激光輻照Si-APD后,在沒有外接電容的情況下,最大表面溫度達到1080 K。然而,當外接電路與電容串聯(lián)時,在相同的激光脈沖寬度和激光能量密度下,Si-APD的最高表面溫度有所降低,并且外接不同電容器時Si-APD溫降程度不同。對于1 μF電容器,溫度降低90 K,相當于降低8.3 %;對于100 nF電容器,溫度降低120 K,相當于降低11.1 %;對于47 pF電容器,溫度降低185 K,相當于降低17.1 %。由此可見,電容值越低,Si-APD表面的最高溫度越低。理論模擬與實驗結(jié)果吻合,驗證了理論模型的正確性。
由式(1)可知,導致Si-APD表面溫度升高的主要因素有兩個:Si-APD內(nèi)部的焦耳熱和其外部的激光熱源。激光致熱與激光參數(shù)和材料有關(guān),不受外部電路的影響。當外部偏置電路中沒有外部電容時,如圖4(a)所示,在激光照射下在Si-APD中產(chǎn)生的載流子被外部電路產(chǎn)生的電場迅速掃走,在Si-APD中產(chǎn)生大的瞬時電流。這導致焦耳加熱增加。因此,在沒有外部電容的情況下,激光輻照Si-APD的表面最高溫度最高。當外部電路連接到如圖4(b)所示的大電容時,隨著電容的連續(xù)充電,積累更多的電荷。這會降低電路中的電流,最終對電流產(chǎn)生阻斷效應,Si-APD中產(chǎn)生的焦耳熱也隨之降低。



圖4 毫秒脈沖激光輻照APD時不同電容值對外接電容電路電流的影響
因此,Si-APD的表面溫度降低。由于焦耳熱的降低,Si-APD的表面溫度低于沒有外接電容的表面溫度。如圖4(c)所示,當外部電容值小時,其電荷存儲容量減小,且更容易充電。這樣,阻止電荷運動的能力導致在Si-APD的高場強區(qū)產(chǎn)生大電流的能力降低;在Si-APD中不再產(chǎn)生焦耳熱,焦耳熱的作用時間最短。因此,當外接電路連接到最小的電容時,Si-APD的表面溫度最低[18]。
6 結(jié) 論
本文建立了毫秒脈沖激光輻照Si-APD外接電容電路的理論模型,并對不同外接電容電路輻照Si-APD的表面溫升進行了模擬仿真和實驗研究。研究結(jié)果表明,外接電容對Si-APD的表面溫升具有顯著的影響。在能量密度為15 J/cm2的1.0 ms脈沖激光作用下,無外接電容時的Si-APD表面最高溫度為1080 K。然而,當連接1 μF、100 nF和47 pF電容時,Si-APD表面溫度分別下降到990 K、960 K和895 K。Si-APD的最高表面溫度隨著電容值的降低而降低。產(chǎn)生這種現(xiàn)象的主要原因是外接電容對回路中電流有一定的阻礙效應:外接電容越小,其對電流的阻斷能力越強,導致回路中電流越小,Si-APD內(nèi)部產(chǎn)生的焦耳熱量越少。理論模擬與實驗結(jié)果吻合,驗證了理論模型的正確性。研究結(jié)果可為Si-APD在實際應用中的熱損傷防護以及外接電路中電容大小的選取提供了理論依據(jù)。

