GaN HEMT 電力電子器件技術(shù)研究進(jìn)展*
鮑 婕,周德金,陳珍海,寧仁霞,吳偉東,黃 偉
(1.黃山學(xué)院智能微系統(tǒng)安徽省工程技術(shù)研究中心,安徽黃山 245041;
2.多倫多大學(xué)電氣與計(jì)算機(jī)工程學(xué)院,加拿大多倫多 M5S3G4;
3.復(fù)旦大學(xué)微電子學(xué)院,上海 200443;
4.清華大學(xué)無(wú)錫應(yīng)用技術(shù)研究院,江蘇無(wú)錫 214072)
1 引言
GaN 高電子遷移率晶體管(HEMT) 由于AlGaN/GaN 界面生長(zhǎng)的異質(zhì)結(jié),具有擊穿電壓高、熱穩(wěn)定性好、平均電子漂移速度高、寬且可調(diào)的帶隙等優(yōu)勢(shì),比傳統(tǒng)的硅功率器件更適合大功率以及高速電子產(chǎn)品[1-2]。擊穿場(chǎng)強(qiáng)高以及高遷移率都利于器件中制作較薄的漂移區(qū),獲得較低的導(dǎo)通電阻,較小的芯片尺寸就能實(shí)現(xiàn)需要的電流能力,從而降低輸入和輸出電容,而高飽和速度和低電容都能加快瞬時(shí)狀態(tài)變化。GaN 器件在高達(dá)650 V 額定電壓等級(jí)的高效、高頻轉(zhuǎn)換器等應(yīng)用中成為了研究熱點(diǎn)[3-4]。除了高頻應(yīng)用優(yōu)勢(shì)以外,GaN HEMT 在空調(diào)、冰箱、牽引逆變器以及儲(chǔ)能系統(tǒng)等開(kāi)關(guān)頻率不足50 kHz 的應(yīng)用場(chǎng)合,相比硅器件也具有開(kāi)關(guān)損耗與傳導(dǎo)損耗都有效改善的性能優(yōu)勢(shì)[5]。
目前國(guó)內(nèi)外已有多家公司對(duì)GaN HEMT 器件進(jìn)行研究,以加拿大的GaN Systems 公司和美國(guó)的Transphorm 公司為主。前者推出了高壓?jiǎn)喂茉鰪?qiáng)型GaN HEMT,后者推出了高壓級(jí)聯(lián)增強(qiáng)型GaN HEMT。美國(guó)宜普(EPC) 公司主要生產(chǎn)低壓增強(qiáng)型GaN HEMT,技術(shù)較為成熟。此外,還有納微(Navitas)和羅姆(ROHM) 株式會(huì)社等公司,均積極開(kāi)展GaN HEMT 功率半導(dǎo)體業(yè)務(wù),并獲得廣泛應(yīng)用[6-8]。在國(guó)內(nèi),富士通公司在2013 年與Transphorm 公司合作,也推出了自己的級(jí)聯(lián)型GaN HEMT;蘇州能訊半導(dǎo)體當(dāng)前已經(jīng)研制出600 V/17 A 的級(jí)聯(lián)型GaN 器件。
2017 年,Transphorm 公司推出全球第一款同時(shí)通過(guò)JEDEC 和AEC-Q101 認(rèn)證的GaN 場(chǎng)效應(yīng)晶體管(650 V、49 mΩ)。2018 年EPC 的GaN 功率器件產(chǎn)品(80 V、脈沖電流75 A、16 mΩ) 首次獲得汽車AEC-Q101 認(rèn)證。該產(chǎn)品的體積遠(yuǎn)小于傳統(tǒng)的Si MOSFET,且開(kāi)關(guān)速度是后者的10~100 倍,產(chǎn)品主要用于激光雷達(dá)、高強(qiáng)度汽車前燈、48~12 V DC-DC 變換器、超高保真信息娛樂(lè)系統(tǒng)等汽車應(yīng)用領(lǐng)域。
為了在應(yīng)用中充分發(fā)揮GaN HEMT 器件的優(yōu)勢(shì),與其關(guān)鍵參數(shù)如導(dǎo)通電阻、擊穿電壓、閾值電壓等密切相關(guān)的器件工藝結(jié)構(gòu)和材料特性,就需要從仿真和實(shí)驗(yàn)多角度進(jìn)行詳細(xì)研究。本文首先介紹了GaN HEMT 的器件類型,然后將器件工藝結(jié)構(gòu)和材料對(duì)GaN HEMT 特性影響的研究現(xiàn)狀進(jìn)行了綜述,最后概括總結(jié)了GaN HEMT 器件的技術(shù)發(fā)展趨勢(shì)和最新參數(shù)指標(biāo)。
2 GaN HEMT 電力電子器件類型
2.1 耗盡型GaN HEMT
GaN HEMT 中AlGaN 和GaN 兩層材料的界面由于晶體極性,形成了一層叫做“二維電子氣(2DEG)”的高遷移率電子,在器件的源極和漏極之間形成了天然的溝道,如圖1(a)[4]所示,使GaN HEMT 具有了固有的常開(kāi)屬性,即耗盡型(D 型)器件。
常開(kāi)特性是GaN HEMT 應(yīng)用的主要障礙,因?yàn)樵诠β兽D(zhuǎn)換器中當(dāng)柵驅(qū)動(dòng)輸出零電壓時(shí),開(kāi)關(guān)要保持在常關(guān)狀態(tài),而GaN HEMT 的負(fù)關(guān)斷柵壓對(duì)柵驅(qū)動(dòng)電路的復(fù)雜度要求較高,也增加了電路失效的風(fēng)險(xiǎn)。因此,通常將D 型GaN HEMT 與硅基低壓E 型MOSFET封裝在一起,組成級(jí)聯(lián)共源共柵器件,電路結(jié)構(gòu)如圖1(b)[9]所示。MOSFET 的漏源電壓決定了HEMT 的柵源電壓,構(gòu)成常關(guān)器件,其驅(qū)動(dòng)電路采用傳統(tǒng)硅基器件的驅(qū)動(dòng)即可。

圖1 耗盡型GaN HEMT
2.2 增強(qiáng)型GaN HEMT
改變GaN HEMT 柵極的工藝結(jié)構(gòu)來(lái)轉(zhuǎn)換閾值電壓極性可以制作出增強(qiáng)型(E 型)GaN HEMT 器件。JONES 等[4]綜述了目前報(bào)道的幾種典型的E 型GaN HEMT 工藝結(jié)構(gòu),包括P 摻雜GaN(或AlGaN)柵、等離子處理的金屬-絕緣體-半導(dǎo)體(MIS)結(jié)構(gòu)、柵極嵌入式以及它們的改進(jìn)結(jié)構(gòu)等,如圖2 所示。
工藝結(jié)構(gòu)改變的宗旨是在無(wú)加載電壓的情況下將柵極下方的2DEG 耗盡,才能使得正向閾值電壓增強(qiáng)2DEG 而形成溝道。圖2(a)中的P 摻雜GaN 柵是在柵極構(gòu)造類似二極管特性的結(jié)構(gòu),通過(guò)二極管壓降抬高閾值電壓;圖2(b)是在柵極下方通過(guò)等離子處理技術(shù)注入氟離子,有效耗盡2DEG;圖2(c)通過(guò)精確刻蝕掉柵極下方一定深度的AlGaN 構(gòu)造出柵極嵌入式結(jié)構(gòu),可以和MIS 結(jié)構(gòu)等其他工藝共同作用,進(jìn)一步提升閾值電壓。
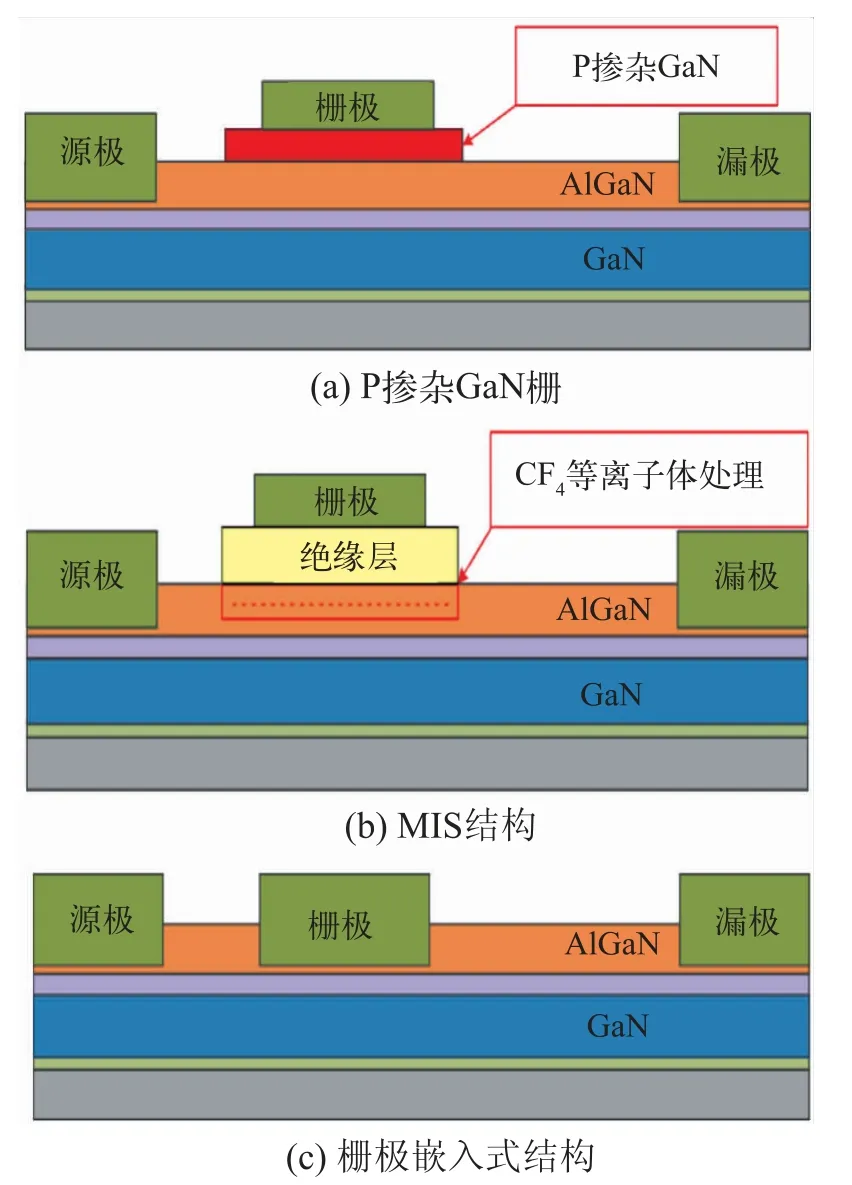
圖2 增強(qiáng)型GaN HEMT
3 GaN HEMT 器件關(guān)鍵技術(shù)
3.1 器件工藝結(jié)構(gòu)
3.1.1 P-GaN 柵HEMT
P-GaN 柵是一種典型的構(gòu)造E 型GaN HEMT 的方案[10-13],在AlGaN 層上面生長(zhǎng)例如Mg 摻雜的P 型GaN 或AlGaN 層。這種結(jié)構(gòu)最大的優(yōu)勢(shì)就是可以通過(guò)金屬/p-GaN 之間的高肖特基勢(shì)壘高度而減小柵極泄漏電流,提供較高的正向閾值電壓VTH[14-15]。P 型材料的有效濃度、厚度以及勢(shì)壘層的結(jié)構(gòu)都對(duì)E 型HEMT 的構(gòu)造有直接的影響[16-17]。LI 等[18]還通過(guò)仿真發(fā)現(xiàn),P-GaN 柵的長(zhǎng)度對(duì)器件的閾值電壓改善不大,同時(shí)卻對(duì)電流能力有著負(fù)面影響,P-GaN 柵越長(zhǎng),溝道區(qū)域就越長(zhǎng),通態(tài)下器件電流會(huì)下降,而擊穿電壓隨之先增大再趨于飽和。
很多報(bào)道都認(rèn)為P-GaN 柵HEMT 在柵極正向偏壓應(yīng)力下和關(guān)斷應(yīng)力下閾值電壓不穩(wěn)定[19],其原因是P-GaN 區(qū)域空穴的積聚或耗盡影響[20],以及AlGaN 區(qū)域的電子俘獲作用[21]。MURUKESAN 等[22]提出在測(cè)量閾值電壓過(guò)程中柵極偏壓的加載方式對(duì)Vth數(shù)值具有直接影響,要對(duì)P-GaN 柵HEMT 的閾值電壓給出標(biāo)準(zhǔn)化定義還有待深入研究。SHI 等[23]通過(guò)研究電子空穴陷落和脫陷的潛在物理機(jī)制,在長(zhǎng)時(shí)間柵偏應(yīng)力下觀察到P-GaN 柵HEMT 具有柵極退化性能自恢復(fù)的能力。
3.1.2 MIS/MOS-HEMT
由于GaN HEMT 器件柵極和緩沖區(qū)泄漏電流是限制其性能和可靠性的主要因素,因此一般在柵金屬和溝道之間會(huì)制作肖特基接觸,柵極電壓就可以控制溝道電勢(shì),不需要做氧化層,只需要兩步光刻工藝,性價(jià)比高。但最大的缺點(diǎn)是肖特基接觸的開(kāi)啟電壓很低,因此閾值電壓就需要更低,這在高壓應(yīng)用中很不利[24-25]。而在柵極和溝道之間使用一層絕緣氧化層,構(gòu)成MIS-HEMT 或氧化物-半導(dǎo)體(MOS)HEMT 結(jié)構(gòu),雖然減小了電子遷移率,但柵極泄漏電流可以減小6~10 個(gè)數(shù)量級(jí)[26-27]。SiO2和Al2O3由于寬帶隙和高化學(xué)穩(wěn)定性等良好的介電性能,通常被選作絕緣柵材料應(yīng)用[28]。
MUKHERJEE 等[2]通過(guò)仿真對(duì)比研究了雙柵MOS-HEMT 和肖特基HEMT 的輸出特性,前者雖然跨導(dǎo)和瞬態(tài)變化速度不如后者,但其驅(qū)動(dòng)電流能力、低閾值電壓、電流開(kāi)關(guān)比以及固有最大增益都更勝一籌。研究者們[24,29]以Al2O3作為介質(zhì)層制作的MOSHEMT,對(duì)比傳統(tǒng)HEMT 結(jié)構(gòu)具有更為優(yōu)異的直流和射頻性能,更適合大功率高頻應(yīng)用。WANG[25]等為了解決MIS-HEMT 中2DEG 載流子遷移率變小的問(wèn)題,采用AlGaN 部分凹進(jìn),即柵極嵌入式結(jié)構(gòu),再輔以多層Al2O3柵介質(zhì)的氟化處理,使氟離子分布在2DEG 溝道足夠的距離之外,同時(shí)精確控制其數(shù)量,實(shí)現(xiàn)在柵極閾值電壓VTH提高至+6.5 V 的同時(shí),漏極飽和電流保持在340 mA,以及較低的柵極泄漏電流和高擊穿電壓。
3.1.3 場(chǎng)板結(jié)構(gòu)及尺寸的影響
使用源極和柵極場(chǎng)板能夠使柵漏之間的電場(chǎng)重新分布,不再集中在柵極邊緣處,減輕電流崩塌效應(yīng),提高擊穿電壓[30-31]。GODFREY 等[31]仿真分析得到隨著源極場(chǎng)板的長(zhǎng)度增加,GaN HEMT 的擊穿電壓隨之增大,然后趨于飽和。當(dāng)柵偏壓過(guò)高時(shí),柵擊穿,柵極泄漏電流突然增大,會(huì)導(dǎo)致器件失效,因此關(guān)斷狀態(tài)下的封阻能力對(duì)HEMT 很重要。JIANG 等[32]提出了帶有柵極場(chǎng)板的T 形柵結(jié)構(gòu),相比于傳統(tǒng)的P-GaN 柵HEMT,減小了金屬/P-GaN 的接觸面積,在高柵壓情況下保護(hù)P-GaN/AlGaN/GaN 形成的P-i-N 二極管不被破壞,從而保證了反向阻斷能力,電場(chǎng)分布的仿真結(jié)果如圖3 所示。LEI 等[33]提出了一種雙嵌入式門(mén)控肖特基漏極的MIS-HEMT,如圖4 所示,嵌入的金屬-2DEG 肖特基接觸帶來(lái)了低導(dǎo)通電壓,MIS 場(chǎng)板起到了將肖特基結(jié)與高電場(chǎng)屏蔽的作用,從而使反向關(guān)斷狀態(tài)時(shí)泄漏電流小,同時(shí)導(dǎo)通電阻很低。
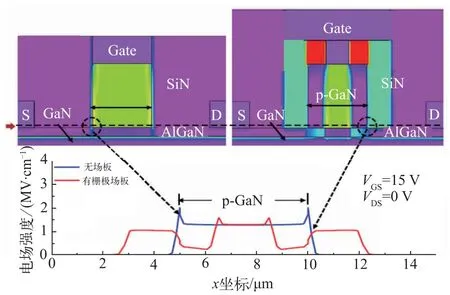
圖3 T 形柵場(chǎng)板結(jié)構(gòu)與傳統(tǒng)結(jié)構(gòu)的電場(chǎng)分布對(duì)比[32]
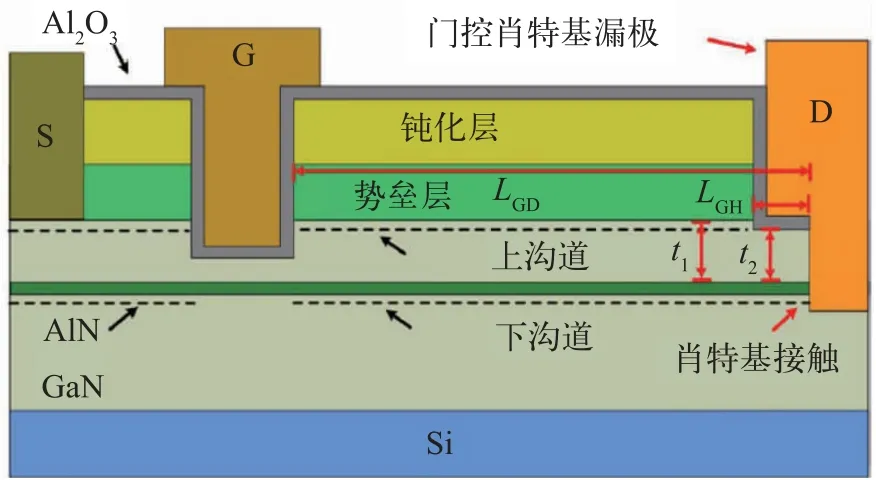
圖4 雙嵌入式門(mén)控肖特基漏極結(jié)構(gòu)的MIS-HEMT[33]
除了場(chǎng)板結(jié)構(gòu)以外,各極尺寸和間距、柵極嵌入深度等[34]也對(duì)器件性能有直接的影響。VERMA 等[35]仿真得到隨著柵漏極間距的增大,2DEG 濃度先增加再減少,GaN HEMT 器件性能隨之先提升再下降。NG等[36]在獨(dú)立GaN 襯底上制作HEMT 樣品,測(cè)試發(fā)現(xiàn)隨著柵漏距離的增大,擊穿電壓隨之增大,到臨界值后趨于飽和。OZAWA 等[37]在柵極和漏極之間制作了單獨(dú)的P-GaN 層。實(shí)驗(yàn)發(fā)現(xiàn)該結(jié)構(gòu)顯著抑制了電流崩塌現(xiàn)象,P-GaN 的位置越靠近柵極改善作用越明顯,因?yàn)镻-GaN 層注入的空穴有效中和了柵極邊緣附近的捕獲電子。然而柵漏距離增大雖能提高擊穿電壓,但同時(shí)會(huì)增大導(dǎo)通電阻;柵極過(guò)長(zhǎng)會(huì)增大柵極泄漏電流,過(guò)短會(huì)加重自熱效應(yīng)[38],導(dǎo)致器件可靠性退化;場(chǎng)板懸垂長(zhǎng)度雖然能提高擊穿電壓,但過(guò)長(zhǎng)也會(huì)引起額外的電流泄漏[39]。因此上述結(jié)構(gòu)尺寸都需要根據(jù)實(shí)際器件結(jié)構(gòu)做出平衡各方面性能的優(yōu)化選擇。
3.2 器件材料特性影響
GaN HEMT 是在襯底上外延生長(zhǎng)的多層薄膜,自下而上通常包括成核層、過(guò)渡層、緩沖層、溝道層、勢(shì)壘層、蓋帽層以及鈍化層[40]。成核層如AlGaN 或AlN 用來(lái)阻止襯底材料向GaN 外延層擴(kuò)散;過(guò)渡層可能包含分級(jí)AlGaN、AlN/GaN 超晶格或者多層AlN,用來(lái)平衡GaN 和襯底之間的應(yīng)力;勢(shì)壘層AlGaN 中Al 成分的比例越高,異質(zhì)結(jié)處的2DEG 濃度升高,器件的閾值電壓會(huì)隨之下降,電流容量會(huì)增大,隨著Al 比例繼續(xù)提高,異質(zhì)結(jié)晶格失配程度更高,導(dǎo)致電子遷移率下降帶來(lái)電流容量的減小[18]。除了上述基本結(jié)構(gòu)以外,GEDDAM 等[41]還分析了溝道與勢(shì)壘層之間引入AlGaN 隔離層對(duì)HEMT 器件性能的影響,除了室溫下增強(qiáng)型器件特性更好以外,其他特性都不如沒(méi)有隔離層的p-GaN HEMT 結(jié)構(gòu),后者更適合高溫大功率應(yīng)用。其他各層材料特性對(duì)器件性能的研究現(xiàn)狀具體分析如下。
3.2.1 鈍化層
由于活性表面區(qū)域缺陷移位造成的表面態(tài)會(huì)影響電子俘獲,而使器件的電流特性退化。在GaN HEMT 的柵源和柵漏之間都需要覆蓋有表面鈍化層,如SiN、SiO2、Si3N4、Al2O3、AlN 和HfO2等。KOEHLER等[42]在通常等離子體增強(qiáng)化學(xué)氣相沉積(PECVD)的SiN 鈍化層下面引入了10 nm 原位SiN 層,保護(hù)AlGaN 勢(shì)壘層表面在PECVD 過(guò)程中不會(huì)受到等離子體的破壞,從而大幅降低了動(dòng)態(tài)導(dǎo)通電阻的增長(zhǎng)。
高介電常數(shù)鈍化層可以提高擊穿電壓、漏極電流和跨導(dǎo)[28,43-44]。MADAN 等[44]仿真分析了不同介質(zhì)材料作為鈍化層對(duì)器件特性的影響,HfO2/Si3N4的堆疊復(fù)合一方面由于HfO2的高介電常數(shù)和熱穩(wěn)定性帶來(lái)很好的電性能,另一方面Si3N4與GaN 的界面相容性更好,用作表面鈍化層能夠獲得大電流和高擊穿電壓。如圖5 所示,高介電常數(shù)表面鈍化層更利于疏緩漏極附近的高電場(chǎng)而抑制電子俘獲,再加上較低的界面缺陷密度,HfO2/Si3N4的堆疊復(fù)合鈍化層得到最高的擊穿電壓。

圖5 不同鈍化層材料的HEMT 擊穿電壓對(duì)比[44]
3.2.2 蓋帽層
GaN HEMT 由于靠近漏極一側(cè)的柵極邊緣電場(chǎng)集中,限制了擊穿電壓,增大了導(dǎo)通電阻。除了采用表面鈍化層和場(chǎng)板技術(shù)可以改進(jìn)器件的表面電場(chǎng)分布外,使用較厚的蓋帽層也是增強(qiáng)擊穿電壓、抑制電流崩塌的可行辦法。HAO 等[45]在常關(guān)AlGaN/GaN HEMT 中通過(guò)自對(duì)準(zhǔn)氫等離子體處理技術(shù),在器件柵漏和柵源之間制作高阻GaN 蓋帽層,如圖6 所示,得到高達(dá)1020 V 的擊穿電壓,且動(dòng)態(tài)導(dǎo)通電阻僅為靜態(tài)時(shí)的2.4 倍,有效抑制了電流崩塌效應(yīng)。LIU 等[46]采用氧等離子體處理技術(shù)制作高阻GaN 蓋帽層,實(shí)現(xiàn)了漏極泄漏電流低至4.4×10-7mA。YOSHIDA 等[47]通過(guò)實(shí)驗(yàn)驗(yàn)證了GaN 蓋帽層厚度增加,動(dòng)態(tài)導(dǎo)通電阻隨之下降,而鈍化層制作之前使用氧氣等離子預(yù)處理也可以得到電流崩塌效應(yīng)的改善。
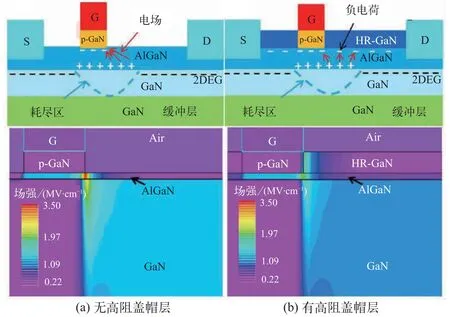
圖6 有無(wú)高阻蓋帽層的HEMT 結(jié)構(gòu)示意圖和電場(chǎng)分布圖對(duì)比[45]
3.2.3 緩沖層
在GaN HEMT 結(jié)構(gòu)中,需要沉積緩沖層用來(lái)消除襯底與GaN 之間的應(yīng)力,通過(guò)碳摻雜或鐵摻雜獲得的高阻GaN 緩沖層對(duì)于獲得優(yōu)異的器件性能起到關(guān)鍵的作用。摻雜元素能夠增加電阻率、減小緩沖區(qū)泄漏電流,增強(qiáng)擊穿電壓。DHARMARASU 等[48]通過(guò)調(diào)整GaN 緩沖區(qū)生長(zhǎng)參數(shù),得到高達(dá)3×1018cm-3的碳摻雜濃度。在對(duì)2DEG 性能、表面形態(tài)和晶體質(zhì)量沒(méi)有產(chǎn)生大影響的基礎(chǔ)上,有效減小了緩沖區(qū)泄漏電流,增大了關(guān)斷時(shí)的擊穿電壓。
LEE 等[49]采用周期重復(fù)的碳摻雜(PCD)GaN 緩沖層結(jié)構(gòu),即6 nm 厚碳摻雜GaN 和12 nm 厚非故意摻雜GaN 組成的結(jié)構(gòu)周期重復(fù),組成總厚度為2 μm 的緩沖層,有效抑制了不良陷阱效應(yīng),從而改善電流崩塌現(xiàn)象。為了進(jìn)一步提升器件的動(dòng)態(tài)特性,LEE 等在此基礎(chǔ)上又在GaN 溝道和緩沖層之間引入了AlGaN背勢(shì)壘層,如圖7 所示,該結(jié)構(gòu)將泄漏電流降低了2 個(gè)數(shù)量級(jí),得到高達(dá)2 kV 的擊穿電壓。HAMZA 等[50]也報(bào)道了背勢(shì)壘層可以減小HEMT 器件的泄漏電流,同時(shí)閾值電壓向正向移動(dòng)了1 V。
3.2.4 襯底材料
以SiC 為襯底材料,由于低寄生電容、較少的表面和界面陷阱效應(yīng)等,相比其他材料上制作的GaN HEMT 開(kāi)關(guān)速度、擊穿電壓以及直流特性等都更為優(yōu)越,但制作成本一直是制約其發(fā)展的重要因素。PANDIT 等[51]仿真分析了SiC 襯底上的GaN HEMT,溝道具有很高的電子遷移率,從而得到非常低的導(dǎo)通電阻。
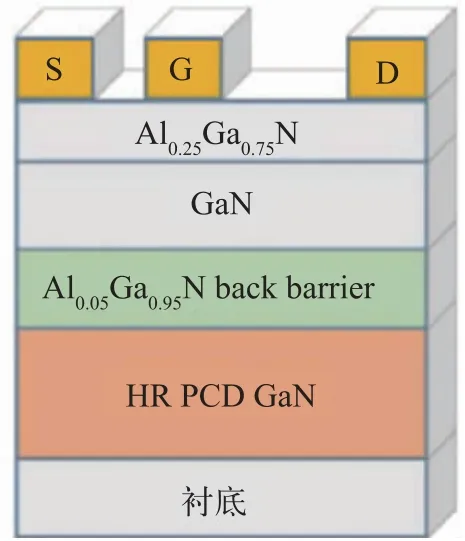
圖7 PCD GaN 緩沖層及AlGaN 背勢(shì)壘層結(jié)構(gòu)示意圖[49]
ANDERSON 等[52]使用金屬-氧化物化學(xué)氣相沉積方法在SiC、氫化物汽相外延(HVPE)GaN 以及氨熱法GaN 襯底上生長(zhǎng)GaN HEMT,實(shí)現(xiàn)了擴(kuò)展缺陷密度超過(guò)5 個(gè)數(shù)量級(jí)的改變,增加了2DEG 遷移率,但抑制了歐姆接觸的形成而使接觸電阻增大。氨熱法GaN 襯底上的HEMT 泄漏電流變大,而HVPE GaN襯底上的HEMT 由于緩沖區(qū)陷阱減少,器件的電流崩塌效應(yīng)得到明顯改善。KUMAZAKI 等[53]也在半絕緣鐵摻雜的獨(dú)立GaN 襯底上通過(guò)HVPE 制作了GaN HEMT,由于結(jié)晶質(zhì)量的改善,同樣發(fā)現(xiàn)缺陷帶來(lái)的電流崩塌現(xiàn)象大幅減少。
硅上GaN 技術(shù)被公認(rèn)為功率電子發(fā)展的重要突破[40],而大尺寸硅襯底上制作高壓GaN 器件,與硅CMOS 工藝兼容還是有很多挑戰(zhàn)的[54-55]。首先高壓器件需要較厚的緩沖疊層,晶圓翹曲要控制在限度內(nèi)以滿足擊穿電壓需求,其次就是晶圓的機(jī)械強(qiáng)度要能承受工藝損傷,以及器件封裝時(shí)背部減薄和金屬化的實(shí)施等。LIU 等[56]將硅上GaN HEMT 轉(zhuǎn)移到SiO2/Si 襯底上,打破了外延層厚度的限制,只有3.2 μm GaN 外延層的情況下,得到高達(dá)2200 V 的擊穿電壓,如圖8(a)所示。缺點(diǎn)是SiO2的熱導(dǎo)率較差,相比原來(lái)的硅上GaN 器件熱阻明顯增大,如果將SiO2替換為AlN 將帶來(lái)極大改善,如圖8(b)所示。
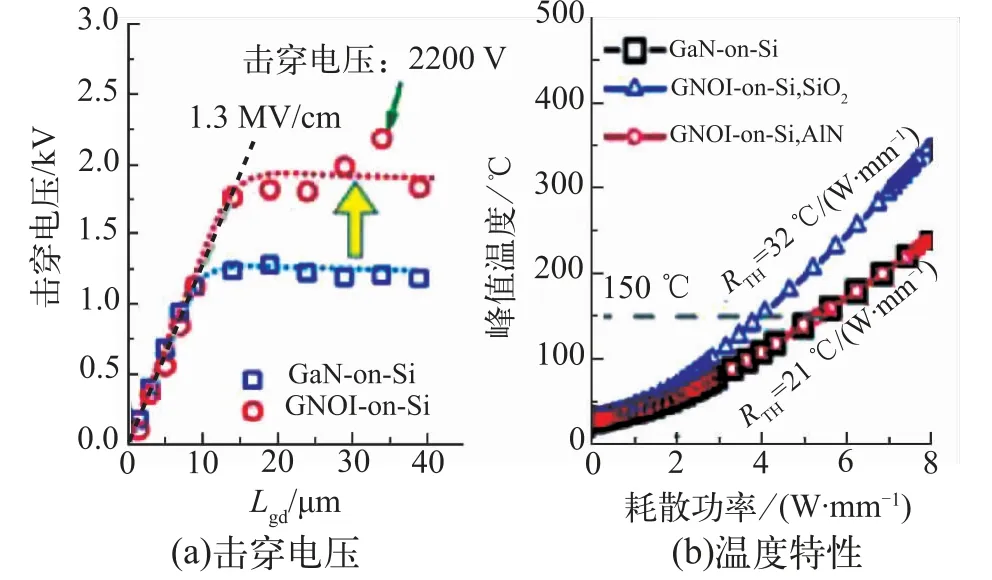
圖8 GNOI-on-Si HEMT 與GaN-on-Si HEMT 的性能對(duì)比[56]
除了上述器件結(jié)構(gòu)和材料以外,電荷俘獲現(xiàn)象對(duì)GaN HEMT 器件性能的影響也不容忽視。器件在關(guān)斷狀態(tài)時(shí),表面鈍化層和界面中的雜質(zhì)會(huì)在電場(chǎng)集中的近漏側(cè)柵極邊緣捕獲電荷,當(dāng)器件再次導(dǎo)通,這些電荷作為虛擬柵極會(huì)削弱2DEG[4,57],這個(gè)問(wèn)題可以通過(guò)優(yōu)化表面處理以及使用合適的鈍化層徹底解決;MIS-HEMT 中柵絕緣層中的電子俘獲會(huì)帶來(lái)閾值電壓位移,從而造成器件電學(xué)性能的不穩(wěn)定[58];另外,器件在高溫下工作時(shí),熱電子會(huì)注入到深度陷阱中,尤其是緩沖層摻雜帶來(lái)的陷阱,這些捕獲電荷也會(huì)削弱2DEG,增大導(dǎo)通電阻,可能造成器件的長(zhǎng)期退化[59-61]。通過(guò)優(yōu)化外延結(jié)構(gòu)、減小垂直泄漏電流比例,可以顯著降低陷阱效應(yīng)帶來(lái)的動(dòng)態(tài)電阻增加。
4 GaN HEMT 器件最新研究進(jìn)展
為了對(duì)比目前GaN HEMT 器件的技術(shù)發(fā)展和參數(shù)指標(biāo),將相關(guān)文獻(xiàn)中的最新研究現(xiàn)狀概括如表1 所示(“—”代表對(duì)應(yīng)參數(shù)文獻(xiàn)中未提及)。LEE 等[49]采用周期重復(fù)的碳摻雜GaN 緩沖層結(jié)構(gòu)以及AlGaN 背勢(shì)壘層,得到的D 型HEMT 泄漏電流低至2×10-3μA;LIU 等[56]以200 mm SiO2/Si 為襯底制作的D 型HEMT,擊穿電壓高達(dá)2200 V。
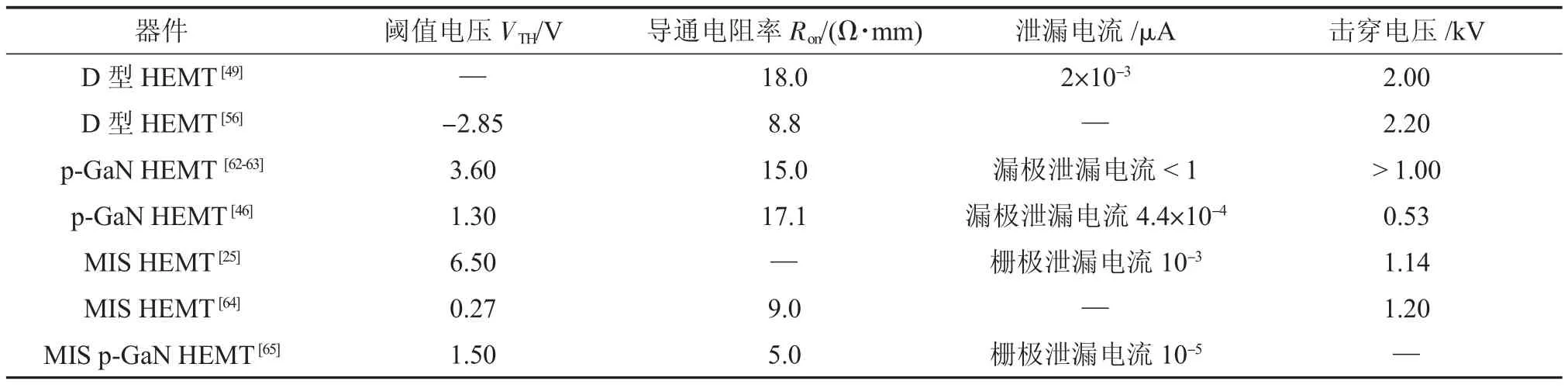
表1 GaN HEMT 器件最新參數(shù)指標(biāo)對(duì)比
GREENS 等[62]在200 mm 多晶AlN 陶瓷芯和單晶硅組成的特制基板上成功制作出650 V p-GaN 柵HEMT,VTH高達(dá)3.6 V,Ron低至15 Ω·mm,關(guān)斷狀態(tài)下150 ℃擊穿電壓高達(dá)650 V 時(shí),漏極泄漏電流只有1 μA。這種CMOS 工藝兼容的技術(shù)非常適合600 V 以上的電機(jī)驅(qū)動(dòng)等應(yīng)用,因?yàn)榫A尺寸和緩沖區(qū)厚度都能得以滿足;POSTHUMA 等[63]在200 mm P+硅襯底上制作了性能與參考文獻(xiàn)[62] 類似的650 V P-GaN 柵HEMT,VTH略低,為2.8 V。
LIU 等[46]制作的含高阻GaN 蓋帽層的p-GaN 柵HEMT 漏極泄漏電流很低;WANG 等[25]采用多層氟化柵堆疊制作的MIS-HEMT 得到高達(dá)6.5 V 的閾值電壓;考慮到大尺寸晶圓工藝一致性帶來(lái)的良率問(wèn)題,HUANG 等[64]提出了超薄勢(shì)壘層無(wú)嵌入技術(shù),器件結(jié)構(gòu)如圖9 所示。以5 nm 厚的超薄AlGaN 勢(shì)壘層來(lái)形成柵極溝道的常關(guān)特性,再通過(guò)低壓化學(xué)氣相沉積鈍化層介質(zhì)來(lái)恢復(fù)柵源和柵漏區(qū)域的2DEG,從而大幅降低導(dǎo)通電阻。由于去掉了嵌入刻蝕工藝,GaN HEMT的生產(chǎn)良率可以得到明顯改善;YU 等[65]報(bào)道了一種新型E 型MIS HEMT 結(jié)構(gòu),如圖10 所示,在p-GaN柵周圍沉積絕緣層和柵金屬,構(gòu)成MIS 結(jié)構(gòu),柵極泄漏電流相比于肖特基柵HEMT 下降了8 個(gè)數(shù)量級(jí)。
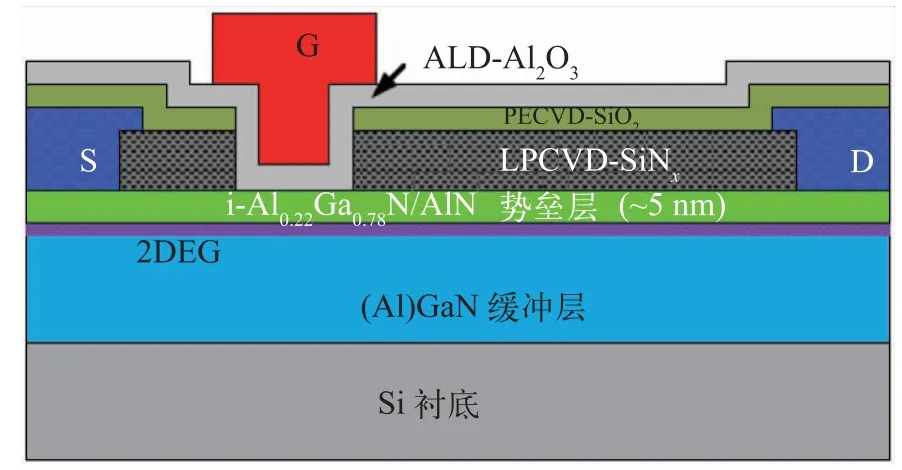
圖9 超薄勢(shì)壘層無(wú)嵌入結(jié)構(gòu)MIS-HEMT[64]
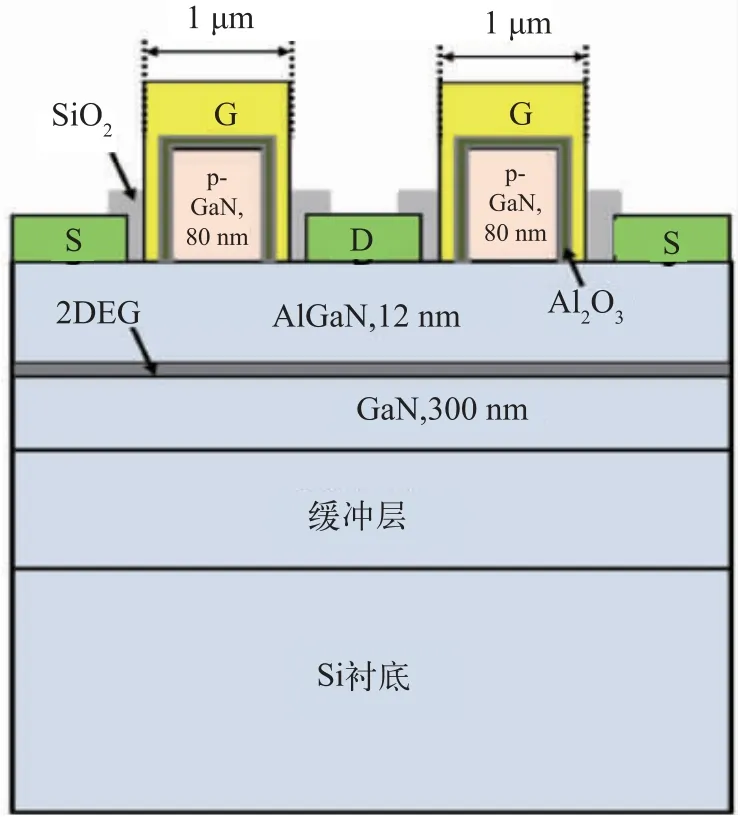
圖10 柵包圍MIS p-GaN HEMT 結(jié)構(gòu)示意圖[65]
5 結(jié)論
GaN HEMT 器件在工作過(guò)程中,電流崩塌現(xiàn)象以及擊穿電壓、泄漏電流等關(guān)鍵參數(shù)與器件工藝結(jié)構(gòu)和表面鈍化層、蓋帽層、緩沖層以及襯底材料特性緊密相關(guān)。本文對(duì)國(guó)內(nèi)外的相關(guān)研究現(xiàn)狀進(jìn)行綜述,對(duì)p-GaN 柵、MIS HEMT 等構(gòu)造增強(qiáng)型GaN HEMT 的典型技術(shù)方案進(jìn)行總結(jié)分析,為GaN HEMT 的研發(fā)及其在應(yīng)用中優(yōu)越性能得以充分發(fā)揮提供了有價(jià)值的參考。

