不規(guī)則H 形量子勢壘增強AlGaN 基深紫外發(fā)光二極管性能
魯 麟郎 藝許福軍郎 婧M SADDIQUE A K呂 琛裴瑞平王 莉王永忠代廣珍
(1.安徽工程大學高端裝備先進感知與智能控制教育部重點實驗室,安徽蕪湖 241000;2.安徽工程大學電氣工程學院,安徽蕪湖 241000; 3.北京大學物理學院寬禁帶半導體研究中心,北京 100871;4.安徽工程大學外國語學院,安徽蕪湖 241000)
1 引 言
作為一種重要的三元氮化物合金,AlGaN具有較高的電子飽和速率、介電常數(shù)和耐高溫等特性[1]。此外,它是禁帶寬度在3.4~6.2 eV之間連續(xù)可調的直接帶隙半導體[2],其范圍幾乎覆蓋整個紫外光譜。近年來,AlGaN基深紫外發(fā)光二極管(LED)在數(shù)據(jù)存儲、生物醫(yī)學、日常消毒、水和空氣凈化、光治療等方面呈現(xiàn)了廣泛的應用潛力[3],因此是當前國際研究熱點領域。
在AlGaN材料中,電子濃度一般相對較高且遷移率較高,而空穴很難實現(xiàn)高濃度,并且遷移率較低,導致在有源區(qū)呈現(xiàn)非對稱分布[4]。而且空穴從p區(qū)向n區(qū)輸運比較困難,這使得空穴在靠近p區(qū)的阱中濃度較高,離p區(qū)越遠的阱中空穴濃度越低。除此之外,電子泄露也是深紫外LED器件中非常嚴重的問題。因而有效地平衡載流子注入的器件結構設計以及相應的機理研究顯得極為重要[5]。而為克服這個嚴重的載流子注入平衡問題,目前國際上提出了一些新型的結構設計,比如組分漸變的電子阻擋層[6]、多層的量子勢壘[7]、組分漸變的量子勢壘等[8-10],因此,探索新穎的結構設計也是提高器件性能的重要途徑。針對AlGaN基多量子阱中電子阻礙效應和空穴有效注入問題,本研究工作中采用了一種不規(guī)則H形量子勢壘策略,以平衡載流子的運輸。本文通過APSYS[11]軟件進行二維數(shù)值模擬計算,并對其物理機制進行了分析和討論。
2 結構設計與參數(shù)設置
圖1展示了本研究中所用的兩種不同結構,為便于分析,除量子阱有源區(qū)組成不同外,其余結構參數(shù)保持一致。圖1(a)所示的結構從最底層c平面的藍寶石開始,上面是1.5 μm厚的AlN緩沖層和0.5 μm的n型Al0.55Ga0.45N。有源區(qū)由5對量子阱組成,其中2.3 nm厚的Al0.37Ga0.63N量子阱和10 nm厚的n型摻雜濃度為1.0×1018cm-3的AlGaN量子壘,最后一層量子壘是20 nm厚的非摻雜Al0.5Ga0.5N。隨后是10 nm厚的Mg摻雜濃度為1.0×1019cm-3的AlGaN電子阻擋層和50 nm厚、p型摻雜濃度為1.0×1018cm-3的 Al0.5Ga0.5N,最后是150 nm厚的摻雜濃度為1.0×1018cm-3的 p-GaN。圖1(c)所示為新型不規(guī)則H形量子壘結構(結構B)。其中的有源區(qū)是由 n-Al0.55Ga0.45N(2.5 nm)/Al0.5Ga0.5N(5.5 nm)/Al0.6Ga0.4N(2 nm)組成。最后一層量子壘是由Al0.55Ga0.45N(2.5 nm)/Al0.5Ga0.5N(17.5 nm)組成。上述器件結構能通過金屬有機物化學氣相沉積系統(tǒng)(MOCVD)進行外延生長實現(xiàn),建議的生長條件是:AlN在1 250℃ 溫度下以1 μm/h的速度進行生長。n-AlGaN和量子阱區(qū)分別在1 150℃和1 080℃下生長,具體細節(jié)已在我們以往的研究工作中進行了詳細描述[12]。
本文采用自洽6能帶k·p理論計算能帶結構和波函數(shù)[13]。為了簡化模擬,俄歇復合系數(shù)和SRH壽命分別設為1×1030m-6·s-1和10 ns[14]。能帶偏移比ΔEc/ΔEv設為0.7/0.3[15]。深紫外LED器件內部工作溫度設為300 K[16]。內置的界面極化電荷根據(jù)Fiorentini等[17]的公式進行計算,其中將40%的理論極化電荷密度用于解釋固定缺陷和其他表面電荷的補償。
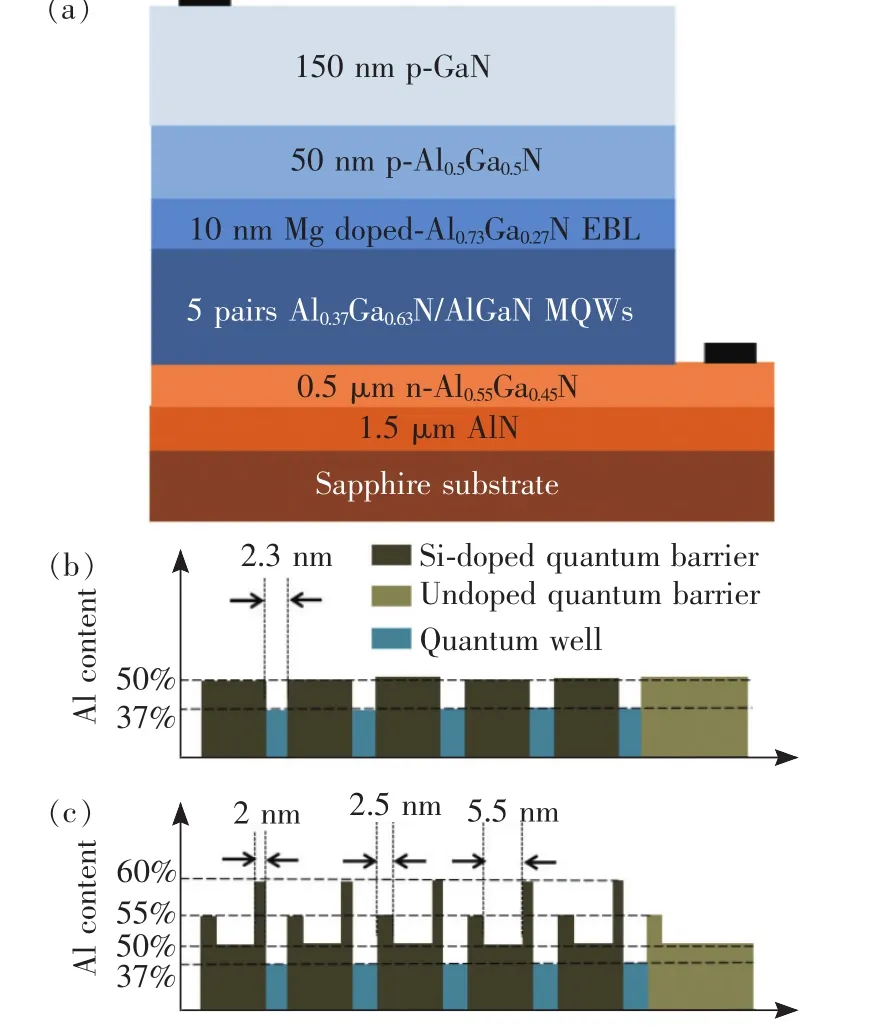
圖1 (a)AlGaN深紫外LED結構示意圖;(b)參考結構(結構A);(c)不規(guī)則H形量子阱結構(結構B)。Fig.1 (a)Schematic DUV-LED structures of different MQWs designs.(b)Structure A.(c)Structure B.
3 結果與分析
圖2給出了結構A(參考結構)和結構B(新結構)的內量子效率和光輸出功率與注入電流密度的函數(shù)關系。可以看出,在整個注入電流密度范圍內,結構B的光輸出功率和內量子效率(IQE)η始終優(yōu)于結構A。尤其是當注入電流密度達到100 A/cm2時,新型結構B的內量子效率和光輸出功率較參考結構A分別提高到1.08倍和1.07倍。此外,當注入電流密度約為65 A/cm2時,結構A和結構B的最大IQE分別為48.50%和52.18%。根據(jù)公式(ηmax-ηmin)/ηmax可得結構A和結構B的效率驟降率分別為3.3%和1.3%。因此,與結構A相比,結構B的器件性能有了明顯的改善,這可能是由于在有源區(qū)中載流子分布的調整以及空穴和電子波函數(shù)的重疊造成的。

圖2 結構A(參考結構)與結構B(新結構)的光輸出功率和內量子效率對電流密度的依賴關系Fig.2 Dependence of the LOP and IQE on injected current density for structures A(reference structure)and B(new structure)

為了更好地理解這種新型不規(guī)則H形量子阱結構提高深紫外LED性能的物理機制,我們選擇注入電流為100 A/cm2時電場的分布情況與能帶圖為例進行詳細分析。圖3為注入電流為100 A/cm2時有源區(qū)電場強度分布。眾所周知,空穴的輸運行為可以用以下公式來描述:其中Vp為空穴漂移速度,μp為空穴遷移率,E與Ek分別為靜電場強度和動能,為空穴有效質量。可以看出,在[0001]方向上增加的電場強度會使空穴獲得更大的動能,這將對空穴有效地注入有源區(qū)有很大幫助。通過計算,結構A與B在有源區(qū)內的平均電場強度分別為3.59×104V/cm和1.30×104V/cm,因而相較于結構A,結構B具有更小的平均電場強度,說明在結構B中采用不規(guī)則H形量子勢壘時,附加了沿[0001]方向上的等效電場。考慮到不規(guī)則H形量子勢壘是由高Al組分雙尖峰勢壘而形成的,附加的額外電場應歸功于極化效應導致的量子勢壘界面上的極化電荷,這在我們以往的研究中已進行了詳細的闡述[12]。
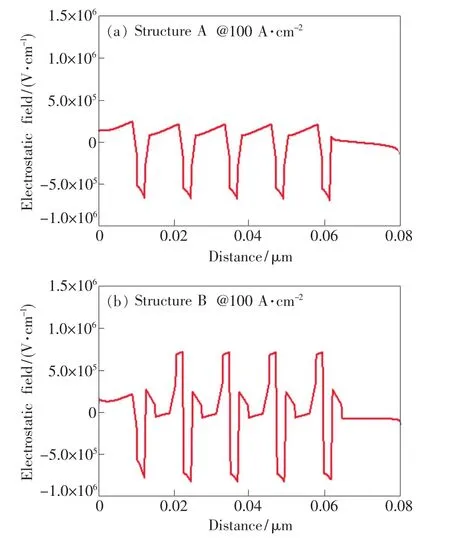
圖3 結構A(a)和B(b)在電流密度為100 A/cm2時的有源區(qū)電場分布Fig.3 Electric field profile in the active regions for structures A(a)and B(b)under the current density of 100 A/cm2
圖4 展示了在注入電流為100 A/cm2時A結構和B結構的能帶圖,A結構和B結構的電子有效勢壘高度分別為220.71 meV和365.03 meV,這表明采用不規(guī)則H形量子勢壘的B樣品具有更強的阻擋電子泄露的能力。而對于空穴,A、B結構的空穴有效勢壘高度分別為415.26,404.07 meV,說明B結構更有利于空穴的有效注入。
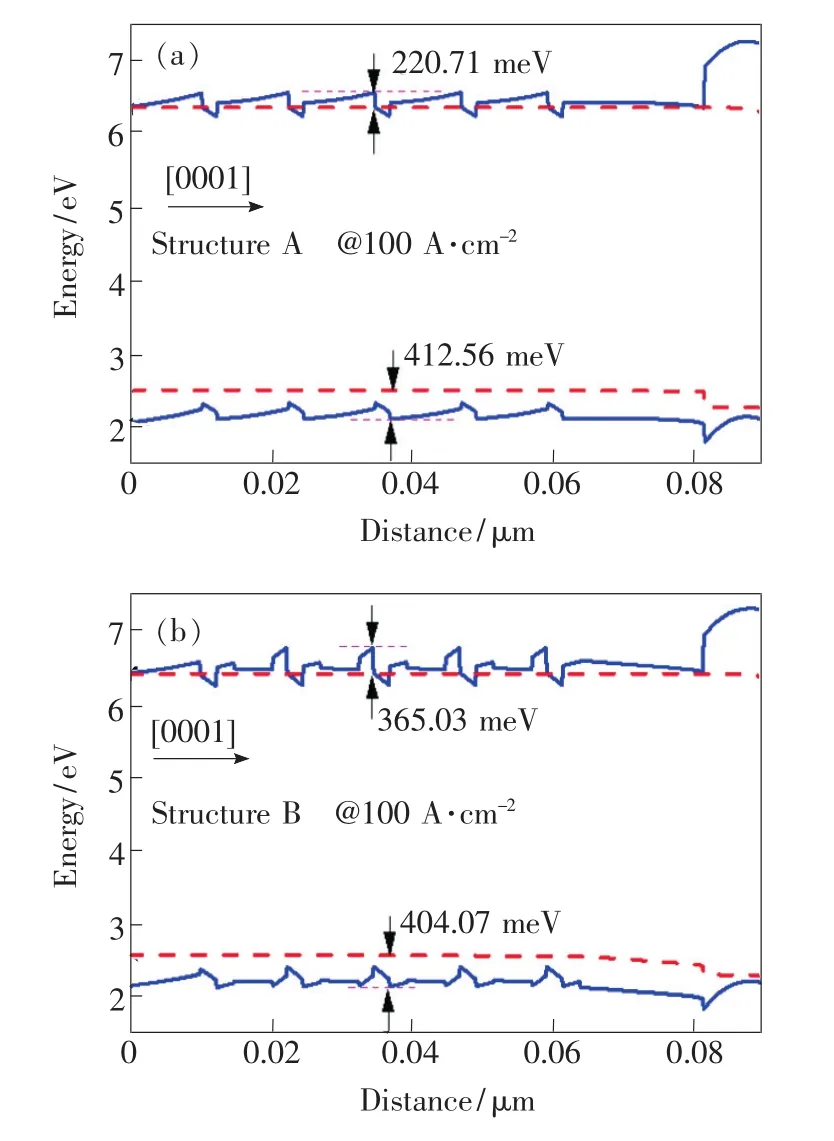
圖4 結構A(a)和B(b)在電流密度為100 A/cm2時的能帶圖Fig.4 Energy band within the active regions of structures A(a)and B(b)under current density of 100 A/cm2

圖5 結構A(a)和結構B(b)在注入電流為100 A/cm2時有源區(qū)的電子與空穴濃度分布Fig.5 Electron and hole concentration of structures A(a)and B(b)under current density of 100 A/cm2
圖5 分別展示了在電流密度為100 A/cm2時結構A和B在有源區(qū)內電子和空穴的濃度分布情況。可以清楚地發(fā)現(xiàn),結構B的電子濃度較結構A僅有輕微的變化,并且在量子阱之間積累了一些電子。圖5(a)中的插圖顯示了電子在p區(qū)的泄露情況,顯然,結構B的電子泄露量要遠小于結構A,這進一步證實了結構B中不規(guī)則的量子勢壘設計可以有效地防止電子泄露。與此同時,如圖5(b)所示,結構B中有源區(qū)的空穴濃度明顯高于結構A,顯著改善了電子和空穴的非平衡注入問題。
為進一步比較兩種結構的性能,我們分析了在注入電流為100 A/cm2時兩種結構的載流子的輻射復合情況。圖6顯示了結構A和B量子阱區(qū)域的平均輻射復合速率分布,可以發(fā)現(xiàn)結構B的平均輻射復合速率是結構A的1.16倍。另外,從圖6也可以看出,結構B中的每一對量子阱中輻射復合速率都顯著高于結構A。結合圖5中空穴與電子的濃度分布,這也進一步驗證了不規(guī)則H形量子勢壘調制的有源區(qū)中空穴濃度的增加是導致輻射復合速率增長的主要原因。

圖6 結構A與結構B在有源區(qū)的輻射復合速率分布Fig.6 Radiative recombination rates of the MQWs for structures A and B
4 結 論
綜上所述,通過引入不規(guī)則H形量子勢壘結構能有效地改善AlGaN基深紫外LED器件的載流子平衡注入難題。與普通的深紫外發(fā)光LED相比,這種不規(guī)則H形量子勢壘結構的LED器件結構在內量子效率和光輸出功率上都有了很大的改善。研究結果表明,不規(guī)則H形量子勢壘產生的電場調制效應使空穴獲得了更多的動能,從而能夠通過更高的勢壘進入有源區(qū)。同時,較高的電子勢壘有效地阻礙了電子逸出有源區(qū),而較低的空穴勢壘也有利于空穴有效注入。因此,采用不規(guī)則H形量子勢壘的結構設計中,器件的性能因空穴濃度的提高得到了極大的提升,從而有效地增加了載流子的輻射復合發(fā)光。我們的研究也表明,在常用的單一Al組分的AlGaN量子阱勢壘中引入Al組分較高的尖峰非規(guī)則結構是一種提高AlGaN基深紫外發(fā)光器件性能的有效途徑。

