集成電路老化及老化檢測技術研究
費躍哲
(中國電子科技集團公司第四十七研究所,沈陽110032)
1 引 言
隨著信息技術的不斷發展,近年來大數據、云計算等技術的應用開始變得愈加廣泛,這對數字集成電路的可靠性提出了更高的要求。
受諸多因素影響,數字集成電路在應用過程中很容易出現老化問題,這不僅會使電路成本大大增加,同時還會直接影響到集成電路的穩定性與可靠性。如果老化問題未能得到及時處理,甚至還有可能會引發嚴重的安全事故。而要想對這一問題進行有效預防,提高數字集成電路得可靠性,則需要對電路老化進行準確測試。
2 數字集成電路老化問題分析
2.1 集成電路老化的概念
數字集成電路老化通常是指集成電路在長時間使用后,其電路性能在各種因素的影響下逐漸下降,并對電路可靠性與穩定性造成影響。
一般來說,集成電路在出現老化問題后,工作頻率出現下降,信號延遲問題隨之產生,老化問題越嚴重,工作頻率下降與信號延遲問題就越嚴重[1]。而從故障現象上來看,老化主要體現在信息采集的延遲上,數字集成電路由組合邏輯電路、觸發器等部分組成,其中邏輯電路負責輸出穩定信號,而觸發器則負責捕捉這一穩定信號。正常情況下,由于邏輯電路的輸出信號能夠在一段時間內持續保持穩定,因此觸發器能夠輕易捕捉到該信號,但在老化的情況下,邏輯電路的輸出信號不斷退化,使觸發器無法完成信號捕捉,而輸出信號則會在觸發器開始工作之前發生跳變,進而引發時序故障。如圖1 所示,當SW2 開關出現故障時,SW3 開關會繼續工作,從而跳過了SW2 開關,使整個電路出現時序故障。
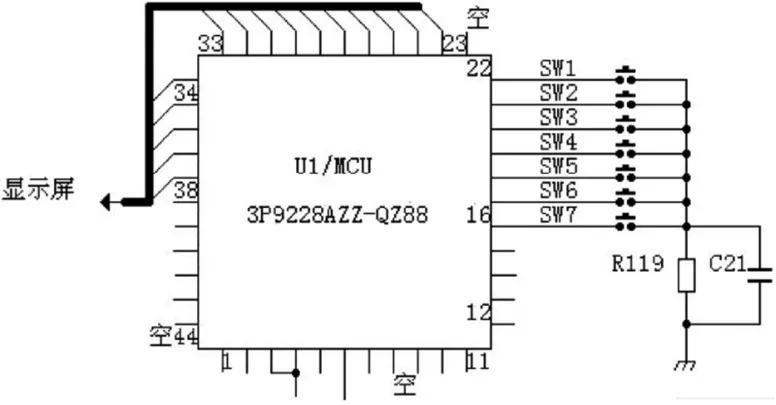
圖1 集成電路故障示意圖
2.2 集成電路老化的影響因素
數字集成電路老化的影響因素有很多,其中影響較大的主要有負偏置溫度不穩定性效應、經時擊穿、電遷移、熱載流子注入等幾種。
(1) 負偏置溫度不穩定性效應
負偏置溫度不穩定性效應主要出現在PMOS 管上,在集成電路運行過程中,PMOS 管的閾值很容易出現電壓漂移的情況,進而導致漏極電壓降低,PMOS 管的性能因此下降[2]。PMOS 管導通過程會出現一定程度的延緩,信號傳播時間也會延長,這些都會使集成電路芯片的故障發生機率大大增加,并使電路老化現象變得愈發嚴重,負偏置溫度不穩定性效應示意圖如圖2 所示。

圖2 動態負偏置溫度不穩定效應
另外,負偏置溫度不穩定性效應的出現還受到很多其他因素的影響,例如溫度、占空比、工作負載、受壓時間等。一般來說,數字集成電路所產生的負偏置溫度不穩定性效應具有動態化特點,整個效應的周期通常可分為應力期與恢復期兩個階段,在這樣的情況下,要想對負偏置溫度不穩定性效應進行可靠性分析,其難度往往會比較高,計算工作也比較復雜。
例如在動態模式下,數字集成電路閾值的電壓變化會比較大,在靜態模式下,數字集成電路的閾值電壓變化則會相對較小;而如果將數字集成電路的占空比與輸入模式確定下來,則大多數負偏置溫度不穩定性效應都可以通過偏置PMOS 柵極電源電壓的方式來解決。可見,對于負偏置溫度不穩定性效應所導致的一系列老化問題,必須要對數字集成電路展開全面測試,并且依據測試中的結果將負偏置溫度不穩定性效應恢復期確定下來,然后對于負偏置溫度不穩定性效應所引起的退化情況進行測量。
(2) 經時擊穿
經時擊穿(TDDB)是與時間相關電介質擊穿。通常情況下,晶體管的柵氧層具有絕緣特性,但在集成電路運行過程中,由于正電荷的不斷累積,在超過一段時間后,累積的正電荷會擊穿柵氧層,使之失去絕緣性,對集成電路的正常運行造成直接影響[3],導致數字集成電路的老化。
(3) 電遷移
電遷移是指在高溫環境下,數字集成電路的金屬線因電流作用而出現金屬遷移,是數字集成電路的一種十分常見的老化故障問題。
數字集成電路的精密性非常高,內部的互連引線密集,直徑也都非常小,這使得電路內部的電流密度相對較大,在高頻率變化的情況下,很多金屬原子都會在電流的影響下沿著電子運動方向而持續運動,如果某處的金屬原子遷移較多,那么本身就非常細的金屬線就很可能出現斷裂的情況。
從整體上來看,電遷移故障的形成原因并不多,通常僅在電源、時鐘線等處的互連引線上出現,引線電流密度與變化頻率越高,出現電遷移現象的機率也就越高,針對這一故障,通常都會通過增加互連引線寬度的方式來進行規避,具體寬度需要根據數字集成電路的電流密度標準值而定。
(4) 熱載流子注入
熱載流子注入是指電子脫離硅襯底而進入柵氧化層,并且會導致閾值電壓發生改變。如今電子產品的尺寸越來越小,而設備內部供電電壓與工作電壓無法再縮小,這就造成其內部集成電路的電場強度與電子運動速率隨之不斷增加,當電子的能量足夠高的時候,電子會脫離硅襯底,隧穿進入到柵氧化層,從而改變閾值電壓。MOS 器件中熱載流子注入(Hot Carrier Injection, HCI)效應的發生,是源于器件工藝尺寸改變導致的工作異常,因為溝道中的橫向和縱向電場增加,所以在強電場作用下,載流子能量迅速的提高,于是載流子變成熱載流子,并導致一系列的熱載流子效應。在深亞微米尺度下,這種效應會減小PMOS 管的閾值電壓,同時增加NMOS 管的閾值電壓,并影響一些關鍵的工藝參數,產生長期的可靠性問題。
3 數字集成電路的常用老化測試技術
數字集成電路老化測試技術方法較多,從總體上來看,可大致分為老化檢測技術與老化預測技術兩類[4]。
3.1 老化檢測技術
老化檢測技術簡單來說就是在數字集成電路出現老化問題后,技術人員利用感知單元對組合邏輯電路進行全面檢測,采集其生成的輸出信號,并對感知單元與觸發器的輸出值進行比對分析,以判斷邏輯電路所輸出的信號是否正確。
在正常情況下,感知單元捕捉到的邏輯電路輸出值會與觸發器輸出值相匹配,一旦發現邏輯電路輸出值與觸發器輸出值存在差異,則可以判斷該數字集成電路出現了老化現象[5]。一種典型故障檢測電路如圖3 所示,當電流經過電阻R1 或R2 時,該電路中的小燈泡全部點亮。當電流經過R3 時,小燈泡不亮。但如果電流流經R3 時有燈泡點亮,則說明該集成電路出現問題,需要對故障進行排除。
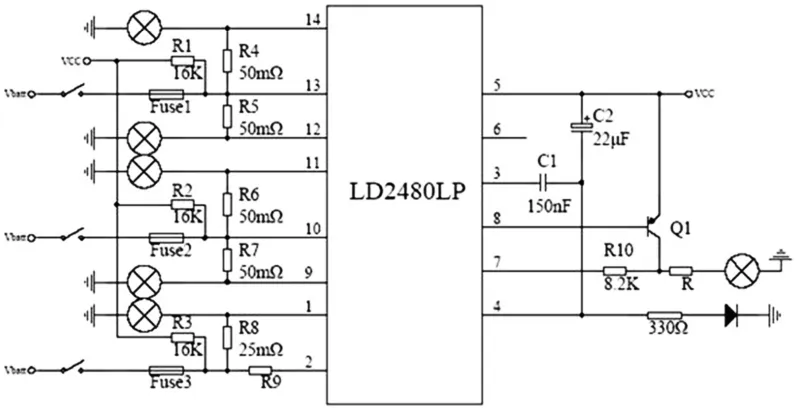
圖3 故障檢測專用集成電路
3.2 老化預測技術
與老化檢測技術相比,老化預測技術主要是用于對數字集成電路老化的預測,即在數字集成電路發生老化之前,通過對電路相關數據參數的檢測與比對分析,來判斷其是否存在即將老化的跡象。
由于老化必然會導致集成電路本身性能的下降,因此即便在老化現象發生后對其進行準確的老化檢測,也只能夠降低電路老化的影響[6]。而老化預測技術則可以在幫助技術人員在老化問題發生之前進行有效預防,且不會對集成電路造成影響,在優化電路性能、大幅度降低電路成本等方面有著非常顯著的優勢,因此其應用價值是非常高的[7]。
一般來說,對于數字集成電路老化的預測主要是通過觀察信號跳變情況來實現。正常運行的數字集成電路會按順序完成信號輸出、捕捉、識別等一系列程序,但在電路老化的情況下,由于信號捕捉會出現延遲,因此信號跳變就會頻繁出現,在測試過程中,只需預先確定可能老化問題的區域,并將其設置為測試范圍,就可以通過持續觀察進行老化預測,一旦該區域信號出現了,那么就說明電路具有潛在老化問題,接下來就可以為電路制定針對性的老化預防措施[8]。當然,由于老化預測技術依賴于信號跳變現象的觀察,因此比較適用于負偏置溫度不穩定性效應所引起的老化問題,而對于其他原因引起的老化,則存在一定的限制。
3.3 老化預測技術與老化檢測技術的對比分析
電路老化本身是一個比較漫長的過程,數字集成電路在長時間使用后,其性能才會因各種因素的影響而逐漸降低,并可能會出現老化故障。因此在電路出現時序故障之前,通常都需要對電路老化情況進行預測,但當數字集成電路出現較為嚴重的老化故障時,則需要通過老化檢測技術對老化故障的原因、嚴重程度等進行深入分析。因此,數字集成電路老化預測技術和老化檢測技術在整體上并不存在著優劣之分,實際應用中必須根據具體情況來對兩種技術進行選擇。
從總體上來看,老化預測技術與老化檢測技術的差別體現在以下幾方面。第一,在應用時間方面來看,老化檢測技術只能在數字集成電路的老化故障發生后才能夠應用,而老化預測技術則必須要在故障發生前進行應用;第二,從數字集成電路的狀態來看,老化檢測過程中,數字集成電路的數據與狀態基本已經被破壞,而在老化預測過程中,電路中的數據或狀態則并未發生變動;第三,在價格方面,老化檢測需要對數字集成電路的實際故障進行深入分析,所以檢測成本是非常高的,相比之下老化預測在成本上會更低;第四,老化檢測對于檢測準確性要求較高,如出現長期的錯誤檢測,其潛在的數據的完整性必然會受到影響,而老化預測則只需在預測失效前收集到數據即可,就能夠保證預測結果的有效性;第五,在實用性上,老化檢測與老化預測的相關技術都可以有效的結合到其他電路之中,但在老化預測的應用會存在一定的限制。
4 結 束 語
數字集成電路的工藝尺寸向微型化的方向不斷發展,對電路的魯棒性與可靠性產生了很大的影響,老化故障問題成為影響數字集成電路性能、可靠性、穩定性的主要原因。面對數字集成電路所存在的各種老化故障問題,要對影響因素做多方面的了解和研究,分析研究探討負偏置溫度不穩定性效應、經時擊穿、電遷移等老化影響因素的原理與規律,并在此基礎上對電路老化預測與檢測技術進行更加靈活的應用,實現對電路老化問題的有效預防與處理。

