PS光阻頂部凹陷問題研究
張 宇,陳珍霞,侯偉康,陳黎暄
(深圳市華星光電技術有限公司,廣東 深圳 518132)
1 引 言
隨著科技的發展和社會的進步,人們對于信息交流和傳遞等方面的依賴程度日益增加。而顯示器件作為信息交換和傳遞的主要載體和物質基礎,現已成為眾多從事信息光電研究科學家爭相搶占的熱點和高地。在液晶顯示的發展趨勢中,高亮度,高對比度,高解析度等高畫質需求十分強烈[1-4]。
對于達到高解析度這一目標,有許多相關設計都要隨之改變和改善。對柱狀隔離子(PS)提出的更高要求是尺寸更小,坡度角更大,頂部面積相對底部面積的比例更大,這意味著要求在制造中對PS的形狀控制更加精細。業內對于這一要求的解決方案主要有兩種,一種是對PS材料的改善,一種是對制程工藝的改善。材料的改善通常是提升PS材料的光敏感度,制程上的改善主要是通過調整光罩和曝光條件來改進曝光顯影的精度。本文對PS形狀的控制,主要通過制程工藝的改善,與傳統的手法不同的是,本文通過對曝光的光分布情況進行分析,并針對其根源提出改善方案。
目前陣列基板部分提升光刻工藝容限主要是通過改變涂膠、光刻、顯影、前烘、后烘的條件及光刻機的調焦調平等方法[5],但這些方法在實際生產中由于長期進行不斷的循環改善工作,使得改善空間有限[6-8]。業內不斷有研究者通過對曝光過程進行計算,找出改善的方向和條件,如通過推導并計算出光刻膠段差區域內光強變化量,計算出光刻平面的調整量,改善溝道的光刻膠殘留[9]。同時為應對LCD高解析度的需求,提升PS的光刻工藝容限,已成為必要。
2 實 驗
實驗采用負型透明PS光阻,實驗流程如圖1所示。采用旋涂進行成膜,熱盤進行預烤,使用光罩圖形為正方形,其中曝光間隙10~300 μm,使用KOH溶液進行顯影,后烘烤制程仍然是熱盤加熱。

圖1 實驗流程圖Fig.1 Flow chart of experiment
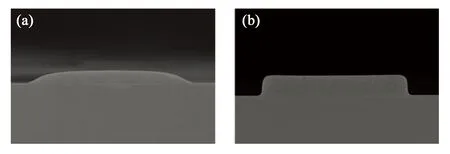
圖2 普通PS(a)和精細化PS(b)截面圖Fig.2 Cross section of normal PS(a) and fine PS(b)
3 結果分析與計算
如圖2所示,通常采用柱狀光阻作為LCD盒內的支撐物,傳統材料所形成的坡度角都比較小,如圖2(a)。而在分辨率不斷提升的大趨勢下,PS尺寸在微米尺度上變得更小,而又需要保持其支撐能力,需要通過增大其頂部面積來達到上述兩方面的平衡。通過增大坡度角,如圖2(b),頂部面積相對底部面積比例變大的同時,總的尺寸也發生了縮減。當縮小PS的尺寸時,往往發生PS頂部凹陷問題,從而導致PS支撐力不足,影響顯示器件性能。本文從曝光顯影的角度對精細化制程中出現的PS光阻頂部凹陷的問題進行了研究。
不同曝光間隙條件下得到的透明的圖案化光阻的形狀,如圖3所示,由接近光罩的正方形形狀,變為菱形,這是由于光罩的間距提高后,直角區域的光分布由于衍射能量降低導致。同時圖案化后的PS光阻頂部的凹陷由嚴重變得輕微。當曝光光源到光刻膠的間距逐漸增大后,顯影圖形變為頂部上凸(圖3e~g)。
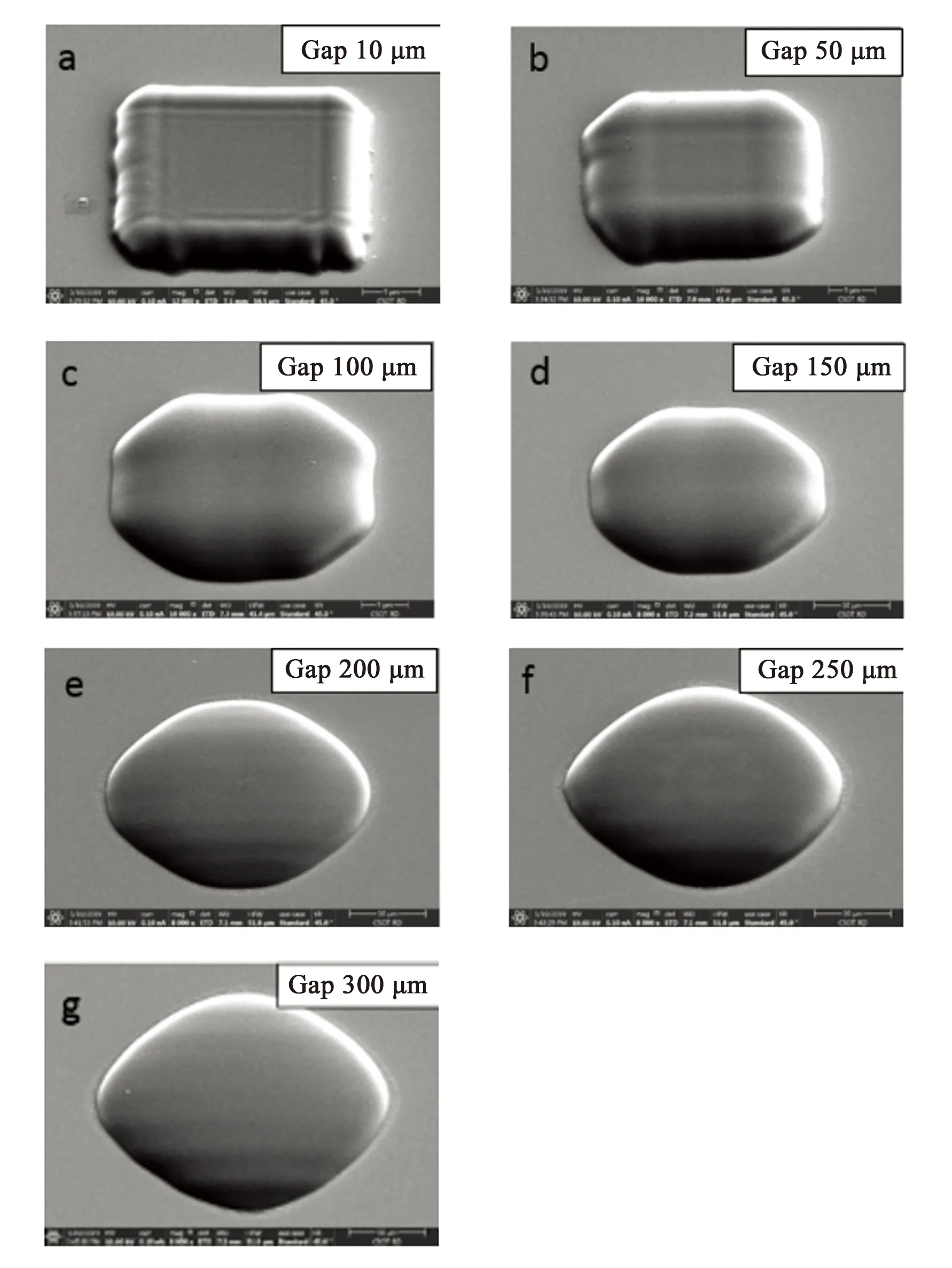
圖3 不同曝光間距下透明光阻的形狀變化。間距變化從10~300 μm,其中10~150 μ變化時,凹陷由0.17 μm逐漸減小到0.04 μm,間距繼續上升,頂部轉變為上凸。Fig.3 PS shapes with different gaps. Gap value changes from 10 μm to 300 μm. As gap value changes from 10 μm to 150 μm, the PS top convave changes from 0.17 μm decrease to 0.04 μm; when gap value increases, PS top shape changes to convex.
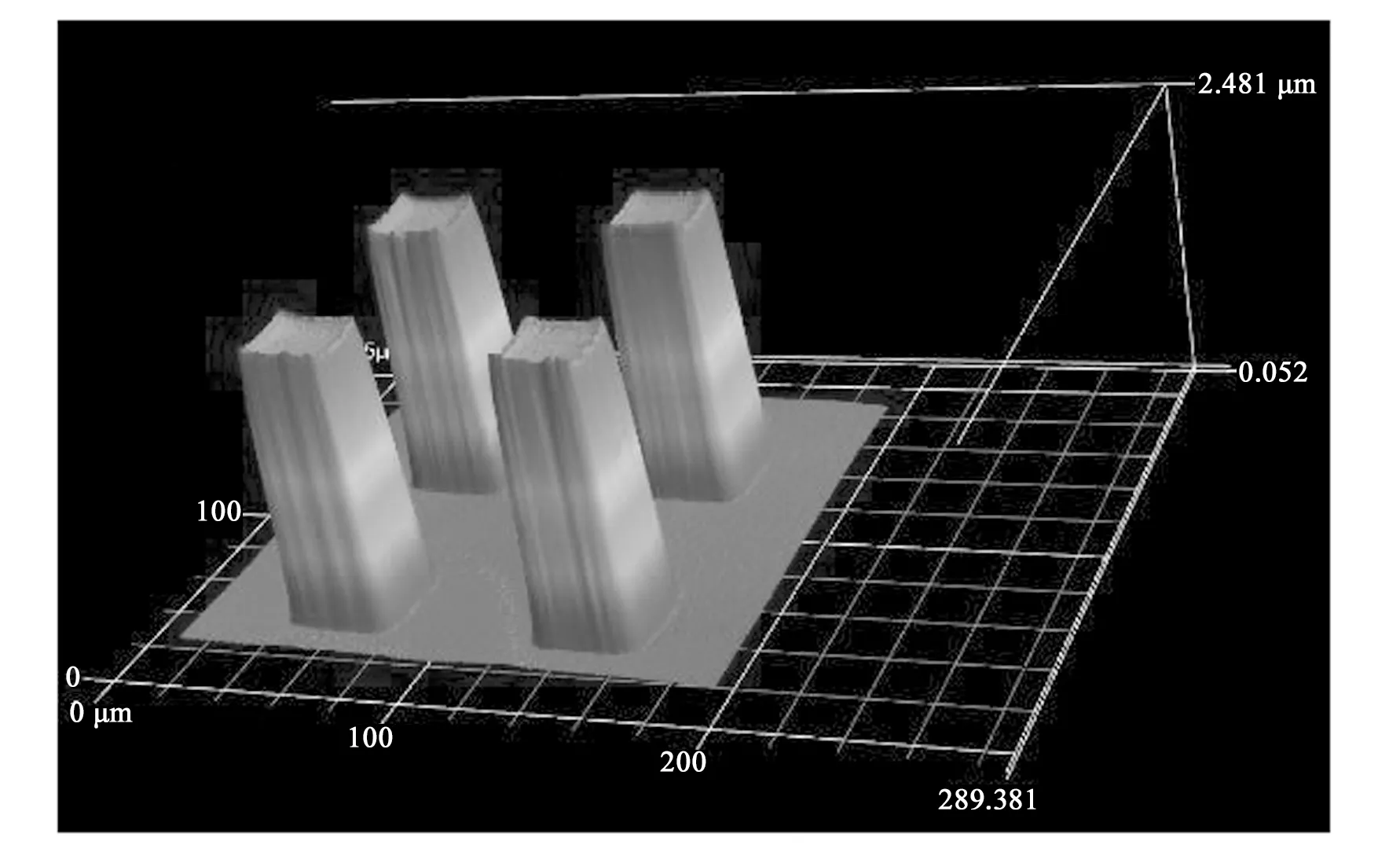
圖4 曝光間距為10 μm的樣品其頂部3D輪廓:PS光刻膠成型后的頂部凹陷模擬。Fig.4 3-D top profile of samples with exposure gap of 10 μm: simulation of top depression after PS photoresist forming

圖5 不同曝光間距下光強分布情況模擬Fig.5 Simulation of light intensity distribution under different exposure gap
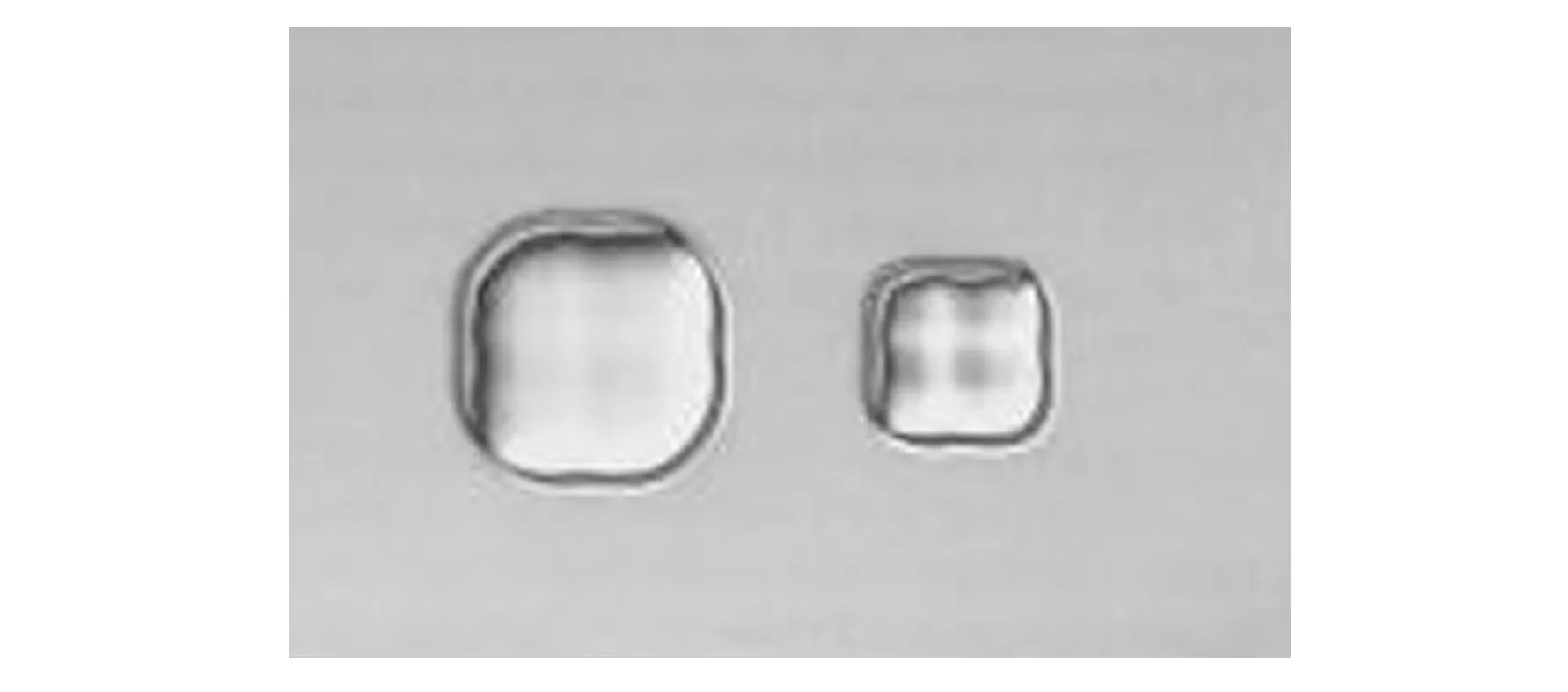
圖6 透明光阻圖案化后頂部分區塊圖Fig.6 Top block map after transparent photoresist patterning
針對這種現象,采用GenIsys商業軟件進行了模擬計算,模擬結果如圖4所示。從模擬結果中可得到兩個重要趨勢:(1)角落光強分布的形狀,從與光罩形狀一致的正方形變為直角削弱后的菱形,這與實際圖案化的光阻形狀變化是一致的;(2)PS光阻頂部受到光能量照射后,圖形變化趨勢也與實驗一致,隨著間距變大光組頂部由凹陷轉為上凸。頂部凹陷還有一個微小的細節,如圖5(a-4,a-5),在曝光間隙在150~200 μm時,頂部形貌呈現出分區塊的情況,這部分同樣由實驗得到驗證,如圖6所示。圖6中采用了平行度更高的曝光機進行,其提供的光源更接近高斯光束,更好地復現出高斯光束在經歷不同的傳播距離時發生的變化。
由曝光機中的光源發出的光,經由其內部的光學構件UM成像系統,變為高斯光束對基板上的光阻進行曝光,光束與基板間放置一個光罩實現光阻的圖案化。經過光罩后光束的傳播符合高斯分布,它可以通過麥克斯韋方程式推導得到[10]均勻介質中的高階高斯光束公式如式(1)。
(1)

圖7 幾種高階高斯光束的光強分布圖。TEM0,TEM1,TEM2。Fig.7 Intensity distributions of several higher-order Gauss beams. TEM0,TEM1,TEM2.
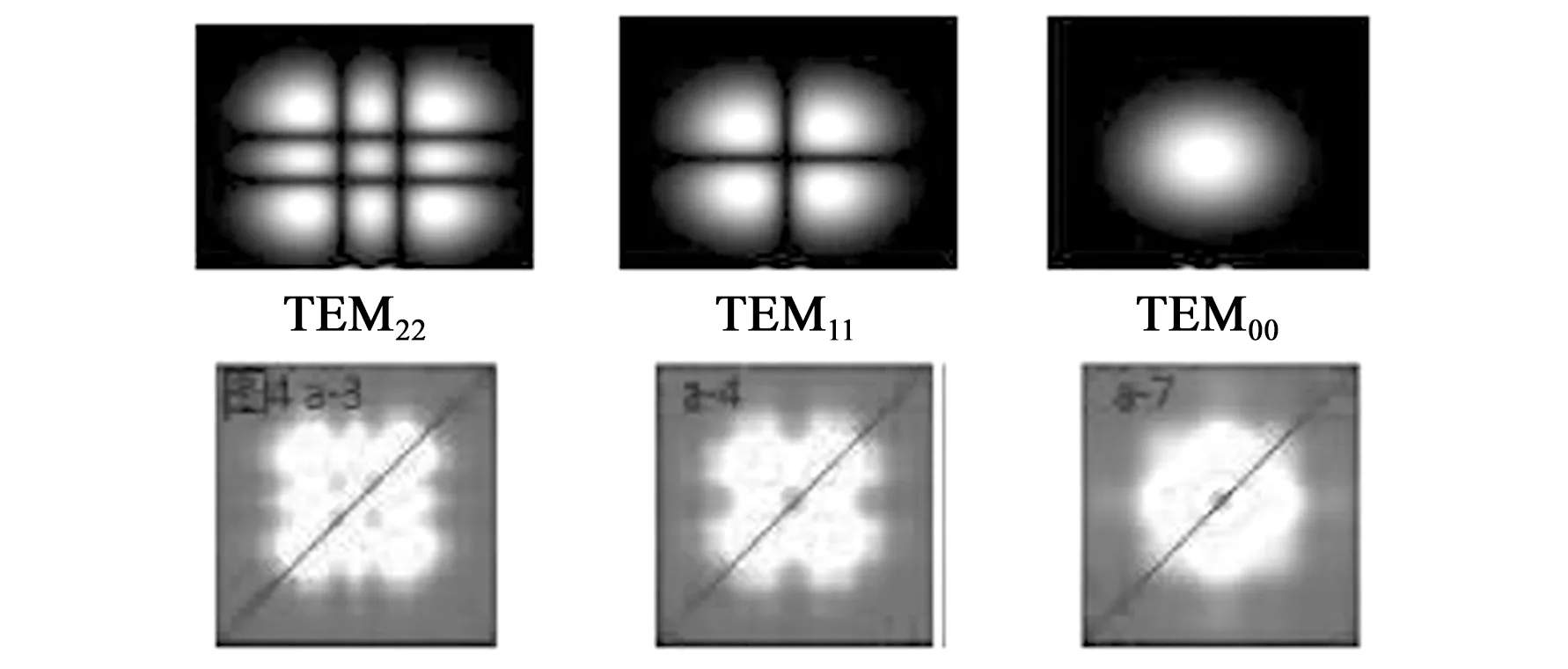
圖8 高階高斯光束的光強分布與模擬光強分布Fig.8 Intensity distribution and simulated intensity distribution of higher-order Gauss beams
其中:m,n為x,y方向上的零點數,此時高階高斯光束分布為厄米-高斯光束,表示為TEMmn模式。幾種高階高斯光束的光強分布圖如圖7所示,其中n為0,m為0,1,2。本實驗中光強的區塊分布符合TEM22,TEM11,TEM00,如圖8所示。
4 結 論
通過實驗可見,光阻頂部凹陷現象,與曝光間距形成強相關。當曝光間距由小變大,即曝光機內光源發出的光,經由光罩后傳播的距離變化,會引起到達光阻的光分布的改變,簡單描述為分峰狀況由多到少變化。在100~200 μm的曝光間距范圍內,分峰數量為4,峰谷強度差異最大,此時容易發生頂部凹陷的問題,且可明顯觀察到頂部圖形呈四區塊。因此,建議在LCD PS高精細化的需求下,降低曝光間距,從傳統的250 μm降低到150 μm或100 μm以下,可避免頂部凹陷問題;另外,也可考慮改變光罩圖形,如從原來的單孔變為多孔相拼,可增加分峰數量,使光強分布差異減小。

