氫氣浸泡輻照加速方法在3DG111 器件上的應用及輻射損傷機理分析*
趙金宇 楊劍群 董磊 李興冀
(哈爾濱工業大學材料科學與工程學院,哈爾濱 150001)
(2018 年11 月8 日收到; 2019 年1 月9 日收到修改稿)
本文以60Co 為輻照源,針對3DG111 型晶體管,利用半導體參數分析儀和深能級缺陷瞬態譜儀,研究高/低劑量率和有/無氫氣浸泡條件下,電性能和深能級缺陷的演化規律. 試驗結果表明,與高劑量率輻照相比,低劑量率輻照條件下,3DG111 型晶體管的電流增益退化更加嚴重,這說明該器件出現了明顯的低劑量率增強效應; 無論是高劑量率還是低劑量率輻照條件下,3DG111 晶體管的輻射損傷缺陷均是氧化物正電荷和界面態陷阱,并且低劑量率條件下,缺陷能級較深; 氫氣浸泡后在高劑量率輻照條件下,與未進行氫氣處理的器件相比,輻射損傷程度明顯加劇,且與低劑量率輻照條件下器件的損傷程度相同,缺陷數量、種類及能級也相同. 因此,氫氣浸泡處理可以作為低劑量率輻射損傷增強效應加速評估方法的有效手段.
1 引 言
空間環境中航天器電子元器件損傷主要是由各種帶電粒子和射線造成[1]. 1991 年,Enlow 等[2]發現雙極型器件在低劑量率下的輻照損傷要遠遠高于高劑量率下的輻照損傷,這一現象被稱為低劑量率輻射損傷增強(enhanced low dose rate sensitivity,ELDRS)效應[3?5]. 這一效應的發現,立刻引起了國際航天領域的廣泛關注. 雙極型器件具有電流驅動能力好、線性度高、噪聲低及匹配特性好等優點[6],廣泛應用于空間電子系統. ELDRS 效應的存在[7],給空間用雙極型器件抗輻射能力的評價帶來很大困難. 若采用實際空間環境的典型劑量率(10–6—10–4Gy(Si)/s)對電子元器件進行抗輻射能力評價,成本高、耗時長. 因此,找到一種可靠、高效的雙極型器件的ELDRS 效應加速評估方法顯得尤為重要. 目前,針對雙極型器件ELDRS效應提出了許多常用的加速評估試驗方法: 1)恒高溫恒劑量率(100 ℃,5 × 10–3—5 × 10–2Gy(Si)/s)輻照; 2)高劑量率輻照后加溫退火; 3)變劑量率輻照等[8?10]. 然而,文獻中已報道的各種加速評估方法均存在著不足. 恒高溫恒劑量率輻照損傷明顯小于低劑量率輻照; 變劑量率方法存在所需時間長、評估總劑量不高及所需器件數量多等缺點[9?14]; 而且,上述評估方法均存在普適性差的缺點. 迄今,國際上還沒有一種加速評估方法能加速評估出所有器件的ELDRS 效應,也沒有快速鑒別器件是否具有ELDRS 效應的有效方法. 近年來,有些文獻報道了加氫輻照法[15?17],但這些文獻只停留于宏觀電性能評價,尚未給出器件加氫處理后高劑量率輻照與低劑量率條件下輻射損傷機制是否一致. 本文基于氫氣浸泡處理,針對3DG111 晶體管,研究高、低劑量率輻照條件下電性能和深能級缺陷的演化規律,探究加氫處理后高劑量率輻照與低劑量率輻照對器件造成輻射損傷行為的關系,可為建立ELDRS 效應加速評估方法提供重要依據.
2 試驗器件與試驗方法
本文選用3DG111 型NPN 晶體管為研究對象,輻照試驗所用晶體管均為同一批次生產. 氫氣浸泡前,需要對晶體管進行開帽處理. 將浸泡容器抽至真空,并注入純度為100%的氫氣. 為確保器件中氫氣濃度達到飽和,需要將器件在室溫條件下浸泡氫氣氛圍中至少144 h,容器內氫氣壓強不低于0.06 MPa.
輻照試驗利用中國科學院新疆理化技術研究所的60Co 輻照源. 高劑量率輻照試驗劑量率為100 rad/s (1 rad =10–2Gy),低劑量率輻照試驗劑量率為10 mrad/s,所有輻照試驗均在室溫條件下進行,輻照之前將氫氣浸泡器件從容器中取出再進行輻照. 輻照試驗表明,60Co 輻照源對開帽和未開帽處理的器件造成的損傷一致,如圖1 所示. 因此對于未經氫氣浸泡處理的器件樣品無需進行開帽處理.
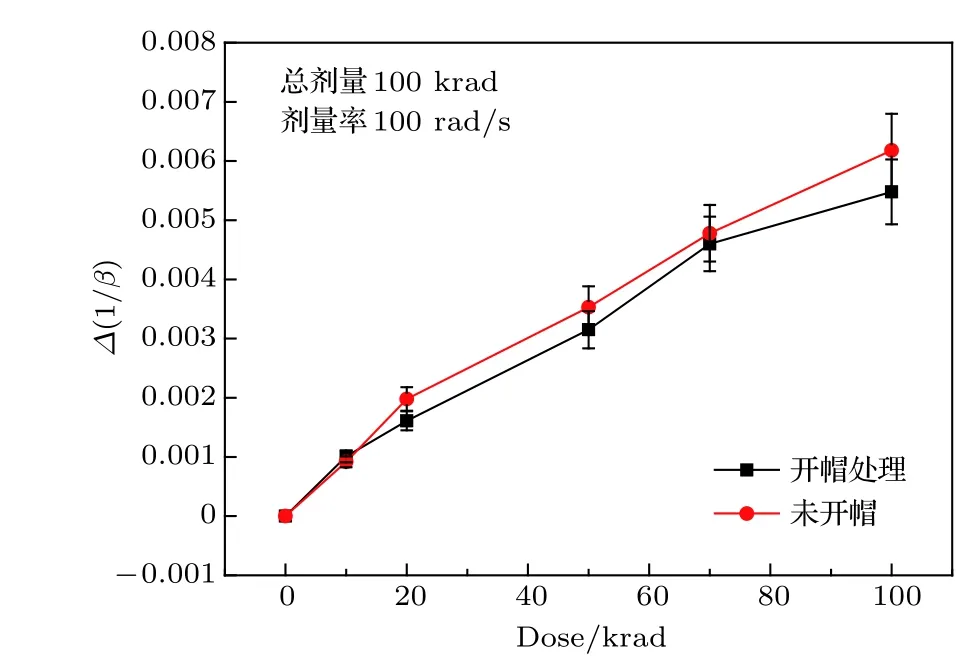
圖1 開帽處理后經γ射線輻照晶體管電流增益倒數變化量與未處理直接輻照對比Fig. 1. Comparison of ? (1/β) ofγ-ray irradiated transistor after open cap treatment with untreated.
采用KEITHLEY 4200-SCS 半導體參數分析儀測試Gummel 特性曲線. 雙極晶體管Gummel特性曲線測試的參數設置為: 發射極接掃描電壓VBE,以0.01 V 的掃描步長,從0.2 V 掃描至1.2 V,即VBE=0.2—1.2 V; 基極和集電極均接地,測試基極電流IB和集電極IC隨發射極電壓的變化趨勢. 本文選取的電流增益β值為VBE=0.65 V 時對應的IC與IB的比值. 通常利用電流增益倒數的變化量表征器件損傷程度.
深能級瞬態譜儀(deep level transient spectroscopy,DLTS)是檢測雙極型器件內部深能級缺陷的有效手段,可以定量表征微觀缺陷種類、濃度及能級等信息. DLTS 測試過程中主要參數設定為: 脈沖寬度TP=0.01 s,脈沖電壓VP=0 V,反向偏壓VR=5 V,溫度從350 K 掃描到40 K,測試周期TW=2.05 s.
3 試驗結果
圖2(a)和圖2(b) 分別為劑量率為100 rad/s和10 mrad/s 的 γ 射線輻照條件下,3DG111 晶體管的基極電流IB和集電極電流IC隨發射極電壓VBE的變化曲線. 由圖2 可見,無論高劑量率還是低劑量率輻照條件下,當發射極電壓相同時,隨著輻照劑量的增加,3DG111 型雙極晶體管基極電流與集電極電流均發生變化. 其中基極電流明顯升高,而集電極電流與基極電流相比變化不顯著. 當輻照劑量相同時,與高劑量率條件下相比,低劑量率輻照條件下基極電流增加程度更加明顯.
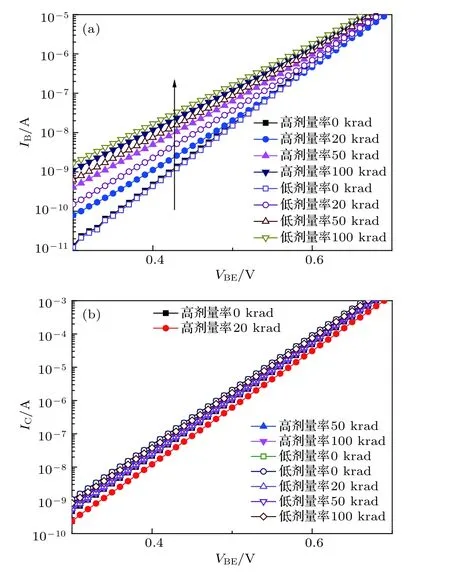
圖2 高劑量率輻照條件下未經氫氣浸泡的晶體管的Gummel 曲線 (a)基極電流; (b)集電極電流Fig. 2. Gummel curve of a transistor that has not been treated with hydrogen at high dose rates: (a) Base current;(b) collector current.
圖3 為高、低劑量率和氫氣浸泡后高劑量率輻照條件下,3DG111 型晶體管電流增益倒數變化量隨著輻照劑量的變化關系. 由圖3 可知,當輻照劑量相同時,與100 rad/s 高劑量率輻照相比,10 mrad/s低劑量率輻照條件下3DG111 晶體管損傷更加嚴重. 這說明3DG111 型晶體管具有明顯的低劑量率增強效應. 另一方面,在輻照劑量相同的條件下,經氫氣浸泡后3DG111 型晶體管電流增益倒數的變化量要遠大于未經氫浸泡的情況. 并且,隨著輻照劑量增加,未經氫氣浸泡的晶體管增益退化開始出現飽和,而經氫氣浸泡的晶體管損傷呈線性增加. 這說明氫加劇了3DG111 型雙極晶體管的損傷程度. 值得注意的是,經氫氣浸泡后高劑量率輻照條件下,晶體管損傷程度與低劑量率輻照條件下相同. 這表明,從宏觀電性能方面分析,氫氣浸泡后高劑量輻照方法可以獲得ELDRS 效應加速評估的效果.
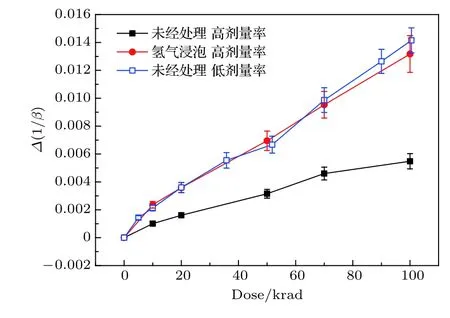
圖3 氫氣浸泡再經γ射線輻照后晶體管電流增益倒數變化量與未經處理輻照樣品對比Fig. 3. Comparison of? (1/β) with/without hydrogen treated sample underγ-ray irradiated.
4 討論與分析
通過分析雙極型晶體管中過剩基極電流( ?IB)與發射極-基極電壓(VBE)的變化關系,可以揭示雙極型晶體管輻射損傷機制. 輻照導致過剩基極電流定義為 ?IB=IB–IB0,式中IB為輻照后晶體管的基極電流,IB0為輻照前的基極電流.
過剩基極電流的變化主要由以下兩種原因導致: 1)輻射感生界面態引起的表面復合電流的增加; 2)輻射感生氧化物俘獲正電荷引起的表面復合電流的增加[18]. 過剩基極電流可由(1)式表示:

式中Ki為常數,Di(T)為總的電離吸收劑量,q為電子電荷,k為玻爾茲曼常數,T為熱力學標準溫度,n是理想因子. 當輻照引起的過剩基極電流主要來自于發射結空間電荷區的復合電流時,n=2;而當過剩基極電流主要來自中性基區復合電流時,n=1.
圖4 給出了高、低劑量率輻照條件下,3DG111晶體管過剩基極電流隨發射極-基極電壓的變化.由圖4 可知,相同總劑量條件下,低劑量率輻照的晶體管過剩基極電流大于高劑量率輻照的晶體管.高、低劑量率輻照條件下,隨著輻照劑量的增加,3DG111 晶體管過剩基極電流的n值均逐漸趨向于2,這說明晶體管在 γ 射線輻照過程中復合電流主要來自空間電荷區. 而且,與高劑量率相比,低劑量率輻照條件下,晶體管過剩基極電流的n值更接近2,這說明低劑量率輻照會導致空間電荷區的復合電流加劇. 對于NPN 雙極晶體管而言,氧化物電荷和界面態均會導致空間電荷區的復合電流加劇[19].
圖5 為經氫氣浸泡處理后100 rad/s 高劑量率輻照和10 mrad/s 低劑量率輻照條件下,過剩基極電流的對比結果. 由圖5 可以看出,兩種輻照條件下,晶體管過剩基極電流隨發射極-基極電壓的變化趨勢相同.
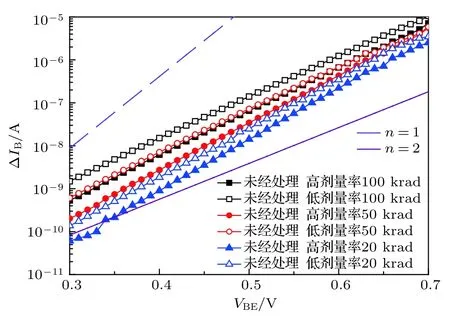
圖4 高低劑量率輻照條件下3DG111 晶體管過剩基極電流對比Fig. 4. Comparison of excess base current of 3DG111 transistors at high and low dose rates.

圖5 氫氣浸泡預處理與未經處理晶體管輻照后過剩基極電流對比Fig. 5. Comparison of excess base current of a transistor after irradiation with/without hydrogen-immersion pretreat ment.
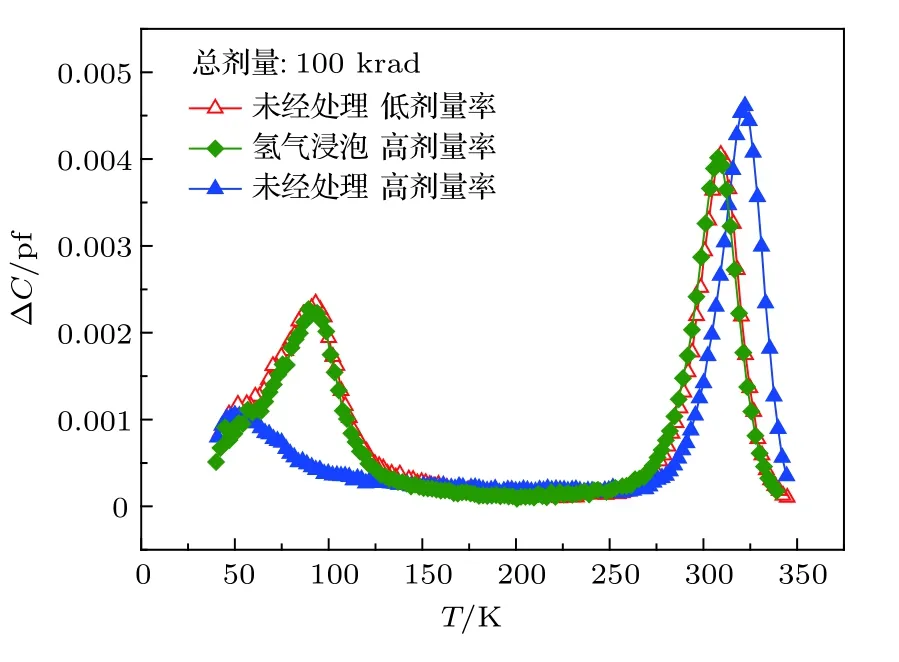
圖6 氫氣浸泡預處理與未經處理晶體管輻照后DLTS曲線對比Fig. 6. Comparison of DLTS curves of a transistor with/without hydrogen-immersion pretreatment.
圖6 為有無氫氣浸泡后高、低劑量率輻照條件下,3DG111 晶體管的DLTS 譜圖. 從圖6 可以發現,有無氫氣浸泡后無論高低劑量率輻照條件下,晶體管的DLTS 譜均存在兩個特征峰. 峰值位于300 K 左右為界面態,峰值在75 K 左右為氧化物電荷,峰的位置代表缺陷的能級[20]. 對于雙極型晶體管,其能級越靠近中帶,能級越深,對性能影響越大. 硅的中帶位置通常在250 K 左右[21].
對于高劑量率輻照條件下,界面態數量多,但能級較淺. 而對于低劑量率輻照條件下,界面態數量減少,但能級較深. 能級越深,對晶體管的性能影響越大. 隨著劑量率的減小,氧化物電荷不僅能級向中帶移動,數量也明顯增多. 綜上所述,無論是高劑量率輻照還是低劑量率輻照,3DG111 晶體管主要產生界面態和氧化物電荷電離缺陷. 與高劑量率輻照相比,低劑量率輻照會產生能級較深的界面態和氧化物電荷,從而導致空間電荷區的復合電流變大,進而導致基極電流增大.
從表1 所列數據可以得出,經氫氣浸泡處理后高劑量率輻照的晶體管和未經氫氣處理直接進行低劑量率輻照的晶體管相比,輻照后產生的缺陷種類、缺陷能級、俘獲截面和缺陷濃度等參數均非常接近. 因此,氫氣浸泡處理加劇了晶體管的輻射損傷,且產生的缺陷與低劑量率輻照的缺陷特征相同. 這說明,對于3DG111 晶體管,氫氣浸泡處理后高劑量率輻照和低劑量率輻照兩種條件下,微觀輻射損傷機制相同. 因此,氫氣浸泡處理可以作為一種ELDRS 效應加速試驗方法的有效手段.

表1 氫氣浸泡預處理與未經處理晶體管輻照后缺陷參數對比Table 1. Comparison of defect parameters of a transistor with/without hydrogen-immersion pretreatment.
近年來,Rashkeev 等[22]和Chen 等[23]針對雙極型器件ELDRS 效應的解釋提出了基于氫的雙分子模型,該模型認為器件內部各種形式的氫是導致器件出現低劑量率增強效應的根本原因. 其基本過程如圖7 所示,雙極型器件在受到輻照時,會在SiO2層內生成電子-空穴對,并發生電子-空穴復合和空穴與含氫缺陷反應兩個過程[24],兩個過程之間存在競爭關系. 在高劑量率輻照時,主要發生電子-空穴復合,此時生成的界面態數量較少; 當輻照劑量率較低時,電子-空穴對生成較少,此時電子-空穴復合減慢,空穴的移動變得更加容易,導致空穴和含氫缺陷反應加劇,生成更多的界面態. 而氫氣浸泡后,由于氫分子與氧原子和硅原子產生結合[25]. 器件內部會引入大量的氫分子,氫分子會對電子和空穴復合產生干擾,同時被輻照后的氫分子可以裂解為氫離子,提高器件內部空穴的濃度. 此時會起到和低劑量率輻照同樣的效果. 根據本文的試驗結果,可以認為低劑量率輻照時影響的不只是界面態的數量,還可以影響界面態的能級. 當界面態能級處于更深位置時,同樣可以加劇器件的輻照損傷.
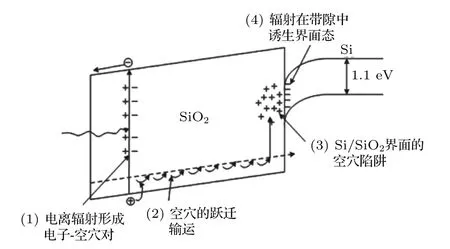
圖7 輻照中的SiO2 中的空穴傳輸、俘獲和質子釋放的示意圖[24]Fig. 7. Schematic illustration of hole transport,trapping and proton release in SiO2 irradiated[24].
長期以來,國內外對低劑量率效應的研究均著眼于界面態的變化情況而忽視了氧化物電荷的變化. 根據本文的DLTS 結果顯示,雙極型器件低劑量率輻照和氫氣浸泡后輻照都會使氧化物電荷的數量顯著增加. 根據目前研究顯示,電子器件SiO2層中主要有兩種氧空位結構[26]: 二聚體(dimer)結構 V oδ和褶皺結構 V oγ ,氧空位會和晶體管內部的氫結合成含氫空位,基于密度泛函理論計算可知,單氫缺陷結構 V oδH 和 V oγH 為空穴的深能級俘獲心,雙氫缺陷結構 V oδH2和 V oγH2為淺能級俘獲心[27]. 輻照產生的電子和空穴會被這些缺陷所俘獲,形成氧化物電荷[28]. 根據本文的試驗結果,氧化物電荷也會影響器件的復合電流,是一種與ELDRS效應密切相關的缺陷.
綜上可以得知,氫氣浸泡和低劑量率輻照在氧化物電荷和界面態上生成上可以起到相似的作用.因此可以得出,氫氣浸泡是一種合理的加速試驗方法,且在微觀缺陷和宏觀電性能方面均有很好的吻合效果.
5 結 論
本文通過對比研究有/無氫氣浸泡高劑量率輻照和未經氫氣浸泡低劑量率輻照三種情況下晶體管的電性能和缺陷參數,提出氫氣浸泡可以作為一種有效的ELDRS 效應加速試驗的方法,并得到如下結論.
1) 3DG111 型晶體管存在明顯的ELDRS 效應. 它表現為在低劑量率輻照時,電性能退化明顯加劇. 造成退化加劇的主要原因是低劑量率輻照時氧化物電荷濃度增加,同時氧化物電荷和界面態能級均向中帶移動,導致晶體管空間電荷區復合加劇,最終導致晶體管損傷程度增大.
2) 經過氫氣浸泡后進行高劑量率輻照的晶體管,其電性能退化程度與低劑量率輻照時相似. 對比兩者的微觀缺陷情況可以得知,兩者的缺陷能級和數量幾乎完全相同. 因此認為氫氣浸泡后再輻照是一種有效的ELDRS 效應加速試驗方法,且損傷情況與低劑量率輻照吻合得很好.
根據本文的試驗經驗,目前我們提出一種氫氣浸泡輻照加速試驗的基本思路. 首先對樣品進行開帽處理,使內部芯片完全暴露. 隨后將樣品浸泡于濃度為100%的氫氣氣氛中,壓強可根據容器安全范圍進行選取. 浸泡至少40 h 后,將樣品從容器中取出,完成規定劑量的輻照試驗.

