FPGA大氣中子輻射效應仿真研究?
趙鵬梅亮常成
(航天科工防御技術研究試驗中心 北京 100854)
1 引言
臨近空間飛行器的定義是可以在臨近空間長期作業的飛行器,由于其具有重要的戰略意義,因此得到眾多國家的重視。組成臨近空間的主要成分為中子,我們把它定義為大氣中子。臨近空間飛行器上裝載大量FPGA、DSP等大規模集成電路,這些集成電路對大氣中子輻射效應反應靈敏,受大氣中子輻射影響,容易發生單粒子翻轉,從而影響整個控制系統的正常運行[1~8]。本文以SRAM型FPGA為研究對象,開展FPGA大氣中子輻射效應研究與分析。
SRAM型FPGA受大氣中子輻射影響,發生單粒子效應的主要內因在于,其存儲單元(SRAM)中的NMOS管受粒子入射影響,產生瞬態脈沖電流,該脈沖電流作用于整個SRAM電路結構中,改變其存儲狀態,影響整個FPGA的正常功能[9~10]。
2 SRAM結構分析與模型建立
2.1 SRAM電路結構分析與工藝參數
SRAM就是靜態隨機存儲器,其結構原理示意圖如圖1所示,SRAM一般由存儲單元陣列、地址譯碼器、靈敏放大器、控制電路以及驅動電路五個結構組成。存儲單元陣列是SRAM實現功能的關鍵部分,而剩下的四個部分主要負責為存儲單元陣列服務。隨著集成工藝的發展,SRAM存儲單元出現了許多不同的電路結構,常見的SRAM存儲單元電路結構有:傳統六管型、六管NMOS型、四管型、改進七管型以及新型八管型。其具體工藝參數參見表 1[9~14]。

表1 五種不同結構SRAM存儲單元MOS管工藝尺寸對比
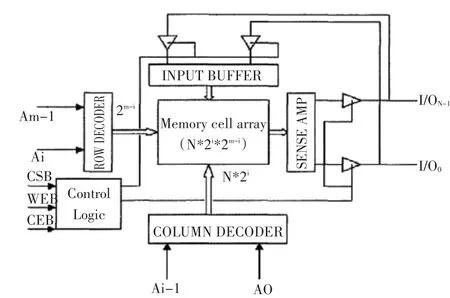
圖1 SRAM結構原理示意圖
2.2 SRAM電路模型建立
根據表1所示的工藝參數,利用仿真軟件PSpice搭建SRAM存儲單元電路結構的仿真電路,以傳統六管型SRAM為例[15],構建電路模型如圖2所示。
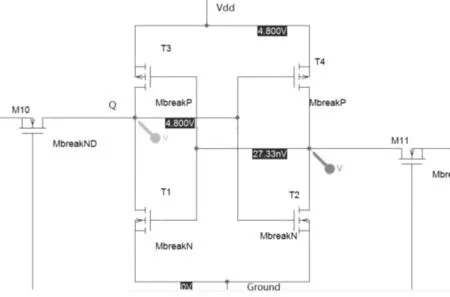
圖2 傳統六管SRAM存儲單元
3 SRAM存儲單元電路仿真分析
3.1 傳統六管型SRAM存儲單元電路仿真分析
利用《NMOS大氣中子輻射效應仿真研究》中所得NMOS管漏極瞬態脈沖電流仿真結果,進行SRAM存儲單元電路仿真分析。
將不同LET分別為0.1、0.5、1MeVcm2/mg時的NMOS管漏極脈沖電流[8]施加到如圖2所示T1管的漏極上,使用PSpice中的Voltage Maker工具對Q數據存儲位進行觀測,記錄的Q點電壓(假設初始狀態為高電平,即SRAM存儲數據為“1”)變化如圖3所示。

圖3 不同LET值下Q存儲位電壓變化示意圖
從圖中可以看出,LET=0.1、0.5 MeVcm2/mg時,Q存儲位電壓在一個短時間內下降,但雖然立即返回到原始電壓,說明此時Q存儲位仍為高電平,SRAM存儲數據仍為“1”;當LET=1MeVcm2/mg時,Q存儲位電壓迅速下降,并最終徹底變為幾乎等于0的電壓,說明此時Q存儲位從高電平變為低電平,SRAM存儲數據從“1”變為“0”,也就是說,SRAM存儲狀態發生改變,具體狀態如圖10所示,可以清楚看出,SRAM受中子輻射影響,其存儲狀態發生了變化。
為了更為全面地研究SRAM存儲單元受中子輻射影響引起的單粒子效應,需要將表1中分析的五種不同結構SRAM進行依次仿真分析,仿真手段與上述流程一致。
3.2 SRAM存儲單元電路仿真分析

圖4 四管SRAM電路仿真示意圖
從表1可以得出,四管SRAM存儲單元由兩個PMOS管以及2個NMOS管構成,2個NMOS作為存儲管存在,主要完成數據的存儲功能,需要注意的是,四管SRAM中的4個MOS管工藝尺寸均為0.18μm,而受到中子輻射的影響主要集中在NMOS管的漏極,因此,以其中一個存儲管N1為例,如圖4所示,將上述得到的0.18μm NMOS管受不同LET值下中子輻射影響而產生的脈沖電流施加到如圖中N1管的漏極,以進行四管SRAM存儲單元的單粒子翻轉仿真分析,仿真具體結果如圖5所示,隨著LET值的不同減小,脈沖電流的沖擊不斷減小,對四管SRAM的影響也不斷地減弱,當LET=1MeV-cm2/mg時,四管SRAM中存儲位Q的電壓,受N1脈沖電流的影響,迅速地減小,直到最終變為幾乎為0,也就是存儲位Q的電壓從高電平變為低電平,即四管SRAM的存儲數據從“1”變為“0”,證實四管SRAM發生了單粒子翻轉;當LET=0.5MeVcm2/mg或0.1MeVcm2/mg時,四管SRAM的存儲位Q的電壓,受N1脈沖電流的影響,電壓持續下降,但與上述情況不同的是,電壓下降到一定的程度(兩個LET值下,Q點電壓下降幅度不同)重新返回到4.8V,也就是Q存儲位的電壓受脈沖電流影響,在一極短的時間內下降,然后迅速返回到初始值,證實四管SRAM并未發生單粒子翻轉。
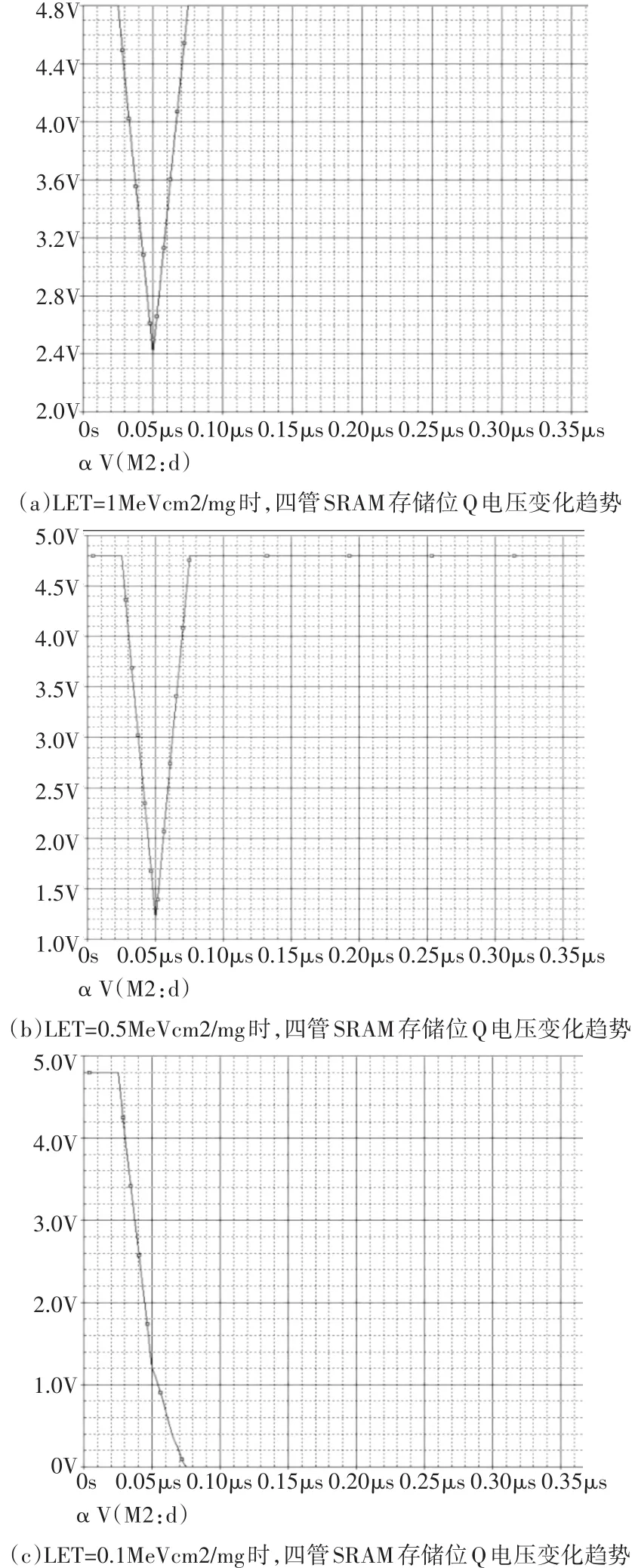
圖5 四管SRAM單粒子翻轉仿真結果
與上述傳統六管SRAM仿真結果進行對比分析可以得出,無論是傳統的六管SRAM存儲單元還是四管SRAM存儲單元,均在中子的LET值為1MeVcm2/mg時,發生了單粒子翻轉,但兩個SRAM存儲單元在結構上存在比較大的差別,主要是結構的組成以及MOS管的工藝尺寸。為了更好地進行對比分析,可以仿真LET=0.8MeVcm2/mg時,0.18μm以及0.35μm的NMOS管受中子輻射,引起的漏極脈沖電流。具體的流程還是參照前文的整個過程,得到的兩個不同工藝尺寸NMOS管,在中子的LET值為0.8MeVcm2/mg時,其漏極產生的脈沖電流,具體仿真結果如圖6所示。
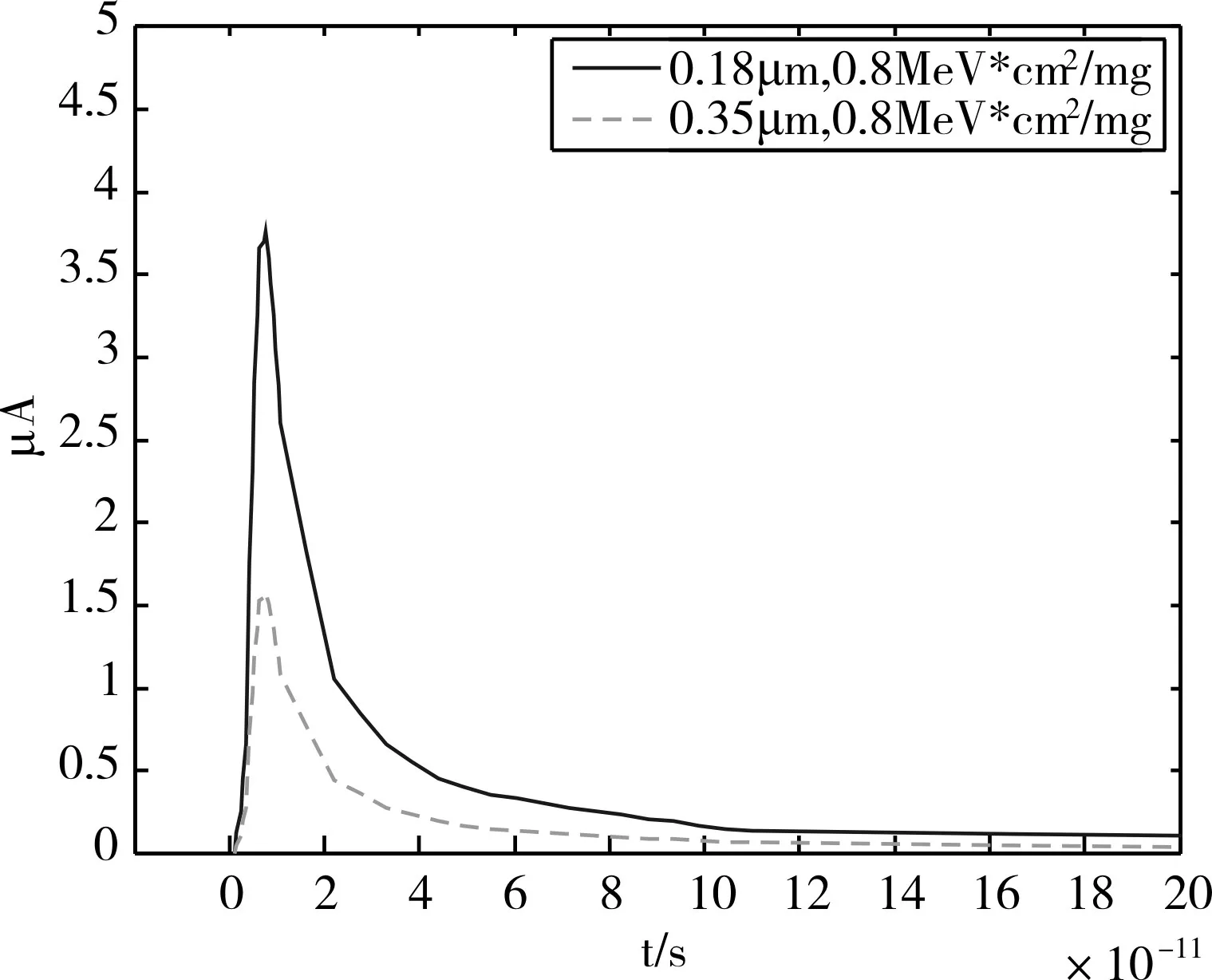
圖6 LET=0.8MeVcm2/mg時,兩種不同尺寸NMOS管漏極脈沖電流
從圖6可以看出,LET=0.8MeVcm2/mg時,0.18μm的NMOS管受中子輻射影響,引起的漏極脈沖電流明顯大于0.35的NMOS管所產生的脈沖電流,符合前文關于工藝尺寸對漏極脈沖電流的影響的論述,下面需要將這兩個脈沖電流施加到四管SRAM以及傳統六管SRAM的仿真電路中,其存儲位Q的電壓變化如圖7所示。
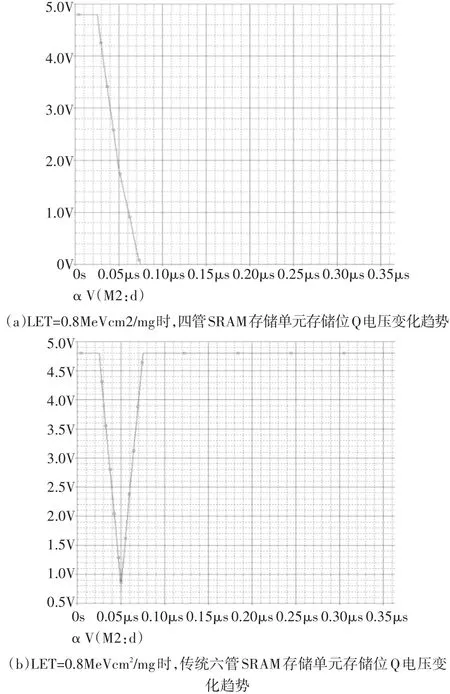
圖7 LET=0.8MeVcm2/mg時,兩種不同結構的SRAM存儲單元Q變化趨勢
從圖7中可以看出,當LET=0.8MeVcm2/mg時,四管SRAM中存儲位Q的電壓變化趨勢與傳統六管SRAM完全不同,四管SRAM中Q點受中子輻射的影響,電壓從4.8V逐漸減小到幾乎0V的狀態,最終維持在0V;而傳統六管SRAM中Q點受中子影響,電壓在極短的時間內,下降到0.8V左右,而后迅速返回到初始值4.8V。以上分析說明,當LET=0.8MeVcm2/mg時,四管SRAM存儲單元發生了單粒子翻轉,而傳統六管SRAM存儲單元并未發生單粒子翻轉。
在對六管NMOS型SRAM、改進型SRAM以及八管SRAM進行仿真對比分析后得出,六管NMOS型SRAM、改進型SRAM以及八管SRAM的存儲單元,其存儲位Q點電壓變化與傳統六管SRAM存儲單元變化一致,證明影響SRAM發生單粒翻轉的決定因素在于其組成的MOS管尺寸大小,尤其是其中負者存儲數據的NMOS管的尺寸,與電路結構關系不大。
4 結語
本文利用建模手段,模擬出五種不同結構SRAM受單粒子輻射發生翻轉的過程,通過對比仿真結果可以得出如下結論:
1)搭載在臨近空間飛行器上的FPGA,受到臨近空間中大氣中子的輻射影響,容易發生單粒子翻轉,尤其以SRAM型FPGA現象最為明顯;
2)SRAM型FPGA受大氣中子輻射影響,發生單粒子翻轉的物理過程為FPGA的存儲結構SRAM中的NMOS受中子入射影響,產生瞬態脈沖電流,影響SRAM的存儲狀態,進而影響整個FPGA的運行;
3)五種不同存儲單元結構的SRAM,受大氣中子輻射影響,其發生單粒子翻轉情況跟其組成MOS管尺寸有關,與其結構形式無關。
本文通過仿真的手段,分析得出中子輻射情況下,FPGA發生單粒子翻轉的主要影響因素,為接下來進行FPGA大氣中子輻射單粒子效應的防護提供參考,具備一定的工程參考價值。

