Pt/Au/n-InGaN肖特基接觸的電流輸運(yùn)機(jī)理?
徐峰 于國浩 鄧旭光 李軍帥 張麗 宋亮范亞明 張寶順
1)(中國科學(xué)院蘇州納米技術(shù)與納米仿生研究所,蘇州 215123)2)(南京大學(xué)揚(yáng)州光電研究院,揚(yáng)州 225009)(2018年6月19日收到;2018年9月2日收到修改稿)
基于熱電子發(fā)射和熱電子場發(fā)射模式,利用I-V方法研究了Pt/Au/n-InGaN肖特基接觸的勢壘特性和電流輸運(yùn)機(jī)理,結(jié)果表明,在不同背景載流子濃度下,Pt/Au/n-InGaN肖特基勢壘特性差異明顯.研究發(fā)現(xiàn),較低生長溫度制備的InGaN中存在的高密度施主態(tài)氮空位(VN)缺陷導(dǎo)致背景載流子濃度增高,同時(shí)通過熱電子發(fā)射模式擬合得到高背景載流子濃度的InGaN肖特基勢壘高度和理想因子與熱電子場發(fā)射模式下的結(jié)果差別很大,表明VN缺陷誘發(fā)了隧穿機(jī)理并降低了肖特基勢壘高度,相應(yīng)的隧穿電流顯著增大了肖特基勢壘總的輸運(yùn)電流,證實(shí)熱電子發(fā)射和缺陷輔助的隧穿機(jī)理共同構(gòu)成了肖特基勢壘的電流輸運(yùn)機(jī)理.低背景載流子濃度的InGaN肖特基勢壘在熱電子發(fā)射和熱電子場發(fā)射模式下擬合的結(jié)果接近一致,表明熱電子發(fā)射是其主導(dǎo)的電流輸運(yùn)機(jī)理.
1 引 言
三元合金銦鎵氮InxGa1?xN是直接帶隙半導(dǎo)體材料,通過改變金屬In的組分可使其帶隙寬度在0.7—3.4 eV的范圍內(nèi)連續(xù)變化,從而覆蓋了從近紅外到紫外的光譜區(qū)域.InGaN材料已成為制造高亮度發(fā)光二極管、高效半導(dǎo)體激光器的理想選擇,同時(shí)它在太陽電池和光電探測器等領(lǐng)域也有著非常廣泛的應(yīng)用前景[1?6].肖特基勢壘器件在高速集成電路、微波技術(shù)等領(lǐng)域有著很好的應(yīng)用前景,但I(xiàn)nGaN材料的高質(zhì)量制備問題卻限制了其肖特基器件的發(fā)展和應(yīng)用[7?10].利用金屬有機(jī)物化學(xué)氣相淀積方法制備高質(zhì)量InGaN薄膜材料的主要困難在于:InGaN表面金屬In分布不均勻[11],甚至?xí)霈F(xiàn)金屬In分凝現(xiàn)象,同時(shí)InN飽和平衡壓強(qiáng)高,分解溫度較低,In原子比Ga原子更難溶入六方晶格,導(dǎo)致InGaN材料存在大量缺陷,載流子遷移率較低[12].基于InGaN材料的肖特基勢壘的報(bào)道較少,Jang等[13]研究了不同退火溫度對(duì)Pt/n-InGaN肖特基勢壘特性的影響,Lin等[14]明確了氮化物表面氧化層的存在對(duì)肖特基勢壘高度和電子輸運(yùn)機(jī)理的影響,Wang等[15]研究了不同襯底材料下的肖特基勢壘電流輸運(yùn)機(jī)理,但上述結(jié)論所采用的肖特基勢壘質(zhì)量均不理想,同時(shí)材料中In組分均偏低,因此目前還沒有關(guān)于In組分大于10%的n-InGaN肖特基勢壘電流輸運(yùn)機(jī)理的研究報(bào)道.本文針對(duì)光伏器件設(shè)計(jì)并制備了大面積的InGaN肖特基接觸,改變生長條件調(diào)控了In組分為30%的n-InGaN的載流子濃度,通過淀積Pt/Au電極研究了n-InGaN肖特基勢壘特性,最后根據(jù)熱電子發(fā)射(thermionic emission,TE)和熱電子場發(fā)射(thermionic field emission,TFE)模式綜合分析了Pt/Au/n-InGaN肖特基的電流輸運(yùn)機(jī)理.
2 實(shí) 驗(yàn)
采用金屬有機(jī)物化學(xué)氣相淀積方法生長實(shí)驗(yàn)所用的In0.3Ga0.7N薄膜.首先在藍(lán)寶石C面襯底上低溫生長30 nm的GaN緩沖層,繼而生長2μm的高溫非故意摻雜GaN層,最后在750,730,700?C的不同反應(yīng)溫度下生長非故意摻雜InGaN薄膜樣品,分別對(duì)應(yīng)編號(hào)為A,B,C的肖特基勢壘樣品.制作金屬接觸之前,將各InGaN分別在丙酮、甲醇和乙醇中以等標(biāo)準(zhǔn)的表面清洗工藝超聲清洗3 min;淀積肖特基接觸之前,將各InGaN在濃度為10%鹽酸溶液中浸泡15 s以去除樣品表面的氧化層和可能存在的金屬In積聚.金屬接觸采用電子束蒸發(fā),歐姆電極所用金屬為Ti/Al/Ni/Au(20/120/30/50 nm),淀積后在600?C氮?dú)夥諊锌焖偻嘶?5 s;肖特基接觸采用Pt/Au(5/5 nm)金屬,面積為2 mm×2 mm.InGaN材料的In組分通過X射線衍射(X-ray diffraction,XRD)方法確定,背景載流子濃度通過范德堡霍耳效應(yīng)得到,肖特基接觸I-V電學(xué)特性采用惠普半導(dǎo)體參數(shù)測試儀測試.
3 結(jié)果與討論
首先對(duì)上述在不同生長溫度下制備的InGaN薄膜樣品進(jìn)行了XRD測試(圖1),掃描方式為ω-2θ.圖1中除了最強(qiáng)的GaN衍射峰外,還能觀察到各樣品較強(qiáng)的InGaN(0002)晶面的衍射峰.以確定實(shí)驗(yàn)所采用的InxGa1?xN薄膜中的In組分.利用Vegard定律,根據(jù)InxGa1?xN(0002)衍射峰相對(duì)于GaN(0002)衍射峰的峰位移動(dòng)計(jì)算了InxGa1?xN樣品的組分[16],并假設(shè)在GaN上外延制備的In-GaN樣品是完全弛豫的:

計(jì)算得到3個(gè)InxGa1?xN樣品In組分均為x=0.3,并且In組分偏差小于0.01,因此忽略由于In組分不同導(dǎo)致的對(duì)其肖特基勢壘特性的影響.進(jìn)一步測試得到樣品A,B和C的(0002)面搖擺曲線半峰寬(full-width half-maximum FWHM)分別為324,639和728 arcsec.通常,對(duì)于六方結(jié)構(gòu)的III族氮化物材料,可利用下式估算薄膜中的螺位錯(cuò)密度[17]:

其中Dscrew為螺位錯(cuò)密度,β為FWHM,Burgers矢量長度b=0.5185 nm. 根據(jù)測得的(0002)面搖擺曲線FWHM計(jì)算得到樣品A,B和C的In0.3Ga0.7N螺位錯(cuò)密度分別為2.09×108,8.12×108和1.05×109cm?3.

圖1 InGaN薄膜(0002)ω-2θ XRD譜Fig.1.XRD ω-2θ scans of the(0002)InGaN of samples A–C.
對(duì)各In0.3Ga0.7N樣品表面形貌進(jìn)行了原子力顯微鏡(atomic force microscope,AFM)測量(圖2),掃描范圍為5μm×5μm.可以發(fā)現(xiàn):750?C生長的In0.3Ga0.7N樣品A薄膜表面較為平整,屬于二維臺(tái)階流模式生長,表面粗糙度(RMS)為0.85 nm,而730,700?C的樣品B,C薄膜趨向于三維模式生長,表面均具有較大的晶粒起伏并且存在高密度V型位錯(cuò)缺陷坑(V-pits),表面粗糙度RMS分別為4.31,6.62 nm,較低生長溫度導(dǎo)致的低表面吸附原子遷移率使薄膜缺陷形態(tài)受動(dòng)力學(xué)控制[18].InGaN材料表面V-pits的產(chǎn)生主要是由于失配應(yīng)變使In原子向螺位錯(cuò)周圍聚集形成金屬In團(tuán)簇,In團(tuán)簇作為異面活性劑使(11ˉ20)晶面的表面能低于(0001)面,從而促使了V-pits的形成[19,20].綜合XRD和AFM的測試結(jié)果可知,較低生長溫度導(dǎo)致的高密度螺位錯(cuò)缺陷對(duì)InGaN材料的晶體質(zhì)量和表面形貌均具有較為顯著的影響.
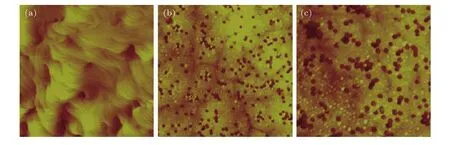
圖2 In0.3Ga0.7N樣品(a)A,(b)B,(c)C的AFM照片F(xiàn)ig.2.AFM surface morphology images of In0.3Ga0.7N(a)A,(b)B,(c)C.
室溫下通過Hall測試研究了In0.3Ga0.7N薄膜的電學(xué)性質(zhì),測得樣品A,B,C的InGaN載流子濃度分別是8.7×1016,5.7×1018和1.9×1019cm?3(圖3).從圖3可以看出,700?C生長的InGaN樣品背景載流子濃度比750?C的增加了兩個(gè)數(shù)量級(jí),Lee等[21]的報(bào)道中也發(fā)現(xiàn)了類似現(xiàn)象,這主要是因?yàn)樽鳛榈吹腘H3在相對(duì)低溫下分解效率較低,導(dǎo)致反應(yīng)氣氛中具有反應(yīng)活性的N濃度不足,出現(xiàn)In:N化學(xué)配比大于1的現(xiàn)象,從而形成高密度的施主態(tài)氮空位(VN)缺陷,顯著增加了InGaN的背景載流子濃度;同時(shí),與VN缺陷相關(guān)的高密度螺位錯(cuò)會(huì)在InGaN中進(jìn)一步作為導(dǎo)電路徑,極大地降低了InGaN的電阻率[22].另一方面,較高的生長溫度能夠壓制VN缺陷的形成[23],抑制了InGaN的背景載流子濃度.

圖3 InGaN樣品載流子濃度隨生長溫度的變化Fig.3.Variation of n-InGaN carrier concentration as a function of growth temperature.
通過TE和TFE模式進(jìn)一步擬合分析了各In-GaN肖特基勢壘的電流輸運(yùn)機(jī)理.TE模式僅考慮TE機(jī)理,TFE模式則包含了TE和隧穿機(jī)理.通常,當(dāng)InGaN材料缺陷密度大于一定值(Ndefect>1019cm?3)時(shí),需考慮肖特基勢壘界面隧穿機(jī)理的作用[12],隧穿機(jī)理極大地影響了肖特基接觸的勢壘特性[24].
在TE和TFE模式下對(duì)各InGaN樣品肖特基勢壘I-V實(shí)驗(yàn)數(shù)據(jù)進(jìn)行擬合,得到了肖特基勢壘高度和理想因子(n)隨載流子濃度的變化.圖4是根據(jù)TE和TFE模式對(duì)I-V數(shù)據(jù)的擬合曲線,擬合結(jié)果和Jang等[13]的研究數(shù)據(jù)列于表1中.TE和TFE模式的電流-電壓特性表達(dá)式分別為[22]

其中,I,V分別為肖特基勢壘正向電流和正向偏壓;肖特基勢壘面積S=2×10?2cm?2;n-In0.3Ga0.7N薄膜樣品有效理查遜常數(shù)A??=4qk2m?/h3=21 A·cm?2·K?2;k是玻爾茲曼常數(shù);q是電荷量;?B是有效勢壘高度;E0是隧穿系數(shù);理想因子Nc是導(dǎo)帶態(tài)密度.
通常,隧穿機(jī)理的形成與氧、VN缺陷相關(guān)的表面態(tài)以及界面氧化層有關(guān)[14],它會(huì)降低肖特基勢壘高度并增大理想因子[24].在TE模式下,擬合得到樣品A肖特基接觸的勢壘高度和理想因子分別是1.04 eV和1.10,非常接近于TFE模式擬合的結(jié)果(1.15 eV和1.05).肖特基勢壘理想因子的正常范圍在1.0—1.3[13],上述擬合結(jié)果表明樣品A肖特基勢壘輸運(yùn)電流中的隧穿成分極少,VN相關(guān)表面態(tài)對(duì)勢壘電流輸運(yùn)機(jī)理的影響可忽略.因此,利用低背景載流子濃度InGaN材料制備的肖特基接觸中,TE是其主導(dǎo)的載流子輸運(yùn)機(jī)理.同時(shí)實(shí)驗(yàn)結(jié)果也驗(yàn)證了預(yù)先的有機(jī)溶液清洗和化學(xué)處理能夠有效去除界面氧化層.在圖4(a)中,當(dāng)正向電壓V超過0.22 V時(shí),I-V特性逐漸偏離了原來的線形關(guān)系,這種偏離是由于異質(zhì)結(jié)構(gòu)和歐姆接觸的串聯(lián)電阻造成的.
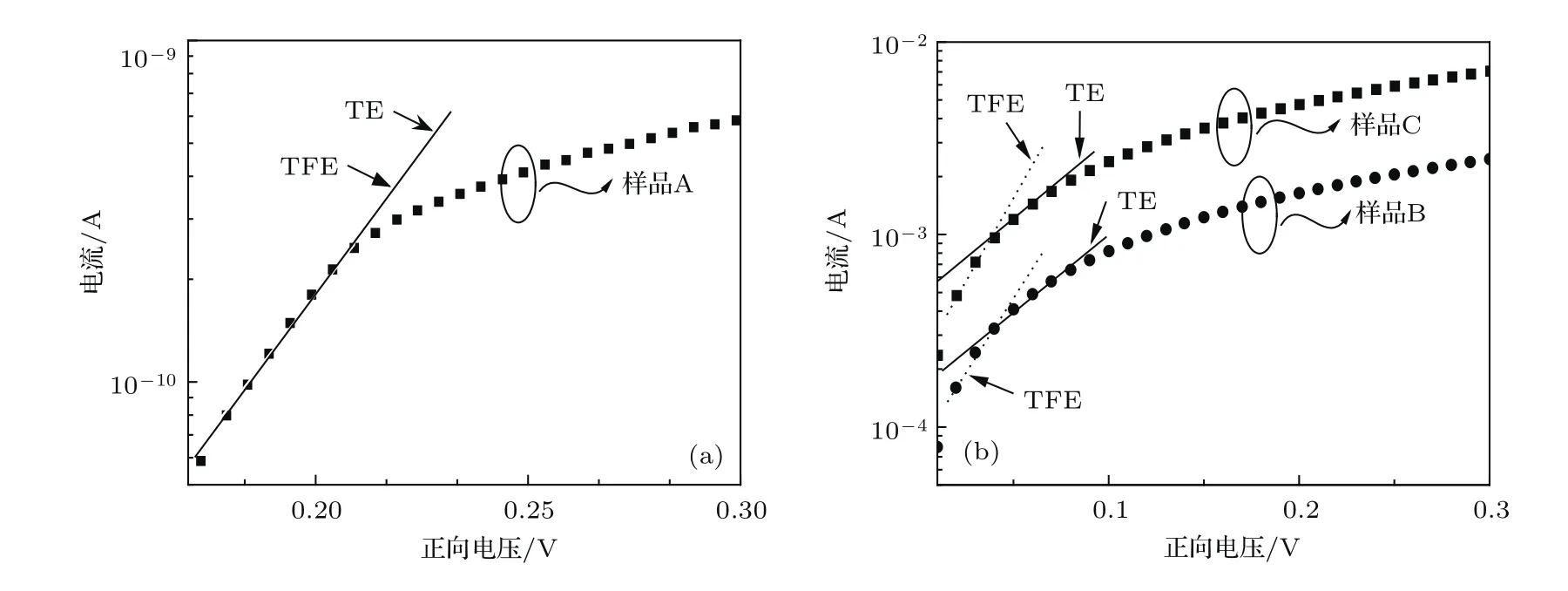
圖4 InGaN肖特基勢壘I-V擬合圖 (a)樣品A;(b)樣品B和CFig.4.Forward I-V characteristics of Schottky barrier:(a)sample A;(b)sample B and C.

表1 TE和TFE模式下Pt/Au/n-InGaN肖特基勢壘特性Table 1.Summary of characteristics of Schottky contact on n-InGaN obtained using TE and TFE models.
相比于樣品A,利用高背景載流子濃度InGaN材料制備的肖特基接觸樣品B和C在TE和TFE兩種模式下的勢壘高度值均出現(xiàn)了明顯減小,同時(shí)它們的理想因子擬合值均遠(yuǎn)超過1,表明InGaN樣品高密度VN缺陷導(dǎo)致其肖特基勢壘性能發(fā)生了衰減,肖特基接觸中存在VN缺陷輔助的隧穿機(jī)理[25].如表1數(shù)據(jù)所示,隧穿機(jī)理使TFE模式下的勢壘有效高度遠(yuǎn)大于TE模式下的擬合值,并且TFE模式下的qE0/kT值均接近1,更證實(shí)了肖特基勢壘輸運(yùn)電流中存在隧穿電流成分[26].因此,VN缺陷輔助的隧穿機(jī)理和TE綜合構(gòu)成了高背景載流子濃度InGaN肖特基勢壘的電流輸運(yùn)機(jī)理.
在表1中,各InGaN肖特基勢壘高度隨背景載流子濃度的增加而減小,并且在圖4中可觀察到樣品B和C的總輸運(yùn)電流明顯大于樣品A,這是由于高密度VN缺陷提高了背景載流子濃度,增加的載流子通過隧穿機(jī)理穿越勢壘,形成隧穿電流增加了總輸運(yùn)電流.Hashizume等[27]研究認(rèn)為非故意的表面施主缺陷會(huì)降低勢壘,從而增加通過勢壘的漏電流.另外,通過與Jang等[13]的低In組分In0.1Ga0.9N的工作對(duì)比發(fā)現(xiàn),InGaN材料中In組分越高,隨生長溫度降低,VN缺陷增加得越快,隧穿效應(yīng)會(huì)進(jìn)一步增強(qiáng),因此高In組分InGaN肖特基勢壘隧穿效應(yīng)更為明顯.
如圖5所示,在?4 V偏壓下,肖特基接觸樣品B和C的暗電流大小比樣品A的暗電流大5個(gè)量級(jí),這主要?dú)w因于InGaN高密度VN缺陷導(dǎo)致的勢壘高度降低.通常暗電流的大小對(duì)肖特基勢壘高度非常敏感,因此,InGaN表面缺陷密度的控制對(duì)Pt/Au/InGaN肖特基勢壘的性能提升以及高質(zhì)量肖特基光電子和光伏器件的制備至為重要.

圖5 Pt/Au/InGaN肖特基接觸的反向I-V特性Fig.5.Reverse I-V characteristics of Pt/Au/InGaN Schottky contacts.
4 結(jié) 論
本文對(duì)n-In0.3Ga0.7N薄膜上的Pt/Au肖特基勢壘進(jìn)行了I-V測試,利用TE和TFE模式研究了Pt/Au/n-In0.3Ga0.7N肖特基勢壘在不同背景載流子濃度下的電流輸運(yùn)機(jī)理,研究發(fā)現(xiàn),利用低背景載流子濃度InGaN材料制備的肖特基接觸中,未出現(xiàn)由于VN缺陷導(dǎo)致的隧穿電流,TE是其主導(dǎo)的電流輸運(yùn)機(jī)理;較低溫度下生長的InGaN薄膜的載流子濃度由于高密度施主態(tài)VN缺陷而呈現(xiàn)指數(shù)增加,在利用高背景載流子濃度InGaN材料制備的肖特基接觸中,高密度VN缺陷惡化肖特基接觸的勢壘特性,導(dǎo)致肖特基勢壘有效高度降低,使TE和缺陷輔助的隧穿機(jī)理共同構(gòu)成了肖特基勢壘的電流輸運(yùn)機(jī)理,隧穿電流的存在顯著增加了通過肖特基勢壘的總輸運(yùn)電流.

