MBE生長GaAsBi過程中Bi組分對背景雜質含量的影響
張 凡, 潘文武, 王利娟, 張焱超, 宋禹忻, 張立瑤, 吳曉燕, 王庶民,4*
(1. 中國科學院 上海微系統與信息技術研究所, 上海 200050; 2. 上海科技大學 物質科學與技術學院, 上海 201210;3. 中國科學院大學, 北京 100190; 4. 查爾姆斯理工大學 微技術和納米科學系, 瑞典 哥德堡 41296)
眾所周知,半導體晶體一般都含有各種各樣的雜質,如:C、H、O、N等.這些雜質的存在將會影響原子的周期性勢場,從而在半導體禁帶中引入雜質能級,影響材料的電學和光學性質.從已有的研究結果發現,在AlGaAs材料中,O作為一種深能級非輻射受主陷阱,會減小輻射效率[1-2].在GaAs中,如果有C的存在,晶格會發生收縮[3].在InGaNAs量子阱中,N的引入會使發光效率減小[4].而在P型GaAs中,H可以充當淺受主雜質的鈍化層[5].
分子束外延(MBE)作為一種高端的外延技術,被廣泛地應用在高質量半導體異質結構和納米結構材料的生長中.雖然MBE工作在超高真空的環境下,但是通過MBE腔體中的殘余氣體分析儀(RGA)發現,在MBE背景真空中仍然有許多殘留氣體和其他的元素.圖1是在用DCA P600 MBE系統生長砷化物時,觀測到的一幅比較典型的RGA圖譜.在圖中可以看到,有氫氣(相對分子質量2)、氮氣(相對分子質量28)、砷(相對分子質量75)和As2(相對分子質量150)等的峰.在一個密閉且不漏氣的MBE腔室中,通常情況下不存在氧氣(相對分子質量32),但是如果鋁源和砷源等源材料不純凈,那么腔室中就可能會引入氧氣.此外,MBE設備中的金屬構件,在加熱條件下會釋放出碳.

圖 1 生長砷化物時,MBE中典型的RGA圖譜
低溫生長時,這些雜質粒子的碰撞黏附效率會增加,從而影響半導體材料的質量.比如,在用MBE設備生長GaAs/AlGaAs量子阱材料時,高的背景雜質含量就會導致二維電子氣遷移率的下降,并且出現顯著的各向異性傳輸[6].
含鉍半導體有許多特殊的性質,比如:較大的帶隙收縮、帶隙對溫度不敏感、非常大的自旋分裂能以及表面活性劑效應等[7-12].因此,含鉍化合物半導體在近些年受到了越來越多的關注和研究.然而,鉍原子相對其它V族元素而言,原子半徑大而且鍵能弱,所以要想在半導體中摻入適當組分的鉍,就需要采用相對較低的生長溫度,通常在350 ℃以下[13].在這么低的生長溫度下,雜質的含量也會增加.研究發現,當摻入的鉍組分不高時,材料中電子和空穴的遷移率幾乎不受影響[14-16].但是,在相同的生長溫度下,GaAsBi、InPBi和GaSbBi體材料的光致發光強度(PL)相對于沒有鉍的情況,會有顯著的增強[17-19].摻入鉍可以提高材料光學質量的原因目前尚不清楚.有很多可能的原因,Segercrantz等[20]用正電子湮沒的方法證實了引入鉍可以減小三族的空位,從而減小材料的本征缺陷,提高材料質量.也有研究人員提出,局域態的存在是使GaAsBi獲得強PL的可能原因之一[21],但是對于高質量的稀鉍材料,沒有觀察到S型溫度依賴性的PL,表明局域態是可以忽略不計的[22].此外,已有的研究表明,背景雜質碳和氧可以影響半導體材料(AlGaAs)的PL強度[1,23].那么鉍的引入是否會減小背景雜質的含量,從而改進材料的質量呢?本文詳細研究了MBE外延生長GaAsBi過程中,鉍的摻入對外延材料中背景雜質含量分布的影響.
1 樣品生長與測試
實驗所用樣品是在半絕緣GaAs(001)襯底上使用P600固態源MBE系統外延生長所得.GaAs(Bi)的生長速率為0.4 mL/s,生長溫度通過熱電偶來進行監控.Ga、As2和Bi的等效束流壓力(BEP)通過一個可伸縮的離子規來測量.在樣品結構中設計了兩個區域,用來研究鉍對界面處和體內雜質含量的影響.圖2展示了樣品結構和生長細節的信息.首先,在720 ℃條件下,生長了100 nm厚的GaAs緩沖層,接著在500 ℃條件下,生長了500 nm厚的GaAs,每層厚度100 nm,在每層之間,生長停頓30 min.在層和層的界面處,As2源和Bi源閘板的開關具有不同的狀態,用以研究背景雜質(C、H、O、N)在界面處的吸附作用.在生長中斷期間,通過控制As源和Bi源的開關來研究鉍和砷對于界面處背景雜質含量的影響.之后,進行GaAs1-xBix的外延生長,各層鉍的含量分別為x=0.05,0.03,0.00,0.01.另外,為了校準鉍源的溫度,保證生長溫度穩定在一個相對較低的溫度條件下(410 ℃),在各層之間有5 min的生長停頓.最后,外延150 nm厚的GaAs覆蓋層,用以防止氧化.GaAs1-xBix樣品的結構特性,通過配備了四晶Ge(220)單色儀的高分辨率X射線衍射儀(HRXRD)測量分析.背景雜質含量的分布則通過EAG公司的Adapt 1010 SIMS設備測試獲得.偵測極限大于1010at/cm3.
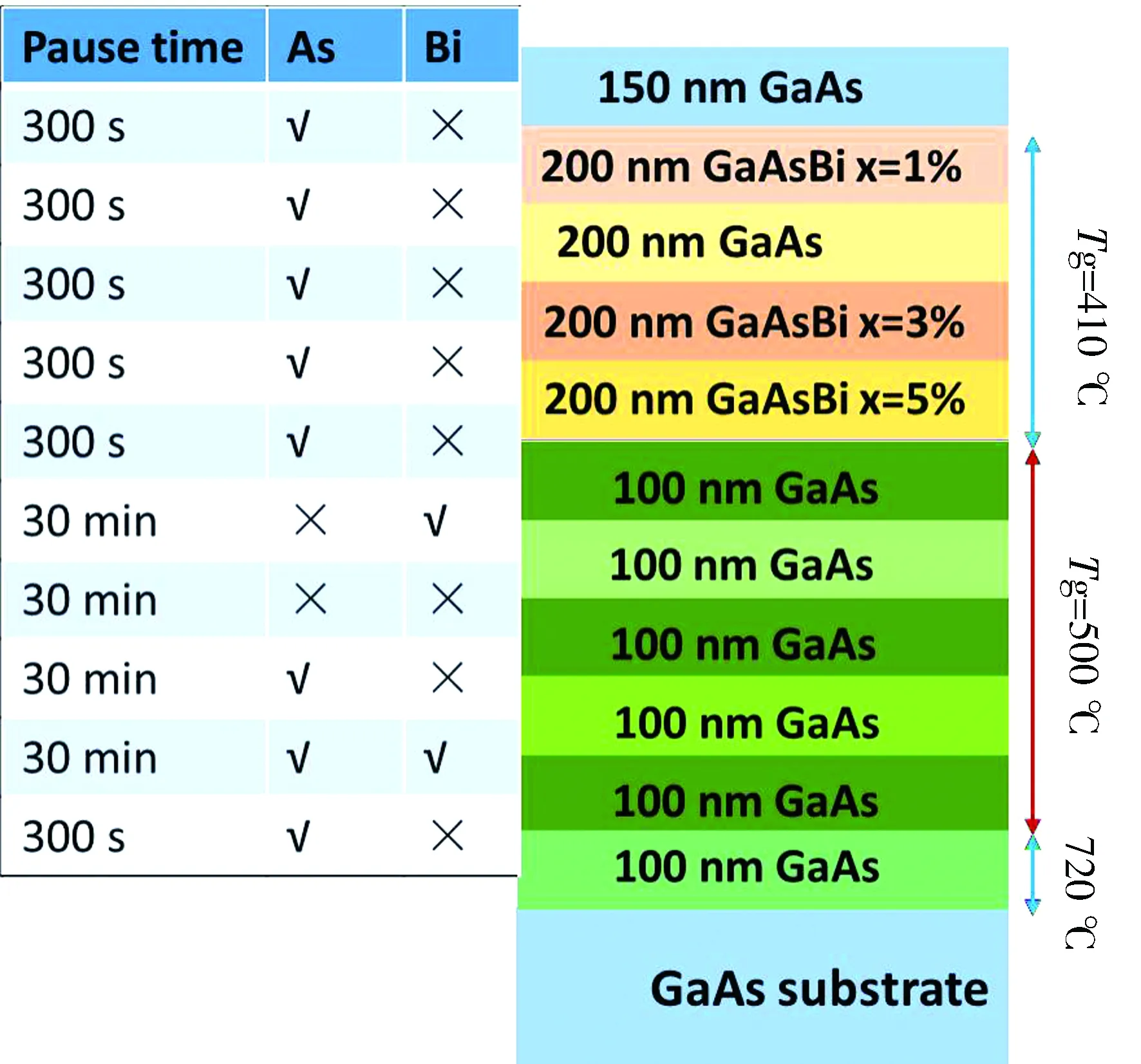
圖 2 GaAs1-xBix的樣品結構

圖 3 GaAs1-xBix樣品(004)和(115)晶面的高分辨率X射線衍射搖擺曲線測試譜
圖3是GaAs1-xBix樣品的HRXRD(004)和(115)晶面的ω-2θ搖擺曲線測試圖.圖中最右邊的峰為襯底峰,半峰寬約為20″.左邊的幾個峰為外延層的峰.x=0.01的峰和右側GaAs襯底的峰有部分交疊.通過對搖擺曲線的模擬分析可得到摻入鉍的組分,模擬分析時,GaBi的晶格常數采用0.632 nm[7].根據對稱的(004)晶面和非對稱的(115)晶面掃描結果分析,GaAs1-xBix樣品x=1%,3%,5%各外延層相對于襯底完全應變.
2 實驗結果與討論
使用二次離子質譜來分析背景雜質的含量分布.圖4為GaAsBi樣品中碳和鉍含量隨深度的分布圖.深度分辨率小于5 nm.紅色實線代表鉍含量的分布隨深度的變化.黑色實線表示碳的含量隨深度的變化.藍色和紫色虛線表示界面.在深度1 500 nm即襯底的位置處,可以看到有一個比較高的C的峰位.如圖4中藍色實線所示,當生長溫度從720 ℃降低到500 ℃再到410 ℃時,相應的背景雜質碳含量的平均值也依次從(2.4±0.8)×1015cm-3變化到(4.6±0.4)×1015cm-3和(4.1±0.5)×1015cm-3.表1為在不同停頓界面處As源和Bi源閘板開關狀態.在生長中斷了30 min的0~4共5個界面處,沒有發現明顯的碳含量的變化.GaAs1-xBix中x在0.01和0.03時,鉍的含量分布比較均勻,但是當x為0.05時,靠近GaAs1-xBix表面處鉍的組分下降比較明顯.這一現象很有可能是因為由于存在鉍的液滴而產生的鉍的表面偏析作用所致.和碳的分布曲線對比,可以發現,在鉍和碳之間存在比較明顯的關聯性.如圖5所示,黑色實線表示不摻鉍時背景雜質碳隨生長溫度的變化.紅色實線表示生長溫度為410 ℃時,不同摻鉍濃度對背景雜質碳的影響.碳雜質濃度隨生長溫度降低而升高,在500 ℃以下趨于飽和.摻入鉍可以減小背景雜質碳的含量,而且,碳含量的下降與鉍含量的增加呈現一定的正比例關系.當摻入鉍的組分為0%、1%、3%、5%時,背景雜質碳的平均含量依次為(4.1±0.5)×1015、(3.1±0.7)×1015、(2.8±0.8)×1015和(2.5±0.8)×1015cm-3.在410 ℃條件下生長的GaAs0.95Bi0.05中背景雜質碳的含量幾乎和生長溫度為720 ℃的GaAs中碳的含量一樣,說明,摻鉍可以顯著降低背景碳摻雜.
如圖6和7所示,可以發現鉍含量的分布和氧含量的分布曲線也呈現類似的現象.同樣的,在GaAs襯底的位置,可以發現氧的峰值已經達到飽和.隨著生長溫度的下降,雜質氧的含量明顯增加.實驗發現,氧的峰值大小和生長中斷的時間長短相一致,在有30 min生長中斷的4個界面(1~4)處,氧的峰強度很接近,沒有太大變化,而在生長停頓時間只有6 min的界面0處,氧的峰值比界面1~4要小.在襯底以上的600 nm GaAs外延層中,上面的300 nm厚的GaAs層可以觀察到氧峰位的凹陷,在中間的200 nm厚的外延層中,可以觀察到氧峰位的凸起.對比圖2所示的樣品結構,可以發現,由于中間的200 nm厚的GaAs在生長時As源打開,且在界面處有30 min的生長中斷,從As源釋放出了氧,所以可以觀察到比較高的氧的峰位.圖7為氧含量的分布與鉍組分以及溫度的關系圖,可以發現,當生長溫度從720 ℃下降到500 ℃和410 ℃時,氧含量的平均值從(3.1±0.9)×1015cm-3增加到(6.4±0.4)×1015cm-3和(1.9±0.3)×1016cm-3.當摻入鉍的組分到3%時,背景雜質氧的含量基本沒太大變化,然而當鉍的組分增加到5%時,氧的含量下降到1×1016cm-3以下.

圖 4 在GaAs襯底上外延生長的GaAs1-xBix中碳含量和鉍含量的SIMS測試分布曲線圖

表 1 在不同停頓界面處As源和Bi源閘板開關狀態
背景雜質氫的分布和鉍的含量之間沒有像氧、碳和鉍那樣具有明顯的相關性,如圖8所示,當摻鉍組分0%~1%時,氫的含量比較高,而當生長溫度為500 ℃或者摻鉍組分超過3%時,氫的含量都在比較低的層級.在x=5%的外延層中出現的氫峰和鉍的液滴相關,表明鉍原子的累積可能會俘獲氫原子.

圖 5 碳含量分布與鉍含量以及溫度變化的關系圖

圖 6 在GaAs襯底上外延生長的GaAs1-xBix中氧含量和鉍含量的SIMS測試分布曲線圖

圖 7 氧含量的分布與鉍組分以及溫度的關系圖
通過SIMS測試獲得的鉍含量和氮含量分布的關系圖如圖9所示.從圖示中可以觀察到一個非常有意思的現象:氮含量的分布與鉍的分布高度相關.不管生長溫度和鉍的組分如何變化,鉍含量的變化和氮含量的變化始終保持步調一致.鉍的組分增加,氮的含量也增加,鉍的組分減小,氮的含量也減小.但是在生長停頓的幾個界面處,打開鉍源,對于界面處氮含量沒有明顯的影響.

圖 8 在GaAs襯底上外延生長的GaAs1-xBix中氫含量和鉍含量的SIMS測試分布曲線圖

圖9 在GaAs襯底上外延生長的GaAs1-xBix中氮含量和鉍含量的SIMS測試分布曲線圖
上述現象表明,由于應變補償效應的影響,鉍的引入可以促進氮的凝入.鉍原子半徑比較大,當在GaAs中摻入鉍時,會產生一定的壓應變.氮原子半徑比較小,如果在GaAsBi中引入氮,可以補償鉍產生的壓應變.
圖10展示了一個可解釋氮和鉍之間應變補償的替換模型示意圖.在用MBE外延材料時,生長溫度往往都在幾百攝氏度,甚至更高,氮氣很容易從腔體和源爐當中釋放出來,因此腔體中存在有圖1所示的氮氣分子,而且N—N鍵的鍵能比較大.很難將氮氣分子中的N—N鍵斷裂為氮原子,因此幾乎不存在N原子替換Ga或者As的位置.實際上,在相對較低溫條件下,以比較低的As/Ga束流比生長GaAsBi時,會產生大量的Ga空位[24-25],氮氣分子就比較容易填滿這些位置,補償由鉍的引入產生的大應變.
3 結束語
在用MBE生長GaAs樣品時,鉍的引入可以在一定程度上影響背景雜質的含量.降低生長溫度會增強背景雜質碳和氧的引入量級.當摻入的鉍組分超過3%時,可以明顯減小C和O的含量,但是對于氫的分布卻沒有影響.實驗發現了鉍和氮的分布呈現很強的相關性,并確認是由于應變補償造成的.在同樣的MBE生長條件下,和GaAs相比,GaAsBi具有更強的光學和輸運特性,一個很可能的原因就是鉍的引入使GaAs材料中碳和氧含量下降.

圖 10 可能的氮的替位模型

