基于GaN同質(zhì)襯底的高遷移率AlGaN/GaN HEMT材料?
張志榮房玉龍尹甲運(yùn)郭艷敏王波王元?jiǎng)偫罴烟J偉立高楠?jiǎng)⑴骜T志紅
1)(專用集成電路國家級(jí)重點(diǎn)實(shí)驗(yàn)室,河北半導(dǎo)體研究所,石家莊 050051)
2)(中國航天標(biāo)準(zhǔn)化與產(chǎn)品保證研究所,北京 100071)
1 引 言
GaN材料具有禁帶寬度大、電子飽和漂移速度高和介電常數(shù)小等特點(diǎn),在高頻、大功率電子器件應(yīng)用方面具有巨大的潛力[1?3].目前,GaN材料主要通過在SiC,Si和藍(lán)寶石等異質(zhì)襯底上外延獲得,受限于異質(zhì)襯底與外延層之間晶格失配和熱失配,GaN外延材料位錯(cuò)密度高達(dá)108—1010cm?2,嚴(yán)重影響器件性能和壽命[4].GaN襯底晶格常數(shù)和熱膨脹系數(shù)與外延材料完全匹配,位錯(cuò)密度可低至105cm?2,有利于獲得高質(zhì)量GaN材料及高性能器件[5?7].近年來,基于GaN襯底同質(zhì)外延AlGaN/GaN高電子遷移率晶體管(high electron mobility transistors,HEMT)逐漸引起人們的廣泛關(guān)注.
GaN表面極易吸附C,O,Si等雜質(zhì),引起GaN緩沖層背景載流子濃度增多[8?10],導(dǎo)致Al-GaN/GaN HEMT器件漏電,是GaN襯底同質(zhì)外延AlGaN/GaN HEMT材料的瓶頸.Koblmüller等[11]通過分子束外延方法生長(zhǎng)了AlGaN/GaN HEMT,使用GaN生長(zhǎng)/分解的交替過程去除表面的C,O雜質(zhì),獲得清潔的生長(zhǎng)界面,界面C,O雜質(zhì)濃度低于1×1017cm?3.金屬有機(jī)化學(xué)氣相沉積(metal-organic chemical vapor deposition,MOCVD)是生長(zhǎng)AlGaN/GaN HEMT材料的常用方法,通常在生長(zhǎng)前采用H2高溫預(yù)處理去除表面雜質(zhì)[12],可以減少襯底表面雜質(zhì)對(duì)外延材料的影響.然而,H2在高溫下(>800?C)會(huì)刻蝕GaN襯底,粗化襯底表面[13?15],影響HEMT材料的外延材料粗糙度,降低AlGaN/GaN HEMT材料二維電子氣(two-dimensional electron gas,2DEG)的遷移率[16].Chen等[17]使用MOCVD同質(zhì)外延AlGaN/GaN HEMT,在升溫過程中采用“兩步法”,利用低速率生長(zhǎng)的GaN緩解H2對(duì)GaN表面的刻蝕,獲得平滑的襯底表面和外延材料表面,Al-GaN/GaN HEMT材料2DEG達(dá)到2068 cm2/V…s,具有良好的電學(xué)性能,但生長(zhǎng)界面的O含量高達(dá)1×1020cm?3.NH3能抑制GaN在高溫下分解,保護(hù)GaN表面.Detchprohm等[18]在GaN襯底上生長(zhǎng)InGaN/GaN光電二極管,升溫過程中引入NH3保護(hù)襯底表面,生長(zhǎng)的LED材料表面光滑,表面粗糙度(root-mean-square,RMS)為0.373 nm(5μm×5μm),但NH3對(duì)GaN表面雜質(zhì)刻蝕作用較弱.
為降低襯底表面雜質(zhì)污染物對(duì)外延材料性能的影響,同時(shí)避免粗糙表面,本文采用NH3/H2混合氣體和H2交替氣氛熱處理的方式預(yù)處理GaN表面,研究了交替氣氛熱處理過程中H2熱處理時(shí)間對(duì)GaN表面刻蝕以及材料性能的影響,同時(shí)研究了2DEG遷移率變化的物理機(jī)理.將此方法應(yīng)用在半絕緣GaN襯底上,獲得了表面形貌良好的AlGaN/GaN HEMT材料,2DEG遷移率大于2100 cm2/V…s.
2 實(shí) 驗(yàn)
使用MOCVD設(shè)備在2英寸(0001)面藍(lán)寶石襯底上生長(zhǎng)了GaN模板材料,GaN厚度2μm,X射線單晶衍射(002)面和(102)面搖擺曲線半高寬分別為240 arcsec和330 arcsec.襯底預(yù)處理具體過程如圖1(a)所示.首先在N2氣氛中升溫至800?C,通入NH3以避免GaN分解;然后繼續(xù)升溫至1030?C,N2切換為H2并保持恒溫5 min;停止通入NH3,在H2中保持恒溫0—3 min,最后繼續(xù)通入NH3.整個(gè)熱處理過程為10 min.分別以三甲基鎵(TMG)、三甲基鋁(TMA)和NH3作為Ga源、Al源和N源,H2為載氣,在GaN模板和GaN襯底上生長(zhǎng)AlGaN/GaN HEMT結(jié)構(gòu),如圖1(b)所示.所用2 inch半絕緣GaN襯底,厚度為360μm,電阻率大于1×106?…cm.
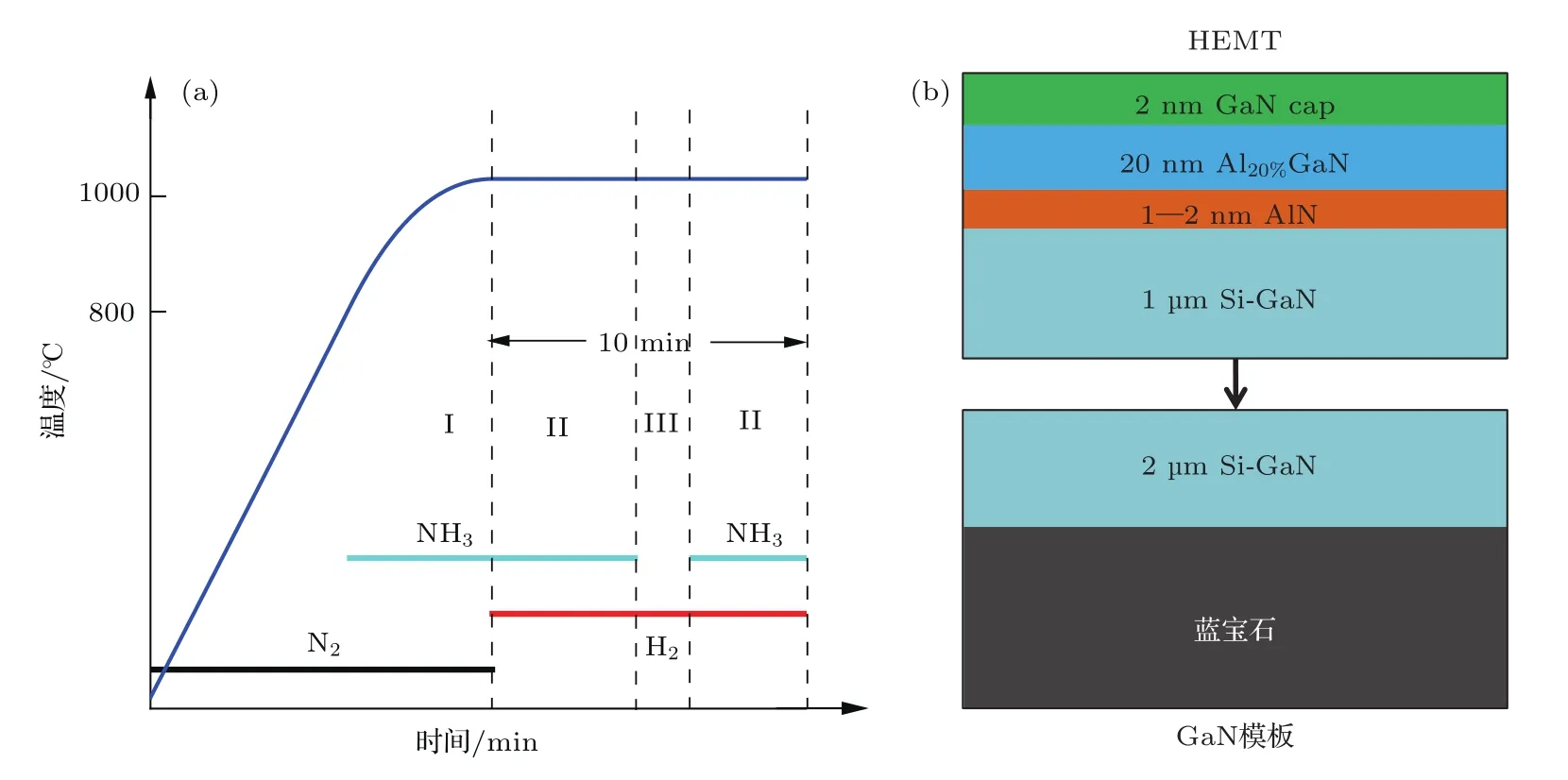
圖1 (a)熱處理過程示意圖,包括N2升溫(I);NH3/H2混合氣體熱處理(II和IV);H2熱處理(III);(b)GaN模板生長(zhǎng)AlGaN/GaN HEMT結(jié)構(gòu)示意圖Fig.1.(a)Illustration of thermal treatment process,conclude temperature ramping process in N2(I),thermal treatment process in NH3/H2mixed gas(II and IV)and H2Gas(III);(b)illustration of AlGaN/GaN HEMT structure on GaN templates.
使用光學(xué)顯微鏡(optical microscope,OM)和原子力顯微鏡(atomic force microscope,AFM)觀察GaN模板和AlGaN HEMT結(jié)構(gòu)的表面形貌;使用霍爾測(cè)試儀測(cè)試AlGaN/GaN HEMT結(jié)構(gòu)2DEG遷移率;使用光熒光譜儀(photoluminescence,PL)表征常溫下(300 K)AlGaN/GaN HEMT結(jié)構(gòu)光學(xué)性能,激發(fā)光源為325 nm He-Cd光器;使用X射線衍射儀(X-ray diffraction,XRD)測(cè)量同質(zhì)外延GaN材料(002)面和(102)面搖擺曲線半高寬;使用二次離子質(zhì)譜(secondary ion mass spectrometry,SIMS)分析GaN襯底與外延層生長(zhǎng)界面的C,O雜質(zhì)濃度.
3 結(jié)果與討論
為了觀察NH3/H2混合氣體和H2交替氣氛熱處理對(duì)GaN表面的影響,熱處理過程結(jié)束后反應(yīng)室立即停止加熱并冷卻至室溫,圖2(a)—(d)分別為熱處理前及H2熱處理0,1和3 min的GaN表面OM圖.圖2(a)與圖2(b)中GaN表面光滑,且外延厚度一致,表明完全的NH3/H2混合氣體高溫下沒有刻蝕GaN表面或刻蝕程度較小;圖2(c)中模板表面出現(xiàn)密集的點(diǎn)狀坑,說明高溫下H2會(huì)刻蝕GaN表面;圖2(d)中模板表面出現(xiàn)網(wǎng)狀凹坑,這是由于H2熱處理時(shí)間加長(zhǎng),加劇了GaN表面刻蝕,使GaN表面出現(xiàn)較大的網(wǎng)狀坑.圖3(a)—(d)分別為熱處理前及H2熱處理0,1和3 min的GaN AFM圖.圖3(a)—(c)中,GaN表面平整,臺(tái)階清晰,表面粗糙度較小(如表1),說明1 min時(shí)間以內(nèi)的H2熱處理對(duì)GaN表面形貌影響較小;圖3(d)出現(xiàn)明顯的亮色區(qū)和暗色區(qū),分別代表表面的凸起和凹陷,且表面粗糙度急劇變大,這與OM圖相對(duì)應(yīng),說明長(zhǎng)時(shí)間的H2熱處理嚴(yán)重刻蝕GaN表面,導(dǎo)致模板表面粗糙不平.
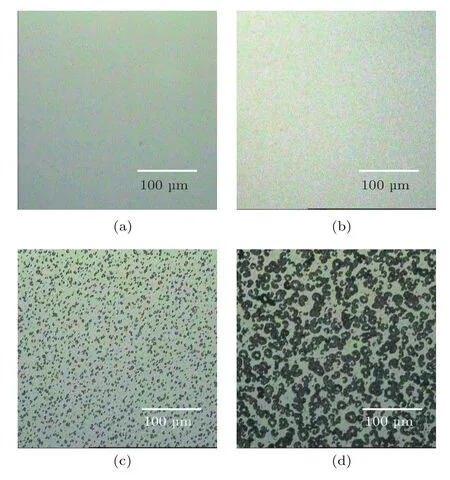
圖2 GaN表面OM形貌 (a)熱處理前;(b)—(d)H2熱處理0,1和3 minFig.2.OM morphologies of GaN templates before(a)and after thermal treatment with H2treatment 0 minute(b),1 minute(c)and 3 minutes(d),respectively.
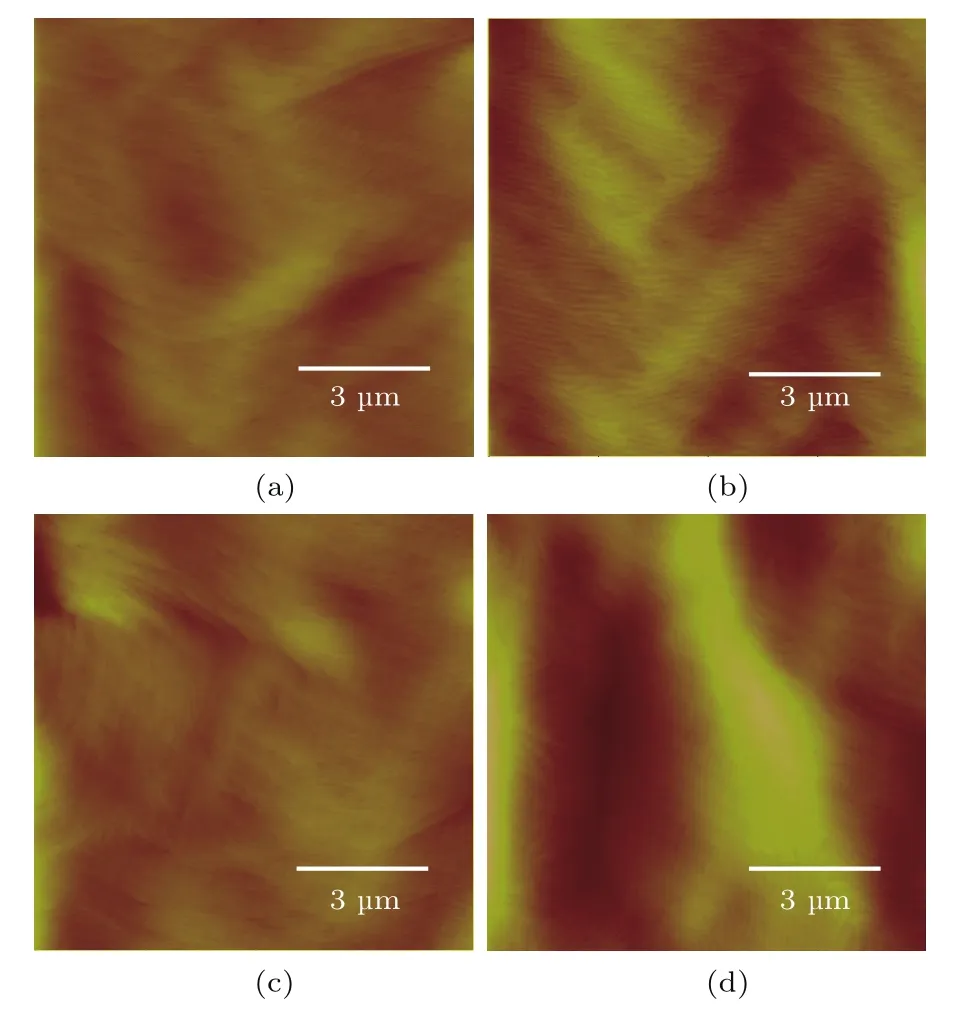
圖3 GaN表面AFM(10μm×10μm)形貌 (a)熱處理前,(b)—(d)H2熱處理0,1和3 minFig.3.AFM(10μm×10μm)morphologies of GaN templates before(a)and after thermal treatment with H2treatment 0 minute(b),1 minute(c)and 3 minutes(d),respectively.

表1 熱處理后的GaN模板及原位生長(zhǎng)AlGaN/GaN HEMT材料參數(shù)Table 1.Properties of GaN template after thermal treatment andin-situgrowth AlGaN/GaN HEMT structures.
采用交替氣氛模式熱處理GaN模板并原位生長(zhǎng)AlGaN/GaN HEMT結(jié)構(gòu),熱處理過程中H2時(shí)間分別為0,1,3 min,樣品記為A,B,C.圖4為AlGaN/GaN HEMT表面AFM形貌.圖4(a)顯示AlGaN/GaN HEMT表面平滑,RMS<0.5 nm;圖4(b)中AlGaN/GaN HEMT表面出現(xiàn)坑狀與丘陵?duì)钚蚊?表面粗糙度增大;圖4(c)中表面出現(xiàn)明顯的凸起與凹陷,甚至出現(xiàn)深坑(黑色區(qū)域),已不能滿足器件工藝要求.對(duì)比GaN模板和Al-GaN/GaN HEMT表面形貌,隨H2熱處理時(shí)間延長(zhǎng),AlGaN/GaN HEMT結(jié)構(gòu)的表面形貌與GaN模板的表面形貌變化一致.說明隨著H2熱處理時(shí)間延長(zhǎng),模板表面GaN刻蝕程度增大.H2熱處理時(shí)間達(dá)到3 min后,GaN表面粗糙不平,導(dǎo)致AlGaN/GaN HEMT材料表面形貌嚴(yán)重惡化.圖4(d)—(f)為樣品A,B,C掃描范圍為2μm×2μm 的表面AFM形貌,從圖4(d)和圖4(e)中可以看到明顯的GaN臺(tái)階流生長(zhǎng)形貌,說明在H2熱處理1 min內(nèi)的GaN模板上生長(zhǎng)了高質(zhì)量的Al-GaN/GaN HEMT材料.而經(jīng)過3 min H2熱處理的模板表面由于受到刻蝕程度嚴(yán)重,生長(zhǎng)的Al-GaN/GaN HEMT材料表面粗糙不平,如圖4(f)所示.

圖4 AlGaN/GaN HEMT表面AFM (a)—(c)分別為熱處理過程中H2處理0,1和3 min 10μm×10μm圖;(d)—(f)為對(duì)應(yīng)2μm×2μm 圖Fig.4.AFM morphologies of AlGaN/GaN HEMT surfaces:(a)–(c)are the 10 μm×10 μm morphologies with H2treatment time are 0 minute,1 minute and 3 minutes in thermal treatment process,respectively,as(d)–(f)are corresponding 2μm×2μm morphologies.
使用霍爾測(cè)試儀測(cè)試了AlGaN/GaN HEMT 2DEG遷移率.采用交替氣氛模式處理GaN模板表面,H2時(shí)間為1 min時(shí)生長(zhǎng)的AlGaN/GaN HEMT遷移率明顯高于H2時(shí)間為0 min和3 min時(shí)的遷移率,如圖5所示.根據(jù)文獻(xiàn)[8,10]報(bào)道,GaN表面極易吸附空氣中的C,O等雜質(zhì),影響材料及器件性能.高溫下H2刻蝕GaN,表面雜質(zhì)發(fā)生解吸附,有利于提升材料質(zhì)量,改善遷移率;但是長(zhǎng)時(shí)間H2熱處理會(huì)加劇GaN分解,GaN表面粗化使得界面散射加劇,2DEG遷移率急劇降低[19].經(jīng)過1 min的H2熱處理,GaN模板表面的雜質(zhì)濃度降低,獲得清潔表面;同時(shí)H2刻蝕GaN表面時(shí)間較短,避免形成粗糙表面,生長(zhǎng)AlGaN/GaN HEMT后表面平整,材料性能提高,2DEG遷移率大于2100 cm2/V…s,如表1所列.

圖5 GaN同質(zhì)外延AlGaN/GaN HEMT 2DEG遷移率Fig.5.2DEG mobility of AlGaN/GaN HEMT on a GaN homogeneous substrate.
測(cè)試了AlGaN/GaN HEMT的室溫(300 K)PL譜.圖6所示為以GaN近帶邊峰(361 nm附近)強(qiáng)度(Ib)歸一化的PL圖譜,560 nm附近的峰為黃光峰.一般認(rèn)為黃光峰的產(chǎn)生機(jī)理及黃光峰強(qiáng)度(Iy)與材料中的C,O等雜質(zhì)及相關(guān)缺陷有關(guān)[20?22].樣品A和C對(duì)應(yīng)的AlGaN/GaN HEMT黃光峰相對(duì)強(qiáng)度(Iy/Ib)遠(yuǎn)高于樣品B對(duì)應(yīng)的AlGaN/GaN HEMT黃光峰相對(duì)強(qiáng)度;樣品C中GaN帶邊峰基本不可見(如表1所列).推測(cè)認(rèn)為:1)NH3抑制了GaN表面分解,使表面吸附的C,O雜質(zhì)沒有脫附或脫附不完全,導(dǎo)致GaN外延時(shí)材料黃光峰相對(duì)強(qiáng)度較高,因此樣品A對(duì)應(yīng)的AlGaN/GaN HEMT材料的黃光峰相對(duì)強(qiáng)度較高[20,21];2)高溫下H2促進(jìn)GaN分解,模板表面吸附的雜質(zhì)脫附比較完全,因此,樣品B對(duì)應(yīng)的AlGaN/GaN HEMT材料的黃光峰相對(duì)強(qiáng)度較低;3)長(zhǎng)時(shí)間的H2刻蝕導(dǎo)致粗糙的生長(zhǎng)界面,影響GaN的生長(zhǎng)機(jī)理及晶體質(zhì)量,樣品C對(duì)應(yīng)的Al-GaN/GaN HEMT材料的GaN近帶邊峰強(qiáng)度降低,黃光峰相對(duì)強(qiáng)度增高[22].
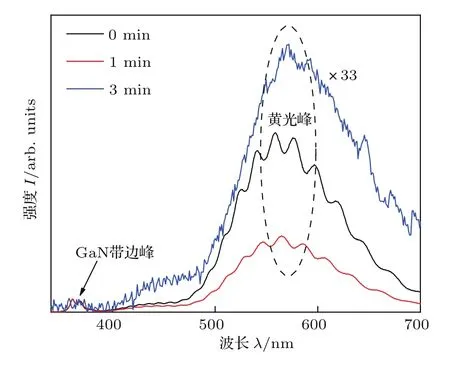
圖6 GaN同質(zhì)外延AlGaN/GaN HEMT結(jié)構(gòu)PL圖譜Fig.6.PL spectra of AlGaN/GaN HEMT on a GaN homogeneous substrate.

表2 已有報(bào)道的GaN襯底同質(zhì)外延AlGaN/GaN HEMT電學(xué)性能及本文數(shù)據(jù)Table 2.Statistical electrical properties data of Al-GaN/GaN HEMT on a GaN homogeneous substrate.

圖7 GaN同質(zhì)外延AlGaN/GaN HEMT表面AFM(2μm×2μm)Fig.7.AFM morphology(2μm×2μm)of AlGaN/GaN HEMT surface on a GaN homogeneous substrate.
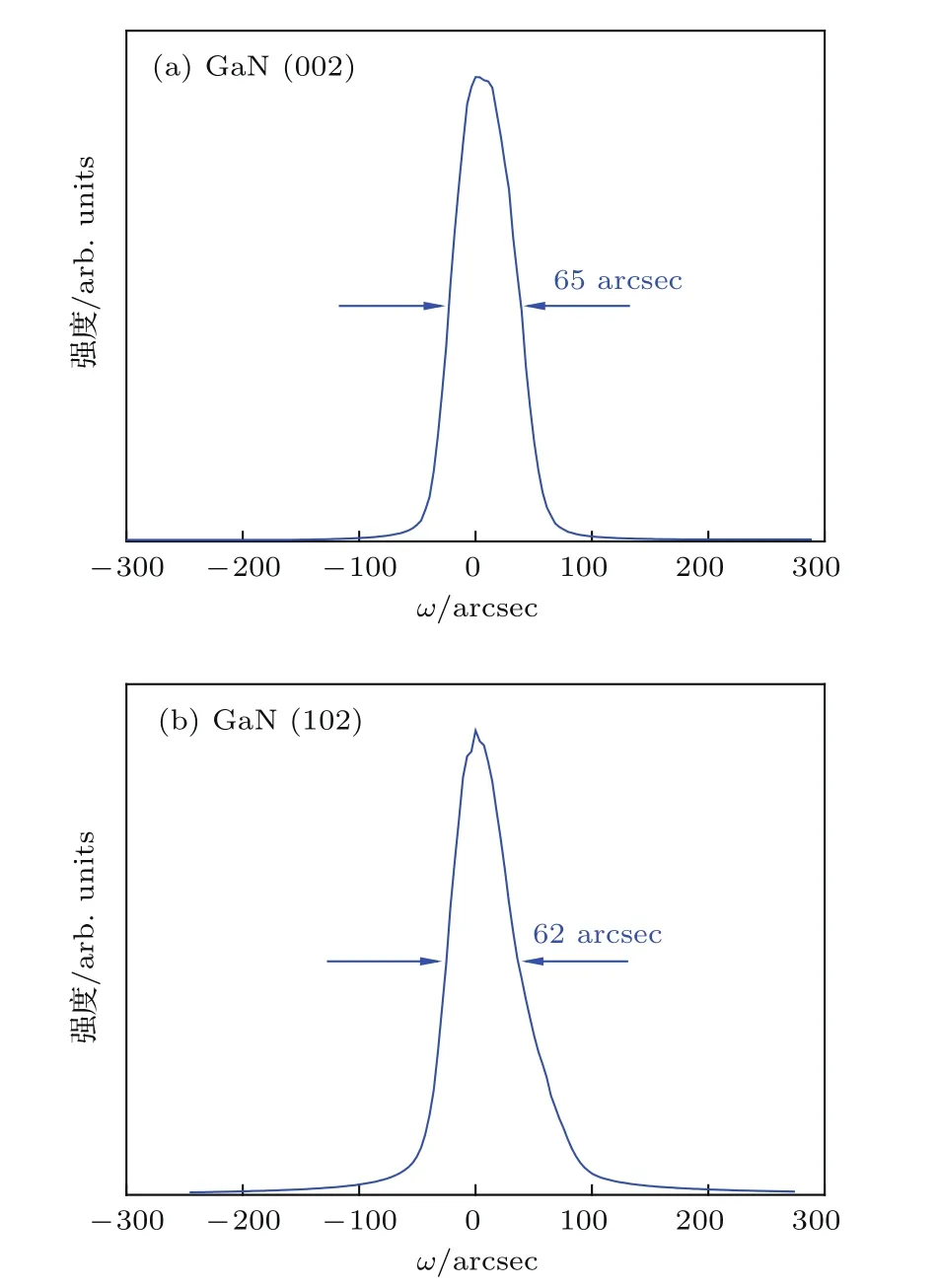
圖8 GaN同質(zhì)外延材料XRD(002)面(a)和(102)面(b)搖擺曲線Fig.8.XRD rocking curves of(002)(a)and(102)(b)peaks of the AlGaN/GaN heterostructure grown on a GaN homogeneous substrate.
在2inchGaN襯底上外延AlGaN/GaN HEMT材料,采用交替氣氛模式處理GaN襯底表面,H2時(shí)間為1 min,GaN厚度約1.4μm.圖7為GaN襯底生長(zhǎng)的AlGaN/GaN HEMT表面AFM(2μm×2μm)圖片,可以看到規(guī)則有序且平直排列的原子臺(tái)階,表面粗糙度為0.126 nm,表面質(zhì)量較高.圖8為GaN同質(zhì)外延材料(002)面和(102)面搖擺曲線,半高寬分別為65 arcsec和62 arcsec,晶體質(zhì)量高.室溫Hall測(cè)試結(jié)果中,2DEG遷移率和濃度分別為2113 cm2/V…s和9.6×1012cm?2,電學(xué)性能良好,遷移率在已有報(bào)道中最高,如表2所列.SIMS譜顯示生長(zhǎng)界面處C,O雜質(zhì)濃度分別為4×1016cm?3和9×1016cm?3,雜質(zhì)濃度低,如圖9所示.說明NH3/H2混合氣體和H2交替氣氛熱處理可以有效清潔GaN襯底表面,獲得高遷移率AlGaN/GaN HEMT材料.

圖9 GaN襯底同質(zhì)外延AlGaN/GaN HEMT中C,O雜質(zhì)SIMS譜,0μm為材料表面Fig.9.SIMS impurity prof i les of C,O in the epiwafer of an AlGaN/GaN HEMT on a GaN homogeneous substrate.The surface is located at 0μm.
4 結(jié) 論
采用NH3/H2混合氣體和H2交替氣氛熱處理的方式,分別在GaN模板和半絕緣GaN襯底上外延AlGaN/GaN HEMT材料.結(jié)果表明,H2能夠去除GaN表面C,O雜質(zhì),降低雜質(zhì)濃度,獲得清潔表面;NH3/H2混合氣體可以抑制高溫刻蝕GaN,獲得平滑的材料表面;采用NH3/H2混合氣體和H2交替氣氛熱處理襯底有利于生長(zhǎng)表面光滑、黃光峰相對(duì)強(qiáng)度較小、2DEG遷移率高的AlGaN/GaN HEMT材料.在采用該方式處理的GaN襯底上同質(zhì)外延AlGaN/GaN HEMT材料,表面平整,晶體質(zhì)量高,2DEG遷移率達(dá)到2113 cm2/V…s,具有良好的電學(xué)性能.
[1]Fang Y L,Feng Z H,Yin J Y,Zhang Z R,Lü Y J,Dun S B,Liu B,Li C M,Cai S J 2015Phys.Status Solidi B252 1006
[2]Khan M A,Kuznia J N,Olson D T,Schaf fW J 1994Appl.Phys.Lett.65 1121
[3]Fang Y L,Feng Z H,Li C M,Song X B,Yin J Y,Zhou X Y,Wang Y G,Lü Y J,Cai S J 2015Chin.Phys.Lett.32 037202
[4]Bajo M M,Hodges C,Uren M J,Kuball M 2012Appl.Phys.Lett.101 033508
[5]Iwata S,Kubo S,Konishi M,Saimei T,Kurai S,Taguchi T,Kainosho K,Yokohata A 2003Mat.Sci.Semicon.Proc.6 527
[6]Kotani J,Yamada A,Ishiguro T,Tomabechi S,Nakamura N 2016Appl.Phys.Lett.108 152109
[7]Arslan E,Alt?ndal ?,?z?elik S,Ozbay E 2009J.Appl.Phys.105 023705
[8]Lee W,Ryou J H,Yoo D,Limb J,Dupuis R D 2007Appl.Phys.Lett.90 093509
[9]OshimuraY,TakedaK,Sugiyama1T,IwayaM,Kamiyama S,Amano H,Akasaki I,Bandoh A,Udagawa T 2010Phys.Status Solidi C7 1974
[10]Demchenko D O,Diallo I C,Reshchikov M A 2016J.Appl.Phys.119 035702
[11]Koblmüller G,Chu R M,Raman A,Mishra U K,Speck J S 2010J.Appl.Phys.107 043527
[12]Bermudez V M 2004Surf.Sci.565 89
[13]Koleske D D,Wickenden A E,Henry R L,Twigg M E,Culbertson J C,Gorman R J 1998Appl.Phys.Lett.73 2018
[14]Koleske D D,Wickenden A E,Henry R L,Culbertson J C,Twigg M E 2001J.Cryst.Growth223 466
[15]Fathallah W,Boufaden T,Jani B E 2007Phys.Status Solidi C4 145
[16]Manfra M J,Pfeiffer L N,West K W,Stormer H L,Baldwin K W,Hsu J W P,Lang D V 2000Appl.Phys.Lett.77 2888
[17]Chen J T,Hsu C W,Forsberg U,Janzén E 2015J.Appl.Phys.117 085301
[18]Detchprohm T,Xia Y,Xi Y,Zhu M,Zhao W,Li Y,Schubert E F,Liu L,Tsvetkov D,Hanser D,Wetzel C 2007J.Cryst.Growth298 272
[19]Zanato D,Gokden S,Balkan N,Ridley B K,Schaf fW J 2004Semicond.Sci.Techol.19 427
[20]Reshchikov M A,Morko? H 2005J.Appl.Phys.97 061301
[21]Ryou J H,Liu J P,Zhang Y,Horne C A,Lee W,Shen S C,Dupuis R D 2008Phys.Status Solidi C5 1849
[22]Calleja E,Sánchez F J,Basak D 1997Phys.Rev.B55 4689
[23]Khan A M,Yang J W,Knap W,Frayssinet E,Hu X,Simin G,Prystawko P,Leszczynski M,Grzegory I,Porowski S,Gaska R,Shur M S,Beaumont B,Teisseire M,Neu G 2000Appl.Phys.Lett.76 3807
[24]Tomás A P,Fontserè A,Llobet J,Placidi M,Rennesson S,Baron N,Chenot S,Moreno J C,Cordier Y 2013J.Appl.Phys.113 174501
[25]Piotrowska A B,Kamińska E A,Wojtasiak W,Gwarek W,Kucharski R,Zajc M,Prystawko P,Kruszewski P,Ekielski M,Kaczmarski J,Kozubal M,Trajnerowicz A,Taube A 2016ECS Trans.75 77

