基于失效特征的靜電損傷分析研究
何勝宗,季啟政,胡 凜,王有亮,梁曉思
(1. 工業和信息化部電子第五研究所,廣東 廣州 510610;2. 北京東方計量測試研究所,北京 100086)
電子產品在生產制造過程中的靜電放電損傷是引起半導體器件失效的重要原因。產品在生產線上出現批量下線時,應當懷疑是否由于靜電放電引起。這種情況,不僅需要對生產線進行排查,而且需要對失效器件開展深入分析工作。然而,對于一般的電子制造企業而言,不具備先進的分析儀器設備和專業的人員分析能力,可能無法快速而準確地進行故障定位、確定故障原因,從而不能快速排除物料缺陷或過電損傷的因素,導致無法準確判定失效是否由靜電放電損傷引起,后續改善措施也無從下手。
對于專業分析機構而言,失效分析在靜電放電損傷方面的應用技術發展迅速,除了常規的外觀、電測、內部形貌觀察等常規手段外,一些電路模擬技術、熱點偵測、微光顯微鏡等技術對微電子器件進行失效定位[1-2],研究的對象也覆蓋了普通的CMOS集成電路[3]、隧道場效應晶體管[4]、銦鎵氧化鋅薄膜晶體管[5]、SiC MESFET[6]等類型。
這些應用技術對于推動靜電放電損傷分析具有十分重要的作用,但對于一般電子制造企業而言,一般不具備這些昂貴的分析儀器和工具,也不愿承擔較高的分析費用,仍然不能有效地指導其開展分析工作。基于此,本文從總結梳理生產制造中常見的靜電源和放電過程入手,總結了元器件靜電放電損傷的敏感結構及其靜電放電損傷的失效機理、典型形貌特征,并探討靜電損傷、EOS損傷和缺陷誘發失效的鑒別方法,最后將這些技術應用在具體的失效案例中,為一般電子制造企業開展靜電放電損傷失效的排查和分析工作提供一種有效而準確的鑒別和分析方法。
1 靜電的產生及來源
靜電是靜止不動的帶電電荷(正電荷或者負電荷),通常存在于物體表面,它是由于物體表面局部正負電荷(電子)失衡造成[7]。通常,靜電產生有三種方式:摩擦起電、界面剝離起電和感應起電。其中,摩擦起電和剝離起電主要發生在非導體材料之間,如有機聚合物、木制品、橡膠、棉花和羊毛制品、人手、玻璃等,影響的因素包括:材料特性、摩擦或接觸面積、速度、環境濕度等;感應起電主要是帶電的物體引起非導體材料感應起電。
不同靜電電位的兩個物體間靜電電荷的轉移過程就是靜電放電。靜電放電方式有接觸放電、空氣放電等。一般來說,靜電只有在發生靜電放電時,才可能會對元器件造成損傷,尤其是快速放電過程。結合企業的電子制造過程,表1給出了電子產品生產制造過程中常見的可能產生靜電的物品和器材以及對元器件影響分析結果。
2 靜電敏感結構
2.1 MOS結構
金屬氧化物半導體(Metal Oxide Semiconductor,MOS)結構是使用一層很薄的氧化物(一般是 SiO2)作為絕緣層[8],將柵與半導體襯底隔離開,也被稱為柵氧層,如圖1所示。由于柵氧層的厚度一般只有 0.1~1.5 μm,柵源極間的等效電容非常小,少量電荷在極間電容上積聚就能夠在電容兩端形成很高的電壓。一旦積聚的靜電電荷產生的電壓超過柵氧層的最大可承受擊穿電壓,柵氧層將發生擊穿。

表1 電子制造過程主要靜電源Tab.1 Main electrostatic sources during manufacturing process
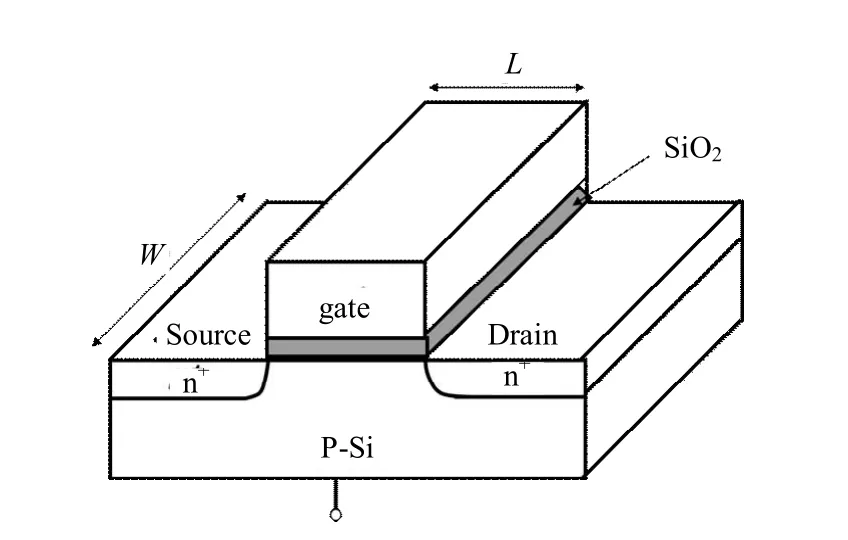
圖1 MOS典型結構圖Fig.1 Typical structure diagram of MOS
2.2 半導體結
半導體結靜電損傷機理:非本征半導體的溫度系數是正的,即溫度越高電阻越大,這可以防止低溫條件下電流積聚而形成局部熱點。但是在反偏情況下,在較窄的結耗盡層上有較大的壓降,能量主要消耗在該位置。由于幾何效應,局部電阻變化和晶體缺陷,使結區電流分布不均勻。當跨越結的兩邊發生靜電放電時,耗盡區溫度很快上升,非本征半導體材料成為本征半導體材料,引起電阻急劇下降,導致二次擊穿,使硅和金屬可以穿過結而擴散,造成局部熱擊穿失效。
半導體結對靜電的敏感程度取決于結區的幾何尺寸、圖形、電阻率、雜質程度、結電容、熱阻、反向漏電流和反向擊穿電壓等。
2.3 膜電阻器
膜電阻器的主要構成為:導電金屬氧化物(電阻體)、金屬附加劑(改善電阻特性材料)、基體(支撐載體)、玻璃燒結物(粘附襯底)等。目前,膜電阻器的靜電放電損傷機理尚無明確定論。其機理可能與靜電放電過程改變電阻膜結構,使金屬微顆粒熔融形成新的導通通路有關[7]。靜電放電發生后,其阻值往往會下降。有研究表明,膜電阻器受靜電放電影響的主要因素是靜電電壓。
2.4 金屬化條
半導體硅襯底上窄而且薄的金屬化條,因其可吸收的能量少,一旦有較大電流流過時,容易發生局部過熱,甚至導致金屬化條燒毀、開路。因此,靜電放電時的短時大電流作用是極易導致金屬化條燒毀的。金屬化條對靜電的敏感程度取決于金屬化條的材料、寬窄厚薄程度、布線結構等。
2.5 壓電晶體
主要是指石英晶體,其靜電放電損傷機理主要是靜電放電過程的瞬時大電流超過晶體的最大允許的驅動電流,造成損壞。另外,過高的電壓所產生的機械應力也可能超過晶體允許的最大限度而導致碎裂,造成性能退化而誘發失效。
3 靜電放電損傷特征分析
3.1 失效統計數據
靜電放電對半導體器件的損傷機理從本質上可分為靜電過電壓導致的場致失效和瞬時放電電流引起的熱致失效[9]。通常,ESD損傷造成的元器件失效的主要模式有:1)端口漏電、擊穿呈阻性甚至短路;2)端口特性無明顯變化,功能異常;3)重要性能參數退化;4)潛在性損傷:暫時無明顯異常,后續使用中才逐漸表現出來。靜電敏感結構主要失效機理匯總見表2。
據有關數據統計,靜電損傷/過電損傷(ESD/EOS)失效是導致半導體器件失效的主要原因,占 50%以上。而在靜電損傷的案例中,受影響最多的是CMOS類集成電路,其次是功放管和微波器件(組件)等。ESD損傷失效占比及損傷元器件種類分布如圖2所示。
3.2 ESD損傷類型及特點
靜電損傷分為突發失效和潛在失效兩種類型。突發失效是指元器件受到靜電放電損傷后,突然完全或部分喪失其規定的功能。具體表現有:PN結區被擊穿、嚴重漏電;集成電路的金屬化條或鍵合引線的熔斷;電容器介質擊穿短路;CMOS電路和MOS功率管因靜電觸發“閂鎖”燒毀等。

表2 靜電敏感結構主要失效機理匯總Tab.2 Summary of main failure mechanisms of electrostatic sensitive structures

圖2 ESD損傷失效占比及ESD損傷元器件種類分布Fig.2 ESD damage failure ratio and ESD damage component type distribution
而潛在失效指靜電放電能量較低,或放電回路有限流電阻,僅造成輕微損傷,器件電參數可能仍然合格或略有變化。主要表現為:柵氧化層損傷、柵氧化物愈合或短路、保護電路受損、電荷陷阱、PN結衰減等。潛在失效同樣對器件產生不利影響:1)使用可靠性下降,縮短預期壽命;2)電參數逐漸惡化、抗過電應力能力下降。
4 ESD、EOS與缺陷誘發失效鑒別方法
4.1 失效背景調查
通常靜電損傷發生具有一定的隨機性和持續性,而EOS損傷發生的階段可能具有一定規律性和可重復性。一般來說,EOS/ESD不具有失效器件的批次性特征,而缺陷引起的失效通常具有一定的批次性特征,而且在“合格品”中可能同樣存在潛在缺陷的跡象或趨勢。因此需關注失效發生是否具備批次性特點。另外,需調查失效發生的階段、周圍工作場景等信息,通過失效背景信息區分三種失效是分析的輔助手段。
4.2 參數測試
通常,對失效樣品需要進行參數測試,這些包括:端口I/V測試、靜態電流、功能測試等,同時會利用同批次良品進行對比。對于靜電損傷引起的失效,其參數測試結果往往與良品差異性小,而 EOS損傷的測試結果則往往差異較明顯。對于缺陷誘發的失效,則可能在大量良品測試中檢測出潛在缺陷的樣品。另外,懷疑靜電損傷的失效,則應該針對良品開展靜電敏感度等級評價測試,評估是否屬于靜電敏感類型器件,同時通過進一步解剖對比模擬失效的樣品與失效樣品之間的差異。
4.3 顯微形貌觀察和分析
通過解剖樣品,并且借助于失效定位手段:如光學顯微觀察、液晶分析法、光發射顯微分析技術(EMMI)以及激光誘導電阻變化技術(OBIRCH)、磁顯微分析以及聚焦離子束剖切(FIB)等方法定位到失效點[10-11],然后直接觀察失效的微觀物理形貌特征,是鑒別三種失效類型最直觀的方式,也是最需要經驗的一個環節。通常,從損傷后的物理微觀形貌來看,靜電損傷形貌通常比較輕微,損傷區域小,損傷點尺寸通常為微米級,或者僅有輕微損傷痕跡,相對于EOS損傷來說要輕微一些。圖3給出了典型的ESD擊穿形貌照片。對于CMOS集成電路而言,多數發生在電極或擴散區之間,往往有明顯的指向性。有時也會伴有金屬化損傷,但相對于EOS損傷來說,損傷區域及尺寸小,不會像EOS損傷那樣有較大面積的金屬化熔融和燒毀的特征[12]。而缺陷誘發的失效,往往具有失效部位和類型單一,且“合格品”中也可能存在類似缺陷。總的來說,ESD失效是EOS失效的一部分,二者之間沒有明顯分界,目前在國際上也沒有很好的方法將二者完全區分開來。在對失效樣品進行判別分析時,要采用上述三種方法進行綜合分析,才能得到較為準確的判斷。

圖3 靜電擊穿典型形貌Fig.3 Typical morphologies of electrostatic breakdown
4.4 典型分析案例
(1)樣品描述:樣品為某型號雙向收發器,陶瓷密封封裝,裝板后測試發現功能失效。委托方共提供了2只失效樣品(F1#、F2#),良品若干。
(2)背景調查:器件在裝板后測試發現功能失效(無法收發數據),排查測試過程異常電應力,未發現異常,懷疑靜電損傷。
(3)非破壞性分析:失效品外觀未見機械損傷、密封區開裂、過電或腐蝕痕跡、引腳殘留焊料。進行X-Ray觀察,均未見明顯異常。對失效品進行端口特性測試,發現失效樣品的功能引腳Pin30(2A5)對地呈現漏電特性。
(4)顯微形貌觀察:將 F1#、F2#樣品機械開封,內部芯片表面未見明顯機械損傷、過電損傷和臟污腐蝕變色等異常形貌。光發射掃描顯微鏡定位(OBIRCH模式)發現失效芯片上Pin30鍵合附近存在異常亮點,該點在激光掃描下,阻值發生變化,光發射顯微鏡探測到該阻抗變化,并標記顏色。而對正常引腳Pin33(2A3)用此方法測試則無亮點。將失效品芯片去層并進行掃描電鏡觀察,可以觀察到兩只芯片相同位置的保護管處存在擊穿熔坑,但擊穿點尺寸都較小(約1 μm)。
(5)靜電防護能力診斷:對裝配生產線進行現場診斷,發現作業過程中大量使用絕緣類包裝材料,且無有效的靜電防護措施。另一方面,查閱該器件規格書可知該器件的靜電敏感電壓(HBM模型)為1000 V,屬于靜電敏感器件。
(6)綜合分析:失效樣品芯片表面無明顯異常,光發射定位后發現端口保護網絡擊穿失效,呈現為小能量擊穿,綜合背景調查和現場診斷結果綜合判斷為靜電放電損傷引起。圖4是該失效分析案例的典型照片。
5 結論
在軍工、航空航天、通信、智能家電、電力電子、醫療電子以及軌道交通等領域電子產品中大量使用靜電敏感器件,靜電放電造成的損失不容忽視。本文通過總結電子制造過程中常見的靜電源,梳理元器件靜電放電損傷的敏感結構、機理及典型形貌特征,探討了靜電損傷、EOS損傷和缺陷誘發失效的鑒別方法,供靜電放電損傷失效分析參考應用。
針對潛在靜電損傷的電子元器件開展深入分析,可以確認損傷是否由靜電放電造成的,而非過電應力、物料缺陷或工藝不良造成的,可以幫助企業明確靜電損傷的來源、過程以及后續靜電防護整改的方向。
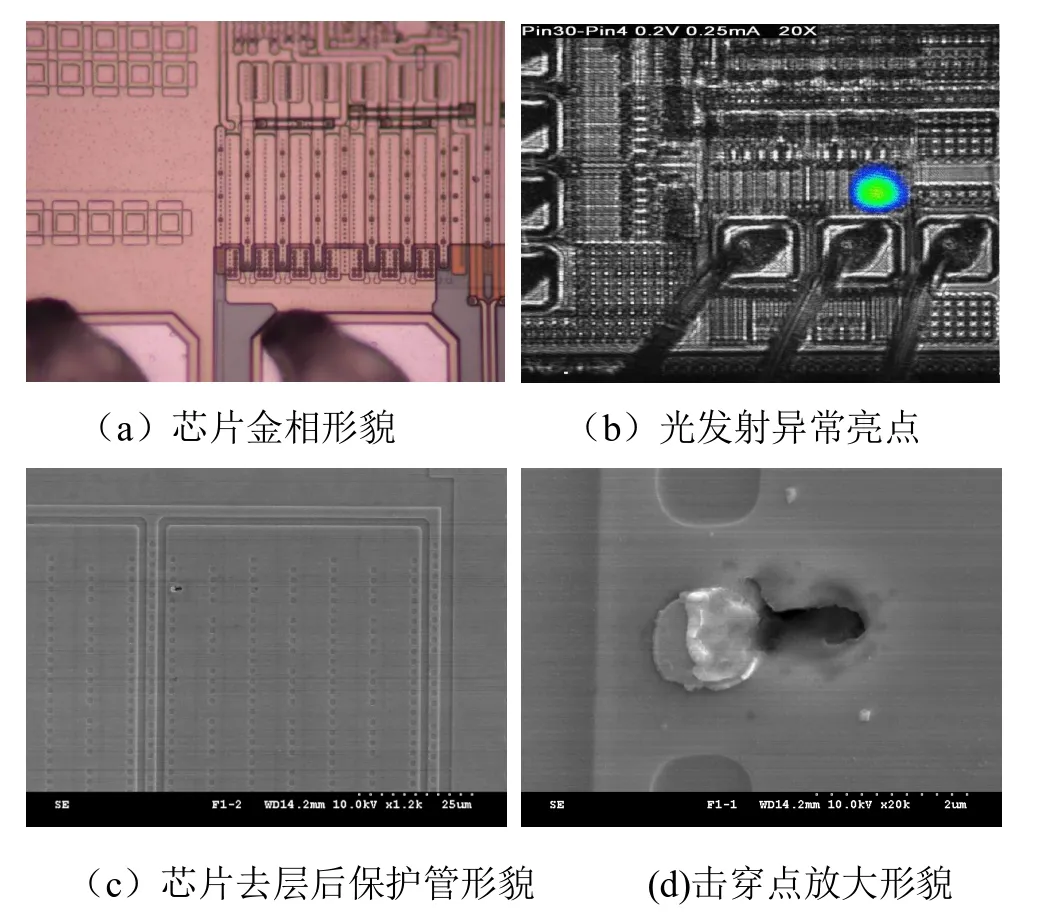
圖4 ESD損傷失效分析典型形貌Fig.4 Typical morphologies of ESD damage failure analysis
參考文獻:
[1]COLVIN J. ESD failure analysis methodology [J].Microelectron Reliab, 1998, 38: 1705-1714.
[2]PUVADA V, DUVVURY C. A simulation study of HBM failure in an internal clock buffer and the design issues for deficient power pin protection strategy [C]//EOS/ESD symposium. NY, USA: IEEE, 1998, 104-107.
[3]ALVAREZ D, ABOU-KHALIL M J, RUSS C, et al.Analysis of ESD failure mechanism in 65nm bulk CMOS ESD NMOSFETs with ESD implant [J]. Microelectron Reliab, 2006, 46(9/10/11): 1597-1602.
[4]KRANTHI, KARMEL N, SHRIVASTAVA, et al. ESD behavior of tunnel FET devices [J]. IEEE Trans Electron Device, 2017, 64(1): 28-36.
[5]LIU Y, CHEN R S, LI B, et al. Analysis of indium-zinc-oxide thin-film transistors under electrostatic discharge stress [J]. IEEE Trans Electron Device, 2017,38(11): 1-5.
[6]PHULPIN T, ISOIRD K, TREMOUILLES D, et al.Analysis of an ESD failure mechanism on a SiC MOSFET[J]. Microelectron Reliab, 2014(8): 177-182.
[7]袁亞飛. 電子工業靜電防護技術與管理 [M]. 北京: 中國宇航出版社, 2013.
[8]陳貴燦, 程軍, 張瑞智, 等. 模擬 CMOS集成電路設計[M]. 西安: 西安交通大學出版社, 2002.
[9]WANG Y L. Key techniques and their applications in failure analysis of microcircuits subjected to ESD stresses[C]// Reliability, Maintainability and Safety (ICRMS),International Conference. NY, USA: IEEE, 2014.
[10]COLVIN J. ESD failure analysis methodology [J].Microelectron Reliab, 1998, 38(11): 1705-1714.
[11]王有亮, 梁曉思, 來萍. 元器件 ESD失效分析中的關鍵技術及其應用 [C]//第五屆靜電防護與標準化國際研討會論文集. USA: 美國靜電放電協會(ESDA), 2016.
[12]工業和信息化部電子第五研究所組. 電子元器件失效分析技術 [M]. 北京: 電子工業出版社, 2015.

