正電子湮沒譜學研究半導體材料微觀結構的應用進展?
曹興忠宋力剛 靳碩學 張仁剛 王寶義 魏龍
1)(中國科學院高能物理研究所,北京 100049)
2)(武漢科技大學理學院,武漢 430000)
正電子湮沒譜學研究半導體材料微觀結構的應用進展?
曹興忠1)?宋力剛1)2)靳碩學1)張仁剛2)王寶義1)魏龍1)
1)(中國科學院高能物理研究所,北京 100049)
2)(武漢科技大學理學院,武漢 430000)
(2016年8月30日收到;2016年10月18日收到修改稿)
正電子湮沒譜學技術在研究材料微觀缺陷、微觀結構方面有著獨特的優勢,尤其是在針對陽離子空位等負電性空位型缺陷的研究中,可以獲取材料內部微觀缺陷的種類與分布的關鍵信息.正電子湮沒壽命和多普勒展寬能譜是正電子湮沒譜學的最基本的分析方法,在半導體材料的空位形成、演化機理以及分布等研究方面能夠發揮獨特的作用;此外,慢正電子束流技術在半導體薄膜材料的表面和多層膜材料的界面的微觀結構和缺陷的深度分布的研究中有廣泛的應用.通過正電子技術所得到的微觀結構和缺陷、電子密度和動量分布等信息對研究半導體微觀結構、優化半導體材料的工藝和性能等方面有著指導作用.本文綜述了正電子湮沒譜學技術在半導體材料方面的應用研究進展,主要圍繞正電子研究平臺在半導體材料微觀缺陷研究中對材料的制備工藝、熱處理、離子注入和輻照情況下,各種缺陷的微觀結構的表征及其演化行為的研究成果展開論述.
正電子湮沒譜學,半導體材料,電子(動量、密度)分布,微觀結構
1 引 言
自20世紀80年代以來,正電子湮沒譜學(positron annihilation spectroscopy,PAS)技術已廣泛用于半導體材料微觀結構的研究,該技術利用正電子的缺陷俘獲湮沒特性反映局域特性(如湮沒位置的電子密度、動量分布等信息)的特點[1,2],通過探測正電子在材料中與電子發生湮沒所釋放的γ光子攜帶的信息,獲取正電子湮沒位置的微觀結構信息.正電子湮沒譜學技術的特色分析方法和高靈敏度,使其對樣品的種類幾乎沒有限制,而且對原子尺度的電負性缺陷極為敏感,材料中缺陷周圍的電子動量和密度、化學環境等都能通過正電子在材料內的湮沒信息反映出[3],進而得到材料的微觀結構信息,因此成為材料科學微結構研究中的有效表征技術.
由制備工藝、熱處理、離子注入和輻照等導致半導體材料內產生的各種缺陷能夠強烈地影響其物理和化學特性,因此,材料內缺陷的表征對研究半導體的性能、優化材料的制備工藝等具有指導意義.從微觀上對固體內的晶體、缺陷、電子等結構進行無損探測分析,發揮了PAS的特色優勢.正電子在半導體中的湮沒過程對晶體的結構類型、缺陷的分布信息、電子動量和密度等都是十分敏感的,實驗獲取的正電子湮沒譜,結合理論計算[4]或其他表征技術,分析特定晶體結構和特定缺陷類型的正電子湮沒信息,能夠為材料微結構的分析提供有力的證據.半導體材料作為基礎材料,是現代電子產業、光伏產業等必不可少的重要材料,研究半導體材料在本征或雜質缺陷情況下的影響和變化,對于深入研究半導體的制備工藝和參數,開發電學、磁學、光學和催化等物理化學性能,開發化合物半導體材料、探索新型半導體材料的應用方面都有著重要意義.實驗測量的正電子湮沒信息可以反映半導體材料的結構、缺陷的類型和缺陷的濃度,進而為我們確定半導體材料的組成和缺陷提供重要的參考信息.
本文結合國際上在該領域的最新研究方向,主要基于正電子湮沒譜學在半導體材料微觀缺陷的應用研究進展展開論述,特別是對半導體材料制備工藝、熱處理、離子注入和輻照過程中缺陷的形成演變、電子結構的分布變化、微觀結構的演化等微觀機理和材料性能之間的相互作用等方面的研究展開深入論述.
2 正電子譜學技術簡介
正電子譜學技術主要包含正電子湮沒壽命測量、角關聯測量、多普勒展寬測量三種常規技術以及近年來發展起來的符合多普勒展寬測量技術、壽命-動量關聯譜技術、慢正電子束流技術[5].實驗室通常以放射性同位素為正電子源,其中最為常用的是22Na,半衰期為2.6年,衰變產生的正電子能量最大能達到545 keV,同時伴隨著1.28 MeV的γ光子的發射.正電子入射到材料內會在極短的時間內損失大量能量到kT量級,動量近似為0,即熱化過程.正電子與電子相互作用時,根據湮沒發生的γ光子數目的不同分為單光子湮沒、雙光子湮沒和三光子湮沒,雙光子湮沒的概率最大[6].根據動量守恒、能量守恒定理,靜止情況下的正負電子對湮沒時發出的兩條γ射線能量相等,大小為mc2,方向相反(伽瑪光子的能量單位統一為MeV).
在正電子湮沒壽命譜(PALS)測量[7]中,以22Na衰變發射的1.28 MeVγ光子的出現為起始時間,再以正負電子對湮沒產生的0.511 MeVγ光子的出現為終止時間,得到的時間間隔為正電子壽命.根據正電子在材料中的壽命值的成分與大小、強度的變化,可以得到材料中缺陷類型和相對濃度的變化信息.
正負電子湮沒時,熱化的正電子動量可忽略不計,而湮沒電子的動量,使得湮沒光子的能量相當于0.511 MeV產生多普勒能移.正電子被缺陷俘獲發生湮沒,缺陷位置的電子平均動能較低,會使多普勒寬峰變窄.正電子湮沒多普勒展寬能譜(DBS)通常以參數法來定義電子湮沒的貢獻[8,9],展寬譜的低能區與全譜面積之比定義為S參數,主要是正電子與價電子湮沒,高能區與全譜面積之比定義為W參數,主要是正電子與核芯層電子湮沒.通過S,W參數變化情況可以得到材料內缺陷的形成與運動情況.
固體材料中的電子動能通常為幾個eV,因此正負電子湮沒對的動量不為0,兩個光子的發射方向不在一條直線上,而是有一定的角度偏移.正電子湮沒角關聯譜(ACAR)通過測量正電子湮沒釋放出的伽瑪光子的角度分布,分析湮沒電子的動量分布[10,11],在晶體材料電子動量分布的研究中,用于測定湮沒電子的費米面.
正電子湮沒多普勒展寬能譜中,高動量電子的湮沒事件受噪聲影響無法充分顯示.近年來發展起來的符合多普勒展寬測量技術(CDB)[12,13],通過雙探測器分別探測兩個γ光子,以符合測量技術判選湮沒電子的有效事例,選擇γ光子的能量差作為分析多普勒展寬能譜的參數,使得高動量湮沒電子的有效事例率提高了104.
正電子湮沒多參數符合測量的另一技術正電子壽命-動量關聯技術(AMOC)通過對正電子湮沒壽命和湮沒輻射γ的多普勒展寬能譜同時進行測量[14],獲取不同正電子湮沒壽命對應的湮沒電子的動量分布信息,以及不同動量的湮沒電子所對應的正電子湮沒壽命的分布信息.
由于放射源釋放正電子的能譜分布特征決定了正電子入射到材料的深度分布,常規正電子湮沒譜學技術通常適用于表征μm-mm量級的體材料內部的微觀結構.慢正電子束流技術[15-22]采用金屬Ni,W以及固體Ne等對正電子具有負功函數的特殊材料,對放射性核素釋放的正電子,或高能粒子打靶產生的正電子進行慢化處理,形成能量單一可調的低能正電子束流.基于慢正電子束流的各種正電子湮沒譜學技術,如正電子湮沒壽命譜、多普勒展寬能譜、符合多普勒展寬能譜等,是研究薄膜材料表面和多層膜表面界面微觀缺陷的主要表征方法之一[23].本實驗室采用固體Ne作為慢化器,建立了束流強度為1×106e+/s(50 m Ci固體22Na),能量在0-30 keV能夠連續可調的慢正電子束流.
3 半導體材料微觀結構研究中的應用
半導體材料的應用基于材料電子能帶的帶隙結構.半導體材料的帶隙結構與材料的組成、形態以及質量等因素密切相關[24,25].正電子與半導體材料中的電子湮沒釋放的γ光子,攜帶了湮沒電子的動量分布信息,由于材料內部存在的電負性空位、雜質元素等微觀缺陷對正電子湮沒位置的電子密度產生影響,進而影響了半導體材料內正電子的湮沒過程和湮沒機理.而半導體材料中空位、雜質元素、微觀結構等形成的中間能帶對半導體的光電等物理性能影響顯著.因此,半導體材料制備工藝、熱處理、離子注入和輻照等實驗手段對半導體材料的微觀結構的研究,都是正電子湮沒譜學技術應用研究的熱點.
3.1 半導體材料制備工藝參數的研究
半導體材料的制備涉及物理、化學等多種實驗方法,其制備工藝和參數決定了材料的表面形貌、晶體結構、尺寸、雜質濃度等,是半導體材料性能和效能的決定性因素.例如,Liu等[26]采用不同前驅體的水熱法制備二氧化鈰納米棒,結果顯示采用CeCl3前驅體的樣品表面比采用Ce(NO3)3前驅體表面粗糙,兩種樣品的Ce價態大部分為4價,部分為3價,CO消耗結果顯示采用CeCl3前驅體制備二氧化鈰的活性與還原性大于采用Ce(NO3)3前驅體制備的二氧化鈰.在正電子湮沒壽命測量結果中,兩種樣品的τ2成分均在400-550 ns范圍內,而CeCl3前驅體樣品的τ2壽命的占比I2大于τ1壽命的占比I1.Khalid等[27]用脈沖激光沉積法在不同的N2壓力下制備ZnO薄膜,隨著N2壓力的不斷增加,ZnO的薄膜磁化強度不斷上升并在0.5 mbar達到最大值.在正電子湮沒多普勒展寬能譜中顯示在0.5 mbar N2條件生長的ZnO的S參數相比0.01和0.3 mbar情況下有顯著提高.Ma等[28]對磁控反應濺射制備的HfO2薄膜進行了研究,結果顯示隨著濺射氣氛中氧含量的增多、濺射功率的減少、濺射氣壓的降低,薄膜的光學反射系數增大,相應地,正電子湮沒多普勒展寬能譜結果顯示,薄膜的S參數逐漸增加.Wan等[29]通過熱硫化Fe薄膜制備黃鐵礦FeS2薄膜,在硫化溫度大于350°C時,硫在薄膜中易于擴散,在之后的慢正電子束多普勒展寬結果發現,在400°C硫化溫度下,S參數相比300°C有所降低,而在玻璃和硅基片上沉積的FeS2薄膜內S參數隨溫度變化基本一致,但在界面區域Si基底上樣品的S參數會突然降低,而SEM的截面形貌圖中顯示硅基片上則會出現熱擴散和外延生長所形成的過渡層.隨著溫度進一步升高到600°C時,正電子湮沒3γ衰變成分相比400°C,500°C時明顯增加.Yu等[30]對不同煅燒溫度下制備的Co3O4樣品的研究發現,200-300°C煅燒后的Co3O4在-80°C條件下對CO依然保有100%的氧化作用,在150-300°C煅燒后,樣品有著類似的比表面積,氧化50%CO所需溫度很低且基本相同,正電子湮沒壽命測量結果表明,在300°C空氣煅燒后,熱處理過程對τ1,τ2影響較小.Hao等[31]對Langmuir-Blodget自組裝法制備的TiO2/PSS進行慢正電子束多普勒測量發現正電子入射能量與雙膜層數目有線性關系,表明多層膜的重復性很好,如圖1所示.

圖1 (網刊彩色)(a)不同雙層膜納米復合體的S(E)曲線,(b)正電子入射能量與界面和基體界面處雙層膜數目關系曲線[31]Fig.1.(color online)(a)TheS-Espectra of nanocomposite films with different bilayers;(b)the incident positron energy versus the number of bilayers in the interface between the composites films and substrate[31].
半導體制備工藝過程中引入的雜質會使半導體材料內的某種載流子濃度大幅增加,使半導體的導電性能發生顯著變化.如在摻Fe的CdS的制備工藝中,Tripathi等[32]采用溶液沉淀法制備六方相CdS:Fe顆粒,發現隨著制備過程中添加的氯化鐵溶液Fe2+濃度增加,制備的CdS:Fe顆粒導電性增強,帶隙寬度逐步降低,過高的Fe2+濃度易導致冷光猝滅現象.通過正電子湮沒壽命譜確認了Fe2+濃度的提高會降低CdS:Fe顆粒的Cd空位濃度.在其他摻Fe的半導體材料的制備工藝方面,如分子束外延制備InN:Fe薄膜,Wang等[33]發現泄流室中的Fe源的溫度從1000°C上升至1180°C時,InN:Fe薄膜的電子濃度線性上升至1.2×1019cm-3,根據圖2中多普勒展寬能譜中S參數與TFe(Fe源的溫度)的非線性關系確認了Fe摻雜引入的氫氧雜質是電子濃度升高的主要因素.Yang等[34]利用正電子湮沒多普勒展寬能譜對金屬有機化學氣相沉積制備的不同Mn濃度摻雜GaN的薄膜進行測量,S-W曲線顯示未摻雜的GaN與2.8%Mn原子摻雜比的GaN的曲線均只出現一種斜率,但二者有區別.之后根據計算發現所有GaN:Mn的R參數(R= ΔS/ΔW)十分接近以及S參數-摻雜濃度曲線也呈線性變化.

圖2 (網刊彩色)不同Fe源溫度制備的InN的正電子湮沒多普勒展寬能譜S(E)曲線[33]Fig.2.(color online)Sparameters of InN as a function of positron energy in positron annihilation measurement.Dependence ofSparameter on Fe cell temperature is shown in the inset[33].
摻雜半導體的制備工藝中除單摻雜外,還有更為復雜的共摻雜情況.例如Pasang等[35]對水熱法制備的共摻雜ZnO晶體研究時,Sn4++Co2+,Ag1++Pd2+和Ag1++W6+共摻雜均引起了ZnO帶隙寬度的降低,而Sn4++Co2+共摻雜的ZnO晶體的帶隙寬度最小,大小為2.84 eV.之后根據XRD結果推測,Sn4++Co2+形成Zn替位摻雜,在參比充分退火Al的CDB結果中顯示Ag++Pd2+和Ag++W6+則形成間隙雜質.利用正電子湮沒壽命譜發現Sn4++Co2+共摻雜的ZnO的平均壽命最大,達到426 ns,且τ2的占比在30%附近.
在其他半導體材料的制備工藝中,梁立歡等[36]發現隨著腐蝕電流密度逐漸增大,多孔硅內形成了減小到一定線度的硅納米晶粒以及硅量子線,量子限制作用增強,產生的激發載流子增加,使得多孔硅發光增強.利用正電子湮沒壽命譜對陽極腐蝕法制備的多孔硅進行測量,結果顯示正電子拾取湮沒壽命τ3隨著腐蝕電流密度的增加先增大后減小,在20 mA/cm2時達到最大的7.36 ns,這與樣品光致發光強度變化一致.Padma等[37]在不同溫度的基底上生長銅酞菁(CuPc),隨著基底溫度的升高,界面層厚度也隨著升高,薄膜粗糙度會降低,通過多普勒展寬能譜測量發現在硅基底溫度為室溫時,薄膜的S參數較高;在100°C,225°C的基底溫度下,薄膜的生長方式分別為2D+和3D島狀生長,兩者在表面和界面處S參數均出現不同,但變化趨勢緩和,在靠近界面處沒有出現在基底處于室溫下時出現的獨特的界面區.在之后的次表面和近界面處的正電子湮沒壽命測量結果顯示,室溫基底條件下兩區域的平均壽命明顯不同,在100°C條件下則是相接近,而在225°C條件下出現了長壽命成分.
3.2 半導體材料的熱處理研究
熱處理是將材料放在一定的環境下加熱、保溫、冷卻,通過改變材料表面或內部的組織結構來控制其性能的一種處理工藝.半導體材料在熱處理過程中其表面或內部原子或分子得到足夠能量后會發生擴散遷移,材料的微觀結構、元素濃度梯度、應力分布等會隨之變化,半導體晶體在熱處理之后其晶體結構、晶粒尺寸、結晶性等也會發生改變.例如,Hao等[38]研究硅與二氧化硅的界面時,發現經過400°C真空退火后,O3≡Si結構存在于界面中,而經更高溫度的650°C熱處理后,O3≡Si結構消失,界面處主要為[-SiO3]2-結構,熱處理溫度達到900°C時,界面處SiOx逐漸轉變為兩種更穩定的相結構Si和SiO2,[-SiO3]2-結構減少,最后在1000°C退火情況下,[-SiO3]2-大部分分離為兩相結構.在正電子湮沒多普勒展寬測量結果中顯示,Si/SiO2樣品中有明顯的界面區,經過650°C熱處理后,界面區的S參數達到最大,在更高溫度的熱處理條件下,S參數隨溫度升高而降低(見圖3).Li等[39]利用X射線近邊吸收結構測量發現在750-1000°C真空退火1 h后的金紅石結構TiO2樣品內出現了Ti3+和氧空位,在750-900°C范圍內隨著退火溫度的升高TiO2的飽和磁化強度逐漸降低,在1000°C退火后反而顯著提高.在正電子湮沒壽命結果中顯示,在750-900°C范圍內,隨著熱處理溫度的升高正電子湮沒壽命成分τ2升高,其占比I2逐漸降低,在1000°C則τ2和I2分別降低和提高至最值.真空環境能使半導體材料在熱處理過程中避免發生變質而影響研究,在熱處理過程中通入惰性氣體對半導體材料能起到類似的保護作用.Zhan等[40]對在Ar氣氛中熱處理后的ZnO薄膜的研究發現,隨著熱處理溫度的升高,ZnO微晶尺寸增大,并沿著(0002)晶面擇優取向生長,而在750°C保溫2 h后,薄膜與基底界面處出現了厚度約為50 nm的斜方六面體結構Zn2SO4.薄膜的飽和磁化強度也隨熱處理溫度的升高而增大,并在600°C達到峰值,在750°C時由于出現了界面反應使得飽和磁化強度迅速下降,而正電子湮沒多普勒展寬能譜顯示,在Ar氣氛中經300°C和600°C熱處理后ZnO薄膜的S參數區別較小.Jia等[41]將外延法制備的重P摻雜的硅薄膜置于氮氣中進行熱處理,發現600°C退火后薄膜內電子濃度有所降低,但隨后在900°C退火后明顯提高,而正電子湮沒多普勒展寬能譜結果顯示,600°C退火后薄膜的S參數明顯高于未退火樣品,并在Si/SiO2界面處達到最大值,而900°C退火后樣品的S參數整體迅速降低.
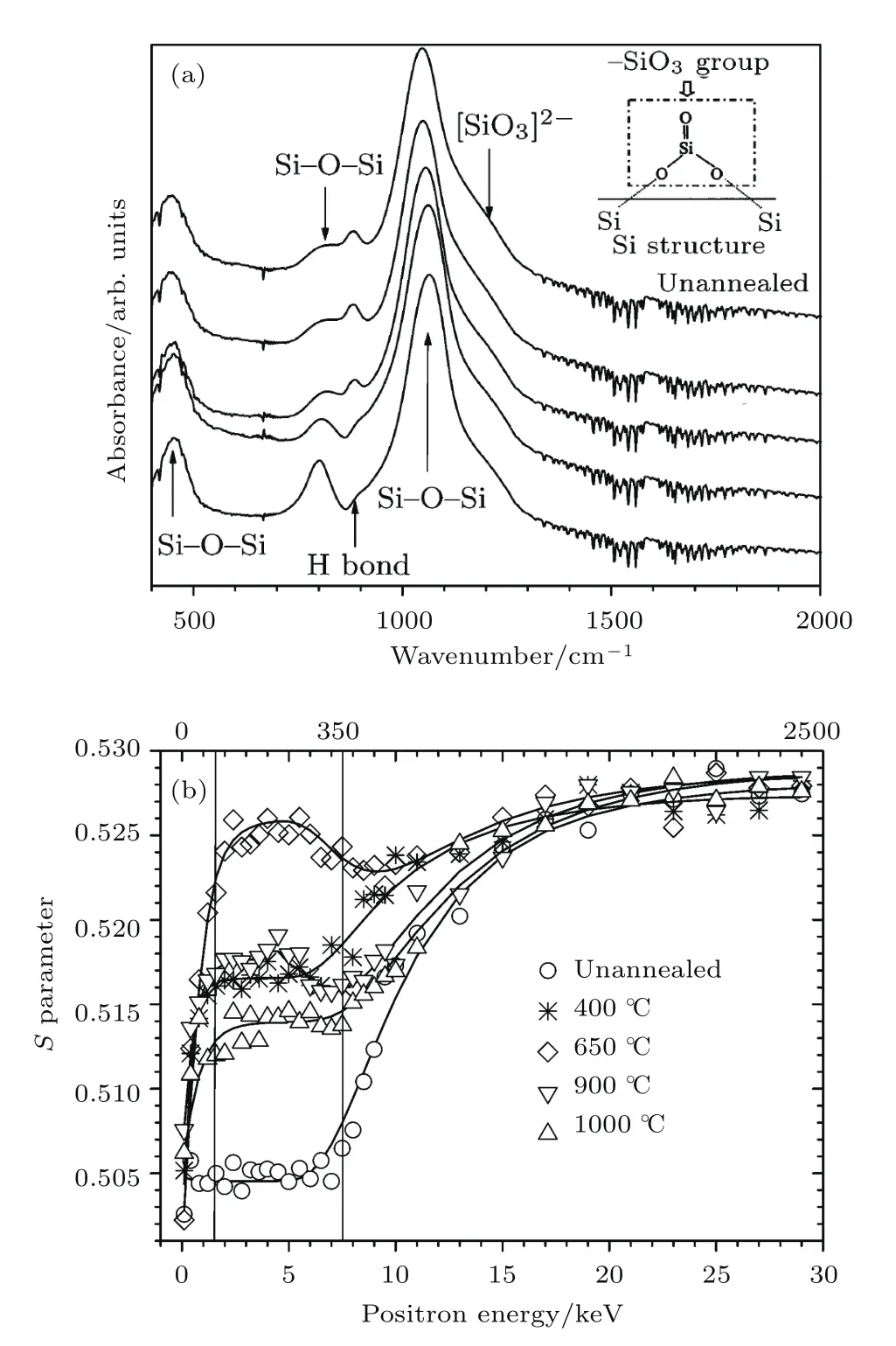
圖3 (a)SiOx/Si樣品在400?C,650?C,900?C,1000?C退火后的紅外吸收光譜;(b)SiOx/Si樣品的S(E)曲線[38]Fig.3.IR absorption of specimens unannealed and annealed at 400?C,650?C,900?C,1000?C.The illustration shows the structure of[-SiO2]2-(a);Sparameters versus incident positron energy for SiOx/Si specimens deposited by ECR-CVD(b)[38].
半導體材料的熱處理過程除了在真空和Ar氣氛等保護性環境中進行外,還有在具有化學活性的氣體環境下進行.如Ren等[42]在不同氣氛中對ZnO薄膜進行熱處理,發現同一熱處理溫度下,在氫氣氛中熱處理后ZnO薄膜的磁化強度相比在氧氣氛中熱處理后的弱,而且隨著熱處理溫度的升高,兩種樣品的氧缺失程度均增加,但ZnO薄膜的磁化強度在氧氣氛中熱處理后逐步升高,在氫氣氛中熱處理后則不斷下降.正電子湮沒多普勒展寬能譜測量結果顯示,在氧氣氛中熱處理的樣品的S參數比同溫度下在氫氣氛中熱處理的高.Lee等[43]研究了不同氣氛的熱處理對ZnSe的影響,在光致發光譜測量結果中,250°C生長的樣品出現了很強的帶邊發光峰,而在700°C H2+H2Se和二甲鋅氣氛中退火后樣品的帶邊發光峰強度相比250°C生長樣品有所降低,同溫度下氮氣氣氛中退火樣品則出現了很強的深能級發光峰,在正電子湮沒多普勒展寬能譜中H2+H2Se氣氛退火樣品在正電子能量為14-15 keV范圍內的R參數(R= ΔS/ΔW)明顯高于未退火樣品,而同范圍內,二甲鋅氣氛退火樣品的R參數比氮氣氣氛高.Yang等[44]研究Zn-MgO薄膜時,發現在氮氣氣氛中快速熱處理后的ZnMgO的近帶邊發光強度相比未熱處理樣品有顯著提高,而在氧氣氣氛熱處理后樣品的發光強度則有輕微下降,在正電子湮沒多普勒展寬能譜測量結果中,2.5-6 keV處的S參數在氮氣氣氛下退火的ZnMgO中顯著提高,而在氧氣氣氛下則會降低,如圖4所示.李卓昕等[45]對在水蒸氣和真空環境中退火后的多孔硅進行了研究,發現在水蒸氣中退火后多孔硅發光強度增大,發射峰位發生藍移;而在真空退火后,多孔硅發光性能基本未變.而圖5中的AMOC測量結果顯示,水蒸氣退火后樣品中所有正電子湮沒壽命成分S參數均降低,在0-5 ns范圍內S參數小于Si元素的特征參數,而真空退火后樣品的S參數整體減小,但在短壽命成分中未出現小于單晶硅的S參數.?edivy等[46]通過正電子湮沒技術對CdTe:Cl和CdZnTe:Ge進行了系統研究,結果顯示Te蒸氣環境退火后,CdTe:Cl的正電子湮沒壽命出現了τ3部分,值約為316-320 ps,在Cd蒸氣退火后,τ3部分約為328 ps,而CdZnTe:Ge在Te蒸氣中退火后的正電子湮沒壽命部分約為320 ps,在Cd蒸氣中退火后未出現部分,而且呈現接近體壽命值的單壽命295 ps.

圖4 (網刊彩色)原生m面ZnO,Zn0.94Mg0.06O及在氫氣氛和氧氣氛退火后Zn0.94Mg0.06O的S(E)曲線[44]Fig.4.(color online)Svalues as a function of incident positron energyEfor the samples:as-grown m-plane ZnO,Zn0.94Mg0.06O and annealed Zn0.94Mg0.06Ofilms in oxygen and nitrogen[44].
通過控制氣氛可以改變半導體材料的熱處理效果,還可利用外加磁場來達到同樣的作用,如Ning等[47]將在(100)晶向的硅基底上制備的約100 nm的c軸高度取向ZnO薄膜置于0,1,3,5,7 T的磁場強度下650°C退火2 h,薄膜的氧缺失程度與磁場有很大關聯,在3 T情況下最低,而相應的薄膜飽和磁化強度也最小,而在7 T情況下,氧缺失嚴重,而相應的飽和磁化強度最大.在正電子湮沒多普勒展寬能譜測量結果中,0,3,7 T三種樣品的S參數十分接近,S,W曲線都只出現一種斜率.
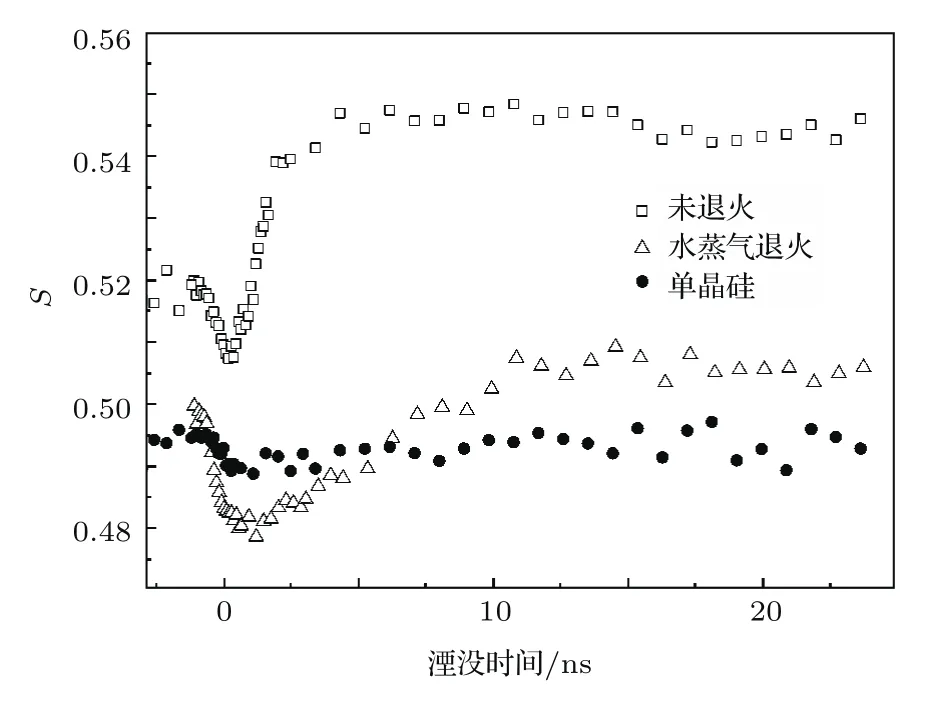
圖5 水蒸氣退火前后樣品的S參數隨正電子湮沒時間的變化[45]Fig.5.Svalues as a function of incident positron lifetime for the samples:as-grown porous silicon,annealed porous silicon in vapor,monocrystalline silicon[45].
不同材料的半導體的熱處理效果也有區別,對于摻雜半導體的熱處理,Liu等[48]研究Co摻雜SnO2稀磁氧化物時,發現經400°C,500°C真空退火后,Co離子進入了SnO2晶格內部,而Sn原子周圍的電子密度升高,其飽和磁矩由室溫的0.14μB/Co分別變為0.41μB/Co,0.21μB/Co,利用VEPFIT軟件解析Co摻雜SnO2的多普勒展寬能譜測量結果中顯示,正電子擴散長度Ld在未退火時最大,在400°C真空退火后顯著降低,而在500°C退火后有所回升.對于半導體異質結的熱處理,Zhao等[49]研究Ta/MgO/NiFe/MgO/Ta異質結的快速退火后磁電阻率增強現象時發現,在較低溫度快速退火可提高MgO層的質量,MgO區域的S參數明顯降低,這些可有效地增強磁阻效應,在高溫快速退火后,S參數會顯著提高(見圖6),磁阻效應也會進一步提高,但在550°C時隨著退火時間的延長,磁阻先升高至最大后迅速降低.Zhao等[50]還在之后的MgO層的自旋電子輸運能力研究中發現高溫退火后MgO結晶性增強并出現(111)擇優生長,雖然能提高磁阻效應,但卻限制了磁電阻率的進一步提高,S參數相對室溫明顯上升.關于有機半導體的熱處理,Maheshwari等[51]對納米酞菁素鈷CoPc研究發現,退火樣品與未退火時相比,形態發生改變并且結晶性增強,這與原子力顯微鏡的結果一致,此時S參數減小隨著退火溫度的升高,酞菁素鈷薄膜晶界增加、晶粒尺寸減小,其S參數增加.Marchiori等[52]發現熱處理對PSiF-DBT薄膜的能量轉換效率提高不明顯,在經過溫度低于200°C退火后,薄膜的分子排列并沒有顯著的改變,對薄膜空穴傳輸能力沒有增強作用,多普勒展寬能譜的S,W參數變化不明顯.
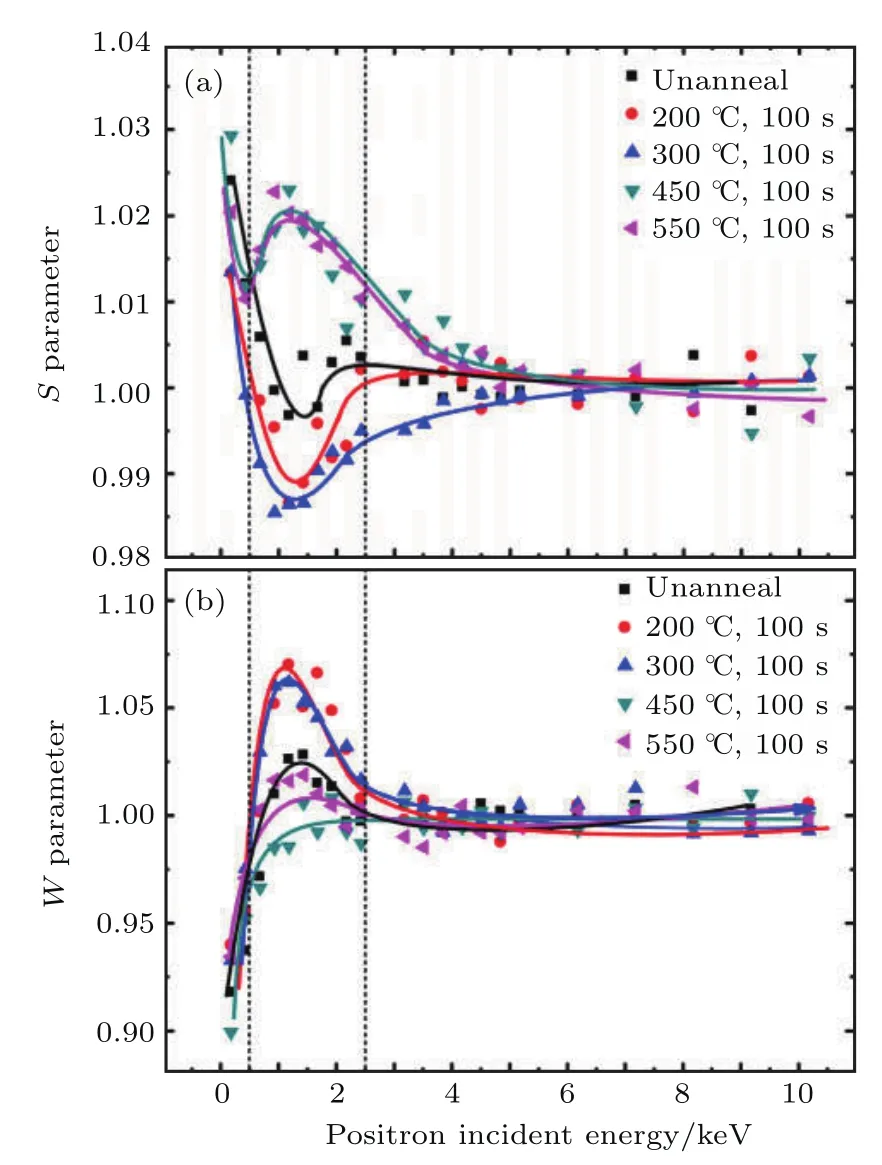
圖6 (網刊彩色)原生及不同溫度下退火的Ta/MgO/NiFe/MgO/Ta異質結的正電子湮沒多普勒展寬的S(E)(a)和W(E)(b)曲線[49]Fig.6.(color online)DopplerS-(a)andW-parameters(b)plotted vs.positron incident energy for the sample 1 in the as-deposited state and after annealing 100 s at different temperatures[49].
3.3 半導體材料的離子注入研究
離子注入作為一種重要的材料改性方法,因其能夠實現較高的離子摻雜濃度,能夠精確控制注入離子的種類、劑量和深度,已經發展成為半導體表面改性及處理的重要手段.在離子注入過程中,注入離子通過與材料的相互作用傳遞自己的能量,造成核能量損失和電子能量損失,該能量損失將導致材料的結構畸變,而注入離子損失能量后也會存留于材料內部.例如,Yu等[53]對800 keV Ge+注入p型4H-SiC進行研究,圖7中正電子湮沒多普勒展寬能譜測量顯示,Ge+注入后樣品在深度約285 nm處形成大量晶格損傷.在符合多普勒展寬能譜測量結果中顯示,即使退火溫度達到1400,樣品內也沒有明顯的Ge析出物出現.Qin等[54]利用正電子湮沒多普勒展寬測量研究Co+注入金紅石結構TiO2晶體時,發現所有Co+注入樣品的S參數相比未注入樣品迅速下降,隨著注入劑量的提高,S參數隨之增大;而在S-W曲線中出現的兩種斜率說明Co+注入樣品的表面和體相的正電子湮沒機理不同.Wei等[55]研究Be注入InP時,發現隨著注入劑量升高,S參數不斷增大.理論計算結果顯示,正電子擴散長度也隨注入劑量的升高而逐漸減小,并且材料內的正電子俘獲量與離子注入劑量呈線性關系.
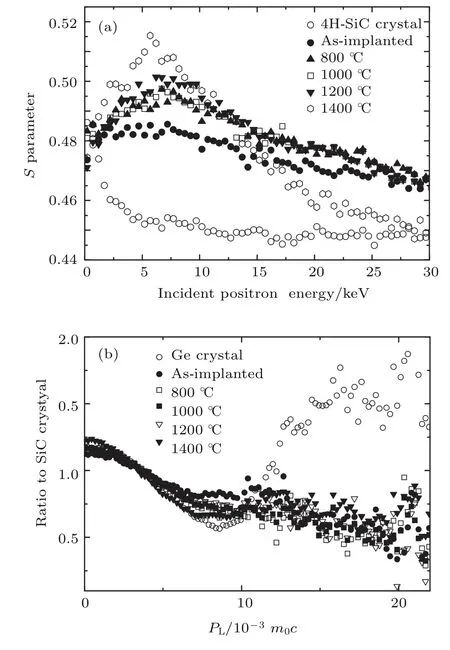
圖7 (a)未注入、Ge離子注入及注入后熱處理4H-SiC的正電子湮沒多普勒展寬S(E)曲線;(b)Ge離子注入及注入后熱處理4H-SiC比未注入4H-SiC的符合多普勒展寬能譜曲線[53]Fig.7.(a)Positron annihilation Doppler broadeningSvalues as a function of the incident positron energies for 4H-SiC before and after Ge ion implantation followed by thermal annealing;(b)ratio curves of coincidence Doppler broadening spectra for the annealed samples relative to that of the un-implanted SiC[53].
除單離子注入外,多離子注入也是重要的半導體改性手段.例如金剛石薄膜在注入氧離子后表現出n型導電性質,但電導率受晶格損傷影響,Hu等[56]對B-O共注入金剛石及O+注入低B濃度的金剛石薄膜進行了研究,發現離子的注入破壞了金剛石的晶格結構,并使薄膜在生長過程中產生的應力轉變為壓應力,而且一部分SP3鍵型轉變為SP2,在正電子湮沒多普勒展寬能譜中顯示,800°C退火后的B-O共注入以及O+注入低B濃度樣品的表面0-32 nm區域S值較大,并隨著深度增加迅速降低到一個穩定區域(32-92 nm),在之后的92-2000 nm區域B-O共注入樣品的S值明顯高于O+注入低B濃度樣品.關于B離子與其他離子對半導體材料的共注入研究中,Zhang等[57]發現B和H離子順次注入到單晶Si可有效減少(111)取向的H板層生長,并促進(100)取向的H板層擇優生長,在正電子湮沒多普勒展寬測量結果中,B離子注入以及B和H離子順次注入的單晶Si中湮沒的S參數值明顯高于H注入Si的S參數值.
3.4 半導體材料輻照效應的應用研究
有些半導體材料如硅、碳化硅、GaAs以及TiO2等在特殊的工作環境如太空,會受到輻射的影響,在輻照過程中,射線粒子與半導體材料相互作用而造成的微觀結構、成分等變化是半導體輻照效應研究的重點.正電子在輻照后半導體材料中的湮沒信息也會隨著材料微觀結構的變化而改變.例如,許楠楠等[58]發現經2.5 MeV的D-D中子輻照后,單晶金紅石型TiO2的晶格畸變嚴重,結晶性變差,并出現氧缺失現象,正電子湮沒壽命顯示,在TiO2輻照后,平均壽命變短,俘獲態的正電子湮沒壽命由輻照前的202 ps縮短為164.5 ps.Liu等[59]研究中子輻照6H-SiC單晶時,發現中子輻照后樣品出現晶格損傷但未產生第二相和多型體,磁性測量結果顯示隨著輻照劑量增加,樣品抗磁性逐步減弱,最后在2.29×1018n/cm2輻照劑量下,樣品抗磁性轉變為鐵磁性,而正電子湮沒兩類主要壽命部分τ1((130±14)ps),τ2((239±20)ps)與輻照劑量無關而τ2成分占比I2則與輻照劑量密切相關.除了中子輻照外,還有質子、α粒子等帶電粒子輻照,如張明蘭等[60]研究質子輻照GaN厚膜時,發現低溫的光致發光譜中黃光帶的發光強度在輻照后減弱,帶邊峰出現“藍移”現象,而黃光帶和其他LO聲子伴線的位置在輻照前后沒有變化,在正電子湮沒壽命測量中顯示,隨著質子注量的增加GaN的正電子湮沒壽命τ2逐步增大并大于體壽命.Pan等[61]利用正電子湮沒壽命譜發現經過40 MeV的氦離子輻照后,n型GaAs半導體的正電子湮沒壽命成分τ2相比參考樣品提高了34 ps.
此外,自離子輻照也是半導體輻照損傷研究的重要手段,如Blakie等[62]對經過1 MeV硅離子輻照SiyO1-y:Er(y≈1/3)薄膜樣品進行正電子湮沒多普勒展寬能譜測量時發現在約4-5×1013Si+/cm2輻照后,樣品的S,W參數達到飽和,與熒光猝滅飽和相對應.
4 半導體材料中微觀缺陷的應用
大多數半導體材料以晶體形式存在,而在半導體晶體中存在的缺陷主要為以空位、間隙原子為代表的點缺陷,此類缺陷對半導體材料的磁學性質、電學性質、光學性質等有很大的影響.例如Liu等[59]采用中子輻照6H-SiC單晶,通過正電子湮沒壽命測量結合磁性變化分析微觀缺陷對SiC磁性的影響,發現中子輻照后樣品內部主要為VSiVC缺陷,而且正電子湮沒壽命τ1,τ2與輻照劑量無關而τ2成分占比I2則與輻照劑量密切相關,隨著輻照劑量的升高,VSiVC也隨之增加,而相應的磁性測量結果顯示,隨著輻照劑量增加,樣品抗磁性逐步減弱,最后在2.29×1018n/cm2輻照劑量下,樣品抗磁性轉變為鐵磁性,根據第一性原理結果進一步說明VSiVC能引入磁性.Zhang等[63]在研究CuInSe2(CIS)黃銅礦半導體薄膜過程中利用正電子壽命測量發現原生樣品壽命值最大,硒氣氛退火后的正電子體壽命值接近CuInSe2雙空位VCu-VIn情況下理論壽命值,在硫氣氛退火后壽命值最低,可能是更小的尺寸的空位型缺陷,在正電子湮沒多普勒展寬能譜中顯示,在接近表面50 nm處為高濃度缺陷層,且原生CIS薄膜的S參數明顯高于S和Se氣氛退火后的樣品,而S-W曲線斜率一致說明三種情況下的缺陷類型相似.Onuma等[64]使用激光輔助分子束外延在Si基底上ZnS外延緩沖層上生長ZnO薄膜,并通過時間分辨光致發光技術和正電子湮沒技術對ZnO薄膜進行了測量.其結果顯示ZnO/ZnS/(111)Si的非輻射缺陷密度相比直接在Si基底上生長的ZnO較小,但一些電中性和帶正電的缺陷依然存在.Tuomisto等[65]通過快速符合多普勒展寬能譜研究發現,在氨熱法制備的不同自由電子濃度的GaN晶體中,Ga空位的濃度不僅與氧含量有關,而且Ga空位還被氫雜質所包圍形成了復合體.Elsayed等[66]對Cu在Zn摻雜的GaAs晶片擴散過程進行了實驗研究,測得的正電子湮沒壽命譜和符合多普勒展寬能譜結果說明經過750 K等時退火后,銅原子出現在空位型缺陷附近,并且形成了VGaVAs-2CuGa復合體(見圖8).Hao等[67]分析N注入直拉硅的正電子湮沒多普勒展寬能譜后,發現N注入后樣品內缺陷主要由O-VSi和N-VSi組成,二者是競爭關系,在650°C,750°C快速熱處理后S參數增大,缺陷主要是N-VSi;在超過850°C時,S參數降低,缺陷由O-VSi主導,在熱處理過程中,兩種缺陷均向表面遷移.

圖8 (網刊彩色)750 K等時退火后Cu擴散GaAs:Zn樣品參比未摻雜GaAs的符合多普勒展寬能譜及理論計算結果[66]Fig.8.(color online)High momentum part of the positron annihilation distribution for Cu in-diffused GaAs:Zn samples subject to isochronal annealing up to 750 K,which shows a maximum effect of the lifetime,normalized to SI undoped GaAs reference(left part).The right part shows the ratio of high momentum distribution to the bulk GaAs for different defects in GaAs from theoretical calculations[66].
根據不同的材料處理方式,半導體材料中的微觀缺陷還包括外來引入的雜質、較大尺寸的空位團及其復合體等.例如,Pasang等[35]對摻雜ZnO晶體研究時,利用正電子湮沒壽命譜發現Ru3+摻雜的ZnO的平均壽命最大,且τ2的占比在24%-39%附近,表明摻雜后ZnO晶體內有大量的空位團和晶界相交,在之后符合多普勒展寬能譜參比充分退火Al的正電子湮沒動量分布曲線中發現Ag+由于離子半徑明顯大于Zn2+而處于ZnO晶格的間隙位置,其正電子動量特征峰強度顯著高于其他過渡金屬摻雜,而Ru3+,Pd2+則是占據了Zn空位,進一步根據XRD結果推測Ru3+在ZnO空位處與O形成了二價鍵,Pd2+則是擴散進入Zn的空位團中.Uedono等[68]利用注氧隔離技術對SOI進行結構改性,根據正電子湮沒壽命和多普勒展寬能譜測量結果分析發現,在退火過程中SOI的次表面區域的缺陷變化有三個階段,前兩階段600°C-800°C,800°C-1100°C的平均尺寸遠大于6空位復合體的空位團的出現及回復過程,且1000°C時氧原子開始擴散并被次表面空位團俘獲,第三階段1100°C-1300°C范圍內出現了平均尺寸接近6空位復合體的氧相關缺陷.Kar等[69]根據在較低溫度所測得的正電子湮沒壽命譜的τ1和τ2成分以及計算所得俘獲率κ分析得出CdS顆粒中的空位團是電中性的,從多普勒展寬譜線的S參數、W參數與尺寸的對應關系發現在10 nm以下,CdS中的電子密度是隨著尺寸降低而遞減的.隨后的光學吸收譜進一步解釋說明了帶隙增寬讓正電子波函數與高動量芯層電子的重疊有很大程度的減少,即與W參數表現一致,而S參數的升高則是由于整個湮沒事件的守恒,后來不同尺寸納米棒的正電子測量顯示出了同樣的結果.Wei等[70]利用慢正電子束流技術對反應離子刻蝕后的硅片進行了研究,結果顯示,硅片經過刻蝕后,表面產生了厚度小于30 ?的C相關薄膜層,在深度超過1200 ?的區域出現空位型缺陷.
在半導體材料缺陷中,氧空位團對半導體的催化活性起到極大的促進作用,例如在Cu-Ce-Ti多元氧化物半導體催化劑中,Liu等[71]利用正電子湮沒壽命測量發現Cu的引入會使樣品內產生大尺寸氧空位團,再通過Cu-Ce-Ti體系的兩次氧化還原反應的循環進一步增強了多元氧化物的催化活性.Liu等[26]對采用不同前驅體的水熱法制備的二氧化鈰納米棒進行正電子湮沒壽命測量,結果顯示采用CeCl3前驅體的樣品表面比采用Ce(NO3)3前驅體表面粗糙,采用Ce(NO3)3前驅體的樣品以電中性Ce3+和VO復合體為主,再根據CO消耗結果推測二氧化鈰的活性與還原性與大尺寸的氧空位有直接的聯系.
氧空位團不僅對半導體催化性能起到促進作用,還能影響半導體的電學性能.二氧化鉿(HfO2)是半導體產業中一種重要的二元過渡金屬氧化物材料,其中氧空位的引入會在禁帶中產生缺陷能級,電子能夠在這些能級之間躍遷.而且大量氧空位聚集形成空位團時,這些陷阱能級便提供了一條電子的通道,使得HfO2成為低阻態.Ma等[28]利用正電子多普勒展寬對磁控反應濺射制備的HfO2薄膜進行了研究,結果顯示隨著濺射氣氛中氧含量的增多、濺射功率的減少、濺射氣壓的降低,S參數逐漸增加,表明氧空位及空位團和納米孔洞等開體積缺陷(open volume defects,OVD)也逐漸增多.
另外,區別于無機半導體晶體的長程有序結構,在有機半導體中,分子構成在很大范圍內可以進行改變,因此自由體積和納米孔洞是有機半導體內兩類較為常見的微觀缺陷.Padma等[37]在不同溫度的基底上生長銅酞菁CuPc,通過多普勒展寬能譜測量發現在硅基底溫度為室溫時,薄膜的S參數較高,主要由于分子排列的無序性以及聚集等結構缺陷的存在較多.在100°C,225°C的基底溫度下,薄膜的S參數表明在次表面和近界面處的分子聚集方式不同,而且分子有序排列,在靠近界面處沒有出現在基底處于室溫下時出現的獨特的界面區.在之后的次表面和近界面處的正電子壽命測量結果顯示,室溫基底條件下兩區域的平均壽命明顯不同,在100°C條件下則是相接近,與分子聚集方式有關,而在225°C條件下出現了長壽命成分,則是由于自由體積和納米空洞的出現.He等[72]利用Amoc對環氧化天然膠乳-石墨烯復合材料測量發現石墨烯網狀結構的形成對環氧化天然橡膠內原子尺度的自由體積空穴有著顯著影響.
半導體材料內的離子有高價態與低價態的區別,也能直接反映在正電子湮沒信息中,例如,馬創新等[73]研究了n型半導體WO3薄膜變色機理,發現熱致變色和電致變色WO3樣品的S參數與原生樣品相比,在膜深層區的增量基本一致,而WO3中低價態的W離子會導致S參數的增大,再根據XPS結果推測熱致變色和電致變色的主要原因在于膜中低價態鎢(W)離子的產生和數量的增多,變色性能的優劣依賴于低價態鎢(W)離子數量的多少,如圖9所示.

圖9 (a)WO3薄膜的S(E)曲線;(b)電致變色 WO3薄膜的W 4f反卷積譜[73]Fig.9. (a)S(E)curve of films at different states;(b)the deconvoluted XPS spectra of W 4f for electrochromic WO3films[73].
5 半導體材料應用研究發展趨勢
綜上所述,正電子湮沒譜學技術在半導體材料微結構表征和微觀缺陷的形成及演變機理的研究中得到了廣泛的應用,半導體材料內離子空位、空位復合體和空位團等缺陷信息可由正電子湮沒壽命、正電子湮沒多普勒展寬能譜表征,有機半導體中的介孔、微孔等較大尺寸缺陷信息可以運用AMOC等技術手段得到,特別在半導體薄膜材料的表面和多層膜材料的界面的微觀結構和缺陷的深度分布的研究中,慢正電子束流技術具有獨特的優勢.通過研究半導體材料微觀結構和缺陷、電子密度和動量分布等微觀機理,并結合其他半導體材料表征手段(如光致發光譜PL、振動試樣磁力計、程序化升溫還原TPR等),探查埃量級尺寸的缺陷變化來研究影響半導體材料性能的主要因素,對優化半導體材料的制備工藝和后處理實驗的參數、探討其對材料宏觀性能的影響等研究提供了有效的實驗分析技術.
但是,針對當前半導體材料發展中的基礎科學問題和研究熱點,期待在以下幾個方面的研究取得進一步的應用發展.譬如,從正電子湮沒特性方面考慮,在化合物半導體中一般會存在負電性的陽離子空位和正電性的陰離子空位,正電子在晶格中的擴散容易被負電性空位所俘獲,但對陰離子空位等正電性缺陷不敏感而難以被正電子湮沒技術直接探測到,而在正電性缺陷中,氧空位(VO)對重要的過渡金屬氧化物半導體材料的電子結構和物理性質有很大的影響,研究氧空位的穩定性以及它對晶體結構和電子結構的影響對于改善金屬氧化物性能至關重要,但通常的正電子湮沒技術對于氧空位等陰離子空位的研究依然存在困難.另一方面,雖然正電子對材料中電子密度變化極為敏感,但通常的正電子湮沒技術探測分析各缺陷的成分和類別有一定局限性.半導體摻雜工藝中,多離子共摻雜相對單離子摻雜的效果更優,例如多種摻雜離子能在晶格內部引入缺陷位,成為電子和空穴的勢阱,可減少電子-空穴復合,較大提高半導體的催化性能.利用符合多普勒展寬測量技術可以得到湮沒電子動量分布并分析湮沒位置周圍的化學環境,進一步獲得氧空位等負離子空位以及其他摻雜元素信息,針對上述情況有明顯的優勢,但目前該技術對負離子空位以及其他摻雜元素的研究依然較少.
從半導體實際應用研究方面考慮,正電子湮沒譜學技術測量通常得到的半導體材料的電子湮沒信息不能真實反映出在部分極端條件如太空中粒子輻照中,半導體的微觀結構情況,這對分析理解半導體器件的服役、異常失效等問題帶來的幫助較小.另一方面,有些半導體材料在特殊的環境如活性氣氛、光照等條件下生長或發生改性,其微觀結構必然發生變化,但目前普遍使用的正電子湮沒測量方法不適于此類研究.
而針對研究半導體的服役問題的研究,正電子湮沒譜學技術在近年來發展了正電子湮沒原位測量技術.在對半導體的研究過程中,材料的性能在各種環境中,如低溫、光照、磁場、氣氛等條件下會發生多種變化,利用正電子湮沒原位測量技術,可以實時追蹤由于外界條件的改變而引起的半導體材料的微觀結構、電子動量和密度分布等的變化,這對精確把握材料的性能有很好的啟發作用.正電子湮沒原位測量技術同樣也可以運用于需要特殊測量方式的半導體材料的研究中,如材料在特殊環境下的生長和改性等問題,而將數字化技術用于正電子湮沒技術后能使得原位測量技術更為方便快捷.
此外,在介孔、微孔等較大尺寸缺陷研究中,正電子素飛行時間譜(TOF)也是正電子湮沒譜學技術中發展起來的另一個新技術,能夠無損地給出材料開孔的尺寸、方向、以及內部連通性等性質,配合AMOC給出的材料內的孔的尺寸、大小等性質則更能全面描述材料內孔的信息.
正電子湮沒譜學技術在幾十年的發展應用過程中有大量的實驗基礎,并且隨著核電子學和核技術的發展,正電子湮沒譜學技術中的探測技術也不斷改進,其探測效率和靈敏度也相應得到提高,但在理論研究方面依然存在不足,若能根據理論計算如第一性原理計算、Monte Carlo方法等得到在半導體材料內的正電子的模擬信息,結合大量的實驗數據建立理論模型,這將為正電子湮沒譜學技術在材料中的研究提供更方便直觀的指導分析作用.隨著半導體材料研究愈來愈趨于復雜性,發展正電子湮沒譜學技術并建立合適的理論,結合其他表征手段研究材料微觀結構的重要性也愈來愈重要,這對材料科學的研究無疑是有力的幫助.
[1]Cheng L J,Yeh C K 1973Solid State Commun.12 529
[2]Arifov P U,Arutyunov N Y,Ilyasov A Z 1977Sov.Phys.Semi.-Ussr11 907
[3]Zhang L H,Cheng B,Zhang J,Zhang L J,Guo W F,Liu J D,Zhang L N,Ye B J 2012Sci.Sin.:Phys.Mech.Astron.42 1217(in Chinese)[張禮紅,成斌,張杰,張麗娟,郭衛鋒,劉建黨,張禮楠,葉邦角 2012中國科學:物理學 力學 天文學42 1217]
[4]Barbiellini B,Genoud P,Jarlborg T 1991J.Phys.:Condens.Matter3 7631
[5]Yu W Z,Yuan J P 1999Physics28 429(in Chinese)[郁偉中,袁佳平1999物理28 429]
[6]Share G H,Murphy R J,Skibo J G,Smith D M,Hudson H S,Lin R P,Shih A Y,Dennis B R,Schwartz R A,Kozlovsky B 2003Astrophys.J.595 85
[7]Zhang Z M,Wang B Y,Ma C X,Zhou C L,Wei L,Zhang T B,Ren S X 2004Nucl.Electron.Detect.Technol.24 490(in Chinese)[章志明,王寶義,馬創新,周春蘭,魏龍,張天保,任紹霞2004核電子學與探測技術24 490]
[8]Cheng G D,Cao X Z,Wu J P,Wu H B,Yang J,Jiang X P,Yu R S,Wang B Y 2013Mater.Rev.27 133(in Chinese)[成國棟,曹興忠,吳建平,伍海彪,楊靜,姜小盼,于潤升,王寶義2013材料導報27 133]
[9]Zubiaga A,Garcia J A,Plazaola F,Tuomisto F,Zuniga-Perez J,Munoz-Sanjose V 2007Phys.Rev.B75 10
[10]Arutyunov N Y,Elsayed M,Krause-Rehberg R,Emtsev V V,Oganesyan G A,Kozlovski V V 2013J.Phys.:Condes.Matter25 28
[11]Kawasuso A,Yoshikawa M,Itoh H,Chiba T,Higuchi T,Betsuyaku K,Redmann F,Krause-Rehberg R 2005Phys.Rev.B72 6
[12]Hu W G,Wang Z,Su B F,Dai Y Q,Wang S J,Zhao Y W 2004Phys.Lett.A332 286
[13]Shao Y D,Wang Z,Dai Y Q,Zhao Y W,Tang F Y 2007Mater.Lett.61 1187
[14]Suzuki R,Ohdaira T,Uedono A,Kobayashi Y 2002Appl.Surf.Sci.194 89
[15]Cao X Z,Wang B Y,Zhang Z M,Wei C F,Zhang T B,Xue D S,Wei L 2004Nucl.Sci.Tech.27 435(in Chinese)[曹興忠,王寶義,章志明,魏存峰,張天保,薛德勝,魏龍2004核技術27 435]
[16]Wang T M,Wang B Y,Chen H M,Yu R S,Wei L,Zhang T B,Yu W Z,He Y J 1999Physics28 573(in Chinese)[王天民,王寶義,陳紅民,于潤升,魏龍,張天保,郁偉中,何元金1999物理28 573]
[17]Wang P,Cao X Z,Ma Y Y,Qin X B,Wang B Y,Ma C X,Wei L 2006High Energ.Phys.Nucl.30 1036(in Chinese)[王平,曹興忠,馬雁云,秦秀波,王寶義,馬創新,魏龍2006高能物理與核物理30 1036]
[18]Ma Y Y,Pei S L,Zhang Z M,Cao X Z,Wang S H,Wang P,Wang B Y,Wei C F,Ma C X,Wei L 2006High Energ.Phys.Nucl.30 166(in Chinese)[馬雁云,裴士倫,章志明,曹興忠,王書鴻,王平,王寶義,魏存峰,馬創新,魏龍2006高能物理與核物理30 166]
[19]Cao X Z,Wang B Y,Yu R S,Wei C F,Xue D S,Wei L 2004High Energ.Phys.Nucl.28 560(in Chinese)[曹興忠,王寶義,于潤升,魏存峰,薛德勝,魏龍 2004高能物理與核物理28 560]
[20]Cao X Z,Wang B Y,Wang P,Ma Y Y,Qin X B,Wei L 2006High Energ.Phys.Nucl.30 1196(in Chinese)[曹興忠,王寶義,王平,馬雁云,秦秀波,魏龍 2006高能物理與核物理30 1196]
[21]Wang B Y,Cao X Z,Wei C F,Zhang Z M,Ma C X,Zhang T B,Wei L 2007Nucl.Sci.Tech.30 247(in Chinese)[王寶義,曹興忠,魏存峰,章志明,馬創新,張天保,魏龍2007核技術30 247]
[22]Wei C F,Wang B Y,Wang P,Cao X Z,Zhang Z M,Ma Y Y,Xue D S,Wei L 2006High Energ.Phys.Nucl.30 1010(in Chinese)[魏存峰,王寶義,王平,曹興忠,章志明,馬雁云,薛德勝,魏龍2006高能物理與核物理30 1010]
[23]Hu Y C,Cao X Z,Li Y X,Zhang P,Jin S X,Lu E Y,Yu R S,Wei L,Wang B Y 2015Acta Phys.Sin.64 247804(in Chinese)[胡遠超,曹興忠,李玉曉,張鵬,靳碩學,盧二陽,于潤升,魏龍,王寶義2015物理學報64 247804]
[24]Alivisatos A P 1996J.Phys.Chem.100 13226
[25]Morkoc H,Strite S,Gao G B,Lin M E,Sverdlov B,Burns M 1994J.Appl.Phys.76 1363
[26]Liu X W,Zhou K B,Wang L,Wang B Y,Li Y D 2009J.Am.Chem.Soc.131 3140
[27]Khalid M,Ziese M,Setzer A,Esquinazi P,Lorenz M,Hochmuth H,Grundmann M,Spemann D,Butz T,Brauer G,Anwand W,Fischer G,Adeagbo W A,Hergert W,Ernst A 2009Phys.Rev.B80 035331
[28]Ma Z W,Liu L X,Xie Y Z,Su Y R,Zhao H T,Wang B Y,Cao X Z,Qin X B,Li J,Yang Y H,Xie E Q 2011Thin Solid Films519 6349
[29]Wan D Y,Wang B Y,Zhou C L,Ma C X,Wang Y T,Zhang R G,Wei L 2004Phys.B:Condens.Matter344 489
[30]Yu Y B,Zhao J J,Han X,Zhang Y,Qin X B,Wang B Y 2013Chin.J.Catal.34 283
[31]Hao W C,Pan F,Wang T M,Zhou C L,Wei L 2006Chin.Phys.Lett.23 223
[32]Tripathi B,Singh F,Avasthi D K,Bhati A K,Das D,Vijay Y K 2008J.Alloys Compd.454 97
[33]Wang X Q,Liu S T,Ma D Y,Zheng X T,Chen G,Xu F J,Tang N,Shen B,Zhang P,Cao X Z,Wang B Y,Huang S,Chen K J,Zhou S Q,Yoshikawa A 2012Appl.Phys.Lett.101 171905
[34]Yang X L,Zhu W X,Wang C D,Fang H,Yu T J,Yang Z J,Zhang G Y,Qin X B,Yu R S,Wang B Y 2009Appl.Phys.Lett.94 151907
[35]Pasang T,Namratha K,Guagliardo P,Byrappa K,Ranganathaiah C,Samarin S,Williams J F 2015Mater.Res.Express2 045502
[36]Liang L H,Li Z X,Wang B Y,Wu W M 2011J.Guangxi Univ.(Nat.Sci.Ed.)36 863(in Chinese)[梁立歡,李卓昕,王寶義,吳偉明 2011廣西大學學報:自然科學版 36 863]
[37]Padma N,Maheshwari P,Bhattacharya D,Tokas R B,Sen S,Honda Y,Basu S,Pujari P K,Rao T V 2016ACS Appl.Mater.Inter.8 3376
[38]Hao X P,Wang B Y,Yu R S,Wei L,Wang H,Zhao D G,Hao W C 2008Chin.Phys.Lett.25 1034
[39]Li D X,Qin X B,Zheng L R,Li Y X,Cao X Z,Li Z X,Yang J,Wang B Y 2013Chin.Phys.B22 037504
[40]Zhan P,Wang W P,Liu C,Hu Y,Li Z C,Zhang Z J,Zhang P,Wang B Y,Cao X Z 2012J.Appl.Phys.111 033501
[41]Jia Y,Oshima T,Yamada A,Konagai M,Takahashi K,Tanigawa S,Wei L 1993Jpn.J.Appl.Phys.Part 1-Regular Papers Short Notes&Review Papers32 1884
[42]Ren H T,Xiang G,Gu G X,Zhang X,Wang W J,Zhang P,Wang B Y,Cao X Z 2012J.Nanomater.202 1
[43]Lee J L,Wei L,Tanigawa S,Kawabe M 1991Appl.Phys.Lett.58 1524
[44]Yang A L,Song H P,Liang D C,Wei H Y,Liu X L,Jin P,Qin X B,Yang S Y,Zhu Q S,Wang Z G 2010Appl.Phys.Lett.96 151904
[45]Li Z X,Wang D N,Wang B Y,Xue D S,Wei L,Qin X B 2010Acta Phys.Sin.59 8915(in Chinese)[李卓昕,王丹妮,王寶義,薛德勝,魏龍,秦秀波 2010物理學報 59 8915]
[46]Sedivy L,Cizek J,Belas E,Grill R,Melikhova O 2016Sci.Rep.6 20641
[47]Ning S,Zhan P,Wang W P,Li Z C,Zhang Z J 2014Chin.Phys.B23 127503
[48]Liu X F,Iqbal J,Gong W M,Yang S L,Gao R S,Zeng F,Yu R H,He B,Hao Y P,Hao X P 2009J.Appl.Phys.105 093931
[49]Zhao C J,Liu Y,Zhang J Y,Sun L,Ding L,Zhang P,Wang B Y,Cao X Z,Yu G H 2012Appl.Phys.Lett.101 072404
[50]Zhao C J,Ding L,Zhao Z D,Zhang P,Cao X Z,Wang B Y,Zhang J Y,Yu G H 2013Appl.Phys.A116 845
[51]Maheshwari P,Dutta D,Mukherjee S,Madhu P K,Mote K R,Pujari P K 2016Phys.Chem.Chem.Phys.18 12886
[52]Marchiori C F N,Yamamoto N A D,Matos C F,Kujala J,Macedo A G,Tuomisto F,Zarbin A J G,Koehler M,Roman L S 2015Appl.Phys.Lett.106 133301
[53]Yu R S,Maekawa M,Kawasuso A,Wang B Y,Wei L 2012Nucl.Instrum.Methods Phys.Res.,Sect.B270 47
[54]Qin X B,Zhang P,Liang L H,Zhao B Z,Yu R S,Wang B Y,Wu W M 2011J.Phys.Conf.Ser.262 012051
[55]Wei L,Tanigawa S,Uedono A,Wada K,Nakanishi H 1994Jpn.J.Appl.Phys.Part 1-Regular Papers Brief Communications&Review Papers33 33
[56]Hu X J,Shen Y G,Hao X P,Wang B Y 2009Diamond Relat.Mater.18 210
[57]Zhang B,Zhang P,Wang J,Zhu F,Cao X Z,Wang B Y,Liu C L 2013Nucl.Phys.Rev.30 471
[58]Xu N N,Li G P,Wang Y B,Zhong H P,Li T J,Gong H F,Wang B Y,Li Z X 2012Nucl.Sci.Tech.35 98(in Chinese)[許楠楠,李公平,王云波,鐘火平,李天晶,龔恒鳳,王寶義,李卓昕2012核技術35 98]
[59]Liu Y,Wang G,Wang S C,Yang J H,Chen L,Qin X Q,Song B,Wang B Y,Chen X L 2011Phys.Rev.Lett.106 087205
[60]Zhang M L,Yang R X,Li Z X,Cao X Z,Wang B Y,Wang X H 2013Acta Phys.Sin.62 017103(in Chinese)[張明蘭,楊瑞霞,李卓昕,曹興忠,王寶義,王曉暉2013物理學報62 017103]
[61]Pan S,Mandal A,Roychowdhury A,Gupta S 2015Appl.Phys.A120 221
[62]Blakie D E,Zalloum O H Y,Wojcik J,Irving E A,Knights A P,Mascher P,Simpson P J 2009J.Appl.Phys.105 053517
[63]Zhang L J,Wang T,Li J,Hao Y P,Liu J D,Zhang P,Cheng B,Zhang Z W,Wang B Y,Ye B J 2012Thin Solid Films525 68
[64]Onuma T,Chichibu S F,Uedono A,Yoo Y Z,Chikyow T,Sota T,Kawasaki M,Koinuma H 2004Appl.Phys.Lett.85 5586
[65]Tuomisto F,Kuittinen T,Zaja?c M,Doradziński R,Wasik D 2014J.Cryst.Growth403 114
[66]Elsayed M,Krause-Rehberg R,Kor ffB,Ratschinski I,Leipner H S 2013Eur.Phys.J.B86 358
[67]Hao X P,Yu R S,Wang B Y,Chen H L,Wang D N,Ma C X,Wei L 2007Appl.Surf.Sci.253 6868
[68]Uedono A,Tanigawa S,Ogura A,Ono H,Suzuki R,Ohdaira T,Mikado T 2000J.Appl.Phys.87 1659
[69]Kar S,Biswas S,Chaudhuri S,Nambissan P M G 2005Phys.Rev.B72 075338
[70]Wei L,Tabuki Y,Tanigawa S 1993Jpn.J.Appl.Phys.Part 1-Regular Papers Short Notes&Review Papers32 7
[71]Liu Z M,Yi Y,Li J H,Woo S I,Wang B Y,Cao X Z,Li Z X 2013Chem.Commun.49 7726
[72]He C Z,She X D,Peng Z,Zhong J P,Liao S Q,Gong W,Liao J H,Kong L X 2015Phys.Chem.Chem.Phys.17 12175
[73]Ma C X,Zhou C L,Qin X B,Wang B Y,Wei L,Kui R X,Qian H J,Su R,Zhong J 2004Nucl.Sci.Tech.27 943(in Chinese)[馬創新,周春蘭,秦秀波,王寶義,魏龍,奎熱西,錢海杰,蘇潤,鐘俊2004核技術27 943]
PACS:78.70.Bj,64.70.kg,98.38.Am,91.60.Ed DOI:10.7498/aps.66.027801
Advances in applications of positron annihilation spectroscopy to investigating semiconductor microstructures?
Cao Xing-Zhong1)?Song Li-Gang1)2)Jin Shuo-Xue1)Zhang Ren-Gang2)Wang Bao-Yi1)Wei Long1)
1)(Institute of High Energy Physics,Chinese Academy of Sciences,Beijing 100049,China)
2)(College of Science,Wuhan University of Science and Technology,Wuhan 430000,China)
30 August 2016;revised manuscript
18 October 2016)
Positron annihilation spectroscopy has unique advantage for detecting the micro-defects and microstructures in materials,especially for investigating the negatively charged defects such as cation vacancies in semiconductors.It is a powerful tool to characterize the important features for vacancy-type defects localized electron states within the forbidden energy gap and cation vacancy which provides the key information about the type and distribution of microdefects.Positron annihilation lifetime and Doppler broadening spectroscopy are the major methods of analyzing the vacancy formation,evolution and distribution mechanism.Importantly,the slow positron beam technique can provide the dependences of surface,defect and interface microstructure information on depth distribution in semiconductor thin film.Vacancy and impurity elements can change the ambient electron density in material.They also induce the middle band,which will have dramatic effects on optical and electrical performance.And the variation of electron density will exert furtherinfluences on the positron-electron annihilation mechanism and process.For the fundamental experiments in semiconductors,fabrication technology,thermal treatment,ion implantation/doping,irradiation etc,positron annihilation spectroscopy technology has been extensively applied to detecting the detailed electron density and momentum distribution,and gained the information about microstructure and defects.It can guide the fundamental researches in experiment and give optimal design of the technology and properties about semiconductors.In principle,defect concentrations can be derived and an indication can be obtained about the nature of the defect.Results are presented showing that cation vacancies can be easily detected.Also charge states and defect levels in the band gap are accessible.By combining the positron annihilation spectroscopy with optical spectroscopies or other experimental methods,it is possible to give detailed identifications of the defects and their chemical surroundings.The positron annihilation spectroscopy technology is a very special and effective nuclear spectroscopy analysis method in studying semiconductor microstructure.In this review,the research progress in applications of positron annihilation spectroscopy technology to semiconductors is reported,which focuses on the experimental results from the Positron Research Platform located in Institute of High Energy Physics,Chinese Academy of Sciences.Under different growth modes and ways of treating semiconductors,the experimental results about the internal micro-defect formation mechanism of material,evolution mechanism,and defect feature research progress are reviewed Future challenges including the analysis of electropositivity vacancy(i.e.oxygen vacancy)and of multi-ion implantation phenomena are also presented new technologies such as digitization and new theory will make the positron annihilation spectroscopy portable and reliable.
positron annihilation spectroscopy,semiconductor,electron density and momentum distribution,microstructure
:78.70.Bj,64.70.kg,98.38.Am,91.60.Ed
10.7498/aps.66.027801
?國家自然科學基金(批準號:0275076,10575112,60606011,10835006,11175191,11475193,11475197,11575205,11505192)資助的課題.
?通信作者.E-mail:caoxzh@ihep.ac.cn
*Project supported by the National Natural Science Foundation of China(Grant Nos.0275076,10575112,60606011,10835006,11175191,11475193,11475197,11575205,11505192).
? Corresponding author.E-mail:caoxzh@ihep.ac.cn

