新型ENEPIG封裝基板化學鍍鈀工藝優化
于金偉
(濰坊學院,山東 濰坊 261061)
?
新型ENEPIG封裝基板化學鍍鈀工藝優化
于金偉
(濰坊學院,山東 濰坊261061)
摘要:化學鍍鈀是制作新型ENEPIG印制電路板最關鍵的工藝,從化學鍍鈀反應機理入手,分析了影響質量的工藝參數,運用實驗設計中健壯設計的實驗方法,對工藝參數進行了優化,找到了新型ENEPIG印制電路板中化學鍍鈀的最優工藝參數:2.2g/L氯化鈀,13.2g/L次磷酸鈉,165mL/L氫氧化銨,33g/L氯化銨,鍍液θ為55℃,pH為9.6。驗證試驗表明,應用改善后的鍍鈀工藝,鈀的沉積速率明顯加快,集中度也得到顯著提高。
關鍵詞:印制電路板; 化學鍍鈀; 工藝; 參數優化
計劃項目(201013);山東省高等學校科技計劃項目(J12LA57);山東省星火計劃項目(2011XH06025)
Process Optimization of Electroless Palladium Plating for
New Type ENEPIG Package Substrate
YU Jinwei
(Weifang University,Weifang 261061,China)
Abstract:Electroless palladium plating is the most key process in new type ENEPIG printed circuit board manufacturing.In this paper,process parameters which influencing the quality were analyzed from the reaction mechanism of electroless palladium plating,and these parameters were optimized by using robust design experimental method of DOE.The optimal process parameters were founded as follows:PdCl22.2g/L,NaH2PO2concentration 13.2g/L,NH4OH 165mL/L,bath temperature 55℃,bath pH 9.6,NH4Cl 33g/L.Validation tests showed that the palladium deposition rate was accelerated obviously and the concentration was increased significantly after the optimized palladium plating process had been applied.
Keyword:printed circuit board;electroless palladium plating;process;parameter optimization
引言
在MEMS封裝領域,封裝基板是承載器件的基礎,其最大的隱患“黑墊”問題困擾了業界很長時間,為徹底解決該問題,開發了新型的ENEPIG(Electroless Nickel,Electroless Palladium,and Immersion Gold,化學鍍鎳,化學鍍鈀與浸金)封裝基板,這種基板表面保護工藝最突出的改善是在化學鍍Ni層和浸Au層之間加入了化學鍍Pd層,它在化學鍍Au過程中阻擋了鍍鎳層與浸金溶液的接觸,避免了浸金制程對鎳層的氧化,從而解決了“黑墊”問題。對ENEPIG封裝基板表面保護這一新工藝來說,化學鍍Pd是最關鍵的工藝[1-3],其工藝參數的選擇會對這一新型基板的質量和生產效率產生顯著影響。而影響ENEPIG印制電路板化學鍍Pd的因素較多,各因素之間又有交叉影響,為統籌實驗分析降低實驗成本,本文運用DOE(Design Of Experiment,試驗設計)的健壯設計的實驗方法對這些參數的選擇進行優化。
1影響印制電路板化學鍍Pd的因素
1.1化學鍍Pd反應機理
以次磷酸鹽作為還原劑的化學鍍Pd是自催化氧化還原反應,按原子氫理論其反應式如下:
H2PO2-+H2O→H++HPO32-+2H
(1)
Pd2++2H→Pd↓+2H+
(2)
H2PO2-+H→H2O+OH-+P
(3)
H2PO2-+H2O→H++HPO32-+H2↑
(4)
總反應式:
2H2PO2-+Pd2++3H→HPO32-+Pd+P+H2O+2H+
(5)
從以上反應式可見,次磷酸根離子水解脫氫并形成亞磷酸根,同時析出兩個活化性初生態氫原子被吸附在鎳面上使其活化;溶液中的Pd2+在鎳面上迅速還原,在催化鎳表面上沉積金屬鈀;鎳表面上的氫原子催化刺激次磷酸根還原成磷并沉積在鈀層中;同時,由于催化作用使次磷酸根氧化,形成亞磷酸,并生成H2放出。因此要得到結晶致密的鍍鈀層,就要及時驅趕所產生的氫氣,否則細小的氣泡吸附在鈀面上,容易形成空洞。
本文針對行業內最有發展前景的ENEPIG印制電路板的化學鍍Pd工藝參數為研究對象,影響化學鍍Pd的因素有NaH2PO2、NH4OH、PdCl2和NH4Cl質量濃度、鍍液溫度及pH等。
1.2NaH2PO2的影響
鍍液中隨著NaH2PO2質量濃度的增加,提高了次磷酸氧化電位,NaH2PO2的還原能力得到增強,表現出沉積速度增加。但是,當NaH2PO2質量濃度大于無活化表面引發臨界值時,會因氧化還原反應使鍍液自然分解,所以NaH2PO2質量濃度要適當[4-5]。
1.3NH4OH的影響
使用NH4OH可防止產生Pd(OH)2沉淀,通過控制沉積速度,改善鍍層外觀。因為絡合物生成氫氧化物的自由能高,所以比產生Pd(OH)2的傾向要小得多。另外,使用NH4OH可較快地增加鈀的沉積速度并且可以延緩pH的下降,從而使鍍液的pH得到穩定[4-5]。
1.4鍍液pH的影響
如果鍍液的pH下降,那么氫離子濃度會增加,導致氧化還原電位降低,還原力減弱。因此還原劑的有效程度與鍍液的pH變化有關[4-5]。
1.5PdCl2的影響
鍍液中隨著PdCl2質量濃度的增加,氧化還原電位提高,化學反應速度加快,表現出沉積速度增加。但是,提高PdCl2質量濃度必須相應提高NaH2PO2質量濃度,即PdCl2的增加受制于NaH2PO2[4-5]。
1.6NH4Cl的影響
NH4Cl作為緩沖劑,它能使鍍液的pH降低減慢,使鍍液較為穩定[4-5]。
1.7鍍液溫度的影響
提高鍍液溫度可以提高離子的活性和擴散速率,從而提高氧化還原電位,使沉積速率增加。但是過高的溫度會加速鍍液的揮發,導致鍍液各種溶質濃度的變化,造成鍍液成分不穩定,同時伴有大量氣體生成,影響鈀的沉積,所以鍍液溫度要適當[4-5]。
2化學鍍鈀過程參數優化
健壯設計通過選擇可控因子的水平組合從而減少系統對噪聲的敏感度,以此來降低系統性能的波動。
2.1制定實驗要求及目標
實驗要求:優化化學鍍Pd工藝,改善過程工藝參數,力求提高鈀的沉積速率。
實驗目標:鈀的沉積速率v>0.7g/(m2·min)。
2.2可控因子和因子水平表的制定
影響化學鍍Pd的主要工藝參數為:PdCl2、NaH2PO2、NH4OH、NH4Cl、鍍液溫度及鍍液pH,對于誤差因子,除鍍液pH選定±2%外,其它因子選定±10%的變差,因此,各因子選擇三個水平。因子水平表見表1。
表1因子水平表

因 子水 平123A:ρ(PdCl2)/(g·L-1)A00.9A01.1A0B:ρ(NaH2PO2)/(g·L-1)B00.9B01.1B0C:ρ(NH4OH)/(mL·L-1)C00.9C01.1C0D:ρ(NH4Cl)/(g·L-1)D00.9D01.1D0E:θ/℃E00.9E01.1E0F:pHF00.98F01.02F0
表1中各因子的1水平組合為現有鍍鈀槽液工藝參數,其具體數值為:2.0g/L PdCl2、12g/L NaH2PO2、150mL/L NH4OH和30g/L NH4Cl,鍍液θ為50℃,則因子參數水平表如表2所示。
表2因子參數水平表

因 子水 平123A:ρ(PdCl2)/(g·L-1)21.82.2B:ρ(NaH2PO2)/(g·L-1)1210.813.2C:ρ(NH4OH)/(mL·L-1)150135165D:ρ(NH4Cl)/(g·L-1)302733E:θ/℃504555F:pH9.89.610.0
2.3設計實驗方案
打開MINITAB軟件,依據上述因子參數水平表選定正交表,把各因子放在正交表的第1至6列。選用菜單【統計】/【DOE】/【田口】/【創建田口設計】,設定相關參數,即可輸出設計表,見表3。
表3試驗設計方案

試驗號ρ(PdCl2)/(g·L-1)ρ(NaH2PO2)/(g·L-1)ρ(NH4OH)/(mL·L-1)ρ(NH4Cl)/(g·L-1)θ/℃pH121215030509.8221215030459.632121503055104210.813527509.85210.813527459.66210.81352755107213.216533509.88213.216533459.69213.2165335510101.81213533509.6111.812135334510121.81213533559.8131.810.816530509.6141.810.8165304510151.810.816530559.8161.813.215027509.6171.813.2150274510181.813.215027559.8192.212165275010202.21216527459.8212.21216527559.6222.210.8150335010232.210.815033459.8242.210.815033559.6252.213.2135305010262.213.213530459.8272.213.213530559.6
2.4鈀的沉積速率測試結果
對表3中的每一試驗方案均用10PNL線路板實施化學鍍Pd,表4是鈀的沉積速率的測量結果。
表4鈀的沉積速率測量結果(mg/min)

實驗號樣 品1234567891013.72.72.22.33.02.23.11.62.41.921.00.91.21.11.31.51.21.11.21.232.72.12.41.82.92.12.12.52.12.541.51.01.51.80.41.11.31.91.71.551.51.01.51.80.41.11.31.91.71.562.62.73.42.73.02.43.03.02.22.473.22.23.32.54.52.33.63.03.64.182.91.42.22.42.02.32.42.42.01.998.07.16.95.96.77.85.36.77.15.9100.81.51.81.41.41.51.31.61.81.6110.80.90.41.00.70.70.60.60.90.6120.71.11.01.31.11.60.91.20.91.1132.71.51.31.62.13.22.02.22.62.9142.32.00.82.51.71.93.11.31.71.8152.22.91.63.32.22.42.52.73.12.4163.03.23.03.73.42.63.22.12.92.8172.62.42.02.12.42.33.12.32.32.9181.20.81.21.20.91.21.61.91.41.5194.14.43.53.13.23.22.93.63.23.4202.52.72.02.22.52.21.82.62.02.1
續表

實驗號樣 品12345678910213.02.93.73.32.23.74.34.04.13.2224.53.13.23.82.53.93.42.83.13.5232.02.71.82.12.12.82.01.82.33.5243.83.93.73.94.33.93.54.13.43.9252.73.84.12.93.93.23.51.84.65.2263.43.12.51.32.62.82.32.92.81.6274.12.32.83.63.44.74.13.05.23.9
2.5SN比的計算
鈀的沉積速率值為望大特性,其計算公式是:

=7.22(dB)
同理可得SN2,SN3,…,SN27的值。
2.6對測得的沉積速率數據進行分析
使用MINITAB軟件,選擇菜單【統計】/【DOE】/【田口】/【分析田口設計】把測量所得數據粘貼在“響應數據位于”上,表5和表6是軟件的分析結果。
表5均值響應
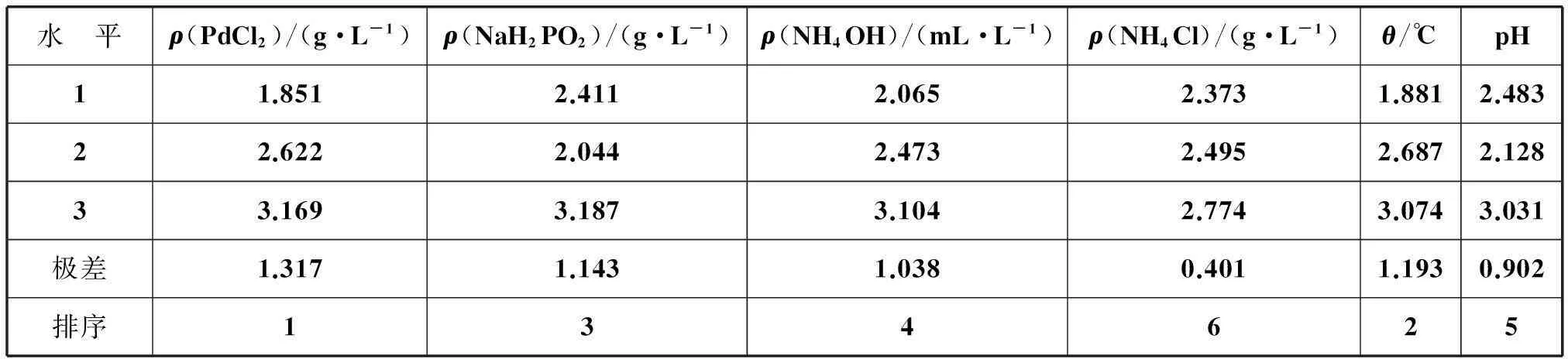
水 平ρ(PdCl2)/(g·L-1)ρ(NaH2PO2)/(g·L-1)ρ(NH4OH)/(mL·L-1)ρ(NH4Cl)/(g·L-1)θ/℃pH11.8512.4112.0652.3731.8812.48322.6222.0442.4732.4952.6872.12833.1693.1873.1042.7743.0743.031極差1.3171.1431.0380.4011.1930.902排序134625
在表5中匯集分析了各個因子不同水平均值的平均值和均值的極差。通過觀察極差的大小排序,就能發現每個因子對于均值的影響程度,依重要度從大到小順序排列為因子ρ(PdCl2)、鍍液θ、ρ(NaH2PO2)、ρ(NH4OH)和pH,因子ρ(NH4Cl)最小,幾乎沒有影響。
表6信噪比響應表(望大)
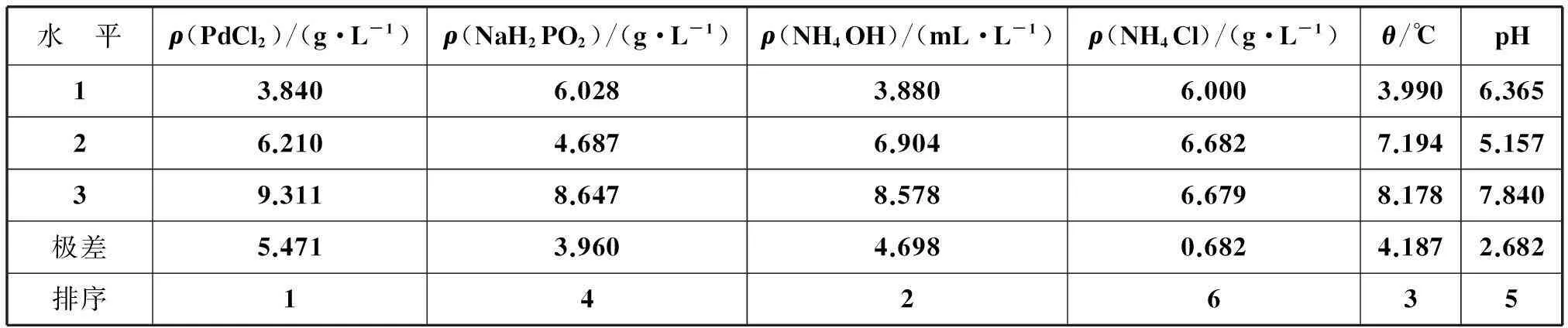
水 平ρ(PdCl2)/(g·L-1)ρ(NaH2PO2)/(g·L-1)ρ(NH4OH)/(mL·L-1)ρ(NH4Cl)/(g·L-1)θ/℃pH13.8406.0283.8806.0003.9906.36526.2104.6876.9046.6827.1945.15739.3118.6478.5786.6798.1787.840極差5.4713.9604.6980.6824.1872.682排序142635
在表6中匯集分析了各個因子不同水平的信噪比平均值和信噪比均值的極差值,通過觀察極差的大小排序,就能發現每個因子對信噪比的影響程度,依重要度從大到小順序排列為因子ρ(PdCl2)、ρ(NH4OH)、鍍液θ、ρ(NaH2PO2)和pH,因子ρ(NH4Cl)最小,幾乎沒有影響。
對上列試驗結果進行分析,能夠看出各因子對散度和位置的影響程度:A、E、B因子對均值影響相對較大,所以是位置因子;A、C、E因子對信噪比影響相對較大,所以是散度因子;因子B不是散度因子,卻是位置因子,由此確定B為調節因子。A、E因子不但是位置因子,還是散度因子。
通常,優化望大特性變量需要兩步,一是找到使位置達到最大化的位置因子的水平;二是選擇非位置因子的散度因子的水平使散度最小化[6]。
經過MINITAB軟件計算得出健壯設計均值主效應分析圖如圖1。

圖1 健壯設計均值主效應分析圖
經過MINITAB軟件計算得出健壯設計SN比主效應分析圖如圖2。

圖2 健壯設計SN比主效應分析圖
依據優化望大特性變量的要求,找到使位置達到最大化的位置因子(A、E、B)的水平。即是因子ρ(PdCl2)取3水平(2.2g/L),鍍液溫度取3水平(55℃),ρ(NaH2PO2)取3水平(13.2g/L)。
在上述因子組合確定后,用因子ρ(NH4OH)的各個水平進行調試,因為它是散度因子而不是位置因子,從而達到讓散度最小化的目的[7]。
使用MINITAB軟件,選擇菜單【統計】/【DOE】/【田口】/【預測田口結果】,得到如表7所示的預測結果。
表7健壯設計預測結果表

ρ(NH4OH)/(mL·L-1)ρ(PdCl2)/(g·L-1)θ/℃ρ(NaH2PO2)/(g·L-1)預測信噪比預測平均值1502.25513.213.67854.260561352.25513.210.65373.852961652.25513.215.35214.89128
從表7可知,在ρ(NH4OH)取不同值時,信噪比都保持較好結果,當ρ(NH4OH)取165mL/L(即3水平)時,鈀的沉積速率信噪比和平均值達到最大值。
根據以上分析,因子水平組合A3B3C3E3F3是最優化工藝參數,對于因子D,因其影響很小,可根據鍍鈀工藝的經濟性,取適宜水平即可[8-10]。
3試驗驗證
按照所得到的最優化工藝參數,進行化學鍍Pd驗證試驗。設置2.2g/L PdCl2,13.2g/L NaH2PO2,165mL/L NH4OH,33g/L NH4Cl,鍍液θ為55℃,鍍液pH 9.6。圖3是化學鍍Pd參數優化后鈀沉積速率的過程能力狀況,圖4是化學鍍Pd參數優化前鈀沉積速率的過程能力狀況。可以看出,應用優化后的工藝參數,鈀的沉積速率均值從6.4g/(m2·min)提升到48.3g/(m2·min)沉積明顯加快,集中度也得到顯著提高。

圖3 鍍鈀參數優化后鈀沉積速率的過程能力狀況

圖4 鍍鈀參數優化前鈀沉積速率的過程能力狀況
4結論
本文使用試驗設計中的健壯設計方法,探索研究了ENEPIG印制電路板中化學鍍Pd的最優化工藝參數。根據優化結果,改進了化學鍍Pd這一關鍵工藝的參數:2.2g/L氯化鈀,13.2g/L次磷酸鈉,165mL/L氫氧化銨,33g/L氯化銨,鍍液θ為55℃,pH為9.6。驗證試驗表明,應用改善后的鍍鈀工藝后,鈀的沉積速率有明顯加快,集中度也得到顯著提高。
參考文獻
[1]章建飛,張庶,向勇,等.表面處理工藝的新發展[J].印制電路信息,2014,(1):18-22.
[2]陳步明,郭忠誠.化學鍍研究現狀及發展趨勢[J].電鍍與精飾,2011,33(11):11-15.
[3]吳道新,劉迎.印刷電路板上化學鍍鈀工藝研究[J].稀有金屬材料與工程,2012,(4):681-684
[4]劉菲,趙彥亮,王文霞.溫度對化學鍍鈀層性能的影響[J].電鍍與涂飾,2013,(5):25-27.
[5]郭宇,吳紅梅,張雄福,等.化學鍍法制備鈀膜工藝[J].電鍍與涂飾,2011(4):15-18.
[6]馬林,何楨.六西格瑪管理[M].2版.北京:中國人民大學出版社,2007:195-197.
[7]于金偉.田口試驗設計在鍵合工藝參數優化中的應用[J].壓電與聲光,2012,(4):631-635.
[8]Ho C E,Yang S C,Kao C R.Interfacial reaction issuses for led-free electronic solders[J].Journal of electronic material,2007,18(1-3):155-174.
[9]Chen H T,Wang C Q,Yan C,et al.Crossinteraction of interfacial reactions in Ni(Au/Ni/Cu)/Sn-Ag-Cu solder joints during reflow soldering and thermal aging[J].J Electronic Materials,2007,36:26-29.
[10]Zeng K J,Stierman R,Abbott D,et al.Root cause of black pad failure of solder joints with electroless nickel/immersion gold plating[C]//Thermal and Thermomechanical Phenomena in Electronics Systems, 2006. ITHERM '06. The Tenth Intersociety Conference on San Diego,CA.2006:1111-1119.
基金項目:國家星火計劃項目(2011GA740047);山東省自然科學基金項目(ZR2012EML03);山東省國際科技合作
收稿日期:2015-06-27修回日期: 2015-08-04
中圖分類號:TQ153.19
文獻標識碼:A
doi:10.3969/j.issn.1001-3849.2016.01.004

