噴淋式GaN-MOCVD反應室的數值模擬及研究
羅磊,曹盛,湯繪華
(1.南昌黃綠照明有限公司,江西 南昌 330047;
2.南昌大學,江西 南昌 330047)
噴淋式GaN-MOCVD反應室的數值模擬及研究
Numerical simulation and research of spraying GaN-MOCVD reaction chamber
羅磊1,2,曹盛1,2,湯繪華1
(1.南昌黃綠照明有限公司,江西 南昌 330047;
2.南昌大學,江西 南昌 330047)
本文以低壓、旋轉、垂直噴淋式的GaN-MOCVD反應室為研究對象,運用計算流體力學(CFD)方法對反應室內部的輸運過程進行了比較詳細數值模擬及研究。數值模擬研究結果發現:在一定外延材料工藝生長參數范圍內,加大進氣流量(Q)可以有效抑制熱浮力效應,從而使反應器內部的流場均勻分布。數值模擬結果不僅對GaN-MOCVD反應室機械結構設計有重要的指導作用,同時也對高品質的外延材料生長工藝參數優化和調試具有重要的參考價值。
GaN-MOCVD反應室;數值模擬;CFD;熱浮力效應
GaN 材料在LED照明、高溫大功率微電子器件、信息顯示存儲和讀取等領域有著廣闊的應用前景,因此,GaN 的制備已經引起越來越多研究人員的關注[1-5]。 而目前公認的最佳 GaN 薄膜生長工藝方法是:金屬有機化合物化學氣相沉積(MOCVD),其原理是將氣態的金屬有機物(TMGa或TEGa等MO源)稀釋于輸運氣流中,與反應氣體NH3同時注入反應室內被加熱的高溫載片表面,在高溫下反應物氣體分解、反應、沉積等一系列氣相與表面化學反應并生成GaN 晶體薄膜。由于反應氣體間存在著熱量和質量的傳輸,使得GaN-MOCVD 反應室內的流場和溫度場十分復雜;目前國內科研院所對GaN-MOCVD反應室數值模擬也做了很多有益的工作,并取得了不少的有意義的成果[6-11]。
本文將基于某生產型立式噴淋式GaN-MOCVD反應室的物理機理提出模型和氣體動力學原理,利用商業計算流體力學(CFD)軟件對該GaN-MOCVD反應室內流場進行二維數值模擬及研究。通過調節進氣流量(Q)得到反應室流場結構數值模擬結果;由此來研究該工藝參數對GaN晶體薄膜生長質量的影響,以提高流場結構品質,優化GaN 晶體薄膜生長質量。
1 GaN-MOCVD反應室物理結構及數值模擬簡化模型
本文研究的GaN-MOCVD反應室采用垂直流設計,GaN-MOCVD反應室物理結構和數值模擬簡化模型如圖1、圖2所示。因為該GaN-MOCVD反應室具有自然的對稱軸,因此數值模擬簡化模型可采用二維軸對稱數學模型,模擬結果只表征中心軸一側的情況,從而減少計算機的計算工作量。
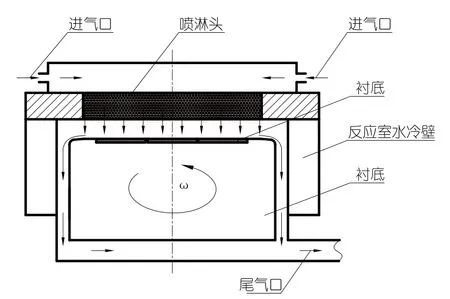
圖1 GaN—MOCVD反應室物理結構示意圖

圖2 簡化的數值模擬模型
2 數值模擬控制方程
結合方程求解和反應室內的實際流動情況,對數值模擬模型做如下假設和簡化:
(1)反應室內氣流速度很低,可假設流動為層流狀態;
(2)反應室內的流動是有粘、定常的;
(3) 反應室內氣體滿足連續流體假設和理想氣體狀態方程;
(4)由于反應物MO源占載體氣流的比例不足1%,故可以忽略化學反應造成的MO源組分的變化對流場和溫度場的影響。
GaN-MOCVD反應室內流動的數學模型為一組耦合的三維偏微分方程[12]:
連續性方程:

動量方程:

組分方程:

能量方程:

狀態方程:

其中:ρ為密度;ui為速度矢分量;gi為重力加速度;p為壓力;μ為分子粘性;T為溫度;Pi為環境壓力,Pi=1.0135×105Pa;Ms為s組分的摩爾質量;Ys為s組份的質量分數;R為通用氣體常數;q和w分別是化學反應的熱量源項和質量源項;施密特數Sc和普朗特數Pr在計算中取值為Sc=Pr=0.7。
3 數值模擬過程與結果分析
3.1 進氣流量(Q)對流場的影響
選定與實際相同的參數作為基準條件:反應室直徑為250 mm,噴淋頭底部與襯底的距離為11 mm,石墨基座表面溫度為1 000 ℃,石墨基座旋轉速度為50 rpm,重力加速度為g=9.8 m2/s,數值模擬中主要反應氣體為TMGa和NH3,載氣為H2和N2的混合氣體,其中TMGa流量固定為50 mL/min,氣體體積組分NH3∶H2∶N2=40%∶30%∶30%,進氣溫度60 ℃。反應室壓力設定為100 torr,進氣流量選取一組數據為:10、20、40 L/min。
從圖3(a)、(b)、(c)可以看出進氣流量對反應室內部流場有重要影響。由圖3(a)可以看出在進氣流量較小的情況時,在石墨基座上方流場出現了渦流,這是由于反應室側壁與石墨基座熱浮力對流產生的。從圖3(b)可以看出隨著進氣流量的加大,熱浮力對流受到了抑制,石墨上方的流場已趨于穩定,從圖3(c)可以看出當進氣流量加大到一定值,熱浮力對流很小,石墨基座上方流場也趨于穩定,但是相對于進氣流量為20 L/min來說進一步加大進氣流量也會使徑向速度增大,徑向速度增大將使氣流通過襯底表面的時間縮短從而導致MO源材料消耗量增加。可知進氣流量加大有利于GaN-MOCVD反應室流場穩定,但也不是越大越好,流量值應當適宜。
同時加大反應室進氣流量對襯底表面材料薄膜厚度均勻性也有重要影響;加大反應室進氣流量這樣使得傳質系數也增大,有利于MO源材料分子在反應室內迅速擴散,這樣就改善了MO源材料分子在常壓下組分分布不均勻的缺點,所以降低反應室壓力有利于得到大面積均勻厚度的襯底表面材料薄膜。
4 結論
本文基于計算流體力學(CFD)技術對某生產型GaN-MOCVD反應室的二維空間流場進行了數值模擬。數值模擬結果有效的再現了具有復雜機械結構和部件運動方式的GaN-MOCVD反應室二維空間流場結構。數值模擬結果不僅對GaN-MOCVD反應室機械結構設計有重要的指導作用,同時也對高品質的外延材料生長工藝參數優化和調試具有重要的參考價值;數值模擬結果發現:

圖3 不同進氣流量下GaN—MOCVD 反應室的流場
(1)適度加大反應室進氣流量,有利于抑制GaN-MOCVD反應室側壁與石墨基座熱浮力對流,從而減少石墨基座上方的渦流,增加GaN-MOCVD反應室流場的平穩性。
(2)適度加大反應室進氣流量,這樣就使得傳質系數也增大,有利于MO源材料分子在反應室內迅速擴散,有利于得到大面積均勻厚度的襯底表面材料薄膜。
[1] 楊基南,劉亞紅. GaN-MOCVD設備產業化發展戰略研究[J]. 新材料產業,2003,6:17~19.
[2] 章其麟,孫文紅,劉燕飛. GaN 材料生長研究[J]. 半導體情報,1997,34(5): 6~9.
[3] 陸大成,汪度,王曉暉. GaN 的 MOCVD 生長[J]. 半導體學報,1995,16(11): 831~834.
[4] 曹傳寶,朱鶴孫. 氮化鎵薄膜及其研究進展[J]. 材料研究學報,2000,14(增刊).
[5] 趙育明,周科衍. 氮化鎵的性質及其金屬有機化學蒸汽沉淀法[J]. 現代化工,1996,3:51~52.
[6] Jin X Z, Cong Z X and Liu M D. Numerical Simulation of Vortex Distribution in Horizontal MOCVD Reactor [J]. Chinese Journal of Sem iconductors , 1993,14(1): 21~27.
[7] Zhang JW, Gao H K, Zhang JK, et al Numerical Simulation of Return Flow in MOCVD Reactor [J}. Chinese Journal of Semiconductors .1994, 15(4):268~272.
[8] Zuo R Zhang H, Liu X L, Numerical Study of Transport Phenomena in a Radial Flow MOCVD with Threeseparate Vertical Inlets[J]. Chinese Journal of Sem iconductors ,2005,26(5): 977~982.
[9] Liu Y, Chen H X,Fu S.CFD Simulation of Flow Patterns in GaN-MOCVD Reactor[J}. Chinese Journal of Sem iconductors, 2004, 25(12);1639~1645.
[10] Guo W P, Shao J P, Luo Y, et al MOCVD Process S i m u l a t i o n o f G a N [J]. C h i n e s e J o u r n a l o f Semiconductors ,2005, 26(4): 735~739.
[11] Zuo R, Zhong H,Xu Q. Numerical Modeling and Optimization of Transport Process for Radial Flow MOCVD Reactor [J].Journal of Synthetic Crysta Is ,2005 , 34(6): 1 011~1 017.
[12] 劉奕,陳海昕,符松. GaN-MOCVD設備反應室流場的CFD 數值仿真[J]. 半導體學報,2004,25(12):1 639~1 646.
TN304
1009-797X (2015) 16-0007-03
A
10.13520/j.cnki.rpte.2015.16.003
羅磊(1984-),男,碩士,主要從事真空設備設計與數值模擬研究。
2015-07-13

