InSb光電導太赫茲源材料性質及輻射場研究
潘 武,張紅林,徐政珂,黃書璘
(重慶郵電大學光電工程學院,重慶400065)
引 言
太赫茲(terahertz,THz)波位于微波與紅外波段之間,頻率為(0.1~10)THz,處于經典理論向微觀量子理論的過渡區[1]。THz技術是一門重要的前沿學科,其中THz輻射源技術尤為重要。光電導天線作為THz波輻射常見方法之一,是目前太赫茲波輻射源研究的重要方向。
在太赫茲輻射理論分析中,光電導天線理論計算是研究重點。用光電導天線方法計算THz波近場輻射時,需考慮影響THz波近場強度的光電導材料載流子遷移率及光電導材料的表面瞬態電流等因素。當使用不同性質飛秒激光脈沖時,產生的THz波電場強度也會不同。本文中重點分析銻化銦(InSb)光電導材料載流子遷移率、光電導材料表面瞬態電流,探討不同性質抽運激光器對產生的太赫茲近場強度的影響,并比較了基于InSb和GaAs材料的THz波功率譜。
1 光電導輻射太赫茲波原理
光電導天線是目前產生和探測太赫茲波最常用的方法之一。它是利用光子能量大于半導體材料禁帶寬度的超短脈沖激光抽運半導體材料,使材料內部產生空穴電子對,然后這些空穴電子對在外加偏置電場的作用下做加速運動,從而形成一個瞬態的光電流,然后這個光電流輻射出低頻THz脈沖[2]。圖1為典型的光電導輻射太赫茲波的示意圖。傳統光電導材料都是采用GaAs,InP等化合物半導體,本文中采用的材料是InSb。這些光電導材料產生THz波的物理機制是一樣的,不同的是相比于傳統材料,InSb的載流子濃度大、遷移率高,有利于THz波輻射。在InSb材料上一般用鍺、銅、鋰合金做電極,與InSb材料形成歐姆接觸,電極之間的空隙一般為幾個毫米[3]。
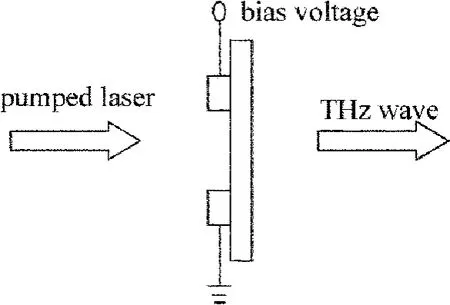
Fig.1 Diagram of photoconductive terahertz radiation
2 光電導材料中載流子遷移率和表面瞬態電流
2.1 光電導材料的載流子遷移率
當抽運激光照射到半導體材料上時,會在半導體材料內部產生光生載流子,這些光生載流子在偏置電場作用下沿固定方向運動形成瞬態電流,載流子遷移率大小是影響光電導輻射的關鍵因素[4]。InSb具有很高的載流子遷移率,是被廣泛關注的太赫茲輻射材料[5]。本文中研究InSb材料,計算并分析該材料內載流子的遷移率。
考慮到俄歇弛豫機制的主要作用,InSb材料內載流子遷移率用下式表示[6]:

式中,q為電子電量,τs為載流子弛豫時間,m*為電子的有效質量。由于俄歇弛豫在InSb半導體中的主要作用,τs近似等于俄歇弛豫時間。俄歇弛豫時間τAug可由下式得出[7]:


Fig.2 InSb mobility curve under different carrier relaxation time
式中,C2為俄歇弛豫系數,n(t)表示為載流子的濃度,變化范圍一般在(1015~1019)cm-3。圖2所示為InSb在不同載流子弛豫時間下的遷移率曲線,由圖可知,載流子弛豫時間越長,載流子遷移率越大。
很高的電子遷移率使InSb材料具備制成高電導率光電導材料的潛質,而電導率是影響表面電流以及THz近場輻射強度的關鍵因素。因此,InSb材料作為光電導輻射太赫茲波材料具有比較好的應用前景。
2.2 光電導材料的表面瞬態電流
光生載流子運動產生皮秒量級的瞬態電流,進而由瞬態電流輻射出具有太赫茲頻率的電磁波。由電磁場理論推導出的光生載流子運動產生的電流[8]為:

式中,εr表示InSb材料相對介電常數,εr=1.9994×1012;Eb為外加偏置電場,本文中采用偏置電壓為40V,天線縫隙為1mm,則Eb=4×104V/m;σs(t)為使用光吸收模型[9]計算出的電導率大小,η0為InSb材料的特征阻抗。對不同性質的載流子,其載流子壽命τc和弛豫時間τs也各不相同,對應的瞬態電流也將不同。
當使用1550nm的激光抽運InSb材料時,取不同性質的載流子得出的瞬態電流結果如圖3所示,從圖3中曲線可看出,載流子壽命相同時,載流子弛豫時間越大,瞬態電流越強;載流子弛豫時間相同時,載流子壽命越長,瞬態電流越強。出現該現象的原因是根據光吸收模型[9],σs(t)與載流子壽命 τc和弛豫時間 τs成正比,而根據(3)式可知,電流js(t)的大小與σs(t)成正比,因此js(t)與載流子壽命τc和弛豫時間τs成正比,js(t)隨著τc和τs的增大而增大。因此從材料選擇方面,可根據實際情況選擇具有較高壽命和弛豫時間的載流子的材料,為太赫茲波輻射創造有利條件。

Fig.3 InSb transient current under different carriers
根據半導體理論,總電流為漂移電流和擴散電流之和[10],總電流強度為:

在用半導體理論研究InSb材料的電流時,要求其大小,需確定InSb材料的光生載流子濃度和載流子遷移率。比較利用半導體理論微觀分析獲得的InSb材料表面電流與利用電磁場理論分析的結果,將載流子遷移率和濃度計算公式帶入(4)式中,圖4為兩種方法的比較曲線,實線為圖3中τc=20ps,τs=10ps時得出的電流曲線,虛線為采用半導體理論計算到的電流曲線,采用的參量τs=10ps。圖中縱坐標取值為相對量,無量綱。從圖4看出,兩條曲線的走勢基本一致,達到峰值的時間基本相同,約為25ps。圖中兩條曲線的最大差別在于使用半導體理論得出的虛線曲線走勢更為平緩,而使用電磁場計算方法得出的實線走勢更為陡峭,在幾十皮秒時就開始迅速衰減,在300ps以后電流大小趨近于0。兩條曲線在200ps以后出現差別較大的原因是使用半導體物理學分析方法沒有考慮光生載流子的壽命問題,只考慮了載流子很短的弛豫時間τs,而電磁場推導出來的電流公式考慮了所有影響因素,包括載流子很短的壽命τc。由于InSb材料的載流子壽命短,在100ps之后載流子濃度快速下降,所以使用電磁場方法計算得到的結果更貼近于實際情況。

Fig.4 Current curves obtained with two kinds of methods
3 不同性質的飛秒抽運激光對太赫茲輻射場的影響
若不同性質的飛秒激光器抽運,得到的THz輻射場也不同。當使用不同飽和能量密度的飛秒激光抽運InSb材料時,產生的THz波近場電場強度Enear(t)也各不相同。圖5所示為使用不同飽和能量密度的飛秒激光抽運InSb得出的結果,計算參量為:載流子壽命τc=20ps,載流子弛豫時間τs=10ps,抽運激光脈沖寬度Δt=100fs,抽運光波長為1550nm,飛秒激光飽和能量密度 F 分別為4×10-11μJ/cm2,6×10-11μJ/cm2和8×10-11μJ/cm2。由圖5可看出,飽和能量密度F越大,產生的THz輻射場幅值越大。這是由于更強的飛秒激光可產生更高的載流子濃度,從而產生較大的電流,進而產生更強的太赫茲波。

Fig.5 THz field under different laser saturation energy density
當使用不同脈沖寬度的飛秒激光脈沖抽運InSb材料時,產生的THz波的近場強度也各不相同。圖6為使用不同脈沖寬度的飛秒激光抽運InSb得出的結果,計算參量為:τc=20ps,載流子弛豫時間 τs=10ps,抽運光波長為1550nm,抽運激光飽和能量密度F=8×10-11μJ/cm2。由于一般實驗中用的飛秒激光器發出的激光脈沖一般在幾十飛秒至幾百飛秒之間,因此本文中對比了脈寬50fs,100fs和200fs的飛秒激光抽運InSb材料的THz近場強度的大小。由于脈沖越短的飛秒激光抽運InSb可產生更高的載流子遷移率和電導率,從而產生更強的表面瞬態電流,進而增大THz近場強度的幅值。
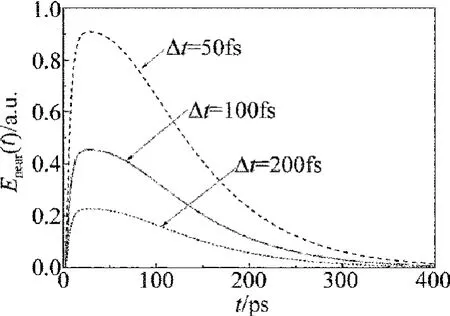
Fig.6 THz field under different pulse width femtosecond laser
4 太赫茲輻射場的功率譜分析
光電導產生THz波機理可用電流瞬沖模型解釋,即光生載流子加速運動產生皮秒量級的表面瞬態電流,從而輻射出THz波。表面瞬態電流js(t)和THz近場輻射Enear(t)的關系[8]如下式所示:

對近場輻射Enear(t)進行頻域變換,應用MATLAB中的pwelch函數對近場輻射Enear(t)進行功率譜估計。采用pwelch函數得出的是時間序列信號的功率如何隨頻率分布。由于在Enear(t)的計算中設置的時間步長為1ps,因而設置pwelch函數中的抽樣頻率f=1THz,計算得出的功率譜曲線如圖7所示,仿真所用抽運光波長為1550nm,抽運激光飽和能量密度F=8 ×10-11μJ/cm2,抽運激光脈沖寬度 Δt=100fs,InSb載流子參量為τc=20ps,τs=10ps。從圖7中可以看出,仿真得到InSb光電導產生的THz波中心頻率為0.2THz,峰值功率約為1.7mW。

Fig.7 THz wave power spectrum curve of InSb photoconduction
本文中計算了GaAs材料近場輻射結果,如圖8所示,為近場THz輻射的頻譜。計算中用的抽運光波長為800nm,GaAs載流子壽命τc=1ps,載流子弛豫時間τs=0.5ps,在0.1THz附近GaAs材料光電導輻射THz波功率達到峰值,峰值功率為0.228μW,GaAs輻射源為微瓦量級,InSb輻射源為毫瓦量級。因此,從理論上InSb材料的光電導輻射源具有較好的應用前景。

Fig.8 THz wave power spectrum curve of GaAs photoconduction
5 結論
分析了InSb材料中的載流子性質,不同性質載流子會產生不同的表面電流,利用電磁場理論計算了光電導材料表面電流。結果表明,電流的產生與載流子壽命和弛豫時間有關,載流子弛豫時間越長,壽命越長,表面電流越強。分析了不同性質飛秒激光器對THz輻射功率的影響,結果表明,飽和能量密度越高,脈沖寬度越短的飛秒激光器能夠產生強度越高的THz近場輻射。分析了基于InSb材料光電導輻射THz波功率譜,THz波中心頻率為0.2THz,最大功率為1.7mW,比常見Si,GaAs等材料輻射的功率高。所以基于InSb材料輻射THz波的方法有較高的研究價值。
[1] ZHU B,CHEN Y,DENG K,et al.Terahertz science and technology and its applications[J].Journal of Chengdu University(Natural Science Edition),2008,27(4):304-307(in Chinese).
[2] SUN B,YAO J Q.Generation of terahertz wave based on optical methods[J].Chinese Journal of Lasers,2006,33(10):1349-1359(in Chinese).
[3] PAN W,HUANG S L,LI T T,et al.Terahertz photoconductive radiation theory research of InSb[J].Laser Technology,2013,37(2):239-242(in Chinese).
[4] SCHOCHE S,JUNXIA S,BOOSOLIS A,et al.Terahertz optical-Hall effect characterization of two-dimensional electron gas properties in AlGaN/GaN high electron mobility transistor structures[J].IEEE Applied Physics Letters,2011,98(9):1-3.
[5] BICIUNAS A,MALEVACH Y,KROTKUS A,et al.Excitation wavelength dependences of terahertz emission from surfaces of InSb and InAs[J].Electronics Letters,2011,47(21):1186-1187.
[6] ZHANG T Y,CAO J C.Study of the surface and far fields of terahertz radiation generated by large-aperture photoconductive antennas[J].Chinese Physics,2004,B13(10):1742-1746.
[7] ZUDOV M A,MITCHELL A P,CHIN A H,et al.Terahertz magneto-spectroscopy of transient plasmas in semiconductors[J].Journal of Applied Physics,2008,94(5):3271-3277.
[8] PAN W,HUANG S L,LI G X,et al.Theoretical study of terahertz radiation through InSb photoconduction[J].Laser and Infrared,2013,43(4):438-441(in Chinese).
[9] JAMES L H,TAE I J.A review of the terahertz conductivity of bulk and nano-materials[J].Journal of Infrared,Millimetre and Terahertz Waves,2012,33(9):871-925.
[10] LIU E K,ZHU B S,LUO J S,et al.Semiconductor physics[M].4th ed.Beijing:National Defense Industry Press,1997:116-145(in Chinese).

