薄膜晶體管液晶顯示器陣列工藝最終關鍵尺寸測試方法研究
劉 耀?,陳 曦,張小祥,劉曉偉,李梁梁,丁向前,郭總杰,袁劍峰
(北京京東方顯示技術有限公司,北京100176)
薄膜晶體管液晶顯示器陣列工藝最終關鍵尺寸測試方法研究
劉 耀?,陳 曦,張小祥,劉曉偉,李梁梁,丁向前,郭總杰,袁劍峰
(北京京東方顯示技術有限公司,北京100176)
最終關鍵尺寸是評價薄膜晶體管液晶顯示器產品性能的一項重要參數。本文研究了在光源照度變化的條件下得到準確的最終關鍵尺寸的方法。通過大量的實驗測試、數據分析,并配合掃描電子顯微鏡(SEM)圖片,確定最終關鍵尺寸合適的測試條件和方法。基于上述分析,選取測量值穩定的光照強度區間中心點的光照強度作為標準樣品參照值,選取此時樣品測試圖片作為標準圖片。測試結果與SEM結果進行對比,得到不同膜層測量值和真實值之間的補償值。并通過不同尺寸產品的數據收集和分析來驗證補償值的可靠性。通過上述方法,可以極大地縮短最終關鍵尺寸測量的校正周期,并為今后新產品開發提供可靠的測試標準。
最終關鍵尺寸;測試方法;掃描電子顯微鏡;補償值
1 引 言
薄膜晶體管液晶顯示器近十年來發展迅猛,形成了近千億美元的巨大產業規模,應用領域覆蓋廣,技術發展更趨成熟,全球產業配套完成,在平板顯示中占據了主導和主流地位。薄膜晶體管液晶顯示器作為當今社會顯示領域的主要技術,已經被非常廣泛的應用在了交通、通訊、計算機、家電、工業、教育、醫療等領域[1-3]。隨著顯示技術的發展和市場的需求,高分辨率(單位面積像素個數)顯示器越來越受人們的青睞。實現高分辨率,就需要更細的線寬和更窄的間距[4-5]。線寬越細,對線寬測量值的準確性要求越高。線寬(即最終關鍵尺寸)作為影響產品性能的一項重要參數,準確的線寬測量值才能反映產品的真實情況。實際生產過程中,一般都采用光學設備對線寬進行測試。金屬層的反光效果明顯,對光照強度的變化很敏感。同時,透明膜層測量邊界的獲取也受光照強度的影響。本輪文主要研究了如何在光照強度變化的情況下,在不增加其他校正手段的情況下,保證最終關鍵尺寸測量的準確性。
2 測試誤差原理分析[6-9]
如圖1所示,金屬層和非金屬層在完成刻蝕工藝之后,邊界都是有坡度存在的形貌。關鍵尺寸測試設備在工作過程中,使用衍生邊檢測器,利用衍生閾值和遲滯閾值的不同來區分邊界。EMag作為邊界強度。如果EMag小于衍生閾值,則該像素被看作是弱的邊界分隔點;如果EMag在衍生閾值和衍生閾值與遲滯閾值總和之間,則該邊界像素被看作是候選邊界分隔點;如果EMag比衍生閾值和遲滯閾值的總和大,則該點就是強的邊界分隔點,適合用來進行邊界分析。在使用過程中,一般選擇邊界強度最大的點作為邊界分隔點進行數據分析。這樣測量值會小于樣品的實際值,原理如圖2所示。關鍵尺寸測試設備在使用透射光工作時,由于測試光源是從下往上透過產品再傳至鏡頭,這樣鏡頭所接收的影像是陰影的部分,造成測量值會比實際值偏大的影響。但是使用落射光時,鏡頭所接收到的影響的焦點是同一焦點,不管自動對焦的誤差如何,落射光所量測出來的關鍵尺寸線寬都是相當穩定的,原理如圖3所示。
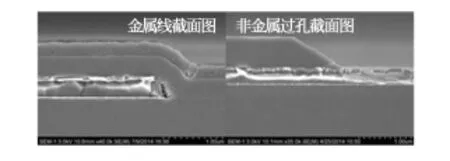
圖1 測試樣品邊界截面圖Fig.1 Boundary section of test samples
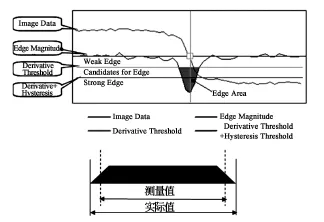
圖2 落射光測試原理示意圖[1]Fig.2 Measuring principle diagram of reflected light
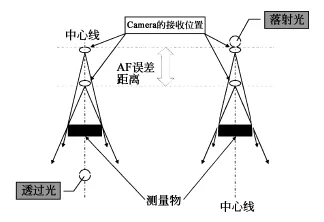
圖3 光學成像原理圖Fig.3 Schematic diagram of optical imaging
3 實驗方法
制備不同膜層的測試樣品時,測試設備和測試鏡頭之間的數據收集必須要保證同一樣品中相同的測試點位。分別收集5%、10%、20%、30%、40%、50%、60%、70%、80%、90%、100%亮度條件下樣品的最終關鍵尺寸。可以根據測試膜層條件的不同,適當地增加測試光照強度。對比不同設備、不同鏡頭之間的測試結果,選取燈頭當前條件下樣品測量值穩定的光照強度區間,然后對其進行再次確認,獲取標準測試圖片。將測試過的樣品制作成SEM測試樣品(針對關鍵尺寸測量過的點位),SEM樣品數量不少于20個。設備測試所得到的數據取平均值和SEM測試所得到的數據取平均值進行對比,得到補償值。選取至少3款其他尺寸樣品,以標準測試圖片的光照強度為基準進行關鍵尺寸測試和SEM校正,獲取補償值,驗證補償值的準確性和可靠性。柵極金屬線采用透射光模式進行測量,其余各層采用落射光模式進行測量。
4 數據分析
圖4是同一樣品、同一鏡頭,不同測試模式下的關鍵尺寸測量結果。從圖中我們可以看出,透射光模式下,測量結果受光照強度影響很小,盡可能選取透射光模式進行最終關鍵尺寸的測量。但是氧化銦錫層是半透明膜質;4Mask條件下,數據線號線受有源層拖尾影響;鈍化層過孔做在數據線號層金屬上。因此氧化銦錫層、數據信號線和鈍化層過孔都不能用透射光模式。而柵極金屬線直接做在玻璃基板上,不受其他層影響,可以采用透射光模式進行測量。透射光的測試結果會大于落射光的測試結果,原因可見測試誤差原理分析。

圖4 不同測量模式柵極金屬層的關鍵尺寸測試結果Fig.4 Critical dimension results of metal layer under different measurement model
圖5是46 in樣品不同光照強度下關鍵尺寸測試結果。其中01/02/03代表不同設備編號, H1/H2代表同一臺設備不同測試探頭。每一個光照強度下的數值都是48個測試點位測量數值的平均值。落射光模式下,關鍵尺寸測量結果會隨著測試光照強度的變化發生改變。由于金屬對光線的反射效果,數據信號線和鈍化層過孔在光照強度達到一定的程度后,關鍵尺寸測試設備就無法進行正常測量。透射光模式下,關鍵尺寸測試結果受光照強度的變化影響不大。不同測試鏡頭之間的差異主要是由燈頭光源強度不同引起的。基于測量結果穩定性和測試誤差(≤0.1 μm)的考慮,光照強度區間選擇在表1中給出。

圖5 不同光照條件下各膜層下關鍵尺寸測試結果Fig.5 Critical dimension results of total layers under different lighting conditions

表1 測試結果穩定的光照范圍Tab.1 Lighting range of stable measuring tests
圖6是46 in樣品測試結果穩定的光照區間初始測試和再次確認的關鍵尺寸測試結果。從測試結果可以看出,在選定的測試區間內測試結果比較穩定,誤差也在可接受的范圍內。此光源條件下,各層光照強度的選擇:氧化銦錫層選擇40%,柵極金屬線選擇40%,數據信號線選擇15%,鈍化層過孔選擇15%。表2給出了標準亮度測試圖片、測試條件、相應的測試結果及偏差(SEM-線寬)。綜合考慮,氧化銦錫層選取-0.1μm,柵極金屬線選取-0.3μm,數據信號線選取0.6μm,鈍化層過孔選取0.4μm作為補償值。

圖6 穩定光照區間下關鍵尺寸兩次測試結果Fig.6 Critical dimension double results under stable lighting range

表2 標準亮度測試圖片和測試條件的選擇Tab.2 Standard luminance test Images and the corresponding test conditions
表3給出了標準亮度條件下,其他尺寸產品的柵極金屬層最終關鍵尺寸測試結果。可接受的誤差范圍為±0.1μm。柵極金屬層的最終關鍵尺寸在選用透射光測試時,補償值選取-0.3 μm,金屬總膜厚在295~465 nm之間,真實值和測試值之間的偏差都在±0.1μm以內,滿足測試要求。
表4給出了標準亮度條件下,其他尺寸產品的數據信號線 最終關鍵尺寸測試結果。數據信號線的最終關鍵尺寸在選用落射光測試時,補償值選取0.6μm,金屬總膜厚在320~415 nm之間,真實值和測試值之間的偏差都在±0.1μm以內,滿足測試要求。根據數據結果分析,可以得出一定的膜層厚度,坡度角對最終測量結果的影響不大。
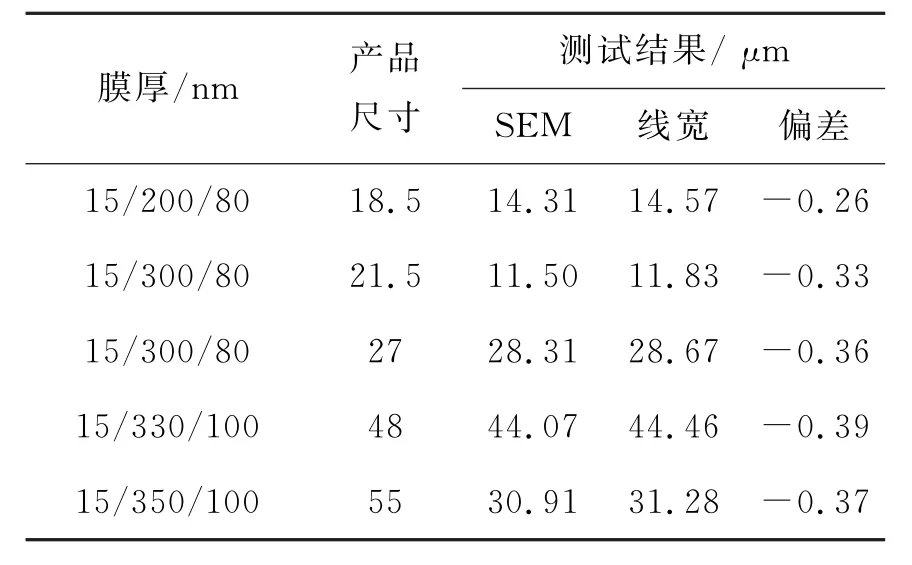
表3 標準亮度各尺寸產品柵極金屬層FICD測試結果Tab.3 Gate FICD results of all sizes products under standard luminance
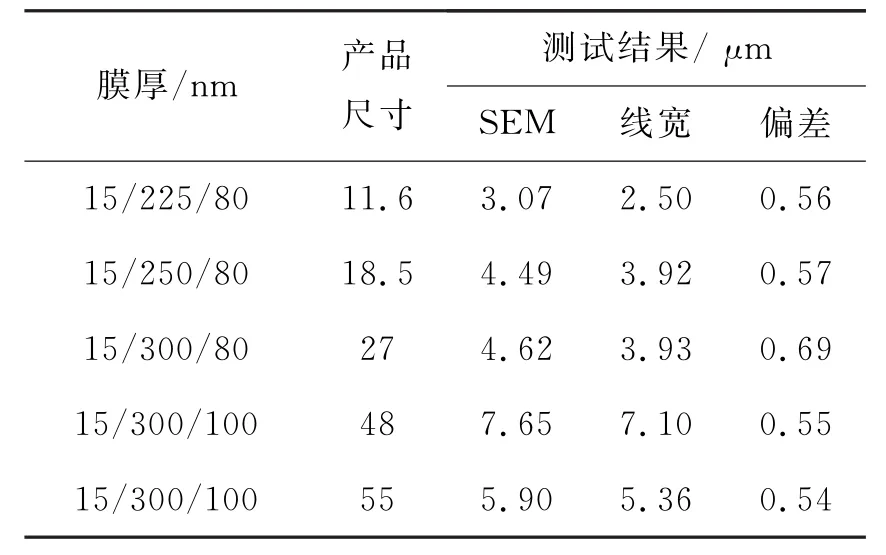
表4 標準亮度各尺寸產品數據信號線最終關鍵尺寸測試結果Tab.4 Data FICD results of all sizes products under standard luminance
表5給出了標準亮度條件下,其他尺寸產品的鈍化層過孔 最終關鍵尺寸測試結果。鈍化層過孔的最終關鍵尺寸在選用落射光測試時,補償值選取0.4μm,鈍化層膜厚在250~400 nm之間,真實值和測試值之間的偏差都在±0.1μm以內,滿足測試要求。
表6給出了標準亮度條件下,其他尺寸產品的氧化銦錫層最終關鍵尺寸測試結果。氧化銦錫層的最終關鍵尺寸在選用落射光測試時,補償值選取-0.1μm,真實值和測試值之間的偏差都在±0.1μm以內,滿足測試要求。
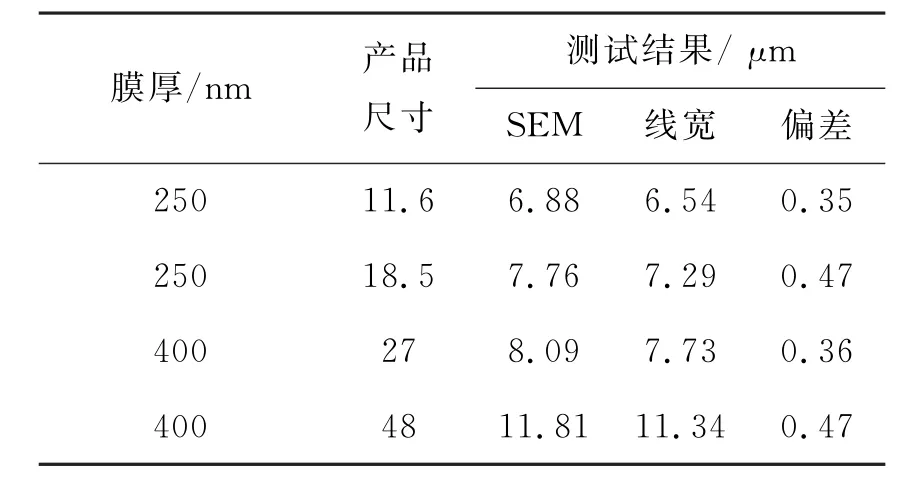
表5 標準亮度各尺寸產品鈍化層過孔最終關鍵尺寸測試結果Tab.5 Via hole FICD results of all sizes products under standard luminance
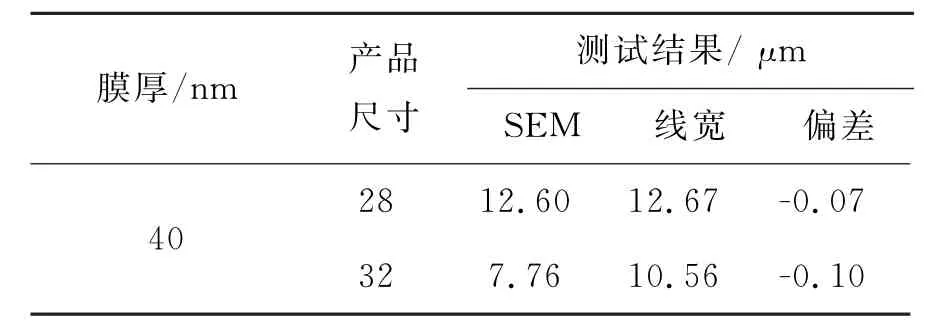
表6 標準亮度各尺寸產品氧化銦錫層最終關鍵尺寸測試結果Tab.6 ITO FICD results of all sizes products under standard luminance
表7給出了標準亮度條件下,5Mask產品的有源層最終關鍵尺寸測試結果。有源層層的最終關鍵尺寸在選用落射光測試時,補償值選取0.6 μm,真實值和測試值之間的偏差都在±0.1μm以內,滿足測試要求。
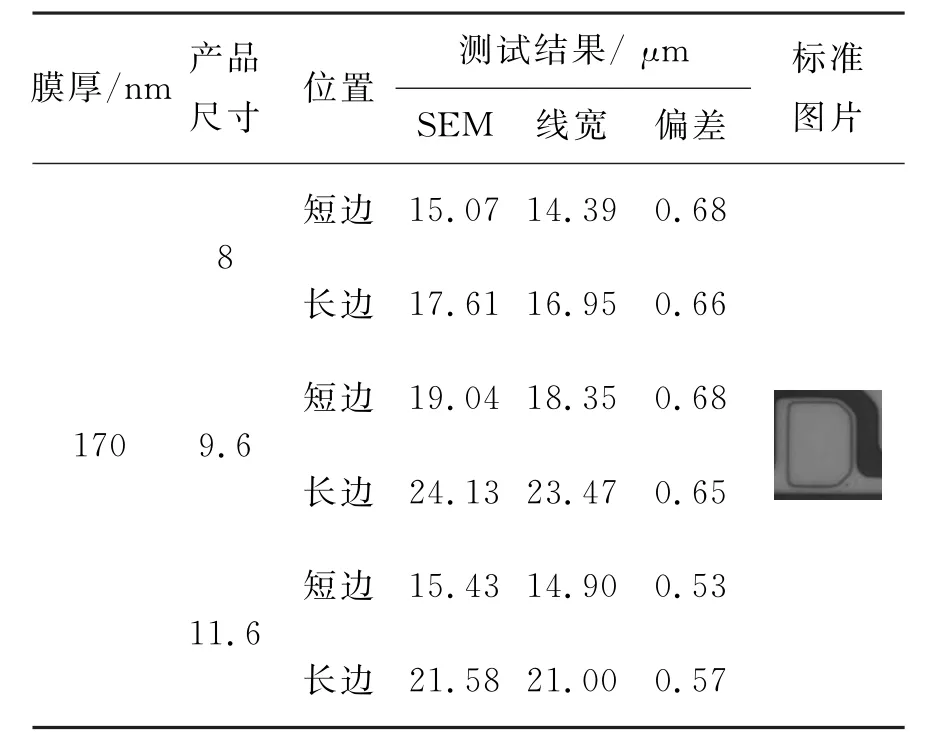
表7 標準亮度各尺寸產品有源層最終關鍵尺寸測試結果Tab.7 Active FICD results of all sizes products under standard luminance
5 結 論
最終關鍵尺寸在測量過程中,測量值會隨著測試燈頭光照強度的變化發生改變。通過數據分析,選擇特定的亮度圖片作為測試基準,同時選擇合適的補償值(柵極金屬線層:-0.3μm,數據線號線層:0.6μm,鈍化層過孔:0.4μm,氧化銦錫層:-0.1μm,有源層:0.6μm),可以保證測試結果接近測試樣品的真實值,測試誤差縮小在可接受范圍內(≤0.1μm)。這樣可以為新產品開發提供可靠的測試標準,縮短新產品開發的周期。
[1] 楊曉萍.京東方TFT-LGD競爭策略研究[D].北京:對外經濟貿易大學,2012.Yang X P.Competition strategy research on the TFT-LCD industry of BOE[D].Beijing:University of International Business and Economics,2012.(in Chinese)
[2] 吳凌劍.TFT-LCD面板行業競爭策略研究—以A公司為例[D].蘇州:蘇州大學,2013.Wu L J.The developing strategy for TFT-LCD manufacturer—a case study for A company[D].Suzhou:Soochow University,2013.(in Chinese)
[3] 李聯益.TFT-LCD液晶顯示技術與應用[J].韶關學院學報,2012,33(4):46-49.Li L Y.TFT-LCD liquid crystal display technology and application[J].Journal of Shaoguan University,2014, 33(4):46-49.(in Chinese)
[4] 黎午升,惠官寶,崔承鎮,等.在鏡像投影曝光機上使用相移掩膜提高解像力的初步研究[J].液晶與顯示,2014,29 (4):544-547.Li W S,Hui G B,Cui C Z,et al.Preliminary study on improving resolution on mirror projection mask aligner with phase shift mask[J].Chinese Journal of Liquid Crystals and Displays,2014,29(4):544-547.(in Chinese)
[5] Chun J,Kang Ch,Ahn S,et al.a-Si TFT-LCD mobile display with high pixel density using pentile RGBWTMalgo-rithm[J].Chinese Journal of Liquid Crystals and Displays,2006,21(5):474-477.
[6] Leea J H,Kim Y S,Kim S R,et al.Real-time application of critical dimension measurement of TFT-LCD Pattern using a newly proposed 2D image-processing algorithm[J].Optics and Lasers in Engineering,2010,46:558-569.
[7] Vassilios Co,Vijaya-Kumar M,Evangelos Go.Effects of image noise on contact edge roughnses and critical dimension uniformity measurement in synthesized scanning electron microscope images[J].Journal of micro/nanolithography,MEMS,and MOEMS:JM 3,2013,12(1):5-13.
[8] Vladimir U,Bill B.Review of reference metrology for nanotechnology:significance,challenges,and solutions[J].Journal of Micro/Nanolithography,MEMS,and MOEMS:JM 3,2012,11(1):10-11.
[9] Sung-Hoon P,Tai-Wook K,Jeong-Ho L,et al.Real-time critical dimension measurement of thin film transistor liquid crystal display patterns using optical coherence tomography[J].Journal of Electronic Imaging,2014,23 (1):1-13.
Final critical dimension measuring method about TFT-LCD array process
LIU Yao,CHEN Xi,ZHANG Xiao-xiang,LIU Xiao-wei,LI Liang-liang, DING Xiang-qian,GUO Zong-jie,YUAN Jian-feng
(Beijing BOE Display Technology Co.Ltd.,Beijing 100176,China)
Final inspection critical dimension(FICD)is an important parameter to evaluate the performance of thin film transistor liquid crystal display(TFT-LCD)products.The method to obtain an accurate FICD data was studied in this paper.By a large number of experimental data and the scanning electron microscope(SEM)images,test conditions and methods were determined.Based on the above analysis,the center of illumination intensity which could provide stable measuring results was selected as the reference value,and the image was collected as golden sample simultaneously.By contrasting the above results and SEM results,the compensation value of the different layers between measured value and true value were obtained.Also the reliability was proved by data analysis of different sizes of products.As a result,calibration period of FICD measurement could be reduced greatly,and reliable test standard was provided for future products.
final inspection critical dimension;measurement method;scanning electron microscope;compensation
TN307
:A
10.3788/YJYXS20153005.0784
1007-2780(2015)05-0784-06
劉耀(1985-),男,山東威海人,碩士,高級研究員,主要從事液晶面板研發和工藝改善工作。E-mail:liuyao_dt @boe.com.cn
2015-01-20;
:2015-02-06.
?通信聯系人,E-mail:liuyao_dt@boe.com.cn

