PVT法制備4英寸碳化硅單晶研究
郭俊敏+郝建民
[摘 要] 本文報道了采用PVT法,通過單晶橫向延展技術,成功制備出了4英寸碳化硅單晶,結合計算機模擬計算,重點分析了籽晶石墨托幾何結構對單晶尺寸延展的影響,結果表明圓臺結構的籽晶石墨托更有利于單晶生長初期的迅速橫向延展,進而實現大尺寸碳化硅單晶的生長,該理論分析結果與試驗結果完全吻合。
[關鍵詞] 4英寸;碳化硅;橫向延展;計算機模擬
中圖分類號:O782 文獻標識碼:A 文章編號:2055-5200(2014)01-033-03
Doi:10.11876/mimt2014010018
The research of 4 Inch Silicon Carbide Single Crystal by Physical vapor Transport GUO Jun-min,HAO Jian-min. (The 46 th Research Instirute ,CETC, Tianjin 300220)
[Abstract] This paper reports the successful preparation of 4 inch silicon carbide single crystal by PVT method.Combined with computer simulation, and analyze the influence of the graphite substrate geometry on the crystal size enlargement, the results show that the cone structure is more advantageous to rapid lateral extension at the early stage,then realize the growth of large size silicon carbide single crystal, the results of theoretical analysis agree well with the test results.
[Key words] 4inch;SiC;lateral extension;computer simulation
1 引言
作為第三代寬禁帶半導體材料的代表,碳化硅具備優異的物理性能,是制備高頻、高溫、抗輻射、大功率和高密度集成電子器件的首選材料[1]。隨著碳化硅基電子器件研究的日趨成熟,大尺寸、高質量的碳化硅需求日趨迫切,成為碳化硅研究的聚焦領域之一。目前,碳化硅單晶的生長主要采用物理氣相傳輸法(Physical vapor Transport,簡稱PVT法)[2],本文的研制成果亦是基于該方法。
2 試驗描述
本文工作采用的是自行研制的3~4英寸PVT法碳化硅單晶生長爐,其加熱采用30KW、10KHz中頻感應裝置,圖1給出了碳化硅單晶生長系統示意圖,由保溫筒(碳纖維)包裹的石墨坩堝反應腔被置于感應線圈纏繞的豎直石英管內,在整個系統的頂部和底部各有一個測溫孔,通過設備上的紅外測溫系統可以測量坩堝頂部和底部的溫度數據,典型的單晶生長溫度范圍是2100℃~2200℃。通過上下移動感應線圈,可以改變線圈與坩堝的相對位置,從而改變熱場分布。生長過程中,籽晶置于坩堝頂部,碳化硅多晶粉料置于底部,在適宜的軸向(粉與籽晶之間)溫度梯度下,碳化硅粉料受熱分解升華,在籽晶處重新結晶。
采用Ansys模擬軟件,分別對工藝試驗中采用的3種不同結構的籽晶石墨托進行模擬計算,圖2給出了這3種籽晶石墨托結構的示意圖,其中籽晶的尺寸為3英寸,在本文所開展的單晶尺寸延展工藝試驗中,我們均采用的是(c)圓臺結構。
3 結果與討論
圖3為研制得到的4英寸碳化硅單晶片的照片,從該圖可以看出,該碳化硅單晶片完整、無裂紋、彎曲度小,結晶質量較好。
PVT法碳化硅單晶生長是在高溫低壓的環境中進行的,源粉與籽晶之間的軸向溫度梯度是促進的驅動力[3-4],而生長前沿的徑向溫度分布決定了結晶表面的形狀,是影響單晶尺寸橫向延展的一個重要因素, A.R. Powell等[5]報道了通過控制徑向溫度梯度實現單晶尺寸的延展。在碳化硅單晶生長中,隨著結晶過程的進行,徑向溫度梯度將降低[6],因而控制生長初始階段單晶尺寸的迅速擴張,對于實現整個晶體的大尺寸生長尤為重要[7]。在生長初始階段營造適宜的徑向溫度梯度,以實現單晶尺寸的迅速擴張,進而實現大尺寸單晶生長正是本文研究的著眼點。
如前所述,本文碳化硅單晶設備采用感應加熱方式,它是用高頻感應線圈感應石墨坩堝,并使之發熱,溫度分布與坩堝各部件的幾何結構密切相關,對于生長初始階段生長前沿的徑向溫度分布而言,籽晶石墨托的影響最為重要。
圖4給出了計算得到的3種幾何結構的籽晶石墨托上溫度分布云圖,圖5給出了自籽晶托中心點至邊緣的徑向溫度分布曲線。從數據不難看出,當籽晶石墨托的幾何結構發生改變時,生長前沿的溫度分布發生較大的變化,具體表現在:在籽晶尺寸范圍(3英寸碳化硅籽晶的半徑為38.1mm)內,當為(a)平面結構和(c)圓臺結構時,溫度中心低,邊緣高,符合碳化硅單晶生長的理想徑向熱場條件,當為(b)圓柱結構時溫度中心高,邊緣低,與碳化硅單晶生長需要的熱場條件相悖。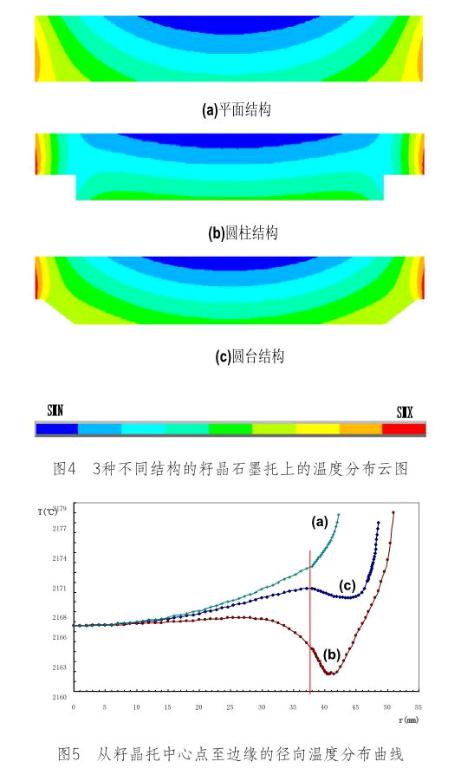
對于(a)結構,與(c)結構相比,一方面,徑向溫度梯度略大,這不利于高質量碳化硅單晶的生長[8];另一方面,由于單晶(籽晶范圍)與多晶(籽晶范圍外,石墨托表面)處于同一生長的起點,要實現單晶的擴張,需要額外嚴格控制單晶與多晶的生長速率比[9],否則會出現單晶尺寸減少的現象,另外,該結構生長條件下,單晶與多晶之間的作用力較
大,從而導致單晶內的應力過大[10],晶體或是晶片碎裂的幾率增加;對于(c)結構,除了籽晶半徑范圍內徑向溫度梯度小外,在平臺邊緣斜坡處溫度降低,這會使得該處多晶的生長速率要高于相鄰的籽晶邊緣的單晶生長速率,但相對于生長方向而言,其位置較單晶區域要低,所以在一定生長階段內不會對單晶區域構成威脅,這就為單晶的橫向擴張提供了有效的空間,另一方面,多晶的存在為單晶的橫向延展提供的良好的支撐平臺[3]。通過以上分析可知,類似于(c)結構的圓臺結構更有利于碳化硅單晶大尺寸的實現,該理論分析結果與我們的試驗結果完全吻合。
4 結論
本文采用PVT法碳化硅單晶生長方式,通過單晶橫向延展技術,成功制備出了4英寸碳化硅單晶,從試驗結果出發,結合計算機模擬計算,重點分析了籽晶石墨托幾何結構對單晶尺寸延展的影響,表明圓臺結構的籽晶石墨托更有利于單晶生長初期的迅速橫向延展,進而實現大尺寸碳化硅單晶的生長。
參 考 文 獻
[1] SrirajmS,SiergiejRR,ClarkeRC,eal.physica.Status. Solidi,1997,162(1):441-457.
[2] Tairov, Yu M,Tsvetvov .VF.ibid,1981,52(1):146-150.
[3] Bubner N, et al. A Transient Model for the Sublimation Growth of Silicon Carbide Single Crystals[J]. J. C rystal Grow th, 1999,205(3):294-304.
[4] 張群社,陳治明,蒲紅斌,等. SiC晶體PVT生長系統的流體力學模型及其有限元分析[J].人工晶體學報, 2005,34: 828.
[5] A.R. Powell, S. Wang, G. Fechko, G.R. Brandes, Mater. Sci. Forum 1998, 13:264-268.
[6] S. Nishizawa, Y. Kitou, W. Bahng, N. Oyanagi, M. NasirKhan, K. Arai, Proc. Int. Conf. on Silicon Carbide andRelated Materials, Raleigh, 1999:99.
[7] W. Bahng , Y. Kitou, S. Nishizawa, H. Yamaguchi, M. Nasir Khan. Journal of Crystal Growth 2000,209 :767-772.
[8] 張群社,陳治明,李留臣,等.PVT法生長大直徑6H2SiC晶體感應加熱對系統的影響[J]. 人工晶體學報,2007,36:181.
[9] Yu.M. Tairov.Growth of bulk sic[J].Materials Science & Engineering B,1995,29(1):83-89.
[10] A.S. Bakin, S.I. Dorozhkin, A.O.Lebedev,B.A. Kirillov,A.A. Ivanov, Yu.M.Tairov,J. Crystal Growth.1999,1015:198-199.

