激光干涉光刻工藝開發與應用研究*
于 航,陸冰睿,陳國平,劉 冉
(復旦大學微電子系專用集成電路與系統國家重點實驗室,上海 200433)
0 引言
近年來,微納科學的飛速發展對微加工技術提出更高的要求[1]。盡管微納結構可以通過自下而上或者自上而下的方法進行加工,例如:化學自組裝、等離子體刻蝕、化學氣相沉積或者納米壓印等方法[2,3]。但這些方法在大面積地制作從亞微米到數個微米區間的周期性結構時,仍然存在工藝過程復雜或者價格昂貴等諸多缺點[4,5]。而激光干涉光刻工藝為在材料表面大面積加工周期性的微納結構提供了一種非常有效的方法[6]。現階段大量使用的中低端光刻機的極限加工尺度為3~5 μm,而激光干涉光刻可以很容易地加工大面積的、尺度從幾百個納米到幾個微米的周期性光柵或者點陣等簡單表面結構。該工藝具有不用使用掩模板,可以大面積快速地加工表面納米結構等諸多優點,在大批量生產時可以極大地降低成本。而這些大面積周期性表面納米結構,由于其在光學、表面化學、生物學領域表現出很多的優異性能[6~8],因此,激光干涉光刻工藝對于研究這些領域具有重要意義。
本文主要介紹了以勞厄干涉儀為基礎的激光干涉光刻(Lloyd’s-Mirror laser interference lithography)設備的開發研究工作,以波長為325 nm紫外激光器為光源,通過較為簡單的光路系統在樣品平臺形成亞微米級別干涉條紋,并利用紫外波段光刻膠(i-line photoresist)記錄所成圖像,進而加工出表面納米圖形。通過實驗對幾種光刻膠在該工藝中的性能特點進行對比,為激光干涉光刻技術更廣闊的應用提供了較為重要的參考。
1 激光干涉平臺的搭建
激光干涉光刻的基本原理是通過2束或者多束相干光形成亞微米或者微米級別的干涉圖形,并通過光刻膠對這些圖形進行感光,進而加工出表面微納結構。
1.1 基本原理
本文中主要研究的是勞厄激光干涉光刻系統,其原理如圖1(a)所示,當2束波長為λ,強度同為I0的平面波分別以相同的入射角θ對稱地射到同一平面,該平面的光強分布可以寫為

式中k=2π/λ。因此,可在垂直于x軸方向的平面上形成光柵線條圖案,其周期為p,可以寫為

對于涂有光刻膠的襯底進行一次曝光后可以形成周期性的光柵結構。從公式(2)可以看出,光柵的周期由入射角和入射光波長決定,當入射光波長一定時,入射角越小,光柵周期越大;相反,則光柵周期越小,如圖1(b)所示。如果將涂有光刻膠的樣品進行一次曝光后,將其旋轉90°可以以同樣的條件進行二次曝光,在理想情況下,干涉場內的光強分布可以寫為

在分別垂直于x,y軸2個方向的光柵焦點上,可以得到均勻分布的點陣列,其中,2個方向周期均為p。而在工藝過程中,如果通過對于曝光劑量的控制,以及2次曝光設置不同參數,可以得到更為豐富的表面結構[9,10]。
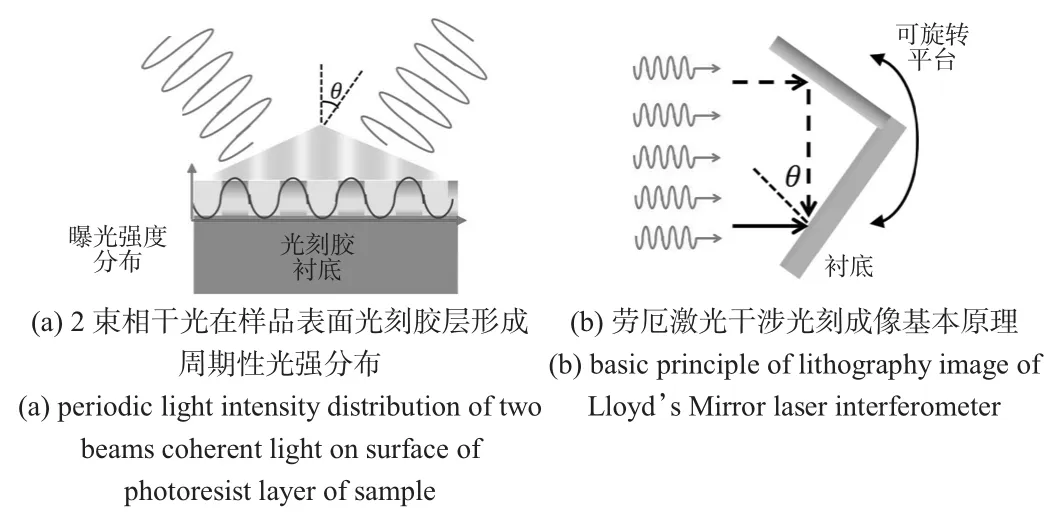
圖1 激光干涉光刻原理圖Fig 1 Principle diagram of laser interfence lithography
1.2 勞厄激光干涉光刻平臺的搭建
本文中使用勞厄干涉光刻系統,如圖2所示,使用325 nm波長的紫外激光器作為光源,激光從激光器出射后經過透鏡(焦距:f=5.77 mm)進入小孔(直徑:D=10 μm),在小孔處一些雜光將被濾掉,光通過小孔后擴束照射在樣品平臺上。在平臺處光斑可近似為相干的平面波,一部分光直接照射在襯底上,而另外一部分照射在反射鏡上,被鏡面反射到襯底上,從而與直接照射在襯底上光形成干涉,形成干涉條紋。根據公式(2),可以容易地通過旋轉樣品臺來改變激光的入射角和控制樣品的曝光時間,從而改變圖形的周期和所獲圖形的占空比。
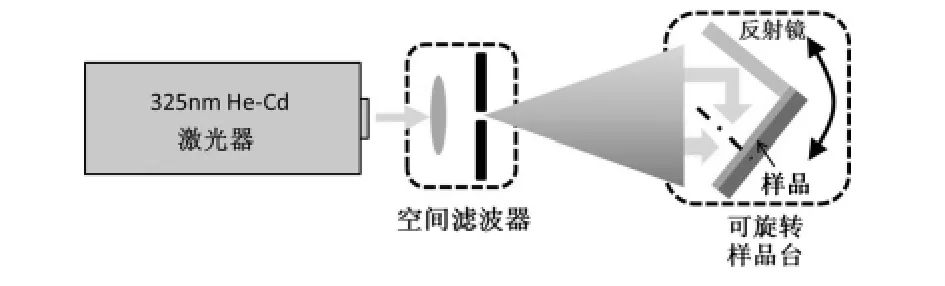
圖2 激光干涉光刻光學系統Fig 2 Optical system of laser interference lithography
2 對表面納米結構的加工
本工作使用波長為325 nm的紫外激光器為光源,因此,在表面結構加工中使用紫外光刻膠(i-line photoresist)用來記錄樣品平臺上的干涉條紋。根據干涉光刻理論和光刻膠在曝光中性質,可以通過在一次曝光后旋轉一定角度進行2次曝光、改變入射角角度和控制工藝過程中的曝光劑量來完成不同周期(period)和不同占空比(duty-cycle)的表面納米結構制作,這種工藝不僅可以得到簡單的光柵結構,而且可以得到更為復雜的二維結構,這些結構包括圓形點陣(線陣)、方形點陣(線陣)、周期性珠簾結構等。
2.1 表面納米結構加工
2.1.1 實驗參數
本實驗中,用蘇州瑞紅RZJ—304正性光刻膠來研究不同表面納米結構的制作。使用半導體工藝標準清洗流程對硅片進行清洗,以確保其表面的清潔。再將光刻膠旋涂在清洗好的硅片上(8000rpm,40s)得到厚度約700nm的光刻膠薄膜。之后,將硅片放置在熱板上進行前烘以使光刻膠中的溶劑揮發(90℃,15 min)。在曝光過程中,將硅片放置在干涉光刻儀中的樣品平臺上,通過調節旋轉平臺的角度來控制入射角度,進而對樣品進行曝光,曝光時間會根據入射角度的變化和加工不同表面結構而進行相應的調整,例如:在制作周期為1500 nm的光柵結構時,入射角為6.2°,曝光劑量為2.7 mJ。在加工二維周期性點陣結構時,可以將每次曝光劑量減為總曝光劑量的50%,這樣經過2次曝光后,可以在樣品表面形成二維結構,例如:在加工周期為2 μm二維點陣樣品時,單次曝光劑量約為1.3 mJ。樣品曝光后使用 RZJ—3038(蘇州瑞紅)顯影液對其顯影(30~60 s),之后再用去離子水沖洗干凈后,將樣品放在熱板上進行堅膜(110℃,15 min)。這樣,就可以得到相應的表面納米結構。
2.1.2 實驗結果討論
在激光干涉光刻工藝中,曝光過程是決定樣品形貌與質量的關鍵。對于正性光刻膠來講,在曝光劑量達到閾值后,占空比隨著曝光劑量的增加而減小,因此,可以通過對曝光劑量的控制達到加工不同占空比的結構。圖3為使用激光干涉光刻工藝加工的表面納米結構的光鏡照片,圖3(a)所示的光柵結構可以通過控制曝光劑量獲得不同粗細的線條寬度。而通過控制二次曝光工藝的曝光劑量,這可以加工豐富的二維陣列表面納米結構,如圖3(b),(c),(d)所示。圖3(b)所示的二維點陣納米圖形使用的曝光劑量較大,而圖3(c)二維方形格子結構則是通過減少2次曝光時間得到的,圖3(d)顯示的二維珠簾結構則是通過使用2次不同的曝光劑量得到的。
通過對曝光劑量的控制,不僅可以得到豐富的二維表面結構,而且可以得到許多不同的結構形貌,如圖4所示。在二維結構的加工中,較大的曝光劑量可以得到針尖形的表面形貌,如圖4(b),(c)所示;而較小的曝光劑量可以得到二位波浪形的表面形貌,如圖4(d)所示。這些特殊結構具有很多新穎的界面和光學特性,具有很高的科研和應用價值,因此,激光干涉光刻由于其簡單的操作方法和無掩模特征,在表面納米結構加工領域具有無可比擬的優勢。
2.2 干涉光刻工藝中對4種光刻膠性能對比
2.2.1 實驗參數
激光干涉光刻對于光刻膠的要求較為嚴格。首先,光刻膠薄膜要較薄(<500 nm),有較高的分辨率(<500 nm)以及較短的感光時間,并且在曝光過程中有著較大的曝光劑量允許度(即工藝窗口),最后,要有較好的物理化學穩定性。因此,為了更好地進行納米結構加工,本文對4種紫外光刻膠進行了研究,分別是SU—8 2000.5和 Futurex NR71—250P負性光刻膠以及Futurex PR1—500A和蘇州瑞紅RZJ—304正性光刻膠。實驗參數如表1所示。

表1 4種光刻膠在干涉光刻工藝中的實驗參數Tab 1 Experimental parameters of four kinds of photoresists in interference lithography process
2.2.2 實驗結果討論
通過對于4種光刻膠在干涉光刻工藝中的性能表現,如圖5所示,在不同尺度不同結構的表面納米圖形的加工中表現出不同的特點,總結出這4種光刻膠的特點如下:
SU—8 2000.5+thinner(1∶3):SU—8 具有較高的光學敏感性和光學分辨率,在工藝過程中使用稀釋液(thinner)可以將光刻膠層厚度降低到100 nm左右,這非常有利于表面納米結構的加工質量,因此,在小周期表面結構(300~500 nm)加工中表現出較高的精度。但由于該光刻膠的光學敏感性太強,致使在加工中工藝窗口較小,對于曝光劑量控制要求較為嚴格,對于工藝參數要求過于精準,因此,在加工過程中成品率較低。
Futurex NR71—250P:這種光刻膠由于其較低的粘度可以在襯底表面制作低于100 nm厚度的光刻膠層,并且由于其在保證較高的光學分辨率的前提下有著較大的工藝窗口,因此,可以使用較廣范圍的曝光劑量,從而更加有利于加工復雜結構。該光刻膠在300 nm~3 μm區間的納米結構加工中均表現出較高的分辨率,具有成品率高,樣品質量較好的特點。
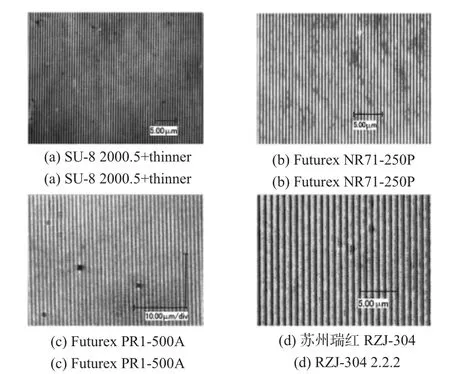
圖5 干涉光刻工藝使用4種光刻膠加工光柵結構的結果對比Fig 5 Comparison of results of grating structure fabricated by inteference lithography process with four kinds of different photoresist
Futurex PR1—500A:這種光刻膠粘度較低,可以在襯底上制作較小厚度的光刻膠層(~200 nm)。但是由于其光學敏感性較低,感光時間較長,在工藝過程中,需要較大的曝光時間(5~10 min),這對于加工數百納米尺度表面結構會有較大不利影響。在實驗過程中使用,盡管這種光刻膠在小尺度(<500 nm)納米結構加工中表現出較好的分辨率,但由于其較長的曝光時間,并不適合大批量加工樣品。
RZJ—304:此光刻膠由于其較高的粘度,從而在旋涂時獲得的光刻膠層較厚(>700 nm)。在工藝過程中,在小尺度(<500 nm)周期樣品加工時精度較低,但在較大尺度(500 nm~3 μm)表面結構加工中表現良好,并且該光刻膠具有感光時間短和工藝窗口較大的特點。因此,盡管這種光刻膠穩定性較差,圖形結構無法長時間保存,但是由于這種國產RZJ—304較為低廉的價格和相對穩定的性能,比較適合大批量加工樣品。
通過對于4種光刻膠在干涉光刻工藝中性能的對比,可以總結出:在小尺度表面納米結構加工中Futurex NR71—250P作為一種性能優異的負性光刻膠,以其較高的分辨率和較好的加工質量,可以滿足激光干涉光刻對于光刻膠的苛刻要求。盡管SU—8光刻膠擁有較高的分辨率,但由于其過于敏感的感光性質,并不滿足干涉光刻大批量加工的需求。對于正膠來講,盡管Futurex PR1—500A過長的曝光時間使其不適合大批量加工樣品,但由于其在小尺度時較高的精度,在小尺度結構加工時仍可使用。而蘇州瑞紅RZJ—304膠,由于其較為穩定的的性能和低廉的價格,在大批量加工時有著較大優勢。因此,在使用干涉光刻平臺加工表面結構時,針對不同的結構和這幾種光刻膠的特點可以靈活選用。
3 結論
本文完成對激光干涉光刻設備的搭建和工藝研究,研究了激光干涉光刻工藝在表面納米結構加工中的應用,并且通過對比4種不同性質光刻膠在工藝過程中的性能,完善了以勞厄激光干涉光刻平臺的工藝過程。激光干涉光刻平臺作為一種無需掩模版,操作簡單的加工平臺,在加工大面積、高質量、高效率加工亞微米和微米級別的表面結構時,擁有無可比擬的優勢。因此,通過對激光干涉光刻平臺的更加深入的研究,可以加工出更為豐富的表面結構,這些結構在材料表面處理,生物檢測,自組裝研究等領域有著非常重要的研究價值。該工藝為激光干涉光刻加工納米結構的深入研究奠定了基礎。
[1] Xia D,Ku Z,Lee S C,et al.Nanostructures and functional materials fabricated by interferometric lithography[J].Advanced Materials,2011,23(2):147 -179.
[2] Matsui S,Kaito T,Fujita J,et al.Three-dimensional nanostructure fabrication by focused-ion-beam chemical vapor deposition[J].Journal of Vacuum Science&Technology B:Microelectronics and Nanometer Structures,2000,18(6):3181 -3184.
[3] Hamley I W.Nanostructure fabrication using block copolymers[J].Nanotechnology,2003,14(10):R39.
[4] Zheng J,Yang R,Xie L,et al.Plasma-assisted approaches in inorganic nanostructure fabrication[J].Advanced Materials,2010,22(13):1451-1473.
[5] Liu P,Cui H,Wang C X,et al.From nanocrystal synthesis to functional nanostructure fabrication:Laser ablation in liquid[J].Phys Chem Chem Phys,2010,12(16):3942 -3952.
[6] Du K,Wathuthanthri I,Mao W,et al.Large-area pattern transfer of metallic nanostructures on glass substrates via interference lithography[J].Nanotechnology,2011,22(28):285 -306.
[7] Menezes J W,Ferreira J,Santos M J,et al.Large-area fabrication of periodic arrays of nanoholes in metal films and their application in biosensing and plasmonic-enhanced photovoltaics[J].Advanced Functional Materials,2010,20(22):3918 -3924.
[8] Ni X,Liu Z,Boltasseva A,et al.The validation of the parallel three-dimensional solver for analysis of optical plasmonic bi-periodic multilayer nanostructures[J].Applied Physics A:Materials Science & Processing,2010,100(2):365 -374.
[9] 張 錦,馮伯儒,郭永康,等.用于大面積周期性圖形制造的激光干涉光刻[J].光電工程,2001,28(6):20 -23.
[10] Lü H,Zhao Q,Zhang Q,et al.Fabrication of two-dimensional superposed microstructure by interference lithography[J].Applied Optics,2011,51(3):302 -305.

