硅通孔銅互連甲基磺酸銅電鍍液中氯離子的作用
季春花,凌惠琴,曹海勇,李明,毛大立
(上海交通大學材料科學與工程學院,上海 200240)
硅通孔銅互連甲基磺酸銅電鍍液中氯離子的作用
季春花,凌惠琴*,曹海勇,李明,毛大立
(上海交通大學材料科學與工程學院,上海 200240)
研究了硅通孔(TSV)鍍銅用甲基磺酸銅高速鍍液(由Cu(CH3SO3)240 g/L、甲基磺酸60 g/L及Cl?50 mg/L組成)中氯離子的作用機理。采用旋轉圓盤電極研究了不同擴散條件下Cl?的作用效果,并采用電化學阻抗譜(EIS)和電子順磁共振(EPR)探討了 Cl?在銅電化學沉積中的影響機制和對 Cu+配位場的影響。結果表明:在深孔內擴散控制條件下,Cl?對銅沉積有明顯的加速作用;在表面非擴散控制區(qū)域,尤其是高電流密度區(qū),Cl?具有一定的抑制效果。因此,Cl?的存在有利于改善TSV深孔鍍銅填充效果,提高填充速率。
硅通孔;銅互連;電鍍;氯離子;甲基磺酸鹽
1 前言
隨著信息化社會的發(fā)展,人們希望電子產(chǎn)品具有更強的功能、更小的體積、更低的價格。但半導體特征尺寸目前已接近物理極限,以往通過減小芯片特征尺寸的方法已無法滿足上述需求。基于TSV(Through-Silicon Via,硅通孔)垂直互連的三維疊層封裝為業(yè)界提供了一種全新的途徑。該技術能夠使芯片在三維方向堆疊的密度最大,外形尺寸最小,能大大提高信號傳輸速度,降低功耗[1-2]。TSV深孔鍍銅技術是 TSV三維封裝能否順利實現(xiàn)產(chǎn)業(yè)化的關鍵技術之一,但由于深孔鍍銅技術難度大、成本高(約占整個 TSV三維封裝成本的40%)、沉積速率慢,很多問題亟待解決,因此成為當前三維電子封裝技術的一個重要研究熱點。
深孔鍍銅技術與普通鍍銅技術有很大不同,其難點在于必須保證銅在深孔內優(yōu)先沉積,在很短的時間內完成無縫隙、無孔洞填充,即達到所謂超填充效果[3]。超填充是指孔底的沉積速率比孔口的快,而只有在電鍍液中添加多種特殊的添加劑才會形成超填充鍍銅。通常在鍍液中添加的有機添加劑分為 3類:抑制劑、加速劑和整平劑。除此而外,還需要加入一定量的Cl?。一般認為,Cl?在硫酸銅鍍銅液中具有3個方面的作用:首先,在抑制劑作用過程中,Cl?與Cu2+形成的Cu+–Cl?配位體,為抑制劑的吸附提供了活性區(qū)域,使抑制劑能夠更好地吸附在電極表面,從而形成阻擋層[4-6];其次,在加速劑作用過程中,加速劑能夠和Cl?結合而形成導通橋,加速傳質過程,從而提高Cu2+的反應速率[6-8];再次,Cl?自身與Cu2+的反應過程中形成了“離子橋”,起到催化作用[4-5,9-11]。另外,Cl?對銅沉積層的結構、晶粒取向和表面反應動力學都有一定的影響。
TSV深孔鍍銅又與印制線路板和大馬士革銅互連電鍍有所不同,硅孔的深寬比遠高于常規(guī)的印制線路板和大馬士革鍍銅,除填孔技術難度大以外,為了降低成本、提高生產(chǎn)效率,要求填孔速率盡可能地快。而印制線路板和大馬士革鍍銅用的鍍銅液主要為傳統(tǒng)的硫酸銅鍍液。由于硫酸銅鍍液要求酸度較高,受其影響,硫酸銅溶解度較低,Cu2+濃度無法提高。若采用該體系進行TSV深孔鍍銅,電鍍時間較長,生產(chǎn)效率很難滿足工業(yè)要求。甲基磺酸銅鍍液允許的Cu2+濃度遠遠高于硫酸銅鍍液,因此可以大大提高沉積速率[12-13],是TSV深孔鍍銅的理想選擇。但甲基磺酸銅鍍液屬于有機酸鹽體系,在鍍液性質、填充機理和添加劑選擇等方面與傳統(tǒng)硫酸銅鍍液體系有很大差異,而目前相關的報道較少,因此需要對該鍍液體系進行深入系統(tǒng)的研究。鑒于這一情況,本文采用電化學線性掃描、電化學阻抗譜分析和 EPR(電子順磁共振)測試等手段,針對甲基磺酸銅鍍液中微量Cl?對TSV深孔鍍銅的影響及作用機理展開深入研究。
2 實驗
Cl?在甲基磺酸銅鍍液中的存在形態(tài)用 EMX-8 EPR光譜儀進行測試。測試溶液中 Cu2+的濃度為10 mmol/L,Cl?質量濃度為50 mg/L。測試在室溫下進行。
不同擴散條件下Cl?的作用效果采用CHI660C電化學工作站測定。采用三電極兩回路系統(tǒng),對電極為鉑電極,參比電極為飽和甘汞電極(SCE)。為測定不同擴散條件下Cl?離子對電極反應的影響,工作電極采用旋轉玻碳電極,轉速分別是150、500、1500和2500 r/min。甲基磺酸銅基礎鍍液的組成為:Cu(CH3SO3)240 g/L,甲基磺酸(MSA)60 g/L,Cl?50 mg/L。線性掃描曲線的測試電壓區(qū)間為0.1 V ~ ?0.4 V,掃描速率為5 mV/s,電流靈敏度為1 × 10?6A/V。電化學阻抗測試在?0.05 V電位下進行,掃描頻率從10 000 Hz到0.01 Hz。
為了考察Cl?對實際TSV深孔鍍銅的影響,進行了實際樣片的電鍍。所用TSV芯片由國外廠家提供,硅孔尺寸為:深度120 μm,孔口直徑60 μm,孔底直徑40 μm。電鍍槽中使用鍍液為1 L,陽極為電解純銅板,陰、陽極分置于電鍍槽兩端。所用甲基磺酸銅鍍液是在上述基礎鍍液中添加了抑制劑300 mg/L、加速劑5 mg/L及整平劑20 mg/L。電鍍時采用GWINSTEK PSM2010直流恒流電源,鍍液采用磁力攪拌,恒溫25 °C,電流密度為1.0 A/dm2,電鍍時間為90 min。
3 結果與討論
3. 1 Cl?對Cu2+配位場的影響
圖1是基礎鍍液中不含Cl?和含Cl?時的EPR圖譜。通過對比可知,甲基磺酸銅有3個順磁中心,其g因子分別為:g1= 2.143 02,g2= 2.248 14,g3= 2.727 93。加入Cl?后,g值沒有發(fā)生變化,但是譜線的強度發(fā)生了改變,g1的強度有所減小,g2的強度增強,g3處發(fā)生了超精細分裂現(xiàn)象。g2和g1的值很接近Cu2+與結晶水以配合鍵結合的信號[14-15],g3則是 Cu2+與甲基磺酸根之間的鍵合作用。因此可以認為,加入Cl?后出現(xiàn)的超精細分裂現(xiàn)象除因為甲基磺酸根與 Cu2+配位之外,還由于Cl?離子參與了配位。

圖1 甲基磺酸銅鍍液電子順磁共振分析結果Figure 1 Results of electron paramagnetic resonance analysis for methanesulfonate copper plating bath
本研究顯示甲基磺酸根會與 Cu2+配位,并且加入Cl?后,Cl?與甲基磺酸根一起參與配位,形成了離子橋。比如,一個Cl?可能和2個或更多的Cu2+配位,在Cu2+之間形成氯橋。氯橋可以使 Cu2+的未成對電子離域,從而在相鄰Cu2+之間強烈作用而形成偶極耦合。另外,氯橋可以在一定條件下加快 Cu2+的電子轉移,進而對Cu2+還原起到加速作用。
3. 2 Cl?對Cu2+電化學還原反應的影響
依據(jù)對圖1的分析可知,在一定條件下Cl?在Cu2+之間能形成氯橋,而 Cu2+還原反應一般分為兩步,即Cu2+/Cu+和 Cu+/Cu。為弄清甲基磺酸銅鍍液體系中這兩步反應的基本情況以及Cl?對它們的影響,借助電化學阻抗測試作進一步分析。圖2給出了不同Cl?質量濃度的鍍液的電化學阻抗譜。圖 2結果顯示,高頻區(qū)出現(xiàn)了半圓弧(容抗弧),這是交換電流電阻和雙電層電容共同作用所形成的,因此這個容抗弧在各鍍液中都會存在,并且對應于 Cu2+/Cu+反應過程的交換電流反應[16-18]。容抗弧的半徑代表交換電流電阻,并且當Cl?含量只有10 mg/L時,該半徑就減小了一半,而隨著Cl?的繼續(xù)添加,半徑逐漸減小,說明 Cl?起到降低Cu2+/Cu+反應電阻,提高還原速率的作用。從圖2中還可以看出,中頻區(qū)出現(xiàn)了一個由Cu+/Cu的快速反應過程決定的很小的容抗弧,而且隨著Cl?用量的增加,這個小的容抗弧略微減小。這說明Cl?對Cu+/Cu快速反應的速率影響不大。低頻區(qū)出現(xiàn)的曲線被認為是由沉積過程中Cu2+擴散作用而產(chǎn)生的Warburg阻抗,它是衡量Cu2+擴散作用的最重要的參數(shù)。

圖2 含不同質量分數(shù)Cl?的甲基磺酸銅鍍液的電化學阻抗譜Figure 2 Electrochemical impedance spectra of methanesulfonate copper plating baths with different mass fractions of Cl?
總之,根據(jù)電化學阻抗譜分析,Cl?能大大加快Cu2+/Cu+反應,而對Cu+/Cu反應速率影響較小,結合圖1的分析結果,可以認為Cl?的加速作用主要是通過氯橋來加強Cu2+/Cu+反應的電子轉移來實現(xiàn)的。
3. 3 不同電位和擴散條件下Cl?的影響
對于TSV硅孔而言,Cu2+很容易達到表面及孔口,還原反應受擴散影響較小,且在一次電流分布中電力線較為集中,過電位較大。而孔內為凹陷部分,Cu2+很難達到,受擴散影響較大,同時深孔內電力線分布非常稀疏,過電位較小。為了研究不同電位和不同擴散條件下Cl?對Cu2+還原反應的影響,測量了不同電極轉速下的電化學極化曲線,結果見圖3。從圖3a可以看出,在轉速150 r/min的條件下,Cl?的存在大大加速了銅的沉積速率。而在轉速為500 r/min的條件下,Cl?的加速作用要小得多(見圖3b)。從圖3c可以發(fā)現(xiàn),在1 500 r/min轉速下隨著陰極過電位的增加,Cl?的作用由加速轉變成了抑制。同樣,當轉速變?yōu)? 500 r/min時,Cl?的抑制作用范圍擴大。由此可見,Cl?的作用與過電位、擴散條件有很大的關系,即當過電位較低、擴散影響較大時,Cl?主要起加速作用;當過電位較高、擴散影響較小時,Cl?表現(xiàn)為抑制作用。對比TSV孔內、孔口的情況不難看出,Cl?的存在將有利于過電位較低、擴散影響較大的深孔內鍍銅,會提高深孔內的沉積速率,而且反過來抑制孔口和孔外 Cu2+的還原,降低孔外的鍍銅速率。Cl?的這種“孔內加速,孔口抑制”的效果,有利于提高甲基磺酸銅鍍液的TSV填充效果。

圖3 不同玻碳電極轉速下含與不含50 mg/L Cl?甲基磺酸銅鍍液的極化曲線Figure 3 Polarization curves for methanesulfonate copper bath with and without 50 mg/L Cl? at different rotation rates on glassy carbon electrode
3. 4 Cl?對實際電鍍的作用效果
為了驗證以上分析,考察了有無Cl?的實際電鍍效果,實驗結果見圖4。
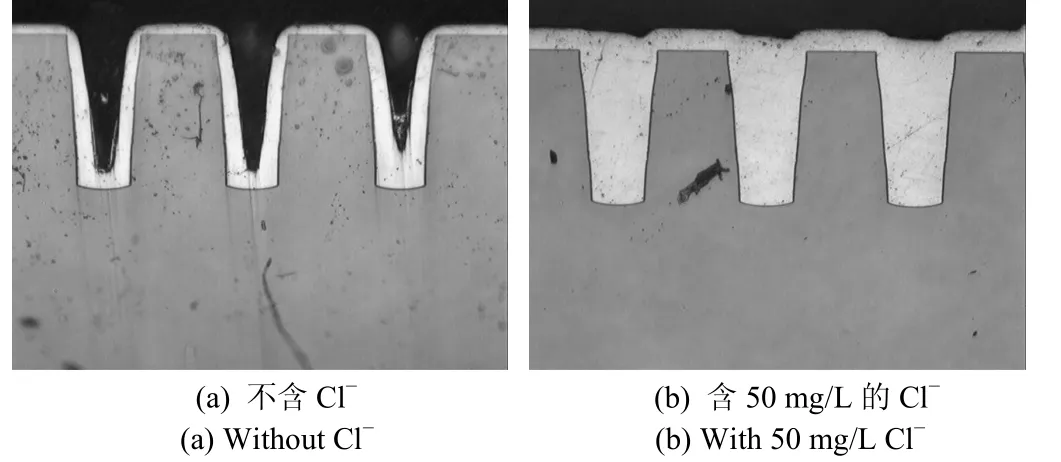
圖4 Cl?離子對甲基磺酸銅鍍液TSV填充效果的影響Figure 4 Effect of Cl? ion on TSV filling in methanesulfonate copper plating bath
從圖4可以直觀看到,Cl?的存在對甲基磺酸銅鍍液的電鍍填充效果影響巨大。無Cl?存在時,雖然在孔的底部表現(xiàn)出一定的加速效果,但沉積速率緩慢,并且主要表現(xiàn)出等壁生長的特點。在添加了Cl?之后,沉積速率顯著提高,在同樣的電流密度和電鍍時間下,快速實現(xiàn)了無缺陷全填充。該結果進一步證明了上述分析的正確性,即微量 Cl?在甲基磺酸銅鍍液中的存在,對TSV銅互連深孔電鍍具有很好的加速填充作用。
4 結論
本文系統(tǒng)研究了TSV三維電子封裝垂直銅互連用甲基磺酸銅高速鍍液中Cl?的影響及作用,獲得如下結論:
(1) 除甲基磺酸根與Cu2+配位之外,Cl?也參與配位形成氯橋。氯橋可以使Cu2+的未成對電子離域,從而加快Cu2+的電子轉移,使Cu2+還原加快。而Cl?的加速作用主要體現(xiàn)在加速Cu2+/Cu+步驟的還原反應中。
(2) Cl?對受擴散控制的低轉速、低過電位區(qū)表現(xiàn)為加速作用,對非擴散控制的高轉速、高過電位區(qū)呈現(xiàn)出一定的抑制效果。因此,Cl?的存在將有利于改善受擴散影響較大的TSV深孔內電鍍,提高填充速率。
(3) 通過TSV深孔的實際電鍍對比,進一步證明Cl?的存在對甲基磺酸銅鍍液的電鍍填充效果影響巨大。無Cl?存在時沉積速率緩慢,填充效果不明顯,主要表現(xiàn)為等壁生長,而在 Cl?存在下沉積速率顯著提高,可快速實現(xiàn)無缺陷全填充。
致謝
本研究得到了上海新陽半導體材料股份有限公司的諸多幫助,在此深表謝意。
[1] KHAN N, YOON S W, VISWANATH A G K, et al. Development of 3-D stack package using silicon interposer for high-power application [J]. IEEE Transactions on Advanced Packaging, 2008, 31 (1): 44-50.
[2] TSUI Y K, LEE S W R. Design and fabrication of a flip-chip-on-chip 3-D packaging structure with a through-silicon via for underfill dispensing [J]. IEEE Transactions on Advanced Packaging, 2005, 28 (3): 413-420.
[3] ANDRICACOS P C, UZOH C, DUKOVIC J O, et al. Damascene copper electroplating for chip interconnections [J]. IBM Journal of Research and Development, 1998, 42 (5): 567-574.
[4] GARRIDO M E H, PRITZKER M D. Inhibition of copper deposition by polyethylene glycol and chloride: II. Analysis and application [J]. Journal of the Electrochemical Society, 2009, 156 (5): D175-D183.
[5] DOW W P, HUANG H S, YEN M Y, et al. Roles of chloride ion in microvia filling by copper electrodeposition: II. Studies using EPR and galvanostatic measurements [J]. Journal of the Electrochemical Society, 2005, 152 (2): C77-C88.
[6] HUNG C C, WANG Y L, LEE W H, et al. Competitive adsorption between bis(3-sodiumsulfopropyl disulfide) and polyalkylene glycols on copper electroplating [J]. Journal of the Electrochemical Society, 2008, 155 (9): H669-H672.
[7] LEE C H, LEE S C, KIM J J. Bottom-up filling in Cu electroless deposition using bis-(3-sulfopropyl)-disulfide (SPS) [J]. Electrochimica Acta, 2005, 50 (16/17): 3563-3568.
[8] TAN M, GUYMON C, WHEELER D R, et al. The role of SPS, MPSA, and chloride in additive systems for copper electrodeposition [J]. Journal of the Electrochemical Society, 2007, 154 (2): D78-D81.
[9] SOARES D M, WASLE S, WEIL K G, et al. Copper ion reduction catalyzed by chloride ions [J]. Journal of Electroanalytical Chemistry, 2002, 532 (1/2): 353-358.
[10] SHAO W, PATTANAIK G, ZANGARI G. Influence of chloride anions on the mechanism of copper electrodeposition from acidic sulfate electrolytes [J]. Journal of the Electrochemical Society, 2007, 154 (4): D201-D207.
[11] SHIMA M, SALAMANCA-RIBA L, MCMICHAEL R D, et al. Magnetic properties of ultrathin laminated Co/Cu films prepared by electrodeposition [J]. Journal of the Electrochemical Society, 2002, 149 (9): C439-C444.
[12] GERNON M D, WU M, BUSZTA T, et al. Environmental benefits of methanesulfonic acid: Comparative properties and advantages [J]. Green Chemical, 1999, 1: 127-140.
[13] CHRISTEL V W, MARCO S, MARLIES K, et al. 金屬の電解析出方法: JP, 特開2006-63450 [P]. 2006–03–09.
[14] 李澤彬, 張剛, 姚有峰. 五水硫酸銅的電子順磁共振研究[J]. 徐州工程學院學報(自然科學版), 2010, 25 (3): 81-84.
[15] TANI A, UENO T, YAMANAKA C, et al. Construction of imaging system for wild-field-range ESR spectra using localized microwave field and its case study of crystal orientation in suspension of copper sulfate pentahydrate (CuSO4·5H2O) [J]. Applied Radiation and Isotopes, 2005, 62 (2): 343-348.
[16] REID J D, DAVID A P. Impedance behavior of a sulfuric acid–cupric sulfate/copper cathode interface [J]. Journal of the Electrochemical Society, 1987, 134 (6): 1389-1394.
[17] FABRICIUS G, SUNDHOLM G. The effect of additives on the electrodeposition of copper studied by the impedance technique [J]. Journal of Applied Electrochemistry, 1984, 14 (6): 797-801.
[18] KRZEWSKA S. Impedance investigation of the mechanism of copper electrodeposition from acidic perchlorate electrolyte [J]. Electrochimica Acta, 1997, 42 (23/24): 3531-3540.
Effect of chloride ion on through-silicon via filling in methanesulfonic acid copper plating bath //
JI Chun-hua, LING Hui-qin*, CAO Hai-yong, LI Ming, MAO Da-li
The effect of chloride ion on via filling by highspeed plating in a methanesulfonic acid (MSA) bath composed of Cu(CH3SO3)240 g/L, MSA 60 g/L, and Cl?50 mg/L for TSV (through-silicon via) copper interconnection was studied. The influence of chloride ion under different forced convection conditions was discussed using rotating disk electrode. The reaction mechanism of chloride ion during copper electrodeposition and coordination field of copper(I) ion in presence of chloride ion were characterized by electrochemical impedance spectroscopy (EIS) and electron paramagnetic resonance (EPR) analysis, respectively. The results indicated that in the bottom of via where the copper electrodeposition is diffusion-controlled, chloride ion accelerates deposition; while at the top of via where the copper electro- deposition is non-diffusion-controlled, especially at high current density area, chloride ion inhibits deposition. The existence of chloride ion enhances the TSV filling effect and velocity.
through-silicon via; copper interconnection; electroplating; chloride ion; methanesulfonate
Institute of Materials Science and Engineering, Shanghai Jiaotong University, Shanghai 200240, China
TQ153.14
A
1004 – 227X (2012) 02 – 0006 – 04
2011–10–13
2011–11–17
國家自然科學基金項目(青年基金)“TSV硅通孔甲基磺酸鍍銅高速填充機理研究”(61006072)。
季春花(1987–),女,江蘇人,在讀碩士研究生,研究方向是TSV三維封裝用銅互連電鍍技術。
凌惠琴,講師,(E-mail) hqling@sjtu.edu.cn,(Tel) 021–34202748。
[ 編輯:溫靖邦 ]

