氮氧化硅薄膜紅外吸收特性的研究
周順,劉衛國,蔡長龍,劉歡
(1.西安電子科技大學 微電子學院,陜西 西安710071;2.西安工業大學 陜西省薄膜技術與光學檢測重點實驗室,陜西 西安710032)
0 引言
氮氧化硅(SiOxNy)薄膜因兼具氧化硅及氮化硅薄膜的優良特性,受到了廣泛關注。近年來,SiOxNy薄膜已在微電子學領域中得到重要應用,被認為將替代熱氧化SiO2作為柵極材料,從而可以提高介電常數、改善阻止雜質擴散的能力和抗輻射能力[1]。同時,SiOxNy薄膜在集成光學領域也得到深入研究。通過改變薄膜中各元素比例來調節薄膜的折射率與消光系數,可以用作光波導材料[2-3]、梯度折射率薄膜[4]以及減反射膜。SiOxNy薄膜折射率調節范圍大的特點為集成光學設計提供了極大的自由度。另外,SiOxNy薄膜還可以作為硅基發光材料[5]。
在紅外吸收特性研究方面,大量文獻研究作為光波導材料的SiOxNy薄膜在波長1.55 μm 左右處的吸收,因為該吸收處于第3 代光纖通訊窗口內,研究目的是降低此處的吸收,從而可以減少通訊能量的損耗。研究主要圍繞如何降低薄膜中N—H、O—H 鍵的含量而開展工作,而對SiOxNy薄膜在長波紅外窗口波長8~12 μm 內的吸收特性研究較少。測試表明,SiOxNy薄膜在波長8~12 μm 內具有較強的吸收。利用此特性可以將其作為熱探測器[6](熱釋電、非晶硅等非制冷紅外探測器)的選擇性吸收層材料。相對于以薄金屬層為代表的寬帶吸收,選擇吸收可以降低環境背景輻射的影響。此外,可以通過調節SiOxNy薄膜的組分來改變它的吸收峰峰值波長,使其吸收特性與人體的長波紅外輻射特性較好匹配。具有該選擇吸收層的熱探測器可用于智能駕駛,入侵報警等系統[7]。文獻[7-8]報道了采用SiOxNy薄膜作為熱探測器的吸收材料,但未研究工藝參數對SiOxNy薄膜吸收峰的影響。
本文利用等離子體增強的化學氣相沉積法(PECVD)沉積SiOxNy薄膜,研究不同N2O 與NH3流量比R 下薄膜的組分及光學常數,對其紅外吸收光譜進行研究,尤其是研究其在長波紅外窗口波長8~12 μm 內的吸收,探討工藝參數與吸收峰之間的關系。
1 實驗方法
SiOxNy薄膜是利用日本SAMCO 公司PD-220N型PECVD 設備沉積而成,該設備是一典型的平行板式等離子沉積臺,等離子體放電射頻電源的頻率為13.56 MHz.基底為單、雙面拋光的硅片(100),電阻率5~9 Ω·cm,沉積前基底用標準清洗工藝清洗后烘干,反應氣體為SiH4(90%Ar 稀釋)、NH3和N2O.固定SiH4與NH3的流量分別為60 cm3/min 與40 cm3/min,N2O 流量在10~50 cm3/min 范圍內變化以獲得不同組分的SiOxNy薄膜。沉積溫度為350 ℃,反應壓強為120 Pa,功率密度為0.5 W/cm2.沉積的薄膜厚度約250 nm.此外,為了進行比較,還沉積了SiOx、SiNx薄膜。SiOx薄膜是采用SiH4與N2O 反應生成;SiNx薄膜采用SiH4與NH3反應生成,其它工藝參數與沉積SiOxNy薄膜相同,沉積條件如表1所示。

表1 SiOxNy、SiNx、SiOx薄膜沉積工藝參數Tab.1 Deposition conditions of SiOxNy,SiNx and SiOxfilms
實驗中,2 種氣體流量比(R 為N2O 與NH3流量比,R0為NH3+N2O 與SiH4流量比)對薄膜的組分及微結構影響尤為重要。R 值大小決定沉積薄膜中O 與N 元素的含量比,而R0值的大小則決定薄膜是否富硅。為了獲得高質量的光學薄膜,以利于今后將其作為增透膜、梯度折射率薄膜等在光學上的應用,采用較大的R0,確保薄膜中不存在Si—Si 鍵或其含量較低,因為它的存在會增加薄膜在可見光及近紅外區的吸收。沉積溫度選擇350 ℃,目的是使生長的薄膜更致密,較好滿足光學應用。
采用英國Kratos 公司AXIS ULTRA 型X 射線光電子能譜儀來測試薄膜元素的結合能及相對含量,譜線采用C 1s 峰(結合能284.8 eV)進行校正。采用美國Perkin-Elmer 公司Spectrum GX 型傅里葉變換紅外光譜儀分別測試硅基底與薄膜樣品的透射率,并將其轉化為吸收度。文中吸收度測試曲線已消除Si 基底的吸收。薄膜的光學常數(厚度、折射率和消光系數)采用美國J.A.Woollam 公司M-2000型變角度光譜橢偏儀測量,文中所給出的折射率數據對應測試波長為633 nm.
2 結果及討論
2.1 薄膜組分分析
圖1給出了不同N2O 與NH3流量比R 下SiOxNy薄膜樣品的元素相對百分含量。由圖可見,流量比R 的增加導致薄膜中的O 含量增加,N 含量減小,而Si 的含量基本不變。這是因為反應過程中N2O 是SiOxNy薄膜中O 源的供應者,而NH3則是N 源的主要供應者。由于化學鍵鍵能不同,在形成的等離子體反應過程中,Si 的游離基先與O 的游離基反應生成Si—O 鍵(鍵能799.6 kJ/mol),只有當所有的O被反應完后,Si—N(鍵能470.0 kJ/mol),Si—H(鍵能299.0 kJ/mol)和N—H(鍵能339.0 kJ/mol)鍵才會形成[9-10]。因此,隨著流量比R 的增加,等離子體中O 游離基的濃度增大,從而增加了O 原子與Si原子的結合,抑制了N 原子與Si 原子的結合,造成薄膜中的O 含量提高,N 含量降低。

圖1 不同流量比R 下的SiOxNy 薄膜的元素相對含量Fig.1 Atomic concentration of the SiOxNy films deposited at different flow ratios R
圖2為不同流量比R 下SiOxNy薄膜的Si 2p 峰位的變化,圖中同時給出了SiOx、SiNx薄膜的結合能以進行比較。由圖可見,隨著流量比R 的增加,Si 2p 的結合能由102.1 eV 線性增至103.0 eV.此結論與文獻[11]一致。峰位的連續變化說明了薄膜中的Si 含有多種的結合,其微結構也隨著發生變化。對于符合化學計量比的SiOxNy薄膜,Gritsenko等[11]認為該薄膜結構不符合隨機混合模型(RMM),此模型認為薄膜結構是由SiO2、Si3N4相隨機混合組成,而是符合隨機結合模型(RBM),薄膜中含有Si—O 鍵與Si—N 鍵,隨機結合形成5 種4 面體結構SiOvN4-v(v=0,1,2,3,4).對于一定組分的薄膜,各4 面體結構含量可由隨機統計公式計算。
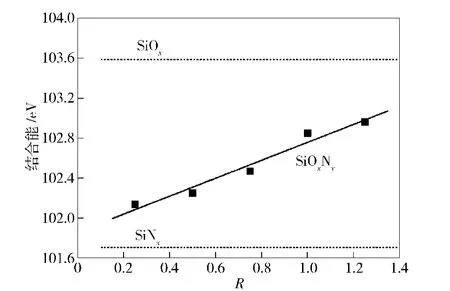
圖2 不同流量比R 下的SiOxNy 薄膜Si 2p 峰的結合能Fig.2 Binding energy of Si 2p peak in the SiOxNy films deposited at different flow ratios R
2.2 紅外吸收光譜分析
圖3為不同N2O 與NH3流量比R 下SiOxNy薄膜的紅外吸收光譜,圖中也給出了SiOx、SiNx的吸收光譜。由圖可見,所有的薄膜在波數650~1 350 cm-1范圍均存在一較強的吸收峰,吸收峰覆蓋了長波紅外窗口8~12 μm 波段,因此可以作為熱探測器的選擇吸收層。
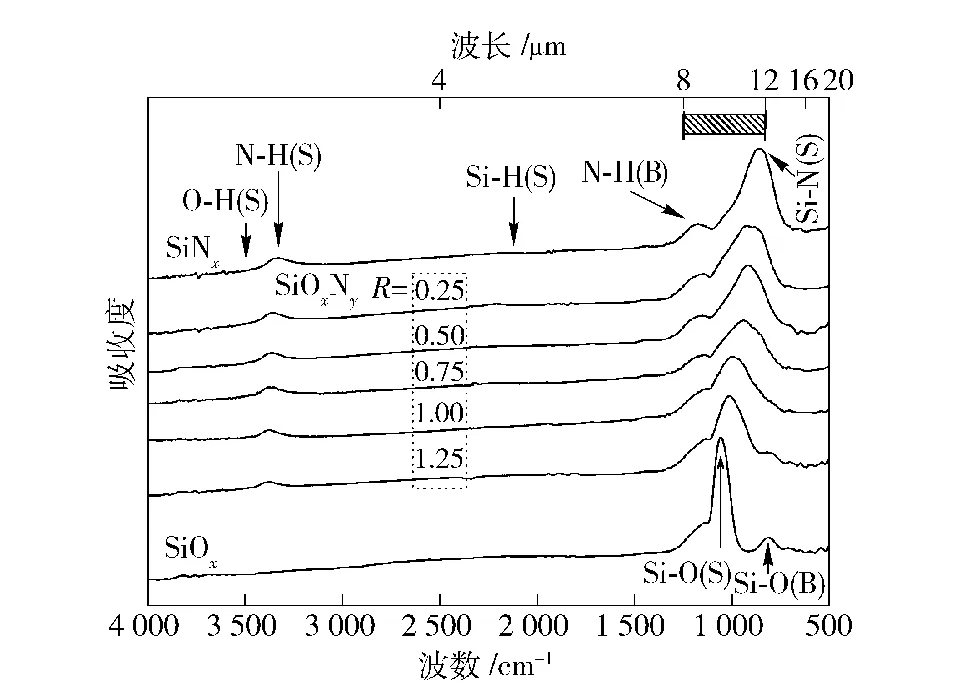
圖3 不同流量比R 下的SiOxNy 薄膜的紅外吸收光譜Fig.3 Infrared absorption spectra of SiOxNy film deposited at different flow ratios R
SiOx薄膜最強的吸收峰位于1 063 cm-1[12],對其高斯解峰,得到位于1 056 cm-1的峰和一個位于1 153 cm-1的左肩寬峰,分別對應于相鄰氧原子在同一相與不同相的非對稱伸縮振動[13]。此外,在815 cm-1還有一個弱的吸收峰,對應于Si—O 彎曲振動,此吸收光譜接近于熱氧化的SiO2的吸收光譜;SiNx薄膜最強的吸收峰位于860 cm-1,能夠被分解為2 個Si—N 伸縮峰,分別位于866 cm-1及980 cm-1[14].
SiOxNy薄膜吸收峰峰值波長在860 cm-1(11.6 μm)與1 063 cm-1(9.4 μm)范圍內變化,且隨流量比R 的增大而向高波數移動。此外,SiOxNy薄膜吸收峰的寬度先增加后減小。吸收峰峰位及寬度的變化與薄膜中的Si—O、Si—N 鍵伸縮振動吸收峰的疊加有關。隨著流量比R 的增加,薄膜中的N 原子被O 原子取代,而O 的電負性比N 的強,造成分子振動頻率的提高[15],這與XPS 結合能分析結論一致。吸收峰寬窄反映了薄膜結構的雜亂程度,由于流量比R 的增加,薄膜中的Si—O 鍵密度增加,Si—N 鍵密度減少,從而影響吸收峰的寬度。這一結果與文獻[16]報道一致,該文獻報道當Si—O 與Si—N 鍵密度相等時,吸收峰寬度最大。
SiOxNy薄膜位于1 175 cm-1及3 350 cm-1處的吸收峰分別對應于N—H 鍵的彎曲及伸縮振動。3 350 cm-1處N—H 鍵吸收峰的一級倍頻峰在波長1.55 μm左右處,研究已表明,SiOxNy薄膜中H 主要以Si—H 鍵、N—H 鍵與O—H 鍵3 種類型存在。由圖可見,沉積的SiOxNy薄膜不存在明顯的O—H 鍵(波數3 500 cm-1)與Si—H 鍵(波數2 170 cm-1)的吸收峰。因此,薄膜中H 的含量主要由N—H 鍵含量決定。按照Lanford 等[17]方法,H 的含量與N—H鍵吸收峰的面積成正比。圖4給出了不同流量比R與H 含量的關系。由圖可見,H 含量隨流量比R 增加而減少。因此可以通過提高流量比R 的方法來沉積低H 含量的SiOxNy薄膜。
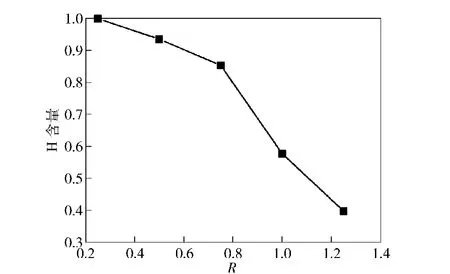
圖4 不同流量比R 下的SiOxNy 薄膜歸一化的H 含量Fig.4 Normalized H content in SiOxNy films deposited at different flow ratios R
目前,常用的熱探測器選擇吸收層材料為氮化硅或氧化硅,為了探討將SiOxNy薄膜作為熱探測器吸收層的應用研究,對薄膜在長波紅外窗口波長8~12 μm 內的吸收強度進行了計算。為此沉積了較厚(>600 nm)的SiOxNy(R=1)、SiOx及SiNx薄膜并進行紅外光譜測試,參考文獻[18]使用的方法,將透射光譜透過率T(ω)轉化為吸收光譜吸收系數α(ω),并分別在波長8~12 μm 內進行積分。轉化后的α(ω)如圖5(a)所示,由圖可見,SiOxNy(R=1)吸收峰的寬度最大。積分歸一化后的結果如圖5(b)所示,結果表明在波長8~12 μm 內,SiOxNy(R=1)薄膜的積分吸收強度最大,因此比SiNx或SiOx薄膜更適合作為吸收層材料。
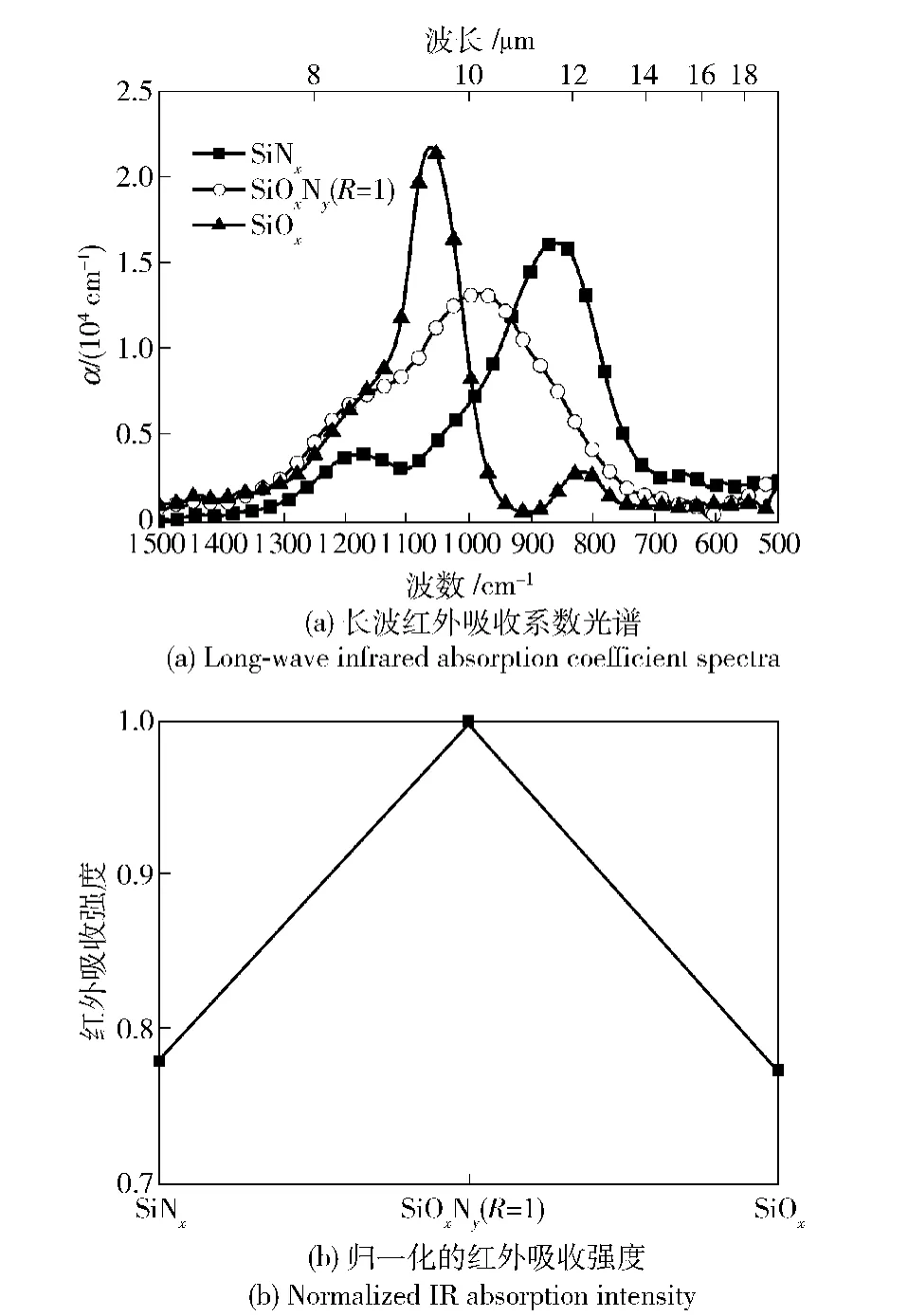
圖5 3 種類型薄膜的紅外吸收特性Fig.5 Infrared absorption properties of the three types of films
2.3 折射率分析
圖6為不同N2O 與NH3流量比R 下薄膜折射率的變化。由圖可見,SiOxNy薄膜折射率在1.84(SiNx)與1.44(SiOx)之間變化。且當流量比R 從0.25 增至1.25 時,薄膜的折射率從1.80 減至1.60.薄膜組分分析結果表明,隨著流量比R 增加,薄膜中的O 含量提高,N 含量降低,生成的薄膜更類似于SiOx薄膜,因而折射率減小。這就便于通過改變流量比R 來調節薄膜的折射率,實現吸收層與紅外敏感層的光學參數匹配,或進行梯度折射率薄膜的研究工作。另一方面,上述薄膜的消光系數k在波長300~1 600 nm 范圍均小于10-6,說明沉積的不是富硅的SiOxNy薄膜,因為富硅會造成薄膜在可見光區的消光系數增大。
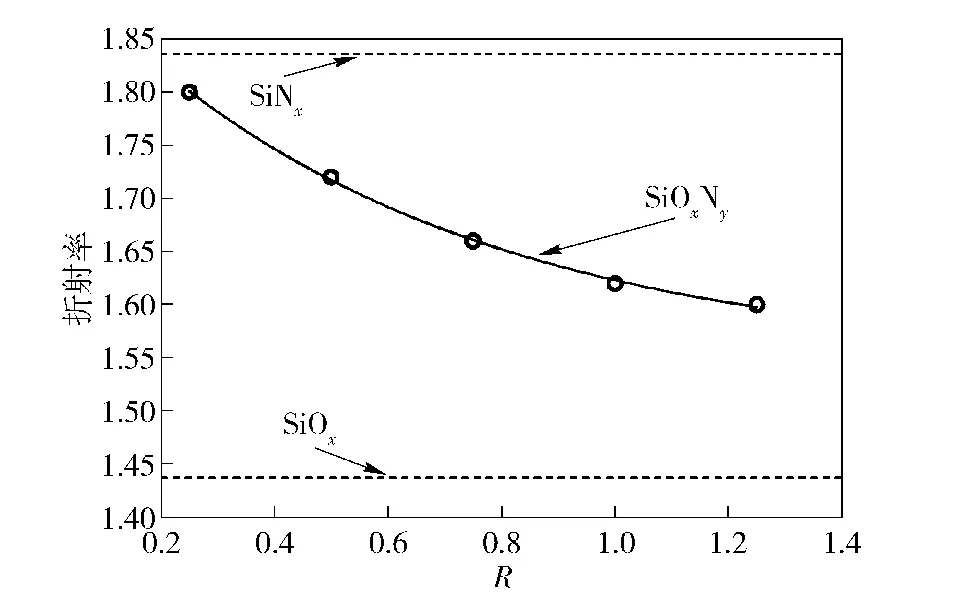
圖6 不同流量比R 下的SiOxNy 薄膜的折射率Fig.6 Refractive indexes of the SiOxNy films as a function of the flow ratio R
3 結論
利用PECVD 方法沉積SiOxNy薄膜,研究了不同N2O 與NH3流量比R 下薄膜的組分、光學常數及紅外吸收特性。隨著流量比R 的增加,SiOxNy薄膜中O 的相對百分含量提高,N 含量降低,而Si 含量基本不變。同時,薄膜由于Si—O、Si—N 鍵形成的吸收峰峰值波長向短波移動,且吸收峰的寬度先增大后減小。此外,薄膜中的H 含量與折射率也隨流量比R 的增加而降低。研究結果表明,SiOxNy薄膜是一種良好的熱探測器選擇吸收層材料。
References)
[1] Green M L,Gusev E P,Degraeve R,et al.Ultrathin (<4 nm)SiO2and Si—O—N gate dielectric layers for silicon microelectronics:understanding the processing,structure,and physical and electrical limits[J].Journal of Applied Physics,2001,90(5):2057-2121.
[2] Germann R,Salemink H W M,Beyeler R,et al.Silicon oxynitride layers for optical waveguide applications[J].Journal of the Electrochemical Society,2000,147(6):2237-2241.
[3] Bona G L,Germann R,Offrein B J.SiON high-refractive-index waveguide and planar lightwave circuits[J].IBM Journal of Research and Development,2003,47(2-3):239- 249.
[4] Weber J,Bartzsch H,Frach P.Sputter deposition of silicon oxynitride gradient and multilayer coatings[J].Applied Optics,2008,47(13):C288-C292.
[5] Dong H P,Chen K J,Wang D Q,et al.A new luminescent defect state in low temperature grown amorphous SiNxOythin films[J].Physica Status Solidi (C)Current Topics in Solid State Physics,2010,7(3-4):828-831.
[6] 劉衛國,金娜.集成非制冷熱成像探測陣列[M].北京:國防工業出版社,2004:250-256.LIU Wei-guo,JIN Na.Integrated uncooled infrared imaging arrays[M].Beijing:National Defense Industry Press,2004:250-256.(in Chinese)
[7] Lenggenhager R,Jaeggi D,Malcovati P,et al.CMOS membrane infrared sensors and improved TMAHW etchant[C]∥IEEE International Electron Devices Meeting.US:San Francisco,1994:531-534.
[8] 董良.MEMS 集成室溫紅外探測器研究[D].北京:清華大學,2004.DONG Liang.Study on MEMS integrated room-temperature infrared detectors[D].Beijing:Tsinghua University,2004.(in Chinese)
[9] Criado D,Alayo M I,Pereyra I,et al.Structural analysis of silicon oxynitride films deposited by PECVD[J].Materials Science and Engineering B,2004,112:123- 127.
[10] Hussein M G,W?rhoff K,Sengo G,et al.Optimization of plasma-enhanced chemical vapor deposition silicon oxynitride layers for integrated optics applications[J].Thin Solid Films,2007,515(7-8):3779-3786.
[11] Gritsenko V A,Xu J B,Kwok R W M,et al.Short range order and the nature of defects and traps in amorphous silicon oxynitride governed by the mott rule[J].Physical Review Letters,1998,81(5):1054-1057.
[12] Dupuis J,Fourmond E,Lelièvre J F,et al.Impact of PECVD SiON stoichiometry and post-annealing on the silicon surface passivation[J].Thin Solid Films,2008,516(20):6954-6958.
[13] 何樂年.PECVD 非晶SiOx∶H 薄膜的Si—O—Si 鍵紅外吸收特性研究[J].真空科學與技術,2001,21(1):60-64.HE Le-nian.Infrared absorption properties of Si—O—Si bonds in plasma deposited amorphous SiOx∶H films[J].Vacuum Science and Technology,2001,21 (1):60-64.(in Chinese)
[14] Ono H,Ikarashi T,Miura Y,et al.Bonding configurations of nitrogen absorption peak at 960 cm-1in silicon oxynitride films[J].Applied Physics Letters,1999,74(2):203-205.
[15] Rebib F,Tomasella E,Dubois M,et al.SiOxNythin films deposited by reactive sputtering:process study and structural characterisation[J].Thin Solid Films,2007,515(7-8):3480-3487.
[16] Prado A D,Mártil I,Fernández M,et al.Full composition range silicon oxynitride films deposited by ECR-PECVD at room temperature[J].Thin Solid Films,1999,343-344(1-2):437-440.
[17] Lanford W A,Rand M J.The hydrogen content of plasma-deposited silicon nitride[J].Journal of Applied Physics,1978,49(4):2473-2477.
[18] Maley N.Critical investigation of the infrared-transmission-data analysis of hydrogenated amorphous silicon alloys[J].Physical Review B,1992,46(4):2078- 2085.

